2ВТП.01 Л2 Акт эл схем кор.PPT
- Количество слайдов: 37
 Военная кафедра Тема 1. Электронные устройства вооружения войск ПВО. Занятие 2 (1/2) Активные элементы электронных устройств Учебные вопросы: 1. Устройство и конструкция электронных ламп. 2. Назначение и характеристики биполярных транзисторов. 3. Назначение и характеристики полевых транзисторов. 4. Назначение интегральных схем.
Военная кафедра Тема 1. Электронные устройства вооружения войск ПВО. Занятие 2 (1/2) Активные элементы электронных устройств Учебные вопросы: 1. Устройство и конструкция электронных ламп. 2. Назначение и характеристики биполярных транзисторов. 3. Назначение и характеристики полевых транзисторов. 4. Назначение интегральных схем.
 1. Устройство и конструкция электронных ламп Электронные лампы предназначены для генерирования, усиления, преобразования и обработки различных электрических сигналов. Простейшим представителем электровакуумных приборов (ЭВП) является диод. Чтобы обеспечить проводимость вакуума, созданного в баллоне электровакуумного диода, необходимо создать в нем присутствие носителей заряда. Обычно в баллоне ЭВП создается вакуум, разреженность составляет меньше 10 6 Па (100 Па=1 мм рт. ст. ). Если в стеклянном сосуде с вакуумом не будет свободных носителей, то ток будет отсутствовать. Электрический ток в вакууме создается путем введения в вакуум электронов. Источником электронов может быть один из электродов ЭВП. Эмиссия электронов (выход) из катода может быть 4 видов: а) холодная б) вторичная в) фотоэлектронная г)термоэлектронная
1. Устройство и конструкция электронных ламп Электронные лампы предназначены для генерирования, усиления, преобразования и обработки различных электрических сигналов. Простейшим представителем электровакуумных приборов (ЭВП) является диод. Чтобы обеспечить проводимость вакуума, созданного в баллоне электровакуумного диода, необходимо создать в нем присутствие носителей заряда. Обычно в баллоне ЭВП создается вакуум, разреженность составляет меньше 10 6 Па (100 Па=1 мм рт. ст. ). Если в стеклянном сосуде с вакуумом не будет свободных носителей, то ток будет отсутствовать. Электрический ток в вакууме создается путем введения в вакуум электронов. Источником электронов может быть один из электродов ЭВП. Эмиссия электронов (выход) из катода может быть 4 видов: а) холодная б) вторичная в) фотоэлектронная г)термоэлектронная
 Основными составными частями ЭВП диода является катод (источник электронов) и анод. Если между катодом и анодом электрическое поле отсутствует, то в близи катода электронное облако имеет постоянные размеры, а между электронами, вылетевшими из катода и вернувшимися в катод, сохраняется динамическое равновесие. Зависимость числа электронов (величины тока, который может протекать в диоде) от температуры показана на рис. 1. 1, где видно, что с увеличением температуры катода ток через диод увеличивается: Iэ=а*Т 2*е –w где а – постоянная материала, зависящая от поверхности катода (металла); W 0 – работа выхода электрона из металла; К – постояная Больцмана. Рис. 1. 1 Зависимость удельного тока эмиссии Iэ от температуры Т. .
Основными составными частями ЭВП диода является катод (источник электронов) и анод. Если между катодом и анодом электрическое поле отсутствует, то в близи катода электронное облако имеет постоянные размеры, а между электронами, вылетевшими из катода и вернувшимися в катод, сохраняется динамическое равновесие. Зависимость числа электронов (величины тока, который может протекать в диоде) от температуры показана на рис. 1. 1, где видно, что с увеличением температуры катода ток через диод увеличивается: Iэ=а*Т 2*е –w где а – постоянная материала, зависящая от поверхности катода (металла); W 0 – работа выхода электрона из металла; К – постояная Больцмана. Рис. 1. 1 Зависимость удельного тока эмиссии Iэ от температуры Т. .
 Маркировка и классификация электронных ламп ЭВП можно классифицировать: а) по типу используемых катодов (с внешним накаливанием и непосредственным разогревом, лампы с холодным катодом); б) по количеству имеющихся электродов (диод – 2 электрода; триод – 3 электрода: катод, сетка, анод; тетрод – первая сетка управляющая, вторая сетка экранирующая, катод, анод; пентод – катод, первая сетка управляющая, вторая сетка экранирующая, третья – антидинатронная, анод). Основное назначение диода – выпрямление гармонических колебаний (тока) и использование их в качестве нелинейных элементов. Триоды, тетроды, пентоды имеют способность усиливать радиосигналы при подаче на их вход (первую сетку) слабых сигналов. Усилительные свойства ЭВП аналогичны усилительным свойствам транзисторов.
Маркировка и классификация электронных ламп ЭВП можно классифицировать: а) по типу используемых катодов (с внешним накаливанием и непосредственным разогревом, лампы с холодным катодом); б) по количеству имеющихся электродов (диод – 2 электрода; триод – 3 электрода: катод, сетка, анод; тетрод – первая сетка управляющая, вторая сетка экранирующая, катод, анод; пентод – катод, первая сетка управляющая, вторая сетка экранирующая, третья – антидинатронная, анод). Основное назначение диода – выпрямление гармонических колебаний (тока) и использование их в качестве нелинейных элементов. Триоды, тетроды, пентоды имеют способность усиливать радиосигналы при подаче на их вход (первую сетку) слабых сигналов. Усилительные свойства ЭВП аналогичны усилительным свойствам транзисторов.
 Коллектор (анод) База (сетка) Эмиттер(катод) Рис. 1. 4 Обозначение транзистора в) ЭВП можно различать по напряжению накала, обеспечивающего нагрев катода; Uнакала=1 В, 6. 3 В и др. г) по габаритам: пальчиковые, миниатюрные, октальные и др. д) по материалу баллона (стеклянные, металлические, металлокерамические и др. ); е) по наполнению баллона.
Коллектор (анод) База (сетка) Эмиттер(катод) Рис. 1. 4 Обозначение транзистора в) ЭВП можно различать по напряжению накала, обеспечивающего нагрев катода; Uнакала=1 В, 6. 3 В и др. г) по габаритам: пальчиковые, миниатюрные, октальные и др. д) по материалу баллона (стеклянные, металлические, металлокерамические и др. ); е) по наполнению баллона.
 Характеристика и принцип работы электронных ламп Электронные лампы имеют следующие основные свойства: а) односторонняя проводимость, т. е. через лампу протекает ток в одном направлении от анода к катоду; б) возможно управление электронным потоком, т. е. величиной тока; в) мощности для управления лампой необходимо меньше, чем мощности, выделяемой в нагрузке. Электроды лампы подсоединяются к штырькам, которые номеруются по часовой стрелке от начала ключа, если наблюдать лампу со стороны цоколя. Особенности характеристик и параметров ламп Основной характеристикой ламп является вольтамперная характеристика (ВАХ). Это зависимость тока от приложенного напряжения. ВАХ диода (анодная характеристика) на рис. 1. 5.
Характеристика и принцип работы электронных ламп Электронные лампы имеют следующие основные свойства: а) односторонняя проводимость, т. е. через лампу протекает ток в одном направлении от анода к катоду; б) возможно управление электронным потоком, т. е. величиной тока; в) мощности для управления лампой необходимо меньше, чем мощности, выделяемой в нагрузке. Электроды лампы подсоединяются к штырькам, которые номеруются по часовой стрелке от начала ключа, если наблюдать лампу со стороны цоколя. Особенности характеристик и параметров ламп Основной характеристикой ламп является вольтамперная характеристика (ВАХ). Это зависимость тока от приложенного напряжения. ВАХ диода (анодная характеристика) на рис. 1. 5.
 Рис. 1. 5 Зависимость тока анода от приложенного напряжения к аноду, при различных значениях напряжения накала (температуры катода) Рис. 1. 7 Условное обозначение триода
Рис. 1. 5 Зависимость тока анода от приложенного напряжения к аноду, при различных значениях напряжения накала (температуры катода) Рис. 1. 7 Условное обозначение триода
 2. Биполярные и полевые транзисторы Транзисторы подразделяются на две большие группы: биполярные и полевые. Различие протекающих в них физических процессов состоит в следующем. В биполярных транзисторах происходит перенос как основных носителей заряда в полупроводнике, так и неосновных; в полевых — только основных. Управление током в биполярных транзисторах осуществляется за счет заряда неосновных носителей, накапливаемых в базовой области, в полевых — за счет действия электрического поля на поток носителей заряда, движущихся в полупроводниковом канале, причем поле направлено перпендикулярно этому потоку.
2. Биполярные и полевые транзисторы Транзисторы подразделяются на две большие группы: биполярные и полевые. Различие протекающих в них физических процессов состоит в следующем. В биполярных транзисторах происходит перенос как основных носителей заряда в полупроводнике, так и неосновных; в полевых — только основных. Управление током в биполярных транзисторах осуществляется за счет заряда неосновных носителей, накапливаемых в базовой области, в полевых — за счет действия электрического поля на поток носителей заряда, движущихся в полупроводниковом канале, причем поле направлено перпендикулярно этому потоку.
 Биполярные транзисторы Биполярные транзисторы делятся на две большие группы: типа п-р-п и р-п-р. Под n понимается электронная проводимость материала, под р — дырочная. Мощные биполярные транзисторы ВЧ и СВЧ диапазона являются, как правило, типа п-р-п. В основе работы биполярного транзистора типа п-р-п лежат три явления: инжекция электронов из эмиттера в область базы, их накопление в базовой области (по отношению к проводимости типа р электроны становятся неосновными носителями заряда) и перенос электронов под действием внешнего электрического поля из базы к коллектору (рис. 1. 8, а). Здесь имеют место два ограничения, не позволяющие увеличивать мощность прибора при одновременном повышении частоты сигнала. Первое ограничение связано с предельной скоростью движения электронов в полупроводнике. Так, для кремния эта скорость, зависящая от напряженности электрического поля, не превышает VНАС=107 см/с (рис. 7. 1, 6). Второе ограничение связано с предельным значением напряженности электрического поля ЕПР, при превышении которого наступает электрический пробой. У кремния ЕПР = 2 105 В/с.
Биполярные транзисторы Биполярные транзисторы делятся на две большие группы: типа п-р-п и р-п-р. Под n понимается электронная проводимость материала, под р — дырочная. Мощные биполярные транзисторы ВЧ и СВЧ диапазона являются, как правило, типа п-р-п. В основе работы биполярного транзистора типа п-р-п лежат три явления: инжекция электронов из эмиттера в область базы, их накопление в базовой области (по отношению к проводимости типа р электроны становятся неосновными носителями заряда) и перенос электронов под действием внешнего электрического поля из базы к коллектору (рис. 1. 8, а). Здесь имеют место два ограничения, не позволяющие увеличивать мощность прибора при одновременном повышении частоты сигнала. Первое ограничение связано с предельной скоростью движения электронов в полупроводнике. Так, для кремния эта скорость, зависящая от напряженности электрического поля, не превышает VНАС=107 см/с (рис. 7. 1, 6). Второе ограничение связано с предельным значением напряженности электрического поля ЕПР, при превышении которого наступает электрический пробой. У кремния ЕПР = 2 105 В/с.
 Рис. 1. 8 Предельная или граничная частота усиления транзистора f. ГР непосредственно связана со временем переноса носителей заряда τТ через базовую область толщиной W (см. рис. 7. 1, а): где — время переноса носителей через базу.
Рис. 1. 8 Предельная или граничная частота усиления транзистора f. ГР непосредственно связана со временем переноса носителей заряда τТ через базовую область толщиной W (см. рис. 7. 1, а): где — время переноса носителей через базу.
 С помощью специальной, очень сложной технологии при создании СВЧ транзисторов удалось приблизиться к теоретическому пределу, определяемому соотношением (7. 3). В качестве примера укажем, что в транзисторе с f. ГР = 400 МГц толщина базовой области W = 0, 7 мкм; f. ГР = 1. . . 2 ГГц W = 0, 2. . . 0, 3 мкм. Помимо двух названных (предельная скорость переноса носителей заряда и допустимая напряженность электрического поля), есть еще два ограничительных фактора, не позволяющих увеличить мощность транзистора: допустимая температура р-п перехода (у кремния не выше 150. . . 200 °С) и эффект оттеснения. Сущность послед него сводится к тому, что с возрастанием заряда оттесняется ко внешнему краю эмиттера. В результате значение тока определяется периметром, а не площадью эмиттера, что не позволяет увеличивать мощность с повышением частоты.
С помощью специальной, очень сложной технологии при создании СВЧ транзисторов удалось приблизиться к теоретическому пределу, определяемому соотношением (7. 3). В качестве примера укажем, что в транзисторе с f. ГР = 400 МГц толщина базовой области W = 0, 7 мкм; f. ГР = 1. . . 2 ГГц W = 0, 2. . . 0, 3 мкм. Помимо двух названных (предельная скорость переноса носителей заряда и допустимая напряженность электрического поля), есть еще два ограничительных фактора, не позволяющих увеличить мощность транзистора: допустимая температура р-п перехода (у кремния не выше 150. . . 200 °С) и эффект оттеснения. Сущность послед него сводится к тому, что с возрастанием заряда оттесняется ко внешнему краю эмиттера. В результате значение тока определяется периметром, а не площадью эмиттера, что не позволяет увеличивать мощность с повышением частоты.
 Вольт амперные, или статические, характеристики биполярного транзистора. При схеме транзистора с общим эмиттером различают два вида семейств характеристик: выходные — зависимости тока коллектора от напряжения коллектор эмиттер и тока базы i. К=Ф(и. КЭ, i. Б) (рис. 7. 4, а) и входные — зависимости тока базы от напряжения эмиттер база и коллектор эмиттер i. Б=Ф(и. ЭБ, и. КЭ) (рис. 7. 4, 6). у кремниевых транзисторов напряжение отсечки Е/Б= 0, 5. . . 0, 7 В. При изменении температуры происходит смещение характеристик. Так, входная характеристика смещается влево при повышении температуры и вправо с ее понижением.
Вольт амперные, или статические, характеристики биполярного транзистора. При схеме транзистора с общим эмиттером различают два вида семейств характеристик: выходные — зависимости тока коллектора от напряжения коллектор эмиттер и тока базы i. К=Ф(и. КЭ, i. Б) (рис. 7. 4, а) и входные — зависимости тока базы от напряжения эмиттер база и коллектор эмиттер i. Б=Ф(и. ЭБ, и. КЭ) (рис. 7. 4, 6). у кремниевых транзисторов напряжение отсечки Е/Б= 0, 5. . . 0, 7 В. При изменении температуры происходит смещение характеристик. Так, входная характеристика смещается влево при повышении температуры и вправо с ее понижением.
 Биполярный транзистор представляет собой структуру из двух р-п-переходов (см. рис. 7. 1). Сначала рассмотрим отдельно взятый р-п-переход, статическая характеристика которого описывается функцией где IS — обратный ток, или ток насыщения; и. П — напряжение, приложенное к р-п переходу; φТ=25, 6 МВ —температурный потенциал. Статическая характеристика р-п-перехода (7. 4), приведенная на рис. 7. 5, имеет два участка: один соответствует открытому р-п-переходу приложении к нему прямого напряжения, другой — закрытому р-п переходу при обратном напряжении. Обратное напряжение, превышающее по абсолютной величине напряжение UПРОБ приводит к электрическому пробою р-п перехода. Рис. 7. 5
Биполярный транзистор представляет собой структуру из двух р-п-переходов (см. рис. 7. 1). Сначала рассмотрим отдельно взятый р-п-переход, статическая характеристика которого описывается функцией где IS — обратный ток, или ток насыщения; и. П — напряжение, приложенное к р-п переходу; φТ=25, 6 МВ —температурный потенциал. Статическая характеристика р-п-перехода (7. 4), приведенная на рис. 7. 5, имеет два участка: один соответствует открытому р-п-переходу приложении к нему прямого напряжения, другой — закрытому р-п переходу при обратном напряжении. Обратное напряжение, превышающее по абсолютной величине напряжение UПРОБ приводит к электрическому пробою р-п перехода. Рис. 7. 5
 В реальной модели значение тока i ограничено сопротивлением активных потерь RS р-п перехода. Закрытый р-п переход характеризуется барьерной, или зарядовой, емкостью где СН. ЗАР — начальная емкость р-п перехода; и — обратное напряжение, приложенное к р-п переходу; φ0 контактная разность потенциалов (φ0=0, 5. . . 0, 8 В — для кремния); γ — коэффициент перехода, зависящий от состава примесей в переходе (обычно γ=0, 5). График функции (7. 5) приведен на рис. 7. 6.
В реальной модели значение тока i ограничено сопротивлением активных потерь RS р-п перехода. Закрытый р-п переход характеризуется барьерной, или зарядовой, емкостью где СН. ЗАР — начальная емкость р-п перехода; и — обратное напряжение, приложенное к р-п переходу; φ0 контактная разность потенциалов (φ0=0, 5. . . 0, 8 В — для кремния); γ — коэффициент перехода, зависящий от состава примесей в переходе (обычно γ=0, 5). График функции (7. 5) приведен на рис. 7. 6.
 Модель транзистора, как структура из двух р-п переходов, может быть представлена в виде, показанном на рис. 7. 7. Каждый из р-п переходов может находиться в открытом или закрытом состоянии в зависимости от приложенного к нему напряжения — прямого или обратного. Таким образом, в зависимости от того, какое напряжение приложено к эмиттерному и коллекторному переходу — прямое или обратное, могут быть четыре состояния биполярного транзистора, показанные в табл. 7. 2, и соответственно четыре области на плоскости его статических характеристик: отсечки (1), активная (2), насыщения (З), инверсная (4) (рис. 7. 8). Область насыщения (З) характеризуется сопротивлением насыщения: При обратном напряжении, приложенном к р-п переходу, превышающем обратное напряжение UПРОБ происходит электрический пробой, сопровождаемый резким
Модель транзистора, как структура из двух р-п переходов, может быть представлена в виде, показанном на рис. 7. 7. Каждый из р-п переходов может находиться в открытом или закрытом состоянии в зависимости от приложенного к нему напряжения — прямого или обратного. Таким образом, в зависимости от того, какое напряжение приложено к эмиттерному и коллекторному переходу — прямое или обратное, могут быть четыре состояния биполярного транзистора, показанные в табл. 7. 2, и соответственно четыре области на плоскости его статических характеристик: отсечки (1), активная (2), насыщения (З), инверсная (4) (рис. 7. 8). Область насыщения (З) характеризуется сопротивлением насыщения: При обратном напряжении, приложенном к р-п переходу, превышающем обратное напряжение UПРОБ происходит электрический пробой, сопровождаемый резким
 увеличением носителей заряда — их лавинному умножению. Эта область обозначена на рис. 7. 8 цифрой 5. Заход в нее недопустим, поскольку пробой р-п перехода является необратимым явлением, приводящим к выходу прибора из строя.
увеличением носителей заряда — их лавинному умножению. Эта область обозначена на рис. 7. 8 цифрой 5. Заход в нее недопустим, поскольку пробой р-п перехода является необратимым явлением, приводящим к выходу прибора из строя.
 Зарядовая модель транзистора в схеме с общей базой. Процессы, протекающие в теоретической модели транзистора при работе в активной области в схеме с общей базой (рис. 7. 9, а; ЭЦ — электрическая цепь), могут быть описаны двумя уравнениями: где QБ — заряд базы; τЭ — среднее время жизни неосновных носителей заряда в области базы (в транзисторе типа п-р-п ими являются электроны; i. КГ — ток эквивалентного генератора в коллекторной цепи; τТ — время пролета носителями заряда базовой области, определяемое согласно (7. 1).
Зарядовая модель транзистора в схеме с общей базой. Процессы, протекающие в теоретической модели транзистора при работе в активной области в схеме с общей базой (рис. 7. 9, а; ЭЦ — электрическая цепь), могут быть описаны двумя уравнениями: где QБ — заряд базы; τЭ — среднее время жизни неосновных носителей заряда в области базы (в транзисторе типа п-р-п ими являются электроны; i. КГ — ток эквивалентного генератора в коллекторной цепи; τТ — время пролета носителями заряда базовой области, определяемое согласно (7. 1).
 Уравнение (7. 6) определяет накопление заряда в базовой области, (7. 7) — их дальнейший перенос к коллектору под действием внешнего электрического поля. Для составления эквивалентной схемы транзистора рассмотрим цепь из параллельно соединенных сопротивления R 1 и емкости С (рис. 7. 10), для которой согласно правилам электротехники запишем: Из последнего выражения получим где Q — заряд, накапливаемый емкостью; τ= СR — постоянная времени цепи.
Уравнение (7. 6) определяет накопление заряда в базовой области, (7. 7) — их дальнейший перенос к коллектору под действием внешнего электрического поля. Для составления эквивалентной схемы транзистора рассмотрим цепь из параллельно соединенных сопротивления R 1 и емкости С (рис. 7. 10), для которой согласно правилам электротехники запишем: Из последнего выражения получим где Q — заряд, накапливаемый емкостью; τ= СR — постоянная времени цепи.
 Сравнивая уравнения (7. 6) и (7. 8), устанавливаем их полное совпадение, что позволяет сделать следующий вывод: эквивалентная схема открытого р-п перехода есть параллельная цепь из сопротивления RЭ и емкости СЭ произведение которых и есть постоянная времени τ= СЭRЭ, где СЭ, RЭ называются диффузионной емкостью или сопротивлением открытого эмиттерного перехода. Сказанное позволяет от схемы рис. 7. 9, а перейти к эквивалентной схеме рис. 7. 9, 6. Совместно решая уравнения (7. 6), (7. 7), получим дифференциальное уравнение, связывающее ток на выходе транзистора (ток коллектора iк) с входным током (ток эмиттера i. Э):
Сравнивая уравнения (7. 6) и (7. 8), устанавливаем их полное совпадение, что позволяет сделать следующий вывод: эквивалентная схема открытого р-п перехода есть параллельная цепь из сопротивления RЭ и емкости СЭ произведение которых и есть постоянная времени τ= СЭRЭ, где СЭ, RЭ называются диффузионной емкостью или сопротивлением открытого эмиттерного перехода. Сказанное позволяет от схемы рис. 7. 9, а перейти к эквивалентной схеме рис. 7. 9, 6. Совместно решая уравнения (7. 6), (7. 7), получим дифференциальное уравнение, связывающее ток на выходе транзистора (ток коллектора iк) с входным током (ток эмиттера i. Э):
 где — коэффициент передачи тока на низкой частоте в схеме с общей базой ωГР — граничная частота, определяемая согласно (7. 1); ωα граничная частота в схеме с общей базой В операционной форме уравнение (7. 9) примет вид Формальной заменой р на jω из формулы (7. 10) получим зависимость коэффициента передачи тока в схеме с общей базой от частоты: Для модуля той же величины из (7. 11) получим
где — коэффициент передачи тока на низкой частоте в схеме с общей базой ωГР — граничная частота, определяемая согласно (7. 1); ωα граничная частота в схеме с общей базой В операционной форме уравнение (7. 9) примет вид Формальной заменой р на jω из формулы (7. 10) получим зависимость коэффициента передачи тока в схеме с общей базой от частоты: Для модуля той же величины из (7. 11) получим
 График функция (7. 12) построен на рис. 7. 11. Из него следует, что при частоте О) = о коэффициент передачи тока α уменьшается в 1, 41 раза по сравнению с его низкочастотным значением α 0 < 1. Коэффициент усиления по мощности в схеме с общей базой есть произведение из коэффициентов усиления по току К 1 по напряжению КU: Из (7. 13) следует, что в схеме с общей базой коэффициент усиления сигнала по мощности КP < КU. Зарядовая модель транзистора в схеме с общим эмиттером. Процессы, протекающие в теоретической модели транзистора при работе в активной области в схеме с общим эмиттером (рис. 7. 12, а), могут быть описаны тремя уравнениями: (7. 6), (7. 7) и дополни тельным — для тока базы 1 который является входным в данной схеме:
График функция (7. 12) построен на рис. 7. 11. Из него следует, что при частоте О) = о коэффициент передачи тока α уменьшается в 1, 41 раза по сравнению с его низкочастотным значением α 0 < 1. Коэффициент усиления по мощности в схеме с общей базой есть произведение из коэффициентов усиления по току К 1 по напряжению КU: Из (7. 13) следует, что в схеме с общей базой коэффициент усиления сигнала по мощности КP < КU. Зарядовая модель транзистора в схеме с общим эмиттером. Процессы, протекающие в теоретической модели транзистора при работе в активной области в схеме с общим эмиттером (рис. 7. 12, а), могут быть описаны тремя уравнениями: (7. 6), (7. 7) и дополни тельным — для тока базы 1 который является входным в данной схеме:
 Совместное решение уравнений (7. 6), (7. 7) и (7. 14), проведенное по той же методике, что и в предыдущем случае, приводит к эквивалентной схеме, приведенной на рис. 7. 12, 6. По аналогии с предыдущим случаем для коэффициента усиления по току в схеме с общим эмиттером и для модуля данной величины получим: где — коэффициент усиления по току на низкой частоте в схеме с общим эмиттером; ωβ — граничная частота в схеме с общим эмиттером. График функции (7. 16) построен на рис. 7. 11. Из него следует, что при частоте ω = ωβ коэффициент передачи тока β уменьшается в 1, 41 раза по сравнению с его низкочастотным значением Β 0>> 1. При частоте ω >> ωβ из (7. 16) получим
Совместное решение уравнений (7. 6), (7. 7) и (7. 14), проведенное по той же методике, что и в предыдущем случае, приводит к эквивалентной схеме, приведенной на рис. 7. 12, 6. По аналогии с предыдущим случаем для коэффициента усиления по току в схеме с общим эмиттером и для модуля данной величины получим: где — коэффициент усиления по току на низкой частоте в схеме с общим эмиттером; ωβ — граничная частота в схеме с общим эмиттером. График функции (7. 16) построен на рис. 7. 11. Из него следует, что при частоте ω = ωβ коэффициент передачи тока β уменьшается в 1, 41 раза по сравнению с его низкочастотным значением Β 0>> 1. При частоте ω >> ωβ из (7. 16) получим
 Коэффициент усиления по мощности в схеме с общим эмиттером по аналогии с (7. 13): Из сравнения (7. 13) с (7. 18) следует, что коэффициент усиления по мощности в схеме с общим эмиттером больше, чем в схеме общей базой. Теоретическая, идеализированная модель транзистора (ТМ), показанная на рис. 7. 9 и 7. 12, отражает наиболее важные процессы, протекающие в его структуре. В реальной эквивалентной схеме биполярного транзистора помимо этой модели следует также учесть: индуктивности выводов электродов ; сопротивления потерь в базе (r. Б) и коллектора (r. Ка r. Кп ); стабилизирующие сопротивления, включаемые последовательно с эмиттерами и отображаемые в виде общего сопротивления (r. СТ); зарядную или барьерную емкость закрытого коллекторного перехода (СКа, СКп). Такая модель транзистора при работе в активной области и схеме с общим эмиттером приведена на рис. 7. 13.
Коэффициент усиления по мощности в схеме с общим эмиттером по аналогии с (7. 13): Из сравнения (7. 13) с (7. 18) следует, что коэффициент усиления по мощности в схеме с общим эмиттером больше, чем в схеме общей базой. Теоретическая, идеализированная модель транзистора (ТМ), показанная на рис. 7. 9 и 7. 12, отражает наиболее важные процессы, протекающие в его структуре. В реальной эквивалентной схеме биполярного транзистора помимо этой модели следует также учесть: индуктивности выводов электродов ; сопротивления потерь в базе (r. Б) и коллектора (r. Ка r. Кп ); стабилизирующие сопротивления, включаемые последовательно с эмиттерами и отображаемые в виде общего сопротивления (r. СТ); зарядную или барьерную емкость закрытого коллекторного перехода (СКа, СКп). Такая модель транзистора при работе в активной области и схеме с общим эмиттером приведена на рис. 7. 13.
 Полевые транзисторы Полевой транзистор относится к разряду униполярных полупроводниковых приборов, в которых осуществляется перенос только основных носителей заряда. Материалом ДЛЯ СВЧ полевых транзисторов обычно служит арсенид галлия (Gа As), позволяющий снизить активные потери в приборе и поднять максимальную частоту усиления до 6. . . 8 ГГц. Основное различие в нескольких типах полевых транзисторов связано с методом управления потоком носителей заряда, движущихся в полупроводниковом канале. Структура одного из полевых транзисторов, называемого металлополупроводниковым, с затвором типа барьера Шоттки приведена на рис. 7. 15.
Полевые транзисторы Полевой транзистор относится к разряду униполярных полупроводниковых приборов, в которых осуществляется перенос только основных носителей заряда. Материалом ДЛЯ СВЧ полевых транзисторов обычно служит арсенид галлия (Gа As), позволяющий снизить активные потери в приборе и поднять максимальную частоту усиления до 6. . . 8 ГГц. Основное различие в нескольких типах полевых транзисторов связано с методом управления потоком носителей заряда, движущихся в полупроводниковом канале. Структура одного из полевых транзисторов, называемого металлополупроводниковым, с затвором типа барьера Шоттки приведена на рис. 7. 15.
 Электрическое поле, создаваемое напряжением, приложенным к затвору, направлено перпендикулярно потоку зарядов в канале. Изменяя значение воздействуют на этот поток, движущийся от истока к стоку, увеличивая или уменьшая выходной ток прибора. Эквивалентная схема полевого транзистора ВЧ диапазона, приведенная на рис. 7. 16, включает в себя: СЗИ — емкость затвор исток, ССИ — емкость сток исток, СЗС — емкость затвор сток (проходная емкость), СЗК — емкость затвор канал, r. ЗК, r. СИ потерь, i. СГ — эквивалентный генератор тока стока. Частотные свойства полевого транзистора определяются постоянной времени: где τЗК= СЗКr. ЗК — постоянная времени цепи затвор канал (см. 7. 16); τК — время пролета носителями заряда по каналу от к стоку.
Электрическое поле, создаваемое напряжением, приложенным к затвору, направлено перпендикулярно потоку зарядов в канале. Изменяя значение воздействуют на этот поток, движущийся от истока к стоку, увеличивая или уменьшая выходной ток прибора. Эквивалентная схема полевого транзистора ВЧ диапазона, приведенная на рис. 7. 16, включает в себя: СЗИ — емкость затвор исток, ССИ — емкость сток исток, СЗС — емкость затвор сток (проходная емкость), СЗК — емкость затвор канал, r. ЗК, r. СИ потерь, i. СГ — эквивалентный генератор тока стока. Частотные свойства полевого транзистора определяются постоянной времени: где τЗК= СЗКr. ЗК — постоянная времени цепи затвор канал (см. 7. 16); τК — время пролета носителями заряда по каналу от к стоку.
 Ток эквивалентного генератора определяется напряжением, приложенным непосредственно к участку затвор канал (см. рис. 7. 15). Поэтому в ВЧ диапазоне, пренёбрегая вторым слагаемым, для генератора стока имеем где S 0 — крутизна статической характеристики; u. ЗК — напряжение между затвором и каналом; и. BX — напряжение на входе прибора. Согласно (7. 22) зависимость амплитуды тока стока от частоты сигнала определяется выражением Из (7. 23) следует, что в полевом транзисторе, как и в биполярном, коэффициент усиления прибора по мощности уменьшается с повышением частоты.
Ток эквивалентного генератора определяется напряжением, приложенным непосредственно к участку затвор канал (см. рис. 7. 15). Поэтому в ВЧ диапазоне, пренёбрегая вторым слагаемым, для генератора стока имеем где S 0 — крутизна статической характеристики; u. ЗК — напряжение между затвором и каналом; и. BX — напряжение на входе прибора. Согласно (7. 22) зависимость амплитуды тока стока от частоты сигнала определяется выражением Из (7. 23) следует, что в полевом транзисторе, как и в биполярном, коэффициент усиления прибора по мощности уменьшается с повышением частоты.
 Вольт амперные или статические характеристики полевого транзистора. При схеме транзистора с общим истоком различают два вида семейств характеристик: зависимости тока стока от напряжения сток истоки затвор исток i. C = Ф(иси, u. ЗИ) (рис. 7. 17, а) и зависимость тока стока от напряжения затвор исток i. C = Ф(иси) (рис. 7. 17, 6). Тангенс угла наклона линейного участка характеристики i. C = Ф(иси) есть статическая крутизна S 0. По внешнему виду статические характеристики полевого транзистора близки к характеристикам биполярного транзистора (см. рис. 7. 4). Однако следует иметь в виду, что биполярный транзистор управляется входным током (при схеме с общим эмиттером — током базы), полевой — входным напряжением затвор исток.
Вольт амперные или статические характеристики полевого транзистора. При схеме транзистора с общим истоком различают два вида семейств характеристик: зависимости тока стока от напряжения сток истоки затвор исток i. C = Ф(иси, u. ЗИ) (рис. 7. 17, а) и зависимость тока стока от напряжения затвор исток i. C = Ф(иси) (рис. 7. 17, 6). Тангенс угла наклона линейного участка характеристики i. C = Ф(иси) есть статическая крутизна S 0. По внешнему виду статические характеристики полевого транзистора близки к характеристикам биполярного транзистора (см. рис. 7. 4). Однако следует иметь в виду, что биполярный транзистор управляется входным током (при схеме с общим эмиттером — током базы), полевой — входным напряжением затвор исток.
 3. Назначение интегральных микросхем Микроэлектроника — область электроники, охватывающая пробле мы исследования, конструирования, изготовления и применения микроэлектронных изделий. Микроэлектронное изделие — электронное устройство с высокой сте пенью миниатюризации. Интегральная микросхема (ИС) — микроэлектронное изделие, вы полняющее' определенную функцию преобразования и обработки сигна ла и имеющее высокую плотность упаковки электрически соединенных элементов (или элементов и компонентов) и (или) кристаллов, кото рое с точки зрения требований к испытаниям, приемке, поставке и экс плуатации рассматривается как единое целое.
3. Назначение интегральных микросхем Микроэлектроника — область электроники, охватывающая пробле мы исследования, конструирования, изготовления и применения микроэлектронных изделий. Микроэлектронное изделие — электронное устройство с высокой сте пенью миниатюризации. Интегральная микросхема (ИС) — микроэлектронное изделие, вы полняющее' определенную функцию преобразования и обработки сигна ла и имеющее высокую плотность упаковки электрически соединенных элементов (или элементов и компонентов) и (или) кристаллов, кото рое с точки зрения требований к испытаниям, приемке, поставке и экс плуатации рассматривается как единое целое.
 Кристалл интегральной микросхемы — часть полупроводниковой пластины, в объёме я на поверхности которой сформированы элементы полупроводниковой микросхемы, межэлементные соединения и кон тактные площадки. Подложка интегральной микросхемы — заготовка, предназначенная для нанесения на нее элементов гибридных и пленочных интегральных микросхем, межэлементных и (или) межкомпонентных соединений, а также контактных площадок. Плата интегральной микросхемы — часть подложки (подложка) гибридной (пленочной) интегральной микросхемы, на поверхности которой нанесены пленочные элементы микросхемы, межэлементные в межкомпонентные соединения л контактные площадки.
Кристалл интегральной микросхемы — часть полупроводниковой пластины, в объёме я на поверхности которой сформированы элементы полупроводниковой микросхемы, межэлементные соединения и кон тактные площадки. Подложка интегральной микросхемы — заготовка, предназначенная для нанесения на нее элементов гибридных и пленочных интегральных микросхем, межэлементных и (или) межкомпонентных соединений, а также контактных площадок. Плата интегральной микросхемы — часть подложки (подложка) гибридной (пленочной) интегральной микросхемы, на поверхности которой нанесены пленочные элементы микросхемы, межэлементные в межкомпонентные соединения л контактные площадки.
 Контактная площадка интегральной микросхемы — металлизиро ванный часток на плате или на кристалле, служащий для у присоедине ния выводов компонентов и интегральных микросхем, перемычек, а также для контроля ее электрических параметров и режимов. Корпус интегральной микросхемы — часть конструкции интеграль ной микросхемы, предназначенная для защиты микросхемы от внешних воздействий и для соединения с внешними электрическими цепями по средством выводов. Тело корпуса — часть корпуса без выводов. Позиция вывода — одно из нескольких равноотстоящих друг от друга местоположений выводов на выходе из тела корпуса, располо женных 'по окружности или в ряду, которое может быть занято или не занято выводом. Каждая позиция вывода обозначается порядковым номером. Шаг позиций выводов — расстояние между номинальным положе нием осей (плоскостей симметрии) позиций выводов. Установочная плоскость — плоскость, на которую устанавливается интегральная микросхема. Ключ — конструктивная особенность, позволяет определить вывод
Контактная площадка интегральной микросхемы — металлизиро ванный часток на плате или на кристалле, служащий для у присоедине ния выводов компонентов и интегральных микросхем, перемычек, а также для контроля ее электрических параметров и режимов. Корпус интегральной микросхемы — часть конструкции интеграль ной микросхемы, предназначенная для защиты микросхемы от внешних воздействий и для соединения с внешними электрическими цепями по средством выводов. Тело корпуса — часть корпуса без выводов. Позиция вывода — одно из нескольких равноотстоящих друг от друга местоположений выводов на выходе из тела корпуса, располо женных 'по окружности или в ряду, которое может быть занято или не занято выводом. Каждая позиция вывода обозначается порядковым номером. Шаг позиций выводов — расстояние между номинальным положе нием осей (плоскостей симметрии) позиций выводов. Установочная плоскость — плоскость, на которую устанавливается интегральная микросхема. Ключ — конструктивная особенность, позволяет определить вывод
 Вывод бескорпусной интегральной микросхемы — проводник, соединенный с контактной площадкой кристалла интегральной микросхемы и предназначенный для электрического соединения и механического крепления бескорпусной интегральной микросхемы при ее соединении с внешними электрическими цепями. (Выводы бескорпусной интеграль ной микросхемы могут быть жесткими (шариковые, столбиковые, ба лочные) и гибкими (лепестковые, проволочные). Гибкие выводы для механического крепления не применяются. ) Полупроводниковая интегральная микросхема — интегральная мик росхема, се элементы и межэлементные соединения которой в выполне ны в объеме и на поверхности полупроводника. Пленочная интегральная микросхема — интегральная микросхема, все элементы и межэлементные соединения которой выполнены в виде пленок (частными случаями пленочных микросхем являются толсто пленочные и тонкопленочные интегральные микросхемы). Гибридная интегральная микросхема — интегральная микросхема, содержащая кроме элементов компоненты и (или) кристаллы (частным случаем гибридной микросхемы является многокристальная ИС).
Вывод бескорпусной интегральной микросхемы — проводник, соединенный с контактной площадкой кристалла интегральной микросхемы и предназначенный для электрического соединения и механического крепления бескорпусной интегральной микросхемы при ее соединении с внешними электрическими цепями. (Выводы бескорпусной интеграль ной микросхемы могут быть жесткими (шариковые, столбиковые, ба лочные) и гибкими (лепестковые, проволочные). Гибкие выводы для механического крепления не применяются. ) Полупроводниковая интегральная микросхема — интегральная мик росхема, се элементы и межэлементные соединения которой в выполне ны в объеме и на поверхности полупроводника. Пленочная интегральная микросхема — интегральная микросхема, все элементы и межэлементные соединения которой выполнены в виде пленок (частными случаями пленочных микросхем являются толсто пленочные и тонкопленочные интегральные микросхемы). Гибридная интегральная микросхема — интегральная микросхема, содержащая кроме элементов компоненты и (или) кристаллы (частным случаем гибридной микросхемы является многокристальная ИС).
 Аналоговая интегральная микросхема — интегральная микросхема, предназначенная для преобразования и обработки сигналов по закону непрерывной функции (частным случаем аналоговой интегральной мик росхемы является микросхема с линейной характеристикой (линейная микросхема)). Цифровая интегральная микросхема — интегральная микросхема, предназначенная для преобразования и обработки сигналов, изменяю щихся по закону дискретной функции (частным случаем цифровой мик росхемы является логическая микросхема). Плотность упаковки интегральной микросхемы — отношение числа элементов и компонентов интегральной микросхемы к ее. объему (объ ем выводов не учитывается). Степень интеграции интегральной микросхемы — показатель степе ни сложности микросхемы, характеризуемый числом содержащихся в ней элементов и компонентов (степень интеграции определяется по фор муле K=g. N, где К — коэффициент, определяющий степень интегра ции, округляемый до ближайшего большего целого числа, АГ – число элементов n компонентов, входящих в интегральную микросхему). Серия интегральных микросхем — совокупность типов интегральных микросхем, которые могут выполнять различные функции, имеют еди ное конструктивно технологическое исполнение а предназначены для совместного применения.
Аналоговая интегральная микросхема — интегральная микросхема, предназначенная для преобразования и обработки сигналов по закону непрерывной функции (частным случаем аналоговой интегральной мик росхемы является микросхема с линейной характеристикой (линейная микросхема)). Цифровая интегральная микросхема — интегральная микросхема, предназначенная для преобразования и обработки сигналов, изменяю щихся по закону дискретной функции (частным случаем цифровой мик росхемы является логическая микросхема). Плотность упаковки интегральной микросхемы — отношение числа элементов и компонентов интегральной микросхемы к ее. объему (объ ем выводов не учитывается). Степень интеграции интегральной микросхемы — показатель степе ни сложности микросхемы, характеризуемый числом содержащихся в ней элементов и компонентов (степень интеграции определяется по фор муле K=g. N, где К — коэффициент, определяющий степень интегра ции, округляемый до ближайшего большего целого числа, АГ – число элементов n компонентов, входящих в интегральную микросхему). Серия интегральных микросхем — совокупность типов интегральных микросхем, которые могут выполнять различные функции, имеют еди ное конструктивно технологическое исполнение а предназначены для совместного применения.
 Полевые транзисторы Полевыми транзисторами называют активные полупроводниковые приборы, в которых выходным током управляют с помощью электрического поля (в биполярных транзисторах выходной ток управляется входным током). Полевые транзисторы называют также униполярными, так как в процессе протекания электрического тока участвует только один вид носителей. Различают два вида полевых транзисторов: с управляющим переходом и с изолированным затвором. Все они имеют три электрода: исток (источник носителей тока), затвор (управляющий электрод) и сток (электрод, куда стекают носители). Устройство транзистора с управляющим р n переходом приведено на рис. 1. Условное графическое обозначение этого транзистора показано на рис. 2, а, б (р-н « типов соответственно). Стрелка указывает направление от слоя р к слою п (как и стрелка в изображении эмиттера биполярного транзистора). В интегральных микросхемах линейные размеры транзисторов могут быть существенно меньше 1 мкм.
Полевые транзисторы Полевыми транзисторами называют активные полупроводниковые приборы, в которых выходным током управляют с помощью электрического поля (в биполярных транзисторах выходной ток управляется входным током). Полевые транзисторы называют также униполярными, так как в процессе протекания электрического тока участвует только один вид носителей. Различают два вида полевых транзисторов: с управляющим переходом и с изолированным затвором. Все они имеют три электрода: исток (источник носителей тока), затвор (управляющий электрод) и сток (электрод, куда стекают носители). Устройство транзистора с управляющим р n переходом приведено на рис. 1. Условное графическое обозначение этого транзистора показано на рис. 2, а, б (р-н « типов соответственно). Стрелка указывает направление от слоя р к слою п (как и стрелка в изображении эмиттера биполярного транзистора). В интегральных микросхемах линейные размеры транзисторов могут быть существенно меньше 1 мкм.
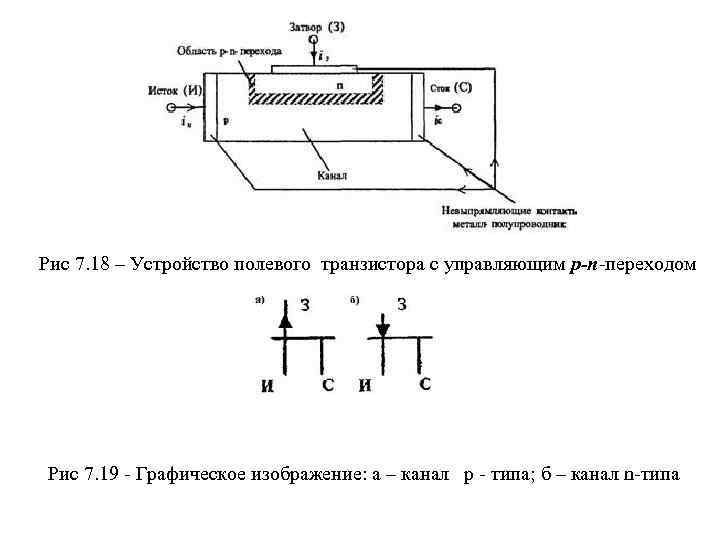 Рис 7. 18 – Устройство полевого транзистора с управляющим p-n переходом Рис 7. 19 Графическое изображение: а – канал р типа; б – канал n типа
Рис 7. 18 – Устройство полевого транзистора с управляющим p-n переходом Рис 7. 19 Графическое изображение: а – канал р типа; б – канал n типа
 Удельное сопротивление слоя п (затвора) намного меньше удельного сопротивления слоя р(канала), поэтому область р n перехода, обедненная подвижными носителями заряда и имеющая очень большое удельное сопротивление, расположена главным образом в слое р. Если типы проводимости слоев полупроводника в рассмотренном транзисторе изменить на противоположные. то получим полевой транзистор с управляющим р n переходом и каналом n типа. Если подать положительное напряжение между затвором и истоком транзистора с каналом p типа: ит > 0, то оно сместит р n переход в обратном направлении. При увеличении обратного напряжения на переходе он расширяется в основном за счет канала (в силу указанного выше различия в удельных сопротивлениях). Увеличение ширины перехода уменьшает толщину канала и, следовательно, увеличивает его сопротивление. Это приводит к уменьшению тока между истоком и стоком. Именно это явление позволяет управлять током с помощью напряжения и соответствующего ему электрического поля. Если напряжение и, достаточно велико, то канал полностью перекрывается областью р n перехода (напряжение отсечки).
Удельное сопротивление слоя п (затвора) намного меньше удельного сопротивления слоя р(канала), поэтому область р n перехода, обедненная подвижными носителями заряда и имеющая очень большое удельное сопротивление, расположена главным образом в слое р. Если типы проводимости слоев полупроводника в рассмотренном транзисторе изменить на противоположные. то получим полевой транзистор с управляющим р n переходом и каналом n типа. Если подать положительное напряжение между затвором и истоком транзистора с каналом p типа: ит > 0, то оно сместит р n переход в обратном направлении. При увеличении обратного напряжения на переходе он расширяется в основном за счет канала (в силу указанного выше различия в удельных сопротивлениях). Увеличение ширины перехода уменьшает толщину канала и, следовательно, увеличивает его сопротивление. Это приводит к уменьшению тока между истоком и стоком. Именно это явление позволяет управлять током с помощью напряжения и соответствующего ему электрического поля. Если напряжение и, достаточно велико, то канал полностью перекрывается областью р n перехода (напряжение отсечки).
 В рабочем режиме р n переход должен находиться под обратным или нулевым напряжением. Поэтому в рабочем режиме ток затвора примерно равен нулю (/3~0), а ток стока практически равен току истока. На ширину р n перехода и толщину канала прямое влияние также оказывает напряжение между истоком и стоком. Пусть иш = 0 и подано положительное напряжение и„с (рис. 3). Это напряжение окажется поданным и на промежуток затвор сток, т е. окажется, что и, с = иис и р-п- переход находится под обратным напряжением. Обратное напряжение в различных областях р п перехода различно. В областях вблизи истока это напряжение практически равно нулю, а в областях вблизи стока это напряжение примерно равно величине иис. Поэтому р n переход будет шире в тех областях, которые ближе к стоку. Можно считать, что напряжение в канале от истока к стоку увеличивается линейно. При и„с = Um „тс канал полностью перекроется вблизи стока (рис. 4). При дальнейшем увеличении напряжения иис эта область канала, в которой он перекрыт, будет расширяться.
В рабочем режиме р n переход должен находиться под обратным или нулевым напряжением. Поэтому в рабочем режиме ток затвора примерно равен нулю (/3~0), а ток стока практически равен току истока. На ширину р n перехода и толщину канала прямое влияние также оказывает напряжение между истоком и стоком. Пусть иш = 0 и подано положительное напряжение и„с (рис. 3). Это напряжение окажется поданным и на промежуток затвор сток, т е. окажется, что и, с = иис и р-п- переход находится под обратным напряжением. Обратное напряжение в различных областях р п перехода различно. В областях вблизи истока это напряжение практически равно нулю, а в областях вблизи стока это напряжение примерно равно величине иис. Поэтому р n переход будет шире в тех областях, которые ближе к стоку. Можно считать, что напряжение в канале от истока к стоку увеличивается линейно. При и„с = Um „тс канал полностью перекроется вблизи стока (рис. 4). При дальнейшем увеличении напряжения иис эта область канала, в которой он перекрыт, будет расширяться.
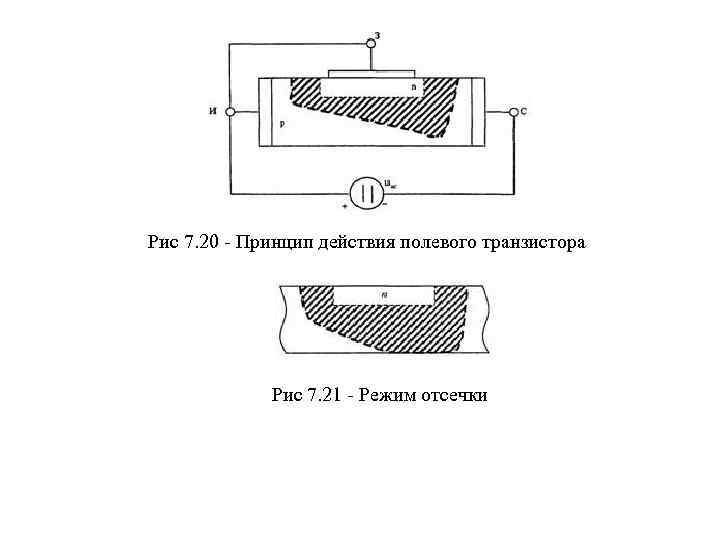 Рис 7. 20 Принцип действия полевого транзистора Рис 7. 21 Режим отсечки
Рис 7. 20 Принцип действия полевого транзистора Рис 7. 21 Режим отсечки


