ВДНУ Шаипов Д.Б.pptx
- Количество слайдов: 17
 Вакуумно-дуговая напылительная установка ВДНУ Подготовил : студент гр. 2341 -21 Проверила: Карибуллина Фарида Рахимова
Вакуумно-дуговая напылительная установка ВДНУ Подготовил : студент гр. 2341 -21 Проверила: Карибуллина Фарида Рахимова
 Введение Данная презентация посвящена описанию крупномасштабной вакуумно-дуговой напылительной установки (ВДНУ), разработанной для Ланчжоуского института физики Китайской аэрокосмической корпорации. Установка предназначена для нанесения различных функциональных покрытий (нитриды, оксиды и карбиды металлов) методом вакуумно-дугового осаждения на металлические и неметаллические изделия. Она обеспечивает вакуумную откачку, создание требуемой для технологических процессов газовой среды, финишную ионную очистку и нанесение покрытий: на трубы (длиной от 1 до 3 м, диаметром от 10 до 60 мм, с максимальной загрузкой 40 штук), листы (размером 2 м 1 м, с максимальной загрузкой 5 штук) и антенны (диаметром до 2 м).
Введение Данная презентация посвящена описанию крупномасштабной вакуумно-дуговой напылительной установки (ВДНУ), разработанной для Ланчжоуского института физики Китайской аэрокосмической корпорации. Установка предназначена для нанесения различных функциональных покрытий (нитриды, оксиды и карбиды металлов) методом вакуумно-дугового осаждения на металлические и неметаллические изделия. Она обеспечивает вакуумную откачку, создание требуемой для технологических процессов газовой среды, финишную ионную очистку и нанесение покрытий: на трубы (длиной от 1 до 3 м, диаметром от 10 до 60 мм, с максимальной загрузкой 40 штук), листы (размером 2 м 1 м, с максимальной загрузкой 5 штук) и антенны (диаметром до 2 м).
 Конструктивная схема ВДНУ Рис. 1. Конструктивная схема вакуумно-дуговой напылительной установки ВДНУ: 1 - основание; 2 - патрубок для подсоединения средств откачки; 3 - эллиптическая крышка; 4 - привод вакуумный прижимной; 5 - окно смотровое; 6 - секция экрана; 7 - планетарный механизм вращения; 8 - механизм перемещения; 9 - электродуговой источник; 10 - ионный источник
Конструктивная схема ВДНУ Рис. 1. Конструктивная схема вакуумно-дуговой напылительной установки ВДНУ: 1 - основание; 2 - патрубок для подсоединения средств откачки; 3 - эллиптическая крышка; 4 - привод вакуумный прижимной; 5 - окно смотровое; 6 - секция экрана; 7 - планетарный механизм вращения; 8 - механизм перемещения; 9 - электродуговой источник; 10 - ионный источник
 Общий вид вакуумно-дуговой напылительной установки ВДНУ Установка состоит из следующих систем: камеры с внутрикамерной оснасткой; системы вакуумной откачки; системы газопитания (газонапуска, поддержания и контроля давления); системы внутрикамерного нагрева изделий; системы источников финишной ионной очистки; системы электродуговых источников металлической плазмы; системы подачи и поддержания напряжения смещения; системы электропитания и управления; системы водяного охлаждения.
Общий вид вакуумно-дуговой напылительной установки ВДНУ Установка состоит из следующих систем: камеры с внутрикамерной оснасткой; системы вакуумной откачки; системы газопитания (газонапуска, поддержания и контроля давления); системы внутрикамерного нагрева изделий; системы источников финишной ионной очистки; системы электродуговых источников металлической плазмы; системы подачи и поддержания напряжения смещения; системы электропитания и управления; системы водяного охлаждения.
 Вакуумная камера с внутрикамерной оснасткой Вакуумная камера выполнена из нержавеющей стали и снабжена каналами для водяного охлаждения. Внутренний диаметр камеры 2400 мм, внутренняя длина 4400 мм. Вакуумная камера состоит из стационарного и подвижного модулей. Загрузка (выгрузка) изделий осуществляется в положении, когда подвижный модуль отведён от стационарного модуля.
Вакуумная камера с внутрикамерной оснасткой Вакуумная камера выполнена из нержавеющей стали и снабжена каналами для водяного охлаждения. Внутренний диаметр камеры 2400 мм, внутренняя длина 4400 мм. Вакуумная камера состоит из стационарного и подвижного модулей. Загрузка (выгрузка) изделий осуществляется в положении, когда подвижный модуль отведён от стационарного модуля.
 Системы вакуумной откачки и газопитания На структуру и свойства наносимых на изделия покрытий существенное влияние оказывает первоначально достигнутая степень разрежения в вакуумной камере и чистота используемых технологических газов. Для эксплуатации установки в промышленном режиме, кроме того, остро встает вопрос достижения требуемой степени разрежения за минимально возможное время. С учётом этого система высокопроизводительной безмасляной вакуумной откачки ВДНУ разработана на основе двух криогенных насосов НВК 630 -20 с быстротой действия 20 м 3/с каждый.
Системы вакуумной откачки и газопитания На структуру и свойства наносимых на изделия покрытий существенное влияние оказывает первоначально достигнутая степень разрежения в вакуумной камере и чистота используемых технологических газов. Для эксплуатации установки в промышленном режиме, кроме того, остро встает вопрос достижения требуемой степени разрежения за минимально возможное время. С учётом этого система высокопроизводительной безмасляной вакуумной откачки ВДНУ разработана на основе двух криогенных насосов НВК 630 -20 с быстротой действия 20 м 3/с каждый.

 Система газопитания обеспечивает подачу технологических газов N 2, O 2, Cx. Hy, Ar и их смесей в вакуумную камеру и поддержание необходимого давления для реализации технологических процессов синтеза и осаждения покрытий. Плавное регулирование и установка необходимых потоков технологических газов осуществляются с помощью четырёхканального регулятора массового расхода газов 1179 G (MKS Instruments, США).
Система газопитания обеспечивает подачу технологических газов N 2, O 2, Cx. Hy, Ar и их смесей в вакуумную камеру и поддержание необходимого давления для реализации технологических процессов синтеза и осаждения покрытий. Плавное регулирование и установка необходимых потоков технологических газов осуществляются с помощью четырёхканального регулятора массового расхода газов 1179 G (MKS Instruments, США).
 Системы внутрикамерного нагрева и охлаждения Система внутрикамерного нагрева обеспечивает нагрев изделий в вакууме (до максимальной температуры 400 С) перед нанесением покрытия и поддержания необходимых температурных режимов во время технологического процесса. Для определения оптимального сценария нагрева изделий: достижение требуемой температуры за приемлемое время (за время вакуумной откачки) с минимальными энергозатратами и поддержания температуры во время процесса напыления, а также для выбора нагревательного элемента - были проведены тепловые расчёты.
Системы внутрикамерного нагрева и охлаждения Система внутрикамерного нагрева обеспечивает нагрев изделий в вакууме (до максимальной температуры 400 С) перед нанесением покрытия и поддержания необходимых температурных режимов во время технологического процесса. Для определения оптимального сценария нагрева изделий: достижение требуемой температуры за приемлемое время (за время вакуумной откачки) с минимальными энергозатратами и поддержания температуры во время процесса напыления, а также для выбора нагревательного элемента - были проведены тепловые расчёты.
 Система водяного охлаждения обеспечивает автономное охлаждение наружной поверхности вакуумной камеры, защитного теплового экрана криогенных насосов, механических вакуумных насосов, компрессоров криогенных насосов, электродуговых и ионных источников.
Система водяного охлаждения обеспечивает автономное охлаждение наружной поверхности вакуумной камеры, защитного теплового экрана криогенных насосов, механических вакуумных насосов, компрессоров криогенных насосов, электродуговых и ионных источников.
 Системы источников ионной очистки и электродуговых источников металлической плазмы Система источников ионной очистки обеспечивает финишную ионную очистку и активацию поверхности изделий перед нанесением покрытия. Система электродуговых источников металлической плазмы обеспечивает генерацию и подачу в вакуумную камеру металлической плазмы для осуществления процессов синтеза и осаждения на поверхности изделий покрытий из нитридов, оксидов, карбидов металлов и их комбинаций, так же как и осаждение чистых металлических покрытий
Системы источников ионной очистки и электродуговых источников металлической плазмы Система источников ионной очистки обеспечивает финишную ионную очистку и активацию поверхности изделий перед нанесением покрытия. Система электродуговых источников металлической плазмы обеспечивает генерацию и подачу в вакуумную камеру металлической плазмы для осуществления процессов синтеза и осаждения на поверхности изделий покрытий из нитридов, оксидов, карбидов металлов и их комбинаций, так же как и осаждение чистых металлических покрытий
 Система подачи и поддержания напряжения смещения Для реализации технологических процессов в вакуумнодуговом способе осаждения покрытий необходимо поддержание на напыляемом изделии в процессе напыления отрицательного потенциала (разном для реализации различных технологий). Для ВДНУ разработан специальный импульсный источник напряжения смещения для подачи и поддержании на изделии отрицательного потенциала с амплитудой выходного напряжения 10 - 1000 В, максимальной амплитудой выходного тока 70 А при частоте выходных импульсов 25 – 25000 Гц, длительности импульсов 20 – 2000 мкс, скважности 5 – 50%.
Система подачи и поддержания напряжения смещения Для реализации технологических процессов в вакуумнодуговом способе осаждения покрытий необходимо поддержание на напыляемом изделии в процессе напыления отрицательного потенциала (разном для реализации различных технологий). Для ВДНУ разработан специальный импульсный источник напряжения смещения для подачи и поддержании на изделии отрицательного потенциала с амплитудой выходного напряжения 10 - 1000 В, максимальной амплитудой выходного тока 70 А при частоте выходных импульсов 25 – 25000 Гц, длительности импульсов 20 – 2000 мкс, скважности 5 – 50%.
 Система электропитания и управления Структурная схема системы управления установкой приведена на рис. 4. В состав системы управления установкой входят: HOST-PC, содержащий два одинаковых двухпортовых адаптера асинхронной связи RS-485(CI 132). Три программируемых логических контроллера (PLC 1 – PLC 3). Связь HOST-PC c PLC 1 – PLC 3 осуществляется по трём витым парам. PLC 1 управляет работой систем откачки, газонапуска, нагрева, охлаждения, вращения внутрикамерных механизмов и подачи напряжения смещения. Возможны два варианта управления работой PLC 1.
Система электропитания и управления Структурная схема системы управления установкой приведена на рис. 4. В состав системы управления установкой входят: HOST-PC, содержащий два одинаковых двухпортовых адаптера асинхронной связи RS-485(CI 132). Три программируемых логических контроллера (PLC 1 – PLC 3). Связь HOST-PC c PLC 1 – PLC 3 осуществляется по трём витым парам. PLC 1 управляет работой систем откачки, газонапуска, нагрева, охлаждения, вращения внутрикамерных механизмов и подачи напряжения смещения. Возможны два варианта управления работой PLC 1.
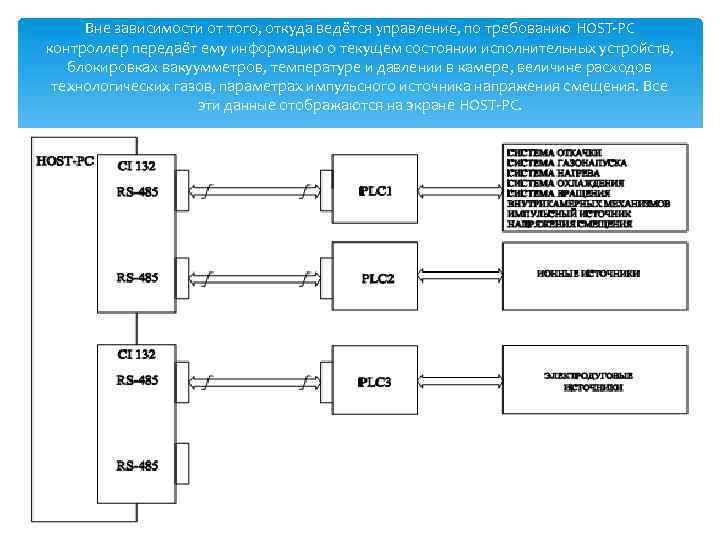 Вне зависимости от того, откуда ведётся управление, по требованию HOST-PC контроллер передаёт ему информацию о текущем состоянии исполнительных устройств, блокировках вакуумметров, температуре и давлении в камере, величине расходов технологических газов, параметрах импульсного источника напряжения смещения. Все эти данные отображаются на экране HOST-PC.
Вне зависимости от того, откуда ведётся управление, по требованию HOST-PC контроллер передаёт ему информацию о текущем состоянии исполнительных устройств, блокировках вакуумметров, температуре и давлении в камере, величине расходов технологических газов, параметрах импульсного источника напряжения смещения. Все эти данные отображаются на экране HOST-PC.
 Технические характеристики ВДНУ Вакуумная камера (нержавеющая сталь, водоохлаждаемая): внутренний диаметр, мм внутренняя длина, мм Вакуумная откачка (на основе криосорбционных насосов): предельное остаточное давление, Па время откачки до предельного остаточного давления, ч Внутрикамерный нагрев изделий (с возможностью регулировки): максимальная мощность, к. Вт максимальная температура нагрева изделий, С Система подачи технологических газов: (четыре канала), см 3/мин Механизмы внутрикамерного перемещения изделий: держатель для труб (длиной до 3 м, диаметром до 60 мм), обеспечивающий их планетарное внутрикамерное перемещение, держатель для листов (длиной до 2 м, шириной до 1 м), обеспечивающий их внутрикамерное вращение, держатель для антенны (диаметром до 2 м), обеспечивающий ее внутрикамерное вращение 2400 4400 5 х10 -4 1 400 0 - 1000 55
Технические характеристики ВДНУ Вакуумная камера (нержавеющая сталь, водоохлаждаемая): внутренний диаметр, мм внутренняя длина, мм Вакуумная откачка (на основе криосорбционных насосов): предельное остаточное давление, Па время откачки до предельного остаточного давления, ч Внутрикамерный нагрев изделий (с возможностью регулировки): максимальная мощность, к. Вт максимальная температура нагрева изделий, С Система подачи технологических газов: (четыре канала), см 3/мин Механизмы внутрикамерного перемещения изделий: держатель для труб (длиной до 3 м, диаметром до 60 мм), обеспечивающий их планетарное внутрикамерное перемещение, держатель для листов (длиной до 2 м, шириной до 1 м), обеспечивающий их внутрикамерное вращение, держатель для антенны (диаметром до 2 м), обеспечивающий ее внутрикамерное вращение 2400 4400 5 х10 -4 1 400 0 - 1000 55
 Система источников ионной очистки изделий: 11 источников ионной очистки с возможностью регулировки ионного тока и ускоряющего напряжения: ток ионного пучка, м. А рабочее ускоряющее напряжение, к. В Система электродуговых источников металлической плазмы (11 электродуговых источников с возможностью регулировки тока дуги и распределения плазменного потока): рабочий ток, А рабочее напряжение, В Источник импульсного напряжения смещения, подаваемого на изделие: напряжение импульса, В ток импульса, А частота следования импульсов, Гц коэффициент заполнения импульса, Система общего электропитания и управления установкой: программно-логическое управление вакуумной откачкой, работой ионных и дуговых источников, возможность компьютерного управления установкой. максимальная потребляемая мощность, к. Вт максимальный расход воды, м 3/час 150 30 1 -4 40 - 130 25 - 35 0 -1000 0 - 70 25 -25000 5 -50 150 6, 2
Система источников ионной очистки изделий: 11 источников ионной очистки с возможностью регулировки ионного тока и ускоряющего напряжения: ток ионного пучка, м. А рабочее ускоряющее напряжение, к. В Система электродуговых источников металлической плазмы (11 электродуговых источников с возможностью регулировки тока дуги и распределения плазменного потока): рабочий ток, А рабочее напряжение, В Источник импульсного напряжения смещения, подаваемого на изделие: напряжение импульса, В ток импульса, А частота следования импульсов, Гц коэффициент заполнения импульса, Система общего электропитания и управления установкой: программно-логическое управление вакуумной откачкой, работой ионных и дуговых источников, возможность компьютерного управления установкой. максимальная потребляемая мощность, к. Вт максимальный расход воды, м 3/час 150 30 1 -4 40 - 130 25 - 35 0 -1000 0 - 70 25 -25000 5 -50 150 6, 2
 Список литературы 1. Handbook of vacuum arc science and technology: fundamentals and applications/ Edited by R. L. Boxman, P. J. Martin, D. Sanders// Noyes Publications, New Jersey, USA, 1995. 2. Nanotechnology: Benefits, Challenges, and Risks/ A. D. Romig, Jr. , and T. A. Michalske// 46 th Annual Technical Conference Proceeding of the Society of Vacuum Coaters. 2003. p. 3 – 8. 3. Two- chamber vacuum – arc plant “DECOR” for deposition of functional and decorative coatings/ M. V. Gordienko, V. V. Ivanov, D. A. Karpov, V. Y. Moiseev, L. I. Popkov, A. I. Prudnikov and V. N. Sharonov// Plasma Devices and Operations. 1997. vol. 5. p. 227 – 237. 4. Cathodic arc deposition of Ti. N and Zr(C, N) at low substrate temperatures using a pulsed bias voltage/ J. Fessmann, W. Olbrich and G. Kampschulte// Materials Science and Engineering. 1991. vol. A 140. p. 830 – 837. 5. Experiments on thick coatings deposited by means of arc technology/ D. A. Karpov, I. F. Kislov, A. I. Ryabchikov, A. A. Ganenko// Surface and Coatings Technology. 1997. vol. 89. p. 58 – 61.
Список литературы 1. Handbook of vacuum arc science and technology: fundamentals and applications/ Edited by R. L. Boxman, P. J. Martin, D. Sanders// Noyes Publications, New Jersey, USA, 1995. 2. Nanotechnology: Benefits, Challenges, and Risks/ A. D. Romig, Jr. , and T. A. Michalske// 46 th Annual Technical Conference Proceeding of the Society of Vacuum Coaters. 2003. p. 3 – 8. 3. Two- chamber vacuum – arc plant “DECOR” for deposition of functional and decorative coatings/ M. V. Gordienko, V. V. Ivanov, D. A. Karpov, V. Y. Moiseev, L. I. Popkov, A. I. Prudnikov and V. N. Sharonov// Plasma Devices and Operations. 1997. vol. 5. p. 227 – 237. 4. Cathodic arc deposition of Ti. N and Zr(C, N) at low substrate temperatures using a pulsed bias voltage/ J. Fessmann, W. Olbrich and G. Kampschulte// Materials Science and Engineering. 1991. vol. A 140. p. 830 – 837. 5. Experiments on thick coatings deposited by means of arc technology/ D. A. Karpov, I. F. Kislov, A. I. Ryabchikov, A. A. Ganenko// Surface and Coatings Technology. 1997. vol. 89. p. 58 – 61.


