Презентация по ЛОКОС.ppt
- Количество слайдов: 38
 Упрощенная схема процесса создания ЛОКОС Page 1
Упрощенная схема процесса создания ЛОКОС Page 1
 Основные особенности и определения • LOCOS = LOCal Oxidation of Silicon (Локальное окисление кремния) • Основные этапы формирования: - активные области пластины маскируются с помощью Si 3 N 4 - в неактивных областях выращивается толстый слой оксида • Используется для электрической изоляции КМОП транзисторов • Редко используется в современном производстве – в настоящее время более распространены другие технологии, такие как траншейная изоляция (Shallow Trench Isolation = STI) Page 2
Основные особенности и определения • LOCOS = LOCal Oxidation of Silicon (Локальное окисление кремния) • Основные этапы формирования: - активные области пластины маскируются с помощью Si 3 N 4 - в неактивных областях выращивается толстый слой оксида • Используется для электрической изоляции КМОП транзисторов • Редко используется в современном производстве – в настоящее время более распространены другие технологии, такие как траншейная изоляция (Shallow Trench Isolation = STI) Page 2
 LOCOS –шаг 1 Формирование N-карманов • Термическое окисление • Нанесение фоторезиста Фотошаблон для формирования n-карманов oxide photoresist p-type substrate Cross section view Фотошаблон для формирования n-карманов Layout view Page 3
LOCOS –шаг 1 Формирование N-карманов • Термическое окисление • Нанесение фоторезиста Фотошаблон для формирования n-карманов oxide photoresist p-type substrate Cross section view Фотошаблон для формирования n-карманов Layout view Page 3
 LOCOS –шаг 1 Формирование N-карманов • Термическое окисление • Нанесение фоторезиста • Формирование рисунка на слое фоторезиста – Фотошаблон для формирования nкарманов – Экспонирование областей, на которых будут сформированы nкарманы Фотошаблон для формирования n-карманов oxide photoresist p-type substrate Cross section view Фотошаблон для формирования n-карманов Layout view Page 4
LOCOS –шаг 1 Формирование N-карманов • Термическое окисление • Нанесение фоторезиста • Формирование рисунка на слое фоторезиста – Фотошаблон для формирования nкарманов – Экспонирование областей, на которых будут сформированы nкарманы Фотошаблон для формирования n-карманов oxide photoresist p-type substrate Cross section view Фотошаблон для формирования n-карманов Layout view Page 4
 LOCOS –шаг 1 Формирование N-карманов • Термическое окисление • Нанесение фоторезиста • Формирование рисунка на слое фоторезиста • Травление оксида • Удаление фоторезиста oxide p-type substrate Cross section view Layout view Page 5
LOCOS –шаг 1 Формирование N-карманов • Термическое окисление • Нанесение фоторезиста • Формирование рисунка на слое фоторезиста • Травление оксида • Удаление фоторезиста oxide p-type substrate Cross section view Layout view Page 5
 LOCOS –шаг 1 Формирование N-карманов • Термическое окисление • Нанесение фоторезиста • Формирование рисунка на слое фоторезиста • Травление оксида • Удаление фоторезиста • Ионная имплантация примесей n-типа через маску оксида n-well p-type substrate Cross section view Layout view Page 6
LOCOS –шаг 1 Формирование N-карманов • Термическое окисление • Нанесение фоторезиста • Формирование рисунка на слое фоторезиста • Травление оксида • Удаление фоторезиста • Ионная имплантация примесей n-типа через маску оксида n-well p-type substrate Cross section view Layout view Page 6
 LOCOS –шаг 2 Формирование активных областей • Осаждение Si. N на подложку • Нанесение фоторезиста на слой Si. N ACTIVE mask n-well Si. N photoresist p-type substrate ACTIVE mask Page 7
LOCOS –шаг 2 Формирование активных областей • Осаждение Si. N на подложку • Нанесение фоторезиста на слой Si. N ACTIVE mask n-well Si. N photoresist p-type substrate ACTIVE mask Page 7
 LOCOS –шаг 2 Формирование активных областей • Осаждение Si. N на подложку • Нанесение фоторезиста на слой Si. N • Проявление фоторезиста ACTIVE mask n-well Si. N photoresist p-type substrate – *ACTIVE MASK ACTIVE mask Page 8
LOCOS –шаг 2 Формирование активных областей • Осаждение Si. N на подложку • Нанесение фоторезиста на слой Si. N • Проявление фоторезиста ACTIVE mask n-well Si. N photoresist p-type substrate – *ACTIVE MASK ACTIVE mask Page 8
 LOCOS –шаг 2 Формирование активных областей • Осаждение Si. N на подложку • Нанесение фоторезиста на слой Si. N • Проявление фоторезиста – *ACTIVE MASK • Травление Si. N в местах, не защищенных фоторезистом – Остается маска Si. N, которая блокирует рост оксида n-well Si. N photoresist p-type substrate ACTIVE mask Page 9
LOCOS –шаг 2 Формирование активных областей • Осаждение Si. N на подложку • Нанесение фоторезиста на слой Si. N • Проявление фоторезиста – *ACTIVE MASK • Травление Si. N в местах, не защищенных фоторезистом – Остается маска Si. N, которая блокирует рост оксида n-well Si. N photoresist p-type substrate ACTIVE mask Page 9
 LOCOS –шаг 2 Формирование активных областей • • Осаждение Si. N на подложку Нанесение фоторезиста на слой Si. N Проявление фоторезиста – FOX p-type substrate *ACTIVE MASK Травление Si. N в местах, на защищенных фоторезистом – • • n-well Остается маска Si. N, которая блокирует рост оксида Удаление фоторезиста Выращивание локального окисла – ACTIVE mask Термическое окисление Page 10
LOCOS –шаг 2 Формирование активных областей • • Осаждение Si. N на подложку Нанесение фоторезиста на слой Si. N Проявление фоторезиста – FOX p-type substrate *ACTIVE MASK Травление Si. N в местах, на защищенных фоторезистом – • • n-well Остается маска Si. N, которая блокирует рост оксида Удаление фоторезиста Выращивание локального окисла – ACTIVE mask Термическое окисление Page 10
 LOCOS –шаг 2 Формирование активных областей • • Осаждение Si. N на подложку Нанесение фоторезиста на слой Si. N Проявление фоторезиста – p-type substrate Остается маска Si. N, которая блокирует рост оксида Удаление фоторезиста Выращивание локального окисла – • FOX Травление Si. N в местах, на защищенных фоторезистом – • • *ACTIVE MASK n-well ACTIVE mask Термическое окисление Удаление Si. N Page 11
LOCOS –шаг 2 Формирование активных областей • • Осаждение Si. N на подложку Нанесение фоторезиста на слой Si. N Проявление фоторезиста – p-type substrate Остается маска Si. N, которая блокирует рост оксида Удаление фоторезиста Выращивание локального окисла – • FOX Травление Si. N в местах, на защищенных фоторезистом – • • *ACTIVE MASK n-well ACTIVE mask Термическое окисление Удаление Si. N Page 11
 LOCOS –шаг 3 Формирование затвора • Выращивание тонкого слоя оксида под затвор – Выращивается по всей поверхности пластины – Незначительно влияет на участки ЛОКОС gate oxide Page 12
LOCOS –шаг 3 Формирование затвора • Выращивание тонкого слоя оксида под затвор – Выращивается по всей поверхности пластины – Незначительно влияет на участки ЛОКОС gate oxide Page 12
 LOCOS –шаг 3 Формирование затвора • Выращивание тонкого слоя оксида под затвор – Выращивается по всей поверхности пластины – Незначительно влияет на участки ЛОКОС • Осаждение поликристаллического кремния • Нанесение фоторезиста POLY mask gate oxide polysilicon POLY mask Page 13
LOCOS –шаг 3 Формирование затвора • Выращивание тонкого слоя оксида под затвор – Выращивается по всей поверхности пластины – Незначительно влияет на участки ЛОКОС • Осаждение поликристаллического кремния • Нанесение фоторезиста POLY mask gate oxide polysilicon POLY mask Page 13
 LOCOS –шаг 3 Формирование затвора • Выращивание тонкого слоя оксида под затвор – – • • Выращивается по всей поверхности пластины Незначительно влияет на участки ЛОКОС Осаждение поликристаллического кремния Нанесение фоторезиста Проявление фоторезиста – *POLY MASK Травление поликристаллического кремния на открытых участках POLY mask gate oxide POLY mask Page 14
LOCOS –шаг 3 Формирование затвора • Выращивание тонкого слоя оксида под затвор – – • • Выращивается по всей поверхности пластины Незначительно влияет на участки ЛОКОС Осаждение поликристаллического кремния Нанесение фоторезиста Проявление фоторезиста – *POLY MASK Травление поликристаллического кремния на открытых участках POLY mask gate oxide POLY mask Page 14
 LOCOS –шаг 3 Формирование затвора • Выращивание тонкого слоя оксида под затвор – – • • • Выращивается по всей поверхности пластины Незначительно влияет на участки ЛОКОС gate oxide Осаждение поликристаллического кремния Нанесение фоторезиста Проявление фоторезиста – *POLY MASK Травление поликристаллического кремния на открытых участках Удаление оксида – Затвор защищен поликремнием Page 15
LOCOS –шаг 3 Формирование затвора • Выращивание тонкого слоя оксида под затвор – – • • • Выращивается по всей поверхности пластины Незначительно влияет на участки ЛОКОС gate oxide Осаждение поликристаллического кремния Нанесение фоторезиста Проявление фоторезиста – *POLY MASK Травление поликристаллического кремния на открытых участках Удаление оксида – Затвор защищен поликремнием Page 15
 LOCOS –шаг 4 Формирование стоков и истоков pканального транзистора • Нанесение фоторезиста PSELECT mask Page 16
LOCOS –шаг 4 Формирование стоков и истоков pканального транзистора • Нанесение фоторезиста PSELECT mask Page 16
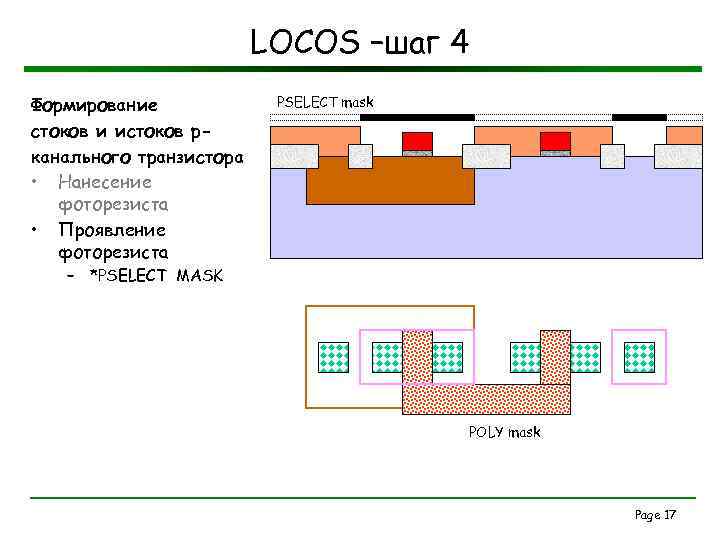 LOCOS –шаг 4 Формирование стоков и истоков pканального транзистора • Нанесение фоторезиста • Проявление фоторезиста PSELECT mask – *PSELECT MASK POLY mask Page 17
LOCOS –шаг 4 Формирование стоков и истоков pканального транзистора • Нанесение фоторезиста • Проявление фоторезиста PSELECT mask – *PSELECT MASK POLY mask Page 17
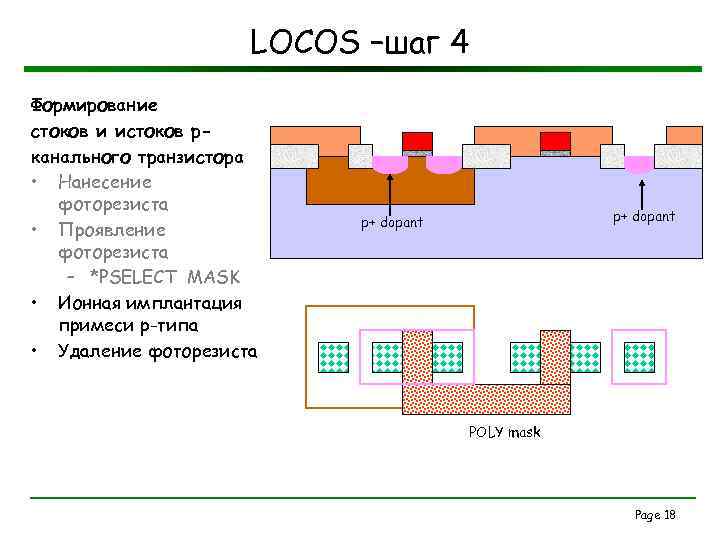 LOCOS –шаг 4 Формирование стоков и истоков pканального транзистора • Нанесение фоторезиста • Проявление фоторезиста – *PSELECT MASK • Ионная имплантация примеси p-типа • Удаление фоторезиста p+ dopant POLY mask Page 18
LOCOS –шаг 4 Формирование стоков и истоков pканального транзистора • Нанесение фоторезиста • Проявление фоторезиста – *PSELECT MASK • Ионная имплантация примеси p-типа • Удаление фоторезиста p+ dopant POLY mask Page 18
 LOCOS –шаг 5 Формирование стоков и истоков nканального транзистора • Нанесение фоторезиста NSELECT mask p+ p+ p+ n POLY mask Page 19
LOCOS –шаг 5 Формирование стоков и истоков nканального транзистора • Нанесение фоторезиста NSELECT mask p+ p+ p+ n POLY mask Page 19
 LOCOS –шаг 5 Формирование стоков и истоков nканального транзистора • Нанесение фоторезиста • Проявление фоторезиста NSELECT mask p+ p+ p+ n – *NSELECT MASK POLY mask Page 20
LOCOS –шаг 5 Формирование стоков и истоков nканального транзистора • Нанесение фоторезиста • Проявление фоторезиста NSELECT mask p+ p+ p+ n – *NSELECT MASK POLY mask Page 20
 LOCOS –шаг 5 Формирование стоков и истоков nканального транзистора • Нанесение фоторезиста • Проявление фоторезиста – *NSELECT MASK • Ионная имплантация примеси n-типа • Удаление фоторезиста n+ p+ p+ n+ n+ p+ n n+ dopant POLY mask Page 21
LOCOS –шаг 5 Формирование стоков и истоков nканального транзистора • Нанесение фоторезиста • Проявление фоторезиста – *NSELECT MASK • Ионная имплантация примеси n-типа • Удаление фоторезиста n+ p+ p+ n+ n+ p+ n n+ dopant POLY mask Page 21
 LOCOS –шаг 6 Формирование контактов • Нанесение газофазного окисла • Нанесение фоторезиста CONTACT mask n+ p+ p+ n+ n+ p+ n CONTACT mask Page 22
LOCOS –шаг 6 Формирование контактов • Нанесение газофазного окисла • Нанесение фоторезиста CONTACT mask n+ p+ p+ n+ n+ p+ n CONTACT mask Page 22
 LOCOS –шаг 6 Формирование контактов • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста – *CONTACT Mask – Одна маска для формирования контактов к активным областям ик поликремниевой коммутации CONTACT mask n+ p+ p+ n+ n+ p+ n CONTACT mask Page 23
LOCOS –шаг 6 Формирование контактов • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста – *CONTACT Mask – Одна маска для формирования контактов к активным областям ик поликремниевой коммутации CONTACT mask n+ p+ p+ n+ n+ p+ n CONTACT mask Page 23
 LOCOS –шаг 6 Формирование контактов • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста – *CONTACT Mask – Одна маска для формирования контактов к активным областям и к поликремниевой коммутации • Удаление оксида n+ p+ p+ n+ n+ p+ n Page 24
LOCOS –шаг 6 Формирование контактов • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста – *CONTACT Mask – Одна маска для формирования контактов к активным областям и к поликремниевой коммутации • Удаление оксида n+ p+ p+ n+ n+ p+ n Page 24
 LOCOS –шаг 6 Формирование контактов • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста – – • • n+ p+ p+ n+ n+ p+ n *CONTACT Mask Одна маска для формирования контактов к активным областям и к поликремниевой коммутации Удаление фоторезиста Напыление металла 1 – Сразу после открытия контактов, чтобы не вырос слой оксида Page 25
LOCOS –шаг 6 Формирование контактов • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста – – • • n+ p+ p+ n+ n+ p+ n *CONTACT Mask Одна маска для формирования контактов к активным областям и к поликремниевой коммутации Удаление фоторезиста Напыление металла 1 – Сразу после открытия контактов, чтобы не вырос слой оксида Page 25
 LOCOS –шаг 7 Формирование первого слоя металлизации • Нанесение фоторезиста METAL 1 mask n+ p+ p+ n+ n+ p+ n METAL 1 mask Page 26
LOCOS –шаг 7 Формирование первого слоя металлизации • Нанесение фоторезиста METAL 1 mask n+ p+ p+ n+ n+ p+ n METAL 1 mask Page 26
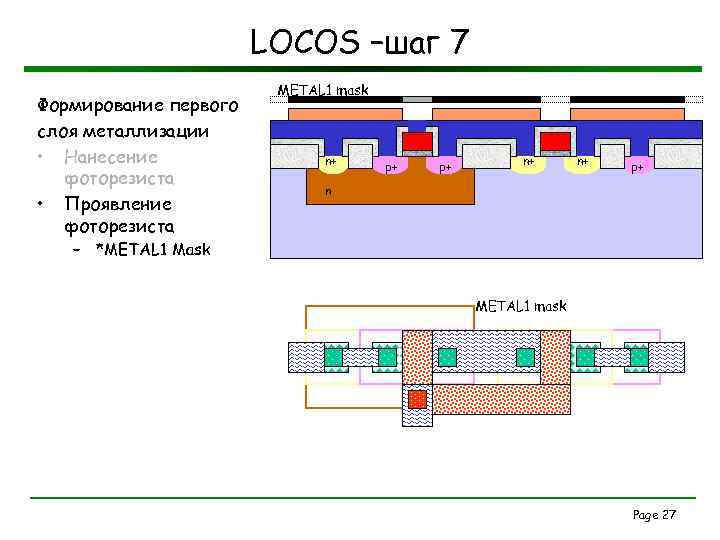 LOCOS –шаг 7 Формирование первого слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста METAL 1 mask n+ p+ p+ n+ n+ p+ n – *METAL 1 Mask METAL 1 mask Page 27
LOCOS –шаг 7 Формирование первого слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста METAL 1 mask n+ p+ p+ n+ n+ p+ n – *METAL 1 Mask METAL 1 mask Page 27
 LOCOS –шаг 7 Формирование первого слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста – *METAL 1 Mask • Травление металла n+ p+ p+ n+ n+ p+ n металлизация по слою поликремния за пределами сечения Page 28
LOCOS –шаг 7 Формирование первого слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста – *METAL 1 Mask • Травление металла n+ p+ p+ n+ n+ p+ n металлизация по слою поликремния за пределами сечения Page 28
 LOCOS –шаг 7 Формирование первого слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста – *METAL 1 Mask • Травление металла • Удаление фоторезиста n+ p+ p+ n+ n+ p+ n Page 29
LOCOS –шаг 7 Формирование первого слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста – *METAL 1 Mask • Травление металла • Удаление фоторезиста n+ p+ p+ n+ n+ p+ n Page 29
 LOCOS –шаг 8 Формирование переходных отверстий к первому слою металлизации • Нанесение газофазного окисла • Нанесение фоторезиста VIA mask n+ p+ p+ n+ n+ p+ n VIA mask Page 30
LOCOS –шаг 8 Формирование переходных отверстий к первому слою металлизации • Нанесение газофазного окисла • Нанесение фоторезиста VIA mask n+ p+ p+ n+ n+ p+ n VIA mask Page 30
 LOCOS –шаг 8 Формирование переходных отверстий к первому слою металлизации • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста VIA mask n+ p+ p+ n+ n+ p+ n – *VIA Mask VIA mask Page 31
LOCOS –шаг 8 Формирование переходных отверстий к первому слою металлизации • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста VIA mask n+ p+ p+ n+ n+ p+ n – *VIA Mask VIA mask Page 31
 LOCOS –шаг 8 Формирование переходных отверстий к первому слою металлизации • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста – *VIA Mask • Травление оксида • Удаление фоторезиста n+ p+ p+ n+ n+ p+ n Page 32
LOCOS –шаг 8 Формирование переходных отверстий к первому слою металлизации • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста – *VIA Mask • Травление оксида • Удаление фоторезиста n+ p+ p+ n+ n+ p+ n Page 32
 LOCOS –шаг 8 Формирование переходных отверстий к первому слою металлизации • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста – *VIA Mask • Травление оксида • Удаление фоторезиста • Напыление металла 2 n+ p+ p+ n+ n+ p+ n Page 33
LOCOS –шаг 8 Формирование переходных отверстий к первому слою металлизации • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста – *VIA Mask • Травление оксида • Удаление фоторезиста • Напыление металла 2 n+ p+ p+ n+ n+ p+ n Page 33
 LOCOS –шаг 9 METAL 2 mask Формирование второго слоя металлизации • Нанесение фоторезиста n+ p+ p+ n+ n+ p+ n METAL 2 mask Page 34
LOCOS –шаг 9 METAL 2 mask Формирование второго слоя металлизации • Нанесение фоторезиста n+ p+ p+ n+ n+ p+ n METAL 2 mask Page 34
 LOCOS –шаг 9 METAL 2 mask Формирование второго слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста n+ p+ p+ n+ n+ p+ n – *METAL 2 Mask METAL 2 mask Page 35
LOCOS –шаг 9 METAL 2 mask Формирование второго слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста n+ p+ p+ n+ n+ p+ n – *METAL 2 Mask METAL 2 mask Page 35
 LOCOS –шаг 9 Формирование второго слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста – *METAL 2 Mask • Травление металла n+ p+ p+ n+ n+ p+ n Page 36
LOCOS –шаг 9 Формирование второго слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста – *METAL 2 Mask • Травление металла n+ p+ p+ n+ n+ p+ n Page 36
 LOCOS –шаг 9 Формирование второго слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста – *METAL 2 Mask • Травление металла • Удаление фоторезиста n+ p+ p+ n+ n+ p+ n Page 37
LOCOS –шаг 9 Формирование второго слоя металлизации • Нанесение фоторезиста • Проявление фоторезиста – *METAL 2 Mask • Травление металла • Удаление фоторезиста n+ p+ p+ n+ n+ p+ n Page 37
 LOCOS –шаг 10+ Формирование дополнительных слоев металлизации • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста • Травление окисла • Осаждение металла • Нанесение фоторезиста • Проявление фоторезиста • Травление металла • Повторять для каждого дополнительного слоя металлизации n+ p+ p+ n+ n+ p+ n p-type substrate Page 38
LOCOS –шаг 10+ Формирование дополнительных слоев металлизации • Нанесение газофазного окисла • Нанесение фоторезиста • Проявление фоторезиста • Травление окисла • Осаждение металла • Нанесение фоторезиста • Проявление фоторезиста • Травление металла • Повторять для каждого дополнительного слоя металлизации n+ p+ p+ n+ n+ p+ n p-type substrate Page 38


