ТЕХНОЛОГИИ ТОНКИХ ПЛЕНОК И ПОКРЫТИЙ.ppt
- Количество слайдов: 62

ТЕХНОЛОГИИ ТОНКИХ ПЛЕНОК И ПОКРЫТИЙ

На базе использования плёнок возникли такие направления в технике как тонкоплёночная электроника, специальные разделы оптики, получение износостойких, коррозионностойких и др. нанокристаллических покрытий. сверхтвердые (Н ≥ 40 ГПа) и ультратвердые (Н ≥ 70 ГПа) наноструктурные тонкие пленки


Схема установки для нанесения покрытия PVD-методом (Physical Vapour Deposition). 1. Перевод материала для покрытия в состояние пара, 2. Транспортировка пара к подложке, 3. Осаждение материала покрытия из паровой фазы, 4. Формирование покрытия. 1 – исходный материал, 2 - испаритель, 3 - поток испарившегося вещества, 4 - подложка, 5 - покрытие, 6 - система транспортировки паровой фазы к подложке, 7 - система фокусировки, 8 - система закрепления подложки, 9 - система регулирования температуры нагрева подложки, 10 - система управления и контроля параметрами, 11 - вакуумная камера, 12 - система создания и поддержания высокого вакуума , 13 - шлюзовая камера, 14 - смотровые контрольные окна, 15 - система охлаждения.

Важнейшим управляющим параметром системы при осаждении покрытий и пленок из газовой фазы является давление компонентов. Точность контроля давления и минимальное остаточное давление посторонних газов определяют распределение осаждаемых частиц по энергиям и, следовательно, однородность формируемой пленки. Негативно сказывается на гомогенности пленки значительное остаточное давление. Посторонние атомы могут взаимодействовать с поверхностью подложки или пленки и встраиваться в их структуру. Фазовые соотношения в системе определяют возможность формирования пленок заданного состава. Таким образом, равновесное давление насыщенных паров и связанная с ним скорость испарения компонентов являются важными термодинамическими характеристиками системы.

Достоинства PVD- метода • возможность получения равномерных поверхностных слоев; • хорошая воспроизводимость свойств; • различный размер покрываемой поверхности; • возможность селективного нанесения на выбранные участки; • почти неограниченный выбор материалов подложки; • достаточная гибкость к требованиям по температуре подложки; • широкий выбор материалов для поверхностных слоев; • возможность получения многослойных покрытий и из разных материалов; изменение состава, структуры и свойств слоев путем варьирования технологическими параметрами нанесения; • возможность выполнения требований к высокой чистоте материала покрытия; минимальное загрязнение окружающей среды.

Недостатки PVD- метода • сложность и большая стоимость технологического и контрольного оборудования, • необходимость очень высокой квалификации обслуживающего персонала, • сравнительно низкая производительность, • сложность разработки технологического режима для конкретного случая получения покрытия; • необходимость специальной подготовки покрываемых поверхностей.

Термическое испарение основано на конденсации молекулярных и атомарных пучков материала, получаемых в результате резистивного, электронно-лучевого и др. нагрева. • давление 10 -3 -10 -5 Па • энергия частиц 0, 1 -0, 3 э. В Процесс термического вакуумного напыления характеризуется температурой на испарителе Tис, давлением воздуха в рабочей камере P 0, температурой нагрева подложек Tп. Температура нагрева вещества в испарителе (Tис) должна обеспечивать достаточно высокую интенсивность испарения, чтобы время напыления пленки не превышало 1 ÷ 2 минут. В то же время чрезмерно высокая интенсивность приводит к образованию мелкозернистой неустойчивой структуры в плёнке. Процесс осаждения пленок на подложку происходит с приемлемой для производства скоростью, если давление насыщенного пара примерно равно 1, 33 Па. Температура вещества, при которой ри = 1, 33 Па (ри – давление насыщенного пара при температуре испарения), называют условной температурой Тусл.

Скорость испарения Vи, кг/(м 2 с), всех веществ определяется давлением паров P (Па), при температуре испарения Tи, (K), и молекулярной массой M вещества (закон Герца, Кнудсена, Лэнгмюра): Если давление паров испаряемого вещества при температуре Tи не превышает 1. 33 Па, то при рабочем давлении в вакуумной камере порядка 10– 2 Па и менее молекулы и атомы испаряемого вещества достигают поверхности подложки без столкновений между собой и с молекулами остаточных газов. В этом случае реализуется молекулярный режим испарения и конденсации, для которого справедливы законы Ламберта – Кнудсена. Варианты метода термического испарения: а) испаритель из металлического листа с защитным покрытием, б) металлический испаритель в виде лодочки, в) керамический тигель с внешним нагревательным элементом, г) испарение лазерным или электронным лучом

Достоинства: • относительная простота оборудования и контроля процесса, • можно получать наноструктурированные пленки металлов, полупроводников и других соединений Недостатки: • Возможности метода ограничены низкими и нерегулярными энергиями конденсирующихся частиц. • Низкая адгезия покрытия вследствие малой энергии осаждающихся на подложку атомов или молекул • Высокая чувствительность к наличию на поверхности подложки посторонних пленок и загрязнений. • Невысокая стабильность структуры и свойств пленок, осажденных при температуре ниже 0, 3… 0, 5 температуры плавления покрытия. • Термические методы осаждения практически непригодны для изготовления покрытий карбидов, нитридов и других соединений, обеспечивающих высокие прочность, коррозионную и термическую стойкость.

Импульсное лазерное осаждение PLD (pulsed laser deposition) использование для испарения материалов излучения импульсного лазера с очень коротким временем импульса Эксимерный лазер с энергией порядка 1 Дж, высокоэнергетическая плазма с плотностью энергии 3 -5 Дж/см 2, состоящая из нейтральных атомов, молекул и ионов с энергией от 0, 1 до 10 э. В. Основная проблема - образование достаточно крупных кластеров в газовой фазе, что отрицательно сказывается на качестве покрытия. Позволяет осаждать многокомпонентные соединения, в том числе сложные оксиды. Возможно точно контролировать химический состав покрытия. Не требуется сверхвысокий вакуум.

Ионно-плазменные методы получения тонких пленок

Катодное распыление основан на использовании плазмы тлеющего разряда в вакууме при давлении порядка 1 -0, 1 Па Схемы катодного распыления: а) двухэлектродный метод, б) четырехэлектродный метод, 1 - вакуумная камера, 2 - держатель подложки (в двухэлектродном методе также является анодом), 3 - подложка, 4 - зона плазмы тлеющего разряда, 5 - мишень, 6 - основной катод, 7 - тепловой катод, 8 - стабилизирующий электрод, 9 - анод.
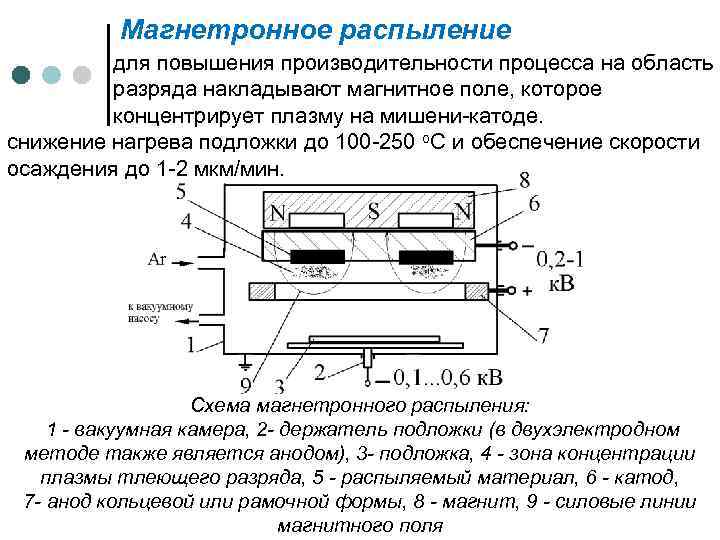
Магнетронное распыление для повышения производительности процесса на область разряда накладывают магнитное поле, которое концентрирует плазму на мишени-катоде. снижение нагрева подложки до 100 -250 о. С и обеспечение скорости осаждения до 1 -2 мкм/мин. Схема магнетронного распыления: 1 - вакуумная камера, 2 - держатель подложки (в двухэлектродном методе также является анодом), 3 - подложка, 4 - зона концентрации плазмы тлеющего разряда, 5 - распыляемый материал, 6 - катод, 7 - анод кольцевой или рамочной формы, 8 - магнит, 9 - силовые линии магнитного поля

Достоинства: • более высокая прочность сцепления и плотность полученных покрытий из-за более высокой энергии распыленных частиц; • формирование покрытий без изменения стехиометрического состава; • возможность получения покрытий из особо тугоплавких и неплавящихся материалов; • возможность управления составом и свойствами покрытия в процессе нанесения; • возможность очистки поверхности основы и растущего покрытия. Основные недостатки: • скорости напыления, как правило, ниже, чем при других вакуумных методах, за исключением магнетронного; • количество загрязнений в материале покрытий несколько выше; • объем камеры ограничивает размер изделия.

Ионно-лучевые методы

Ионно-лучевое распыление Главное отличие - ионы инертного газа подаются к распыляемому материалу из отдельно расположенного независимого ионного источника в виде концентрированного потока с энергией 1 -10 кэ. В вакуум 10 -3… 10 -2 Па Схема ионно-лучевого распыления: 1 - вакуумная камера, 2 - держатель подложки, 3 - подложка, 4 - концентрированный поток ионов, 5 - распыляемый материал, 6 - держатель мишени, 7 - ионно-лучевой источник, 8 - магнитная система концентрации плазмы тлеющего разряда, 9 - устройство фокусировки ионного луча, 10 - зона концентрации плазмы тлеющего разряда, 11 - поток частиц осаждающегося на подложку материала.

Преимущество метода ионного распыления Большая площадь распыляемой пластины материала — мишени, выполняющей функции источника атомов осаждаемого вещества, позволяет получить равномерные по толщине пленки на подложках больших размеров; Мишень представляет собой длительно не заменяемый источник материала, что облегчает автоматизацию, повышает однородность процесса; Обеспечивается высокая адгезия пленки к подложке благодаря большой энергии конденсирующихся атомов; Получение пленок из тугоплавких металлов протекает без перегрева вакуумной камеры; Возможно получение окисных, нитридных и других пленок, в том числе легированных, в результате химических реакций атомов распыляемого металла с вводимыми в камеру газами; Можно получать органические пленки; Недостатком методом ионно-лучевого распыления является сложность точного соблюдения химического состава осаждаемого покрытия.
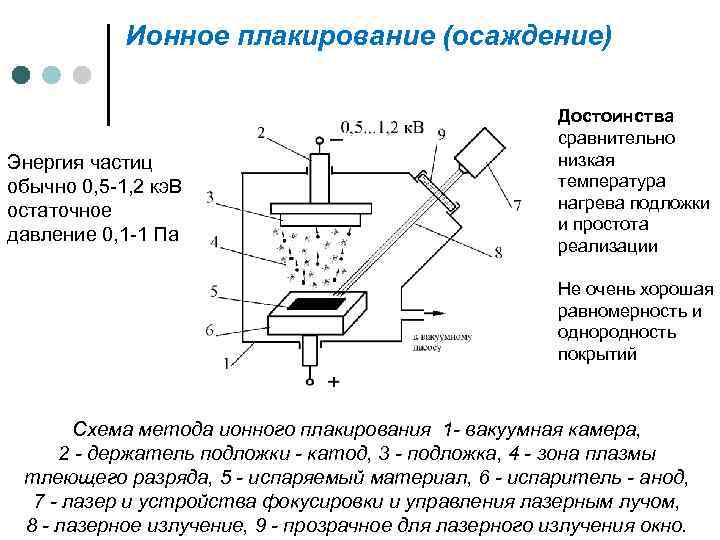
Ионное плакирование (осаждение) Энергия частиц обычно 0, 5 -1, 2 кэ. В остаточное давление 0, 1 -1 Па Достоинства сравнительно низкая температура нагрева подложки и простота реализации Не очень хорошая равномерность и однородность покрытий Схема метода ионного плакирования 1 - вакуумная камера, 2 - держатель подложки - катод, 3 - подложка, 4 - зона плазмы тлеющего разряда, 5 - испаряемый материал, 6 - испаритель - анод, 7 - лазер и устройства фокусировки и управления лазерным лучом, 8 - лазерное излучение, 9 - прозрачное для лазерного излучения окно.

Ионная имплантация основан на внедрении ионов высоких энергий в поверхность материала. Процесс проводят в вакууме порядка 10 -4… 10 -3 Па с помощью ионно-лучевых ускорителей (имплантеров). Схема метода ионной имплантации: 1 - источники ионов, 2 - поток ионов, 3 - систему анализа и сепарации ионов, 4 - система фокусировки, 5 - ускоритель ионов, 6 - система стабилизации и сканирования ионного луча, 7 - ионный луч, 8 - вакуумная камера, 9 - модифицируемый материал, 10 - держатель модифицируемого материала (образцов).

Достоинства: • возможность получать практически любые сочетания материалов в поверхностном нанослое, независимость от пределов растворимости компонентов в твердой фазе, • низкие температуры модифицируемого материала и отсутствие заметных изменений размеров, структуры и свойств основного материала, • нет явной границы раздела, отсутствие проблемы адгезии, • контролируемость глубины обработки, • хорошая воспроизводимость и стабильность процесса, • высокая чистота процесса в вакууме, • возможность за счет высокоточного сканирования ионного луча по обрабатываемой поверхности создавать сложные поверхностные наноструктуры, • возможность одновременной или последовательной имплантации ионов различных материалов.

Недостатки: • возможность обработки поверхностей материалов только в зоне прямого действия ионного луча, • малая глубина проникновения ионов в материал (особенно при низких энергиях), • протекание процессов распыления поверхности, • высокая стоимость и сложность оборудования и обработки, сложность, недостаточная изученность и трудность контролирования всего комплекса протекающих при ионной имплантации процессов.

Ионно-лучевое перемешивание Ионному облучению подвергается композиция из материала с уже нанесенным поверхностным слоем. Бомбардирующие поверхность ионы инертного газа выбивают поверхностные атомы материала слоя и основы из их равновесных положений, вызывая каскады атомных столкновений. В результате граница между поверхностным слоем и основой размывается и происходит перемешивание. Этот метод позволяет преодолеть такие недостатки ионной имплантации, как ограничение максимальной концентрации легирующего элемента эффектом распыления, возможность снижения энергии ионов, времени и доз ионного облучения. Процесс ведут в вакууме 10 -3… 10 -2 Па. В качестве инертного газа используют чаще всего аргон или ксенон. Использование ионов с более высокими атомными номерами приводит к повышению эффективности процессов перемешивания.

Лазерная группа методов Наноструктурное состояние достигается в тонких поверхностных слоях металлических материалов или изделий путем взаимодействия вещества с лазерным излучением высокой плотности. Используется импульсное лазерное излучение с плотностью энергии 103… 1010 Вт/см 2 и временем импульса 10 -2… 10 -9 с. Под действием лазерного облучения поверхностный слой материала толщиной 0, 1… 100 мкм очень быстро расплавляется и затем затвердевает со скоростями охлаждения 104… 108 К/с. При этом основная масса металлического материала вследствие кратковременности термического воздействия не нагревается и обеспечивает высокие скорости теплоотвода. Лазерное легирование или лазерная имплантация связана с дополнительным введением в оплавляемый поверхностный слой легирующих веществ. цели: 1. создание на поверхности модифицированного слоя с химическим составом и, следовательно, свойствами, отличающимся от основного металла; 2. облегчение формирования наноструктурного или аморфного состояния при затвердевании оплавленного поверхностного слоя.

Механизмы роста пленок Механизм роста пленок зависит от условий роста, природы наносимого вещества, материала и структуры подложки, а также метода получения. Тонкие пленки разделяют на эпитаксиальные и неэпитаксиальные. В случае эпитаксиального роста кристаллическая решетка пленки является как бы продолжением кристаллической решетки подложки. При небольшом несоответствии параметров ячеек может наблюдаться формирование дислокаций несоответствия на границе «пленка-подложка» , а также образование островковых структур. Гомоэпитаксия - химический состав подложки и растущего слоя совпадают. Гетероэпитаксия – химические составы не совпадают.

Строение поверхности монокристалла

Механизм роста при гомоэпитаксии

Механизм роста при гетероэпитаксии необходимо принимать во внимание дополнительные условия: поверхностную энергию и несоответствие параметров ячеек. γпленка + γпленка/подложка ≤ γподложка, то происходит полное смачивание и рост по механизму Франка-Ван-дер-Мерве. В противоположном случае наблюдается рост по механизму Вольмера-Вебера с образованием островковых структур. Если различие в параметрах кристаллических решеток пленки и подложки существенно, то наблюдается рост по механизму Странского-Крастанова.

Химическое осаждение из паровой фазы (CVD) компоненты получаемой пленки транспортируют в виде паров их летучих соединений к подложке, где происходит разложение паров и образование пленки требуемого состава. Подбор соединений, стабильных в газовой фазе и легко разлагающихся при нагревании.

Преимущество метода CVD : • возможность нанесения однородных по составу и толщине пленок на детали сложной конфигурации; • возможность достижения высоких скоростей осаждения (до нескольких мм/ч) с одновременным сохранением высокого качества пленки; • хорошая воспроизводимость свойств покрытий при неизменности существенных параметров процесса; • легкость управления процессом и гибкость на этапе отладки технологического режима; • возможность перехода от высоковакуумной аппаратуры к установкам с разрежением ≈10 Па или проточной аппаратуре, работающей в интервале давлений 102 -105 Па.
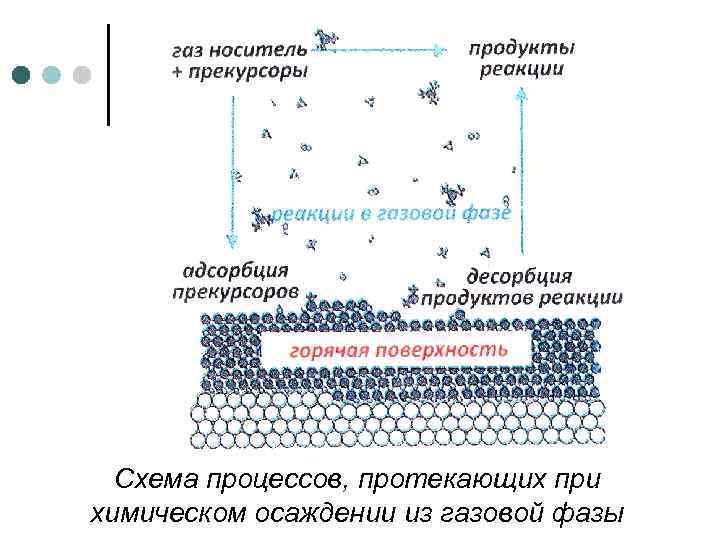
Схема процессов, протекающих при химическом осаждении из газовой фазы
![Контроль роста ¢ jк = const 1 N exp [- Ea / (k. BT)], Контроль роста ¢ jк = const 1 N exp [- Ea / (k. BT)],](https://present5.com/presentation/78453395_132955933/image-32.jpg)
Контроль роста ¢ jк = const 1 N exp [- Ea / (k. BT)], где jк - скорость роста пленки в кинетическом режиме, N – концентрация прекурсора над подложкой, Ea - энергия активации. Скорость роста пленки в кинетическом режиме ¢ jм = const 2 N √D/T. Скорость массопереноса ¢ 1/ jр = 1/ jк + 1/ jм Скорость роста

Диффузионный режим. Лимитирующей стадией является массоперенос, тогда как скорость осаждения достаточно высока. Кинетический режим. Лимитирующей стадией является рост пленки. Скорость осаждения слабо зависит от плотности потока. Режимы роста пленки: А – кинетический режим; Б – диффузионный режим; В - результирующая кривая

Химическое осаждение из растворов Основная сложность в формировании пленок заданного состава состоит в выборе состава и соотношения химических реагентов в маточном растворе. Следует учитывать кинетику реакций, эффекты адгезии и смачивания подложки, что приводит к необходимости введения дополнительных компонентов - стабилизирующих агентов или ПАВ.

Методы нанесения покрытий из растворов 1. Нанесение на вращающуюся подложку (spin-coating), при котором распределение раствора по поверхности происходит за счет центробежной силы (широко применяется для нанесения пленок на гладкие подложки); Толщина пленок зависит от: ¢ вязкости и концентрации раствора, ¢ скорости испарения растворителя, ¢ скорости вращения, ¢ Продолжительности вращения.
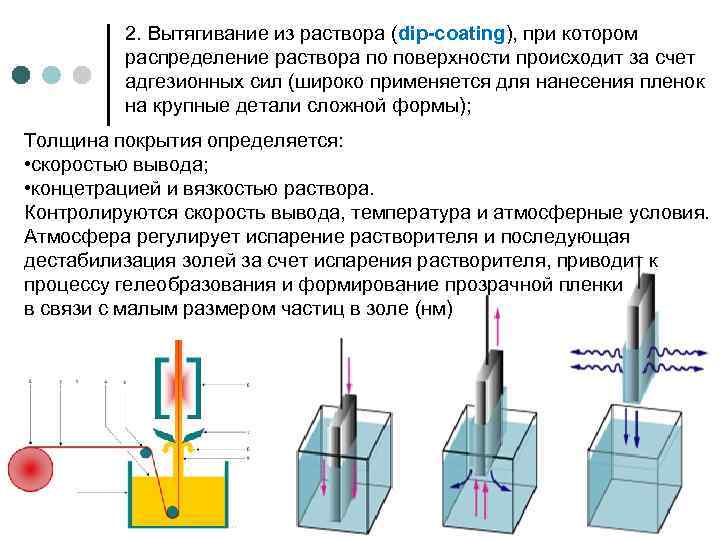
2. Вытягивание из раствора (dip-coating), при котором распределение раствора по поверхности происходит за счет адгезионных сил (широко применяется для нанесения пленок на крупные детали сложной формы); Толщина покрытия определяется: • скоростью вывода; • концетрацией и вязкостью раствора. Контролируются скорость вывода, температура и атмосферные условия. Атмосфера регулирует испарение растворителя и последующая дестабилизация золей за счет испарения растворителя, приводит к процессу гелеобразования и формирование прозрачной пленки в связи с малым размером частиц в золе (нм)
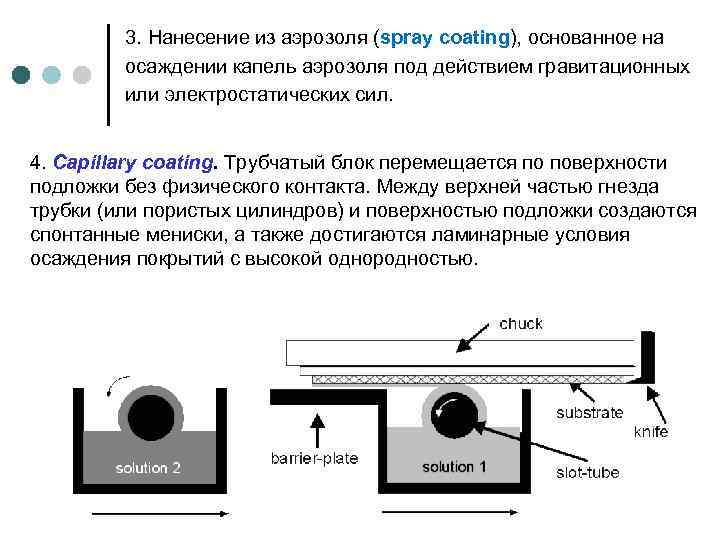
3. Нанесение из аэрозоля (spray coating), основанное на осаждении капель аэрозоля под действием гравитационных или электростатических сил. 4. Capillary coating. Трубчатый блок перемещается по поверхности подложки без физического контакта. Между верхней частью гнезда трубки (или пористых цилиндров) и поверхностью подложки создаются спонтанные мениски, а также достигаются ламинарные условия осаждения покрытий с высокой однородностью.
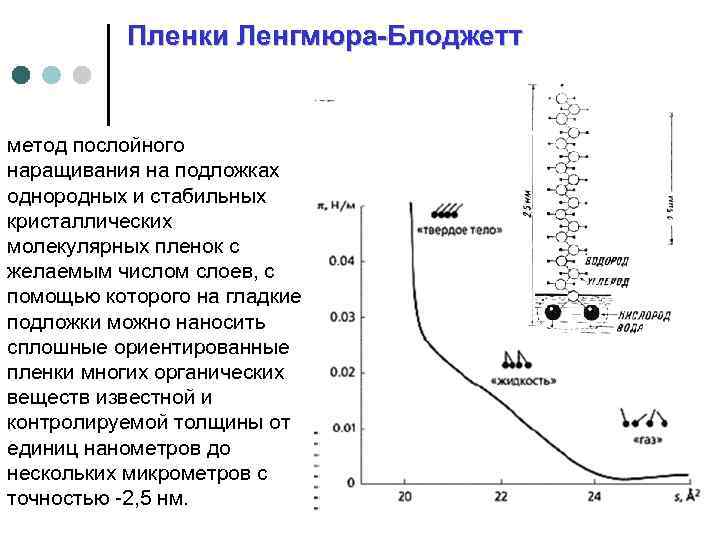
Пленки Ленгмюра-Блоджетт метод послойного наращивания на подложках однородных и стабильных кристаллических молекулярных пленок с желаемым числом слоев, с помощью которого на гладкие подложки можно наносить сплошные ориентированные пленки многих органических веществ известной и контролируемой толщины от единиц нанометров до нескольких микрометров с точностью -2, 5 нм.

Схема нанесения слоев Перенос монослоя на твердую подложку вертикальным и горизонтальным лифтом

Схема нанесения многослойной пленки: 1 – распределение пленки силами поверхностного натяжения; а, б, в – нанесение первого, второго, третьего слоя

Возможные типы пленок Ленгмюра-Блоджетт

На процесс нанесения пленок влияет присутствие примесей. Поэтому все применяемые химические вещества должны быть наивысшей чистоты, а вода должна иметь высокое электрическое сопротивление. Указанные значения удельных концентраций и р. Н должны строго выдерживаться. Характер нанесения монослоев на твердую поверхность зависит от контактного угла между твердым телом и поверхностью воды, покрытой пленкой. Для облегчения процесса переноса монослой должен находиться при постоянном поверхностном давлении. Идеальность формируемой структуры зависит от степени гидрофобности и структуры подложки. Отклонения от идеальной структуры слоев выражают параметром Φ: Ф = θ↑ / θ↓ где θ↑ и θ↓- доля осажденных молекул при вытягивании и погружении подложки соответственно. Для идеальных пленок типа «голова к голове» или «хвост к хвосту» Ф = 1, а для пленок типа «голова к хвосту» Ф < < 1 или Ф > > 1, в зависимости от ориентации пленки и гидрофильности подложки.
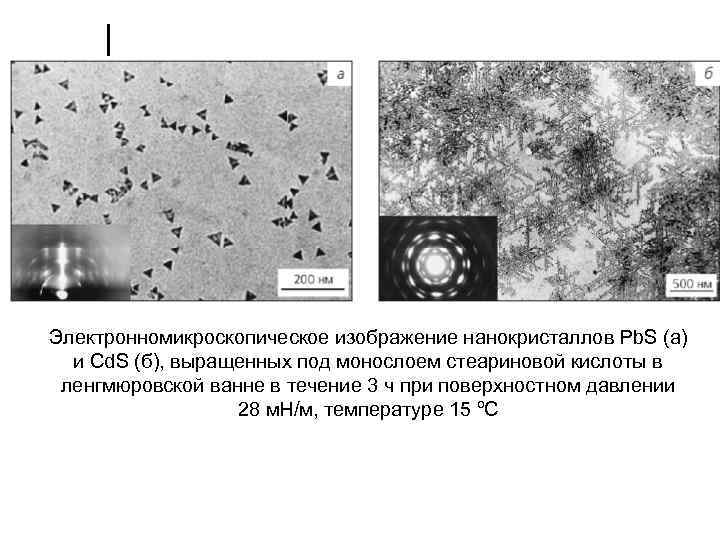
Электронномикроскопическое изображение нанокристаллов Рb. S (a) и Cd. S (б), выращенных под монослоем стеариновой кислоты в ленгмюровской ванне в течение 3 ч при поверхностном давлении 28 м. Н/м, температуре 15 ºС

Получение упорядоченных пленок (гетероструктур) Полупроводниковые сверхструктуры или сверхрешетки – периодические пленочные системы с толщинами слоев от 1 до 100 нм, синтезируемые на поверхности монокристаллической матрицы. Состоят из чередующихся слоев двух полупроводников, различающихся или составом, или типом проводимости. Используют два типа сверхрешеток: композиционные и легированные. Легированные сверхрешетки – периодичность параметров создается введением небольшого количества примеси в узкие строго ограниченные части кристаллической структуры.

Сверхрешетки nipi на основе As. Ga имеют непрямую в реальном пространстве запрещенную зону с электронами и дырками, разнесенными на половину периода сверхрешетки. Эффективная ширина запрещенной зоны и концентрация носителей не являются фиксированными, а зависят от толщины слоев, составляющих решетку, концентрации легирующей примеси и могут быть управляемы извне внешним напряжением или оптическим возбуждением.
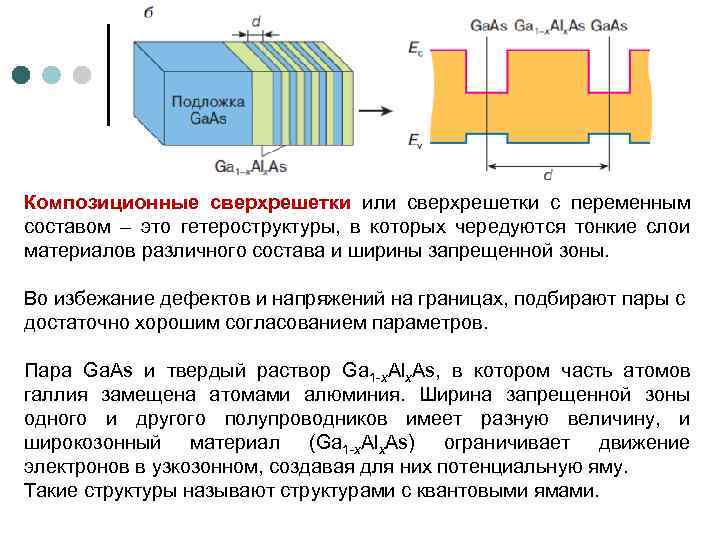
Композиционные сверхрешетки или сверхрешетки с переменным составом – это гетероструктуры, в которых чередуются тонкие слои материалов различного состава и ширины запрещенной зоны. Во избежание дефектов и напряжений на границах, подбирают пары с достаточно хорошим согласованием параметров. Пара Ga. As и твердый раствор Ga 1 -x. Alx. As, в котором часть атомов галлия замещена атомами алюминия. Ширина запрещенной зоны одного и другого полупроводников имеет разную величину, и широкозонный материал (Ga 1 -x. Alx. As) ограничивает движение электронов в узкозонном, создавая для них потенциальную яму. Такие структуры называют структурами с квантовыми ямами.

Молекулярно-лучевая эпитаксия (molecular -beam epitaxy, MBE) пучки атомов, являющихся компонентами растущего соединения, направляются в сверхвысоком вакууме на нагретую подложку, где и происходит синтез соединения и рост эпитаксиального слоя. Установки для выращивания гетероэпитаксиальных слоев соединений кадмий-ртуть-теллур методом МЛЭ Обь-М.
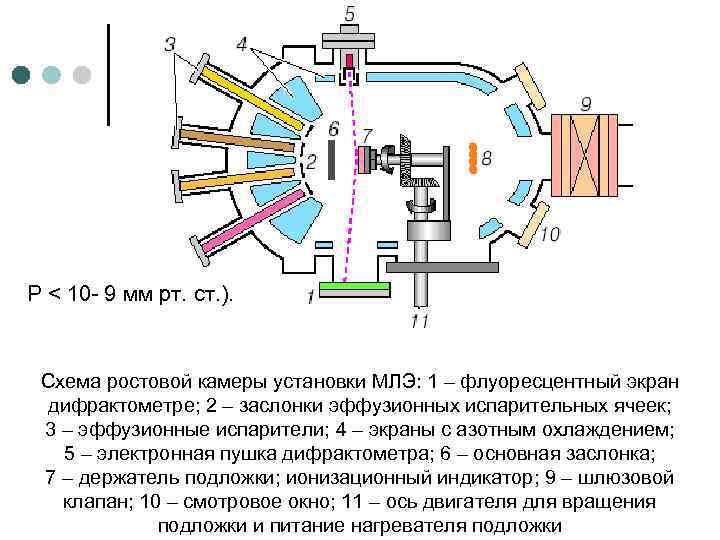
Р < 10 - 9 мм рт. ст. ). Схема ростовой камеры установки МЛЭ: 1 – флуоресцентный экран дифрактометре; 2 – заслонки эффузионных испарительных ячеек; 3 – эффузионные испарители; 4 – экраны с азотным охлаждением; 5 – электронная пушка дифрактометра; 6 – основная заслонка; 7 – держатель подложки; ионизационный индикатор; 9 – шлюзовой клапан; 10 – смотровое окно; 11 – ось двигателя для вращения подложки и питание нагревателя подложки

Источники пучков атомов – испарительные ячейки (эффузионные ячейки Кнудсена), в каждой из которых содержится один из элементов (входящих в соединение), из которых выращивается слой. Эффузия – медленное истечение газа через малое отверстие. выполняются из тугоплавкого материала, например нитрида бора. Достоинство - постоянство скорости истечения из нее пара испаряемого вещества во время процесса напыления. Температура каждой испарительной ячейки выбирается так, чтобы обеспечить выход из нее молекулярного пучка нужной интенсивности, т. к. она определяет концентрации элементов в растущем слое.

Для образования атомно резких границ между соседними слоями с разным составом важно, чтобы скорость роста слоя равнялась нескольким ангстрем в секунду. Рост слоев при МЛЭ определяется в основном кинетикой взаимодействия I - зона генерации молекулярных пучков с поверхностью эффузионными ячейками с кристалла в отличие от других механическими заслонками; методов. II – зона смешивания пучков элементов, испаряемых из разных эффузионных ячеек; III – зона кристааллизации на подложке

Процессы на растущей поверхности 1. адсорбция; 2. миграция (поверхностная диффузия); 3. встраивание атомов; 4. термическая десорбция атомов; 5. образование и дальнейший рост двумерных зародышей кристалла на подложке; 6. взаимная диффузия атомов.

Основные контролируемые параметры: 1. Тип поверхности; 2. Температура подложки; 3. Плотность потока падающих частиц. Температура подложки определяет соотношение между потоками адсорбции и десорбции атомов, а также скорость поверхностной диффузии перед встраиванием атомов в решетку. С ростом температуры увеличивается скорость десорбции и уменьшается доля атомов ростового вещества, попадающего в растущий слой (коэффициент прилипания). Регулировка плотности потока осаждаемого материала осуществляется выбором температуры источника испаряемого элемента, а также температурой подложки. Чем выше скорость осаждения, тем чище растущий слой. Однако при высоких скоростях осаждения адсорбированные атомы не успевают преодолеть необходимый диффузионный путь и «встроиться» в кристаллическую решетку растущего слоя, что приводит к образованию мелкозернистых агрегатов.

Молекулярно-лучевая эпитаксия обеспечивает: 1) получение монокристаллических слоев высокой чистоты; 2) выращивание многослойных структур с резкими изменениями состава на границах слоев 3) получение гладких бездефектных поверхностей при гетероэпитаксии; 4) получение сверхтонких слоев с контролируемой толщиной за счет точности управления потоками и относительно малых скоростей роста; 5) создание структур со сложными профилями состава и (или) легирования. 6) обеспечивается и легко воспроизводится предельно высокое качество слоев с заданным химическим составом, в том числе исключительное совершенство структуры и однородность толщины эпитаксиального слоя. 7) позволяет использовать при выращивании различные способы маскирования, выращивать эпитаксиальные слои элементарных полупроводников, полупроводниковых соединений, металлов и диэлектриков.
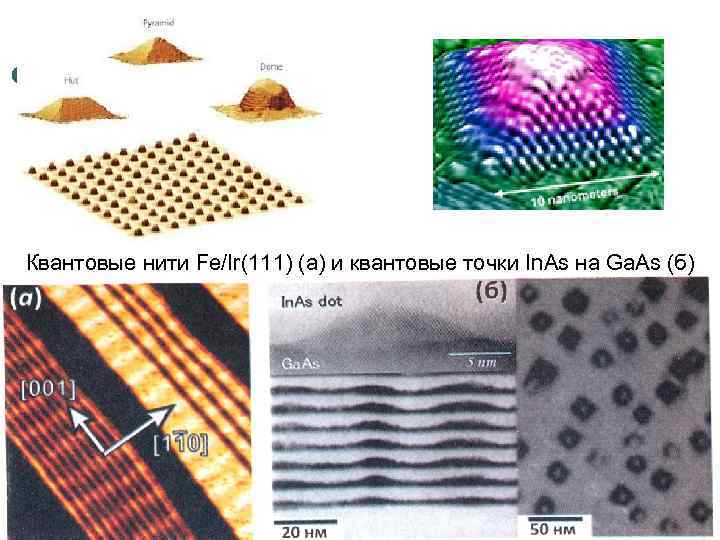
Квантовые нити Fe/Ir(111) (a) и квантовые точки In. As на Ga. As (б)

метод газофазной эпитаксии из металлоорганических соединений (ГФЭ МОС) (metalorganic vapor phase epitaxy, MOVPE) исходные газообразные реагенты пиролитически (под действием высокой температуры) разлагаются у поверхности подложки, выделяя Схема горизонтального реактора открытого типа с пленкообразующие охлаждаемыми стенками для ГФЭ МОС: компоненты, причем 1 – кварцевый корпус; 2 – катушка ВЧ-генератора подложка является для нагревания подложки; 3 – блок нагревания, 4 – подложки; 5, 6 - водяное охлаждение. более нагретым Схематически показано распределение скоростей и телом, чем температуры в газовом потоке в диффузионном окружающая среда. слое вблизи подожки

Главные параметры: химический состав, давление газа и температура подложки Реакции, протекающие у поверхности при получении тонких слоев полупроводников АIIIBV Разновидность – ГФЭ МОС с пониженным давлением в реакторе. Это позволяет эффективно управлять как градиентом концентрации примесей, так и градиентом изменения состава основных компонентов. Друга особенность - процесс выращивания ведется при значительно больших скоростях газового потока. Это позволяет получать более однородные слои.

Химическая сборка поверхностных наноструктур Метод химической сборки (ХС) и его разновидности - метод молекулярного наслаивания (МН) и атомно-слоевая эпитаксия (АСЭ) - основаны на образовании поверхностных химических соединений при хемосорбции компонентов из газовой фазы и являются новыми так называемыми циклично-дискретными процессами. Благодаря возможности реализовать практически монослойную хемосорбцию компонентов формирование кристаллических структур происходит по слоевому механизму, то есть без образования трехмерных зародышей. Это позволяет получать сплошные пленки при толщинах в несколько монослоев вещества (менее 1 нм). Используют этот метод в основном для синтеза наноструктур бинарных соединений.

1. Синтез основывается на протекании необратимых в условиях эксперимента химических реакций между функциональными группами на поверхности твердого тела и молекулами подводимого извне реагента. При этом используемые реагенты и продукты реакции не должны вступать в химические взаимодействия между собой. 2. Для постепенного наращивания слоя нового вещества необходимо проводить многократную и попеременную (в заданной последовательности) обработку последнего парами соответствующих соединений. При этом каждый вновь образующийся монослой новых функциональных групп должен содержать активные атомы или группы атомов, способные реагировать с новой порцией того же или иного реагента. 3. Для осуществления реакций в процессе МН необходимо некоторое структурное соответствие между поверхностью исходной твердофазной матрицы и данным соединением. Главное – это наличие на поверхности как исходной, так и образующейся в ходе синтеза достаточного количества функциональных групп и с таким взаимным расположение, которое обусловливает возможность возникновения поперечных связей между присоединившимися атомами для образования трехмерной решетки синтезируемого твердого вещества.
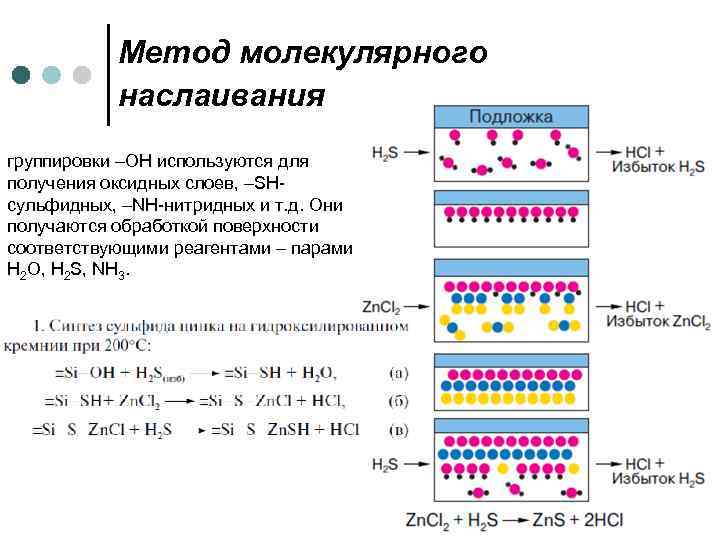
Метод молекулярного наслаивания группировки –ОН используются для получения оксидных слоев, –SHсульфидных, –NH-нитридных и т. д. Они получаются обработкой поверхности соответствующими реагентами – парами H 2 O, H 2 S, NH 3.
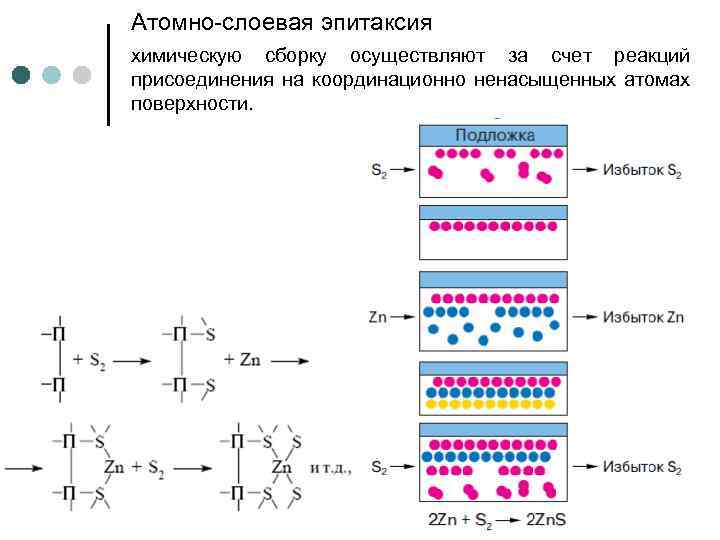
Атомно-слоевая эпитаксия химическую сборку осуществляют за счет реакций присоединения на координационно ненасыщенных атомах поверхности.
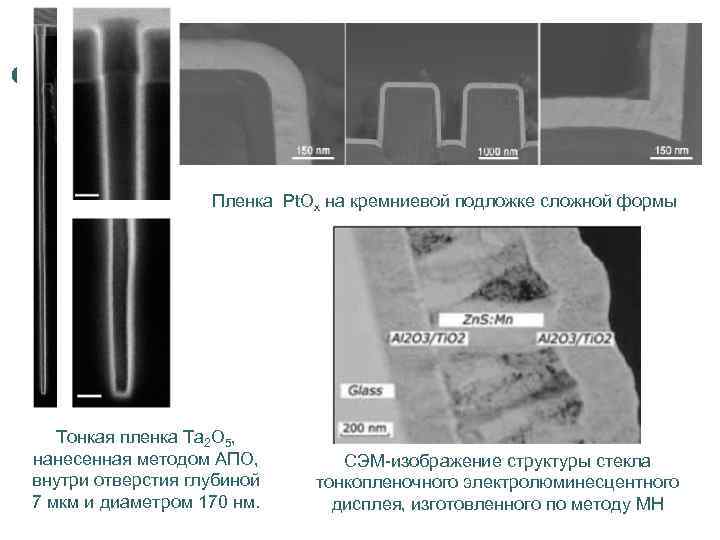
Пленка Pt. Ox на кремниевой подложке сложной формы Тонкая пленка Ta 2 O 5, нанесенная методом АПО, внутри отверстия глубиной 7 мкм и диаметром 170 нм. СЭМ-изображение структуры стекла тонкопленочного электролюминесцентного дисплея, изготовленного по методу МН

Уникальность методов химической сборки состоит в том, что можно выращивать моноатомные слои, а также различные комбинации слоев разных материалов. При этом растут плотные покрытия, не имеющие микроотверстий, обладающие высокой однородностью по толщине даже при формировании покрытия внутри пор, канавок, полостей, что невозможно достигнуть другими распространенными технологическими методами.
ТЕХНОЛОГИИ ТОНКИХ ПЛЕНОК И ПОКРЫТИЙ.ppt