тема 6-ОФ-14.ppt
- Количество слайдов: 38
 ТЕМА 6 Контактные и поверхностные явления 6. 1. Металл-полупроводник 6. 2. p-n переход 6. 3. Гетеропереход 6. 4. Поверхностные состояния СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
ТЕМА 6 Контактные и поверхностные явления 6. 1. Металл-полупроводник 6. 2. p-n переход 6. 3. Гетеропереход 6. 4. Поверхностные состояния СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
 6. 1 Работа выхода E 0 Термодинамическая работа выхода EF Внешняя (истинная) работа выхода Эмиссии электронов из металла препятствует потенциальный барьер. Снижение этого барьера по мере увеличения прилагаемого внешнего электрического поля называется эффектом Шоттки. а — Одномерный модельный потенциал полубесконечной решетки. Два типа волновых функций в полубесконечном кристалле: б — объемные состояния; в — поверхностные состояния. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
6. 1 Работа выхода E 0 Термодинамическая работа выхода EF Внешняя (истинная) работа выхода Эмиссии электронов из металла препятствует потенциальный барьер. Снижение этого барьера по мере увеличения прилагаемого внешнего электрического поля называется эффектом Шоттки. а — Одномерный модельный потенциал полубесконечной решетки. Два типа волновых функций в полубесконечном кристалле: б — объемные состояния; в — поверхностные состояния. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
 6. 1 Контактная разность потенциалов Если два различных металла привести в соприкосновение, то между ними возникает разность потенциалов, называемая контактной разностью потенциалов. Итальянский физик А. Вольта установил, что если металлы Ме: Аl, Zn, Sn, Pb, Sb, Bi, Hg, Fe, Cu, Ag, Au, Pt, Pd привести в контакт в указанной последовательности, то каждый предыдущий при соприкосновении с одним из следующих зарядится положительно. Этот ряд называется рядом Вольта. Алессандро Вольта (1745 -1827) Контактная разность потенциалов для различных металлов составляет от десятых до целых вольт. Вольта экспериментально установил два закона: 1. Контактная разность потенциалов зависит лишь от химического состава и температуры соприкасающихся металлов. 2. Контактная разность потенциалов последовательно соединенных различных проводников, находящихся при одинаковой температуре, не зависит от химического состава промежуточных проводников и равна контактной разности потенциалов, возникающей при непосредственном соединении крайних проводников вакуум E 0 Ф 1 Вольтов столб - «элемент Вольта» — первый гальванический элемент СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 Ф 2 Ме 1 Ме 2 φ- контактная разность потенциалов
6. 1 Контактная разность потенциалов Если два различных металла привести в соприкосновение, то между ними возникает разность потенциалов, называемая контактной разностью потенциалов. Итальянский физик А. Вольта установил, что если металлы Ме: Аl, Zn, Sn, Pb, Sb, Bi, Hg, Fe, Cu, Ag, Au, Pt, Pd привести в контакт в указанной последовательности, то каждый предыдущий при соприкосновении с одним из следующих зарядится положительно. Этот ряд называется рядом Вольта. Алессандро Вольта (1745 -1827) Контактная разность потенциалов для различных металлов составляет от десятых до целых вольт. Вольта экспериментально установил два закона: 1. Контактная разность потенциалов зависит лишь от химического состава и температуры соприкасающихся металлов. 2. Контактная разность потенциалов последовательно соединенных различных проводников, находящихся при одинаковой температуре, не зависит от химического состава промежуточных проводников и равна контактной разности потенциалов, возникающей при непосредственном соединении крайних проводников вакуум E 0 Ф 1 Вольтов столб - «элемент Вольта» — первый гальванический элемент СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 Ф 2 Ме 1 Ме 2 φ- контактная разность потенциалов
 6. 1 Работа выхода — разница между максимальной энергией (обычно измеряемой в электрон-вольтах), которую необходимо сообщить электрону для его «непосредственного» удаления из объёма твёрдого тела, и энергией Ферми. Элемент э. В Элемент Ag: 4. 52 – 4. 74 Al: Ba: 2. 52 – 2. 7 Cd: э. В Элемент э. В As: 3. 75 Au: Be: 4. 98 Bi: 4. 31 C: ~5 Ca: 2. 87 4. 08 Ce: 2. 9 Co: 5 Cr: 4. 5 Cs: 2. 14 Cu: 4. 53 – 5. 10 Eu: 2. 5 Fe: 4. 67 – 4. 81 Ga: 4. 32 Gd: 2. 90 Hf: 3. 9 Hg: 4. 475 In: 4. 09 Ir: K: 2. 29 La: 3. 5 Li: 2. 93 Lu: ~3. 3 Mg: 3. 66 Mn: Mo: 4. 36 – 4. 95 Na: 2. 36 Nb: 3. 95 – 4. 87 Nd: 3. 2 Ni: Os: 5. 93 Pb: 4. 25 Pd: 5. 22 – 5. 6 Pt: 5. 12 – 5. 93 Rb: 2. 261 Re: 4. 72 Rh: 4. 98 Ru: 4. 71 Sb: 4. 55 – 4. 7 Sc: 3. 5 Se: 5. 9 Si: 4. 60 – 4. 85 Sm: 2. 7 Sn: 4. 42 Sr: ~2. 59 Ta: 4. 00 – 4. 80 Tb: 3. 00 Te: 4. 95 Th: 3. 4 Ti: 4. 33 W: 4. 32 – 5. 22 Y: 3. 1 ~3. 84 U: 3. 63 – 3. 90 V: 4. 3 Yb: 2. 60 [1] Zn: 3. 63 – 4. 9 Zr: 5. 00 – 5. 67 B: э. В 4. 06 – 4. 26 Tl: 5. 1 – 5. 47 Элемент ~4. 45 4. 1 5. 04 – 5. 35 4. 05 Источник: CRC Handbook of Chemistry and Physics version 2008, стр. 12 -114. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
6. 1 Работа выхода — разница между максимальной энергией (обычно измеряемой в электрон-вольтах), которую необходимо сообщить электрону для его «непосредственного» удаления из объёма твёрдого тела, и энергией Ферми. Элемент э. В Элемент Ag: 4. 52 – 4. 74 Al: Ba: 2. 52 – 2. 7 Cd: э. В Элемент э. В As: 3. 75 Au: Be: 4. 98 Bi: 4. 31 C: ~5 Ca: 2. 87 4. 08 Ce: 2. 9 Co: 5 Cr: 4. 5 Cs: 2. 14 Cu: 4. 53 – 5. 10 Eu: 2. 5 Fe: 4. 67 – 4. 81 Ga: 4. 32 Gd: 2. 90 Hf: 3. 9 Hg: 4. 475 In: 4. 09 Ir: K: 2. 29 La: 3. 5 Li: 2. 93 Lu: ~3. 3 Mg: 3. 66 Mn: Mo: 4. 36 – 4. 95 Na: 2. 36 Nb: 3. 95 – 4. 87 Nd: 3. 2 Ni: Os: 5. 93 Pb: 4. 25 Pd: 5. 22 – 5. 6 Pt: 5. 12 – 5. 93 Rb: 2. 261 Re: 4. 72 Rh: 4. 98 Ru: 4. 71 Sb: 4. 55 – 4. 7 Sc: 3. 5 Se: 5. 9 Si: 4. 60 – 4. 85 Sm: 2. 7 Sn: 4. 42 Sr: ~2. 59 Ta: 4. 00 – 4. 80 Tb: 3. 00 Te: 4. 95 Th: 3. 4 Ti: 4. 33 W: 4. 32 – 5. 22 Y: 3. 1 ~3. 84 U: 3. 63 – 3. 90 V: 4. 3 Yb: 2. 60 [1] Zn: 3. 63 – 4. 9 Zr: 5. 00 – 5. 67 B: э. В 4. 06 – 4. 26 Tl: 5. 1 – 5. 47 Элемент ~4. 45 4. 1 5. 04 – 5. 35 4. 05 Источник: CRC Handbook of Chemistry and Physics version 2008, стр. 12 -114. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
 6. 1 Эмиссия электронов Термоэлектро нная эми ссия (эффект Ричардсона) — явление испускания электронов нагретыми телами. где: Φ - работа выхода, А- константа Ричардсона, 1928 г. ток автоэлектронной эмиссии из металла в вакуум Оуэн Уилланс Ричардсон (1879 - 1959) , Нобелевской премии по физике в 1928 г. «за работы по термионным исследованиям» СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
6. 1 Эмиссия электронов Термоэлектро нная эми ссия (эффект Ричардсона) — явление испускания электронов нагретыми телами. где: Φ - работа выхода, А- константа Ричардсона, 1928 г. ток автоэлектронной эмиссии из металла в вакуум Оуэн Уилланс Ричардсон (1879 - 1959) , Нобелевской премии по физике в 1928 г. «за работы по термионным исследованиям» СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
 6. 1 Зонная диаграмма полупроводников: а) n‑типа; б) p‑типа Примеч. - F=EF СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
6. 1 Зонная диаграмма полупроводников: а) n‑типа; б) p‑типа Примеч. - F=EF СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
 6. 1 Зонная диаграмма контакта металл-полупроводник (n‑типа) СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
6. 1 Зонная диаграмма контакта металл-полупроводник (n‑типа) СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
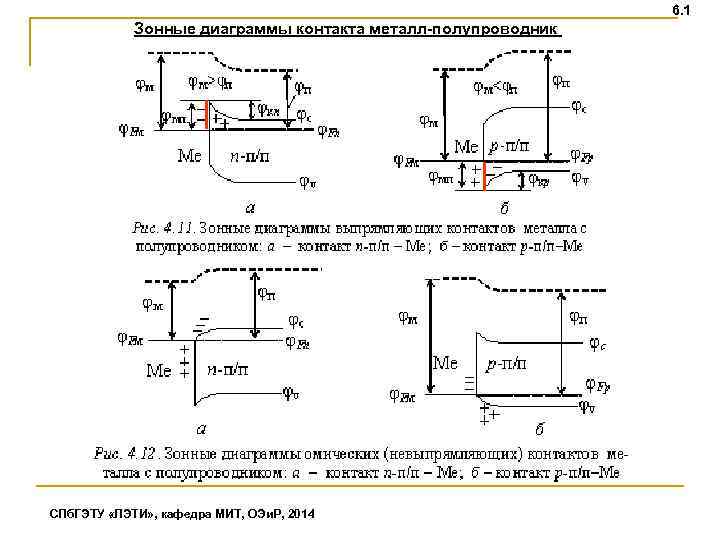 6. 1 Зонные диаграммы контакта металл-полупроводник СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
6. 1 Зонные диаграммы контакта металл-полупроводник СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
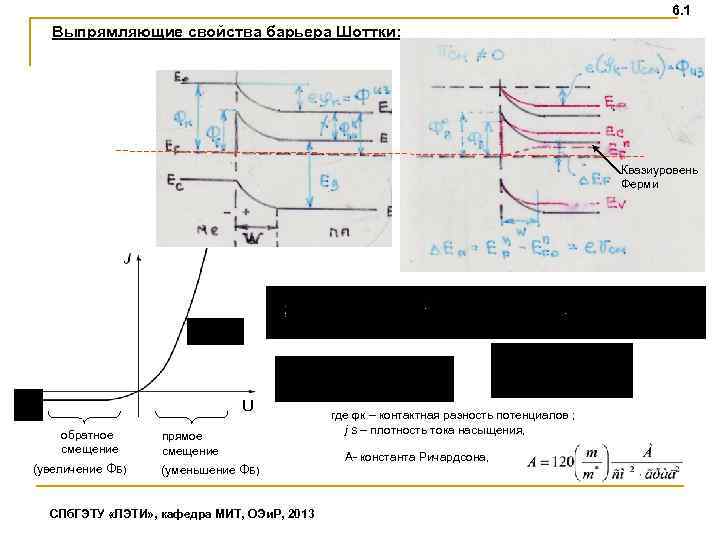 6. 1 Выпрямляющие свойства барьера Шоттки: Квазиуровень Ферми U обратное смещение (увеличение ФБ) прямое смещение (уменьшение ФБ) СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013 где φк – контактная разность потенциалов ; j S – плотность тока насыщения, А- константа Ричардсона,
6. 1 Выпрямляющие свойства барьера Шоттки: Квазиуровень Ферми U обратное смещение (увеличение ФБ) прямое смещение (уменьшение ФБ) СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013 где φк – контактная разность потенциалов ; j S – плотность тока насыщения, А- константа Ричардсона,
 6. 1 Вальтер Герман Шоттки • Немецкий физик. • Родился в городе Цюрихе (Швейцария), учился в Берлинском университете, где в 1912 году получил степень доктора философии. • В 1913 - 1914 гг. открыл явление возрастания тока насыщения под действием • внешнего ускоряющего электрического поля (эффект Шоттки) и разработал теорию этого эффекта. • В 1915 году изобрел электронную лампу с экранной сеткой. • В 1916 - 1919 гг. работал в лаборатории "Сименс и Гальске", • в 1918 году предложил супергетеродинный принцип усиления. • В 1923 - 1930 гг. Шоттки читал лекции в Вюрцбургском университете, профессор Ростокского университета. С 1927 года он вновь работает в лаборатории "Сименс и Гальске". • В 1930 году рассмотрел пустые узлы кристаллической решетки, нескомпенсированные атомом в междоузлии ("дефекты Шоттки"). • В 1939 году Шоттки исследовал потенциальный барьер, возникающий в приконтактном слое полупроводник-металл, а затем разработал теорию полупроводниковых диодов с таким барьером (диоды Шоттки или диоды с барьером Шоттки). • Шотки предложил механизм проводимости в полупроводниках. • Внес большой вклад в изучение процессов, происходящих в электронных лампах и в полупроводниках. • Исследования Шоттки относятся к физике твердого тела, термодинамике, статистике, электронике, физике полупроводников. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013 Вальтер Герман Шоттки (1886— 1976)
6. 1 Вальтер Герман Шоттки • Немецкий физик. • Родился в городе Цюрихе (Швейцария), учился в Берлинском университете, где в 1912 году получил степень доктора философии. • В 1913 - 1914 гг. открыл явление возрастания тока насыщения под действием • внешнего ускоряющего электрического поля (эффект Шоттки) и разработал теорию этого эффекта. • В 1915 году изобрел электронную лампу с экранной сеткой. • В 1916 - 1919 гг. работал в лаборатории "Сименс и Гальске", • в 1918 году предложил супергетеродинный принцип усиления. • В 1923 - 1930 гг. Шоттки читал лекции в Вюрцбургском университете, профессор Ростокского университета. С 1927 года он вновь работает в лаборатории "Сименс и Гальске". • В 1930 году рассмотрел пустые узлы кристаллической решетки, нескомпенсированные атомом в междоузлии ("дефекты Шоттки"). • В 1939 году Шоттки исследовал потенциальный барьер, возникающий в приконтактном слое полупроводник-металл, а затем разработал теорию полупроводниковых диодов с таким барьером (диоды Шоттки или диоды с барьером Шоттки). • Шотки предложил механизм проводимости в полупроводниках. • Внес большой вклад в изучение процессов, происходящих в электронных лампах и в полупроводниках. • Исследования Шоттки относятся к физике твердого тела, термодинамике, статистике, электронике, физике полупроводников. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013 Вальтер Герман Шоттки (1886— 1976)
 6. 1 Вольт-амперная характеристика (ВАХ) барьера Шоттки: • Вольт‑амперная характеристика барьера Шоттки имеет ярко выраженный несимметричный вид. • В области прямых смещений ток экспоненциально сильно растёт с ростом приложенного напряжения. • В области обратных смещений ток от напряжения не зависит. • В обоих случаях, при прямом и обратном смещении, ток в барьере Шоттки обусловлен основными носителями – электронами. • По этой причине диоды на основе барьера Шоттки являются быстродействующими приборами, поскольку в них отсутствуют рекомбинационные и диффузионные процессы. • Несимметричность вольт-амперной характеристики барьера Шоттки – типичная для барьерных структур. • Зависимость тока от напряжения в таких структурах обусловлена изменением числа носителей, принимающих участие в процессах переноса заряда. • Роль внешнего напряжения заключается в изменении числа электронов, переходящих из одной части барьерной структуры в другую. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
6. 1 Вольт-амперная характеристика (ВАХ) барьера Шоттки: • Вольт‑амперная характеристика барьера Шоттки имеет ярко выраженный несимметричный вид. • В области прямых смещений ток экспоненциально сильно растёт с ростом приложенного напряжения. • В области обратных смещений ток от напряжения не зависит. • В обоих случаях, при прямом и обратном смещении, ток в барьере Шоттки обусловлен основными носителями – электронами. • По этой причине диоды на основе барьера Шоттки являются быстродействующими приборами, поскольку в них отсутствуют рекомбинационные и диффузионные процессы. • Несимметричность вольт-амперной характеристики барьера Шоттки – типичная для барьерных структур. • Зависимость тока от напряжения в таких структурах обусловлена изменением числа носителей, принимающих участие в процессах переноса заряда. • Роль внешнего напряжения заключается в изменении числа электронов, переходящих из одной части барьерной структуры в другую. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
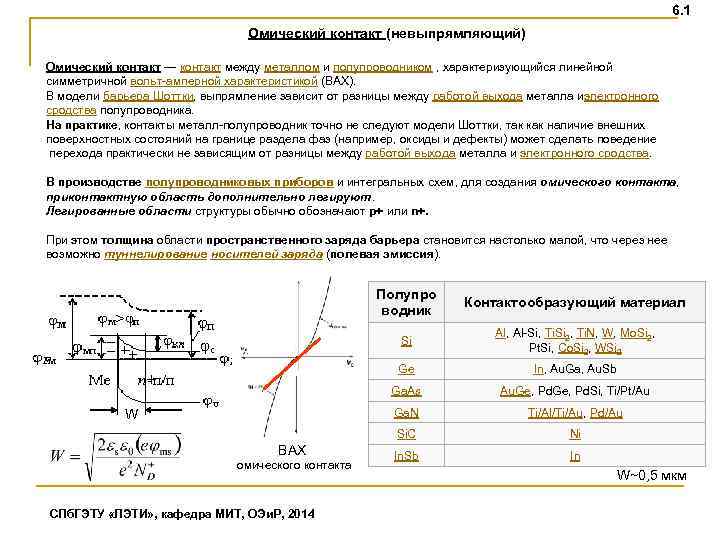 6. 1 Омический контакт (невыпрямляющий) Омический контакт — контакт между металлом и полупроводником , характеризующийся линейной симметричной вольт-амперной характеристикой (ВАХ). В модели барьера Шоттки, выпрямление зависит от разницы между работой выхода металла иэлектронного сродства полупроводника. На практике, контакты металл-полупроводник точно не следуют модели Шоттки, так как наличие внешних поверхностных состояний на границе раздела фаз (например, оксиды и дефекты) может сделать поведение перехода практически не зависящим от разницы между работой выхода металла и электронного сродства. В производстве полупроводниковых приборов и интегральных схем, для создания омического контакта, приконтактную область дополнительно легируют. Легированные области структуры обычно обозначают p+ или n+. При этом толщина области пространственного заряда барьера становится настолько малой, что через нее возможно туннелирование носителей заряда (полевая эмиссия). Полупро водник Si СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 Ti/Al/Ti/Au, Pd/Au Si. C омического контакта Au. Ge, Pd. Si, Ti/Pt/Au Ga. N ВАХ In, Au. Ga, Au. Sb Ga. As W Al, Al-Si, Ti. Si 2, Ti. N, W, Mo. Si 2, Pt. Si, Co. Si 2, WSi 2 Ge + Контактообразующий материал Ni In. Sb In W~0, 5 мкм
6. 1 Омический контакт (невыпрямляющий) Омический контакт — контакт между металлом и полупроводником , характеризующийся линейной симметричной вольт-амперной характеристикой (ВАХ). В модели барьера Шоттки, выпрямление зависит от разницы между работой выхода металла иэлектронного сродства полупроводника. На практике, контакты металл-полупроводник точно не следуют модели Шоттки, так как наличие внешних поверхностных состояний на границе раздела фаз (например, оксиды и дефекты) может сделать поведение перехода практически не зависящим от разницы между работой выхода металла и электронного сродства. В производстве полупроводниковых приборов и интегральных схем, для создания омического контакта, приконтактную область дополнительно легируют. Легированные области структуры обычно обозначают p+ или n+. При этом толщина области пространственного заряда барьера становится настолько малой, что через нее возможно туннелирование носителей заряда (полевая эмиссия). Полупро водник Si СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 Ti/Al/Ti/Au, Pd/Au Si. C омического контакта Au. Ge, Pd. Si, Ti/Pt/Au Ga. N ВАХ In, Au. Ga, Au. Sb Ga. As W Al, Al-Si, Ti. Si 2, Ti. N, W, Mo. Si 2, Pt. Si, Co. Si 2, WSi 2 Ge + Контактообразующий материал Ni In. Sb In W~0, 5 мкм
 6. 1 Энергия ионизации примесей Примеси Энергия ионизации, э. В Германи й Доноры Примеси Кремни й 0, 0120 0, 044 As 0, 0127 0, 049 Sb 0, 0096 0, 039 Bi 0, 069 Акцептор ы B 0, 0104 0, 045 Al 0, 0102 0, 057 Ga 0, 0108 0, 065 In 0, 0112 0, 16 Ga. As, In. Sb, In. P P Энергия ионизации, э. В Доноры Te 0, 003 Si 0, 002 Se 0, 005 Акцепторы Mg СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 0, 012 Cd 0, 021 Zn 0, 024 Co 0, 16 Ni 0, 21
6. 1 Энергия ионизации примесей Примеси Энергия ионизации, э. В Германи й Доноры Примеси Кремни й 0, 0120 0, 044 As 0, 0127 0, 049 Sb 0, 0096 0, 039 Bi 0, 069 Акцептор ы B 0, 0104 0, 045 Al 0, 0102 0, 057 Ga 0, 0108 0, 065 In 0, 0112 0, 16 Ga. As, In. Sb, In. P P Энергия ионизации, э. В Доноры Te 0, 003 Si 0, 002 Se 0, 005 Акцепторы Mg СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 0, 012 Cd 0, 021 Zn 0, 024 Co 0, 16 Ni 0, 21
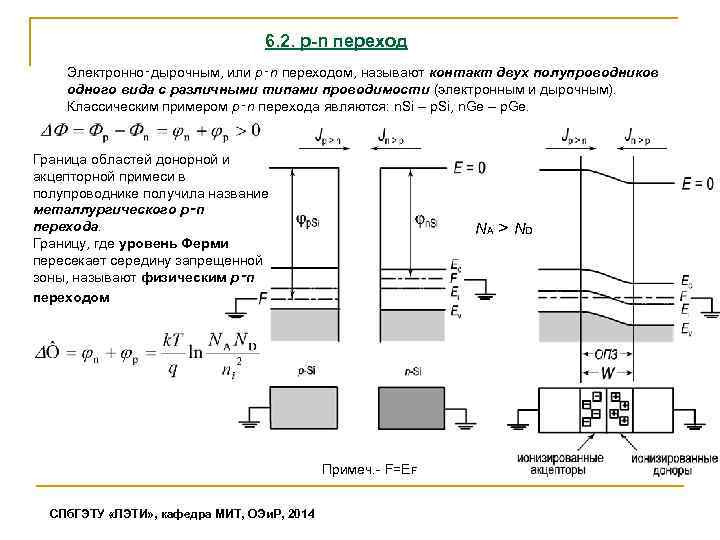 6. 2. p-n переход Электронно‑дырочным, или p‑n переходом, называют контакт двух полупроводников одного вида с различными типами проводимости (электронным и дырочным). Классическим примером p‑n перехода являются: n. Si – p. Si, n. Ge – p. Ge. Граница областей донорной и акцепторной примеси в полупроводнике получила название металлургического p‑n перехода. Границу, где уровень Ферми пересекает середину запрещенной зоны, называют физическим p‑n переходом NA > ND Примеч. - F=EF СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
6. 2. p-n переход Электронно‑дырочным, или p‑n переходом, называют контакт двух полупроводников одного вида с различными типами проводимости (электронным и дырочным). Классическим примером p‑n перехода являются: n. Si – p. Si, n. Ge – p. Ge. Граница областей донорной и акцепторной примеси в полупроводнике получила название металлургического p‑n перехода. Границу, где уровень Ферми пересекает середину запрещенной зоны, называют физическим p‑n переходом NA > ND Примеч. - F=EF СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
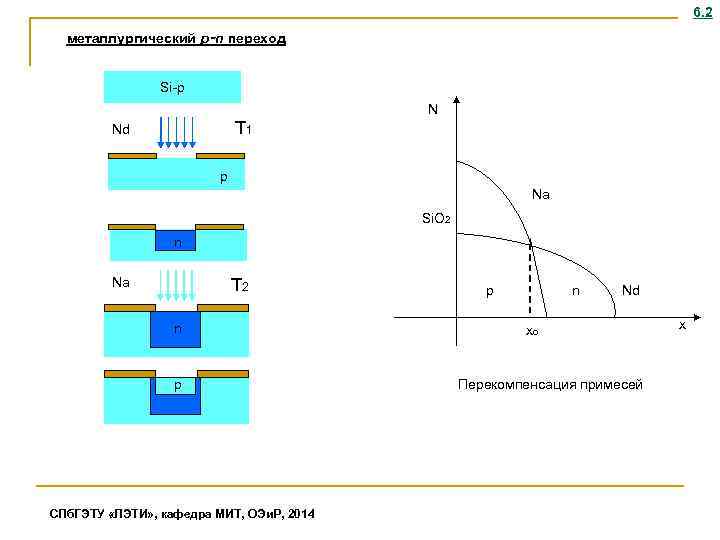 6. 2 металлургический p‑n переход Si-p N Т 1 Nd p Na Si. O 2 n Na Т 2 n p СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 p n Nd xo Перекомпенсация примесей x
6. 2 металлургический p‑n переход Si-p N Т 1 Nd p Na Si. O 2 n Na Т 2 n p СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 p n Nd xo Перекомпенсация примесей x
 6. 2 Распределение концентрации равновесных носителей заряда в p‑n переходе (1) NA > ND (2) (3) СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
6. 2 Распределение концентрации равновесных носителей заряда в p‑n переходе (1) NA > ND (2) (3) СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
 6. 2 Поле и потенциал в p‑n переходе Где (x) – зависимость потенциала от координаты, (x) – плотность объемного заряда, (II) (I) Будем решать уравнение Пуассона отдельно для областей I и II. (I) граничные условия На металлургической границе p‑n перехода при x = 0 значение потенциала I II СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 x < 0, (II) x > 0.
6. 2 Поле и потенциал в p‑n переходе Где (x) – зависимость потенциала от координаты, (x) – плотность объемного заряда, (II) (I) Будем решать уравнение Пуассона отдельно для областей I и II. (I) граничные условия На металлургической границе p‑n перехода при x = 0 значение потенциала I II СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 x < 0, (II) x > 0.
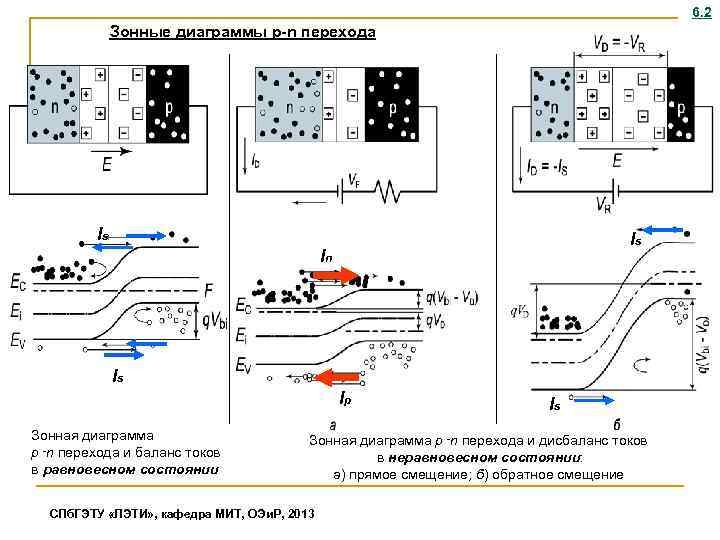 6. 2 Зонные диаграммы p-n перехода Is Is In Is Ip Зонная диаграмма p‑n перехода и баланс токов в равновесном состоянии Is Зонная диаграмма p‑n перехода и дисбаланс токов в неравновесном состоянии: а) прямое смещение; б) обратное смещение СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
6. 2 Зонные диаграммы p-n перехода Is Is In Is Ip Зонная диаграмма p‑n перехода и баланс токов в равновесном состоянии Is Зонная диаграмма p‑n перехода и дисбаланс токов в неравновесном состоянии: а) прямое смещение; б) обратное смещение СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
 6. 2 Расщепление квазиуровней Ферми в р‑n переходе √ D = L Токи в несимметричном p‑n nереходе при прямом смещении СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
6. 2 Расщепление квазиуровней Ферми в р‑n переходе √ D = L Токи в несимметричном p‑n nереходе при прямом смещении СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
 6. 2 Емкость p‑n перехода Барьерная емкость CB – это емкость p‑n перехода при обратном смещении VG < 0, обусловленная изменением заряда ионизованных доноров в области пространственного заряда Диффузионная емкость CD – это емкость p‑n перехода при прямом смещении VG > 0, обусловленная изменением заряда Qp инжектированных носителей в базу из эмиттера Qp. Зависимость барьерной емкости СB от приложенного обратного напряжения VG используется для приборной реализации. Полупроводниковый диод, реализующий эту зависимость, называется варикапом. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
6. 2 Емкость p‑n перехода Барьерная емкость CB – это емкость p‑n перехода при обратном смещении VG < 0, обусловленная изменением заряда ионизованных доноров в области пространственного заряда Диффузионная емкость CD – это емкость p‑n перехода при прямом смещении VG > 0, обусловленная изменением заряда Qp инжектированных носителей в базу из эмиттера Qp. Зависимость барьерной емкости СB от приложенного обратного напряжения VG используется для приборной реализации. Полупроводниковый диод, реализующий эту зависимость, называется варикапом. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
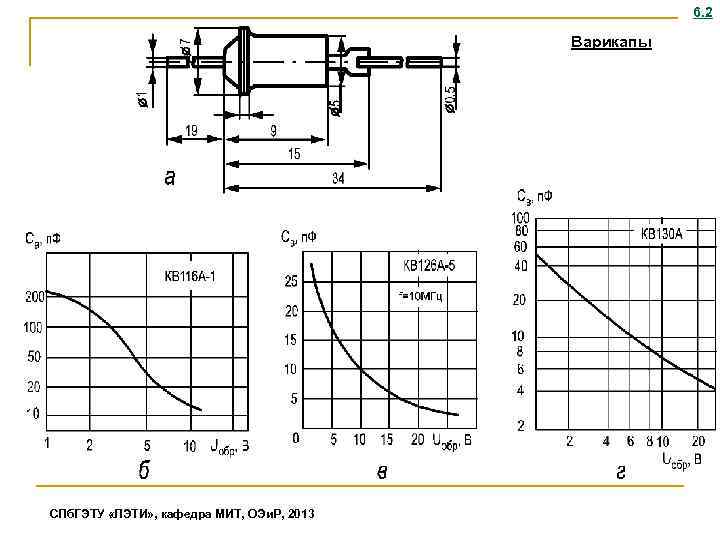 6. 2 Варикапы СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
6. 2 Варикапы СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
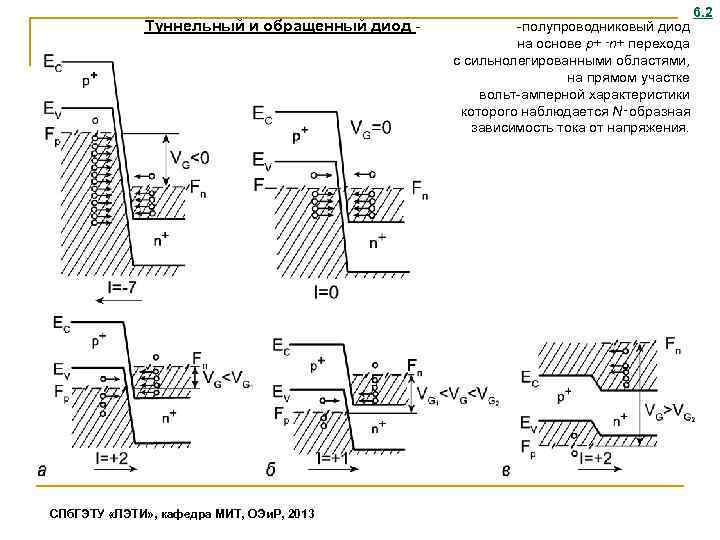 6. 2 Туннельный и обращенный диод - -полупроводниковый диод на основе p+‑n+ перехода с сильнолегированными областями, на прямом участке вольт-амперной характеристики которого наблюдается N‑образная зависимость тока от напряжения. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
6. 2 Туннельный и обращенный диод - -полупроводниковый диод на основе p+‑n+ перехода с сильнолегированными областями, на прямом участке вольт-амперной характеристики которого наблюдается N‑образная зависимость тока от напряжения. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
 6. 2 Туннельный и обращенный диоды СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
6. 2 Туннельный и обращенный диоды СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
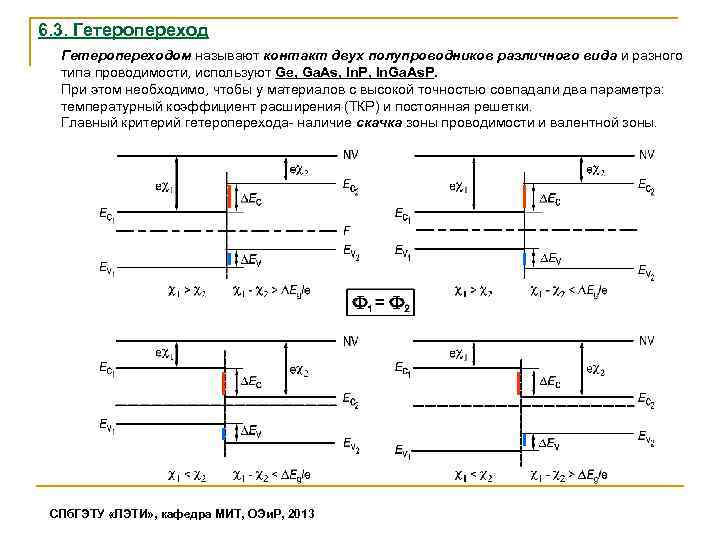 6. 3. Гетеропереходом называют контакт двух полупроводников различного вида и разного типа проводимости, используют Ge, Ga. As, In. P, In. Ga. As. P. При этом необходимо, чтобы у материалов с высокой точностью совпадали два параметра: температурный коэффициент расширения (ТКР) и постоянная решетки. Главный критерий гетероперехода- наличие скачка зоны проводимости и валентной зоны. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
6. 3. Гетеропереходом называют контакт двух полупроводников различного вида и разного типа проводимости, используют Ge, Ga. As, In. P, In. Ga. As. P. При этом необходимо, чтобы у материалов с высокой точностью совпадали два параметра: температурный коэффициент расширения (ТКР) и постоянная решетки. Главный критерий гетероперехода- наличие скачка зоны проводимости и валентной зоны. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
 6. 3. Гетеропереход E 0 Зонная диаграмма гетероперехода p. Ge – n. Ga. As в равновесных условиях Зонная диаграмма гетероперехода n. Ge – p. Ga. As в равновесных условиях
6. 3. Гетеропереход E 0 Зонная диаграмма гетероперехода p. Ge – n. Ga. As в равновесных условиях Зонная диаграмма гетероперехода n. Ge – p. Ga. As в равновесных условиях
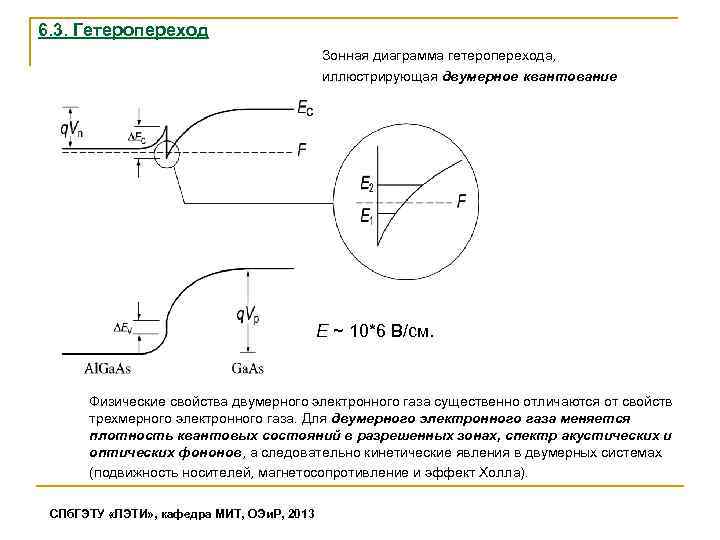 6. 3. Гетеропереход Зонная диаграмма гетероперехода, иллюстрирующая двумерное квантование E ~ 10*6 В/см. Физические свойства двумерного электронного газа существенно отличаются от свойств трехмерного электронного газа. Для двумерного электронного газа меняется плотность квантовых состояний в разрешенных зонах, спектр акустических и оптических фононов, а следовательно кинетические явления в двумерных системах (подвижность носителей, магнетосопротивление и эффект Холла). СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
6. 3. Гетеропереход Зонная диаграмма гетероперехода, иллюстрирующая двумерное квантование E ~ 10*6 В/см. Физические свойства двумерного электронного газа существенно отличаются от свойств трехмерного электронного газа. Для двумерного электронного газа меняется плотность квантовых состояний в разрешенных зонах, спектр акустических и оптических фононов, а следовательно кинетические явления в двумерных системах (подвижность носителей, магнетосопротивление и эффект Холла). СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
 6. 4. Поверхностные состояния Природа поверхностных состояний (ПС) По физической природе поверхностные состояния разделяются на четыре основных типа: • поверхностные состояния типа Тамма (1932 г), обусловленные обрывом периодической решетки кристалла. • поверхностные состояния типа Шокли (1939 г); • поверхностные состояния, обусловленные дефектами кристаллической решетки на поверхности; • поверхностные состояния, обусловленные примесью на поверхности У. Б. Шокли И. Е. Тамм Шокли, рассчитывая энергетический спектр цепочки атомов конечных размеров, показал, что наличие границ приводит к отщеплению от разрешенных зон по одному объемному состоянию и возникновению состояний в запрещенной зоне, локализованных вблизи границы. Концентрация шоклиевских состояний, так же как и таммовских, по порядку равна концентрации поверхностных атомов, т. е. величине порядка 10*15 см-2. Шоклиевские ПС можно трактовать как ненасыщенные химические связи атомов, находящихся на поверхности полупроводника. Поверхностные состояния за счет дефектов кристаллической решетки на поверхности (вакансии, междоузлия, дислокации) имеют аналогичную с локальными уровнями природу за счет этих же дефектов в объеме. Локализованные состояния на поверхности могут быть обусловлены также примесью в кристаллической решетке вблизи поверхности, абсорбцией атомов и молекул на поверхности полупроводника. Различают моноэнергетические ПС, имеющие дискретный уровень, и ПС, квазинепрерывно распределенные по энергии в запрещенной зоне по определенному закону, образующие континиум ПС. По зарядовому состоянию ПС, бывают двух типов – донороподобные и акцептороподобные. • Состояния донорного типа положительно заряжены, если расположены выше уровня Ферми, и нейтральны, если расположены ниже уровня Ферми. • Состояния акцепторного типа нейтральны, если расположены выше уровня Ферми, и отрицательно заряжены, если расположены ниже уровня Ферми. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 ( “surface states – поверхностные состояния”)
6. 4. Поверхностные состояния Природа поверхностных состояний (ПС) По физической природе поверхностные состояния разделяются на четыре основных типа: • поверхностные состояния типа Тамма (1932 г), обусловленные обрывом периодической решетки кристалла. • поверхностные состояния типа Шокли (1939 г); • поверхностные состояния, обусловленные дефектами кристаллической решетки на поверхности; • поверхностные состояния, обусловленные примесью на поверхности У. Б. Шокли И. Е. Тамм Шокли, рассчитывая энергетический спектр цепочки атомов конечных размеров, показал, что наличие границ приводит к отщеплению от разрешенных зон по одному объемному состоянию и возникновению состояний в запрещенной зоне, локализованных вблизи границы. Концентрация шоклиевских состояний, так же как и таммовских, по порядку равна концентрации поверхностных атомов, т. е. величине порядка 10*15 см-2. Шоклиевские ПС можно трактовать как ненасыщенные химические связи атомов, находящихся на поверхности полупроводника. Поверхностные состояния за счет дефектов кристаллической решетки на поверхности (вакансии, междоузлия, дислокации) имеют аналогичную с локальными уровнями природу за счет этих же дефектов в объеме. Локализованные состояния на поверхности могут быть обусловлены также примесью в кристаллической решетке вблизи поверхности, абсорбцией атомов и молекул на поверхности полупроводника. Различают моноэнергетические ПС, имеющие дискретный уровень, и ПС, квазинепрерывно распределенные по энергии в запрещенной зоне по определенному закону, образующие континиум ПС. По зарядовому состоянию ПС, бывают двух типов – донороподобные и акцептороподобные. • Состояния донорного типа положительно заряжены, если расположены выше уровня Ферми, и нейтральны, если расположены ниже уровня Ферми. • Состояния акцепторного типа нейтральны, если расположены выше уровня Ферми, и отрицательно заряжены, если расположены ниже уровня Ферми. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 ( “surface states – поверхностные состояния”)
 6. 4. Эффект поля и зонная диаграмма при эффекте поля ОПЗ область пространственного заряда (ОПЗ). Изменение концентрации свободных носителей в приповерхностной области полупроводника под действием внешнего электрического поля получило название эффекта поля Величина разности потенциалов между квазинейтральным объемом и произвольной точкой ОПЗ называется электростатическим потенциалом. Электростатический потенциал на поверхности полупроводника поверхностный потенциал s. Поверхностная концентрация а) в случае обеднения; б) в случае обогащения СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 Полупроводниковые приборы на основе эффекта поля: • приборы с зарядовой связью, полевые транзисторы, и т. п.
6. 4. Эффект поля и зонная диаграмма при эффекте поля ОПЗ область пространственного заряда (ОПЗ). Изменение концентрации свободных носителей в приповерхностной области полупроводника под действием внешнего электрического поля получило название эффекта поля Величина разности потенциалов между квазинейтральным объемом и произвольной точкой ОПЗ называется электростатическим потенциалом. Электростатический потенциал на поверхности полупроводника поверхностный потенциал s. Поверхностная концентрация а) в случае обеднения; б) в случае обогащения СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014 Полупроводниковые приборы на основе эффекта поля: • приборы с зарядовой связью, полевые транзисторы, и т. п.
 Зонная диаграмма приповерхностной области полупроводника n-типа при различных состояниях поверхности: ns > n 0 ps < n 0 а) обогащение б) обеднение в) слабая инверсия г) сильная инверсия p-n СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013 p-n 6. 4.
Зонная диаграмма приповерхностной области полупроводника n-типа при различных состояниях поверхности: ns > n 0 ps < n 0 а) обогащение б) обеднение в) слабая инверсия г) сильная инверсия p-n СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013 p-n 6. 4.
 Уравнение Пуассона для ОПЗ первый интеграл уравнения Пуассона: Величина электрического поля на поверхности Es будет: Плотность пространственного заряда на единицу площади Область обогащения Область слабой инверсии Область сильной инверсии СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013 Область обеднения
Уравнение Пуассона для ОПЗ первый интеграл уравнения Пуассона: Величина электрического поля на поверхности Es будет: Плотность пространственного заряда на единицу площади Область обогащения Область слабой инверсии Область сильной инверсии СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013 Область обеднения
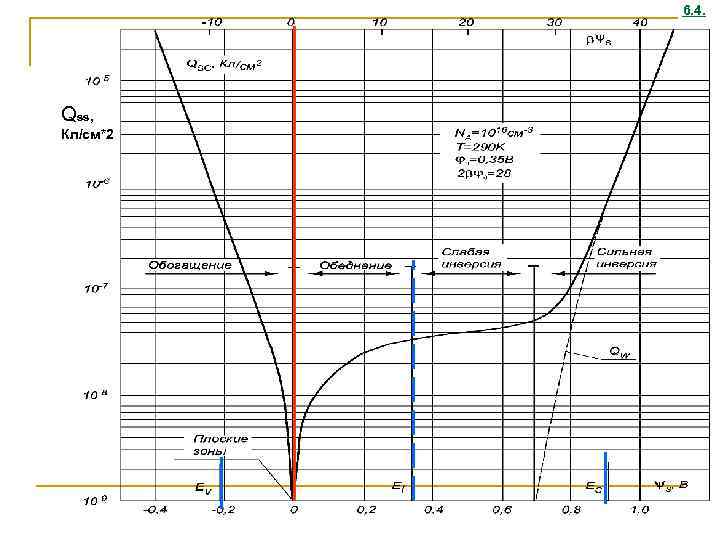 6. 4. Qss, Кл/см*2
6. 4. Qss, Кл/см*2
 Устройство МДП‑структур и их энергетическая диаграмма Структура: металл – диэлектрик – полупроводник Зонная диаграмма для идеальной МДП‑структуры Устройство МДП‑структуры 1 – затвор, 2 – подзатворный диэлектрик, 3 – полупроводниковая подложка, 4 – омический контакт
Устройство МДП‑структур и их энергетическая диаграмма Структура: металл – диэлектрик – полупроводник Зонная диаграмма для идеальной МДП‑структуры Устройство МДП‑структуры 1 – затвор, 2 – подзатворный диэлектрик, 3 – полупроводниковая подложка, 4 – омический контакт
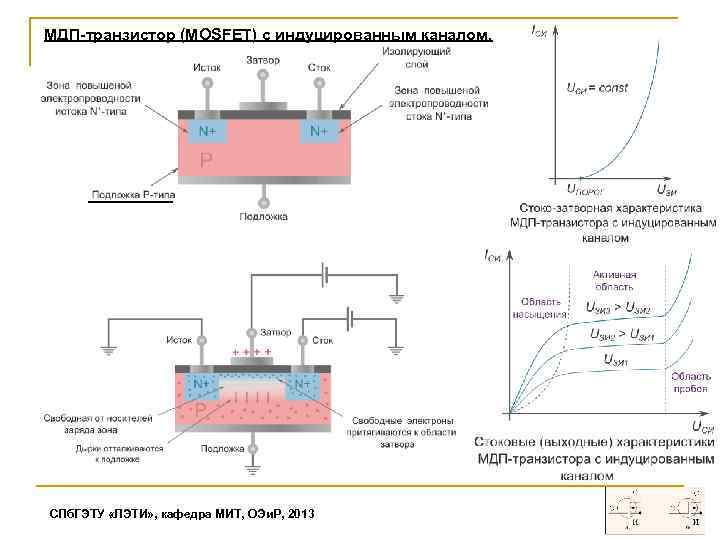 МДП-транзистор (MOSFET) с индуцированным каналом. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
МДП-транзистор (MOSFET) с индуцированным каналом. СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2013
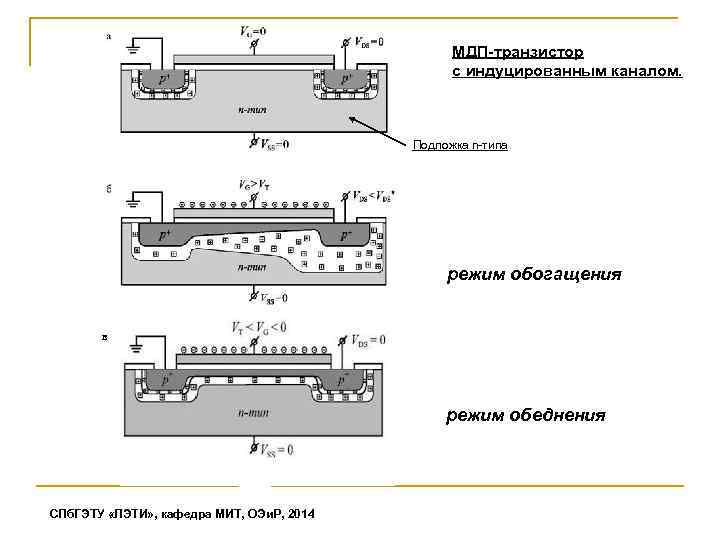 МДП-транзистор с индуцированным каналом. Подложка n-типа режим обогащения в режим обеднения СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
МДП-транзистор с индуцированным каналом. Подложка n-типа режим обогащения в режим обеднения СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
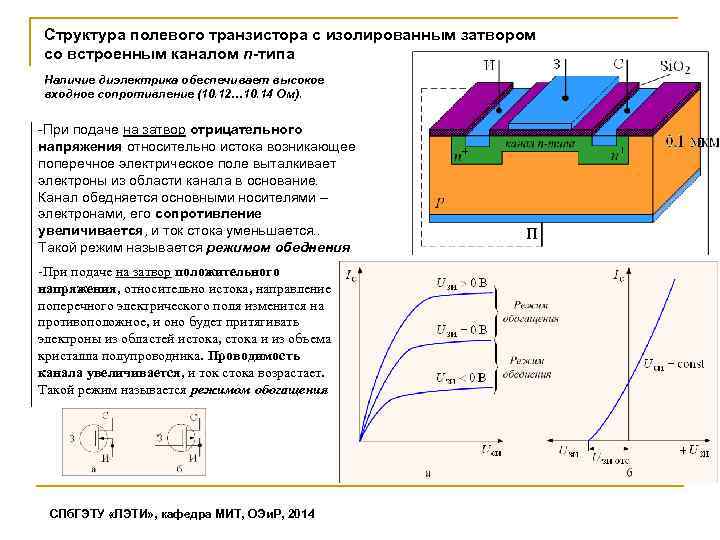 Структура полевого транзистора с изолированным затвором со встроенным каналом n-типа Наличие диэлектрика обеспечивает высокое входное сопротивление (10. 12… 10. 14 Ом). -При подаче на затвор отрицательного напряжения относительно истока возникающее поперечное электрическое поле выталкивает электроны из области канала в основание. Канал обедняется основными носителями – электронами, его сопротивление увеличивается, и ток стока уменьшается. . Такой режим называется режимом обеднения -При подаче на затвор положительного напряжения, относительно истока, направление поперечного электрического поля изменится на противоположное, и оно будет притягивать электроны из областей истока, стока и из объема кристалла полупроводника. Проводимость канала увеличивается, и ток стока возрастает. Такой режим называется режимом обогащения СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
Структура полевого транзистора с изолированным затвором со встроенным каналом n-типа Наличие диэлектрика обеспечивает высокое входное сопротивление (10. 12… 10. 14 Ом). -При подаче на затвор отрицательного напряжения относительно истока возникающее поперечное электрическое поле выталкивает электроны из области канала в основание. Канал обедняется основными носителями – электронами, его сопротивление увеличивается, и ток стока уменьшается. . Такой режим называется режимом обеднения -При подаче на затвор положительного напряжения, относительно истока, направление поперечного электрического поля изменится на противоположное, и оно будет притягивать электроны из областей истока, стока и из объема кристалла полупроводника. Проводимость канала увеличивается, и ток стока возрастает. Такой режим называется режимом обогащения СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
 В настоящее время полевые транзисторы вытесняют биполярные в ряде применений. Это связано со следующими преимуществами МДП-транзисторов: • Управляющая цепь полевых транзисторов потребляет ничтожную энергию, т. к. входное сопротивление этих приборов очень велико. Как правило, усиление мощности и тока в МДПтранзисторах много больше, чем в биполярных. • Управляющая цепь изолирована от выходной цепи, значительно повышаются надежность работы и помехоустойчивость схем на МДП-транзисторах. • МДП-транзисторы имеют низкий уровень собственных шумов, что связано с отсутствием инжекции носителей заряда. • Полевые транзисторы обладают более высоким быстродействием, т. к. в них нет инерционных процессов накопления и рассасывания носителей заряда. • В результате мощные МДП-транзисторы все больше вытесняют биполярные транзисторы там, где требуется высокое быстродействие и повышенная надежность работы. Однако МДП-транзисторы имеют и недостатки. • Вследствие высокого сопротивления канала в открытом состоянии МДП-транзисторы имеют большее падение напряжения, чем падение напряжения на насыщенном биполярном транзисторе. • МДП-транзисторы имеют существенно меньшее значение предельной температуры структуры, равное 150°C (для биполярных транзисторов 200°C). СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
В настоящее время полевые транзисторы вытесняют биполярные в ряде применений. Это связано со следующими преимуществами МДП-транзисторов: • Управляющая цепь полевых транзисторов потребляет ничтожную энергию, т. к. входное сопротивление этих приборов очень велико. Как правило, усиление мощности и тока в МДПтранзисторах много больше, чем в биполярных. • Управляющая цепь изолирована от выходной цепи, значительно повышаются надежность работы и помехоустойчивость схем на МДП-транзисторах. • МДП-транзисторы имеют низкий уровень собственных шумов, что связано с отсутствием инжекции носителей заряда. • Полевые транзисторы обладают более высоким быстродействием, т. к. в них нет инерционных процессов накопления и рассасывания носителей заряда. • В результате мощные МДП-транзисторы все больше вытесняют биполярные транзисторы там, где требуется высокое быстродействие и повышенная надежность работы. Однако МДП-транзисторы имеют и недостатки. • Вследствие высокого сопротивления канала в открытом состоянии МДП-транзисторы имеют большее падение напряжения, чем падение напряжения на насыщенном биполярном транзисторе. • МДП-транзисторы имеют существенно меньшее значение предельной температуры структуры, равное 150°C (для биполярных транзисторов 200°C). СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
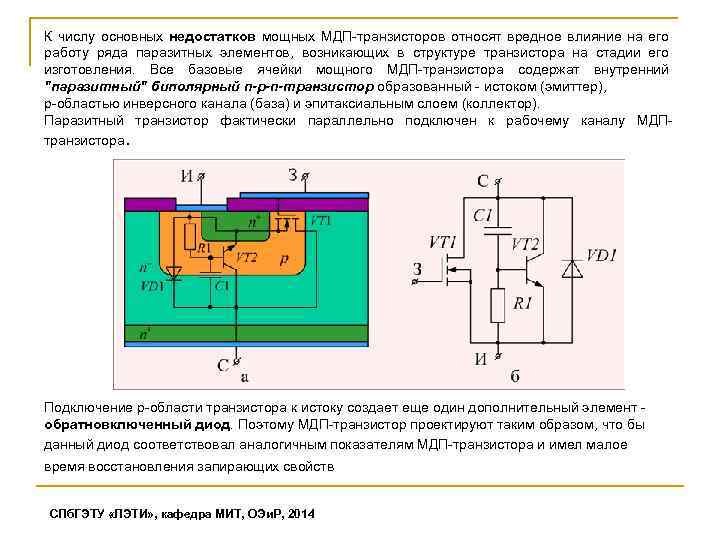 К числу основных недостатков мощных МДП-транзисторов относят вредное влияние на его работу ряда паразитных элементов, возникающих в структуре транзистора на стадии его изготовления. Все базовые ячейки мощного МДП-транзистора содержат внутренний "паразитный" биполярный n-p-n-транзистор образованный - истоком (эмиттер), p-областью инверсного канала (база) и эпитаксиальным слоем (коллектор). Паразитный транзистор фактически параллельно подключен к рабочему каналу МДПтранзистора. Подключение p-области транзистора к истоку создает еще один дополнительный элемент - обратновключенный диод. Поэтому МДП-транзистор проектируют таким образом, что бы данный диод соответствовал аналогичным показателям МДП-транзистора и имел малое время восстановления запирающих свойств СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
К числу основных недостатков мощных МДП-транзисторов относят вредное влияние на его работу ряда паразитных элементов, возникающих в структуре транзистора на стадии его изготовления. Все базовые ячейки мощного МДП-транзистора содержат внутренний "паразитный" биполярный n-p-n-транзистор образованный - истоком (эмиттер), p-областью инверсного канала (база) и эпитаксиальным слоем (коллектор). Паразитный транзистор фактически параллельно подключен к рабочему каналу МДПтранзистора. Подключение p-области транзистора к истоку создает еще один дополнительный элемент - обратновключенный диод. Поэтому МДП-транзистор проектируют таким образом, что бы данный диод соответствовал аналогичным показателям МДП-транзистора и имел малое время восстановления запирающих свойств СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
 СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014
СПб. ГЭТУ «ЛЭТИ» , кафедра МИТ, ОЭи. Р, 2014


