2013Q2 Mini-Lection.pptx
- Количество слайдов: 32
 Станислав В. Усенков Моделирование системы кремний/диоксид методом Монте-Карло Группа 2, ИФП СО РАН Новосибирск, 2013 г.
Станислав В. Усенков Моделирование системы кремний/диоксид методом Монте-Карло Группа 2, ИФП СО РАН Новосибирск, 2013 г.
 1. Структура диоксида кремния 2. Испарение Si. O 2 3. Нанокластеры кремния в Si. O 2
1. Структура диоксида кремния 2. Испарение Si. O 2 3. Нанокластеры кремния в Si. O 2
 Что такое диоксид кремния (Si. O 2) ? 3 Диоксид кремния – бесцветное, кристаллическое (либо аморфное) вещество. Полевой транзистор Si. O 2 Температура плавления составляет 1713 -1728 °C, что значительно выше температуры плавления кремния, приблизительно равной 1415 °C. Обладает высокой твёрдостью и прочностью. Затвор Исток Подложка Сток Искусственно полученные плёнки диоксида кремния используются в качестве подзатворного диэлектрика при формировании КМОП транзисторов в интегральных схемах. Граница раздела между кремниевой подложкой и слоем Si. O 2 является наилучшей из всех существующих границ раздела между полупроводником и диэлектриком. Она практически не содержит дефектов и не влияет на протекающий в канале ток.
Что такое диоксид кремния (Si. O 2) ? 3 Диоксид кремния – бесцветное, кристаллическое (либо аморфное) вещество. Полевой транзистор Si. O 2 Температура плавления составляет 1713 -1728 °C, что значительно выше температуры плавления кремния, приблизительно равной 1415 °C. Обладает высокой твёрдостью и прочностью. Затвор Исток Подложка Сток Искусственно полученные плёнки диоксида кремния используются в качестве подзатворного диэлектрика при формировании КМОП транзисторов в интегральных схемах. Граница раздела между кремниевой подложкой и слоем Si. O 2 является наилучшей из всех существующих границ раздела между полупроводником и диэлектриком. Она практически не содержит дефектов и не влияет на протекающий в канале ток.
 Строение диоксидной матрицы Схематическое сечение разных вариантов диоксидной матрицы. Показан основной структурный элемент Si. O 2 – тетраэдр Si. O 4: атом кремния окружен четырьмя атомами кислорода (в сечении видны только три); каждый атом кислорода соединен с двумя атомами кремния. Кристаллический кварц Кварцевое стекло Тетраэдр Si. O 4 Тетраэдрический угол Кремний Кислород Тетраэдры, имеющие общие атомы кислорода, образуют множество структур, например, трех- и шестизвенные кольца. 4
Строение диоксидной матрицы Схематическое сечение разных вариантов диоксидной матрицы. Показан основной структурный элемент Si. O 2 – тетраэдр Si. O 4: атом кремния окружен четырьмя атомами кислорода (в сечении видны только три); каждый атом кислорода соединен с двумя атомами кремния. Кристаллический кварц Кварцевое стекло Тетраэдр Si. O 4 Тетраэдрический угол Кремний Кислород Тетраэдры, имеющие общие атомы кислорода, образуют множество структур, например, трех- и шестизвенные кольца. 4
 Дефекты в диоксидной матрице 5 1. Трехкоординированный атом кремния с неспаренным электроном 2. Силиленовый центр 3. Кремний-кремниевая связь 4. Немостиковый кислород, оксирадикал 5. Пероксидный мостик 6. Пероксидный радикал 7. Гидроксильная группа 8. Кремний-водородная связь
Дефекты в диоксидной матрице 5 1. Трехкоординированный атом кремния с неспаренным электроном 2. Силиленовый центр 3. Кремний-кремниевая связь 4. Немостиковый кислород, оксирадикал 5. Пероксидный мостик 6. Пероксидный радикал 7. Гидроксильная группа 8. Кремний-водородная связь
 Эксперименты по испарению Si. O 2 6 СТМ изображение 30 нм пленки диоксида кремния на Si(001) после отжига в сверхвысоком вакууме. Темное круглое пятно в центре – поверхность кремния. R. Tromp, G. W. Rubloff, P. Balk, F. K. Le. Goues. Phys. Rev. Lett. , 55 (21), p. 2332 -2337 (1985). • • • Французов А. А. , Макрушин Н. И. . ЖТФ, том 45, выпуск 3. с. 600 -605 (1975). A. A. Frantsuzov, N. I. Macrushin. Thin Solid Films, 32, p. 247 -249 (1976). Алгазин Ю. Б. , Блюмкина Ю. А. , Свиташев К. К. ЖТФ, том 50, с. 2152 -2155 (1980).
Эксперименты по испарению Si. O 2 6 СТМ изображение 30 нм пленки диоксида кремния на Si(001) после отжига в сверхвысоком вакууме. Темное круглое пятно в центре – поверхность кремния. R. Tromp, G. W. Rubloff, P. Balk, F. K. Le. Goues. Phys. Rev. Lett. , 55 (21), p. 2332 -2337 (1985). • • • Французов А. А. , Макрушин Н. И. . ЖТФ, том 45, выпуск 3. с. 600 -605 (1975). A. A. Frantsuzov, N. I. Macrushin. Thin Solid Films, 32, p. 247 -249 (1976). Алгазин Ю. Б. , Блюмкина Ю. А. , Свиташев К. К. ЖТФ, том 50, с. 2152 -2155 (1980).
 Испарение диоксида кремния Si. O 2 Ямка на месте отверстия 7 Поверхность Si СТМ изображения отверстий в диоксиде после отжига разной длительности при 700°C. Толщина испаряемой пленки 0. 3 нм. 21 минута 33 минуты 57 минут Heiji Watanabe, Ken Fujita, Masakazu Ichikawa. APL, 70 (9), p. 1095 -1097 (1997). СТМ изображения отверстий в диоксиде после отжига разной длительности при 750°C. Площадь сканирования – 500 x 500 нм 2. 30 секунд 90 секунд 120 секунд Yi Wei, Robert M. Wallace, Alan C. Seabaugh. APL, 69 (9), p. 1270 -1272 (1996).
Испарение диоксида кремния Si. O 2 Ямка на месте отверстия 7 Поверхность Si СТМ изображения отверстий в диоксиде после отжига разной длительности при 700°C. Толщина испаряемой пленки 0. 3 нм. 21 минута 33 минуты 57 минут Heiji Watanabe, Ken Fujita, Masakazu Ichikawa. APL, 70 (9), p. 1095 -1097 (1997). СТМ изображения отверстий в диоксиде после отжига разной длительности при 750°C. Площадь сканирования – 500 x 500 нм 2. 30 секунд 90 секунд 120 секунд Yi Wei, Robert M. Wallace, Alan C. Seabaugh. APL, 69 (9), p. 1270 -1272 (1996).
 Испарение диоксида кремния 8 Фрагмент увеличенной поверхности Si в отверстии. СТМ изображения, полученные при 700°C отжиге ~1 нм Si. O 2 на подложке Si(111). Площадь 510 x 510 нм 2. СТМ изображение двух отверстий в пленке, образованных в различное время, и зависимость их размера от времени. K. Xue, J. B. Xu, H. P. Ho. Nanotechnology, 18, 485709 (2007).
Испарение диоксида кремния 8 Фрагмент увеличенной поверхности Si в отверстии. СТМ изображения, полученные при 700°C отжиге ~1 нм Si. O 2 на подложке Si(111). Площадь 510 x 510 нм 2. СТМ изображение двух отверстий в пленке, образованных в различное время, и зависимость их размера от времени. K. Xue, J. B. Xu, H. P. Ho. Nanotechnology, 18, 485709 (2007).
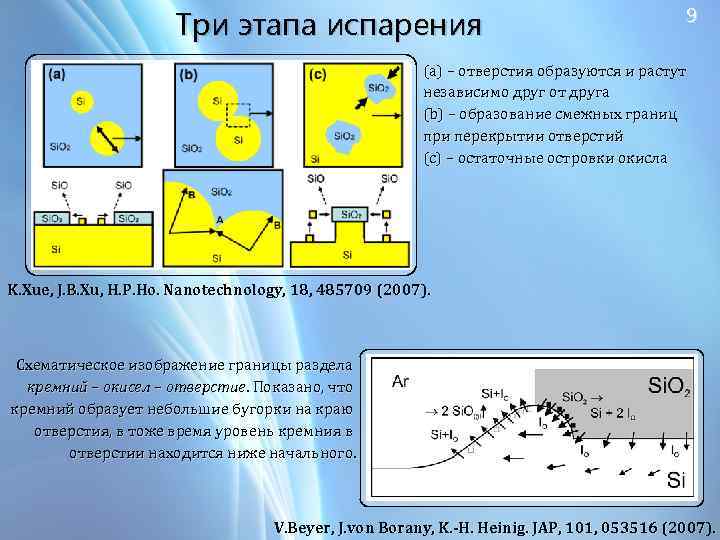 Три этапа испарения 9 (a) – отверстия образуются и растут независимо друг от друга (b) – образование смежных границ при перекрытии отверстий (c) – остаточные островки окисла K. Xue, J. B. Xu, H. P. Ho. Nanotechnology, 18, 485709 (2007). Схематическое изображение границы раздела кремний – окисел – отверстие. Показано, что кремний образует небольшие бугорки на краю отверстия, в тоже время уровень кремния в отверстии находится ниже начального. V. Beyer, J. von Borany, K. -H. Heinig. JAP, 101, 053516 (2007).
Три этапа испарения 9 (a) – отверстия образуются и растут независимо друг от друга (b) – образование смежных границ при перекрытии отверстий (c) – остаточные островки окисла K. Xue, J. B. Xu, H. P. Ho. Nanotechnology, 18, 485709 (2007). Схематическое изображение границы раздела кремний – окисел – отверстие. Показано, что кремний образует небольшие бугорки на краю отверстия, в тоже время уровень кремния в отверстии находится ниже начального. V. Beyer, J. von Borany, K. -H. Heinig. JAP, 101, 053516 (2007).
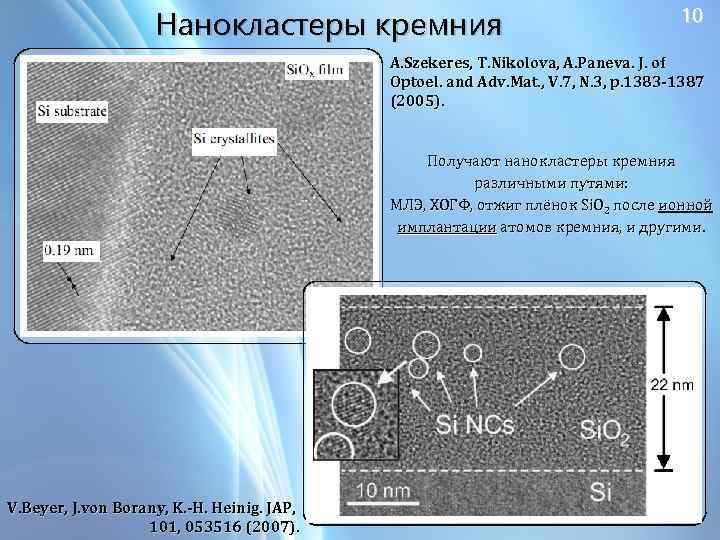 Нанокластеры кремния 10 A. Szekeres, T. Nikolova, A. Paneva. J. of Optoel. and Adv. Mat. , V. 7, N. 3, p. 1383 -1387 (2005). Получают нанокластеры кремния различными путями: МЛЭ, ХОГФ, отжиг плёнок Si. O 2 после ионной имплантации атомов кремния, и другими. V. Beyer, J. von Borany, K. -H. Heinig. JAP, 101, 053516 (2007).
Нанокластеры кремния 10 A. Szekeres, T. Nikolova, A. Paneva. J. of Optoel. and Adv. Mat. , V. 7, N. 3, p. 1383 -1387 (2005). Получают нанокластеры кремния различными путями: МЛЭ, ХОГФ, отжиг плёнок Si. O 2 после ионной имплантации атомов кремния, и другими. V. Beyer, J. von Borany, K. -H. Heinig. JAP, 101, 053516 (2007).
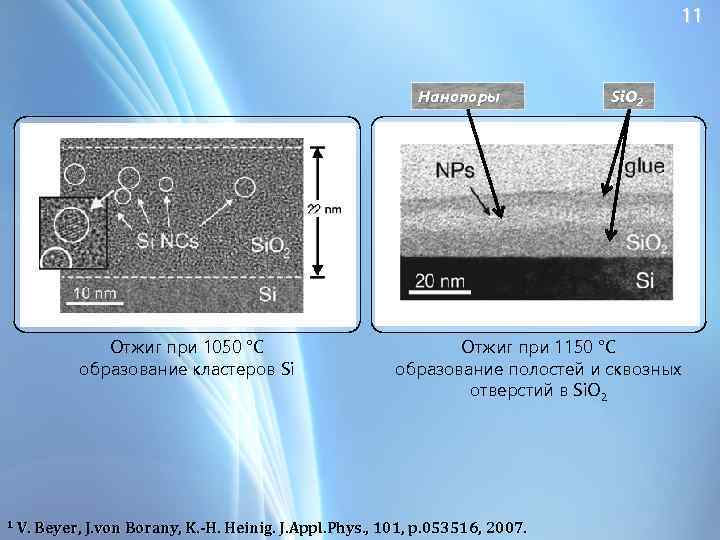 11 Нанопоры Отжиг при 1050 °C образование кластеров Si Si. O 2 Отжиг при 1150 °C образование полостей и сквозных отверстий в Si. O 2 1 V. Beyer, J. von Borany, K. -H. Heinig. J. Appl. Phys. , 101, p. 053516, 2007.
11 Нанопоры Отжиг при 1050 °C образование кластеров Si Si. O 2 Отжиг при 1150 °C образование полостей и сквозных отверстий в Si. O 2 1 V. Beyer, J. von Borany, K. -H. Heinig. J. Appl. Phys. , 101, p. 053516, 2007.
 1. 2. 3. 4. 5. Примеры работ по моделированию Si/Si. O 2 Вычислительный комплекс Sil. Sim 3 D Представление Si. O 2 в решеточной модели Поиск параметров Результаты
1. 2. 3. 4. 5. Примеры работ по моделированию Si/Si. O 2 Вычислительный комплекс Sil. Sim 3 D Представление Si. O 2 в решеточной модели Поиск параметров Результаты
 Работы по моделированию Si/Si. O 2 Si 13 O Si / кварц Структура интерфейса, полученная во время симуляции отжига, основанной на вычислениях из первых принципов и МК моделировании. K. -O. Ng, D. Vanderbilt. Phys. Rev. B. , 59, p. 10132 -10137 (1999). Si / тридимит Структура интерфейса между кремниевой подложкой и кварцем/тридимитом, сгенерированная во время симуляции отжига с использованием методов МД и МК. Yuhai Tu, J. Tersoff. Phys. Rev. Lett. , 84 (19), p. 4393 -4396 (2000).
Работы по моделированию Si/Si. O 2 Si 13 O Si / кварц Структура интерфейса, полученная во время симуляции отжига, основанной на вычислениях из первых принципов и МК моделировании. K. -O. Ng, D. Vanderbilt. Phys. Rev. B. , 59, p. 10132 -10137 (1999). Si / тридимит Структура интерфейса между кремниевой подложкой и кварцем/тридимитом, сгенерированная во время симуляции отжига с использованием методов МД и МК. Yuhai Tu, J. Tersoff. Phys. Rev. Lett. , 84 (19), p. 4393 -4396 (2000).
 Методы моделирования 14 Использование моделирования имеет следующие преимущества: 1. Отсутствие затрат на опытные образцы и проведение экспериментов – нужна только вычислительная техника. 2. Объяснение экспериментально наблюдаемых эффектов. Размеры моделируемых систем (количество атомов) и времён растёт в следующем порядке: 1. ab initio (без приближений) 2. ab initio (с приближениями) N ~ 101 атомов, t < 10 -9 сек. 3. Молекулярная динамика N ~ 106 атомов, t < 10 -6 сек. 4. Методы Монте-Карло N ~ 106 атомов, t > 103 сек. Соответственно, в таком же порядке увеличивается количество упрощений и приближений, которые могут повлиять на корректность результата.
Методы моделирования 14 Использование моделирования имеет следующие преимущества: 1. Отсутствие затрат на опытные образцы и проведение экспериментов – нужна только вычислительная техника. 2. Объяснение экспериментально наблюдаемых эффектов. Размеры моделируемых систем (количество атомов) и времён растёт в следующем порядке: 1. ab initio (без приближений) 2. ab initio (с приближениями) N ~ 101 атомов, t < 10 -9 сек. 3. Молекулярная динамика N ~ 106 атомов, t < 10 -6 сек. 4. Методы Монте-Карло N ~ 106 атомов, t > 103 сек. Соответственно, в таком же порядке увеличивается количество упрощений и приближений, которые могут повлиять на корректность результата.
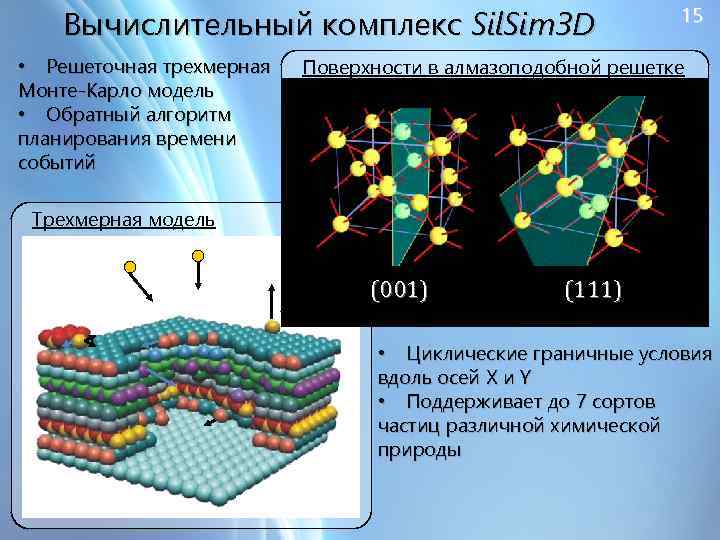 Вычислительный комплекс Sil. Sim 3 D • Решеточная трехмерная Монте-Карло модель • Обратный алгоритм планирования времени событий 15 Поверхности в алмазоподобной решетке Трехмерная модель (001) (111) • Циклические граничные условия вдоль осей X и Y • Поддерживает до 7 сортов частиц различной химической природы
Вычислительный комплекс Sil. Sim 3 D • Решеточная трехмерная Монте-Карло модель • Обратный алгоритм планирования времени событий 15 Поверхности в алмазоподобной решетке Трехмерная модель (001) (111) • Циклические граничные условия вдоль осей X и Y • Поддерживает до 7 сортов частиц различной химической природы
 Вычислительный комплекс Sil. Sim 3 D 16 Возможные типы элементарных событий, происходящих с частицами: Диффузионные шаги (1) В 1 2 3 координационную сферу Адсорбция из потока (2) Десорбция (3) Реадсорбция (4) Химические реакции (5) Превращение (A B) Обмен (A+B C+D) Объединение (A+B C) Распад (A C + D) Вероятность события = exp ( – Eбарьер / k. T ) Время ожидания события ~ νD / вероятность события
Вычислительный комплекс Sil. Sim 3 D 16 Возможные типы элементарных событий, происходящих с частицами: Диффузионные шаги (1) В 1 2 3 координационную сферу Адсорбция из потока (2) Десорбция (3) Реадсорбция (4) Химические реакции (5) Превращение (A B) Обмен (A+B C+D) Объединение (A+B C) Распад (A C + D) Вероятность события = exp ( – Eбарьер / k. T ) Время ожидания события ~ νD / вероятность события
 Решеточная модель матрицы Si. O 2 Атом O Атом Si Тетраэдр Si. O 4 Модельный слой представляет собой прямоугольный параллелепипед размерностью (Nx × Ny × Nz) атомных мест, расположенный на полубесконечной подложке. Тетраэдры Si. O 4 в модельной системе. Атомы кремния и кислорода занимают узлы алмазоподобной кристаллической решетки. 17 Частично заполненная сетка позволяет упростить модель и сохранить правильный ближний порядок, скорость расчётов остаётся характерно высокой для решёточной модели.
Решеточная модель матрицы Si. O 2 Атом O Атом Si Тетраэдр Si. O 4 Модельный слой представляет собой прямоугольный параллелепипед размерностью (Nx × Ny × Nz) атомных мест, расположенный на полубесконечной подложке. Тетраэдры Si. O 4 в модельной системе. Атомы кремния и кислорода занимают узлы алмазоподобной кристаллической решетки. 17 Частично заполненная сетка позволяет упростить модель и сохранить правильный ближний порядок, скорость расчётов остаётся характерно высокой для решёточной модели.
 Энергетические параметры модели 18 Модель Si/Si. O 2 предусматривает следующие сорта частиц: • • атом кислорода (O), атом кремния (Si), молекула моноокиси кремния (Si. O), молекула кислорода (O 2). Из известных экспериментальных и расчетных данных выбираются следующие характеристики модели: • • • энергии диффузионных шагов Ediff всех сортов частиц в различных конфигурациях ближайшего окружения; энергии сублимации (отрыва от поверхности) Esub частиц; энергии активации основных химических реакций Er, i: • Образование Si. O: Si + O Si. O • Распад Si. O: Si. O Si + O • Окисление в потоке O 2: Si + O 2 Si. O + O Для каждого вычислительного эксперимента дополнительно задаются: • • температура (K), скорость осаждения веществ (МС/сек), морфология исходной поверхности (расположение атомов в узлах решетки), длительность процесса.
Энергетические параметры модели 18 Модель Si/Si. O 2 предусматривает следующие сорта частиц: • • атом кислорода (O), атом кремния (Si), молекула моноокиси кремния (Si. O), молекула кислорода (O 2). Из известных экспериментальных и расчетных данных выбираются следующие характеристики модели: • • • энергии диффузионных шагов Ediff всех сортов частиц в различных конфигурациях ближайшего окружения; энергии сублимации (отрыва от поверхности) Esub частиц; энергии активации основных химических реакций Er, i: • Образование Si. O: Si + O Si. O • Распад Si. O: Si. O Si + O • Окисление в потоке O 2: Si + O 2 Si. O + O Для каждого вычислительного эксперимента дополнительно задаются: • • температура (K), скорость осаждения веществ (МС/сек), морфология исходной поверхности (расположение атомов в узлах решетки), длительность процесса.
 «Эволюция» стенок отверстия в Si. O 2 1000°C t, сек Зависимость диаметра отверстия от t 0 10 20 25 30 35 1100°C 19
«Эволюция» стенок отверстия в Si. O 2 1000°C t, сек Зависимость диаметра отверстия от t 0 10 20 25 30 35 1100°C 19
 Скорость десорбции Si. O 2 Верхний монослой Si Фрагмент поверхности Si. O 2 Si Поверхность Si Нижний монослой Si 20 Si. O 2 T = 1200°C
Скорость десорбции Si. O 2 Верхний монослой Si Фрагмент поверхности Si. O 2 Si Поверхность Si Нижний монослой Si 20 Si. O 2 T = 1200°C
 Зарождение отверстий в Si. O 2 21 Тонкая несовершенная пленка Si. O 2 с дефектной областью Область с дефектом Начальный момент времени Зарождение отверстия Образование отверстия (сквозного)
Зарождение отверстий в Si. O 2 21 Тонкая несовершенная пленка Si. O 2 с дефектной областью Область с дефектом Начальный момент времени Зарождение отверстия Образование отверстия (сквозного)
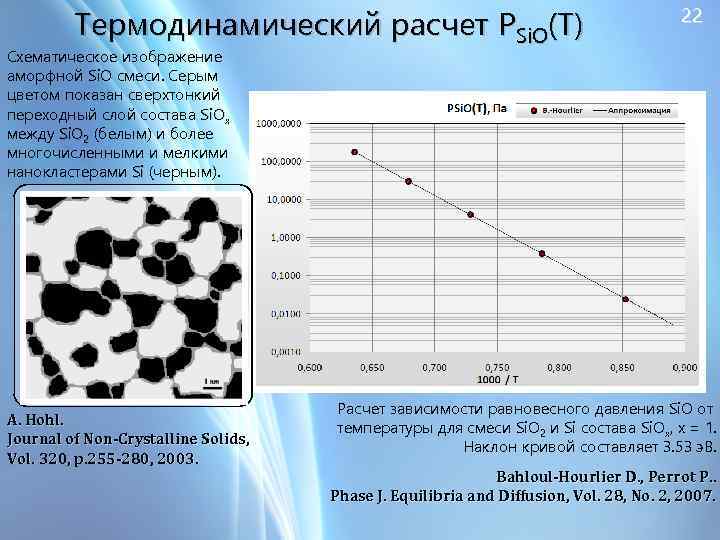 Термодинамический расчет PSi. O(T) 22 Схематическое изображение аморфной Si. O смеси. Серым цветом показан сверхтонкий переходный слой состава Si. Ox между Si. O 2 (белым) и более многочисленными и мелкими нанокластерами Si (черным). A. Hohl. Journal of Non-Crystalline Solids, Vol. 320, p. 255 -280, 2003. Расчет зависимости равновесного давления Si. O от температуры для смеси Si. O 2 и Si состава Si. Ox, x = 1. Наклон кривой составляет 3. 53 э. В. Bahloul-Hourlier D. , Perrot P. . Phase J. Equilibria and Diffusion, Vol. 28, No. 2, 2007.
Термодинамический расчет PSi. O(T) 22 Схематическое изображение аморфной Si. O смеси. Серым цветом показан сверхтонкий переходный слой состава Si. Ox между Si. O 2 (белым) и более многочисленными и мелкими нанокластерами Si (черным). A. Hohl. Journal of Non-Crystalline Solids, Vol. 320, p. 255 -280, 2003. Расчет зависимости равновесного давления Si. O от температуры для смеси Si. O 2 и Si состава Si. Ox, x = 1. Наклон кривой составляет 3. 53 э. В. Bahloul-Hourlier D. , Perrot P. . Phase J. Equilibria and Diffusion, Vol. 28, No. 2, 2007.
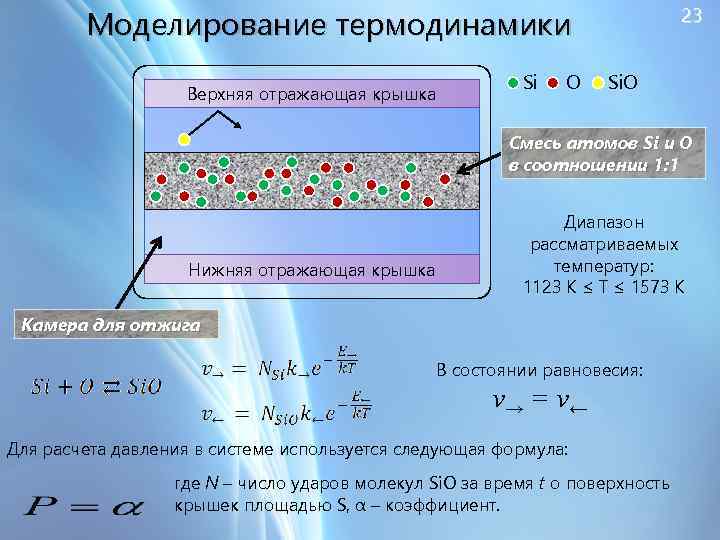 Моделирование термодинамики Верхняя отражающая крышка Si O 23 Si. O Смесь атомов Si и O в соотношении 1: 1 Нижняя отражающая крышка Диапазон рассматриваемых температур: 1123 K ≤ T ≤ 1573 K Камера для отжига В состоянии равновесия: v→ = v← Для расчета давления в системе используется следующая формула: где N – число ударов молекул Si. O за время t о поверхность крышек площадью S, α – коэффициент.
Моделирование термодинамики Верхняя отражающая крышка Si O 23 Si. O Смесь атомов Si и O в соотношении 1: 1 Нижняя отражающая крышка Диапазон рассматриваемых температур: 1123 K ≤ T ≤ 1573 K Камера для отжига В состоянии равновесия: v→ = v← Для расчета давления в системе используется следующая формула: где N – число ударов молекул Si. O за время t о поверхность крышек площадью S, α – коэффициент.
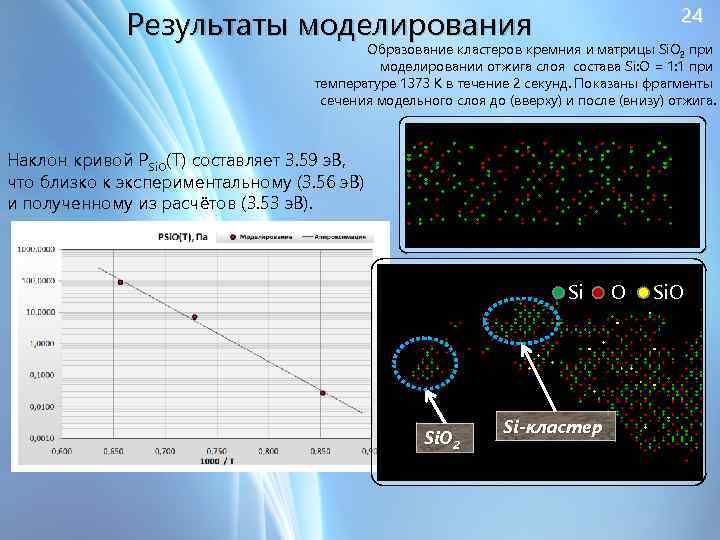 Результаты моделирования 24 Образование кластеров кремния и матрицы Si. O 2 при моделировании отжига слоя состава Si: O = 1: 1 при температуре 1373 K в течение 2 секунд. Показаны фрагменты сечения модельного слоя до (вверху) и после (внизу) отжига. Наклон кривой PSi. O(T) составляет 3. 59 э. В, что близко к экспериментальному (3. 56 э. В) и полученному из расчётов (3. 53 э. В). Si Si. O 2 Si-кластер O Si. O
Результаты моделирования 24 Образование кластеров кремния и матрицы Si. O 2 при моделировании отжига слоя состава Si: O = 1: 1 при температуре 1373 K в течение 2 секунд. Показаны фрагменты сечения модельного слоя до (вверху) и после (внизу) отжига. Наклон кривой PSi. O(T) составляет 3. 59 э. В, что близко к экспериментальному (3. 56 э. В) и полученному из расчётов (3. 53 э. В). Si Si. O 2 Si-кластер O Si. O
 Эксперимент: Si. O 2 в потоке Si Критические условия перехода от травления слоя Si. O 2 в потоке кремния к росту кремниевой плёнки (1) 1 D. C. Streit, F. Allen. J. Appl. Phys. , 61 (8), 1987. 25
Эксперимент: Si. O 2 в потоке Si Критические условия перехода от травления слоя Si. O 2 в потоке кремния к росту кремниевой плёнки (1) 1 D. C. Streit, F. Allen. J. Appl. Phys. , 61 (8), 1987. 25
 Моделирование осаждения Si на Si. O 2 26 Вид спереди Вид сверху Si O Рост плёнки в потоке Si (0. 5 МС/сек) при температуре 950 K Травление матрицы Si. O 2 в потоке Si (0. 01 МС/сек) при температуре 1250 K
Моделирование осаждения Si на Si. O 2 26 Вид спереди Вид сверху Si O Рост плёнки в потоке Si (0. 5 МС/сек) при температуре 950 K Травление матрицы Si. O 2 в потоке Si (0. 01 МС/сек) при температуре 1250 K


 Поверхность Si в потоке O 2 Критические условия (давление / температура) взаимодействия O 2 с Si(111). Прямая PTR соответствует образованию окисла на чистой поверхности, прямая PC – граница, когда рост и испарение Si. O 2 скомпенсированы. ДБЭ-осцилляции при травлении кислородом вицинальных подложек Si(111): T=1110°К, T=1050°K, T=1050°K T=1020°К, T=1005°К, A. A. Shklyaev, Takanori Suzuki. Phys. Rev. Lett. , 75, p. 272 -275 (1995). 29 Травление кислородом поверхности Si(111) в виде вакансионных островков моноатомной глубины. движение ступеней вакансионные островки развитие рельефа С. С. Косолобов, А. Л. Асеев, А. В. Латышев, ФТП, 35 (9), с. 1084 (2001).
Поверхность Si в потоке O 2 Критические условия (давление / температура) взаимодействия O 2 с Si(111). Прямая PTR соответствует образованию окисла на чистой поверхности, прямая PC – граница, когда рост и испарение Si. O 2 скомпенсированы. ДБЭ-осцилляции при травлении кислородом вицинальных подложек Si(111): T=1110°К, T=1050°K, T=1050°K T=1020°К, T=1005°К, A. A. Shklyaev, Takanori Suzuki. Phys. Rev. Lett. , 75, p. 272 -275 (1995). 29 Травление кислородом поверхности Si(111) в виде вакансионных островков моноатомной глубины. движение ступеней вакансионные островки развитие рельефа С. С. Косолобов, А. Л. Асеев, А. В. Латышев, ФТП, 35 (9), с. 1084 (2001).
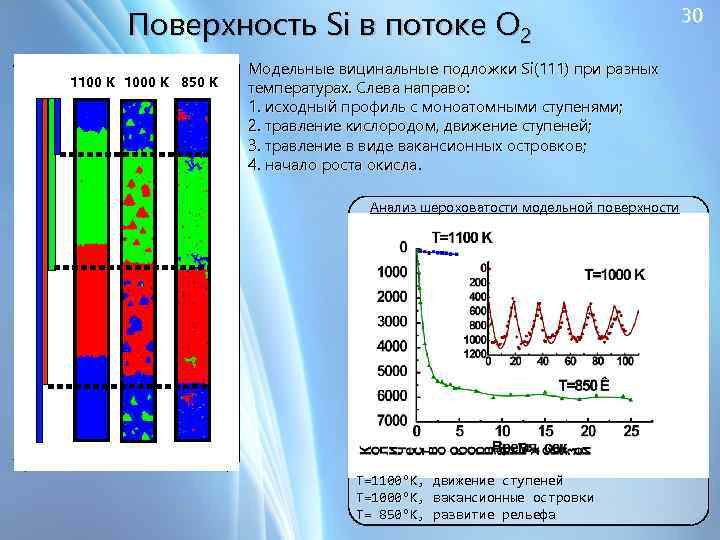 Поверхность Si в потоке O 2 1100 K 1000 K 850 K Модельные вицинальные подложки Si(111) при разных температурах. Слева направо: 1. исходный профиль с моноатомными ступенями; 2. травление кислородом, движение ступеней; 3. травление в виде вакансионных островков; 4. начало роста окисла. Анализ шероховатости модельной поверхности T=1100°К, движение ступеней T=1000°К, вакансионные островки T= 850°К, развитие рельефа 30
Поверхность Si в потоке O 2 1100 K 1000 K 850 K Модельные вицинальные подложки Si(111) при разных температурах. Слева направо: 1. исходный профиль с моноатомными ступенями; 2. травление кислородом, движение ступеней; 3. травление в виде вакансионных островков; 4. начало роста окисла. Анализ шероховатости модельной поверхности T=1100°К, движение ступеней T=1000°К, вакансионные островки T= 850°К, развитие рельефа 30
 Испарение дефектного Si. O 2 31 Изображение пленки диоксида после 30 секунд отжига при 1150°C. До отжига в пленку проводилась ионная имплантация Si+: (низкий поток) Наблюдаются отверстия различных форм и размеров (~ 15 -40 мкм). (высокий поток). Отверстия (черные области и точки на изображении) расположены очень плотно, и имеют различные размеры (30 -200 нм, < 10 нм для точек) и неправильные формы. V. Beyer, J. von Borany, K. -H. Heinig. JAP, 101, 053516 (2007).
Испарение дефектного Si. O 2 31 Изображение пленки диоксида после 30 секунд отжига при 1150°C. До отжига в пленку проводилась ионная имплантация Si+: (низкий поток) Наблюдаются отверстия различных форм и размеров (~ 15 -40 мкм). (высокий поток). Отверстия (черные области и точки на изображении) расположены очень плотно, и имеют различные размеры (30 -200 нм, < 10 нм для точек) и неправильные формы. V. Beyer, J. von Borany, K. -H. Heinig. JAP, 101, 053516 (2007).
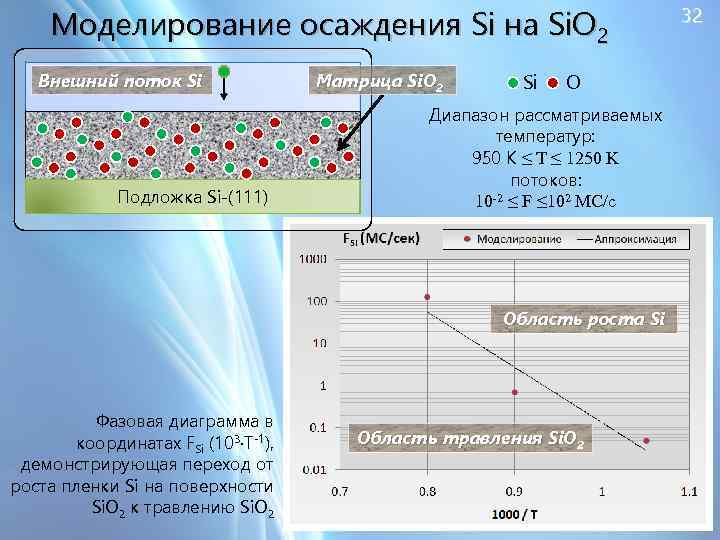 Моделирование осаждения Si на Si. O 2 Внешний поток Si Подложка Si-(111) Матрица Si. O 2 Si O Диапазон рассматриваемых температур: 950 K ≤ T ≤ 1250 K потоков: 10 -2 ≤ F ≤ 102 МС/с Область роста Si Фазовая диаграмма в координатах FSi (103∙T-1), демонстрирующая переход от роста пленки Si на поверхности Si. O 2 к травлению Si. O 2 Область травления Si. O 2 32
Моделирование осаждения Si на Si. O 2 Внешний поток Si Подложка Si-(111) Матрица Si. O 2 Si O Диапазон рассматриваемых температур: 950 K ≤ T ≤ 1250 K потоков: 10 -2 ≤ F ≤ 102 МС/с Область роста Si Фазовая диаграмма в координатах FSi (103∙T-1), демонстрирующая переход от роста пленки Si на поверхности Si. O 2 к травлению Si. O 2 Область травления Si. O 2 32


