СПЕЦИАЛЬНОЕ ТЕХНОЛОГИЧЕСКОЕ ОБОРУДОВАНИЕ Тема №


СПЕЦИАЛЬНОЕ ТЕХНОЛОГИЧЕСКОЕ ОБОРУДОВАНИЕ Тема № 8: Оборудование для получения покрытий из газовой фазы и из жидкостных сред

ХИМИЧЕСКОЕ САЖДЕНИЕ ИЗ ГАЗОВОЙ ФАЗЫ ХОГФ представляет собой процесс, когда газы или пары реагируют с образованием твердых продуктов на поверхности подложки. Данный метод позволяет получать практически любые пленки, используемые в производстве ИС и ППП: - Подзатворный диэлектрик (Si 02, Si 3 N 4, Тi. O 2, AI 203, Нf. O 2) - Токоведущие дорожки (AI и его сплавы, Ti. W, WN, Ta. N, Hf. N) - Изоляция (Si 02, ФСС, БФСС, АСС, БСС, ГФСС) - Пассивация (ФСС, Six. Ny, ПКЛК, AI 203, Six. Ny. Hz, Six. Oy. Nz) - Конденсаторный диэлектрик (Si 02, Si 3 N 4, Та 205, Ti 02, Nb 205, Нf. O 2, AI 203) - Маскирующий слой (Si 3 N 4, Si 02 ) - Затвор и межсоединения (ПК, ПКЛФ, силициды ТПМ, ТПМ) - Обкладка накопительного конденсатора (ПК, ПКЛФ, AI и его сплавы, ТПМ)

ХИМИЧЕСКИЕ РЕАКЦИИ, ПРОТЕКАЮЩИЕ ПРИ ОСАЖДЕНИИ ИЗ ГАЗОВОЙ ФАЗЫ Пиролиз: Si. H 4(г) → Si(тв)+2 H 2(г) Восстановление: WF 6(г)+3 H 2(г) → W(тв)+6 HF(г) Окисление: Si. H 4(г)+4 N 20(г) → Si 02(тв)+4 N 2(г)+2 H 20 Аммонолиз: 3 Si. H 2 CI 2(г)+4 NH 3(г) → Si 3 N 4(тв) + 6 H 2(г) +6 HCI(г) Образование карбида: Ti. CI 4(г)+CH 4(г) → Тi. Cl(тв) +4 HCI(г) Диспропорционировани: 2 Ge. I 2(г) → Ge(тв)+Ge. I 4(г) Металлоорганическая: (CH 3)3 Ga(г)+As. H 3(г) → Ga. As(тв)+3 CH 4(г) Химического переноса: 6 Ga. As(тв)+6 HCl → As 4(г)+As 2(г)+6 Ga. Cl(г)+3 H 2(г)

ФУНКЦИИ ОБОРУДОВАНИЯ ДЛЯ ХОГФ 1. Подготовка и перенос газообразных реагентов к месту реакции; 2. Подача на подложку энергии, активизирующей процесс осаждения (тепло, излучение, плазма); 3. Поддержание в зоне реакции необходимой температуры и давления; 4. Обеспечение условий для оптимального протекания химической реакции на подложках; 5. Эффективное удаление побочных продуктов химической реакции из реакционной камеры. Кроме того, в современном оборудовании должна обеспечиваться автоматическая загрузка и выгрузка пластин в реакционную камеру.

СОСТАВ ОБОРУДОВАНИЯ ДЛЯ ХОГФ 1. Реактор; 2. Газовая система; 3. Вакуумная система или выхлопная система (для установок, работающих при атмосферном давлении); 4. Система возбуждения и поддержания плазменного разряда (для процессов с плазменной активацией и процессов очистки внутрикамерной оснастки); 5. Система охлаждения и/или термостатирования элементов реактора, газовой и вакуумной систем; 6. Система загрузки-выгрузки; 7. Система управления; 8. Система контроля толщины осаждаемых пленок.

РЕАКТОР СИСТЕМЫ ДЛЯ ХОГФ СОДЕРЖИТ: - реакционную камеру с пластинами, расположенными в операционных кассетах или на подложкодержателе, - систему нагрева пластин, - устройства для ввода газовой смеси, - устройства для создания плазменного разряда.

ГАЗОВАЯ СИСТЕМА РЕАКТОРА ДЛЯ ХОГФ ОБЕСПЕЧИВАЕТ ПОДГОТОВКУ И ПОДАЧУ В РЕАКТОР НЕОБХОДИМЫХ ПОТОКОВ: - реакционных газов, - паров жидких реагентов, - продувочных газов.

ВАКУУМНАЯ (ВЫХЛОПНАЯ) СИСТЕМА УСТАНОВКИ ДЛЯ ХОГФ ОБЕСПЕЧИВАЕТ: - поддержание в реакционной камере необходимого давления; - удаление продуктов реакции; - откачку и поддержание необходимого давления в шлюзовых камерах.

СИСТЕМА УПРАВЛЕНИЯ УСТАНОВКИ ДЛЯ ХОГФ ОБЕСПЕЧИВАЕТ: - автоматизацию управления всеми системами установки, - диагностику состояния систем установки, - автоматическое выполнение процессов осаждения и очистки, - хранение и передачу информации по локальным сетям и т. д.

ТРЕБОВАНИЯ К ОБОРУДОВАНИЮ ДЛЯ ХОГФ - технологические; - эксплуатационные; - безопасности; - экономические.

ТЕХНОЛОГИЧЕСКИЕ ТРЕБОВАНИЯ К УСТАНОВКАМ ДЛЯ ХОГФ Характеризуют выходные параметры процесса осаждения и являются определяющими при выборе оборудования. К ним относятся: - разброс толщины осаждаемого слоя по пластине, загрузке, и между процессами; - диаметр обрабатываемых пластин; - скорость осаждения; - производительность процесса. Точность поддержания операционных параметров оборудования должна быть в пределах 5 % при точности их измерения 0, 5 %; Оборудование должно обеспечивать минимальную привносимую дефектность технологического процесса.

ЭКСПЛУАТАЦИОННЫЕ ТРЕБОВАНИЯ - оборудование должно быть максимально простым в управлении и обслуживании; - все узлы оборудования должны быть легко доступны для обслуживания и/или замены; - обслуживание должно быть минимизировано по объему работ и времени, ремонт оборудования должен осуществляться заменой унифицированных составных частей, - критические отказы оборудования не допустимы и должны быть исключены за счет создания системы превентивного обслуживания, основанной на анализе тенденций информативных признаков; - обязательным является соблюдение графика превентивного обслуживания, включающего: - преждевременную (до поломки) замену деталей и узлов установки, - очистку деталей, узлов установки, а также оснастки с целью исключения изменения параметров технологического процесса из-за засорения ловушек, фильтров, вакуумного масла, отслаивания осадков от внутрикамерной оснастки.

ТРЕБОВАНИЯ БЕЗОПАСНОСТИ 1. Большинство реагентов, используемых в ХОГФ -процессах, и продуктов реакций являются токсичными и пожароопасными. 2. В оборудовании могут использоваться несовместимые друг с другом газы (например, моносилан и трифторид азота). 3. В любом оборудовании имеются движущиеся части, горячие детали и электрические блоки. Поэтому для обеспечения безопасности по отношению к персоналу и окружающей среде оборудование должно быть оснащено: - датчиками (сенсорами) и микропереключателями, обеспечивающими безопасную работу движущихся частей оборудования;

- блокировками, предотвращающими одновременную подачу в реакционную камеру несовместимых газов, подачу токсичных и пожароопасных газов в реакционную камеру при нарушении ее герметичности или при открытых шлюзовых затворах; - датчиками, отслеживающими давление сжатого воздуха, азота и других газов и блокировками, предотвращающими подачу реакционных газов в аварийной ситуации; - датчиками, отслеживающими температуру, давление или поток охлаждающей жидкости и/или термостабилизирующих агентов; - датчиками, отслеживающими работу вытяжных систем, подключенных к установке; - защитными панелями, дверцами, которые закрывают потенциально опасные узлы оборудования. Для предотвращения загрязнения окружающей среды установки ХОГФ должны подключаться к скрубберам, которые располагаются после вакуумных насосов или после выхлопа из реакционной камеры.

ЭКОНОМИЧЕСКИЕ ТРЕБОВАНИЯ - для ХОГФ осаждения слоев должны использоваться наименее опасные, дешевые и доступные реагенты с максимальными сроками хранения. - энергетические затраты должны быть минимизированы или сравнимы с затратами на других типах оборудования для осаждения аналогичных слоев.

ПРИЗНАКИ КЛАССИФИКАЦИИ ОБОРУДОВАНИЯ ДЛЯ ХОГФ - способ активации химической реакции; - давление в реакционной камере; -способ нагрева подложек; - количество обрабатываемых пластин и форма реакционной камеры; -частота ВЧ-разряда, способ генерации плазмы (для реакторов с плазменной активацией).

КЛАССИФИКАЦИЯ ОБОРУДОВАНИЯ ДЛЯ ХОГФ ПО СПОСОБУ АКТИВАЦИИХИМИЧЕСКОЙ РЕАКЦИИ - оборудование с термической активацией осаждения; - оборудование с плазменной активацией осаждения; - оборудование с фотонной или лазерной активацией осаждения (обычно коротковолнового/ дальнего/ ультрафиолетового излучения).

КЛАССИФИКАЦИЯ ОБОРУДОВАНИЯ ДЛЯ ХОГФ ПО ВЕЛИЧИНЕ ДАВЛЕНИЯВ РЕАКЦИОННОЙ КАМЕРЕ - системы атмосферного давления (APCVD); -системы пониженного давления (RP), включающие: - системы субатмосферного давления (50 -700 мм. рт. ст. ) (SACVD); -системы низкого давления (10 -2 - 20 мм рт. ст. ) (LPCVD); -системы сверхнизкого давления (10 -6 - 10 -3 мм. рт. ст. ) (UHVCVD). Оборудование с термической активацией процесса осаждения может работать во всех вышеуказанных диапазонах давления. Оборудование в плазменной и фотонной активацией работает только в диапазоне низких давлений.

КЛАССИФИКАЦИЯ ОБОРУДОВАНИЯ ДЛЯ ХОГФ ПО СПОСОБУ НАГРЕВА ПОДЛОЖЕК - системы с резистивным нагревом; - системы с радиационным нагревом; - системы с индукционным нагревом. Резистивный нагрев используется как длянизких, так и для высоких температур. Индукционный - для средних и высоких температур.

КЛАССИФИКАЦИЯ ОБОРУДОВАНИЯ ДЛЯ ХОГФ ПО КОЛИЧЕСТВУ ОБРАБАТЫВАЕМЫХ ПОДЛОЖЕК - системы групповой обработки; - системы поштучной обработки

КЛАССИФИКАЦИЯ ОБОРУДОВАНИЯ ДЛЯ ХОГФ ПО ФОРМЕ РЕАКЦИОННОЙ КАМЕРЫ - трубчатые горизонтальные и вертикальные реакторы; - вертикальные колпаковые реакторы с плоским подложкодержателем; - цилиндрические реакторы; - планарные (плоскопараллельные реакторы); - вертикальный реактор для активации плазмой высокой плотности.

КЛАССИФИКАЦИЯ ОБОРУДОВАНИЯ ДЛЯ ХОГФ ПО ЧАСТОТЕ РАЗРЯДА И СПОСОБУ ГЕНЕРАЦИИ ПЛАЗМЫ - низкочастотные системы с частотой 40 - 440 к. Гц; - высокочастотные системы с частотой 13, 56 и 27, 12 МГц; - системы использующие двойную частоту: высокую и низкую; - СВЧ (микроволновые) системы с частотой 2, 45 ГГц. Обычно НЧ разряд используется в трубчатых горизонтальных реакторах. В планарных реакторах диодного типа используется высокая частота или двойная (смешанная) частота.

ТРУБЧАТЫЙ РЕАКТОР ПОНИЖЕННОГО ДАВЛЕНИЯ С ГОРЯЧИМИ СТЕНКАМИ 1 - кварцевая реакционная труба; 2 -трехзонная резистивная печь; 3 - консольный загрузчик; 4 - кварцевая кассета; 5 - кремниевые пластины; 6 - затвор; 7 - задний фланец; 8 - входной патрубок; 9 - передний фланец; 10 - датчик давления.

РЕАКТОР ПОНИЖЕННОГО ДАВЛЕНИЯ КОЛПАКОВОГО ТИПА С ХОЛОДНЫМИ СТЕНКАМИ 1 - металлический колпак; 2 - подложкодержатель/ ВЧ - электрод; 3 - пластины; 4 - выхлопной патрубок; 5 - входной патрубок.

КОНВЕЙЕРНЫЙ РЕАКТОР АТМОСФЕРНОГО ДАВЛЕНИЯ С ГОРЯЧИМИ СТЕНКАМИ 1 - кремниевые пластины; 2 - конвейер; 3 - нагреватель; 4 - инжекторный блок; 5, 6 - азотный затвор; 7 - выхлопной коллектор
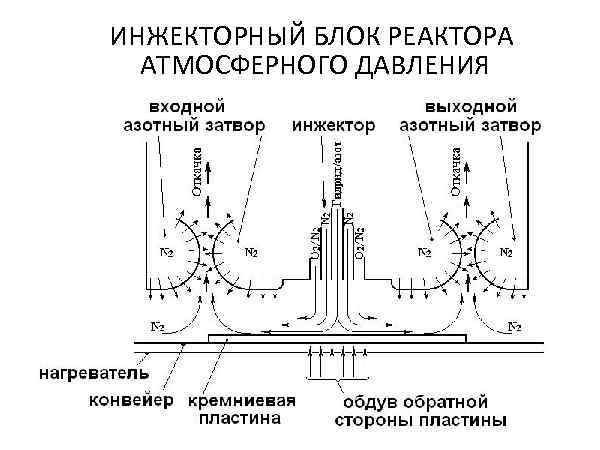
ИНЖЕКТОРНЫЙ БЛОК РЕАКТОРА АТМОСФЕРНОГО ДАВЛЕНИЯ
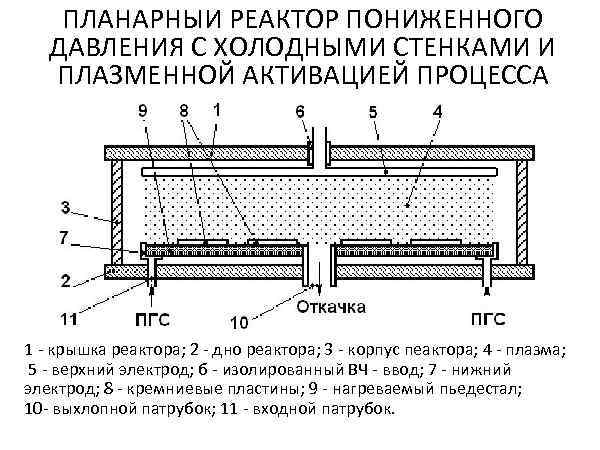
ПЛАНАРНЫИ РЕАКТОР ПОНИЖЕННОГО ДАВЛЕНИЯ С ХОЛОДНЫМИ СТЕНКАМИ И ПЛАЗМЕННОЙ АКТИВАЦИЕЙ ПРОЦЕССА 1 - крышка реактора; 2 - дно реактора; 3 - корпус пеактора; 4 - плазма; 5 - верхний электрод; б - изолированный ВЧ - ввод; 7 - нижний электрод; 8 - кремниевые пластины; 9 - нагреваемый пьедестал; 10 - выхлопной патрубок; 11 - входной патрубок.

УСТАНОВКА ОСАЖДЕНИЯ СЛОЕВ НИТРИДА КРЕМНИЯ И ПОЛИКРИСТАЛЛИЧЕСКОГО КРЕМНИЯ "ИЗОТРОН-4 -150" (НИИТМ, Россия)
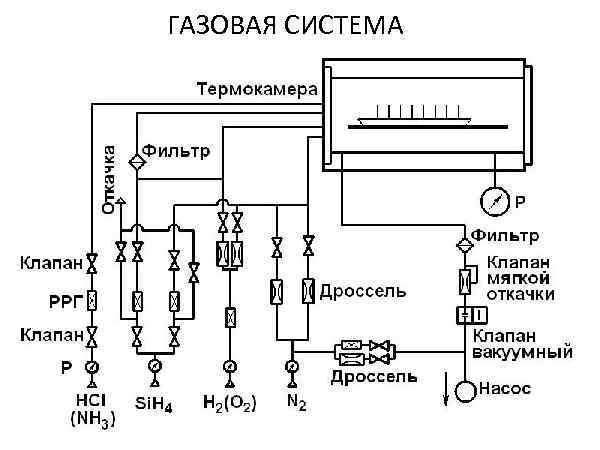
ГАЗОВАЯ СИСТЕМА

ТЕХНИЧЕСКИЕ ХАРАКТЕРИСТИКИ Режим работы автоматический Максимальный диаметр пластин 150 мм Количество реакторов, шт 3 Количество обрабатываемых пластин 150 шт. Диапазон рабочих температур 400 - 900°С Длина рабочей тепловой зоны 800 ± 25 мм Неравномерность распределения температуры - от 400 до 600 °С ± 1. 5°С - свыше 600 до 900 °С ± 1°С Время разогрева электропечи до максимальной рабочей температуры 2 ч. Предельное остаточное давление в реакционных камерах не более 1. 3 Па Диапазон рабочего давления 15 -100 Па Максимальный расход газов на один реактор: N 2 - 7000 л/ч: 02 - 300 л/ч: HCI -120 л/ч Мощность потребления в режиме разогрева не более 75 к. ВА в устоявшемся режиме 900°С не более 55 к. ВА
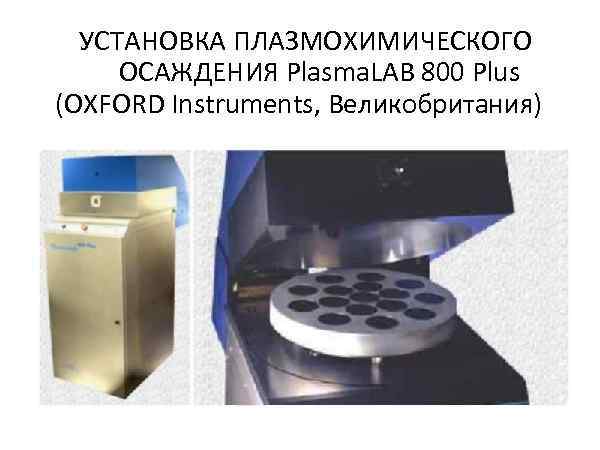
УСТАНОВКА ПЛАЗМОХИМИЧЕСКОГО ОСАЖДЕНИЯ Plasma. LAB 800 Plus (OXFORD Instruments, Великобритания)

КЛАСТЕРНАЯ СИСТЕМА System 1 OO

ОСАЖДЕНИЕ ПЛЁНОК ИЗ РАСТВОРОВ РАСТВОР представляет собой смесь: - кремнийорганического соединения (ТЭОС); - воды; - органических растворителей; - легирующих добавок. Процесс осаждения состоит из следующих стадий: - нанесение плёнкообразующего раствора; - сушка раствора (удаление растворителей); - термообработка-1 (полное удаление растворителей и органических остатков) - термообработка-2 (удаление основной части влаги, разложение неорганических солей и кислот, окончательное формирование окисных плёнок); - термообработка-3 (стеклообразование).

ФУНКЦИОНАЛЬНЫЕ СЛОИ ИЭОТ, ПОЛУЧАЕМЫЕ ОСАЖДЕНИЕМ ПОКРЫТИЙ ИЗ РАСТВОРОВ - примесно-силикатные стекла для диффузии (AI, В, Sb, Ga, Au, Р, Pt, Zn); - межуровневая изоляция; - планаризация топологического рельефа; - пассивация; - антиотражающие покрытия.

ДОСТОИНСТВА МЕТОДА ОСАЖДЕНИЯ ПЛЁНОК ИЗ РАСТВОРОВ 1. ПРОСТОТА процесса и оборудования; 2. Низкая температура процесса; 3. Высокая воспроизводимость процесса; 4. Возможность планаризации рельефа.

МЕТОДЫ НАНЕСЕНИЯ ПЛЁНКООБРАЗУЮЩИХ РАСТВОРОВ 1. Окунание; 2. Полив подложки; 3. Распыление; 4. Центрифугирование.
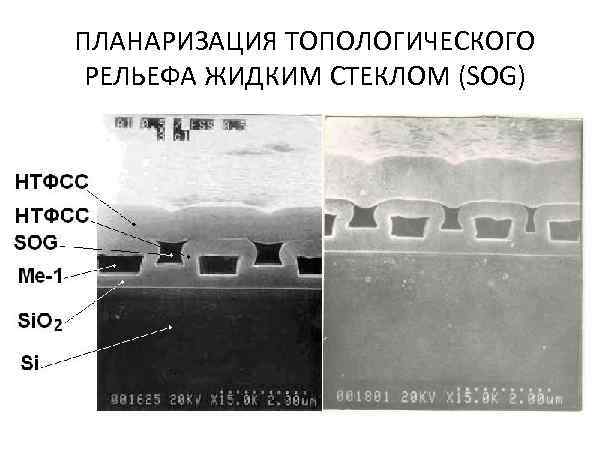
ПЛАНАРИЗАЦИЯ ТОПОЛОГИЧЕСКОГО РЕЛЬЕФА ЖИДКИМ СТЕКЛОМ (SOG)

УСТАНОВКА НАНЕСЕНИЯ SOG TR 6131 (Tazmo Semix, Япония)
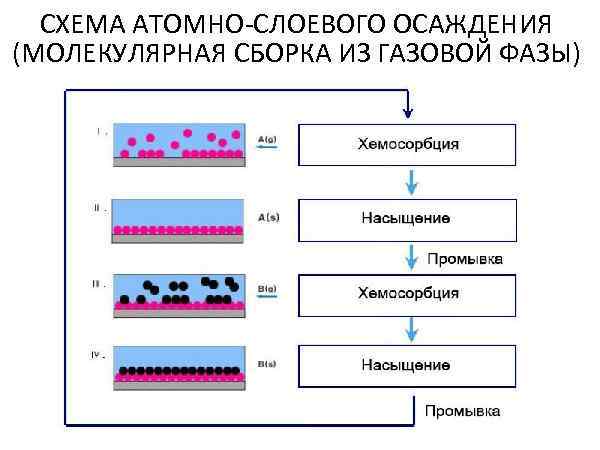
СХЕМА АТОМНО-СЛОЕВОГО ОСАЖДЕНИЯ (МОЛЕКУЛЯРНАЯ СБОРКА ИЗ ГАЗОВОЙ ФАЗЫ)

МЕТОДОМ АТОМНО-СЛОЕВОГО ОСАЖДЕНИЯ МОЖНО ПОЛУЧАТЬ - ЧИСТЫЕ МАТЕРИАЛЫ (С, AI, Si, Ti, Fe, Со, Ni, Ge и др. ) - ОКСИДЫ; - НИТРИДЫ; - СОЕДИНЕНИЯ С: S, Se, Те; -ДРУГИЕ СОЕДИНЕНИЯ.

СРАВНЕНИЕ МЕТОДА АТОМНО-СЛОЕВОГО ОСАЖДЕНИЯ И ХОГФ АТОМНО-СЛОЕВОЕ ХОГФ ОСАЖДЕНИЕ ■ Аналоговый (нм/мин) ■ Дискретный (нм/цикл) ■ Определяется поверхностью параметрами процесса ■ Прецизионность ■ Высокая скорость ■ Использует отдельные осаждения источники для каждого ■ В качестве источников вещества можно использовать ■ Существенное влияние от смеси газодинамических ■ Существенная параметров зависимость от параметров процесса
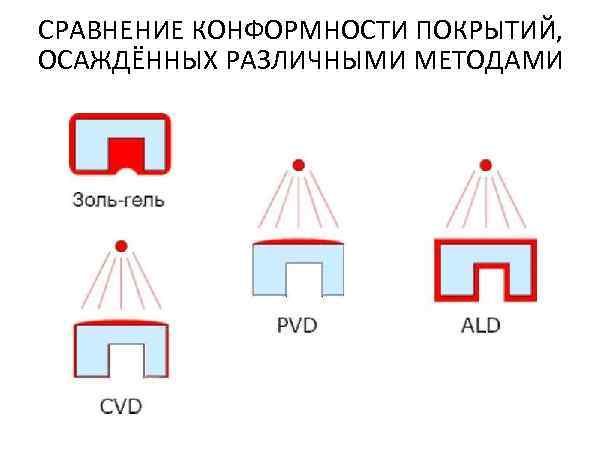
СРАВНЕНИЕ КОНФОРМНОСТИ ПОКРЫТИЙ, ОСАЖДЁННЫХ РАЗЛИЧНЫМИ МЕТОДАМИ
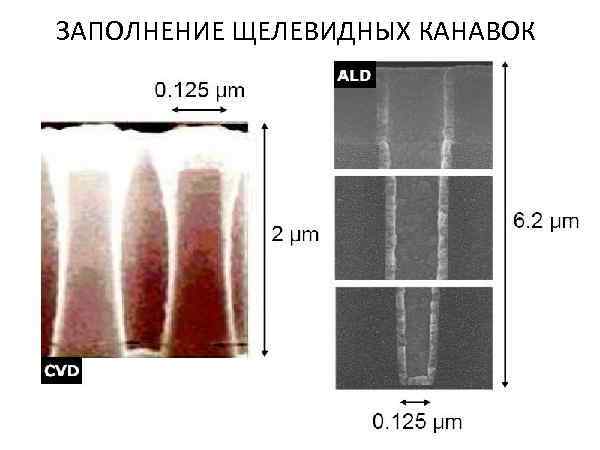
ЗАПОЛНЕНИЕ ЩЕЛЕВИДНЫХ КАНАВОК
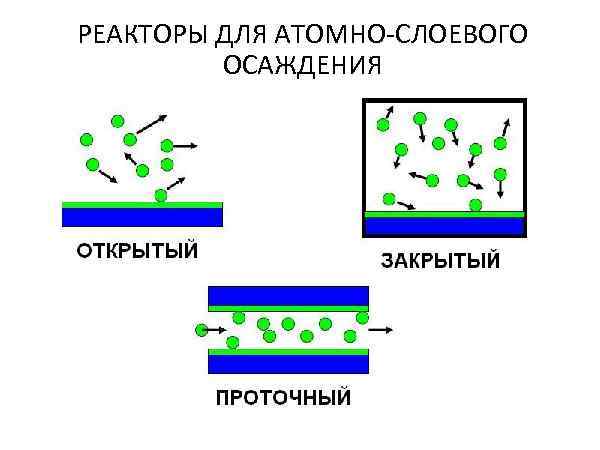
РЕАКТОРЫ ДЛЯ АТОМНО-СЛОЕВОГО ОСАЖДЕНИЯ

УСТАНОВКА АТОМНО-СЛОЕВОГО ОСАЖДЕНИЯ STELLAR (ASM Intl, Нидерланды)
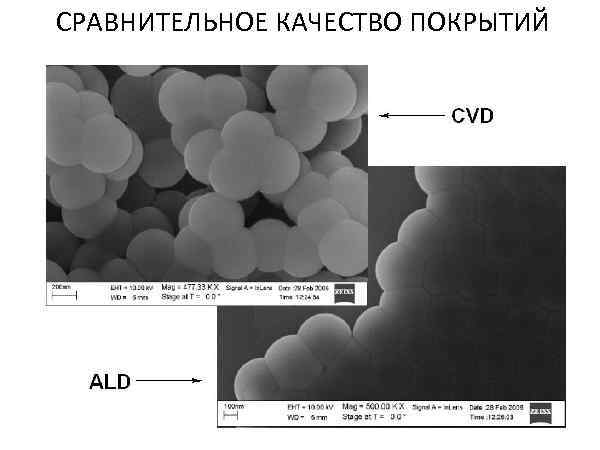
СРАВНИТЕЛЬНОЕ КАЧЕСТВО ПОКРЫТИЙ

ИСПОЛЬЗОВАНИЕ АТОМНО-СЛОЕВОГО ОСАЖДЕНИЯ ПРИ ФОРМИРОВАНИИ ПОДЗАТВОРНОГО ДИЭЛЕКТРИКА
осаждение.ppt
- Количество слайдов: 47

