Cеминар_по_ионной_имплантации.ppt
- Количество слайдов: 33
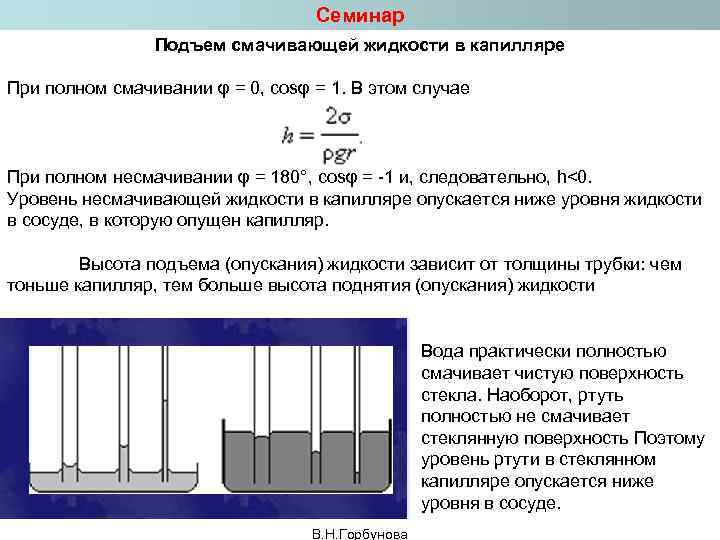 Семинар Подъем смачивающей жидкости в капилляре При полном смачивании φ = 0, cosφ = 1. В этом случае При полном несмачивании φ = 180°, cosφ = -1 и, следовательно, h<0. Уровень несмачивающей жидкости в капилляре опускается ниже уровня жидкости в сосуде, в которую опущен капилляр. Высота подъема (опускания) жидкости зависит от толщины трубки: чем тоньше капилляр, тем больше высота поднятия (опускания) жидкости Вода практически полностью смачивает чистую поверхность стекла. Наоборот, ртуть полностью не смачивает стеклянную поверхность Поэтому уровень ртути в стеклянном капилляре опускается ниже уровня в сосуде. В. Н. Горбунова
Семинар Подъем смачивающей жидкости в капилляре При полном смачивании φ = 0, cosφ = 1. В этом случае При полном несмачивании φ = 180°, cosφ = -1 и, следовательно, h<0. Уровень несмачивающей жидкости в капилляре опускается ниже уровня жидкости в сосуде, в которую опущен капилляр. Высота подъема (опускания) жидкости зависит от толщины трубки: чем тоньше капилляр, тем больше высота поднятия (опускания) жидкости Вода практически полностью смачивает чистую поверхность стекла. Наоборот, ртуть полностью не смачивает стеклянную поверхность Поэтому уровень ртути в стеклянном капилляре опускается ниже уровня в сосуде. В. Н. Горбунова
 Семинар Расчет распределения примеси в случае двойной последовательной диффузии. Если ведется двойная последовательная диффузия акцепторной примеси с параметрами Соа, Da, tа, а затем донорной примеси с параметрами Сод, Dд, ta в полупроводник с электропроводностью n-типа, равномерно легированный примесью с концентрацией Св, то суммарное распределение концентрации имеет вид Первая диффузия является более глубокой, последующая — более мелкой, но с более высокой концентрацией, поэтому при двойной последовательной диффузии будут получены структуры n-p-n согласно формуле или р-n-р, если поменять местами типы примесей. Подобное распределение является типичным при получении структуры диффузионного транзистора. В. Н. Горбунова
Семинар Расчет распределения примеси в случае двойной последовательной диффузии. Если ведется двойная последовательная диффузия акцепторной примеси с параметрами Соа, Da, tа, а затем донорной примеси с параметрами Сод, Dд, ta в полупроводник с электропроводностью n-типа, равномерно легированный примесью с концентрацией Св, то суммарное распределение концентрации имеет вид Первая диффузия является более глубокой, последующая — более мелкой, но с более высокой концентрацией, поэтому при двойной последовательной диффузии будут получены структуры n-p-n согласно формуле или р-n-р, если поменять местами типы примесей. Подобное распределение является типичным при получении структуры диффузионного транзистора. В. Н. Горбунова
 Семинар Расчет распределения примеси в случае двойной последовательной диффузии. Для определения глубины залегания эмиттерного р-n-перехода приравняем суммарную концентрацию нулю и учтем, что Св во много раз меньше концентраций диффундирующих доноров и акцепторов. Тогда для распределения Воспользуемся аппроксимацией erfc-фуикции: Преобразуя данное выражение, получим В. Н. Горбунова
Семинар Расчет распределения примеси в случае двойной последовательной диффузии. Для определения глубины залегания эмиттерного р-n-перехода приравняем суммарную концентрацию нулю и учтем, что Св во много раз меньше концентраций диффундирующих доноров и акцепторов. Тогда для распределения Воспользуемся аппроксимацией erfc-фуикции: Преобразуя данное выражение, получим В. Н. Горбунова
 Семинар Расчет распределения примеси в случае двойной последовательной диффузии. Это уравнение решим методом итерации, принимая за начальное значение тогда Уточненное значение глубины залегания эмиттерного р-n-перехода Преобразуя данное выражение, получим Глубина залегания коллекторного перехода: В. Н. Горбунова
Семинар Расчет распределения примеси в случае двойной последовательной диффузии. Это уравнение решим методом итерации, принимая за начальное значение тогда Уточненное значение глубины залегания эмиттерного р-n-перехода Преобразуя данное выражение, получим Глубина залегания коллекторного перехода: В. Н. Горбунова
 Семинар Диффузия примеси из ионно-имплантированного слоя. Ионная имплантация используется для предварительной загонки строго фиксированного количества примеси с высокой воспроизводимостью от процесса к процессу и высокой однородностью распределения по поверхности облучаемых пластин профиль распределения внедренных атомов описывается кривой Гаусса: Максимум концентрации примеси в отличие от случая введения ее методом диффузии залегает не на поверхности, а на глубине х =Rp N-поверхностная плотность внедренных атомов 1/см 2 , Q-доза облучения, е- заряд одного иона, n- кратность ионизации В. Н. Горбунова
Семинар Диффузия примеси из ионно-имплантированного слоя. Ионная имплантация используется для предварительной загонки строго фиксированного количества примеси с высокой воспроизводимостью от процесса к процессу и высокой однородностью распределения по поверхности облучаемых пластин профиль распределения внедренных атомов описывается кривой Гаусса: Максимум концентрации примеси в отличие от случая введения ее методом диффузии залегает не на поверхности, а на глубине х =Rp N-поверхностная плотность внедренных атомов 1/см 2 , Q-доза облучения, е- заряд одного иона, n- кратность ионизации В. Н. Горбунова
 Семинар Диффузия примеси из ионно-имплантированного слоя. Глубина залегания р-n-перехода: При извлечении корня следует учитывать оба знака. Поскольку максимум распределения залегает в объеме полупроводника, то возможно одновременное образование двух р-n переходов, разделенных базовым слоем, Пример 1 Рассчитать характеристики замедления ионов при имплантации, параметры распределения заданной примеси в кремнии используя симметричное распределение Гаусса. № Примесь Энергия, варианта кэ. В Доза, мк. Кл/см 2 Концентрация примеси в исходном кремнии 1 B 40 1016 2 P 100 150 1015 В. Н. Горбунова
Семинар Диффузия примеси из ионно-имплантированного слоя. Глубина залегания р-n-перехода: При извлечении корня следует учитывать оба знака. Поскольку максимум распределения залегает в объеме полупроводника, то возможно одновременное образование двух р-n переходов, разделенных базовым слоем, Пример 1 Рассчитать характеристики замедления ионов при имплантации, параметры распределения заданной примеси в кремнии используя симметричное распределение Гаусса. № Примесь Энергия, варианта кэ. В Доза, мк. Кл/см 2 Концентрация примеси в исходном кремнии 1 B 40 1016 2 P 100 150 1015 В. Н. Горбунова
 Семинар Характеристики кремния и германия, необходимые для расчета Материал Атомный номер Z Атомная масса М г/моль Число атомов в ед. объема, × 1022 1/см 2 Si 14 28 5, 04 Ge 32 72, 6 4, 53 Коэффициенты, учитывающие торможение, обусловленное взаимодействуем, В. Н. Горбунова электронным
Семинар Характеристики кремния и германия, необходимые для расчета Материал Атомный номер Z Атомная масса М г/моль Число атомов в ед. объема, × 1022 1/см 2 Si 14 28 5, 04 Ge 32 72, 6 4, 53 Коэффициенты, учитывающие торможение, обусловленное взаимодействуем, В. Н. Горбунова электронным
 Семинар Расчет профилей распределения концентрации внедренных примесей в структурах с двойной имплантацией Для создания транзистора типа n-р-n в эпитаксиальный слой с электропроводностью n-типа производят последовательную имплантацию ионов акцепторной примеси с энергией Eа и дозой Nа для формирования базовой области и ионов донорной примеси с энергией Ед , и дозой Nд, для формирования эмиттера, причем Rpa>Rpд, а Сmax a
Семинар Расчет профилей распределения концентрации внедренных примесей в структурах с двойной имплантацией Для создания транзистора типа n-р-n в эпитаксиальный слой с электропроводностью n-типа производят последовательную имплантацию ионов акцепторной примеси с энергией Eа и дозой Nа для формирования базовой области и ионов донорной примеси с энергией Ед , и дозой Nд, для формирования эмиттера, причем Rpa>Rpд, а Сmax a
 Семинар = откуда где Глубину залегания эммитерного перехода с учетом того, определяем из условия В. Н. Горбунова
Семинар = откуда где Глубину залегания эммитерного перехода с учетом того, определяем из условия В. Н. Горбунова
 Семинар откуда где Для ориентировочного расчета более просто глубину залегания эмиттерного перехода можно оценить, исходя из равенства В. Н. Горбунова
Семинар откуда где Для ориентировочного расчета более просто глубину залегания эмиттерного перехода можно оценить, исходя из равенства В. Н. Горбунова
 Семинар Задача Глубина проникновения в вещество характеризуется пробегом. Траектория отдельных ионов в кристалле подобны ломанным линиям, каждый прямолинейный участок и полная длина которых отличаются друг от друга. Вся совокупность пробегов отдельных ионов группируется по закону нормального распределения случайной величины со значением среднего полного пробега R и среднеквадратичным отклонением пробега R. Практическую важность имеет средний нормальный пробег Rp – проекция траектории среднего полного пробега на направление первоначальной скорости иона и его среднеквадратичное отклонение Rp. Для расчета среднего полного пробега R (см) иона с энергией Е (э. В) используют формулы, в которых энергия и пробег выражены в безразмерных единицах и соответственно: В. Н. Горбунова
Семинар Задача Глубина проникновения в вещество характеризуется пробегом. Траектория отдельных ионов в кристалле подобны ломанным линиям, каждый прямолинейный участок и полная длина которых отличаются друг от друга. Вся совокупность пробегов отдельных ионов группируется по закону нормального распределения случайной величины со значением среднего полного пробега R и среднеквадратичным отклонением пробега R. Практическую важность имеет средний нормальный пробег Rp – проекция траектории среднего полного пробега на направление первоначальной скорости иона и его среднеквадратичное отклонение Rp. Для расчета среднего полного пробега R (см) иона с энергией Е (э. В) используют формулы, в которых энергия и пробег выражены в безразмерных единицах и соответственно: В. Н. Горбунова
 Семинар Здесь L — нормирующий множитель пробега, см -1; F — нормирующий множитель энергии, 1/э. В. Радиус экранирования заряда ядра атомными электронами (см) В. Н. Горбунова
Семинар Здесь L — нормирующий множитель пробега, см -1; F — нормирующий множитель энергии, 1/э. В. Радиус экранирования заряда ядра атомными электронами (см) В. Н. Горбунова
 Семинар Коэффициент передачи ионом с массой М 1 атому с массой М 2 максимально возможной энергии при лобовом столкновении: Коэффициенты, учитывающие торможение, обусловленное электронным взаимодействием, Параметры, учитывающие торможение, обусловленные ядерным взаимодействием, с=0. 45, d=0. 3. Собственная концентрация атомов в кристалле N 2, см-3, заряды ядер иона Z 1, атомов мишени Z 2. В. Н. Горбунова
Семинар Коэффициент передачи ионом с массой М 1 атому с массой М 2 максимально возможной энергии при лобовом столкновении: Коэффициенты, учитывающие торможение, обусловленное электронным взаимодействием, Параметры, учитывающие торможение, обусловленные ядерным взаимодействием, с=0. 45, d=0. 3. Собственная концентрация атомов в кристалле N 2, см-3, заряды ядер иона Z 1, атомов мишени Z 2. В. Н. Горбунова
 Семинар Средний нормальный пробег и стандартное отклонение пробега. Средний нормальный пробег связан со средним полным пробегом Корректирующая поправка, обусловленная упругим рассеянием иона, где полная энергия, затраченная на упругое рассеяние иона, В. Н. Горбунова
Семинар Средний нормальный пробег и стандартное отклонение пробега. Средний нормальный пробег связан со средним полным пробегом Корректирующая поправка, обусловленная упругим рассеянием иона, где полная энергия, затраченная на упругое рассеяние иона, В. Н. Горбунова
 Семинар Взаимодействие иона с атомами мишени носит случайный характер. Моноэнергетический пучок ионов после прохождения некоторого слоя вещества приобретает дисперсию по энергиям. В результате часть ионов проходит половину своего пути без заметных потерь энергии и проникает на глубину, превышающую RP, а часть ионов испытывает более сильное торможение и останавливается, не дойдя до Rp. Стандартное среднеквадратичное отклонение нормального пробега В. Н. Горбунова
Семинар Взаимодействие иона с атомами мишени носит случайный характер. Моноэнергетический пучок ионов после прохождения некоторого слоя вещества приобретает дисперсию по энергиям. В результате часть ионов проходит половину своего пути без заметных потерь энергии и проникает на глубину, превышающую RP, а часть ионов испытывает более сильное торможение и останавливается, не дойдя до Rp. Стандартное среднеквадратичное отклонение нормального пробега В. Н. Горбунова
 Семинар Ядерная тормозная способность Sn(ε): при где с=0, 45, d=0, 3 В. Н. Горбунова
Семинар Ядерная тормозная способность Sn(ε): при где с=0, 45, d=0, 3 В. Н. Горбунова
 Коэффициенты диффузии и энергии активации для некоторых примесей в кремнии. Акцепторы Доноры Элемент Do, см 2/с Eа, э. В Бор 5, 1 3, 7 Фосфор 3, 85 3, 66 Алюминий 1, 385 3, 39 Мышьяк 24 4, 08 Индий 0, 785 3, 63 Сурьма 12, 9 3, 98 Галлий 0, 374 3, 41 Висмут 1, 08 3, 85 В. Н. Горбунова
Коэффициенты диффузии и энергии активации для некоторых примесей в кремнии. Акцепторы Доноры Элемент Do, см 2/с Eа, э. В Бор 5, 1 3, 7 Фосфор 3, 85 3, 66 Алюминий 1, 385 3, 39 Мышьяк 24 4, 08 Индий 0, 785 3, 63 Сурьма 12, 9 3, 98 Галлий 0, 374 3, 41 Висмут 1, 08 3, 85 В. Н. Горбунова
 Максимальная растворимость некоторых примесей в кремнии. Элемент Максимальная растворимость, ат/см 3 Температура максимальной растворимости, о. С Алюминий 2* 1019 1150 Бор 4* 1020 1200 Висмут 8* 1017 1300 Галлий 4* 1019 1250 Индий 1019 1300 Мышьяк 2* 1021 1150 Сурьма 8* 1019 1300 Фосфор 1, 3* 1021 1150 В. Н. Горбунова
Максимальная растворимость некоторых примесей в кремнии. Элемент Максимальная растворимость, ат/см 3 Температура максимальной растворимости, о. С Алюминий 2* 1019 1150 Бор 4* 1020 1200 Висмут 8* 1017 1300 Галлий 4* 1019 1250 Индий 1019 1300 Мышьяк 2* 1021 1150 Сурьма 8* 1019 1300 Фосфор 1, 3* 1021 1150 В. Н. Горбунова
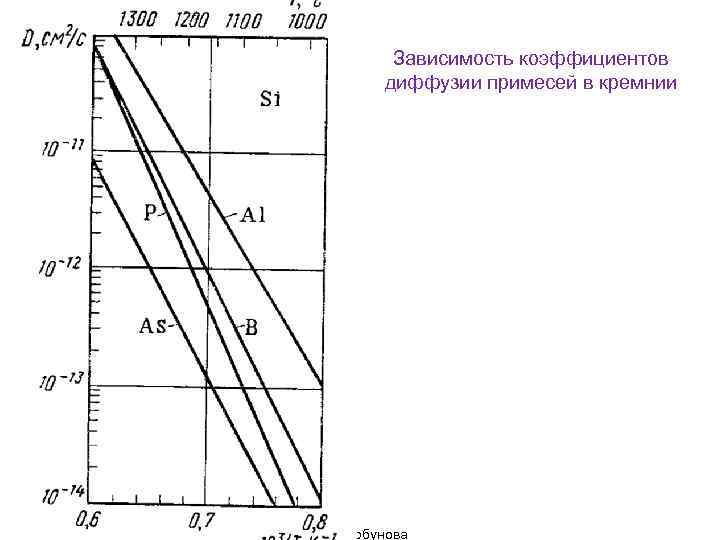 Зависимость коэффициентов диффузии примесей в кремнии В. Н. Горбунова
Зависимость коэффициентов диффузии примесей в кремнии В. Н. Горбунова
 Предельная растворимость примесей в кремнии. В. Н. Горбунова
Предельная растворимость примесей в кремнии. В. Н. Горбунова
 Предельная растворимость примесей в кремнии. В. Н. Горбунова
Предельная растворимость примесей в кремнии. В. Н. Горбунова
 В. Н. Горбунова
В. Н. Горбунова
 1. Раскройте сущность термина «эпитаксия» . 2. Приведите классификацию эпитаксиальных процессов. 3. При каких условиях можно использовать положение о поверхностном псевдоморфизме? 4. Какие методы получения эпитаксиальных структур Вам известны ? Приведите сравнительную характеристику. 5. Раскройте сущность метода молекулярно-лучевой эпитаксии. Приведите блоксхему установки. 6. Кратко охарактеризуйте метод газофазной эпитаксии. Приведите основные типы реакций. В. Н. Горбунова
1. Раскройте сущность термина «эпитаксия» . 2. Приведите классификацию эпитаксиальных процессов. 3. При каких условиях можно использовать положение о поверхностном псевдоморфизме? 4. Какие методы получения эпитаксиальных структур Вам известны ? Приведите сравнительную характеристику. 5. Раскройте сущность метода молекулярно-лучевой эпитаксии. Приведите блоксхему установки. 6. Кратко охарактеризуйте метод газофазной эпитаксии. Приведите основные типы реакций. В. Н. Горбунова
 Пробеги и дисперсии пробегов ионов примеси кремнии В. Н. Горбунова
Пробеги и дисперсии пробегов ионов примеси кремнии В. Н. Горбунова
 Расчет дозы облучения, необходимой для получения заданной концентрации примеси. Так как профиль распределения концентрации внедренной примеси описывается кривой Гаусса, то для ее, построения необходимо знать средний нормальный пробег Rр, среднеквадратичное отклонение пробега ΔRр и дозу облучения N. Обычно все три параметра неизвестны. Известными являются глубина залегания р-n-перехода xj максимальная концентрация примеси Сmах и концентрация примеси в исходной пластине полупроводника Св. Выражение для глубины залегания р-n-перехода формулы В. Н. Горбунова найдем из
Расчет дозы облучения, необходимой для получения заданной концентрации примеси. Так как профиль распределения концентрации внедренной примеси описывается кривой Гаусса, то для ее, построения необходимо знать средний нормальный пробег Rр, среднеквадратичное отклонение пробега ΔRр и дозу облучения N. Обычно все три параметра неизвестны. Известными являются глубина залегания р-n-перехода xj максимальная концентрация примеси Сmах и концентрация примеси в исходной пластине полупроводника Св. Выражение для глубины залегания р-n-перехода формулы В. Н. Горбунова найдем из
 Дозу облучения рассчитаем из соотношения Для определения стандартного отклонения пробегов ΔRP используем графическое решение. Зададим несколько значений энергии, найдем для них ΔRP и Rp и построим зависимость правой части уравнения ( от энергии. Затем параллельно оси энергий проведем прямую на уровне заданного значения xj, т. е. построим левую часть уравнения. Точка пересечения правой и левой частей уравнения определяет искомую энергию E. Для найденной энергии рассчитаем стандартное отклонение пробега ΔЯp и вычислим дозу облучения. В. Н. Горбунова
Дозу облучения рассчитаем из соотношения Для определения стандартного отклонения пробегов ΔRP используем графическое решение. Зададим несколько значений энергии, найдем для них ΔRP и Rp и построим зависимость правой части уравнения ( от энергии. Затем параллельно оси энергий проведем прямую на уровне заданного значения xj, т. е. построим левую часть уравнения. Точка пересечения правой и левой частей уравнения определяет искомую энергию E. Для найденной энергии рассчитаем стандартное отклонение пробега ΔЯp и вычислим дозу облучения. В. Н. Горбунова
 Пример 6. Определить энергию ионов и дозу облучения, необходимые для создания р-n-перехода на глубине xj=0. 3 мкм с помощью имплантации фосфора в кремний с электропроводностью р-типа и с Св = 1016 см-3, если необходимо обеспечить Сmax = 5∙ 1019 см-3 1. Согласно уравнению 2. Построим зависимость RР + 4, 12ΔRР от энергии в диапазоне 80— 150 кэ. В, пользуясь данными табл. На том же рисунке проведем линию x. J=0, 3 мкм и по точке пересечения определим E=113 кэ. В. Для практических целей более удобно задавать энергию ионов кратной 5 или 10 кэ. В. Принимаем E=110 кэ. В. Н. Горбунова
Пример 6. Определить энергию ионов и дозу облучения, необходимые для создания р-n-перехода на глубине xj=0. 3 мкм с помощью имплантации фосфора в кремний с электропроводностью р-типа и с Св = 1016 см-3, если необходимо обеспечить Сmax = 5∙ 1019 см-3 1. Согласно уравнению 2. Построим зависимость RР + 4, 12ΔRР от энергии в диапазоне 80— 150 кэ. В, пользуясь данными табл. На том же рисунке проведем линию x. J=0, 3 мкм и по точке пересечения определим E=113 кэ. В. Для практических целей более удобно задавать энергию ионов кратной 5 или 10 кэ. В. Принимаем E=110 кэ. В. Н. Горбунова
 2. Построим зависимость RР + 4, 12ΔRР от энергии в диапазоне 80— 150 кэ. В, пользуясь данными табл. На том же рисунке проведем линию x. J=0, 3 мкм и по точке пересечения определим E=113 кэ. В. Для практических целей более удобно задавать энергию ионов кратной 5 или 10 кэ. В. Принимаем E=110 кэ. В. Графическое определение энергии ионов В. Н. Горбунова
2. Построим зависимость RР + 4, 12ΔRР от энергии в диапазоне 80— 150 кэ. В, пользуясь данными табл. На том же рисунке проведем линию x. J=0, 3 мкм и по точке пересечения определим E=113 кэ. В. Для практических целей более удобно задавать энергию ионов кратной 5 или 10 кэ. В. Принимаем E=110 кэ. В. Графическое определение энергии ионов В. Н. Горбунова
 3. Интерполируя данные, найдем, что для Е=110 кэ. В Rp= 136 нм, ΔRp=38 нм. 4. Найдем дозу облучения: =2, 5∙ 3, 8∙ 10 -6 ∙ 5∙ 1019=4, 751014 cм-2 В. Н. Горбунова
3. Интерполируя данные, найдем, что для Е=110 кэ. В Rp= 136 нм, ΔRp=38 нм. 4. Найдем дозу облучения: =2, 5∙ 3, 8∙ 10 -6 ∙ 5∙ 1019=4, 751014 cм-2 В. Н. Горбунова
 Расчет режимов имплаитации для создания структуры. транзисторной Создание структуры n-р-n-транзистора на кремнии с толщиной базовой области ω = 0. 1 мкм, глубиной залегания эмиттерного перехода Xjэ = 0, 2 мкм, концентрацией доноров Св =2∙ 1016 см-3 и максимальными концентрациями акцепторной и донорной примесей Сmaxа = 3∙ 1018, Сmax d = 1∙ 1020 см-3. Создание эмиттерной и базовой областей производится имплантацией фосфора и бора соответственно. Режимы ионной имплантации определяются дозами Na, Nд и энергиями Eа , Eд. Данная задача в общем виде не решается, поэтому введем ряд упрощающих соотношений. 1. Запишем выражение для глубины залегания коллекторного р-nперехода: В. Н. Горбунова
Расчет режимов имплаитации для создания структуры. транзисторной Создание структуры n-р-n-транзистора на кремнии с толщиной базовой области ω = 0. 1 мкм, глубиной залегания эмиттерного перехода Xjэ = 0, 2 мкм, концентрацией доноров Св =2∙ 1016 см-3 и максимальными концентрациями акцепторной и донорной примесей Сmaxа = 3∙ 1018, Сmax d = 1∙ 1020 см-3. Создание эмиттерной и базовой областей производится имплантацией фосфора и бора соответственно. Режимы ионной имплантации определяются дозами Na, Nд и энергиями Eа , Eд. Данная задача в общем виде не решается, поэтому введем ряд упрощающих соотношений. 1. Запишем выражение для глубины залегания коллекторного р-nперехода: В. Н. Горбунова
 = Rpa+3, 16ΔR pa Для ионов с массами М 1 и М 2 в диапазоне энергий 20 -100 кэ. В справедливо приближенное соотношение между пробегом и стандартным отклонением пробега или Поэтому Xjk= Rpa+3, 16 откуда В. Н. Горбунова
= Rpa+3, 16ΔR pa Для ионов с массами М 1 и М 2 в диапазоне энергий 20 -100 кэ. В справедливо приближенное соотношение между пробегом и стандартным отклонением пробега или Поэтому Xjk= Rpa+3, 16 откуда В. Н. Горбунова
 Пользуясь табл. , принимаем Еа=40 кэ. В, тогда Rpa =0, 161 мкм, ΔRpa = 0, 0538 мкм. Следовательно Xjk= 0, 161+3, 12∙ 0, 058 =0, 33 мкм Различие с требуемым значением хjк не повышает 10%. Что допустимо. 2. доза облучения ионами бора В. Н. Горбунова
Пользуясь табл. , принимаем Еа=40 кэ. В, тогда Rpa =0, 161 мкм, ΔRpa = 0, 0538 мкм. Следовательно Xjk= 0, 161+3, 12∙ 0, 058 =0, 33 мкм Различие с требуемым значением хjк не повышает 10%. Что допустимо. 2. доза облучения ионами бора В. Н. Горбунова
 3. Приближенное выражение для глубины залегания эмипериого р-n-перехода . В. Н. Горбунова
3. Приближенное выражение для глубины залегания эмипериого р-n-перехода . В. Н. Горбунова


