f006f97ea9c6e45f75c727bd2c7134fd.ppt
- Количество слайдов: 29

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Разработки лаборатории НМСТ СПб. ПУ MEMS devices of laboratory NMST SPb. PU А. Н. Казакин A. N. Kazakin Санкт-Петербург, ОНТИ СПб. ПУ, НИЛ «НМСТ» St. Petersburg, Joint Institute of Science and Technology SPb. PU, Laboratory Nano & Microsystems Technology Санкт-Петербург – 2016
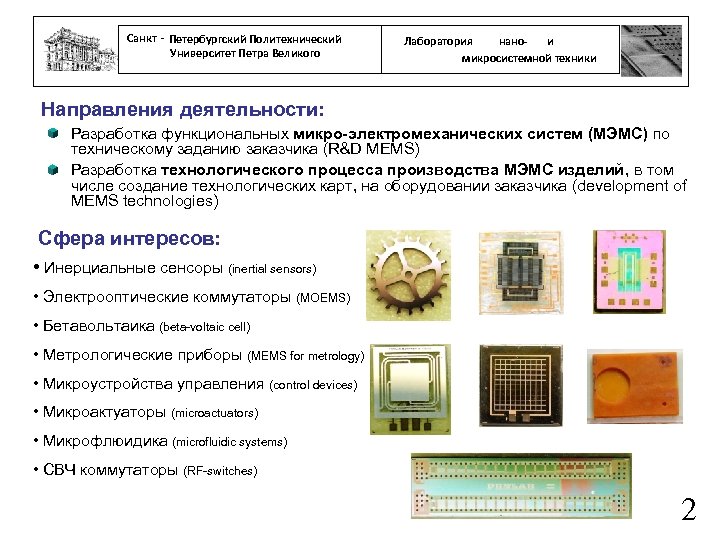
Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Направления деятельности: Разработка функциональных микро-электромеханических систем (МЭМС) по техническому заданию заказчика (R&D MEMS) Разработка технологического процесса производства МЭМС изделий, в том числе создание технологических карт, на оборудовании заказчика (development of MEMS technologies) Сфера интересов: • Инерциальные сенсоры (inertial sensors) • Электрооптические коммутаторы (MOEMS) • Бетавольтаика (beta-voltaic cell) • Метрологические приборы (MEMS for metrology) • Микроустройства управления (control devices) • Микроактуаторы (microactuators) • Микрофлюидика (microfluidic systems) • СВЧ коммутаторы (RF-switches) 2

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Технология «кремний-на-стекле» (Silicon-on-glass) МЭМС, создаваемые по технологии КНС (MEMS on SOI wafers) Гироскопы и акселерометры (gyro & accelerometer) Электромеханические реле (electromechanical switch) Электрооптические коммутаторы (MOEMS switch) Микроманипуляторы (microactuator) Микроклапана (microvalve) Переменные конденсаторы (variable capacitors) Ячейки энергонезависимой памяти (PI memory) 3

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники МИКРООПТОЭЛЕКТРОМЕХАНИЧЕСКИЙ ПЕРЕКЛЮЧАТЕЛЬ ОПТИЧЕСКОГО ИЗЛУЧЕНИЯ (MOEMS Switch) (Optical fiber) (Vertical micromirror) Размер чипа 5 x 5 мм (chip size 5 x 5 mm); Толщина кремниевой структуры 100 мкм (height of silicon structure 100 μm); Ширина торсионов 8 мкм, длина ~ 2 мм (torsions width – 8 μm, length – 2000 μm) 4

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Результаты моделирования параметров оптического коммутатора (Simulation in COMSOL Multiphysics) • Общее перемещение зеркала – 120 мкм (total mirror shift – 120 μm) • Управляющее напряжение – 100 В (switch voltage – 100 V) Карта смещений (torsions displacement) Зависимость статического усилия, развиваемого приводом как функция от перекрытия зубцов Распределение потенциала между зубьями привода (potential distribution in electrostatic comb drive) 5
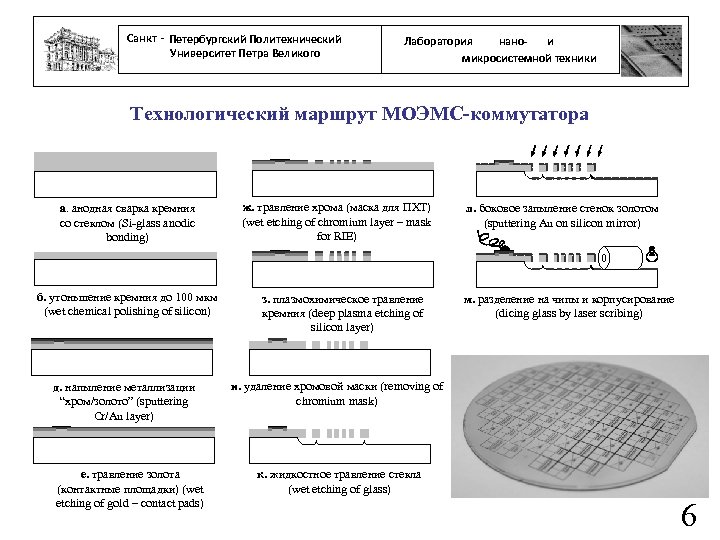
Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Технологический маршрут МОЭМС-коммутатора а. анодная сварка кремния со стеклом (Si-glass anodic bonding) б. утоньшение кремния до 100 мкм (wet chemical polishing of silicon) д. напыление металлизации “хром/золото” (sputtering Cr/Au layer) е. травление золота (контактные площадки) (wet etching of gold – contact pads) ж. травление хрома (маска для ПХТ) (wet etching of chromium layer – mask for RIE) з. плазмохимическое травление кремния (deep plasma etching of silicon layer) л. боковое запыление стенок золотом (sputtering Au on silicon mirror) м. разделение на чипы и корпусирование (dicing glass by laser scribing) и. удаление хромовой маски (removing of chromium mask) к. жидкостное травление стекла (wet etching of glass) 6
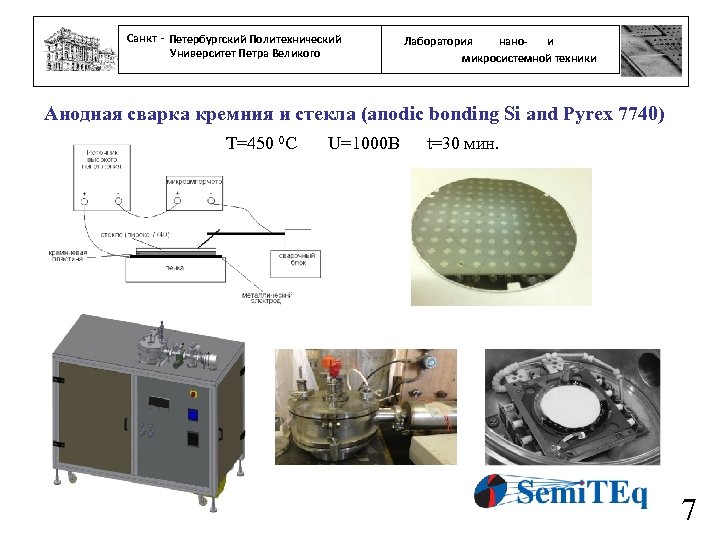
Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Анодная сварка кремния и стекла (anodic bonding Si and Pyrex 7740) T=450 0 C U=1000 В t=30 мин. 7

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Химическое утоньшение кремниевой пластины Обработка в щелочном растворе с добавкой окислителя при 100 о. С (chemical polishing of silicon wafer by hot alkaline etching with adding of oxidized agent) - быстрый процесс (fast etching) скорость травления ~ 4, 5 мкм/мин - низкая шероховатость поверхности (low roughness of silicon surface) - остановка по времени травления (time control etch-stop) 8

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Нанесение металлизации и маски для плазменного травления (metallization and mask for RIE) - Напыление слоя Cr/Au (0, 5 мкм) (magnetron sputtering of gold metallization layer) - Фотолитография контактных площадок (photolithography and etching of contact pads) - Нанесение маскирующего слоя для ПХТ (mask for deep RIE): хром (Cr) h = 0, 1 мкм алюминий (Al) h = 0, 2 мкм фоторезист (resist ma-1275) h > 5 мкм диоксид кремния (Si. O 2) h > 1 мкм - Фотолитография по маскирующему слою (photolithography and etching of RIE mask) 9

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Глубокое анизотропное плазменное травление кремния (Deep silicon RIE etching in Bosch-process) - НИИИС, Нижний Новгород (Oxford Plasma. Lab 100) - МИЭТ, Зеленоград (Oxford Plasma. Lab 100) - ИМИ РАН, Ярославль - Semiteq, Санкт-Петербург - Гирооптика, Санкт-Петербург (Oxford Estrella) Блок-схема реактора ВЧ-индукционного разряда (ИМИРАН, Ярославль) 10
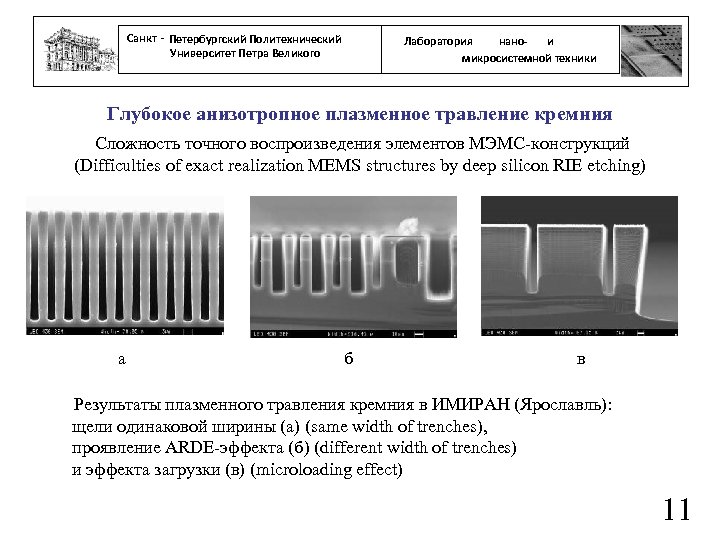
Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Глубокое анизотропное плазменное травление кремния Сложность точного воспроизведения элементов МЭМС-конструкций (Difficulties of exact realization MEMS structures by deep silicon RIE etching) а б в Результаты плазменного травления кремния в ИМИРАН (Ярославль): щели одинаковой ширины (а) (same width of trenches), проявление ARDE-эффекта (б) (different width of trenches) и эффекта загрузки (в) (microloading effect) 11
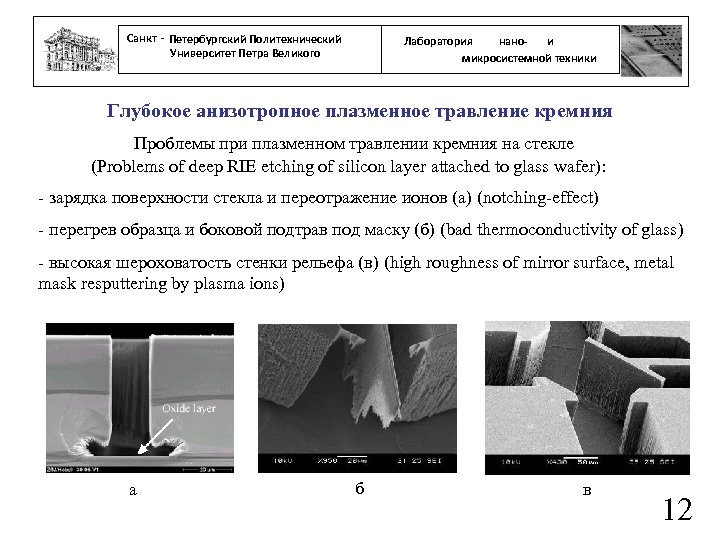
Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Глубокое анизотропное плазменное травление кремния Проблемы при плазменном травлении кремния на стекле (Problems of deep RIE etching of silicon layer attached to glass wafer): - зарядка поверхности стекла и переотражение ионов (а) (notching-effect) - перегрев образца и боковой подтрав под маску (б) (bad thermoconductivity of glass) - высокая шероховатость стенки рельефа (в) (high roughness of mirror surface, metal mask resputtering by plasma ions) а б в 12

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Фрагменты изготовленного оптического коммутатора после жидкостного травления стекла (View of MOEMS switch after RIE of silicon and wet etching of glass) • Общее перемещение зеркала – 120 мкм • Управляющее напряжение – 100 В 13

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники ИНЕРЦИАЛЬНЫЕ СЕНСОРЫ (Inertial Sensors) Размер чипа 5 x 5 мм (chip size 5 x 5 mm); Толщина кремниевой структуры 50 мкм (h. Si = 50 μm) www. gyro. ru www. mems. ru Чувствительный элемент датчика угловых скоростей (MEMS gyroscope) Чувствительный элемент акселерометра (MEMS accelerometer) 14

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники ИНЕРЦИАЛЬНЫЕ СЕНСОРЫ (Inertial Sensors) (в сотрудничестве с ЗАО «Гирооптика» , Санкт-Петербург) Микрогироскопы Микроакселерометры Плата БИЧЭ-М Дрейф нулевого сигнала 0, 3 mg динамический диапазон 100 g нелинейность - не более 0, 3% Дрейф нулевого сигнала 5 град. /час динамический диапазон 360 град. /с нелинейность - не более 0, 5% Изделие БИНС-М Погрешность определения углов ориентации - не более 5 угл. мин Погрешность определения координат - не более 10 м за 60 с движения объекта www. gyro. ru Устойчивость к ударам до 16000 g www. mems. ru 15
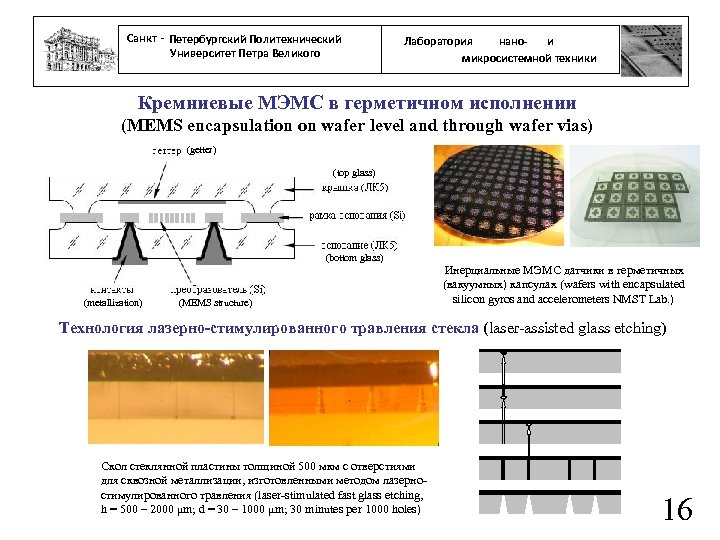
Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Кремниевые МЭМС в герметичном исполнении (MEMS encapsulation on wafer level and through wafer vias) (getter) (top glass) (bottom glass) (metallization) (MEMS structure) Инерциальные МЭМС датчики в герметичных (вакуумных) капсулах (wafers with encapsulated silicon gyros and accelerometers NMST Lab. ) Технология лазерно-стимулированного травления стекла (laser-assisted glass etching) Скол стеклянной пластины толщиной 500 мкм с отверстиями для сквозной металлизации, изготовленными методом лазерностимулированного травления (laser-stimulated fast glass etching, h = 500 – 2000 μm; d = 30 – 1000 μm; 30 minutes per 1000 holes) 16
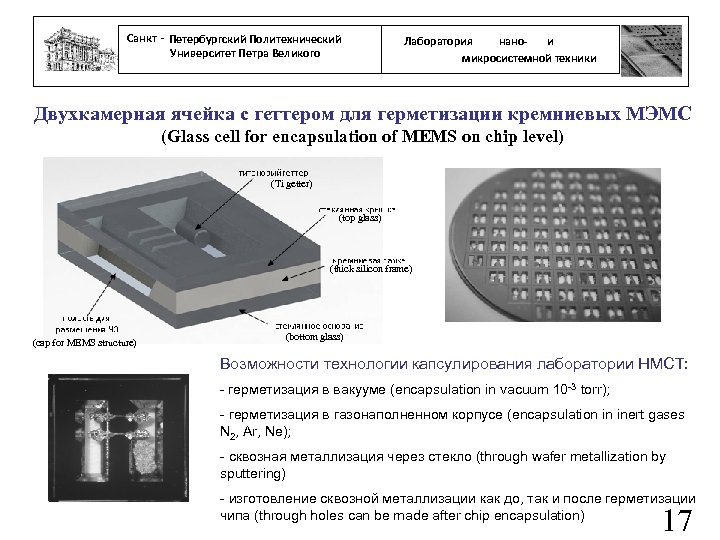
Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Двухкамерная ячейка с геттером для герметизации кремниевых МЭМС (Glass cell for encapsulation of MEMS on chip level) (Ti getter) (top glass) (thick silicon frame) (cap for MEMS structure) (bottom glass) Возможности технологии капсулирования лаборатории НМСТ: - герметизация в вакууме (encapsulation in vacuum 10 -3 torr); - герметизация в газонаполненном корпусе (encapsulation in inert gases N 2, Ar, Ne); - сквозная металлизация через стекло (through wafer metallization by sputtering) - изготовление сквозной металлизации как до, так и после герметизации чипа (through holes can be made after chip encapsulation) 17

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники ТЕПЛОВЫЕ ДАТЧИКИ (Thermal sensors) Тепловой микропреобразователь Две 20 -элементные термопары (thermopiles) Кремниевый чип 2, 5*3*0, 4 мм 8 миллиграмм Мембрана из чередующихся слоев Si. O 2 и Si 3 N 4 Механическая прочность Поликремниевые термопары Нагреватель 100 Ом (heater) Мембрана толщина 1 мкм Датчик – прототип для Высокая термо. ЭДС и стабильность Нагреватель с низким ТКС Линейность преобразования микрорасходомера вакуумметра инклинометра акселерометра термоанемометра 18

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Тепловой преобразователь переменного напряжения (Thermal AC-DC converter) Вторичный эталон для ВНИИ Метрологии Частотный диапазон (frequency range) 10 Hz … 1 MHz Входное напряжение (input voltage) 1 V Выходное напряжение (output voltage) 100 m. V Точность измерения (accuracy) 10 -5 % 1 -е поколение 2 -е поколение 3 -е поколение 19

Санкт - Петербургский Политехнический Университет Петра Великого корпусирование Modif - Flat -16 TO-8 нанои Лаборатория микросистемной техники МНОГОФУНКЦИОНАЛЬНЫЕ ТЕПЛОВЫЕ ПРЕОБРАЗОВАТЕЛИ 3101. 8 Non standard Modif 155. 36 -2 20

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Тепловой преобразователь – ИНКЛИНОМЕТР (inclinometer) Отклонение от вертикали Диапазон углов +/- 90 o Точность 1% Принцип действия Конвекция в замкнутом объеме (Convection in closed volume) 21
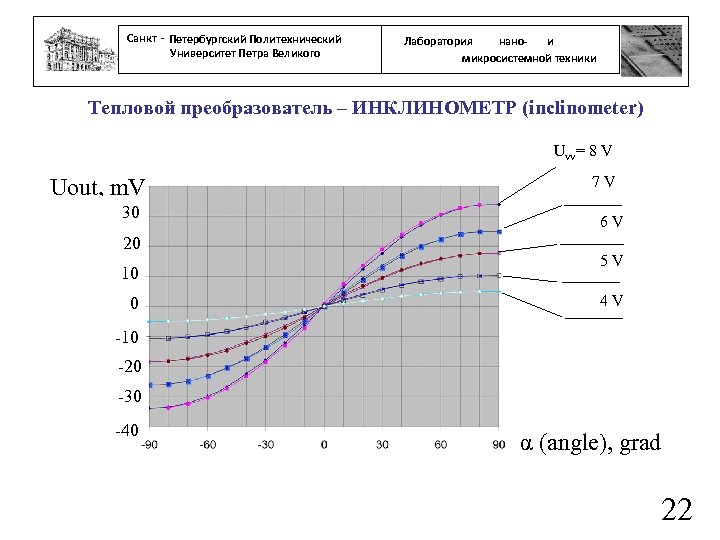
Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Тепловой преобразователь – ИНКЛИНОМЕТР (inclinometer) Uvv= 8 V Uout, m. V 30 20 10 0 7 V 6 V 5 V 4 V -10 -20 -30 -40 α (angle), grad 22

St. Petersburg State Polytechnical University NMST Laboratory Тепловой датчик – АКСЕЛЕРОМЕТР (accelerometer) Не требуется сложная электроника для обработки сигнала 23
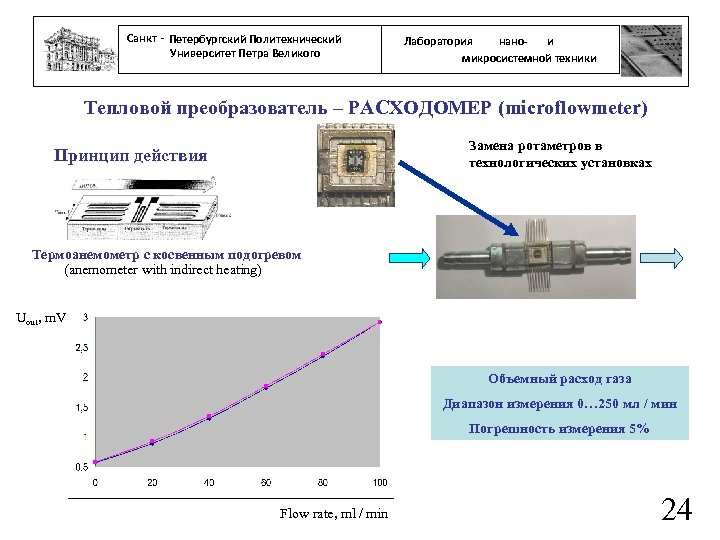
Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Тепловой преобразователь – РАСХОДОМЕР (microflowmeter) Замена ротаметров в технологических установках Принцип действия Термоанемометр с косвенным подогревом (anemometer with indirect heating) Uout, m. V Объемный расход газа Диапазон измерения 0… 250 мл / мин Погрешность измерения 5% Flow rate, ml / min 24

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники МЭМС - датчики для летательных микроаппаратов «Датчик- прототип» Тепловой микропреобразователь Тепловой акселерометр Термоанемометр с косвенным подогревом датчики истинной воздушной скорости датчики отрыва потока Тепловой инклинометр Инерциальная навигационная система Датчики крена и тангажа 25

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники ТЕПЛОВОЙ ДАТЧИК ВАКУУМЕТРА (Vacuum meter) 26

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Технологические возможности лаборатории: Компьютерное моделирование электрофизических характеристик МЭМС и изготовление фотошаблонов (программные платформы AUTOCAD и Solid. Works, ANSYS и специализированные пакеты Coventor и COMSOL Multiphysics) (CAD, computer simulation of MEMS parameters) • Стандартные технологии микроэлектроники (фотолитография, вакуумное напыление, химическое и плазменное травление, лазерная и дисковая резка, монтаж кристаллов и т. д. ) (Standard CMOS technologies: photolithography, vacuum sputtering, wet and dry etching, dicing, packaging) • Технологии поверхностной и объемной микромеханики (bulk and surface MEMS technology): Глубокое щелочное травление кремния (deep alkaline etching of silicon) Электрохимическое травление (electrochemical etching) Микрогальваника (galvanic Ni, Cu, Pb, Sn) Фотолитография по толстым резистам (SU-8 photolithography) Анодная сварка кремния и стекла (anodic bonding) Лазерная микрообработка металлов и диэлектриков (laser micromachining) Специфические технологии микрообработки (special micromachining): Технология пористого кремния (porous silicon technology) Технология фоточувствительных стекол (technology of photosensitive glasses) Лазерно-стимулируемое травление стекла (laser-stimulated glass etching) Электроэрозия стекла (electroerosion of glass) Механическая 3 D-обработка (mechanical 3 D-micromachining) 27

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Примеры некоторых микроустройств лаборатории НМСТ: Кремниевые микроиглы для биомедицины Silicon microneedles Микроанализатор ионного потока Ion Energy Micro Analyzer Зонд из фотоситалла для аэродинамических исследований Microprobe for aerodynamic research Galvanic nickel grids h = 60 μm Тепловые микропреобразователи Thermal sensors Сферы применения: вакууметр, акселерометр, инклинометр, термоанемометр, микрорасходомер Эталон для калибровки гелиевых течеискателей Diffusion leak for helium leakage (Range flow 10 -6 - 10 -10 m 3*Pa / s) Diffusion of boron in n-Si Pickling of a relief Oxidation Anisotropic etching 28

Санкт - Петербургский Политехнический Университет Петра Великого нанои Лаборатория микросистемной техники Санкт-Петербург, ОНТИ СПб. ПУ, НИЛ «НМСТ» St. Petersburg, Joint Institute of Science and Technology SPb. PU, Laboratory Nano & Microsystems Technology Тел. : 8 (812) 550 -03 -72 Сайт: www. mems. ru Эл. почта: pen@mems. ru Пятышев Евгений Нилович, заведующий лабораторией Pyatyshev Evgenyi, pen. mems@gmail. com Казакин Алексей Николаевич, научный сотрудник Kazakin Aleksei, +7 (921) 998 -38 -23 29
f006f97ea9c6e45f75c727bd2c7134fd.ppt