4. ПЭМ, РЭМ.ppt
- Количество слайдов: 23
 Просвечивающий и Растровый и электронные микроскопы
Просвечивающий и Растровый и электронные микроскопы
 Просвечивающий электронный микроскоп (ПЭМ) (TEM) Электро нный микроско п — микроскоп, отличающийся возможностью получать сильно увеличенное изображение объектов, используя для их «освещения» электроны. В отличие от оптического микроскопа, в электронном микроскопе используют потоки электронов и магнитные или электростатические линзы. Некоторые электронные микроскопы позволяют увеличивать изображение в 2 млн. раз, в то время как максимальное увеличение лучших оптических микроскопов достигает 2000 раз. Как электронные, так и оптические микроскопы имеют ограничения в разрешающей способности в зависимости от длины волн. В электронных микроскопах используются электростатические или электромагнитные линзы для формирования изображения путем управления пучком электронов и концентрации его на отдельных участках изображения подобно тому, как оптический микроскоп использует стеклянные линзы для фокусирования света на (или сквозь) изображении.
Просвечивающий электронный микроскоп (ПЭМ) (TEM) Электро нный микроско п — микроскоп, отличающийся возможностью получать сильно увеличенное изображение объектов, используя для их «освещения» электроны. В отличие от оптического микроскопа, в электронном микроскопе используют потоки электронов и магнитные или электростатические линзы. Некоторые электронные микроскопы позволяют увеличивать изображение в 2 млн. раз, в то время как максимальное увеличение лучших оптических микроскопов достигает 2000 раз. Как электронные, так и оптические микроскопы имеют ограничения в разрешающей способности в зависимости от длины волн. В электронных микроскопах используются электростатические или электромагнитные линзы для формирования изображения путем управления пучком электронов и концентрации его на отдельных участках изображения подобно тому, как оптический микроскоп использует стеклянные линзы для фокусирования света на (или сквозь) изображении.

 История создания электронного микроскопа Создание ПЭМ связано с успехам в области теоретической и экспериментальной физики и обязано открытием электрона с его волновыми свойствами. Прямым намёком на такую возможность явилась гипотеза волновой природы электрона, выдвинутая в 1924 году Луи де Бройлем и экспериментально подтвержденная в 1927 году К. Дэвиссоном и Л. Джермером в США и Дж. Томсоном в Англии. Это привело к созданию основ электронной оптики. Главным приложениям электронной оптики являлось изобретение и создание Электронного микроскопа в 1930 -х годах, построенного по аналогии, по законам волновой оптики, но с применением электрических и магнитных полей для фокусировки электронных лучей. В 1931 году Р. Руденберг получил патент на просвечивающий электронный микроскоп (ПЭМ), а в 1932 году М. Кнолль и Э. Руска построили первый просвечивающий микроскоп, применив магнитные линзы для фокусировки электронов. (Э. Руска за данный вклад стал лауреатом Нобелевской премии по физике за 1986 год). Растровый (или сканнирующий) электронный микроскоп (РЭМ) (или СЭМ) был изобретен в 1952 Чарльзом Отли. И лишь после ряда технических усовершенствований он был внедрен в производство в середине 1960 -х годов.
История создания электронного микроскопа Создание ПЭМ связано с успехам в области теоретической и экспериментальной физики и обязано открытием электрона с его волновыми свойствами. Прямым намёком на такую возможность явилась гипотеза волновой природы электрона, выдвинутая в 1924 году Луи де Бройлем и экспериментально подтвержденная в 1927 году К. Дэвиссоном и Л. Джермером в США и Дж. Томсоном в Англии. Это привело к созданию основ электронной оптики. Главным приложениям электронной оптики являлось изобретение и создание Электронного микроскопа в 1930 -х годах, построенного по аналогии, по законам волновой оптики, но с применением электрических и магнитных полей для фокусировки электронных лучей. В 1931 году Р. Руденберг получил патент на просвечивающий электронный микроскоп (ПЭМ), а в 1932 году М. Кнолль и Э. Руска построили первый просвечивающий микроскоп, применив магнитные линзы для фокусировки электронов. (Э. Руска за данный вклад стал лауреатом Нобелевской премии по физике за 1986 год). Растровый (или сканнирующий) электронный микроскоп (РЭМ) (или СЭМ) был изобретен в 1952 Чарльзом Отли. И лишь после ряда технических усовершенствований он был внедрен в производство в середине 1960 -х годов.
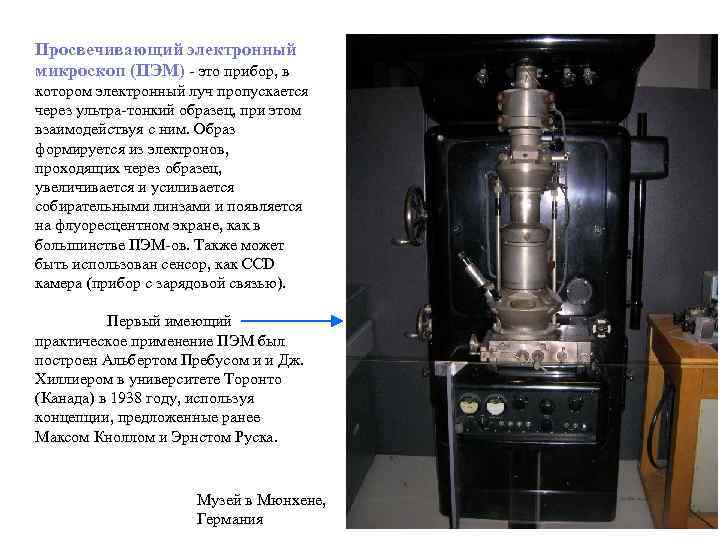 Просвечивающий электронный микроскоп (ПЭМ) - это прибор, в котором электронный луч пропускается через ультра-тонкий образец, при этом взаимодействуя с ним. Образ формируется из электронов, проходящих через образец, увеличивается и усиливается собирательными линзами и появляется на флуоресцентном экране, как в большинстве ПЭМ-ов. Также может быть использован сенсор, как CCD камера (прибор с зарядовой связью). Первый имеющий практическое применение ПЭМ был построен Альбертом Пребусом и и Дж. Хиллиером в университете Торонто (Канада) в 1938 году, используя концепции, предложенные ранее Максом Кноллом и Эрнстом Руска. Музей в Мюнхене, Германия
Просвечивающий электронный микроскоп (ПЭМ) - это прибор, в котором электронный луч пропускается через ультра-тонкий образец, при этом взаимодействуя с ним. Образ формируется из электронов, проходящих через образец, увеличивается и усиливается собирательными линзами и появляется на флуоресцентном экране, как в большинстве ПЭМ-ов. Также может быть использован сенсор, как CCD камера (прибор с зарядовой связью). Первый имеющий практическое применение ПЭМ был построен Альбертом Пребусом и и Дж. Хиллиером в университете Торонто (Канада) в 1938 году, используя концепции, предложенные ранее Максом Кноллом и Эрнстом Руска. Музей в Мюнхене, Германия
 Магнитная линза Поскольку оптическая сила такой линзы, т. е. способность фокусировать электроны, зависит от напряженности магнитного поля вблизи оси, для ее увеличения желательно сконцентрировать магнитное поле в минимально возможном объеме. Практически это достигается тем, что катушку почти полностью закрывают магнитной "броней" из специального никель-кобальтового сплава, оставляя лишь узкий зазор в ее внутренней части. Создаваемое таким образом магнитное поле может быть в 10 -100 тыс. раз более сильным, чем магнитное поле Земли.
Магнитная линза Поскольку оптическая сила такой линзы, т. е. способность фокусировать электроны, зависит от напряженности магнитного поля вблизи оси, для ее увеличения желательно сконцентрировать магнитное поле в минимально возможном объеме. Практически это достигается тем, что катушку почти полностью закрывают магнитной "броней" из специального никель-кобальтового сплава, оставляя лишь узкий зазор в ее внутренней части. Создаваемое таким образом магнитное поле может быть в 10 -100 тыс. раз более сильным, чем магнитное поле Земли.
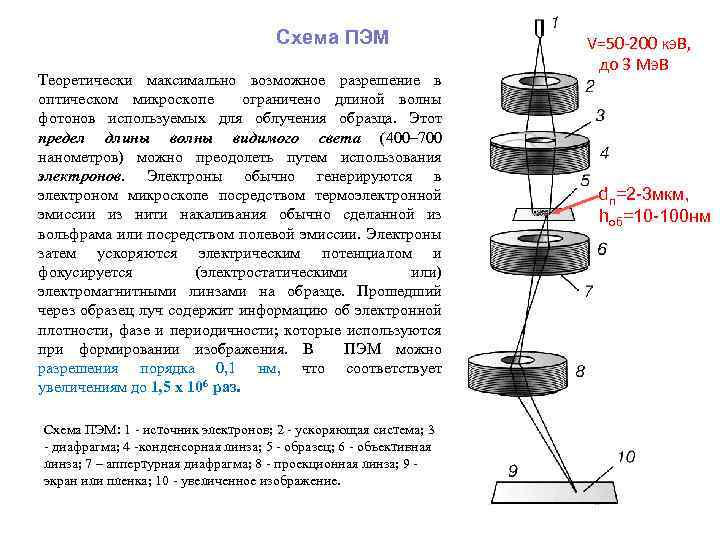 Схема ПЭМ Теоретически максимально возможное разрешение в оптическом микроскопе ограничено длиной волны фотонов используемых для облучения образца. Этот предел длины волны видимого света (400– 700 нанометров) можно преодолеть путем использования электронов. Электроны обычно генерируются в электроном микроскопе посредством термоэлектронной эмиссии из нити накаливания обычно сделанной из вольфрама или посредством полевой эмиссии. Электроны затем ускоряются электрическим потенциалом и фокусируется (электростатическими или) электромагнитными линзами на образце. Прошедший через образец луч содержит информацию об электронной плотности, фазе и периодичности; которые используются при формировании изображения. В ПЭМ можно разрешения порядка 0, 1 нм, что соответствует увеличениям до 1, 5 х 106 раз. Схема ПЭМ: 1 - источник электронов; 2 - ускоряющая система; 3 - диафрагма; 4 -конденсорная линза; 5 - образец; 6 - объективная линза; 7 – аппертурная диафрагма; 8 - проекционная линза; 9 - экран или пленка; 10 - увеличенное изображение. V=50 -200 кэ. В, до 3 Мэ. В dп=2 -3 мкм, hоб=10 -100 нм
Схема ПЭМ Теоретически максимально возможное разрешение в оптическом микроскопе ограничено длиной волны фотонов используемых для облучения образца. Этот предел длины волны видимого света (400– 700 нанометров) можно преодолеть путем использования электронов. Электроны обычно генерируются в электроном микроскопе посредством термоэлектронной эмиссии из нити накаливания обычно сделанной из вольфрама или посредством полевой эмиссии. Электроны затем ускоряются электрическим потенциалом и фокусируется (электростатическими или) электромагнитными линзами на образце. Прошедший через образец луч содержит информацию об электронной плотности, фазе и периодичности; которые используются при формировании изображения. В ПЭМ можно разрешения порядка 0, 1 нм, что соответствует увеличениям до 1, 5 х 106 раз. Схема ПЭМ: 1 - источник электронов; 2 - ускоряющая система; 3 - диафрагма; 4 -конденсорная линза; 5 - образец; 6 - объективная линза; 7 – аппертурная диафрагма; 8 - проекционная линза; 9 - экран или пленка; 10 - увеличенное изображение. V=50 -200 кэ. В, до 3 Мэ. В dп=2 -3 мкм, hоб=10 -100 нм
 Разрешение ПЭМ Де Бройлевская длина волны частицы: l = h/mv =h/p, где m-масса и v - скорость частицы, h – постоянная Планка. Длина волны де Бройля электрона после прохождения им ускоряющего потенциала U : l = h/Ö (2 me. U) Так для U = 150 В, l = 1 Å !!! Из тории дифракции предел разрешения ПЭМ: D = 0, 5 l/sin(r/f), где r =20 мкм – радиус апертурной диафрагмы, f =2 мм –фокусное расстояние. Для 100 кэ. В (l = 0, 037 Å) получаем D @ 2 Å. Кроме того аппертурная диафрагма повышаент контраст изображения: если r- , то контраст -¯. f r
Разрешение ПЭМ Де Бройлевская длина волны частицы: l = h/mv =h/p, где m-масса и v - скорость частицы, h – постоянная Планка. Длина волны де Бройля электрона после прохождения им ускоряющего потенциала U : l = h/Ö (2 me. U) Так для U = 150 В, l = 1 Å !!! Из тории дифракции предел разрешения ПЭМ: D = 0, 5 l/sin(r/f), где r =20 мкм – радиус апертурной диафрагмы, f =2 мм –фокусное расстояние. Для 100 кэ. В (l = 0, 037 Å) получаем D @ 2 Å. Кроме того аппертурная диафрагма повышаент контраст изображения: если r- , то контраст -¯. f r
 Катоды эмиттеры электронов
Катоды эмиттеры электронов
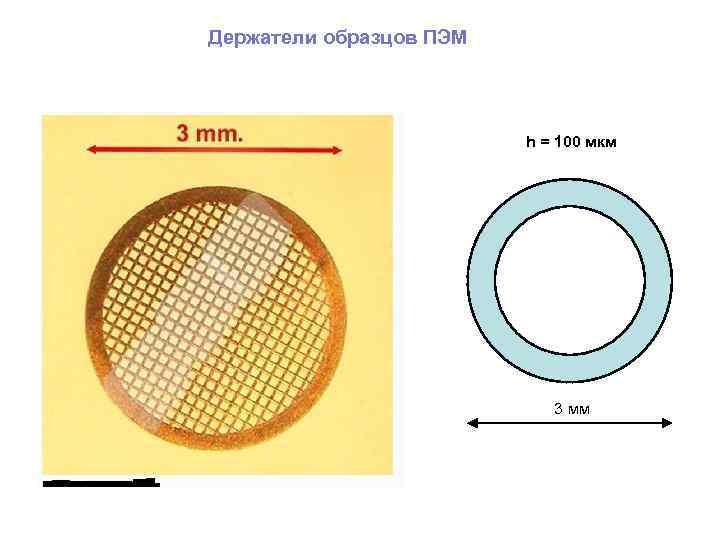 Держатели образцов ПЭМ h = 100 мкм 3 мм
Держатели образцов ПЭМ h = 100 мкм 3 мм
 Особенности наблюдения и подготовки образцов для ПЭМ и ТЭМ 1. Электропроводящая поверхность образца 2. Светло-польное изображение - увелич. изображение микроструктуры, сформированное электронами, прошедшими через объект с малыми энергетич. потерями - структура изображается на экране электроннолучевой трубки темными линиями и пятнами на светлом фоне; 3. Хроматическая аберрация - снижение скорости электронов после просвечивания объекта, приводящее к ухудшению разрешения; усиливается с увеличением толщины объекта; 4. Металлы исследуют в виде получаемой химическим или ионным травлением ультратонкой фольги. 5. Ультрамикротом (ультратом) - прибор для получения ультратонких (0, 010, 1 мкм) срезов объектов с помощью стеклянных или алмазных ножей; 6. Оттенение - физич. контрастирование микрочастиц, макромолекул, вирусов, состоящее в том, что на образец в вакуумной установке напыляется тонкая пленка металла; при этом "тени" (ненапыленные участки) прорисовывают контуры частиц и позволяют измерять их высоту ; 7. Химич. контрастирование - очень тонкие (не более 0, 01 мкм) пленки и срезы, повышая их контраст обработкой соед. тяжелых металлов (Os, U, Pb и др. ), к-рые избирательно взаимод. с компонентами микроструктуры 8. Реплика - тонкая, прозрачная для электронов пленка из полимерного материала либо аморфного углерода, повторяющая микрорельеф массивного объекта или его скола. 9. Эмульсий и биол. ткани с большим содержанием воды может быть исследована методами криорепликации или криоультратомия (-150 °С );
Особенности наблюдения и подготовки образцов для ПЭМ и ТЭМ 1. Электропроводящая поверхность образца 2. Светло-польное изображение - увелич. изображение микроструктуры, сформированное электронами, прошедшими через объект с малыми энергетич. потерями - структура изображается на экране электроннолучевой трубки темными линиями и пятнами на светлом фоне; 3. Хроматическая аберрация - снижение скорости электронов после просвечивания объекта, приводящее к ухудшению разрешения; усиливается с увеличением толщины объекта; 4. Металлы исследуют в виде получаемой химическим или ионным травлением ультратонкой фольги. 5. Ультрамикротом (ультратом) - прибор для получения ультратонких (0, 010, 1 мкм) срезов объектов с помощью стеклянных или алмазных ножей; 6. Оттенение - физич. контрастирование микрочастиц, макромолекул, вирусов, состоящее в том, что на образец в вакуумной установке напыляется тонкая пленка металла; при этом "тени" (ненапыленные участки) прорисовывают контуры частиц и позволяют измерять их высоту ; 7. Химич. контрастирование - очень тонкие (не более 0, 01 мкм) пленки и срезы, повышая их контраст обработкой соед. тяжелых металлов (Os, U, Pb и др. ), к-рые избирательно взаимод. с компонентами микроструктуры 8. Реплика - тонкая, прозрачная для электронов пленка из полимерного материала либо аморфного углерода, повторяющая микрорельеф массивного объекта или его скола. 9. Эмульсий и биол. ткани с большим содержанием воды может быть исследована методами криорепликации или криоультратомия (-150 °С );
 The 200 k. V FEI – ТЕМ, SEM Разрешение 0, 1 0, 2 нм
The 200 k. V FEI – ТЕМ, SEM Разрешение 0, 1 0, 2 нм
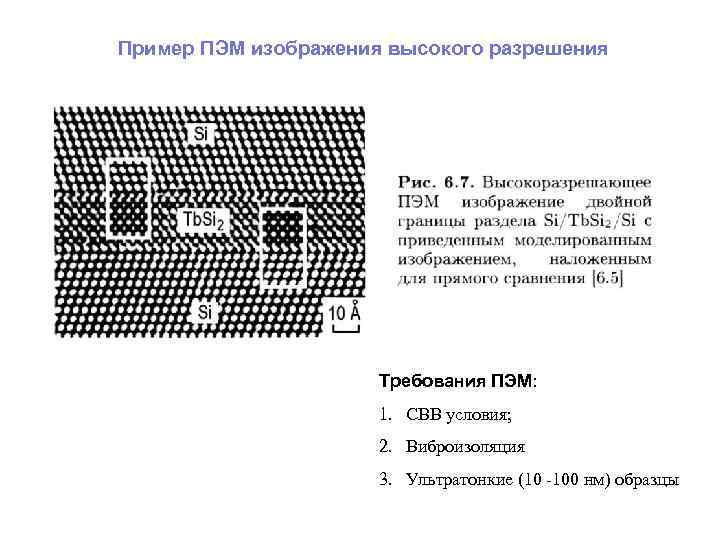 Пример ПЭМ изображения высокого разрешения Требования ПЭМ: 1. СВВ условия; 2. Виброизоляция 3. Ультратонкие (10 -100 нм) образцы
Пример ПЭМ изображения высокого разрешения Требования ПЭМ: 1. СВВ условия; 2. Виброизоляция 3. Ультратонкие (10 -100 нм) образцы
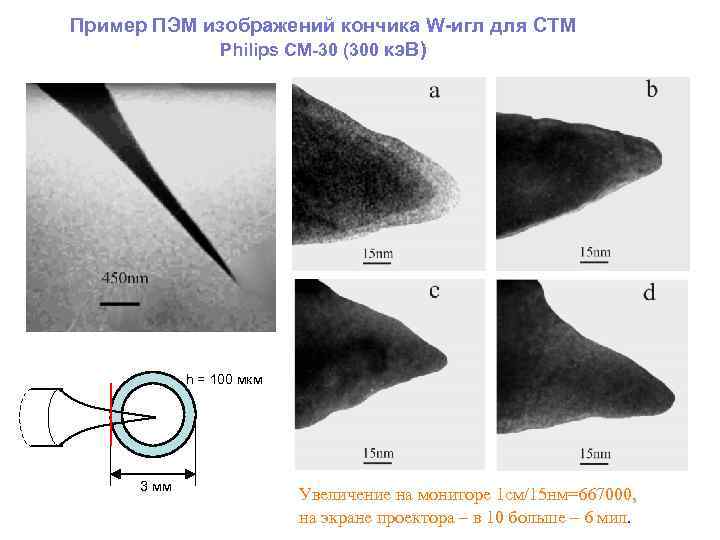 Пример ПЭМ изображений кончика W-игл для СТМ Philips CM-30 (300 кэ. В) h = 100 мкм 3 мм Увеличение на мониторе 1 см/15 нм=667000, на экране проектора – в 10 больше – 6 мил.
Пример ПЭМ изображений кончика W-игл для СТМ Philips CM-30 (300 кэ. В) h = 100 мкм 3 мм Увеличение на мониторе 1 см/15 нм=667000, на экране проектора – в 10 больше – 6 мил.
 Электронография – дифракция электронов высокой энергии ПЭМ 1. Электронный пучок сфокусирован на образце; 2. На экране – дифракционная картина; Пример дифракционной картины ПЭМ от монокристаллического кочнчика W иглы для СТМ
Электронография – дифракция электронов высокой энергии ПЭМ 1. Электронный пучок сфокусирован на образце; 2. На экране – дифракционная картина; Пример дифракционной картины ПЭМ от монокристаллического кочнчика W иглы для СТМ
 Пример дифракционной картины ПЭМ от текстуры In 2 Se 3 Дифракционная картина от текстуры (частично ориентированные кристаллиты) In 2 Se 3.
Пример дифракционной картины ПЭМ от текстуры In 2 Se 3 Дифракционная картина от текстуры (частично ориентированные кристаллиты) In 2 Se 3.
 РАСТРОВЫЙ ЭЛЕКТРОННЫЙ МИКРОСКОП (РЭМ/ПЭМ). Схема РЭМ и принцип работы: 1. «Толстый» образец; 2. Тонкий луч (1 -10 нм) ~разрешение 3. Синхронное сканирование двух пучков по строке: X и кадру: Y. M=L/l 3. Визуализация топографии; 4. Карта распределения элементов, использую соответствующие детекторы; L Типы сигналов, генерируемые при облучении образца первичным электронным пучком с Eo: M=L/l Y 1. ВЭ (0 -50 э. В): а)затенение – квази-3 D, в) хим. контраста нет c) разрешение 5 нм; 2. ОРЭ (50 э. В-E 0): Контраст ~N-элемента, энергоанализатор даст оже пики; 3. ТО: Iто = I(E 0) –Iвэ –Iорэ –Iпр, (детекторы не нужны) 4. ХРИ: при настройке на Хар. Изл. эл-та – карта данного элемента (аналогично оже анализу, но глубина >, разрешение <. 5. КЛ: слабое излучение УФ и видимого света (ФЭУ); 6. Прошед. эл-ны. : без хроматич. аберрации ; X l 6 4 I(E 0) 2 1 5 3
РАСТРОВЫЙ ЭЛЕКТРОННЫЙ МИКРОСКОП (РЭМ/ПЭМ). Схема РЭМ и принцип работы: 1. «Толстый» образец; 2. Тонкий луч (1 -10 нм) ~разрешение 3. Синхронное сканирование двух пучков по строке: X и кадру: Y. M=L/l 3. Визуализация топографии; 4. Карта распределения элементов, использую соответствующие детекторы; L Типы сигналов, генерируемые при облучении образца первичным электронным пучком с Eo: M=L/l Y 1. ВЭ (0 -50 э. В): а)затенение – квази-3 D, в) хим. контраста нет c) разрешение 5 нм; 2. ОРЭ (50 э. В-E 0): Контраст ~N-элемента, энергоанализатор даст оже пики; 3. ТО: Iто = I(E 0) –Iвэ –Iорэ –Iпр, (детекторы не нужны) 4. ХРИ: при настройке на Хар. Изл. эл-та – карта данного элемента (аналогично оже анализу, но глубина >, разрешение <. 5. КЛ: слабое излучение УФ и видимого света (ФЭУ); 6. Прошед. эл-ны. : без хроматич. аберрации ; X l 6 4 I(E 0) 2 1 5 3
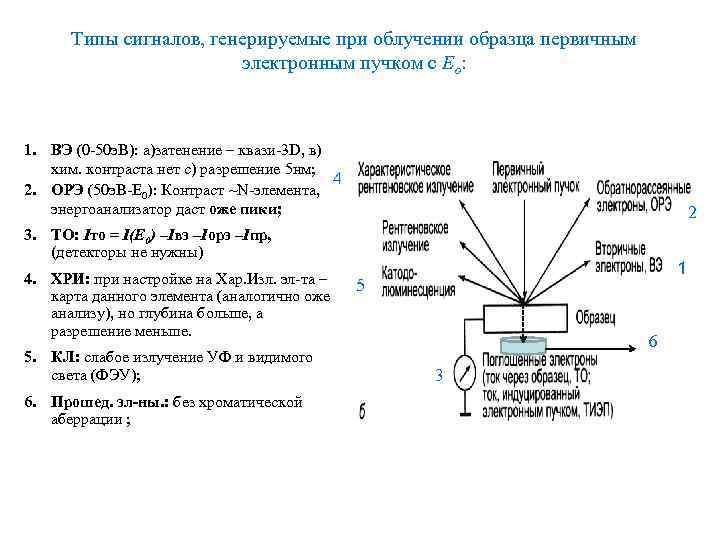 Типы сигналов, генерируемые при облучении образца первичным электронным пучком с Eo: 1. ВЭ (0 -50 э. В): а)затенение – квази-3 D, в) хим. контраста нет c) разрешение 5 нм; 4 2. ОРЭ (50 э. В-E 0): Контраст ~N-элемента, энергоанализатор даст оже пики; 2 3. ТО: Iто = I(E 0) –Iвэ –Iорэ –Iпр, (детекторы не нужны) 4. ХРИ: при настройке на Хар. Изл. эл-та – карта данного элемента (аналогично оже анализу), но глубина больше, а разрешение меньше. 5. КЛ: слабое излучение УФ и видимого света (ФЭУ); 6. Прошед. эл-ны. : без хроматической аберрации ; 1 5 6 3
Типы сигналов, генерируемые при облучении образца первичным электронным пучком с Eo: 1. ВЭ (0 -50 э. В): а)затенение – квази-3 D, в) хим. контраста нет c) разрешение 5 нм; 4 2. ОРЭ (50 э. В-E 0): Контраст ~N-элемента, энергоанализатор даст оже пики; 2 3. ТО: Iто = I(E 0) –Iвэ –Iорэ –Iпр, (детекторы не нужны) 4. ХРИ: при настройке на Хар. Изл. эл-та – карта данного элемента (аналогично оже анализу), но глубина больше, а разрешение меньше. 5. КЛ: слабое излучение УФ и видимого света (ФЭУ); 6. Прошед. эл-ны. : без хроматической аберрации ; 1 5 6 3
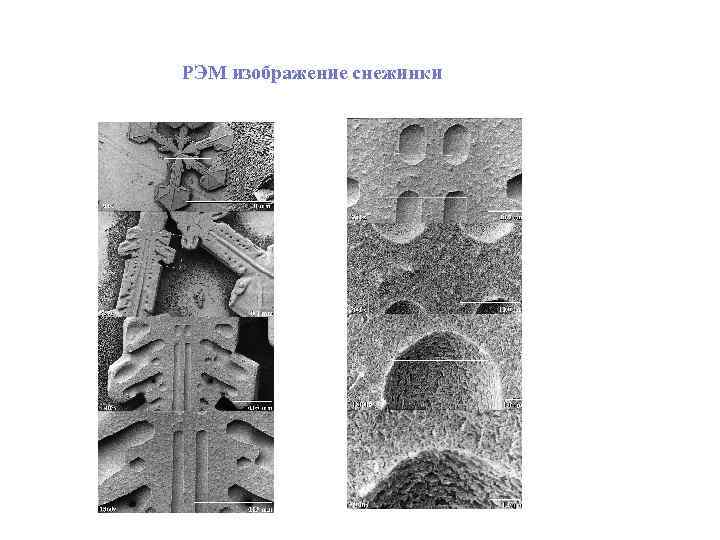 РЭМ изображение снежинки
РЭМ изображение снежинки
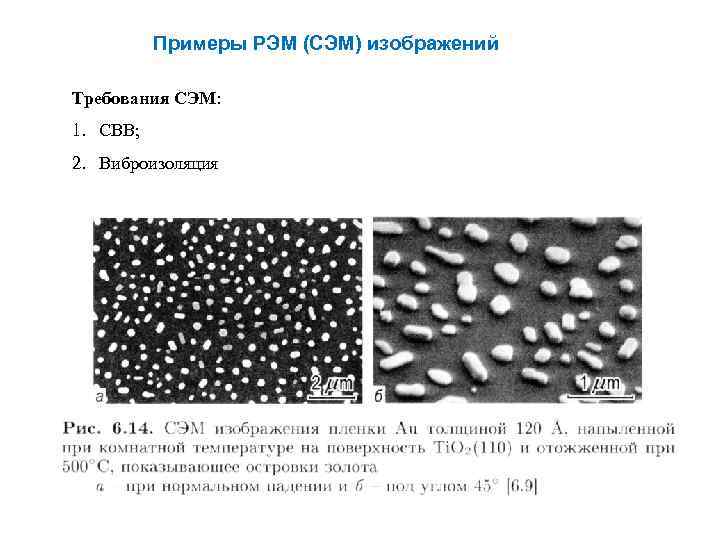 Примеры РЭМ (СЭМ) изображений Требования СЭМ: 1. СВВ; 2. Виброизоляция
Примеры РЭМ (СЭМ) изображений Требования СЭМ: 1. СВВ; 2. Виброизоляция
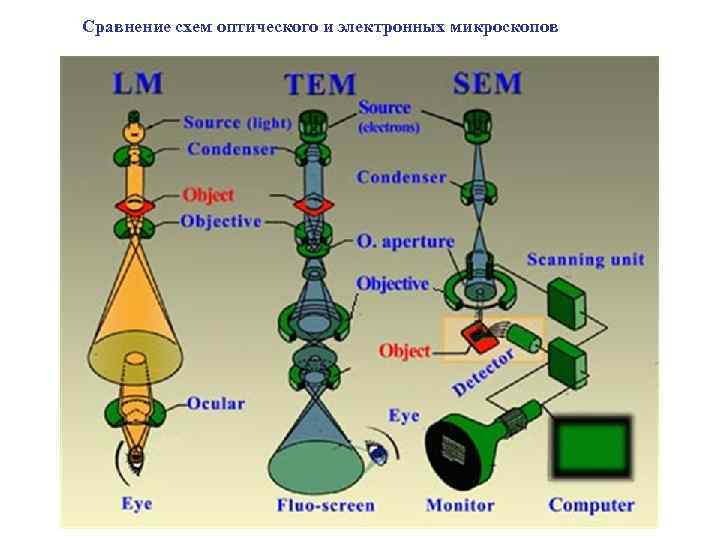 Сравнение схем оптического и электронных микроскопов
Сравнение схем оптического и электронных микроскопов
 Сравнение ПЭМ и СЭМ Преимущества ПЭМ 1. Лучшее разрешение вплоть до атомного 0, 2 нм; 2. В дифракционном режиме изучение кристаллографических свойств; Преимущества СЭМ 1. Более простая оптика и меньшее E 0; 2. Возможность исследования «толстых» образцов; 3. Использование разных детекторов и 3. Низкая плотность электронного пучка – не анализаторов – позволяет элементное стимулирует реакции на поверхности картирование образца с остаточными газами.
Сравнение ПЭМ и СЭМ Преимущества ПЭМ 1. Лучшее разрешение вплоть до атомного 0, 2 нм; 2. В дифракционном режиме изучение кристаллографических свойств; Преимущества СЭМ 1. Более простая оптика и меньшее E 0; 2. Возможность исследования «толстых» образцов; 3. Использование разных детекторов и 3. Низкая плотность электронного пучка – не анализаторов – позволяет элементное стимулирует реакции на поверхности картирование образца с остаточными газами.
 Литература 1. К. Оура, В. Г. Лифщиц, А. А. Саранин, А. В. Зотов Введение в физику поверхности. – М. : Мир, 2006. 2. Праттон, Введение в физику поверхности 3. Я. С. Уманский, Ю. А. Скаков, А. Н. Иванов, Л. Н. Расторгуев. Кристаллография, рентгенография и электронная микроскопия. М. : Металлургия, 1982, 632 с. 4. Д. Синдо. Т. Оикава. Аналитическая просвечивающая электронная микроскопия. М. : Техносфера, 2006, 256 с
Литература 1. К. Оура, В. Г. Лифщиц, А. А. Саранин, А. В. Зотов Введение в физику поверхности. – М. : Мир, 2006. 2. Праттон, Введение в физику поверхности 3. Я. С. Уманский, Ю. А. Скаков, А. Н. Иванов, Л. Н. Расторгуев. Кристаллография, рентгенография и электронная микроскопия. М. : Металлургия, 1982, 632 с. 4. Д. Синдо. Т. Оикава. Аналитическая просвечивающая электронная микроскопия. М. : Техносфера, 2006, 256 с


