7e4ebdaffe1bcd12bf81316cd50ec76e.ppt
- Количество слайдов: 45

Проблемы развития кремниевой микро- и наноэлектроники А. А. Орликовский Физико-технологический институт РАН director@ftian. ru

Содержание. 1. Развитие высокопроизводительной литографии (~100 пластин/час). 2. Проблемы энерговыделения и теплоотвода в КМОП СБИС. 3. Эволюция структуры МДП-транзистора. 4. Разброс характеристик МДП-транзисторов с длинами каналов в глубоком суб-100 нм диапазоне? 5. После МДП-транзистора? 6. Проблемы многоуровневых соединений в СБИС.
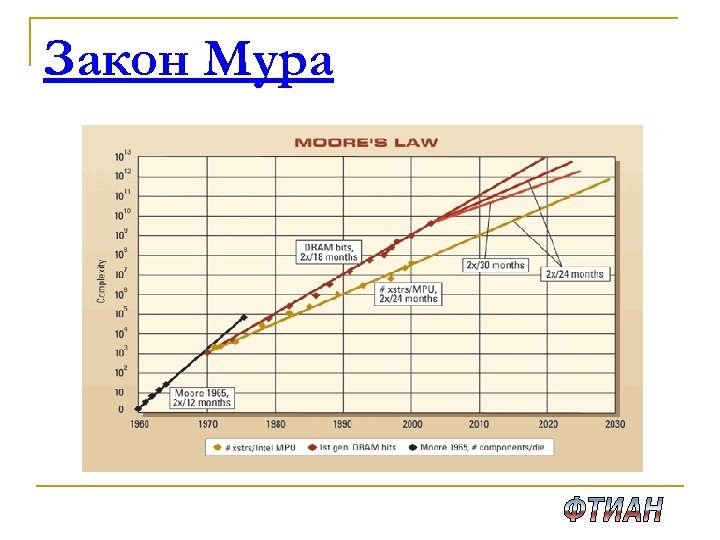
Закон Мура

Развитие оптической литографии R = k 1 /NA k 1 – несовершенство систем изображения, дифракционные эффекты, несовершенство регистрирующей среды. n n n Оптимальная коррекция шаблонов Оптимизация резистов Совершенствование оптической системы = 193 нм NA=0, 95; k 1=0, 25; R= 50 нм
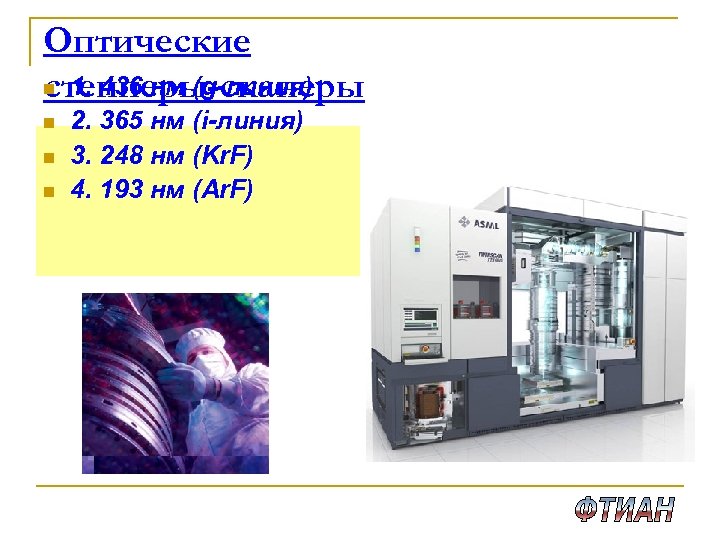
Оптические n 1. 436 нм (g-линия) степперы-сканеры n n n 2. 365 нм (i-линия) 3. 248 нм (Kr. F) 4. 193 нм (Ar. F)
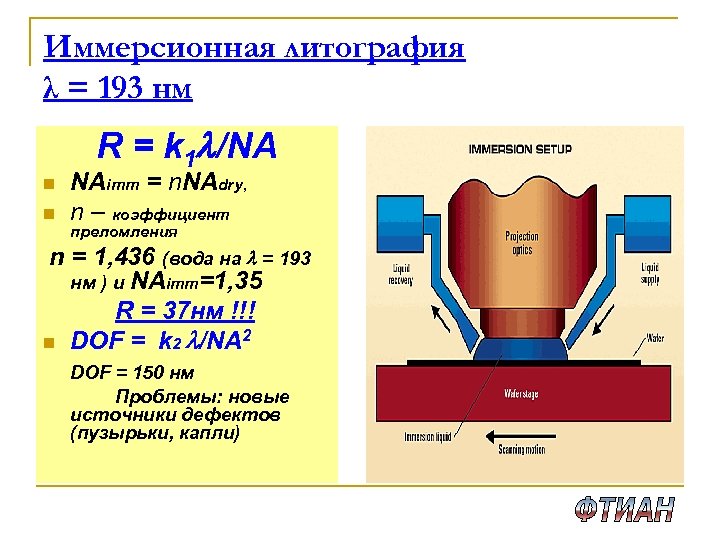
Иммерсионная литография λ = 193 нм R = k 1 /NA n n NAimm = n. NAdry, n – коэффициент преломления n = 1, 436 (вода на = 193 нм ) и NAimm=1, 35 R = 37 нм !!! n DOF = k 2 /NA 2 DOF = 150 нм Проблемы: новые источники дефектов (пузырьки, капли)
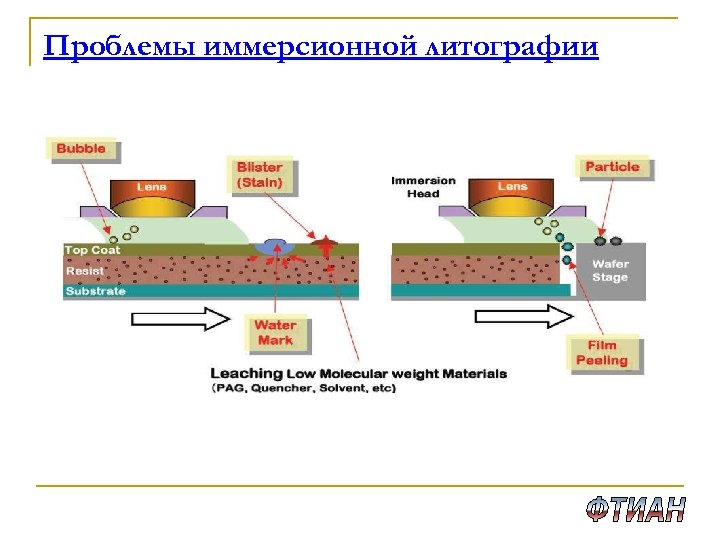
Проблемы иммерсионной литографии

Перспективы иммерсионной литографии на длине волны 193 нм Применение жидкостей с большими n (1, 6; 1, 8). Для 2 -ой генерации (1, 6) степперов-сканеров R ≤ 32 нм, для 3 -ей (1, 8) R ~ 28 нм. n
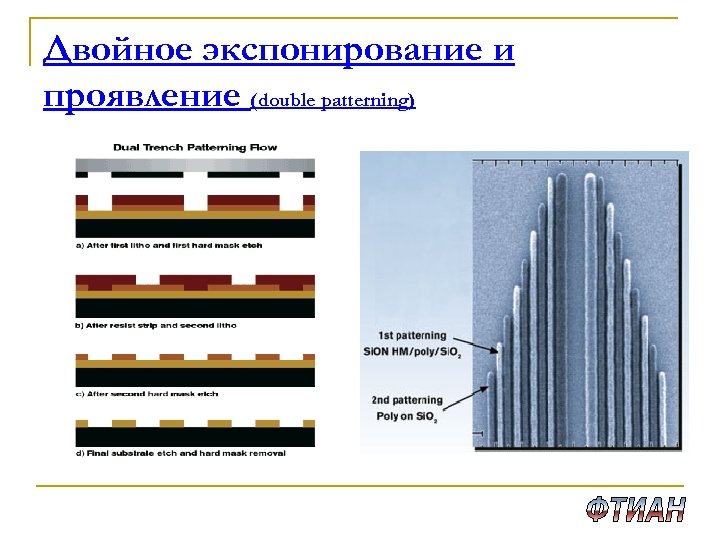
Двойное экспонирование и проявление (double patterning)
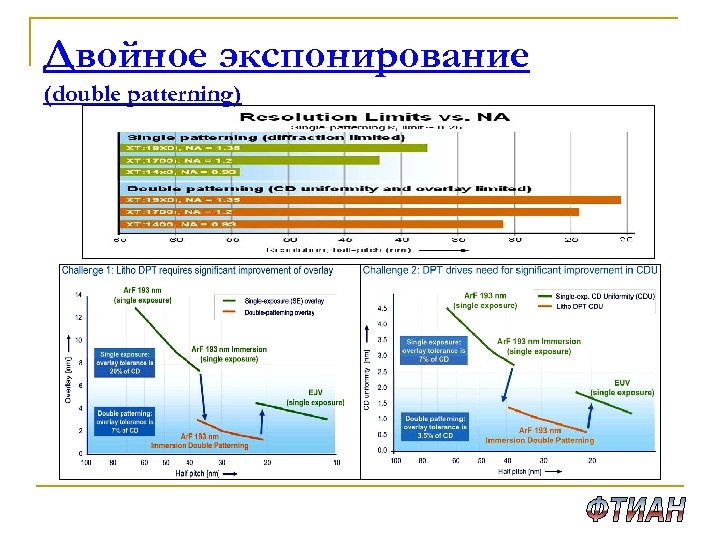
Двойное экспонирование (double patterning)

Литография для поколений ИС с минимальным размером 22 нм и меньше 1. ЭУФ на λ = 13, 5 нм (EUV) – отражающая оптика, производительность до 100 пластин/час 2. Высоковольтная многолучевая электронная литография (HVEB-DW) 3. Низковольтная многолучевая электронная литография (LVEB-DW) До 10000 пучков, производительность от 5 до 30 пластин/час

ЭУФ-литография NA=0, 25 – 0, 40; k 1=0, 6 – 0, 4; R = 32 – 12 нм n Преимущества: - ЭУФЛ является оптической и проекционной, используются стеклянные заготовки для шаблонов; - может быть использована для нескольких поколений ИС; - работоспособность уже продемонстрирована на прототипах литографов, - возможность создать источник света с меньшей длиной волны.
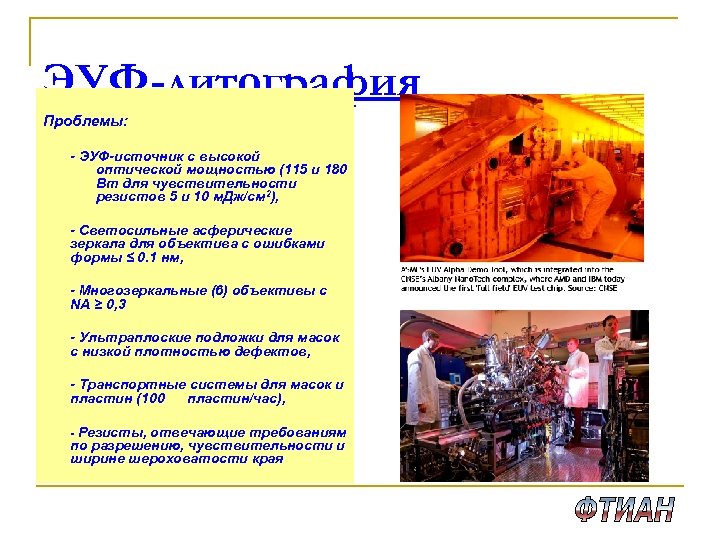
ЭУФ-литография Проблемы: - ЭУФ-источник с высокой оптической мощностью (115 и 180 Вт для чувствительности резистов 5 и 10 м. Дж/см 2), - Светосильные асферические зеркала для объектива с ошибками формы ≤ 0. 1 нм, - Многозеркальные (6) объективы с NA ≥ 0, 3 - Ультраплоские подложки для масок с низкой плотностью дефектов, - Транспортные системы для масок и пластин (100 пластин/час), - Резисты, отвечающие требованиям по разрешению, чувствительности и ширине шероховатости края
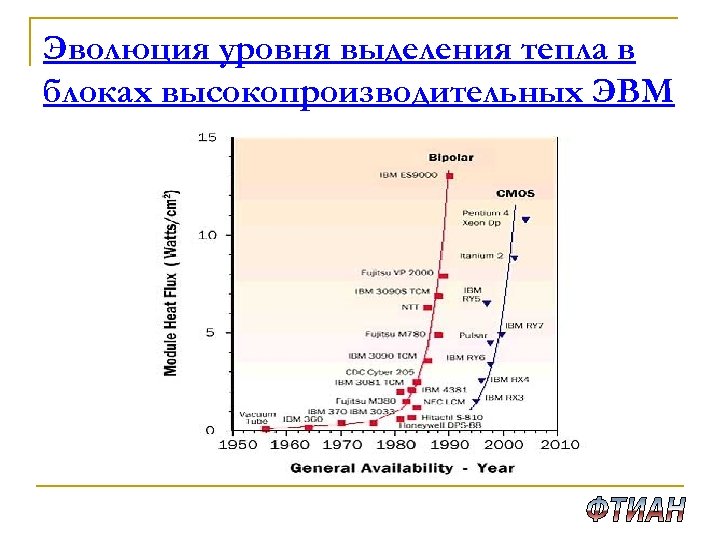
Эволюция уровня выделения тепла в блоках высокопроизводительных ЭВМ

КМОП СБИС затвор исток Подложка КМОП ИС – 90% рынка ИС с начала 1980 -х годов PΣ ≈ CΣ f (Vп)2 Lк=10 нм, CΣ = 5 х10 -17 Ф, f=10 ГГц, N=5. 109, Vп=1 B, PΣ = 2, 5 к. Вт !!!

Воздушное охлаждение Р=60 -85 Вт/см 2 RT 1 = 0, 20 -0, 27 0 C/Вт Р = 141, 5 Ра RT 2 = 0, 10 -0, 07 0 C/Вт

Жидкостное охлаждение: непрямое (микроканалы < 0, 1 мм) T = 600 C, Р = 227 Вт/см 2 (а), 320 Вт/см 2(b), 397 Вт/см 2(c)

Прямое охлаждение кристалла процессора водой: распылением и струйное Способ/ жидк. распылением струйное FC-72 60 Вт/см 2 120 Вт/см 2 ВОДА 160 Вт/см 2 460 Вт/см 2

Прямое охлаждение кристалла процессора водой: Power 6, 65 нм 5. 104 микроканалов шириной 30 -50 мкм P 400 Вт/см 2 при низкой мощности насоса
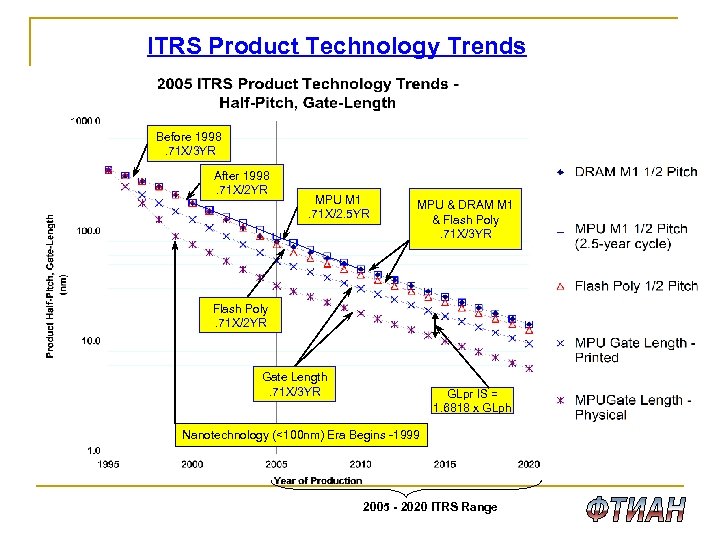
ITRS Product Technology Trends Fig 7&8 Simplified – Option 1 Before 1998. 71 X/3 YR After 1998. 71 X/2 YR MPU M 1. 71 X/2. 5 YR MPU & DRAM M 1 & Flash Poly. 71 X/3 YR Flash Poly. 71 X/2 YR Gate Length. 71 X/3 YR GLpr IS = 1. 6818 x GLph Nanotechnology (<100 nm) Era Begins -1999 2005 - 2020 ITRS Range

Быстродействие ВПСК 1. f ~ 1/Lk при Lk≥ 100 нм f/P ~ (1/Lk)3 2. При Lk≤ 100 нм f/P ~ (1/Lk)2 В области длин канала 100 нм зависимость потребляемой мощности от длины канала меняется

МДП-транзистор З «Золотое время масштабирования» закончилось при МР ~ 100 нм Размеры: Lk, Wk, tox, ширина соединения 1/ Nk VП 1/ Плотность размещения 1/ 2 Быстродействие Мощность 1/ 2 Плотность мощности 1 Энергия на операцию 1/ 3 И Подложка С 1. Увеличение Nk приводит к катастрофическому снижению подвижности носителей в канале 2. Напряжение питания (~1 В) уменьшать возможно только в ущерб производительности 3. Толщина подзатворного диэлектрика становится туннельно тонкой 4. Сопротивление поли-Si затвора становится неудовлетворительно высоким

Напряжение питания Vп мин = 0, 8 – 1, 0 B n Iвкл μCox(Wk/2 Lk)(Vп-Vпор)2 n Iвыкл ~ μ(Wk/Lk)(k. T/e)2 exp(-Vпор/nk. T), n>1 1. Vп снижать нельзя из-за снижения Iвкл → 2. Vпор снижать нельзя из-за экспоненциального увеличения Iвыкл и неизбежного большого разброса Vпор

Полная рассеиваемая кристаллом мощность PΣ ≈ CΣ f (Uп 2 ) + Iут Uп + Iвыкл Uп Токи утечки: Iox- ток прямого туннелирования через подзатворный диэлектрик, Ip-n – ток утечки обратно смещенного р-п перехода «сток-подложка» , Iист-ст – ток прямого туннелирования «исток-сток»

Увеличение доли статической мощности (высокопроизводительные системы на кристалле - ВПСК) n n Увеличение производительности ВПСК осуществляется схемотехническими, архитектурными и алгоритмическими средствами С уменьшением Lk плотность статической мощности становится сравнимой с плотностью динамической мощности

Ток прямого туннелирования «исток-сток» Ток туннелирования IT ~ exp{-2(2 m. Ub/ћW 2)1/2}, Ub – высота барьера над уровнем Ферми в контактах, W – ширина барьера. Термоэммиссионный ток (в закрытом состоянии) ITE ~ exp {- (Ub/k. T)}. Условие преобладания IT над ITE : W < (ћ 2 Ub/8 mk. T)1/2. ITE = 10 -9 A/мкм, Ub/k. T = 20 -→ W (Lk) < 12 нм Эксперимент: при Lk = 5 нм IT ~ 10 -6 A/мкм (J. Lolivier et al. SOI 2005)

Вклад тока туннелирования «стокисток» в статическую мощность Туннельный транзистор: смена концепции, схемотехники, материалов(? ) 2015 год: Lk = 10 нм, N = 5. 109 МДП КНИ транзисторов Рст = 10 -9 А/мкм х(30 х10 -3 мкм)х1 Вх 5. 109 = 150 м. Вт 2020 год: Lk = 5 нм, N = 5. 1010 транзисторов Рст = 10 -6 А/мкм х (15 х10 -3 мкм)х1 Вх5. 1010 = 750 Вт (!)

Эволюция структуры МДП-транзистора n n n Подзатворный диэлектрик в высоким (Zr. O 2, Hf. O 2, Zr. Si. O 4, Hf. Si. O 4, Si 3 N 4, Al 2 O 3 и др. ) Металлический затвор (Ta с работой выхода 4, 3 э. В для n- МДПТ и Ti. N (4, 9 э. В) p-МДПТ с Hf. Si. O 4, Ni. Si для транзисторов обоих типов) Применение структур с напряженным кремнием в канале (увеличение подвижности электронов и дырок), применение нелегированного сверхтонкого КНИ, поиск материалов для каналов р- и п- транзисторов с высокой подвижностью, встроенных в кремниевую подложку (Ge, Ge/Si и др) Iвкл μCox(Wk/2 Lk)(Vп-Vпор)2 n Сверхмелкое легирование областей стока и истока (xj ~ 10 нм и меньше)
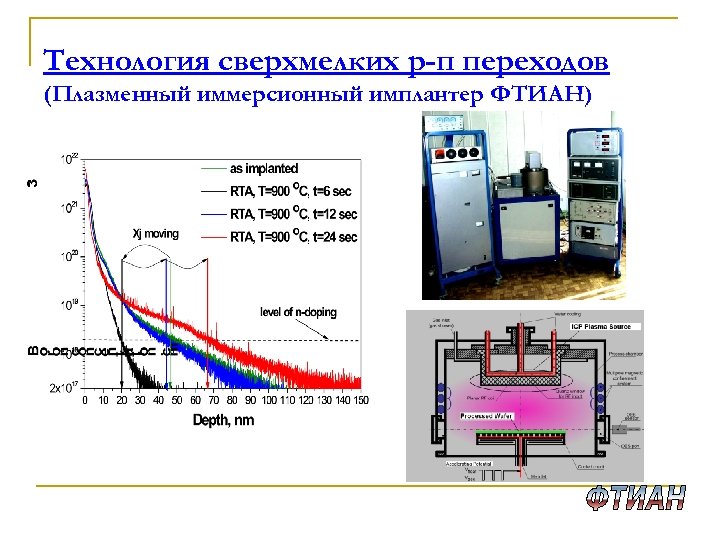
Технология сверхмелких р-п переходов (Плазменный иммерсионный имплантер ФТИАН)

Эволюция структуры МДП транзистора Поколение ИС 65 нм 45 нм 32 нм 22 нм Технология Объемная подложка, Одноосные напряжения н. КНИ. Ультратонкий КНИ Затвор Поликремний/ металлы/ силициды Металлы, силициды Подзатворн. диэлектрик Si. ON/ Hf. O 2 Биаксиальн. Ультранапряжения тонкий КНИ

Нано. МДПТ в ультратонком КНИ (Lk ~ 10 нм, t. Si =2 -5 нм ) затвор Si layer исток канал сток • Меньше токи утечки • Почти идеальный наклон подпороговых характеристик (~60 м. В/дек) • Ниже разброс пороговых напряжений • Меньше емкости «сток/исток – подложка»

Квантовые эффекты в нано. МДП-транзисторе n n n 1. Эффекты, связанные с поперечным квантованием носителей в канале транзистора: а) Сдвиг порогового напряжения и изменение тока открытого транзистора; б) Квантовый транспорт в канале транзистора: учет зонной структуры кремния; в) Емкость «канал-затвор» ; г) Сильное рассеяние на шероховатостях поверхности: подвижность от толщины слоя кремния ~ d^6 или d^4; n 2. Квантовомеханическое отражение и интерференция при продольном движении в канале. n 3. Статистика Ферми-Дирака в контактах. n 4. Туннелирование между истоком и стоком.

Квантовое моделирование нано. МДП транзистора в ультратонком КНИ Неоднородный канал Произвольные примеси в канале Требования к совершенству ультратонкого КНИ резко возрастают!

После МДП-транзистора (направления поисков) ►Нанотрубки, графены в канале ПТ (Гейм, Новоселов) ►Кремниевые нанопровода в канале МДПТ ►Одноэлектронные транзисторы ► Новые архитектуры (crossbar - HP, CMOL – Струков, Лихарев)

Проблемы многоуровневых соединений 1. Промышленное внедрение новых материалов: медь, “low k” диэлектрики, барьерные слои, слои “etch stop” и т. д. 2. Минимизация потерь и задержек в соединениях (ρ, RC) 3. Обеспечение надежности соединений и контактов 4. Создание метрологических методов и средств
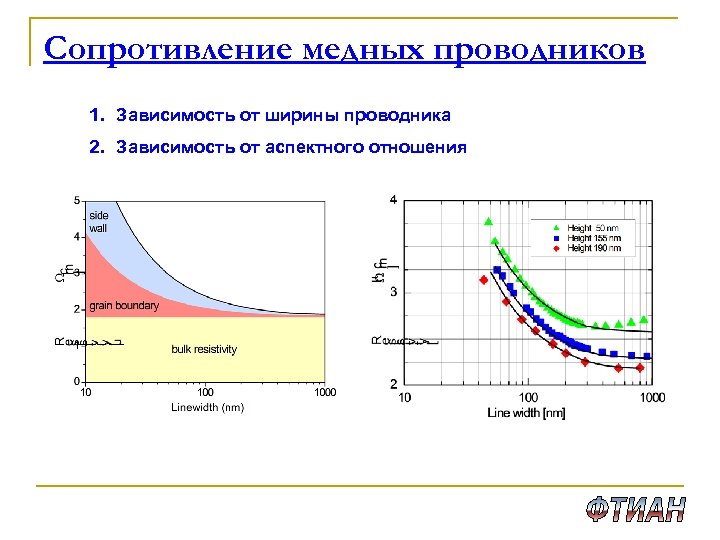
Сопротивление медных проводников 1. Зависимость от ширины проводника 2. Зависимость от аспектного отношения
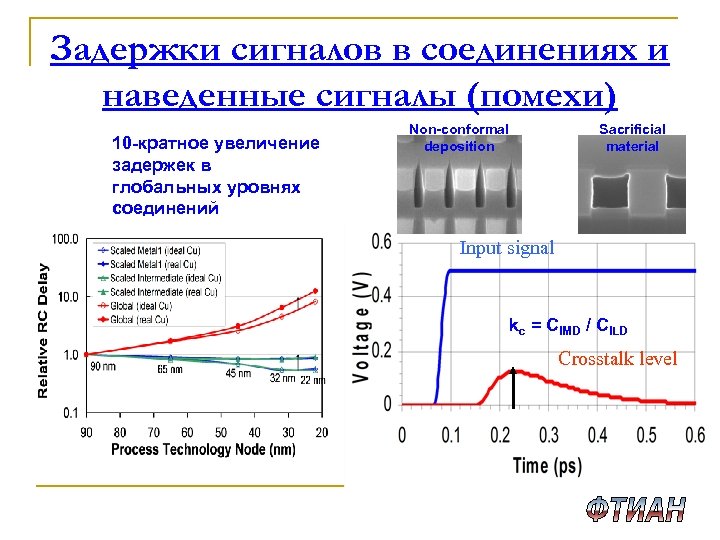
Задержки сигналов в соединениях и наведенные сигналы (помехи) 10 -кратное увеличение задержек в глобальных уровнях соединений Non-conformal deposition Sacrificial material Input signal kc = CIMD / CILD Crosstalk level
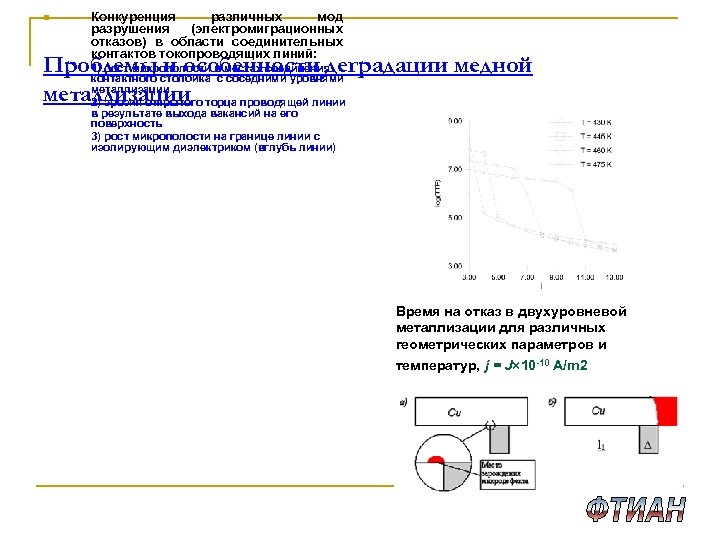
n Конкуренция различных мод разрушения (электромиграционных отказов) в области соединительных контактов токопроводящих линий: 1) рост микрополости Проблемы столбика вс местах соединениядеградации медной и особенности контактного соседними уровнями металлизации торца проводящей линии 2) эрозия открытого в результате выхода вакансий на его поверхность 3) рост микрополости на границе линии с изолирующим диэлектриком (вглубь линии) Время на отказ в двухуровневой металлизации для различных геометрических параметров и температур, j = J 10 -10 А/m 2

Проблемы теории и моделирования для медной металлизации n Адгезионная прочность интерфейсов в условиях электрических, механических и тепловых нагрузок в зависимости от дефектности слоев, образующих интерфейс (отсутствие отслоений, коробления и т. д. ) Интерфейсы и контакты: между проводящей линией (ПЛ) и барьерными слоями, ПЛ и защитным диэлектриком, ПЛ и слоями материалов, вводимых между ПЛ и контактной ножкой для улучшения адгезии (Ta, Ta. N, Ti. N); металлический электрод–high-K диэлектрик–полупроводник с высокой подвижностью (структуры типа Ti. N/Hf. O 2/Ge) n Оптимизация адгезионной прочности межсоединений в зависимости от концентрации и распределения дефектов, текстуры границ и рабочих параметров (немонотонность и существенная нелинейность работы отрыва и поверхностного натяжения) n Рост сопротивления и нагрева из-за необходимости использования до 20% сечения медного проводника для барьерной пленки, предотвращающей диффузию атомов меди в примыкающие диэлектрики n Отсутствует точное описание действия обратных экспериментальных данных для Сu металлизации) n Необходимо дальнейшее развитие микроскопической дискретной теории электромиграционного разрушения, развитой К. Валиевым, Т. Махвиладзе, М. Сарычевым, для плотноупакованных нанотранзисторных ИС (дискретное описание транспорта вакансий и ионов, процессов деформирования, атомистическое описание структуры проводящих элементов) механических напряжений (недостаточно

Развивающиеся методы соединений n n 1. Оптические соединения (эмиттеры, волноводы, модуляторы, детекторы) 2. СВЧ (передающие и принимающие антенны, генераторы, волноводы, свободное пространство и т. д. ) 3. 3 D - интеграция 4. Нанотрубки

Оптические соединения n Фотонные переключатели с большой полосой пропускания, соединяющие ядра процессора Пропускная способность 40 Гбит/с на один канал n Волноводы и модуляторы, изготовленные по кремниевой технологии

Оптические соединения n Лазеры и фотоприемники

СВЧ беспроводные соединения n Внутри- и межчиповые соединения с использованием интегрированных передатчиков и приемников n 1, 16 Гбит/с

Заключение n 1. Согласно закону Мура ожидается, что к 2020 году будет освоена КМОП технология с длинами каналов транзисторов 6 нм. Это потребует преодоления следующих проблем: q q Проблема литографии в суб-10 нм диапазоне минимальных размеров Проблема большого энергопотребления Проблема выполнения требований к разбросу параметров транзисторов Проблема создания высоконадежных и скоростных соединений на кристалле

Заключение n 2. Закон Мура может быть завершен и раньше 2020 года, если эквивалентная стоимость одного компонента системы на кристалле перестанет снижаться прежними темпами. n 3. После 2020 года наступит эра квантовых процессоров, для развития которых будут сформулированы новые закономерности.
7e4ebdaffe1bcd12bf81316cd50ec76e.ppt