Поверхность “It





![Структура поверхности Ga. As(001) [001] Структура поверхности Ga. As(001) [001]](https://present5.com/presentation/3/16414912_158001360.pdf-img/16414912_158001360.pdf-7.jpg)






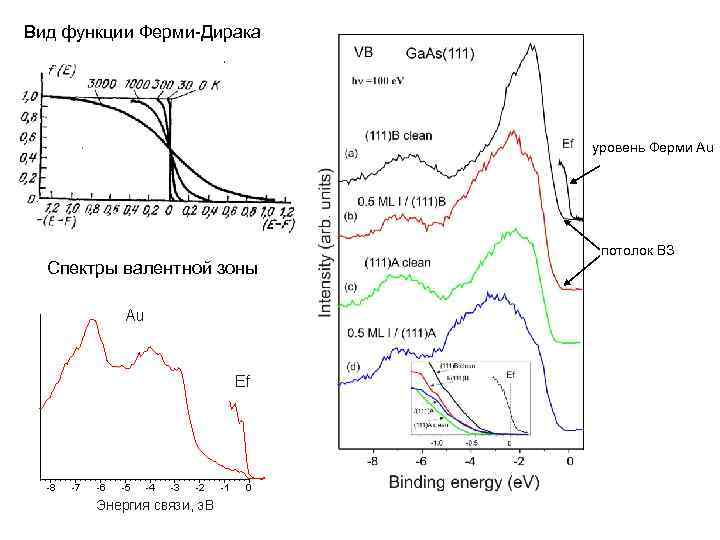








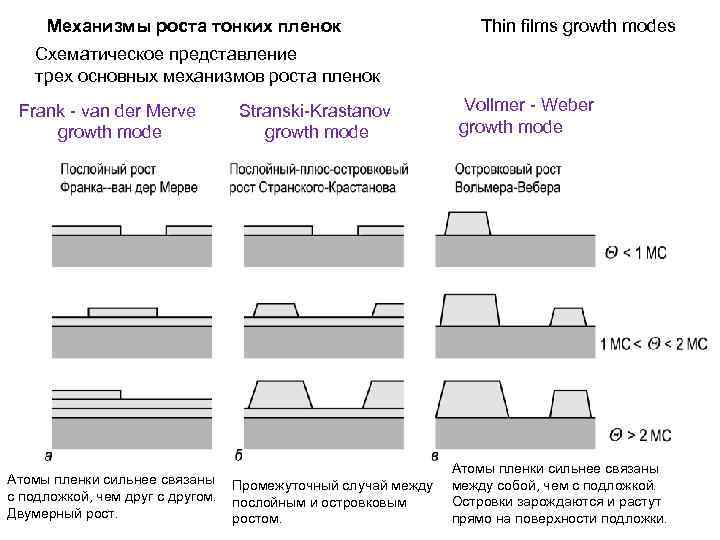

 Поверхность “It is sometimes said that God made the bulk and Devil made the surface. ” Поверхность – первый и неизбежный «дефект» любого кристалла, доступного для эксперимента. Неизбежность данного Wolfgang Pauli дефекта делает неизбежной задачу его исследования, а, точнее, три класса задач: 1. Наиболее типичной средой, в которой прибывают кристаллы, является воздух (N, O, пары H 2 O), кристалл вступает в химическое взаимодействие. Поэтому большой раздел науки о поверхности связан с исследованием проблемы коррозии и изысканием способов пассивации поверхности. Пассивация — переход поверхности т. т. в неактивное, пассивное состояние, связанное с образованием тонких поверхностных слоёв соединений, препятствующих коррозии. 2. Очень многие химические реакции протекают на поверхности кристалла легче и селективнее, чем в иных условиях. Поэтому еще один большой раздел науки о поверхности – гетерогенный катализ.
Поверхность “It is sometimes said that God made the bulk and Devil made the surface. ” Поверхность – первый и неизбежный «дефект» любого кристалла, доступного для эксперимента. Неизбежность данного Wolfgang Pauli дефекта делает неизбежной задачу его исследования, а, точнее, три класса задач: 1. Наиболее типичной средой, в которой прибывают кристаллы, является воздух (N, O, пары H 2 O), кристалл вступает в химическое взаимодействие. Поэтому большой раздел науки о поверхности связан с исследованием проблемы коррозии и изысканием способов пассивации поверхности. Пассивация — переход поверхности т. т. в неактивное, пассивное состояние, связанное с образованием тонких поверхностных слоёв соединений, препятствующих коррозии. 2. Очень многие химические реакции протекают на поверхности кристалла легче и селективнее, чем в иных условиях. Поэтому еще один большой раздел науки о поверхности – гетерогенный катализ.
 3. Все кристаллы растут не иначе, как путём отложения атомов, молекул или более крупных частиц на своей поверхности. Поэтому один из самых интересных и крупных разделов науки о поверхности – это изучение элементарных механизмов роста кристаллов. По этой же причине, любой атом в объёме кристалла, в своё время был на поверхности, и, можно сказать, объём просто пронизан памятью о поверхности.
3. Все кристаллы растут не иначе, как путём отложения атомов, молекул или более крупных частиц на своей поверхности. Поэтому один из самых интересных и крупных разделов науки о поверхности – это изучение элементарных механизмов роста кристаллов. По этой же причине, любой атом в объёме кристалла, в своё время был на поверхности, и, можно сказать, объём просто пронизан памятью о поверхности.
 Дифракция медленных электронов
Дифракция медленных электронов
 Структура и стехиометрия поверхности Ga. As(001) [001] As/Ga. As(001): T 100° МЛЭ, HCl-i. PA (1 x 1) (2 x 4)/c(2 x 8) (3 x 6)/(2 x 6) (4 x 2)/c(8 x 2) (4 x 6) 420 °С 480 °С 550 °С 600 °С O. E. Tereshchenko S. I. Chikichev, A. S. Terekhov, JVST A 17 (1999) 2655 Изменение отношения As/Ga на поверхности Можно ли осуществить после обработки низкотемпературную реконструкцию в HCl-i. PA и последующего поверхности изменяя её стехиометрию? прогрева в СВВ
Структура и стехиометрия поверхности Ga. As(001) [001] As/Ga. As(001): T 100° МЛЭ, HCl-i. PA (1 x 1) (2 x 4)/c(2 x 8) (3 x 6)/(2 x 6) (4 x 2)/c(8 x 2) (4 x 6) 420 °С 480 °С 550 °С 600 °С O. E. Tereshchenko S. I. Chikichev, A. S. Terekhov, JVST A 17 (1999) 2655 Изменение отношения As/Ga на поверхности Можно ли осуществить после обработки низкотемпературную реконструкцию в HCl-i. PA и последующего поверхности изменяя её стехиометрию? прогрева в СВВ
![> Структура поверхности Ga. As(001) [001] > Структура поверхности Ga. As(001) [001]](https://present5.com/presentation/3/16414912_158001360.pdf-img/16414912_158001360.pdf-7.jpg) Структура поверхности Ga. As(001) [001]
Структура поверхности Ga. As(001) [001]
 Structure of chemically prepared In. As(001) surface under UHV annealing STM LEED (2 x 4)/c(2 x 8) 60 x 60 nm Tann. =330°C (2 x 4)/(4 x 2) 60 x 60 nm Tann. =375°C Tann. =20° First order phase transition (4 x 2)/c(8 x 2) 55 x 55 nm Tann. =410°C O. E. Tereshchenko , et al. Appl. Phys. Lett. 82 (2003) 4280
Structure of chemically prepared In. As(001) surface under UHV annealing STM LEED (2 x 4)/c(2 x 8) 60 x 60 nm Tann. =330°C (2 x 4)/(4 x 2) 60 x 60 nm Tann. =375°C Tann. =20° First order phase transition (4 x 2)/c(8 x 2) 55 x 55 nm Tann. =410°C O. E. Tereshchenko , et al. Appl. Phys. Lett. 82 (2003) 4280
 СТМ ДМЭ 55 x 55 nm
СТМ ДМЭ 55 x 55 nm
 Следует отличать адсорбцию от абсорбции, при которой вещество диффундирует в объем жидкости или твердого тела и образует раствор или гель. Термин сорбция объединяет оба понятия. Вещество, на поверхности которого происходит адсорбция, называется адсорбентом, а поглощаемое — адсорбатом. В зависимости от характера взаимодействия между молекулой адсорбата и адсорбентом адсорбцию принято подразделять на физическую адсорбцию (слабые взаимодействие) и хемосорбцию (сильные взаимодействия). Чёткой границы между физической адсорбцией и хемосорбцией не существует; в качестве граничного значения принята энергия связи между адсорбатом и адсорбентом, равная 0, 5 э. В на атом или молекулу. Процесс, обратный адсорбции, называется десорбцией. Если скорости адсорбции и десорбции равны, то говорят об установлении адсорбционного равновесия. В состоянии равновесия количество адсорбированных молекул остаётся постоянным сколь угодно долго, если неизменны внешние условия (давление, температура и состав системы). Введение в физику поверхности: Пер. с англ. / Оура Кендзиро, Лифшиц В. Г. , Саранин А. А. , Зотов А. В. , Катаяма М. - М. Наука, 2006. - 490 с.
Следует отличать адсорбцию от абсорбции, при которой вещество диффундирует в объем жидкости или твердого тела и образует раствор или гель. Термин сорбция объединяет оба понятия. Вещество, на поверхности которого происходит адсорбция, называется адсорбентом, а поглощаемое — адсорбатом. В зависимости от характера взаимодействия между молекулой адсорбата и адсорбентом адсорбцию принято подразделять на физическую адсорбцию (слабые взаимодействие) и хемосорбцию (сильные взаимодействия). Чёткой границы между физической адсорбцией и хемосорбцией не существует; в качестве граничного значения принята энергия связи между адсорбатом и адсорбентом, равная 0, 5 э. В на атом или молекулу. Процесс, обратный адсорбции, называется десорбцией. Если скорости адсорбции и десорбции равны, то говорят об установлении адсорбционного равновесия. В состоянии равновесия количество адсорбированных молекул остаётся постоянным сколь угодно долго, если неизменны внешние условия (давление, температура и состав системы). Введение в физику поверхности: Пер. с англ. / Оура Кендзиро, Лифшиц В. Г. , Саранин А. А. , Зотов А. В. , Катаяма М. - М. Наука, 2006. - 490 с.
 Ø Kinetics of Cs and I adsorption on Ga. As(001) non-intermixing; Ø selective interaction Cs /Ga. As(001) I /Ga. As(001) • Langmuir adsorption model with constant sticking coefficient. • The sticking coefficients for As- и Ga -rich surfaces of Ga. As coincide to within 5%. Work function variation of Ga. As(001) under Cs and I deposition Cs I + - + Ø The difference in Cs adsorption on As- and Ga-rich surfaces is due to the difference in the interaction mechanism of Cs with arsenic and gallium surface Phys. Rev. B (2009) atoms!
Ø Kinetics of Cs and I adsorption on Ga. As(001) non-intermixing; Ø selective interaction Cs /Ga. As(001) I /Ga. As(001) • Langmuir adsorption model with constant sticking coefficient. • The sticking coefficients for As- и Ga -rich surfaces of Ga. As coincide to within 5%. Work function variation of Ga. As(001) under Cs and I deposition Cs I + - + Ø The difference in Cs adsorption on As- and Ga-rich surfaces is due to the difference in the interaction mechanism of Cs with arsenic and gallium surface Phys. Rev. B (2009) atoms!
 I on Ga. As(001): first principal calculation -Ga. As(001)-(4 x 2) 2 -Ga. As(001)-(2 x 4) S 1 T 4 >0 <0 >0 - +
I on Ga. As(001): first principal calculation -Ga. As(001)-(4 x 2) 2 -Ga. As(001)-(2 x 4) S 1 T 4 >0 <0 >0 - +
 Photoemission experiment Core-levels and surface chemical shifts sample +q -q Ga As
Photoemission experiment Core-levels and surface chemical shifts sample +q -q Ga As
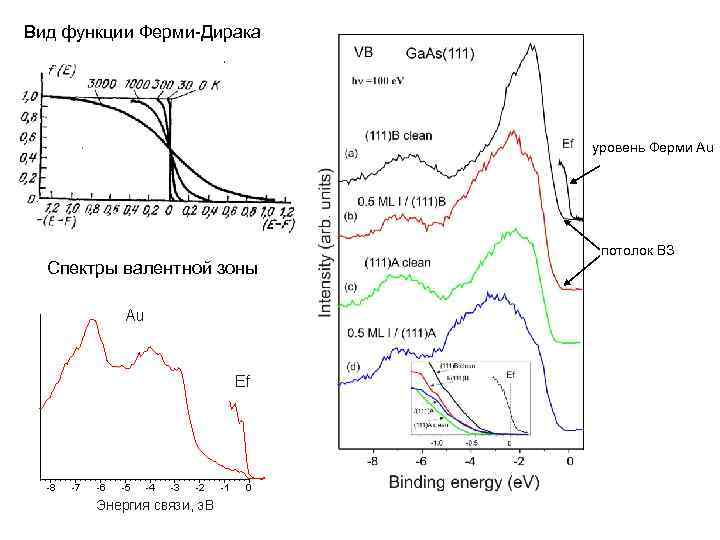 Вид функции Ферми-Дирака уровень Ферми Au потолок ВЗ Спектры валентной зоны
Вид функции Ферми-Дирака уровень Ферми Au потолок ВЗ Спектры валентной зоны
 Pseudopotential approach The basic idea of the pseudopotential The pseudo-wave-function fulfill Schrödinger-like equation with Hamiltonian that is dependent on energy and contains additional repulsive, nonlocal potential. The usage of plane- wave formalism leads to equation We used VASP code, which realized the pseudopotential approach
Pseudopotential approach The basic idea of the pseudopotential The pseudo-wave-function fulfill Schrödinger-like equation with Hamiltonian that is dependent on energy and contains additional repulsive, nonlocal potential. The usage of plane- wave formalism leads to equation We used VASP code, which realized the pseudopotential approach
 Эпитаксия i – на i - упорядоченность - ориентированный рост одного кристалла на поверхности другого (подложки) Общая характеристика методов эпитаксии 4 вида (по типу материнской фазы): 1. Газофазная (CVD- chemical vapor deposition) 1872 г. John Haworth Ga(CH 3)3+As. H 3 Ga. As(тв)+3 CH 4 2. Жидкофазная ( LPE – liquid phase epitaxy) 1963 Henri Nelson Leo Esaki – изобрёл туннельный диод (Нобель. Л. ) 3. Молекулярно – лучевая (пучковая) эпитаксия. В конце 1960 -х годов Дж. Р. Артуром (J. R. Arthur) и Альфредом Чо (Alfred Y. Cho). 4. Твердофазная эпитаксия
Эпитаксия i – на i - упорядоченность - ориентированный рост одного кристалла на поверхности другого (подложки) Общая характеристика методов эпитаксии 4 вида (по типу материнской фазы): 1. Газофазная (CVD- chemical vapor deposition) 1872 г. John Haworth Ga(CH 3)3+As. H 3 Ga. As(тв)+3 CH 4 2. Жидкофазная ( LPE – liquid phase epitaxy) 1963 Henri Nelson Leo Esaki – изобрёл туннельный диод (Нобель. Л. ) 3. Молекулярно – лучевая (пучковая) эпитаксия. В конце 1960 -х годов Дж. Р. Артуром (J. R. Arthur) и Альфредом Чо (Alfred Y. Cho). 4. Твердофазная эпитаксия
 Фундаментальные проблемы эпитаксии (по Чикичеву С. И. ) 1. Какие физические принципы определяют эпитаксиальный рост? При каких условиях эпитаксия невозможна? 2. Для пары произвольно выбранных материалов, каковы условия, при которых эпитаксия термодинамически устойчива. Какова равновесная фазовая диаграмма в зависимости от таких параметров, как толщина, решёточное несоответствие, состав (стехиометрия) 3. Какие структуры, отличающиеся от объёмной (равновесной), возникают на начальной стадии эпитаксиального роста. Достаточно ли интуитивных аргументов для предсказания поверхностных структур. Каков наилучший способ описания идентификации и предсказания факторов, контролирующих рост (например, поверхностная энергия границы раздела). 4. Каким образом ступени на поверхности влияют на рост и структуру эпитаксиального слоя? Можно ли ими контролировать, с тем чтобы управлять структурой и морфологией, возникающей в ходе эпитаксии. Может ли рост или устойчивость желаемой структуры управляться с помощью исскуственных ограничений типа: конечного латерального размера подложки или спецрельефа как при графоэпитаксия.
Фундаментальные проблемы эпитаксии (по Чикичеву С. И. ) 1. Какие физические принципы определяют эпитаксиальный рост? При каких условиях эпитаксия невозможна? 2. Для пары произвольно выбранных материалов, каковы условия, при которых эпитаксия термодинамически устойчива. Какова равновесная фазовая диаграмма в зависимости от таких параметров, как толщина, решёточное несоответствие, состав (стехиометрия) 3. Какие структуры, отличающиеся от объёмной (равновесной), возникают на начальной стадии эпитаксиального роста. Достаточно ли интуитивных аргументов для предсказания поверхностных структур. Каков наилучший способ описания идентификации и предсказания факторов, контролирующих рост (например, поверхностная энергия границы раздела). 4. Каким образом ступени на поверхности влияют на рост и структуру эпитаксиального слоя? Можно ли ими контролировать, с тем чтобы управлять структурой и морфологией, возникающей в ходе эпитаксии. Может ли рост или устойчивость желаемой структуры управляться с помощью исскуственных ограничений типа: конечного латерального размера подложки или спецрельефа как при графоэпитаксия.
 5. Какие метастабильные фазы могут индуцироваться эпитаксиальным ростом или специальной обработкой? Каков наилучший способ описания релаксации метастабильных фаз? Можно ли контролировать деградацию нужной фазы? 6. Как реалистично описывать кинетические процессы происходящие при росте? (Если мы знаем исходную структуру подложки и все атомные детали (обычно), можем ли мы предсказать морфологию и структуру, получающегося эпислоя? 7. Можно ли путём соответствующих обработок поверхности и выбором ростовых условий заставить плёнку расти послойно с гладкими, резкими границами путём создания энергетических барьеров, предотвращающих развитие рельефа и трёхмерный рост. 8. Каковы энергетические, энтропийные и электронные свойства дефектов гетерограниц и гетероструктур, возникающих при гетероэпитаксии?
5. Какие метастабильные фазы могут индуцироваться эпитаксиальным ростом или специальной обработкой? Каков наилучший способ описания релаксации метастабильных фаз? Можно ли контролировать деградацию нужной фазы? 6. Как реалистично описывать кинетические процессы происходящие при росте? (Если мы знаем исходную структуру подложки и все атомные детали (обычно), можем ли мы предсказать морфологию и структуру, получающегося эпислоя? 7. Можно ли путём соответствующих обработок поверхности и выбором ростовых условий заставить плёнку расти послойно с гладкими, резкими границами путём создания энергетических барьеров, предотвращающих развитие рельефа и трёхмерный рост. 8. Каковы энергетические, энтропийные и электронные свойства дефектов гетерограниц и гетероструктур, возникающих при гетероэпитаксии?
 Система молекулярно-лучевой эпитаксии Схема MBE установки: 1 – подложка, 2 – растущая пленка, 3 – заслонки, 4 – эффузионные ячейки основных компонентов, 5 – эффузионные ячейки легирующих примесей; I – зона генерации молекулярных пучков, II – зона смешивания пучков, III – зона кристаллизации на подложке (зона роста)
Система молекулярно-лучевой эпитаксии Схема MBE установки: 1 – подложка, 2 – растущая пленка, 3 – заслонки, 4 – эффузионные ячейки основных компонентов, 5 – эффузионные ячейки легирующих примесей; I – зона генерации молекулярных пучков, II – зона смешивания пучков, III – зона кристаллизации на подложке (зона роста)
 Experimental Set-Up Riber CBE-32 Substrate: (0001)Al 2 O 3 back side is coated by Mo or Cr Variation ranges of growth parameters: Growth rate 0. 1 -1. 0 ML/s Substrate temperature 20 - 1100 o C Ammonia flux 5 x 10 -7 – 5 x 10 -4 Torr Sources: Ga, Al – effusion cells NH 3 – gas source
Experimental Set-Up Riber CBE-32 Substrate: (0001)Al 2 O 3 back side is coated by Mo or Cr Variation ranges of growth parameters: Growth rate 0. 1 -1. 0 ML/s Substrate temperature 20 - 1100 o C Ammonia flux 5 x 10 -7 – 5 x 10 -4 Torr Sources: Ga, Al – effusion cells NH 3 – gas source
 Reflection High-Energy Electron Diffraction Cathodoluminescence Specular beam detection h Initial beam Sample Registration system fluorescent Controller display CCD camera
Reflection High-Energy Electron Diffraction Cathodoluminescence Specular beam detection h Initial beam Sample Registration system fluorescent Controller display CCD camera
 Ga. N(0001): growth conditions N-polar Ga-polar (1 x 1) (2 x 2)
Ga. N(0001): growth conditions N-polar Ga-polar (1 x 1) (2 x 2)
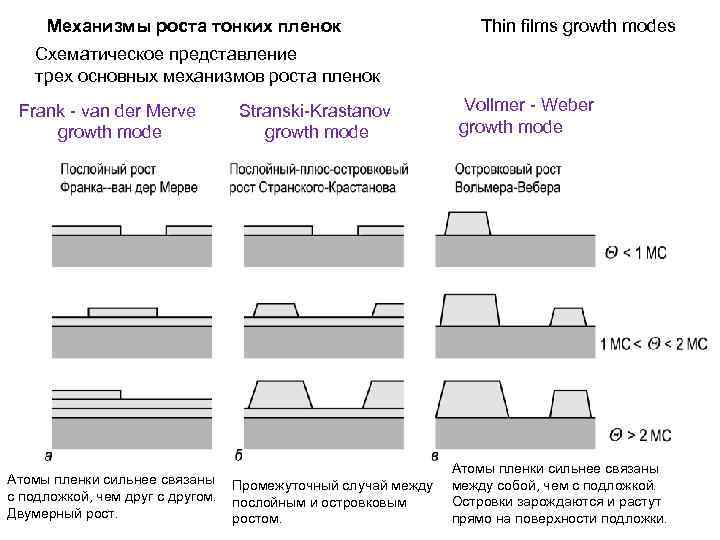 Механизмы роста тонких пленок Thin films growth modes Схематическое представление трех основных механизмов роста пленок Frank - van der Merve Stranski-Krastanov Vollmer - Weber growth mode Атомы пленки сильнее связаны Промежуточный случай между собой, чем с подложкой, чем друг с другом. послойным и островковым Островки зарождаются и растут Двумерный рост. ростом. прямо на поверхности подложки.
Механизмы роста тонких пленок Thin films growth modes Схематическое представление трех основных механизмов роста пленок Frank - van der Merve Stranski-Krastanov Vollmer - Weber growth mode Атомы пленки сильнее связаны Промежуточный случай между собой, чем с подложкой, чем друг с другом. послойным и островковым Островки зарождаются и растут Двумерный рост. ростом. прямо на поверхности подложки.
 Элементарные процессы в зоне роста: 1 – адсорбция атомов из зоны смешивания на поверхности, 2 – миграция адсорбированных ато- мов по поверхности, 3 – встраивание адсорбированных атомов в крис- таллическую решетку, 4 – термическая десорбция, 5 – образование по- верхностных зародышей, 6 – взаимная диффузия. Над растущей поверх- ностью показаны атомы газовой смеси компонентов в приповерхностной области. Буквами n-n и i-i показаны нормальная и инвертированная поверхности раздела растущей гетероструктуры.
Элементарные процессы в зоне роста: 1 – адсорбция атомов из зоны смешивания на поверхности, 2 – миграция адсорбированных ато- мов по поверхности, 3 – встраивание адсорбированных атомов в крис- таллическую решетку, 4 – термическая десорбция, 5 – образование по- верхностных зародышей, 6 – взаимная диффузия. Над растущей поверх- ностью показаны атомы газовой смеси компонентов в приповерхностной области. Буквами n-n и i-i показаны нормальная и инвертированная поверхности раздела растущей гетероструктуры.

