НАНОЭЛЕКТРОНИКА материалы к государственному










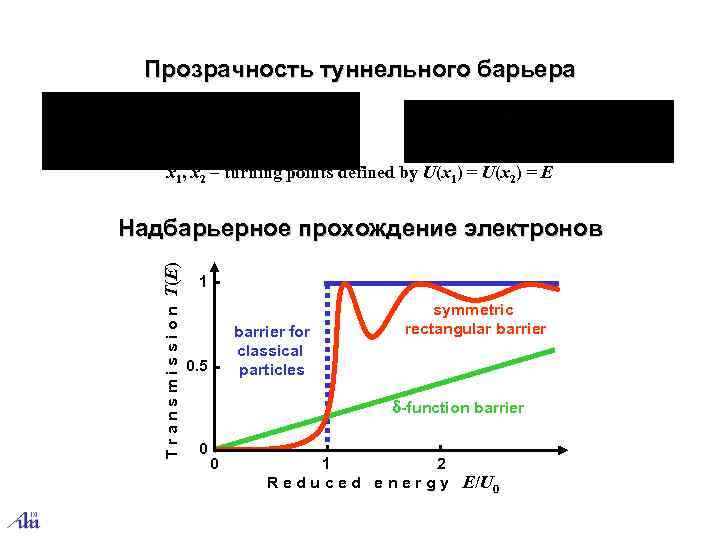


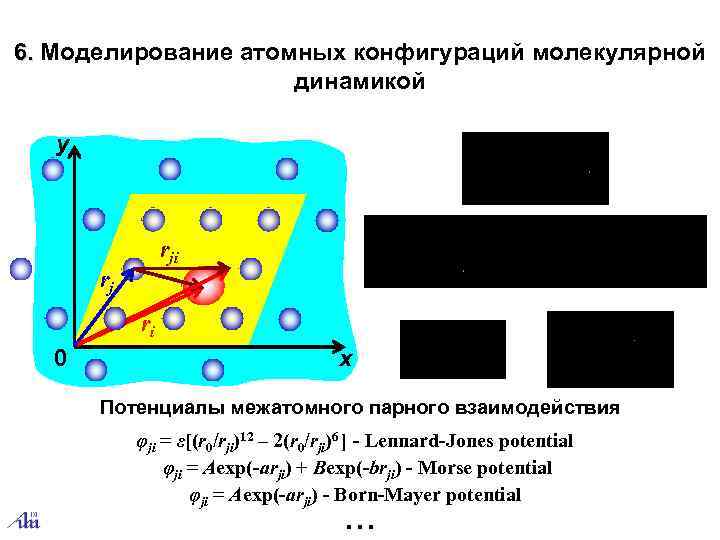
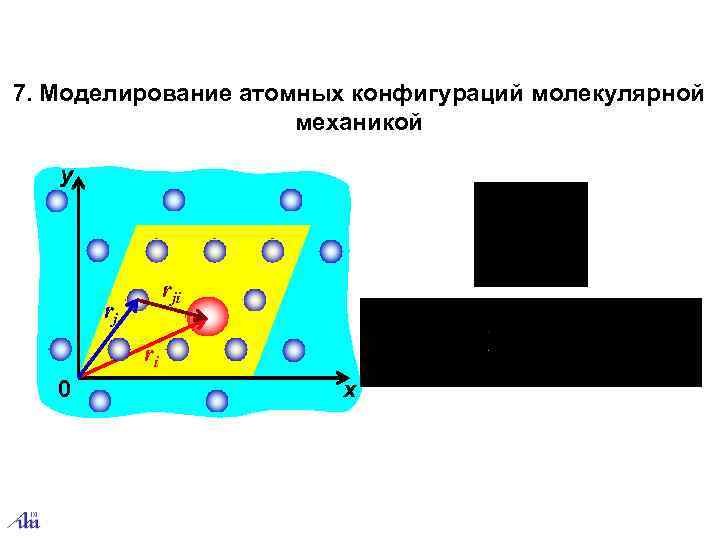

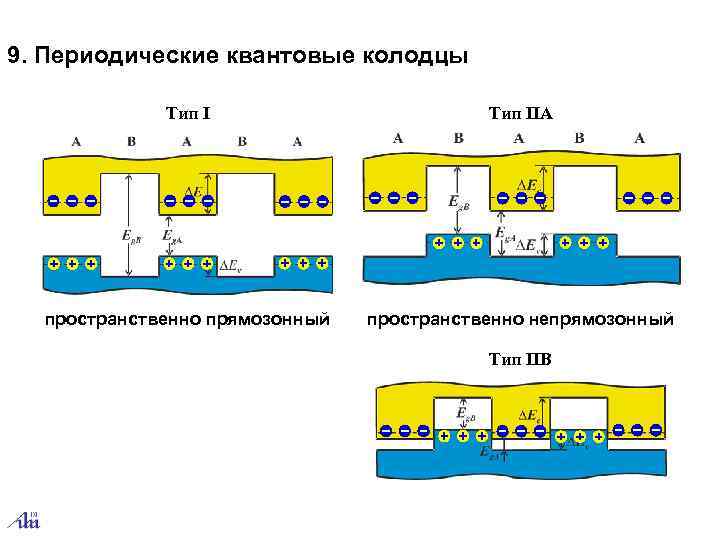
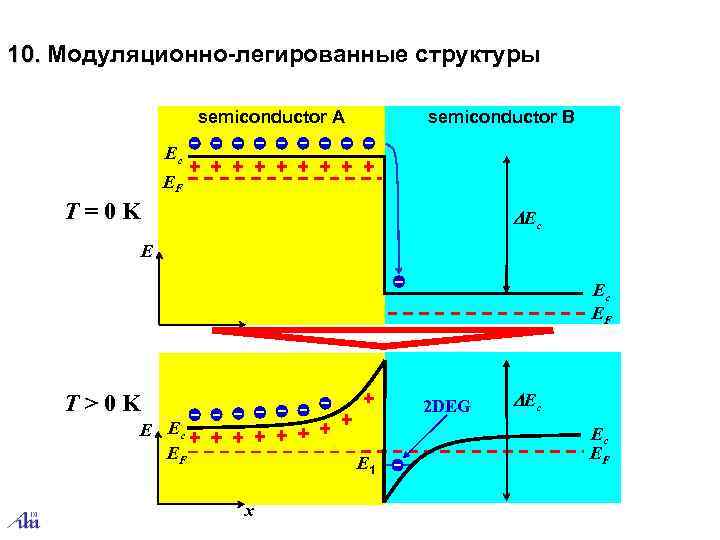


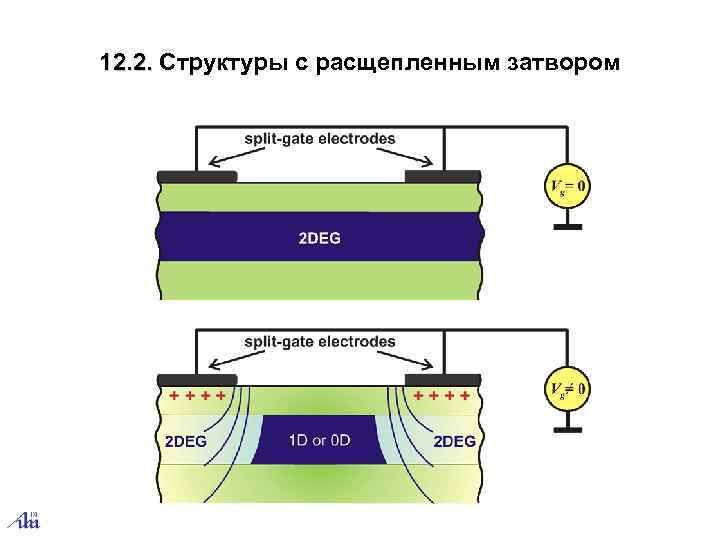

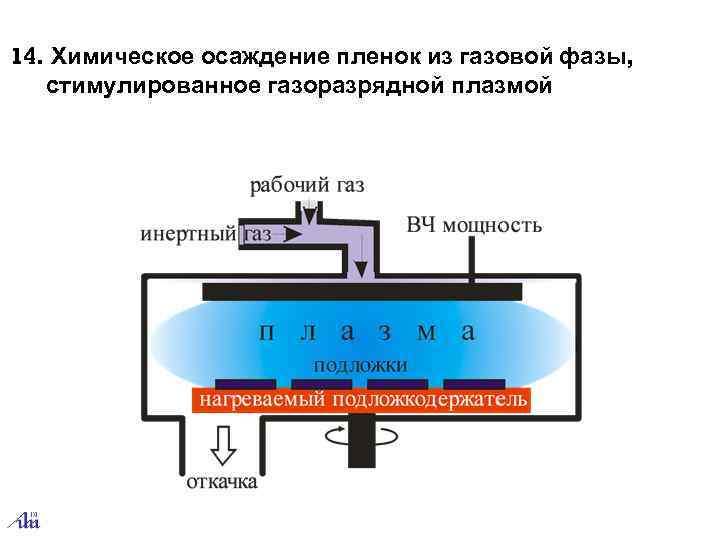
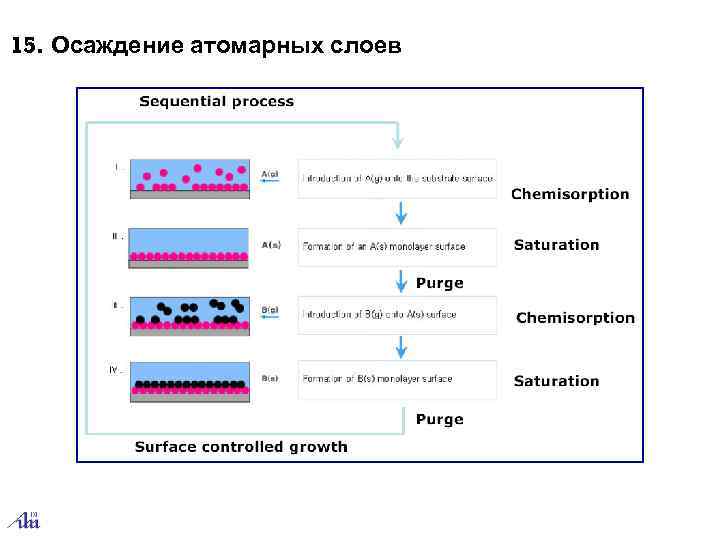
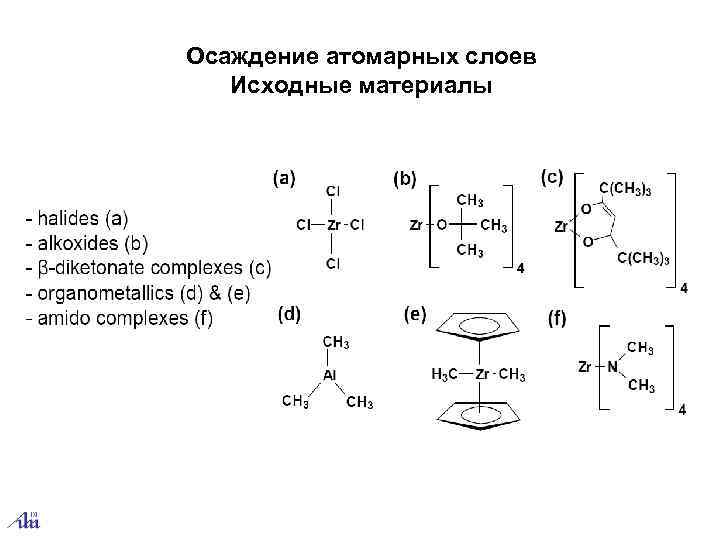






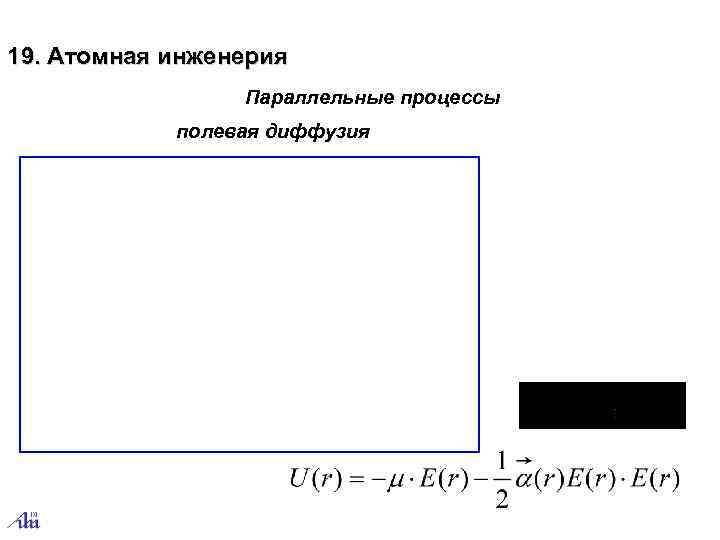
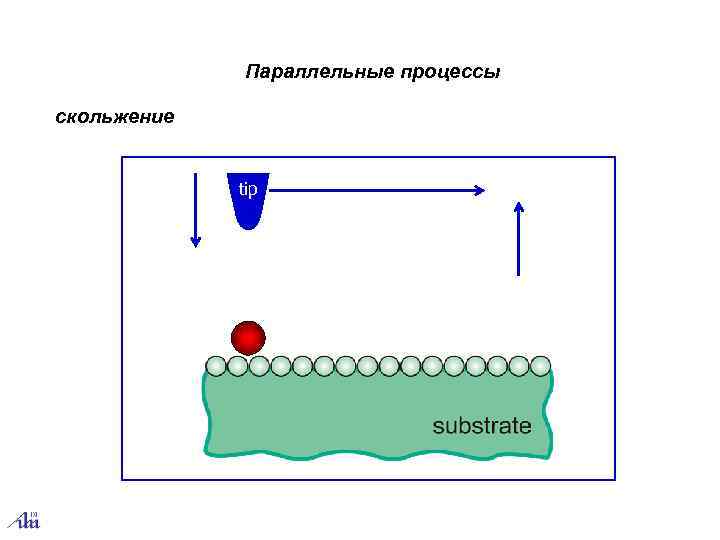



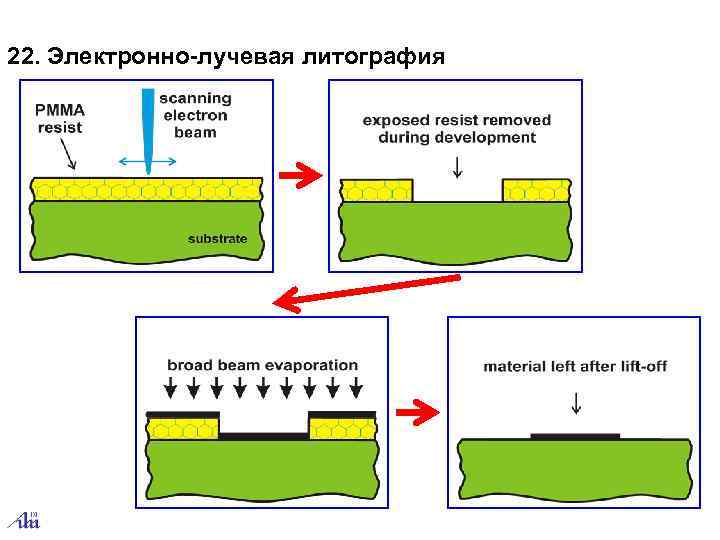
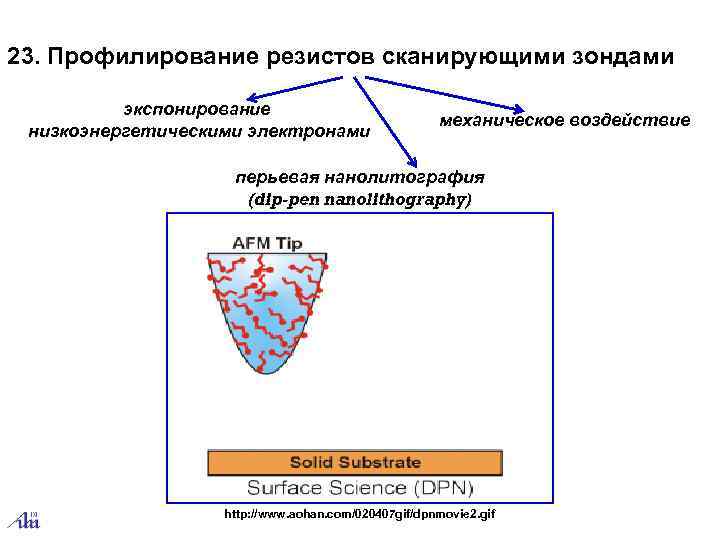
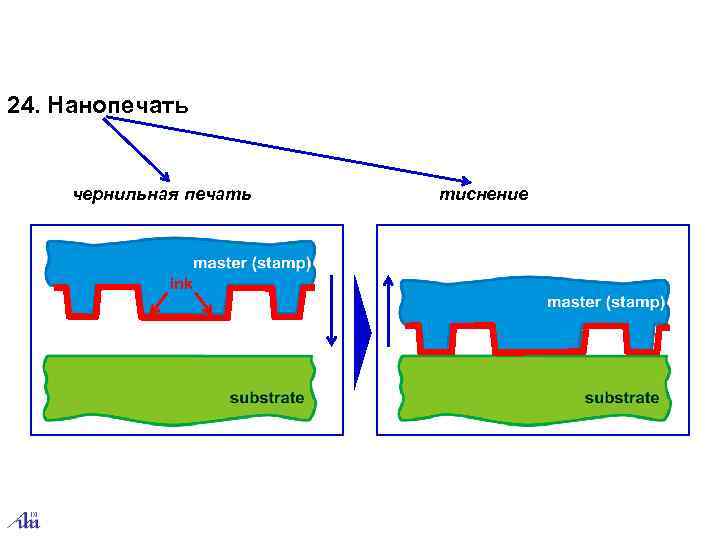
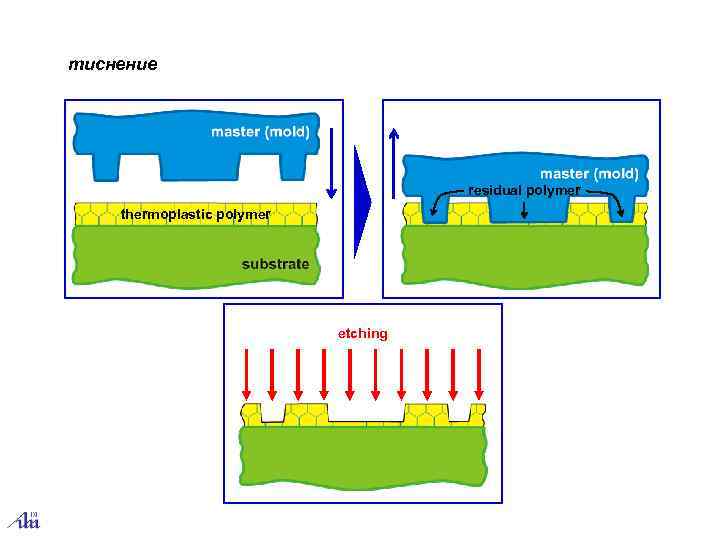


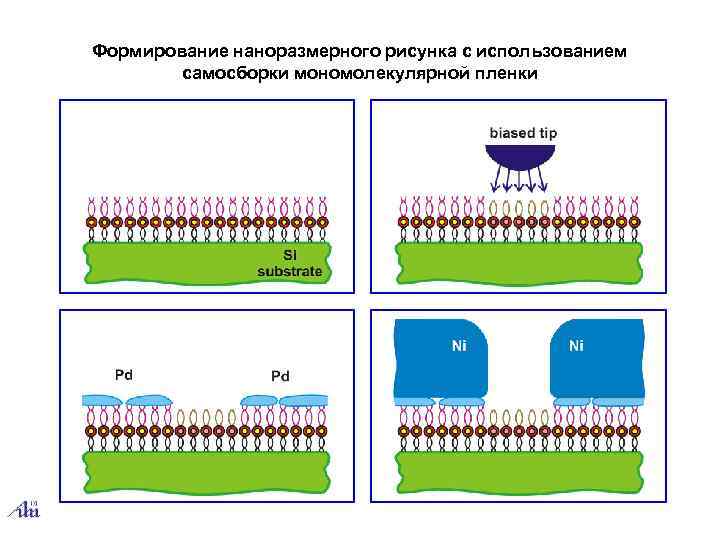

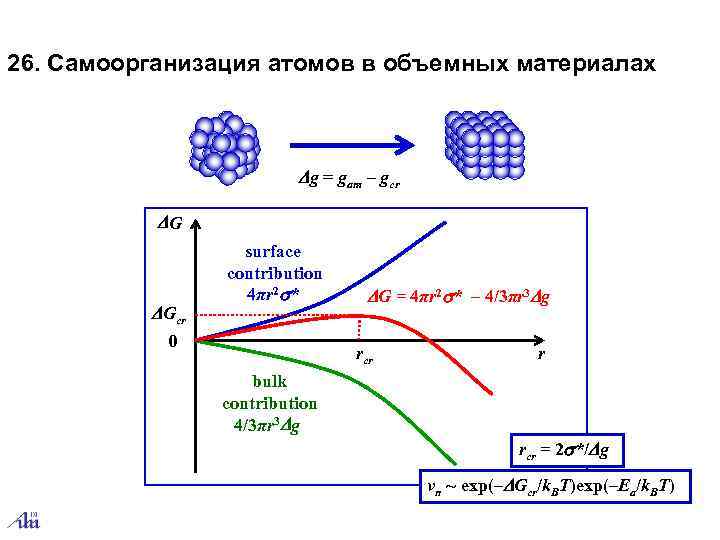


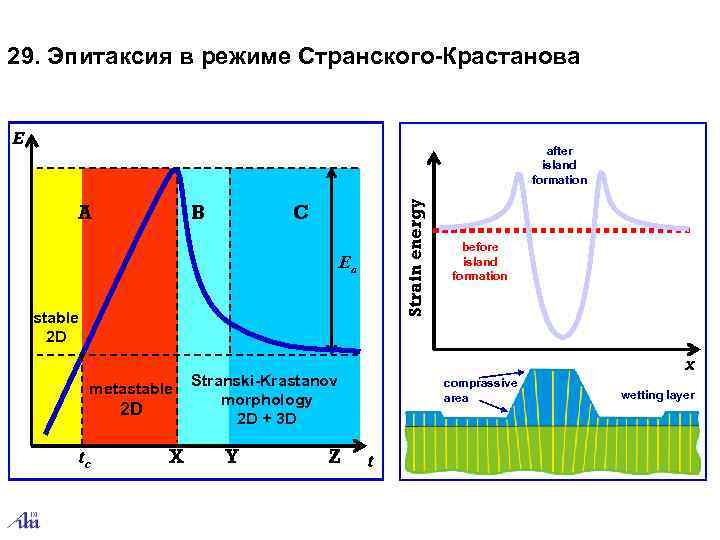
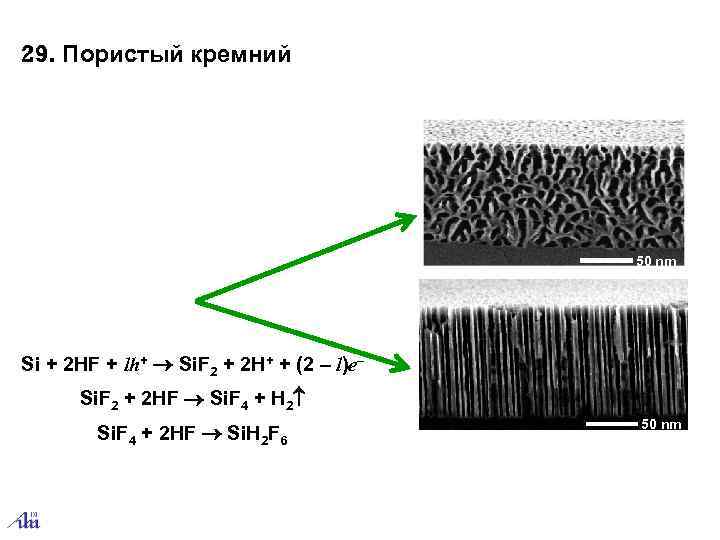
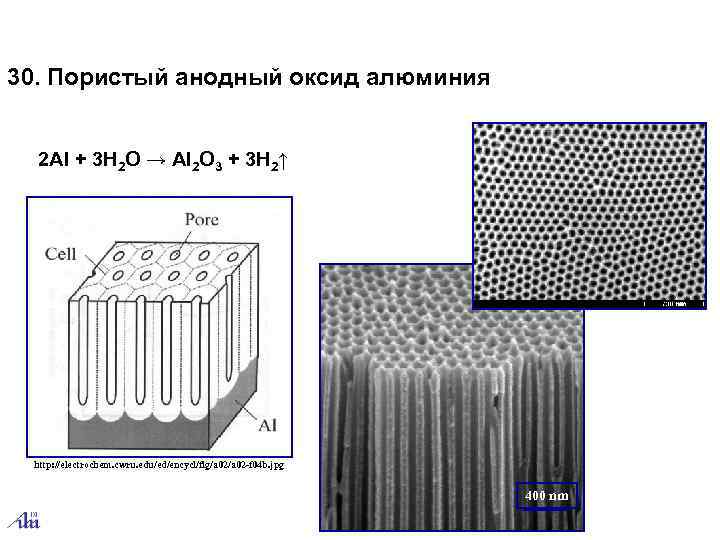







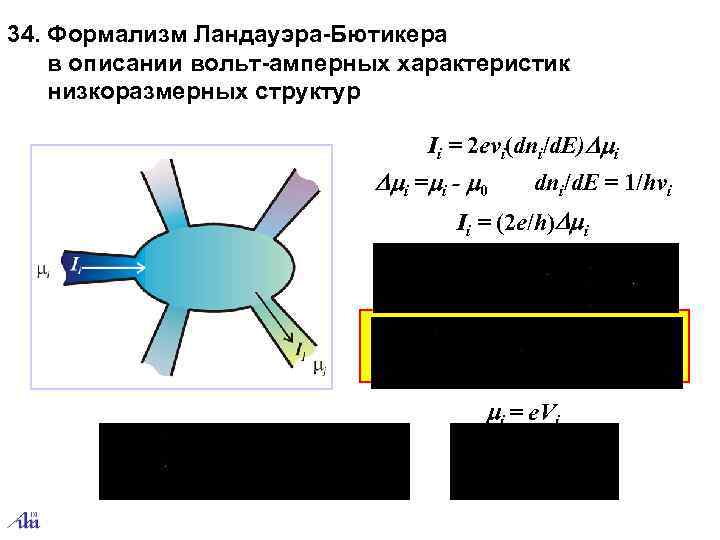

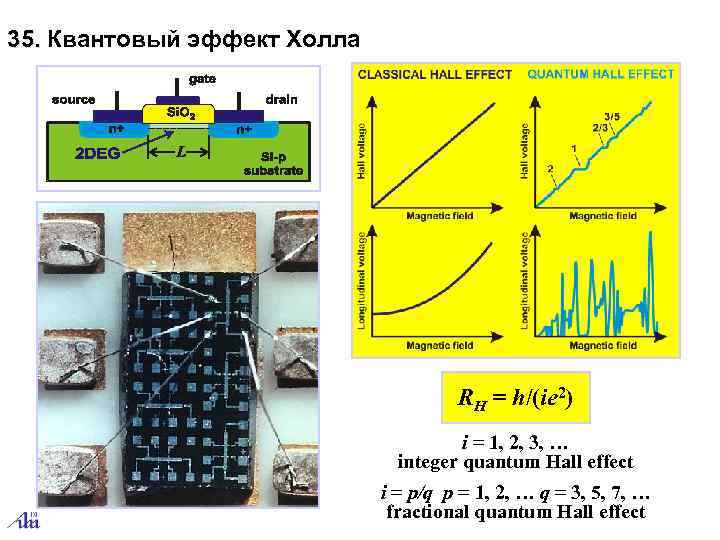

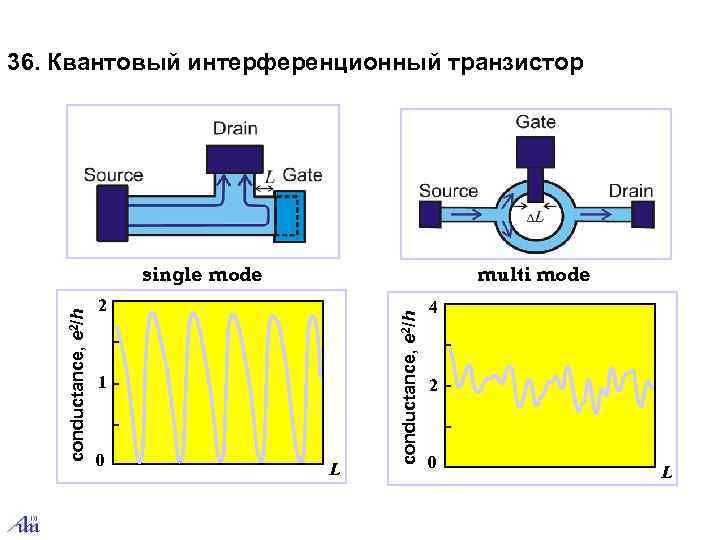
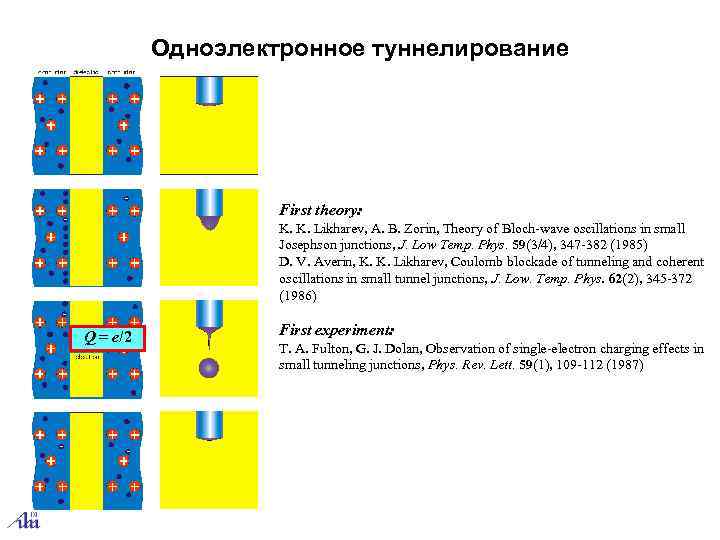
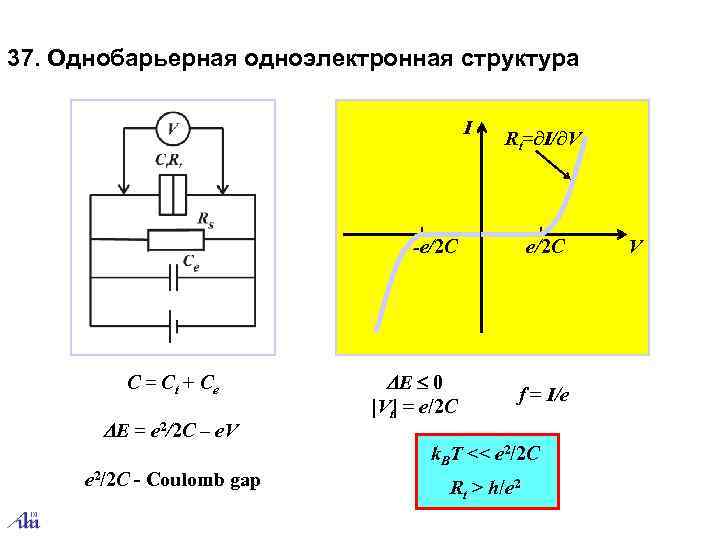
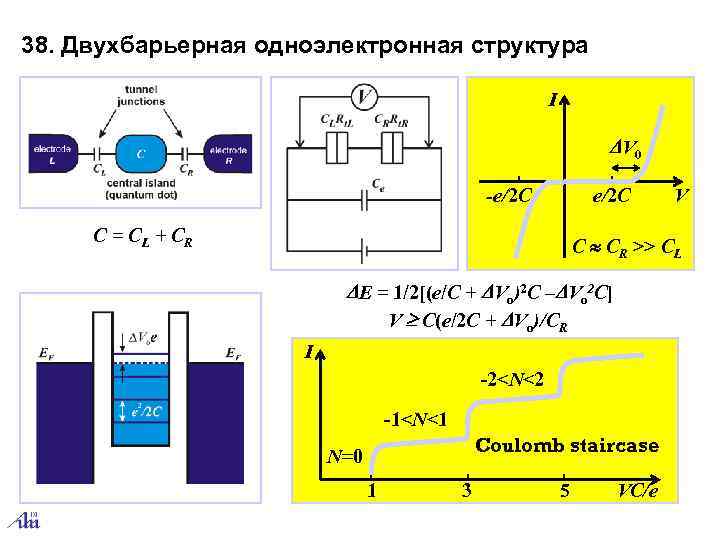
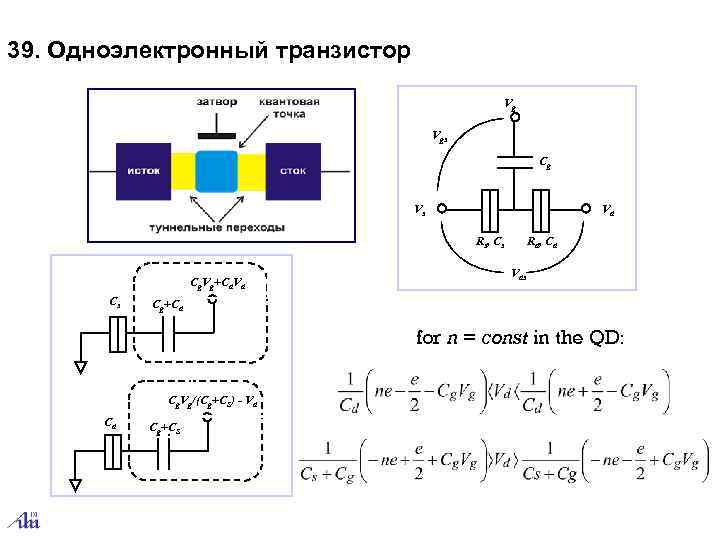


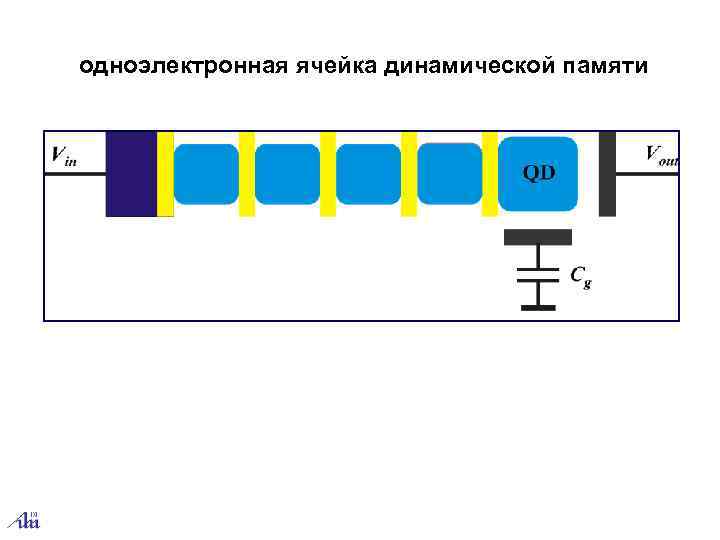
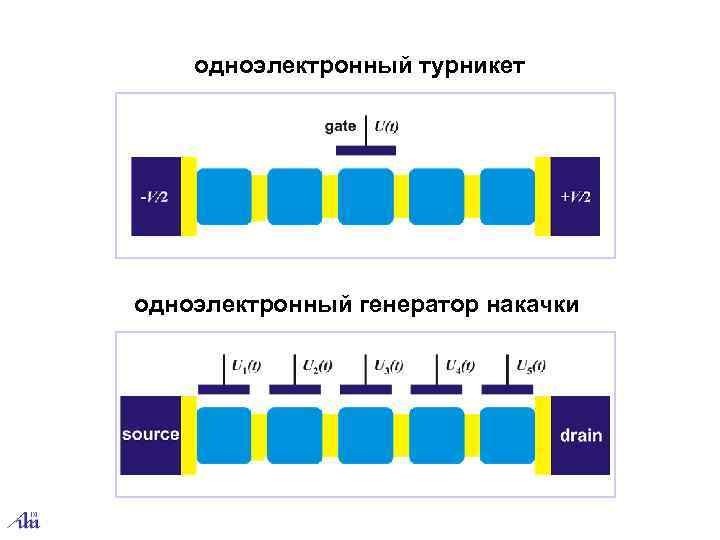

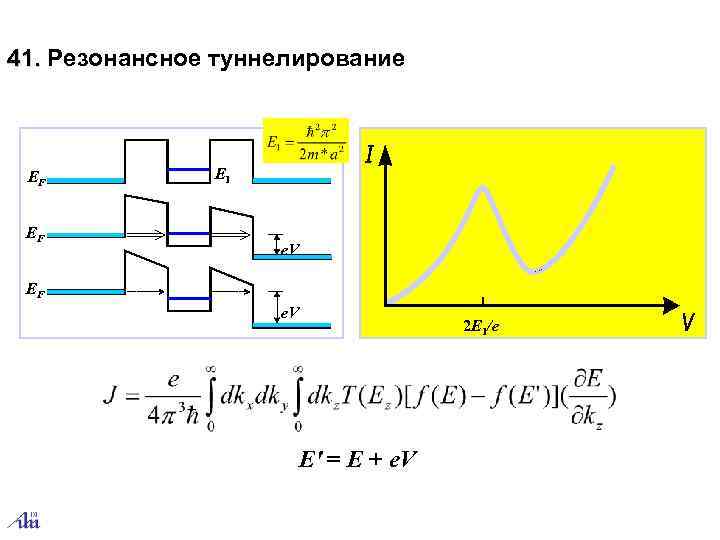
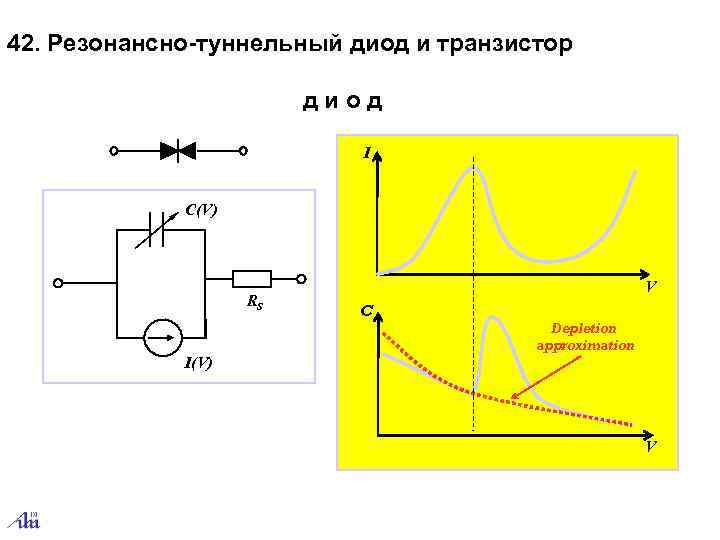
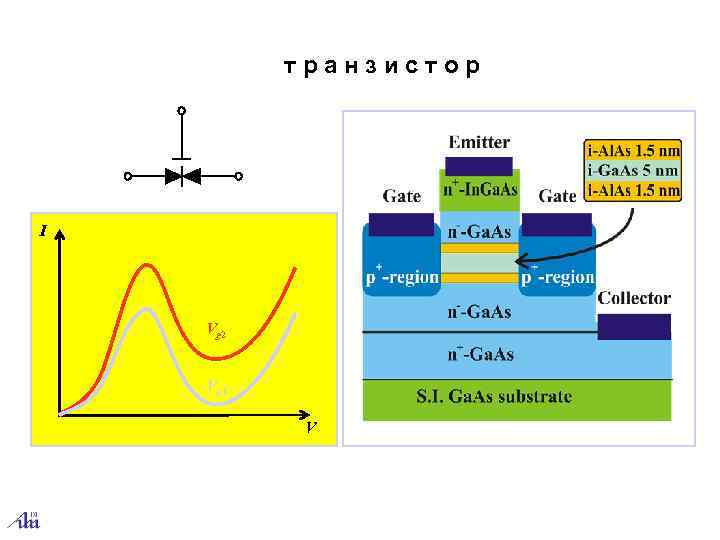
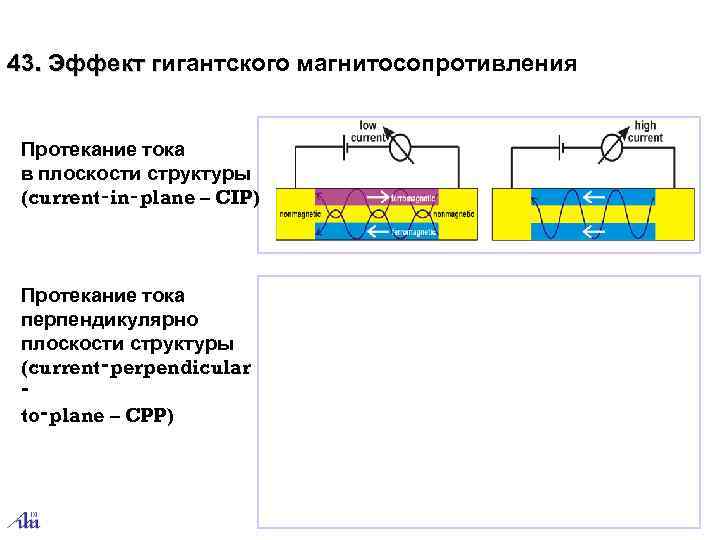
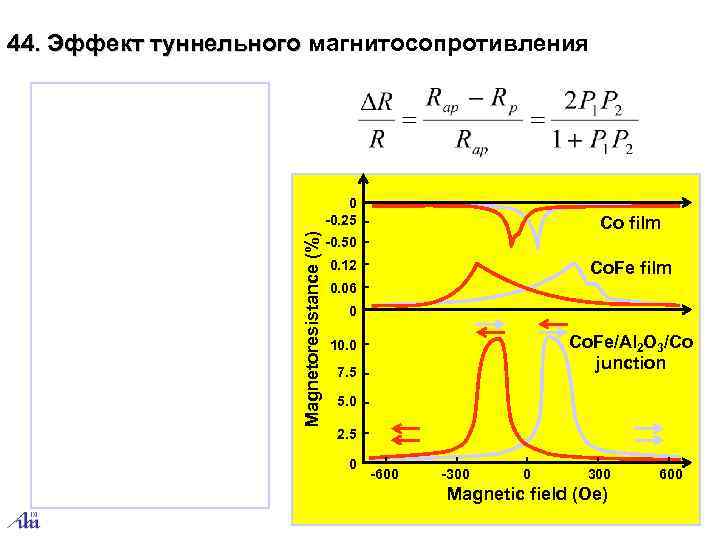
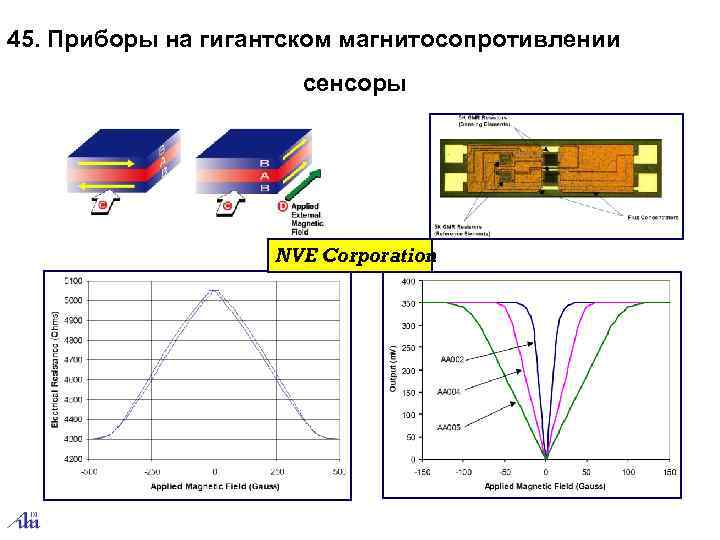
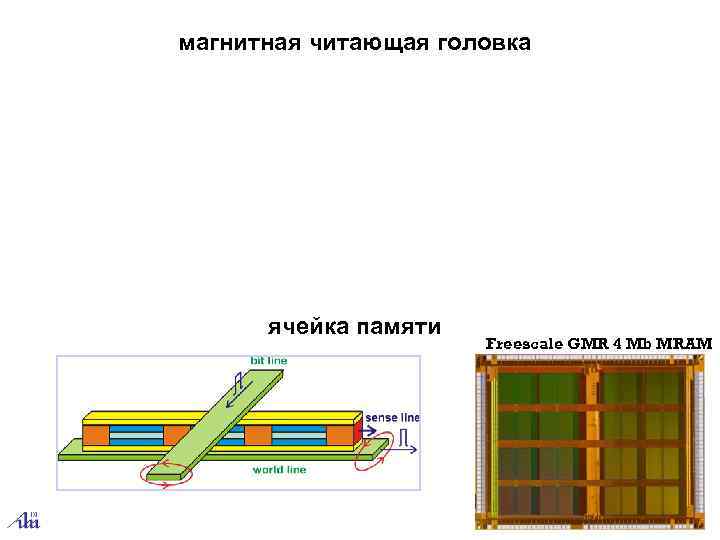
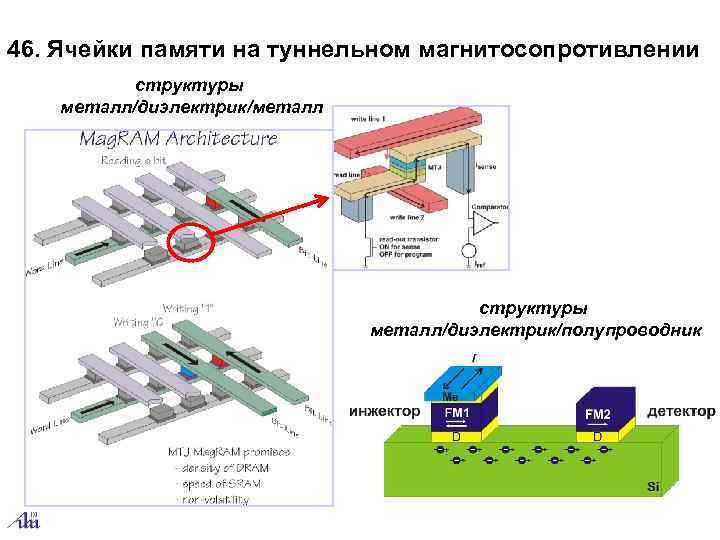

Наноэлектроника - госэкзамен.ppt
- Количество слайдов: 79
 НАНОЭЛЕКТРОНИКА материалы к государственному экзамену В. Е. Борисенко Белорусский государственный университет информатики и радиоэлектроники
НАНОЭЛЕКТРОНИКА материалы к государственному экзамену В. Е. Борисенко Белорусский государственный университет информатики и радиоэлектроники
 Л И Т Е Р А Т У Р А e-library в лаборатории 119 -1 отв. Стемпицкий Виктор Романович
Л И Т Е Р А Т У Р А e-library в лаборатории 119 -1 отв. Стемпицкий Виктор Романович
 Наноэлектроника (nanoelectronics) это область науки и техники, занимающаяся созданием, исследованием и применением электронных приборов с нанометровыми размерами элементов, в основе функционирования которых лежат квантовые эффекты.
Наноэлектроника (nanoelectronics) это область науки и техники, занимающаяся созданием, исследованием и применением электронных приборов с нанометровыми размерами элементов, в основе функционирования которых лежат квантовые эффекты.
 1. Квантовое ограничение free electrons: confined electrons: n=3 n = 2 a/n (n = 1, 2, . . . ) E 3 kn = 2 / n = n /a U(x) n=2 E 2 Y(x) n=1 E 1 0 a x
1. Квантовое ограничение free electrons: confined electrons: n=3 n = 2 a/n (n = 1, 2, . . . ) E 3 kn = 2 / n = n /a U(x) n=2 E 2 Y(x) n=1 E 1 0 a x
 Следствия квантового ограничения в низкоразмерных структурах конечное ненулевое минимальное значение энергии носителей заряда дискретность разрешенных энергетических состояний изменение характера межзонных переходов CB CB VB
Следствия квантового ограничения в низкоразмерных структурах конечное ненулевое минимальное значение энергии носителей заряда дискретность разрешенных энергетических состояний изменение характера межзонных переходов CB CB VB
 2. Элементарные низкоразмерные структуры
2. Элементарные низкоразмерные структуры
 3. Баллистический транспорт носителей заряда и универсальная баллистическая проводимость определения EF → v. F = (2 EF/m)1/2, k. F = (2 m*EF)1/2/ħ , F = 2 /k. F средняя длина свободного пробега le = v. F sc = Dd/v. F 2 при упругом рассеянии средняя длина свободного пробега lin = v. F при неупругом рассеянии длина фазовой когерентности l = (D )1/2
3. Баллистический транспорт носителей заряда и универсальная баллистическая проводимость определения EF → v. F = (2 EF/m)1/2, k. F = (2 m*EF)1/2/ħ , F = 2 /k. F средняя длина свободного пробега le = v. F sc = Dd/v. F 2 при упругом рассеянии средняя длина свободного пробега lin = v. F при неупругом рассеянии длина фазовой когерентности l = (D )1/2
 Универсальная баллистическая проводимость I = ( 1 – 2)ev(dn/d ) dn/d = 1/ ħv (for 2 spins) ( 1 – 2) = e(V 1 – V 2) 1 2 G = I/(V 1 – V 2) G = e 2/ ħ = 2 e 2/h e 2/h = 38, 740 мк. См, h/e 2 = 25, 812807 к. Ом
Универсальная баллистическая проводимость I = ( 1 – 2)ev(dn/d ) dn/d = 1/ ħv (for 2 spins) ( 1 – 2) = e(V 1 – V 2) 1 2 G = I/(V 1 – V 2) G = e 2/ ħ = 2 e 2/h e 2/h = 38, 740 мк. См, h/e 2 = 25, 812807 к. Ом
 4. Туннелирование носителей заряда
4. Туннелирование носителей заряда
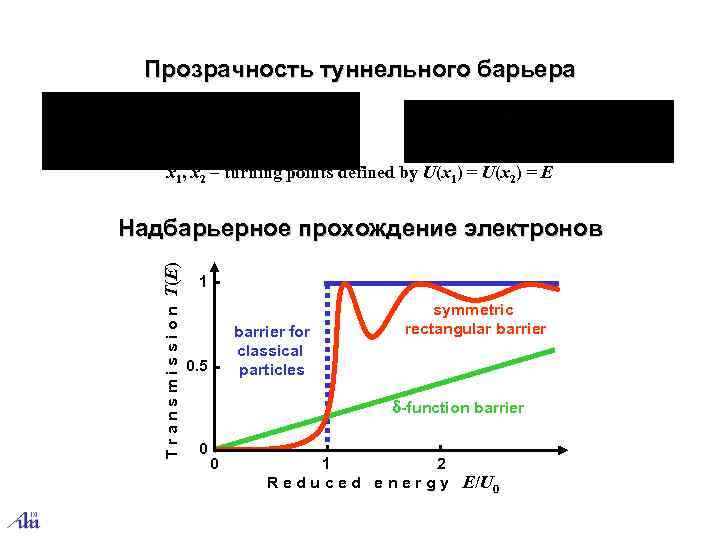 Прозрачность туннельного барьера x 1, x 2 – turning points defined by U(x 1) = U(x 2) = E Надбарьерное прохождение электронов T r a n s m i s s i o n T(E) 1 symmetric barrier for rectangular barrier classical 0. 5 particles d-function barrier 0 1 2 R e d u c e d e n e r g y E/U 0
Прозрачность туннельного барьера x 1, x 2 – turning points defined by U(x 1) = U(x 2) = E Надбарьерное прохождение электронов T r a n s m i s s i o n T(E) 1 symmetric barrier for rectangular barrier classical 0. 5 particles d-function barrier 0 1 2 R e d u c e d e n e r g y E/U 0
 5. Сверхрешетки film material strained superlattice relaxed superlattice substrate material substrate
5. Сверхрешетки film material strained superlattice relaxed superlattice substrate material substrate
 Конструирование сверхрешеток из полупроводников правило Вегарда: a(x) = xa 1 + (1 - x)a 2
Конструирование сверхрешеток из полупроводников правило Вегарда: a(x) = xa 1 + (1 - x)a 2
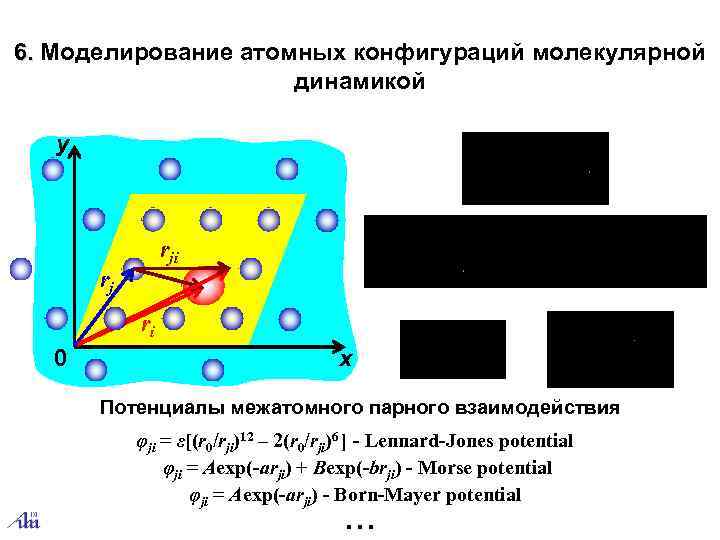 6. Моделирование атомных конфигураций молекулярной динамикой y rji rj ri 0 x Потенциалы межатомного парного взаимодействия φji = ε[(r 0/rji)12 – 2(r 0/rji)6 ] - Lennard-Jones potential φji = Aexp(-arji) + Bexp(‑brji) - Morse potential φji = Aexp(-arji) - Born-Mayer potential …
6. Моделирование атомных конфигураций молекулярной динамикой y rji rj ri 0 x Потенциалы межатомного парного взаимодействия φji = ε[(r 0/rji)12 – 2(r 0/rji)6 ] - Lennard-Jones potential φji = Aexp(-arji) + Bexp(‑brji) - Morse potential φji = Aexp(-arji) - Born-Mayer potential …
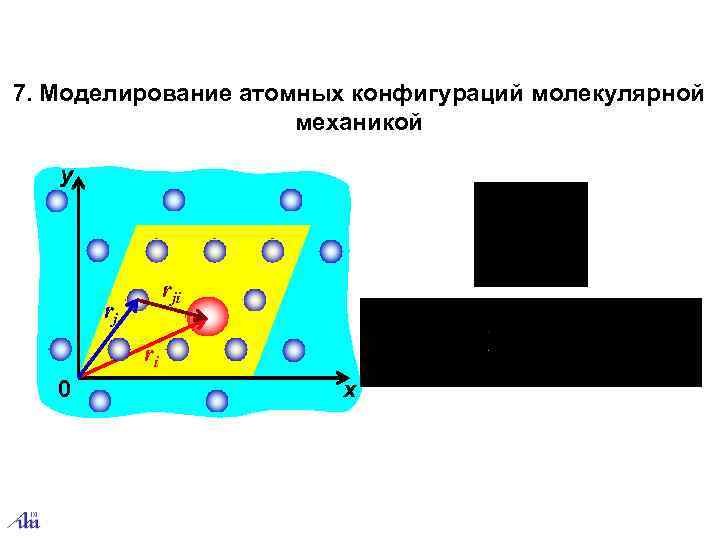 7. Моделирование атомных конфигураций молекулярной механикой y rji rj ri 0 x
7. Моделирование атомных конфигураций молекулярной механикой y rji rj ri 0 x
 8. Правило Андерсона для гетероструктур Ec = Ec. B – Ec. A = c. A – c. B Ev = Eg. B – Eg. A – Ec
8. Правило Андерсона для гетероструктур Ec = Ec. B – Ec. A = c. A – c. B Ev = Eg. B – Eg. A – Ec
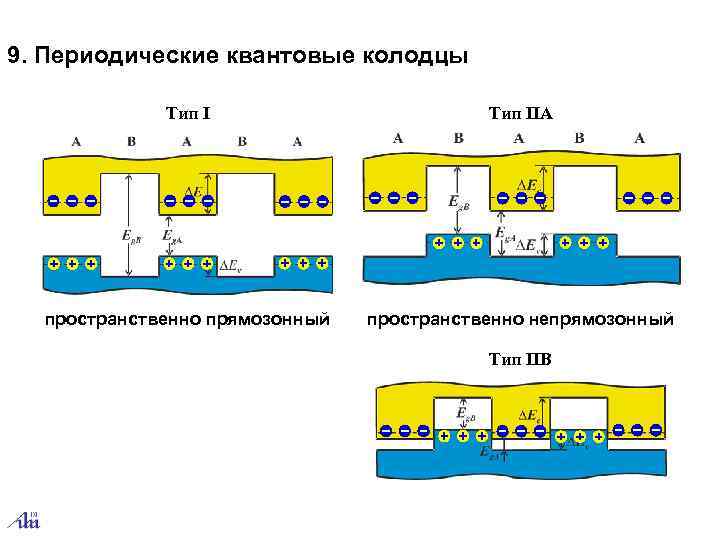 9. Периодические квантовые колодцы Тип IIА пространственно прямозонный пространственно непрямозонный Тип IIВ
9. Периодические квантовые колодцы Тип IIА пространственно прямозонный пространственно непрямозонный Тип IIВ
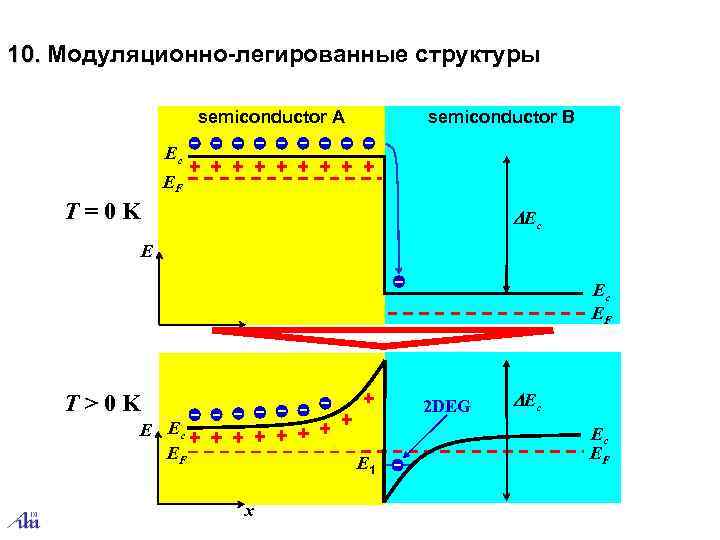 10. Модуляционно-легированные структуры semiconductor A semiconductor B Ec EF T = 0 K Ec E Ec EF x T > 0 K 2 DEG Ec E Ec EF E 1 x
10. Модуляционно-легированные структуры semiconductor A semiconductor B Ec EF T = 0 K Ec E Ec EF x T > 0 K 2 DEG Ec E Ec EF E 1 x
 11. Дельта-легированные структуры
11. Дельта-легированные структуры
 12. Структуры с квантовым ограничением 12. внешним электрическим полем 12. 1. Структуры металл/диэлектрик/полупроводник 12. 1.
12. Структуры с квантовым ограничением 12. внешним электрическим полем 12. 1. Структуры металл/диэлектрик/полупроводник 12. 1.
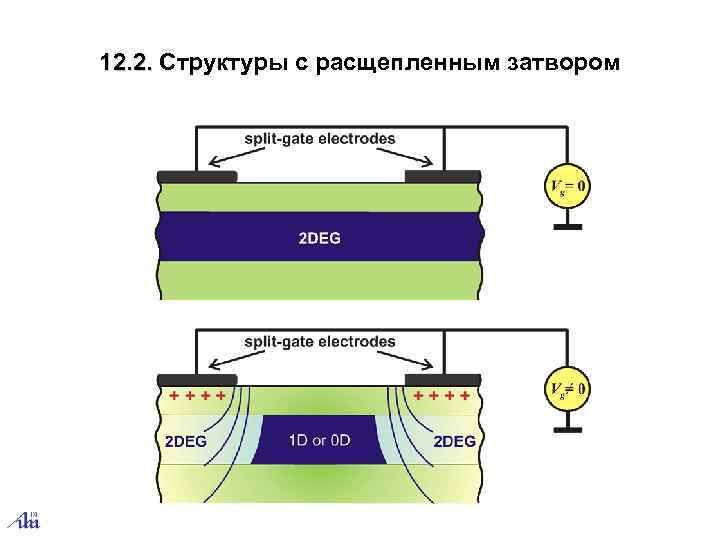 12. 2. Структуры с расщепленным затвором
12. 2. Структуры с расщепленным затвором
 13. Химическое осаждение пленок из газовой фазы 650 o. C (CH 3)3 Ga + As. H 3 → Ga. As↓ + 3 CH 4 Химическое осаждение из газовой фазы при пониженном давлении (low pressure chemical vapor deposition, LPCVD) P = 0, 1 – 2, 0 Торр
13. Химическое осаждение пленок из газовой фазы 650 o. C (CH 3)3 Ga + As. H 3 → Ga. As↓ + 3 CH 4 Химическое осаждение из газовой фазы при пониженном давлении (low pressure chemical vapor deposition, LPCVD) P = 0, 1 – 2, 0 Торр
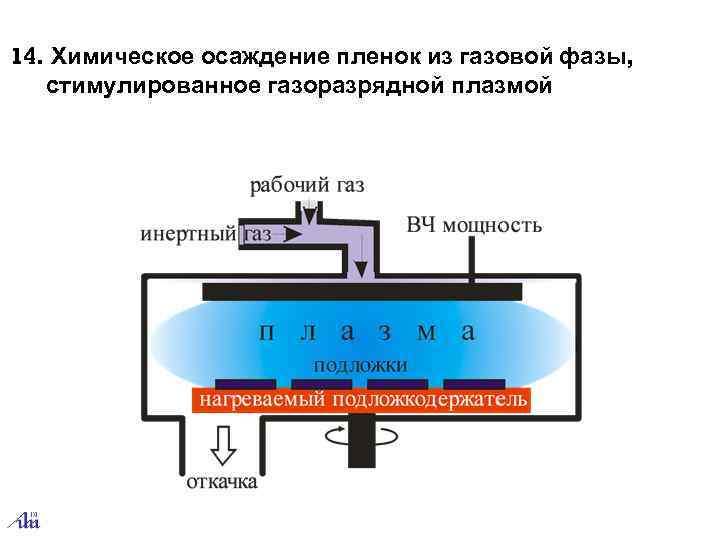 14. Химическое осаждение пленок из газовой фазы, стимулированное газоразрядной плазмой
14. Химическое осаждение пленок из газовой фазы, стимулированное газоразрядной плазмой
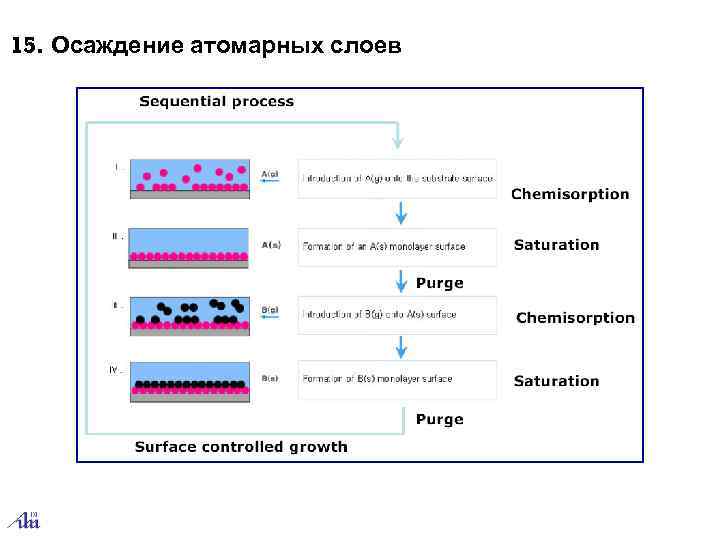 15. Осаждение атомарных слоев
15. Осаждение атомарных слоев
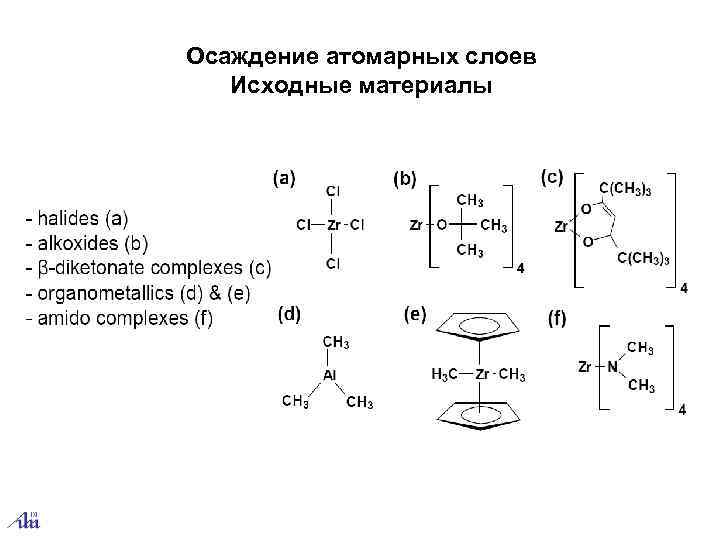 Осаждение атомарных слоев Исходные материалы
Осаждение атомарных слоев Исходные материалы
 Формирование пленки Al 2 O 3 осаждением атомарных слоев
Формирование пленки Al 2 O 3 осаждением атомарных слоев
 16. Молекулярно-лучевая эпитаксия
16. Молекулярно-лучевая эпитаксия
 Reflection High Energy Electron Diffraction Low Energy Electron Diffraction
Reflection High Energy Electron Diffraction Low Energy Electron Diffraction
 17. Физические основы сканирующей туннельной микроскопии STM Режимы: с постоянной высотой зонда, с постоянным током
17. Физические основы сканирующей туннельной микроскопии STM Режимы: с постоянной высотой зонда, с постоянным током
 18. Физические основы атомной силовой микроскопии AFM
18. Физические основы атомной силовой микроскопии AFM
 Атомный силовой микроскоп (atomic force microscope) detection systems
Атомный силовой микроскоп (atomic force microscope) detection systems
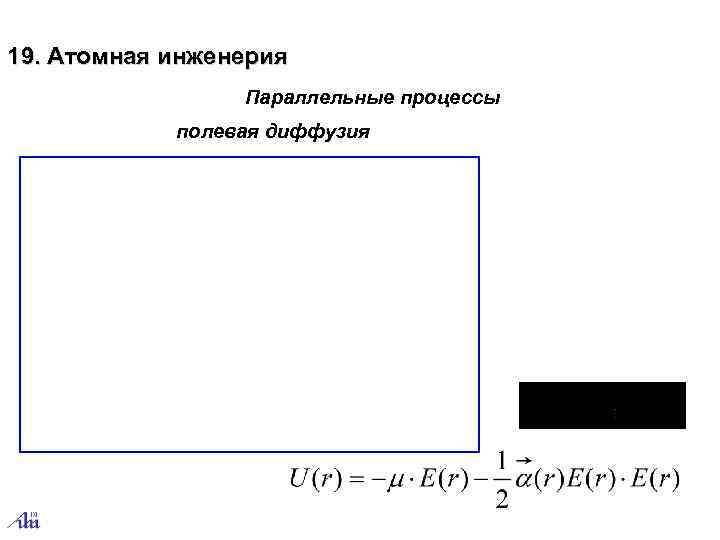 19. Атомная инженерия Параллельные процессы полевая диффузия
19. Атомная инженерия Параллельные процессы полевая диффузия
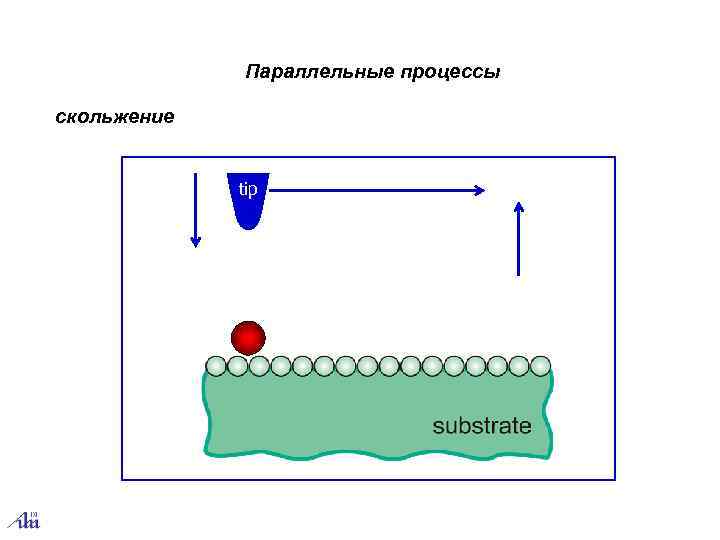 Параллельные процессы скольжение tip
Параллельные процессы скольжение tip
 Перпендикулярные процессы контактный перенос полевое испарение электромиграция
Перпендикулярные процессы контактный перенос полевое испарение электромиграция
 20. Локальное окисление полупроводников и металлов Si. O 2 lines on Si
20. Локальное окисление полупроводников и металлов Si. O 2 lines on Si
 21. Локальное химическое осаждение материалов из газовой фазы
21. Локальное химическое осаждение материалов из газовой фазы
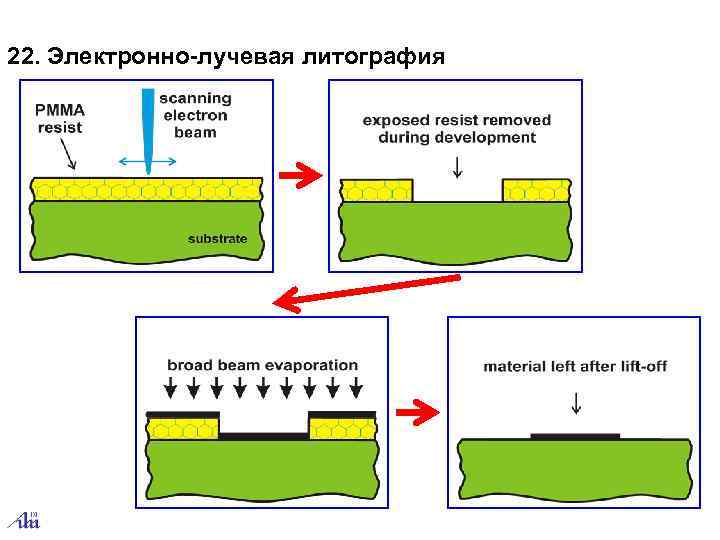 22. Электронно-лучевая литография
22. Электронно-лучевая литография
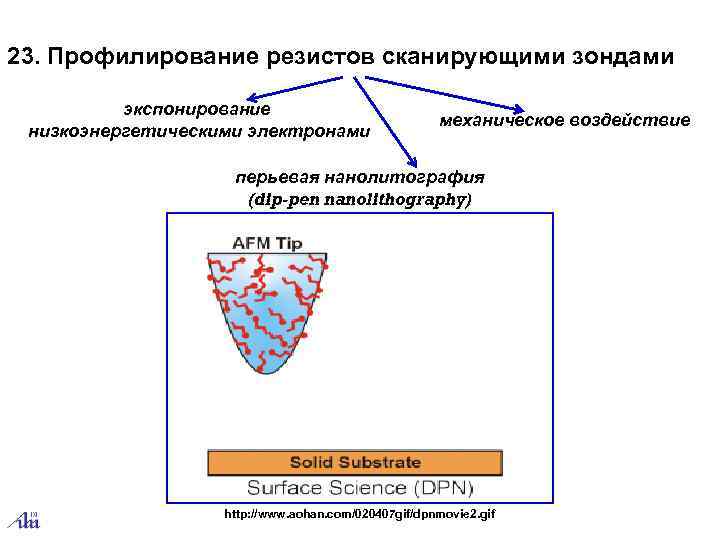 23. Профилирование резистов сканирующими зондами экспонирование механическое воздействие низкоэнергетическими электронами перьевая нанолитография (dip-pen nanolithography) http: //www. aohan. com/020407 gif/dpnmovie 2. gif
23. Профилирование резистов сканирующими зондами экспонирование механическое воздействие низкоэнергетическими электронами перьевая нанолитография (dip-pen nanolithography) http: //www. aohan. com/020407 gif/dpnmovie 2. gif
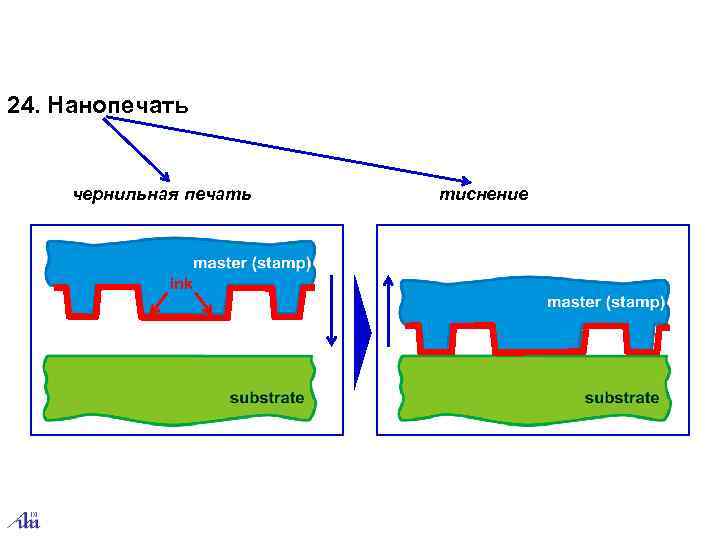 24. Нанопечать чернильная печать тиснение ink
24. Нанопечать чернильная печать тиснение ink
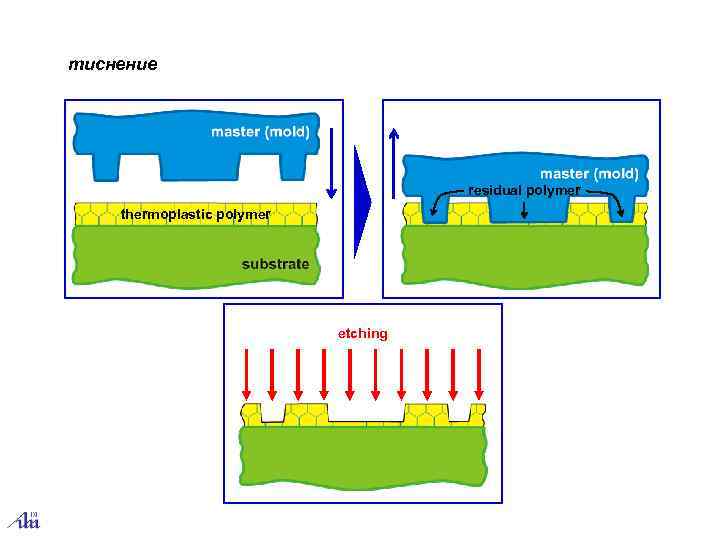 тиснение residual polymer thermoplastic polymer etching
тиснение residual polymer thermoplastic polymer etching
 25. Самосборка молекул Самосборка (самоупорядочение) молекул – процесс адсорбции и специфического расположения молекул на твердой поверхности. Движущая сила – хемосорбция, которая в особенности проявляется в высокоэнергетических реакциях между адсорбантом и адсорбирующей поверхностью.
25. Самосборка молекул Самосборка (самоупорядочение) молекул – процесс адсорбции и специфического расположения молекул на твердой поверхности. Движущая сила – хемосорбция, которая в особенности проявляется в высокоэнергетических реакциях между адсорбантом и адсорбирующей поверхностью.
 Молекулярные блоки для самосборки аминовые группы (NH 2) поверхностная галогены (Cl, I, …) функциональная группа алкильные группы (CH 3, C 2 H 5, …) CH 2 -группы промежуточная группа фенильные группы (C 6 H 5) силаны RSi. X 3 прикрепляющая группа (R = CH 3, C 2 H 5, …, X = CH 2 O, Cl) тиол (RSH)
Молекулярные блоки для самосборки аминовые группы (NH 2) поверхностная галогены (Cl, I, …) функциональная группа алкильные группы (CH 3, C 2 H 5, …) CH 2 -группы промежуточная группа фенильные группы (C 6 H 5) силаны RSi. X 3 прикрепляющая группа (R = CH 3, C 2 H 5, …, X = CH 2 O, Cl) тиол (RSH)
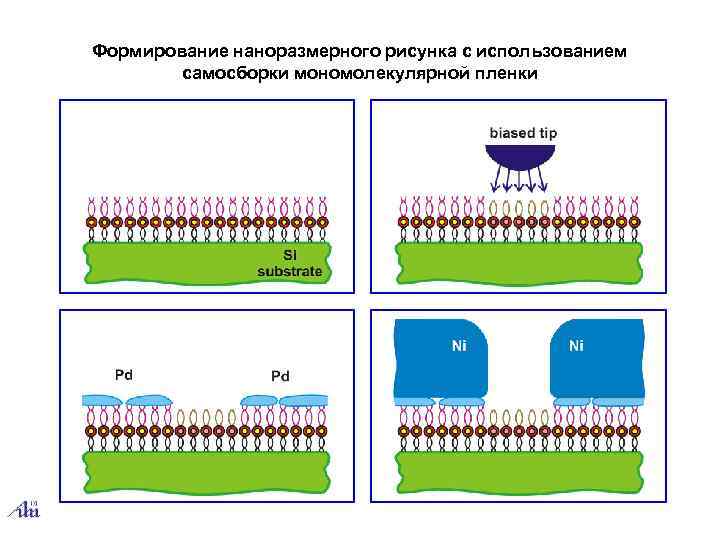 Формирование наноразмерного рисунка с использованием самосборки мономолекулярной пленки
Формирование наноразмерного рисунка с использованием самосборки мономолекулярной пленки
 Самоорганизация (self-organization) атомов – определенное расположение взаимодействующих атомов в твердом теле. Движущая сила – минимизация потенциальной энергии системы взаимодействующих атомов.
Самоорганизация (self-organization) атомов – определенное расположение взаимодействующих атомов в твердом теле. Движущая сила – минимизация потенциальной энергии системы взаимодействующих атомов.
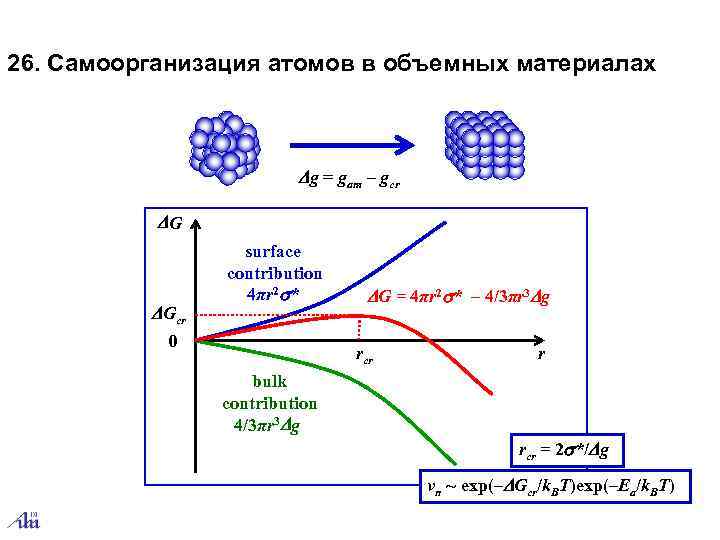 26. Самоорганизация атомов в объемных материалах g = gam – gcr G surface contribution 4πr 2 * G = 4πr 2 * – 4/3πr 3 g Gcr 0 rcr bulk contribution 4/3πr 3 g rcr = 2 */ g vn ~ exp(– Gcr/k. BT)exp(–Ea/k. BT)
26. Самоорганизация атомов в объемных материалах g = gam – gcr G surface contribution 4πr 2 * G = 4πr 2 * – 4/3πr 3 g Gcr 0 rcr bulk contribution 4/3πr 3 g rcr = 2 */ g vn ~ exp(– Gcr/k. BT)exp(–Ea/k. BT)
 27. Золь-гель технология Золь – раствор коллоидных Гель – сеть жестко связанных частиц в жидкости полимерных цепочек Si(OR)4, R = CH 3, C 2 H 5, C 3 H 7, … гидролиз OR OH RO Si OR + 4 H 2 O HO Si OH + 4 ROH OR OH поликонденсация OH HO Si OH + HO Si OH + H 2 O OH OH
27. Золь-гель технология Золь – раствор коллоидных Гель – сеть жестко связанных частиц в жидкости полимерных цепочек Si(OR)4, R = CH 3, C 2 H 5, C 3 H 7, … гидролиз OR OH RO Si OR + 4 H 2 O HO Si OH + 4 ROH OR OH поликонденсация OH HO Si OH + HO Si OH + H 2 O OH OH
 28. Самоорганизация атомов на вицинальных поверхностях кристаллов вицинальная поверхность кристалла Вицинальная поверхность - поверхность, которая не являются равновесной для данного кристалла Формирование квантовых шнуров
28. Самоорганизация атомов на вицинальных поверхностях кристаллов вицинальная поверхность кристалла Вицинальная поверхность - поверхность, которая не являются равновесной для данного кристалла Формирование квантовых шнуров
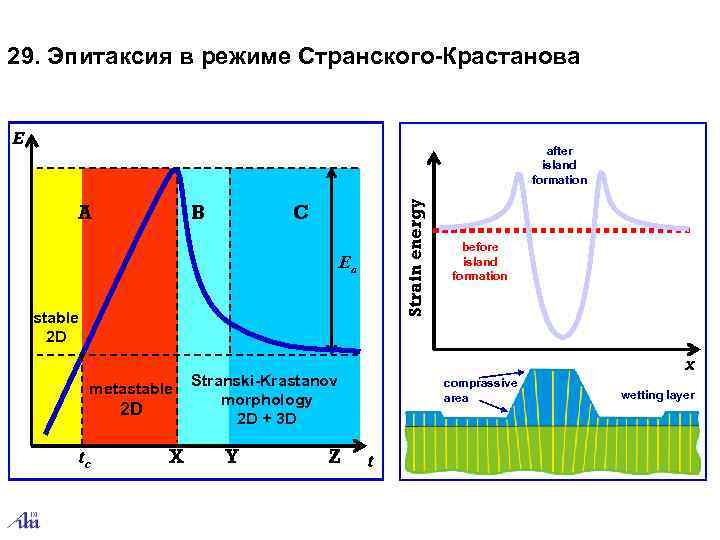 29. Эпитаксия в режиме Странского-Крастанова E after island formation Strain energy A B C before Ea island formation stable 2 D x Stranski-Krastanov comprassive metastable wetting layer morphology area 2 D + 3 D tс X Y Z t
29. Эпитаксия в режиме Странского-Крастанова E after island formation Strain energy A B C before Ea island formation stable 2 D x Stranski-Krastanov comprassive metastable wetting layer morphology area 2 D + 3 D tс X Y Z t
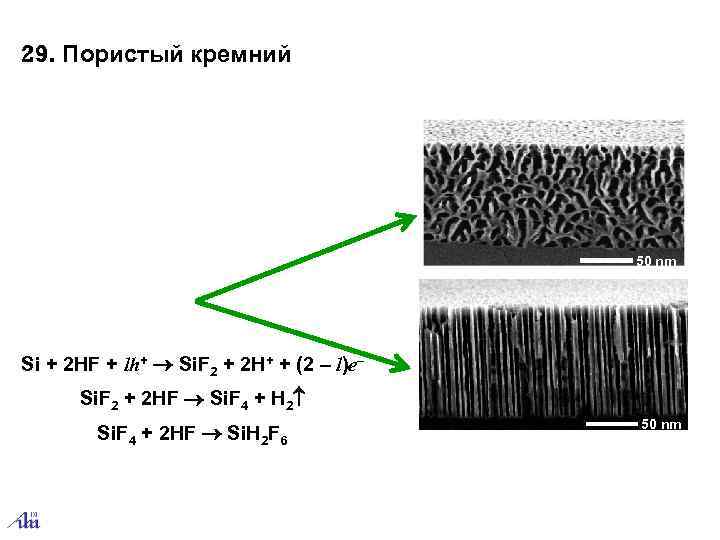 29. Пористый кремний 50 nm Si + 2 HF + lh+ Si. F 2 + 2 H+ + (2 – l)e– Si. F 2 + 2 HF Si. F 4 + H 2 50 nm Si. F 4 + 2 HF Si. H 2 F 6
29. Пористый кремний 50 nm Si + 2 HF + lh+ Si. F 2 + 2 H+ + (2 – l)e– Si. F 2 + 2 HF Si. F 4 + H 2 50 nm Si. F 4 + 2 HF Si. H 2 F 6
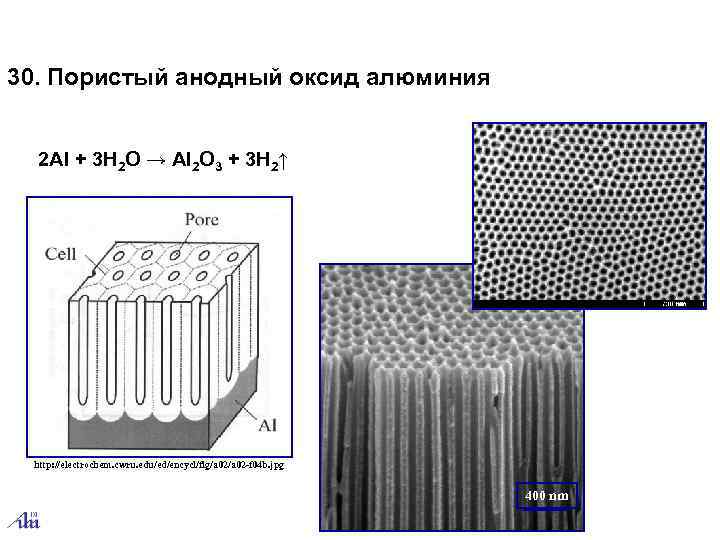 30. Пористый анодный оксид алюминия 2 Al + 3 H 2 O → Al 2 O 3 + 3 H 2↑ http: //electrochem. cwru. edu/ed/encycl/fig/a 02 -f 04 b. jpg 400 nm
30. Пористый анодный оксид алюминия 2 Al + 3 H 2 O → Al 2 O 3 + 3 H 2↑ http: //electrochem. cwru. edu/ed/encycl/fig/a 02 -f 04 b. jpg 400 nm
 Углеродные наноструктуры фуллерены графен углеродные нанотрубки (fullerens) (graphene) (carbon nanotubes) C 60 C 70 R. Buckminster Fuller, American architect designed a dome having the form of a football for 1967 Montreal World Exhibition. H. W. Kroto, R. F. Curl, R. E. Smalley, J. R. Heath, C-60 buckminsterfullerene, Nature 318, 162 -163 (1985))
Углеродные наноструктуры фуллерены графен углеродные нанотрубки (fullerens) (graphene) (carbon nanotubes) C 60 C 70 R. Buckminster Fuller, American architect designed a dome having the form of a football for 1967 Montreal World Exhibition. H. W. Kroto, R. F. Curl, R. E. Smalley, J. R. Heath, C-60 buckminsterfullerene, Nature 318, 162 -163 (1985))
 31. Графен
31. Графен
 31. Графен
31. Графен
 32. Углеродные нанотрубки graphen → carbon nanotube d = 1. 2 – 1. 4 nm
32. Углеродные нанотрубки graphen → carbon nanotube d = 1. 2 – 1. 4 nm
 Одностенные углеродные нанотрубки
Одностенные углеродные нанотрубки
 Многостенные углеродные нанотрубки
Многостенные углеродные нанотрубки
 33. Интерференция электронных волн и эффект Аронова-Бома Фазовая интерференция (phase interference of electron waves) 1 = A 1 exp(i 1) 2 = A 2 exp(i 2) W = 1 + 2 2 = A 12 + A 22 + 2 A 1*A 2 cos( 1 - 2) Эффект Аронова-Бома (Aharonov‑Bohm effect) = 2 ( / 0) 0 = h/e – the quantum of the magnetic flux http: //www. physics. gatech. edu/davidovic/nano 0_files/image 002. jpg
33. Интерференция электронных волн и эффект Аронова-Бома Фазовая интерференция (phase interference of electron waves) 1 = A 1 exp(i 1) 2 = A 2 exp(i 2) W = 1 + 2 2 = A 12 + A 22 + 2 A 1*A 2 cos( 1 - 2) Эффект Аронова-Бома (Aharonov‑Bohm effect) = 2 ( / 0) 0 = h/e – the quantum of the magnetic flux http: //www. physics. gatech. edu/davidovic/nano 0_files/image 002. jpg
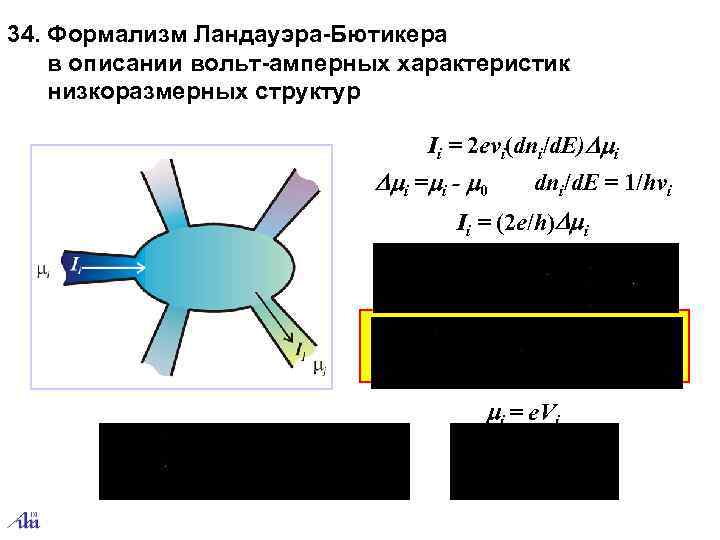 34. Формализм Ландауэра-Бютикера в описании вольт-амперных характеристик низкоразмерных структур Ii = 2 evi(dni/d. E) i i = i - 0 dni/d. E = 1/hvi Ii = (2 e/h) i i = e. Vi
34. Формализм Ландауэра-Бютикера в описании вольт-амперных характеристик низкоразмерных структур Ii = 2 evi(dni/d. E) i i = i - 0 dni/d. E = 1/hvi Ii = (2 e/h) i i = e. Vi
 Эффект Холла R = V/I RH = VH/I RH = B/(en) E. H. Hall, On a new action of the magnet on electric currents, Am. J. Math. 2, 287 -292 (1879).
Эффект Холла R = V/I RH = VH/I RH = B/(en) E. H. Hall, On a new action of the magnet on electric currents, Am. J. Math. 2, 287 -292 (1879).
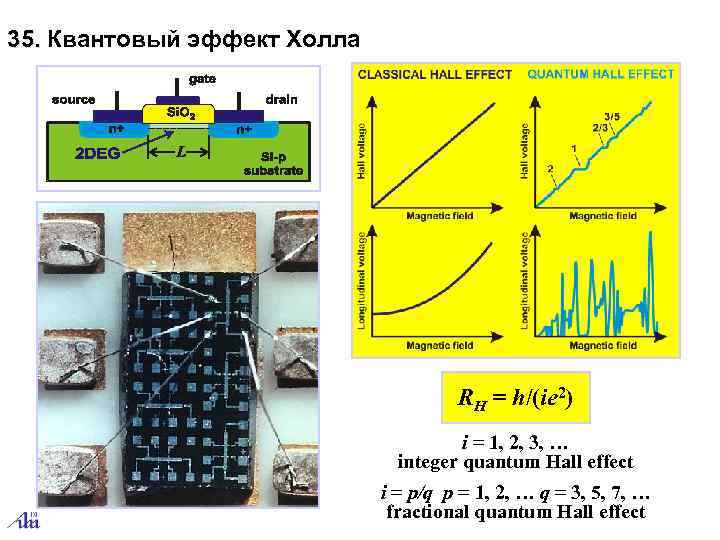 35. Квантовый эффект Холла RH = h/(ie 2) i = 1, 2, 3, … integer quantum Hall effect i = p/q p = 1, 2, … q = 3, 5, 7, … fractional quantum Hall effect
35. Квантовый эффект Холла RH = h/(ie 2) i = 1, 2, 3, … integer quantum Hall effect i = p/q p = 1, 2, … q = 3, 5, 7, … fractional quantum Hall effect
 Объяснение квантового эффекта Холла идеальная структура The cyclotron frequency ωc = e. B/m Landau levels Ei = (i + ½)ħωc i = 1, 2, …. разупорядоченная структура k. BT << ħωc
Объяснение квантового эффекта Холла идеальная структура The cyclotron frequency ωc = e. B/m Landau levels Ei = (i + ½)ħωc i = 1, 2, …. разупорядоченная структура k. BT << ħωc
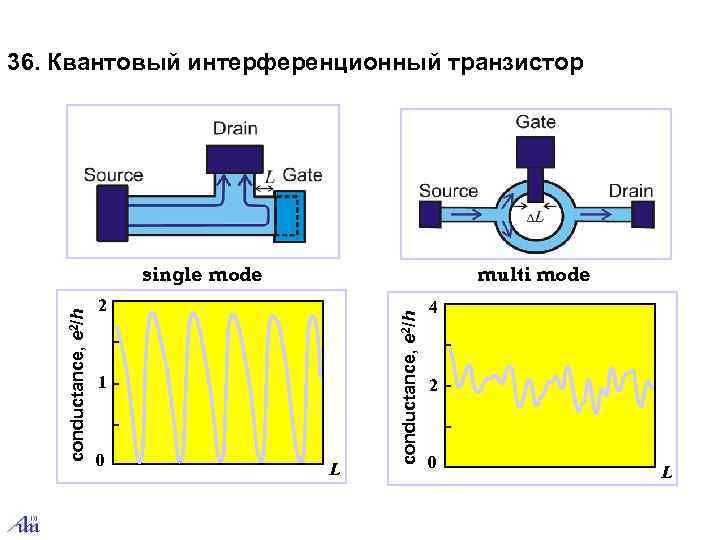 36. Квантовый интерференционный транзистор single mode multi mode 2 4 conductance, e 2/h 1 2 0 L
36. Квантовый интерференционный транзистор single mode multi mode 2 4 conductance, e 2/h 1 2 0 L
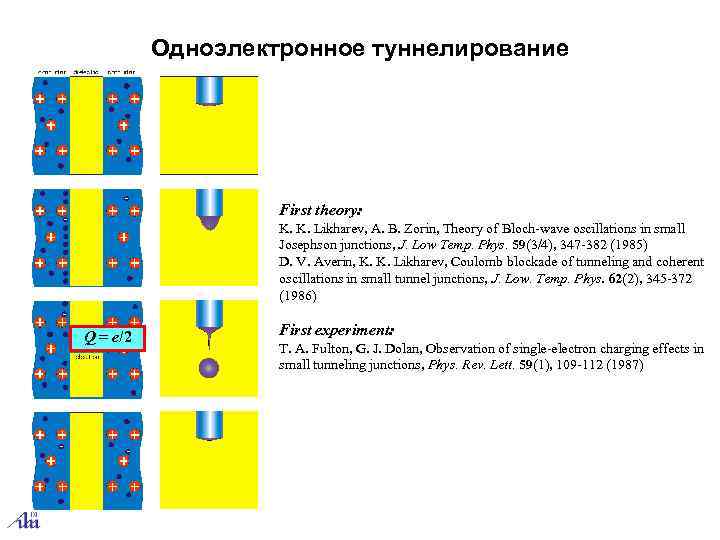 Одноэлектронное туннелирование First theory: K. K. Likharev, A. B. Zorin, Theory of Bloch‑wave oscillations in small Josephson junctions, J. Low Temp. Phys. 59(3/4), 347 -382 (1985) D. V. Averin, K. K. Likharev, Coulomb blockade of tunneling and coherent oscillations in small tunnel junctions, J. Low. Temp. Phys. 62(2), 345 -372 (1986) Q = e/2 First experiment: T. A. Fulton, G. J. Dolan, Observation of single-electron charging effects in small tunneling junctions, Phys. Rev. Lett. 59(1), 109 -112 (1987)
Одноэлектронное туннелирование First theory: K. K. Likharev, A. B. Zorin, Theory of Bloch‑wave oscillations in small Josephson junctions, J. Low Temp. Phys. 59(3/4), 347 -382 (1985) D. V. Averin, K. K. Likharev, Coulomb blockade of tunneling and coherent oscillations in small tunnel junctions, J. Low. Temp. Phys. 62(2), 345 -372 (1986) Q = e/2 First experiment: T. A. Fulton, G. J. Dolan, Observation of single-electron charging effects in small tunneling junctions, Phys. Rev. Lett. 59(1), 109 -112 (1987)
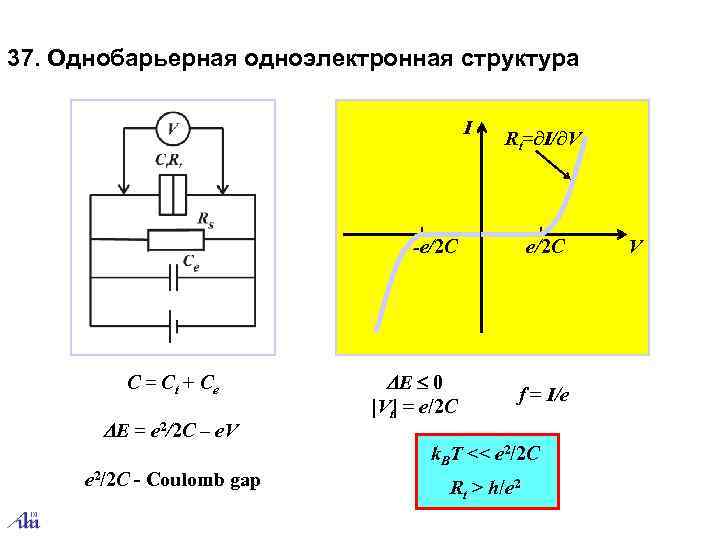 37. Однобарьерная одноэлектронная структура I Rt=∂I/∂V -e/2 C V C = Ct + Ce E 0 f = I/e Vt = e/2 C E = e 2/2 C – e. V k. BT << e 2/2 C - Coulomb gap Rt > h/e 2
37. Однобарьерная одноэлектронная структура I Rt=∂I/∂V -e/2 C V C = Ct + Ce E 0 f = I/e Vt = e/2 C E = e 2/2 C – e. V k. BT << e 2/2 C - Coulomb gap Rt > h/e 2
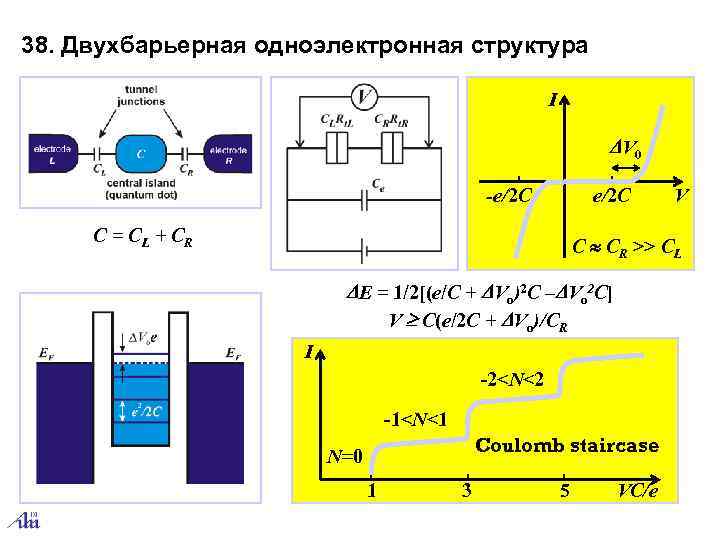 38. Двухбарьерная одноэлектронная структура I V 0 -e/2 C e/2 C V C = CL + CR C CR >> CL E = 1/2[(e/C + Vo)2 C – Vo 2 C] V C(e/2 C + Vo)/CR I -2
38. Двухбарьерная одноэлектронная структура I V 0 -e/2 C e/2 C V C = CL + CR C CR >> CL E = 1/2[(e/C + Vo)2 C – Vo 2 C] V C(e/2 C + Vo)/CR I -2
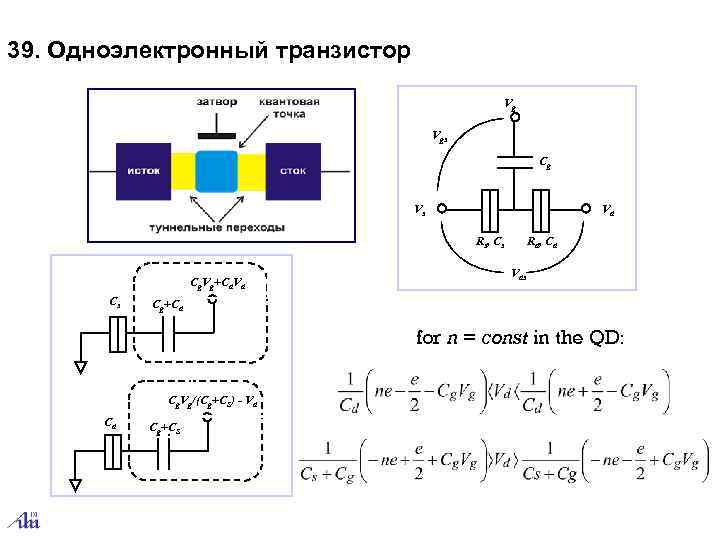 39. Одноэлектронный транзистор Vg Vgs Cg Vs Vd Rs, Cs Rd, Cd Vds Cg. Vg+Cd. Vd Cs Cg+Cd for n = const in the QD: Cg. Vg/(Cg+CS) - Vd Cg+CS
39. Одноэлектронный транзистор Vg Vgs Cg Vs Vd Rs, Cs Rd, Cd Vds Cg. Vg+Cd. Vd Cs Cg+Cd for n = const in the QD: Cg. Vg/(Cg+CS) - Vd Cg+CS
 Характеристики одноэлектронного транзистора Vd Ids 0 1 2 0 1 1, 0, 1 2, 1, 0 2, 1 0 1 2 -e/2 Cg 3 e/2 Cg 5 e/2 Cg Vg -1 Vg Ids Vg=0 Vds
Характеристики одноэлектронного транзистора Vd Ids 0 1 2 0 1 1, 0, 1 2, 1, 0 2, 1 0 1 2 -e/2 Cg 3 e/2 Cg 5 e/2 Cg Vg -1 Vg Ids Vg=0 Vds
 40. Приборы на одноэлектронном туннелировании одноэлектронная ловушка E(i) e- U
40. Приборы на одноэлектронном туннелировании одноэлектронная ловушка E(i) e- U
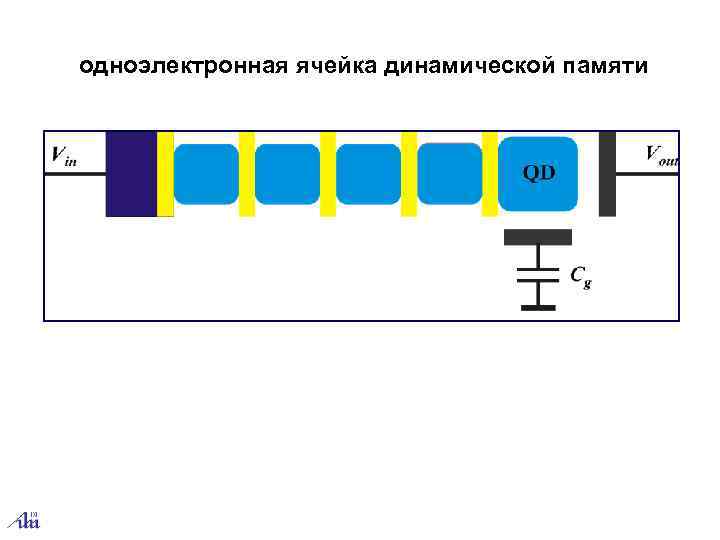 одноэлектронная ячейка динамической памяти
одноэлектронная ячейка динамической памяти
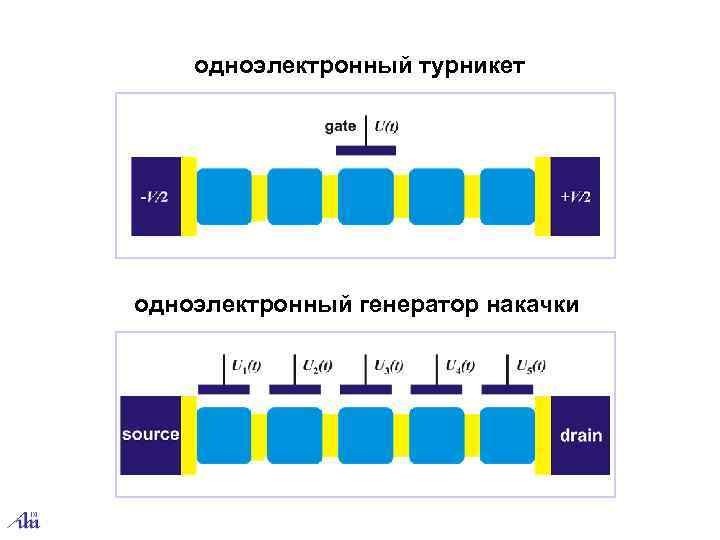 одноэлектронный турникет одноэлектронный генератор накачки
одноэлектронный турникет одноэлектронный генератор накачки
 логические элементы
логические элементы
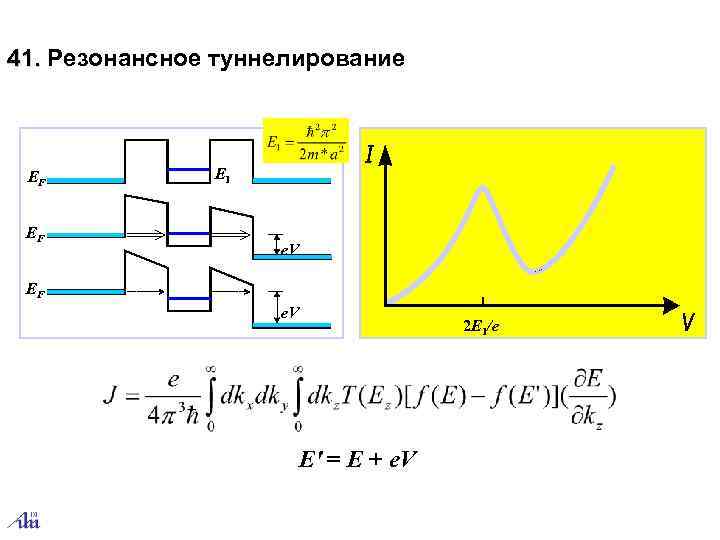 41. Резонансное туннелирование 41. EF E 1 1 EF e. V 2 E 1/e E' = E + e. V
41. Резонансное туннелирование 41. EF E 1 1 EF e. V 2 E 1/e E' = E + e. V
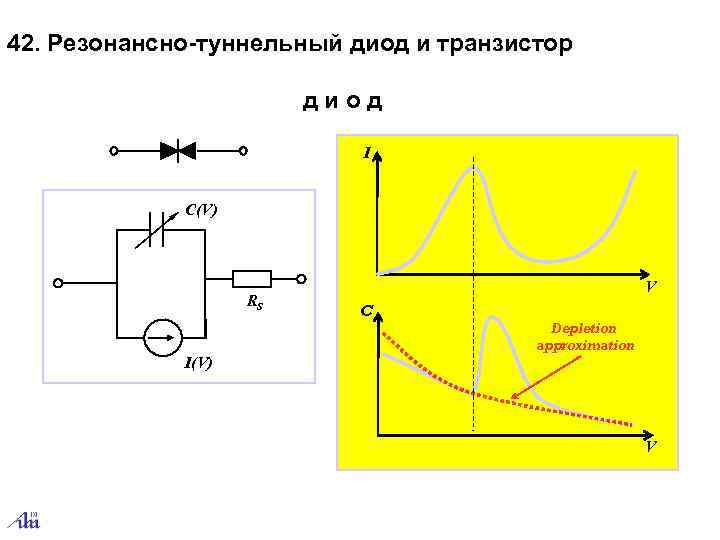 42. Резонансно-туннельный диод и транзистор д и о д I C(V) V RS C Depletion approximation I(V) V
42. Резонансно-туннельный диод и транзистор д и о д I C(V) V RS C Depletion approximation I(V) V
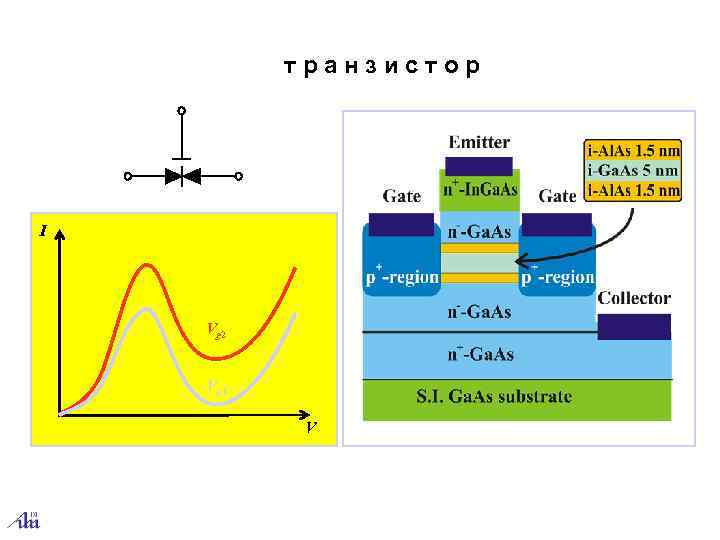 т р а н з и с т о р I Vg 2 Vg 1 V
т р а н з и с т о р I Vg 2 Vg 1 V
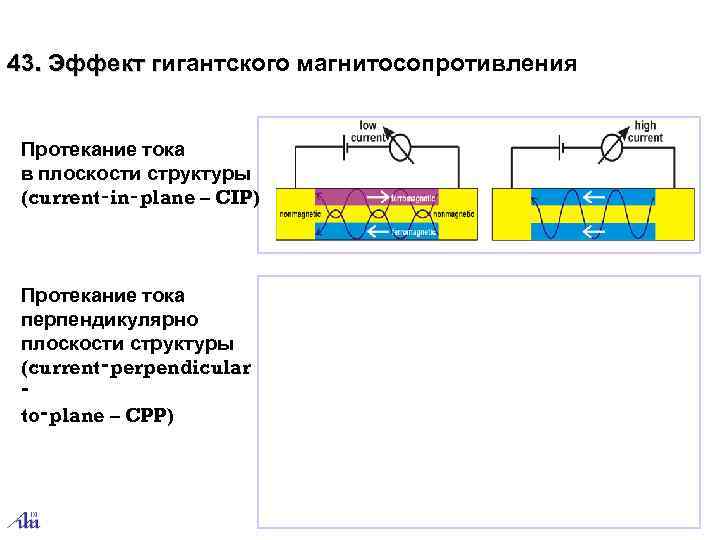 43. Эффект гигантского магнитосопротивления Эффект г Протекание тока в плоскости структуры (current‑in‑plane – CIP) Протекание тока перпендикулярно плоскости структуры (current‑perpendicular ‑ to‑plane – CPP)
43. Эффект гигантского магнитосопротивления Эффект г Протекание тока в плоскости структуры (current‑in‑plane – CIP) Протекание тока перпендикулярно плоскости структуры (current‑perpendicular ‑ to‑plane – CPP)
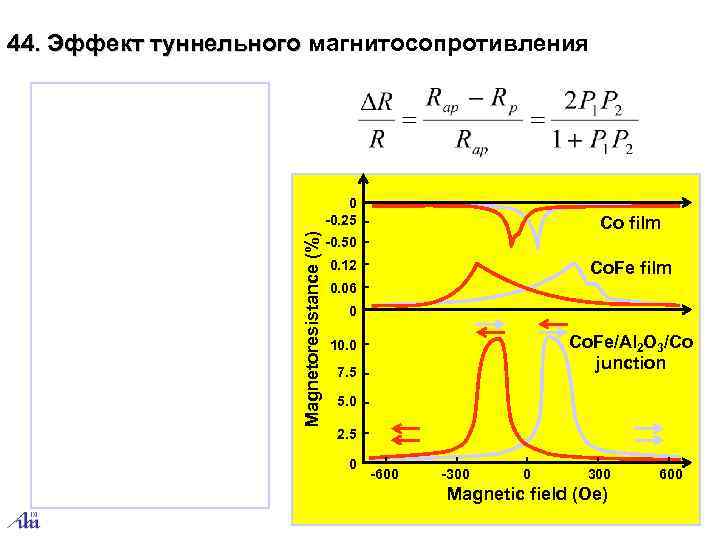 44. Эффект туннельного магнитосопротивления 44. Эффект туннельного 0 -0. 25 Co film Magnetoresistance (%) -0. 50 0. 12 Co. Fe film 0. 06 0 10. 0 Co. Fe/Al 2 O 3/Co 7. 5 junction 5. 0 2. 5 0 -600 -300 0 300 600 Magnetic field (Oe)
44. Эффект туннельного магнитосопротивления 44. Эффект туннельного 0 -0. 25 Co film Magnetoresistance (%) -0. 50 0. 12 Co. Fe film 0. 06 0 10. 0 Co. Fe/Al 2 O 3/Co 7. 5 junction 5. 0 2. 5 0 -600 -300 0 300 600 Magnetic field (Oe)
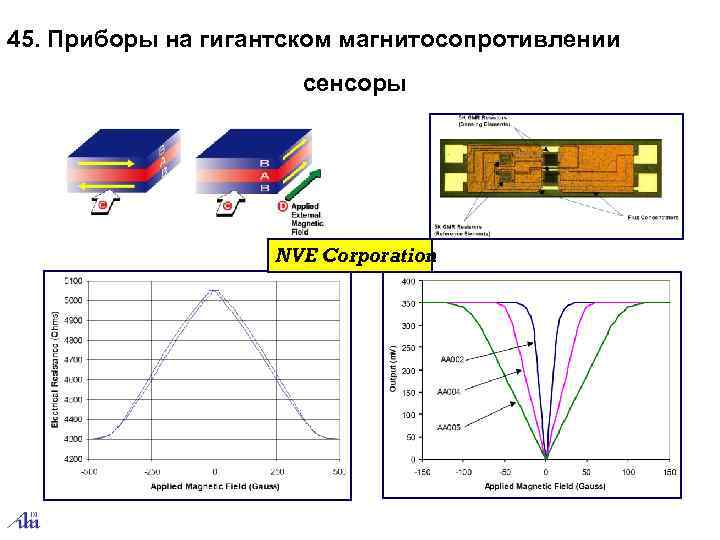 45. Приборы на гигантском магнитосопротивлении сенсоры NVE Corporation
45. Приборы на гигантском магнитосопротивлении сенсоры NVE Corporation
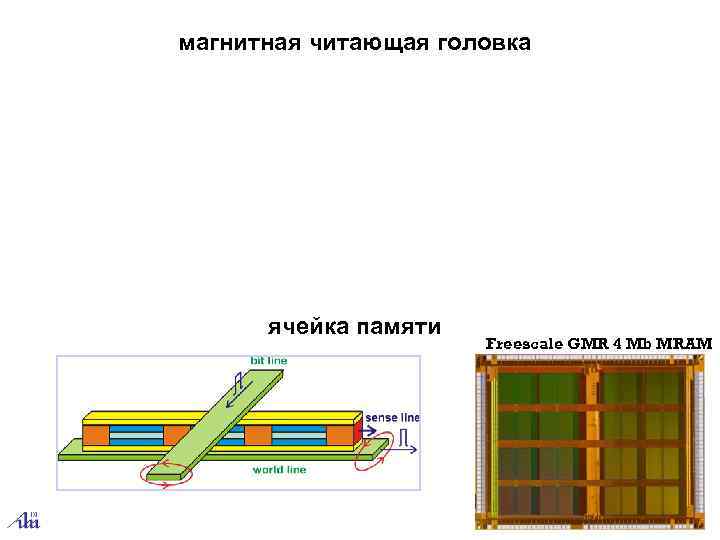 магнитная читающая головка ячейка памяти Freescale GMR 4 Mb MRAM
магнитная читающая головка ячейка памяти Freescale GMR 4 Mb MRAM
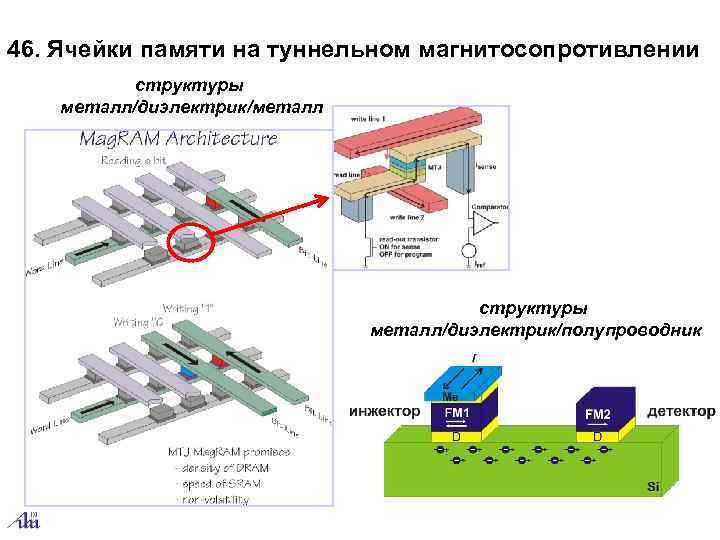 46. Ячейки памяти на туннельном магнитосопротивлении структуры металл/диэлектрик/металл структуры металл/диэлектрик/полупроводник
46. Ячейки памяти на туннельном магнитосопротивлении структуры металл/диэлектрик/металл структуры металл/диэлектрик/полупроводник
 NANOELECTRONICS Удачи на экзамене ! C В. Е. Борисенко, 2014
NANOELECTRONICS Удачи на экзамене ! C В. Е. Борисенко, 2014

