моя КОНФЕТКА.ppt
- Количество слайдов: 10

Молекулярно-лучевое осаждение и эпитаксия кремния. Установка сублимационной эпитаксии кремния.

Эпитаксия – это процесс ориентированного наращивания монокристаллических слоев вещества на подложку, при котором кристаллографическая ориентация наращиваемого слоя повторяет кристаллографическую ориентацию подложки. Общая схема установки МЛЭ Составные части: 1) 2) 3) 4) 5) 6) 7) 8) Держатель подложки с нагревателем; Подложка; Масс-спектрометр; Эффузионные ячейки; Заслонки; Манипулятор; Электронная пушка; Экран. Область ростовой камеры: I зона - зона генерации молекулярных пучков; II зона - зона смешения ; испаряемых элементов III зона -зона кристаллизации (эпитаксиального роста)

Схема установки МЛЭ Si Схема эффузионной ячейки 1) 2) 3) 4) Тигель; Нагреватель; Радиационный экран; Термопара; Схема электронно-лучевого испарителя 1) 2) 3) 4) Тигель; Нагреватель; Радиационный экран; Термопара; 1) 2) 3) 4) 5) 6) 7) 8) 9) 10) Корпус; Фокусирующий электрод; Катод; Изолятор; Основание катодного узла Магниты Тигель Трубка охлаждения

Процесс эпитаксиального роста - Адсорбция атомов или молекул из зоны смешивания на поверхности подложки; - Поверхностная миграция атомов и диссоциация адсорбированных молекул; - Встраивание адсорбированных атомов в кристаллическую решетку; - Термическая десорбция - Образование поверхностных зародышей, - Взаимная диффузия. Схематическое изображение процессов, происходящих при выращивании тонкой пленки методом МЛЭ: 1 – поверхностная диффузия, 2 – десорбция, 3 – взаимодиффузия, 4 – встраивание в решетку, 5 – поверхностная аггрегация

Оценка метода МЛЭ Достоинтсва: 1) Легко контролируемые состав и толщина растущего слоя 2) Невысокая плотность дефектов 3) Рост эпитаксиальных слоев при достаточно низких температурах 4) Возможность получить все модификации кремния (от аморфного до монокристаллического) изменяя лишь температуру осаждения Недостатки: 1) Высокие требования к вакууму 2) Неравномерное осаждение материала 3) Скорость роста 1 мкм/час

BESOI-технология как разновидность КНИ-технологии
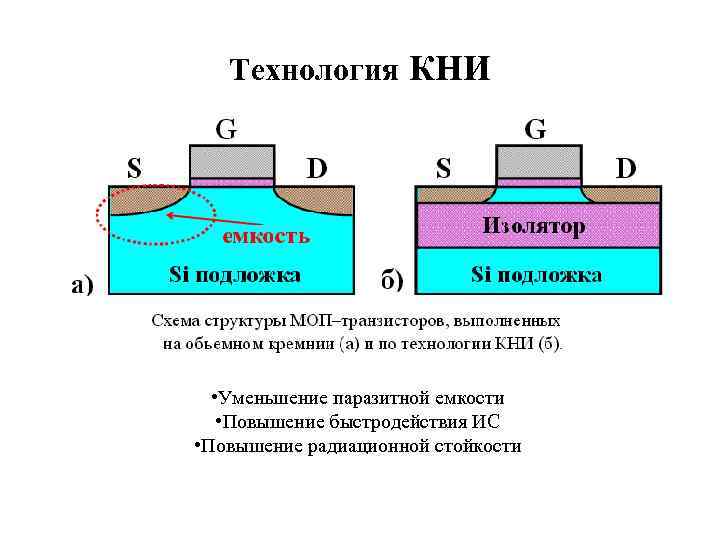
Технология КНИ • Уменьшение паразитной емкости • Повышение быстродействия ИС • Повышение радиационной стойкости

BESOI (bond &etching SOI) –технология а) исходные пластины б) сращивание приборной и опорной пластин и удаление излишней части приборной пластины в) окончательный продукт Технологическая схема получения структур КНИ методом прямого сращивания пластин (BESOI [соединение и стравливание с обратной стороны КНИ])

Основные этапы I этап – обработка пластин II этап – сращивание пластин а) термическое окисление б) полировка с применением химических и плазменных методов в) очистка поверхности от пылевидных частиц г) промывание деионизованной водой д) обработка струей сверхчистой деионизированной воды в спец. камерах (т. к. поверхности перед сращиванием должны быть гидрофильными) е) сушка подложек с помощью центрифуг а) прижатие пластин друг к другу полированными сторонами, б) начальное сращивание за счет сил Ван-дер. Ваальса между молекулами воды в) образование и полимеризация групп силанола Si-ОН, возникновение прямых связей Si-O-Si г) отжиг с повышением температуры д) замена существующих связей на ковалентные связи Si-Si III этап – удаление большей части приборной пластины а) шлифовка б) полировка в) различные виды травление до стоп-слоя Структура гидрофильного слоя на поверхности пластин перед сращиванием

Оценка метода BESOI Достоинтсва: Недостатки: 1) Легко контролируемые состав и толщина растущего слоя 1) Не экономное расходование материала 2) Возможность изготовления КНИ с практически любой толщиной слоев кремния и изолирующего диэлектрика 3) Доступность легирования кремния и его комбинация с другими материалами
моя КОНФЕТКА.ppt