MTP_l1.ppt
- Количество слайдов: 29
 Моделирование технологических процессов Лекция 1
Моделирование технологических процессов Лекция 1
 Принципы взаимодействия кремниевых фабрик и дизайн -центров 2
Принципы взаимодействия кремниевых фабрик и дизайн -центров 2
 X-FAB 0. 18 мкм 3
X-FAB 0. 18 мкм 3
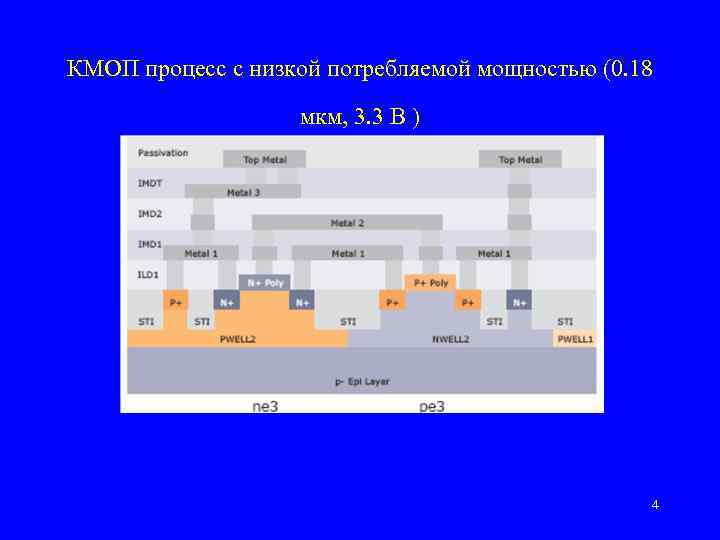 КМОП процесс с низкой потребляемой мощностью (0. 18 мкм, 3. 3 В ) 4
КМОП процесс с низкой потребляемой мощностью (0. 18 мкм, 3. 3 В ) 4
 Высоковольтный КМОП процесс с 5 -6 уровневой металлизацией 5
Высоковольтный КМОП процесс с 5 -6 уровневой металлизацией 5
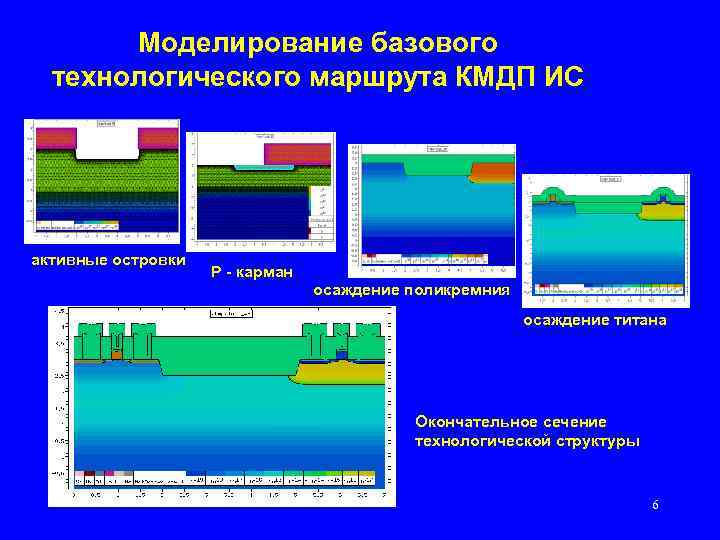 Моделирование базового технологического маршрута КМДП ИС активные островки P - карман осаждение поликремния осаждение титана Окончательное сечение технологической структуры 6
Моделирование базового технологического маршрута КМДП ИС активные островки P - карман осаждение поликремния осаждение титана Окончательное сечение технологической структуры 6
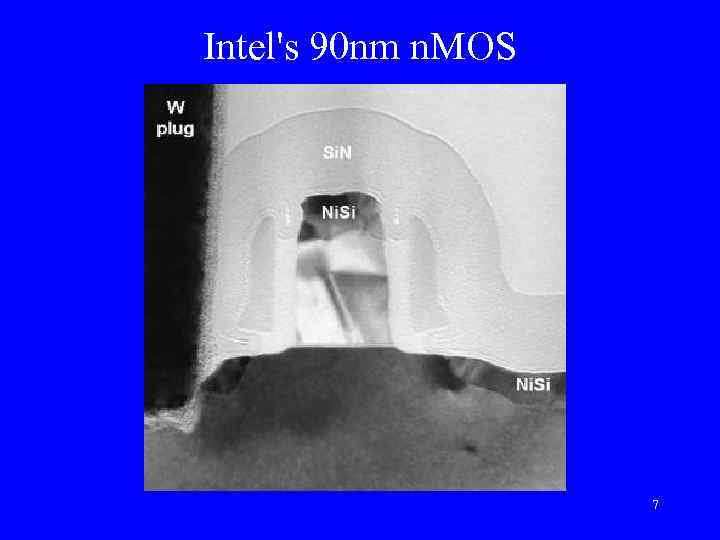 Intel's 90 nm n. MOS 7
Intel's 90 nm n. MOS 7
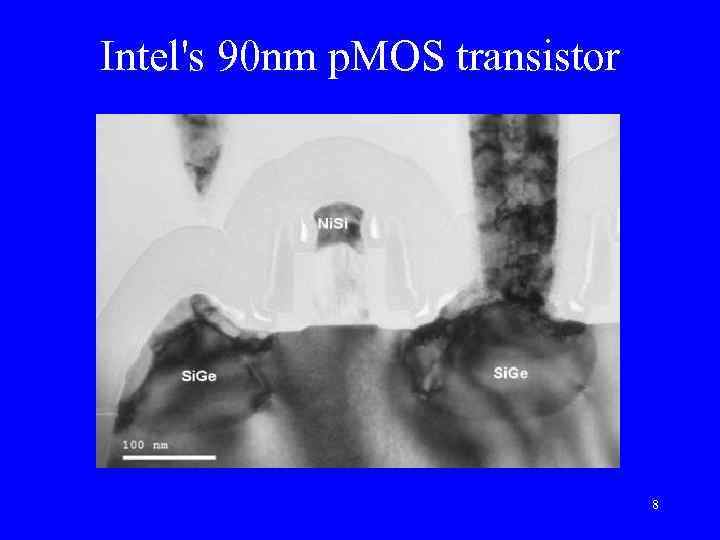 Intel's 90 nm p. MOS transistor 8
Intel's 90 nm p. MOS transistor 8
 Intel's 65 nm n. MOS transistor 9
Intel's 65 nm n. MOS transistor 9
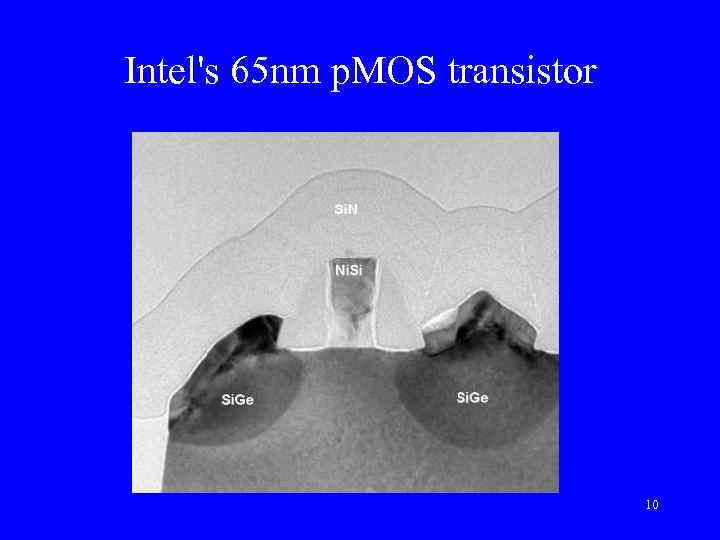 Intel's 65 nm p. MOS transistor 10
Intel's 65 nm p. MOS transistor 10
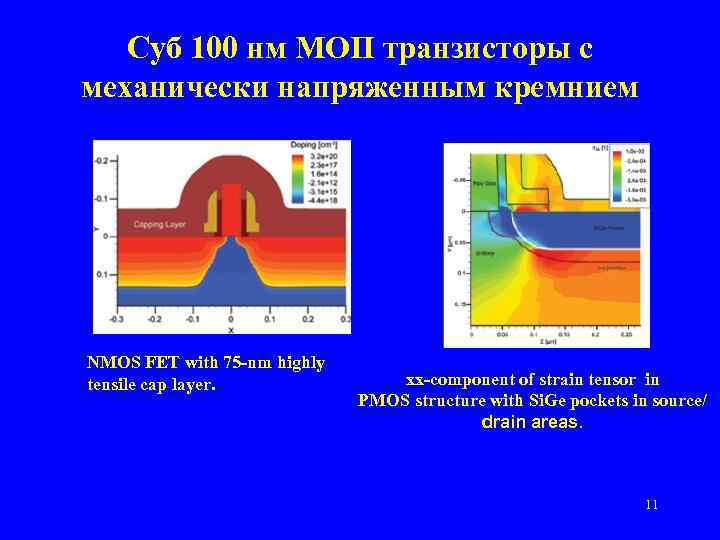 Суб 100 нм МОП транзисторы с механически напряженным кремнием NMOS FET with 75 -nm highly tensile cap layer. xx-component of strain tensor in PMOS structure with Si. Ge pockets in source/ drain areas. 11
Суб 100 нм МОП транзисторы с механически напряженным кремнием NMOS FET with 75 -nm highly tensile cap layer. xx-component of strain tensor in PMOS structure with Si. Ge pockets in source/ drain areas. 11
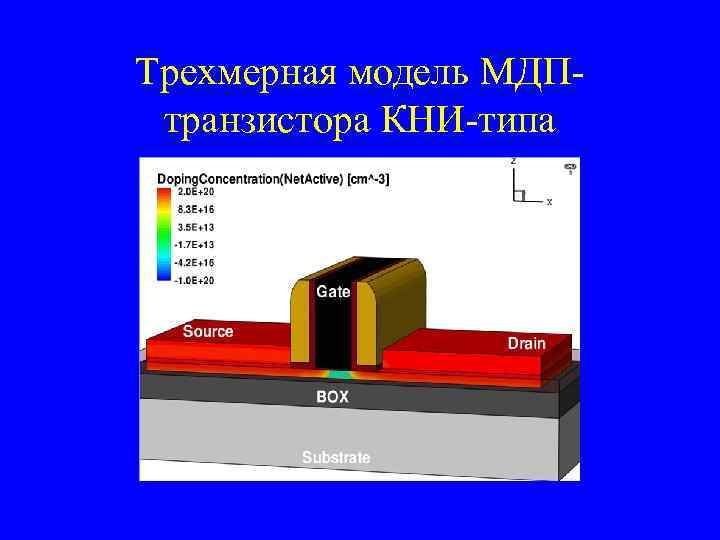 Трехмерная модель МДПтранзистора КНИ-типа
Трехмерная модель МДПтранзистора КНИ-типа
 Функция распределения порогового напряжения с учетом разброса фокуса и дозы в процессе литографии
Функция распределения порогового напряжения с учетом разброса фокуса и дозы в процессе литографии
 Виртуальный эксперимент: автоматизированное рабочее место Sentaurus Workbench Варьируются длина канала n-МДП транзистора, определяемая параметром end. Gate, доза ионной имплантации при создании n- областей истока/стока (dose. LDD) и длительность отжига исток/стоков (diff. Time) 14
Виртуальный эксперимент: автоматизированное рабочее место Sentaurus Workbench Варьируются длина канала n-МДП транзистора, определяемая параметром end. Gate, доза ионной имплантации при создании n- областей истока/стока (dose. LDD) и длительность отжига исток/стоков (diff. Time) 14
 Виртуальный эксперимент в программной среде Sentaurus Workbench варьируемый параметр – толщина анизотропно стравливаемого нитрида кремния при формировании спейсера а б в а – нет осаждения; б – толщина осаждаемого слоя 5 нм; в - толщина осаждаемого слоя 10 нм 15
Виртуальный эксперимент в программной среде Sentaurus Workbench варьируемый параметр – толщина анизотропно стравливаемого нитрида кремния при формировании спейсера а б в а – нет осаждения; б – толщина осаждаемого слоя 5 нм; в - толщина осаждаемого слоя 10 нм 15
 Нормализованная чувствительность задержки в инверторе к разбросу технологических параметров 16
Нормализованная чувствительность задержки в инверторе к разбросу технологических параметров 16
 Цель дисциплины • формирование знаний в области математического моделирования технологических процессов микро- и наноэлектроники, позволяющих глубже понимать сущность процессов, используемых в производстве изделий интегральной электроники, проектировать эти изделия на основе современных методов и с использованием современных компьютерных технологий 17
Цель дисциплины • формирование знаний в области математического моделирования технологических процессов микро- и наноэлектроники, позволяющих глубже понимать сущность процессов, используемых в производстве изделий интегральной электроники, проектировать эти изделия на основе современных методов и с использованием современных компьютерных технологий 17
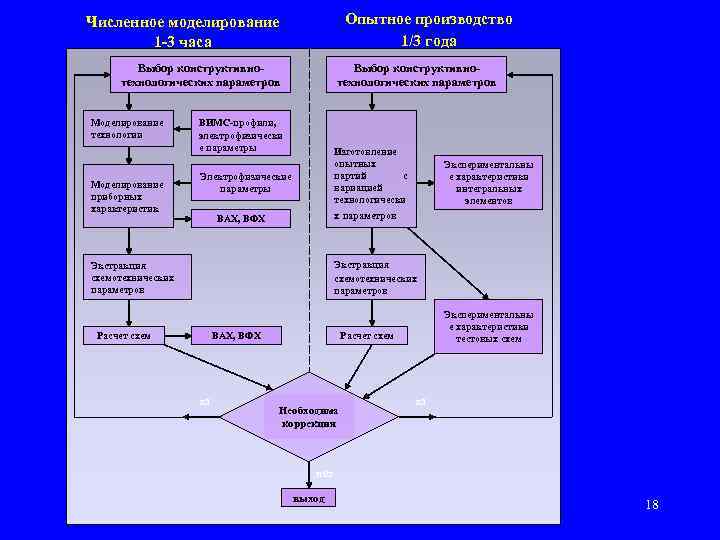 Опытное производство 1/3 года Численное моделирование 1 -3 часа Выбор конструктивнотехнологических параметров Моделирование технологии Моделирование приборных характеристик ВИМС-профили, электрофизически е параметры Изготовление опытных партий с вариацией технологически Электрофизические параметры Экспериментальны е характеристики интегральных элементов х параметров ВАХ, ВФХ Экстракция схемотехнических параметров ВАХ, ВФХ Расчет схем да Экспериментальны е характеристики тестовых схем Расчет схем Необходима коррекция да нет выход 18
Опытное производство 1/3 года Численное моделирование 1 -3 часа Выбор конструктивнотехнологических параметров Моделирование технологии Моделирование приборных характеристик ВИМС-профили, электрофизически е параметры Изготовление опытных партий с вариацией технологически Электрофизические параметры Экспериментальны е характеристики интегральных элементов х параметров ВАХ, ВФХ Экстракция схемотехнических параметров ВАХ, ВФХ Расчет схем да Экспериментальны е характеристики тестовых схем Расчет схем Необходима коррекция да нет выход 18
 Познание и моделирование «Вся эволюция организмов и история человечества связана с информацией и моделями» Акад. Н. М. Амосов Любое знание представляет собой модель реальности, так как любая научная дисциплина всегда имеет дело только с приближенным (т. е. модельным) описанием. Процесс познания может быть рассмотрен как процесс построения моделей, где построение математической модели означает достижение наивысшей точки индуктивного обобщения экспериментальных данных и теоретических построений 19
Познание и моделирование «Вся эволюция организмов и история человечества связана с информацией и моделями» Акад. Н. М. Амосов Любое знание представляет собой модель реальности, так как любая научная дисциплина всегда имеет дело только с приближенным (т. е. модельным) описанием. Процесс познания может быть рассмотрен как процесс построения моделей, где построение математической модели означает достижение наивысшей точки индуктивного обобщения экспериментальных данных и теоретических построений 19
 Важность моделирования в микро- и наноэлектронике Пример. При разработке солнечных элементов на монокристаллическом кремнии используется технологический процесс легирования бором и фосфором для создания контактов и формирования поля на тыловой поверхности для повышения эффективности солнечного элемента. Даже такой несложный технологический процесс может привести в конечном счете к падению эффективности, а не к ее повышению: деформации – дислокации – центры рекомбинации – снижение времени жизни – падение эффективности. Создание высокоэффективного элемента требует теоретических (модели разного уровня) и экспериментальных исследований 20
Важность моделирования в микро- и наноэлектронике Пример. При разработке солнечных элементов на монокристаллическом кремнии используется технологический процесс легирования бором и фосфором для создания контактов и формирования поля на тыловой поверхности для повышения эффективности солнечного элемента. Даже такой несложный технологический процесс может привести в конечном счете к падению эффективности, а не к ее повышению: деформации – дислокации – центры рекомбинации – снижение времени жизни – падение эффективности. Создание высокоэффективного элемента требует теоретических (модели разного уровня) и экспериментальных исследований 20
 Задачи дисциплины: • изучение основных физических явлений, используемых в процессах формирования элементов интегральных схем; математическое описание этих явлений с помощью основных уравнений, характеризующих процессы внедрения и перераспределения примеси в полупроводниковых материалах; • изучение принципов численного моделирования технологических процессов и математических моделей основных технологических операций; • формирование знаний в области достижений отечественной и зарубежной науки и техники в области математического моделирования технологических процессов микро- и наноэлектроники; 21
Задачи дисциплины: • изучение основных физических явлений, используемых в процессах формирования элементов интегральных схем; математическое описание этих явлений с помощью основных уравнений, характеризующих процессы внедрения и перераспределения примеси в полупроводниковых материалах; • изучение принципов численного моделирования технологических процессов и математических моделей основных технологических операций; • формирование знаний в области достижений отечественной и зарубежной науки и техники в области математического моделирования технологических процессов микро- и наноэлектроники; 21
 Задачи дисциплины (продолжение): • формирование навыков по проведению численного моделирования процессов формирования основных интегральных структур, технологических маршрутов и отдельных технологических операций, анализу, систематизации и обобщению полученных расчетных данных, подготовки материалов для составления отчетов; • обучение методам исследования объектов интегральной микро- и наноэлектроники на базе программных средств математического моделирования технологических процессов и современных компьютерных технологий. 22
Задачи дисциплины (продолжение): • формирование навыков по проведению численного моделирования процессов формирования основных интегральных структур, технологических маршрутов и отдельных технологических операций, анализу, систематизации и обобщению полученных расчетных данных, подготовки материалов для составления отчетов; • обучение методам исследования объектов интегральной микро- и наноэлектроники на базе программных средств математического моделирования технологических процессов и современных компьютерных технологий. 22
 Разновидности современных МДП транзисторных структур Fujitsu: 32 нм 23
Разновидности современных МДП транзисторных структур Fujitsu: 32 нм 23
 Влияние механических напряжений на подвижность носителей в кремнии 24
Влияние механических напряжений на подвижность носителей в кремнии 24
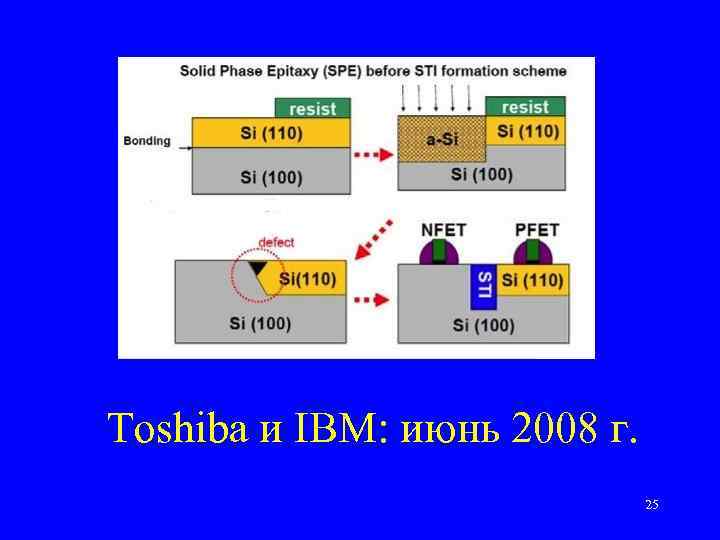 Toshiba и IBM: июнь 2008 г. 25
Toshiba и IBM: июнь 2008 г. 25
 Литература: • Технология, конструкции и методы моделирования кремниевых интегральных микросхем. М. А. Королев, Т. Ю. Крупкина. М. А. Ревелева. Под ред. чл. -корр. РАН Ю. А. Чаплыгина. Ч. 1 М. , БИНОМ. Лаборатория знаний, 2007 • Технология, конструкции и методы моделирования кремниевых интегральных микросхем. М. А. Королев, Т. Ю. Крупкина, М. Г. Путря, В. И. Шевяков. Ч. 2 Элементы и маршруты изготовления кремниевых ИС и методы их математического моделирования. Под ред. чл. -корр. РАН Ю. А. Чаплыгина. М. , БИНОМ. Лаборатория знаний, 2009 Е. А. Артамонова, А. Г. Балашов, А. С. Ключников, А. Ю. Красюков, С. А. Поломошнов. Лабораторный практикум по курсу «Моделирование в среде TCAD» . Ч. 1. Введение в приборно-технологическое моделирование. Методические указания. Под ред. Крупкиной Т. Ю. • • Г. Я. Красников. Конструктивно-технологические особенности субмикронных МОП-транзисторов. Ч. 1, М. , Техносфера, 2002. • МОП – СБИС. Моделирование элементов и технологических процессов. Под ред. П. Антонетти и др. М. Радио и связь. 1988. 26
Литература: • Технология, конструкции и методы моделирования кремниевых интегральных микросхем. М. А. Королев, Т. Ю. Крупкина. М. А. Ревелева. Под ред. чл. -корр. РАН Ю. А. Чаплыгина. Ч. 1 М. , БИНОМ. Лаборатория знаний, 2007 • Технология, конструкции и методы моделирования кремниевых интегральных микросхем. М. А. Королев, Т. Ю. Крупкина, М. Г. Путря, В. И. Шевяков. Ч. 2 Элементы и маршруты изготовления кремниевых ИС и методы их математического моделирования. Под ред. чл. -корр. РАН Ю. А. Чаплыгина. М. , БИНОМ. Лаборатория знаний, 2009 Е. А. Артамонова, А. Г. Балашов, А. С. Ключников, А. Ю. Красюков, С. А. Поломошнов. Лабораторный практикум по курсу «Моделирование в среде TCAD» . Ч. 1. Введение в приборно-технологическое моделирование. Методические указания. Под ред. Крупкиной Т. Ю. • • Г. Я. Красников. Конструктивно-технологические особенности субмикронных МОП-транзисторов. Ч. 1, М. , Техносфера, 2002. • МОП – СБИС. Моделирование элементов и технологических процессов. Под ред. П. Антонетти и др. М. Радио и связь. 1988. 26
 Учебный план • Введение в предмет курса. Роль приборнотехнологического моделирования в проектировании интегральных микросхем. • Теоретические основы процесса ионной имплантации. Ионная имплантация, механизмы торможения ионов. Теория ЛШШ, диффузионная модель Бирсака. Эффект каналирования. • Методы моделирования процесса ионной имплантации. Системы координат при моделировании ионной имплантации. Моделирование ионной имплантации методом Монте-Карло. Аналитические аппроксимации распределения ионов. Функции Гаусса. Распределения Пирсона-IV. Аналитические аппроксимации распределения ионов, учитывающие эффект каналирования. Распределения постимплантационных дефектов. Особенности 27 моделирования ионной имплантации в многослойных
Учебный план • Введение в предмет курса. Роль приборнотехнологического моделирования в проектировании интегральных микросхем. • Теоретические основы процесса ионной имплантации. Ионная имплантация, механизмы торможения ионов. Теория ЛШШ, диффузионная модель Бирсака. Эффект каналирования. • Методы моделирования процесса ионной имплантации. Системы координат при моделировании ионной имплантации. Моделирование ионной имплантации методом Монте-Карло. Аналитические аппроксимации распределения ионов. Функции Гаусса. Распределения Пирсона-IV. Аналитические аппроксимации распределения ионов, учитывающие эффект каналирования. Распределения постимплантационных дефектов. Особенности 27 моделирования ионной имплантации в многослойных
 • Теоретические основы процесса диффузии примесей Диффузия примесей, описание на макроскопическом и микроскопическом уровне. Основные механизмы диффузии примесей в кристаллической решетке. Связанная диффузия. Коэффициент диффузии, зависимость от температуры и концентрации носителей. • Методы моделирования процесса диффузии примесей. Особенности диффузии различных типов примеси. Модель связанной диффузии, основные уравнения. • Рубежное тестирование • Граничные и начальные условия в моделировании диффузии. Моделирование кластеризации примеси. Особенности диффузии различных типов примеси. Взаимное влияние примесей в процессе диффузии. TED –эффект. Моделирование диффузии в поликристаллическом кремнии. • Теоретические основы процесса окисления кремния. Термическое окисление кремния. Модель Дила-Гроува, вывод основного уравнения. Константы линейного и параболического роста. Начальный этап процесса окисления. Механизмы возникновения механических напряжений. 28
• Теоретические основы процесса диффузии примесей Диффузия примесей, описание на макроскопическом и микроскопическом уровне. Основные механизмы диффузии примесей в кристаллической решетке. Связанная диффузия. Коэффициент диффузии, зависимость от температуры и концентрации носителей. • Методы моделирования процесса диффузии примесей. Особенности диффузии различных типов примеси. Модель связанной диффузии, основные уравнения. • Рубежное тестирование • Граничные и начальные условия в моделировании диффузии. Моделирование кластеризации примеси. Особенности диффузии различных типов примеси. Взаимное влияние примесей в процессе диффузии. TED –эффект. Моделирование диффузии в поликристаллическом кремнии. • Теоретические основы процесса окисления кремния. Термическое окисление кремния. Модель Дила-Гроува, вывод основного уравнения. Константы линейного и параболического роста. Начальный этап процесса окисления. Механизмы возникновения механических напряжений. 28
 • Методы моделирования процесса термического окисления. Основные этапы численного моделирования процесса окисления. Влияние окислительной атмосферы на процесс диффузии. Моделирование диффузии в присутствии подвижных границ. Моделирование сегрегации примеси. Модель Массуда. Моделирование двумерного окисления. Силицидизация. • Моделирование процессов травления и осаждения. Физико-химические и геометрические модели травления/осаждения слоев. Алгоритм струны. Модель баллистического осаждения. • Моделирование процесса фотолитографии. Основные этапы численного моделирования литографии. Расчет изображения на поверхности фоторезиста. Расчет интенсивности освещения в пленке фоторезиста. Моделирование процесса проявления. • Методы численного моделирования полупроводниковых приборов. Базовые уравнения численного моделирования приборов. Методы дискретизации. Проблемы устойчивости и сходимости 29
• Методы моделирования процесса термического окисления. Основные этапы численного моделирования процесса окисления. Влияние окислительной атмосферы на процесс диффузии. Моделирование диффузии в присутствии подвижных границ. Моделирование сегрегации примеси. Модель Массуда. Моделирование двумерного окисления. Силицидизация. • Моделирование процессов травления и осаждения. Физико-химические и геометрические модели травления/осаждения слоев. Алгоритм струны. Модель баллистического осаждения. • Моделирование процесса фотолитографии. Основные этапы численного моделирования литографии. Расчет изображения на поверхности фоторезиста. Расчет интенсивности освещения в пленке фоторезиста. Моделирование процесса проявления. • Методы численного моделирования полупроводниковых приборов. Базовые уравнения численного моделирования приборов. Методы дискретизации. Проблемы устойчивости и сходимости 29


