Презентация _МАРТ.ppt
- Количество слайдов: 19

МИНОБРНАУКИ РОССИИ ФГБОУ ВПО «МАТИ – Российский государственный технологический университет имени К. Э. Циолковского» «Растровая электронная микроскопия» Направление: 150600. 62 «Материаловедение и технология новых материалов» Выполнили: Алексеева Т. М. , Раевских А. Н. Группа: 4 МТМ– 5 ДМ– 093

В основе работы растрового электронного микроскопа (РЭМ) лежит сканирование поверхности образца сфокусированным электронным лучом (построчное перемещение луча вдоль поверхности образца), поэтому часто его называют сканирующим электронным микроскопом (СЭМ), что ближе к общепринятому английскому названию – scanning electron microscope (SEM). Наилучшее разрешение РЭМ порядка 5 – 10 нм примерно на порядок хуже, чем у просвечивающего электронного микроскопа (ПЭМ), зато РЭМ обладает глубиной резкости 0. 6 – 0. 8 мм, что примерно на два порядка больше, чем у оптического и других электронных микроскопов. Разрешающая способность РЭМ определяется: 1 – площадью сечения или диаметром электронного луча (d) в месте его взаимодействия с образцом; 2 – контрастом, создаваемым образцом и детекторной системой; 3 – областью генерации сигнала в образце. Диаметр пучка в основном зависит от конструктивных особенностей и качества узлов микроскопа и прежде всего электронной оптики. В современных РЭМ достигнуто высокое совершенство компонентов конструкции, что позволило уменьшить диаметр зонда до 5 – 10 нм. Контраст зависит от нескольких факторов: топографии поверхности, химического состава объекта, поверхностных локальных магнитных и электрических полей, кристаллографической ориентации элементов структуры. Важнейшими из них являются топографический, зависящий от неровностей поверхности образца, а также композиционный, зависящий от химического состава.

ИСТОРИЯ МЕТОДА • 1926 год – работы Ганса Буша о влиянии электромагнитного поля на траекторию заряженных частиц и о его использовании в качестве электромагнитной линзы; установка основополагающих принципов геометрической оптики; • 1931 год – создание Максом Кноллом и Эрнстом Брушем первого просвечивающего электронного микроскопа; • 1935 год – доработка прибора, добавление в конструкцию «анализатора электронного пучка» ; • 1938 год – создание Манфредом фон Арденне сканирующего электронного микроскопа (фактически, оснащение просвечивающего микроскопа сканирующей системой); • 1942 год – Владимир Зворыкин опубликовал детали первого сканирующего электронного микроскопа, позволяющего проанализировать не только образец на просвет, но и поверхность массивного образца; этот микроскоп достигал разрешения порядка 50 нм; • 1952 год – создание Чарльзом Отли и Деннисом Мак. Милланом первого РЭМ (SEM 1 или Scanning Electron Microscope 1) с разрешением 50 нм и обеспечением трехмерного эффекта воспроизведения рельефа образца; • 1960 год – изобретение Томасом Эверхартом и Ричардом Торнли детектора, дополняющего устройство РЭМ, использующегося и в современных микроскопах; • 1965 год – фирма «Cambridge Instrument Co. » выпускает первый коммерческий сканирующий электронный микроскоп Stereoscan.

Схема генерации различных излучений при воздействии электронного пучка на образец

ОТРАЖЕННЫЕ ЭЛЕКТРОНЫ образуются при рассеивании падающих на образец первичных электронов в результате однократного упругого рассеивания или в результате многократного рассеивания на малые углы. Размеры области генерации отраженных электронов возрастают с увеличением ускоряющего первичные электроны напряжения и уменьшения среднего атомного номера Z элементов, входящих в состав образца. Протяженность области может изменяться от 0, 1 до 1 мкм. Сечение, с которого получают сигнал, будет существенно больше сечения зонда. Поэтому разрешение РЭМ в режиме регистрации отраженных электронов небольшое и изменяется от десятков нанометров при работе с невысокими ускоряющими напряжениями и тяжелыми материалами до сотен нанометров при работе с большими ускоряющими напряжениями и легкими материалами. Доля отраженных электронов зависит от атомного номера материала и почти не зависит от энергии пучка. Средняя энергия отраженных электронов меньше энергии первичного пучка, но имеет тот же порядок величины.

ВТОРИЧНЫЕ ЭЛЕКТРОНЫ. Первичные электроны, проникающие в образец, взаимодействуют с электронами внешних оболочек атомов объекта, передавая им часть своей энергии. Происходит ионизация атомов образца, а высвобождающиеся в этом случае электроны могут покинуть образец в виде вторичных электронов. Они характеризуются очень малой энергией до 50 э. В и поэтому выходят из участков образца очень близких к поверхности. По этой причине вторичные электроны легко отклоняются управляющей сеткой (запирающим напряжением) и собираются с очень высокой степенью эффективности (близкой к 100%). Низкая кинетическая энергия вторичных электронов сильно ограничивает их длину свободного пробега. Как следствие, они могут покинуть образец, если появились очень близко к поверхности, на расстоянии не более 1 – 10 нм от нее. Поэтому при использовании сигнала вторичных электронов разрешающая способность микроскопа определяется лишь диаметром первичного пучка, а не рассеянием электронов в пучке. Количество образующихся вторичных электронов слабо зависит от атомного номера элемента. Основным параметром, определяющим выход вторичных электронов, является угол падения пучка первичных электронов на поверхность объекта. Таким образом, вариации наклона микроучастков поверхности вызывают резко выраженные изменения в выходе вторичных электронов. Этот эффект используется для получения информации о топографии поверхности.

Факторы, влияющие на вторичную эмиссию. Эмиссия вторичных электронов определяется четырьмя факторами. Работой выхода. Её определяют как энергию, которую нужно передать электрону, находящемуся на уровне Ферми, чтобы он смог покинуть материал. Типичные значения работы выхода равны нескольким э. В, причем она зависит как от состава, так и от структуры (упаковки атомов) поверхности. Работа выхода зависит от наличия поверхностного адсорбированных атомов и загрязняющей пленки. Энергией и интенсивностью пучка. Казалось бы, увеличение энергии первичного электрона должно увеличивать количество вторичных электронов. Однако при этом уменьшаются потери энергии в приповерхностной области, и доля достигающих поверхность вторичных электронов уменьшается. С другой стороны, количество вторичных электронов всегда прямо пропорционально току первичного пучка. Отметим, что плотность материала влияет на коэффициент эмиссии вторичных электронов не слишком сильно. Так как тяжелые материалы имеют небольшую длину свободного побега, потери энергии в поверхностной области повышены. Это приводит к увеличению количества вторичных электронов. Наиболее ярко роль плотности проявляется при невысокой энергии пучка, когда длина свободного пробега сравнительно мала. Влияние вариации плотности маскируется поверхностной пленкой. Топографией поверхности. Наиболее сильно на выход вторичных электронов влияют неровности поверхности. Выступающие из поверхности области имеют повышенный выход вторичных электронов. Напротив, в углублениях выход вторичных электронов понижен вследствие их возврата в образец. Поскольку вторичные электроны попадают в ускоряющее электрическое поле, они достигают анода, даже если были выбиты из областей, находящихся вне его «зоны прямой видимости» . Использование вторичных электронов наилучшим образом подходит для неровных поверхностей, что позволяет получить высокое решение и хорошую контрастность.

Подготовка образцов для исследования в РЭМ На РЭМ могут исследоваться как шлифы, так и поверхности объектов без предварительной подготовки. Изготовление шлифов к исследованию в РЭМ в общем осуществляется так же как и для светомикроскопического исследования. Однако есть и некоторые особенности. Образцы должны быть электропроводящими. Для обеспечения их хорошего электрического контакта с предметным столиком и для фиксации образцов при наклоне стола используют специальные токопроводящие клеи. При исследовании непроводящих материаловдиэлектриков на их поверхность наносится напылением тонкая пленка электропроводников – золото, сплавы палладия, графит и т. д. При работе с органическими материалами нужно учитывать, что при длительном контакте зонда с образцом возможно его термическое разрушение. Перед испытанием рекомендуется проводить очистку образцов в различных растворителях с использованием ультразвука. Важным требованием, предъявляемым к образцу в растровом электронном микроскопе, является отсутствие электростатической зарядки поверхности. Изменение поверхностного заряда изменяет выход вторичных электронов, снижает разрешающую способность и искажает изображение. Зарядки непроводящих можно избежать, используя низкое напряжение пучка или покрывая образец тонкой проводящей пленкой.

Устройство растрового электронного микроскопа Он состоит из следующих основных узлов: § электронной пушки 1 – 3, эмитирующей электроны; § электронно-оптической системы 4 – 6, формирующей электронный зонд и обеспечивающей его сканирование на поверхности образца; § системы, формирующей изображение 7 – 14. РЭМ имеет вакуумную камеру, которая служит для создания необходимого разряжения (~10 -6 Торр) в рабочем объеме электронной пушки и электронно -оптической системы. Составными частями микроскопа являются также механические узлы обеспечивающие установку и перемещение образца.

Устройство детектора Эверхарта-Торнли 1 – электрод 250 В; 2 – световод; 3 – кристалл-сцинтиллятор (12 к. В); 4 – фотоумножитель.

Для регистрации отраженных электронов могут использоваться различные типы детекторов, в том числе и детектор Эверхарта-Торнли, но с некоторым изменением. Это вызвано тем, что отраженные электроны имеют высокую энергию, движутся прямолинейно, не отклоняясь электрическим полем в отличие от вторичных электронов. Поэтому нет необходимости использовать в детекторе высокие напряжения и, следовательно, коллектор. Получение изображения в отраженных электронах вызвано тем, что эмиссия этих электронов зависит от порядкового номера химического элемента. Поэтому, например, на плоской поверхности образца участок материала с более высоким средним порядковым номером атомов отражает большее количество электронов. Он выглядит на экране более светлым относительно других участков образца. Полученный контраст называют композиционным. В том случае, когда поверхность образца имеет ярко выраженные неровности, то дополнительно к композиционному возникает топографический контраст. Для разделения композиционного и топографического контрастов применяют два детектора отраженных электронов Эверхарта-Торнли.
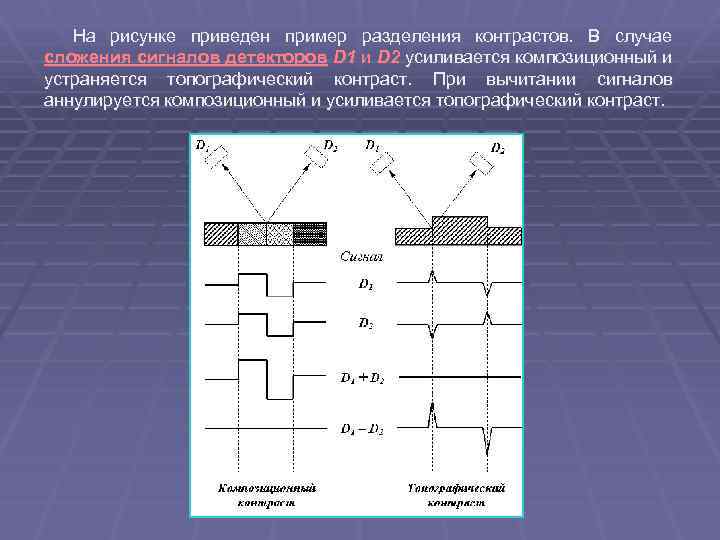
На рисунке приведен пример разделения контрастов. В случае сложения сигналов детекторов D 1 и D 2 усиливается композиционный и устраняется топографический контраст. При вычитании сигналов аннулируется композиционный и усиливается топографический контраст.

Растровые микроскопы применяются как микроскопы исследовательский инструмент в физике, электронике, биологии, фармацевтике, медицине, материаловедении, и т. д. Их главная функция — получение увеличенного изображения исследуемого образца и/или изображений образца в различных регистрируемых сигналах. В качестве примера, демонстрирующего возможности РЭМ, на рисунке приведены изображения, так называемых, алмазоподобных пленок, полученных на подложках из Ni и Si (изображения получены в Университете Бристоля, Англия). Особенно необходимо отметить изображение «в» , полученное в режиме scoss-seclion (поперечною сечения), из которого можно получить информацию о толщине сформированной пленки и ее внутренней структуре (правда, с не очень большим разрешением).

Преимущества Основным достоинством РЭМ является высокая информативность прибора, обусловленная возможностью наблюдать изображение, используя сигналы различных датчиков. В определенном режиме РЭМ может быть использован для технологических операций: засветка фоторезистора, проведение локальной диффузии в полупроводник, микрообработка и др. Высокая информативность, простота изготовления объектов для исследования, высокая степень автоматизации количественного анализа изображения и обработки результатов измерении делают РЭМ наиболее универсальным прибором для исследования структуры материалов и топографии поверхности. С помощью РЭМ можно получать изображения больших площадей поверхностей на массивных образцах широком диапазоне увеличений от 10 до 50000 и выше с достаточно высоким разрешением. На РЭМ можно исследовать общий характер структуры всей поверхности объекта при малых увеличениях и детально изучить любой интересующий исследователя участок при больших увеличениях другими методами (например, СТМ). РЭМ имеет большую глубину фокуса, что позволяет наблюдать объемное изображение структуры с возможностью ее количественной оценки.
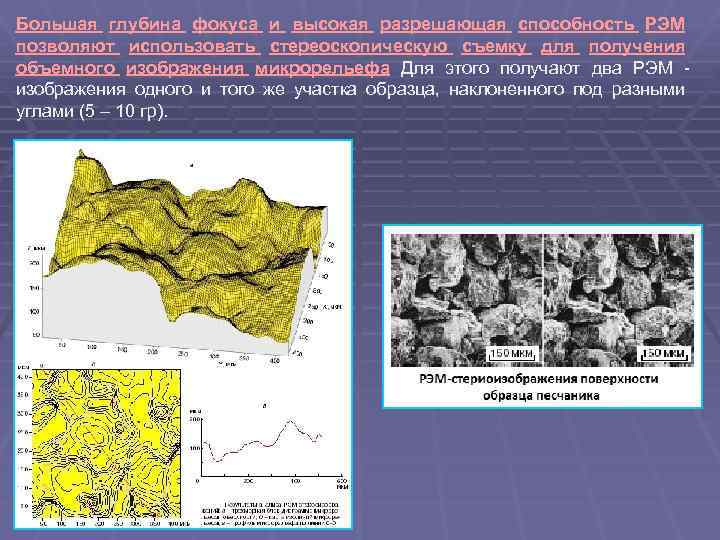
Большая глубина фокуса и высокая разрешающая способность РЭМ позволяют использовать стереоскопическую съемку для получения объемного изображения микрорельефа Для этого получают два РЭМ изображения одного и того же участка образца, наклоненного под разными углами (5 – 10 гр).

Основные производители сканирующих электронных микроскопов Зарубежные производители: • Carl Zeiss Microscopy — Германия; • FEI Company — США (слилась с Philips Electron Optics); • Hitachi — Япония; • JEOL — Япония (Japan Electron Optics Laboratory); • Tescan — Чехия; • KYKY — Китай.
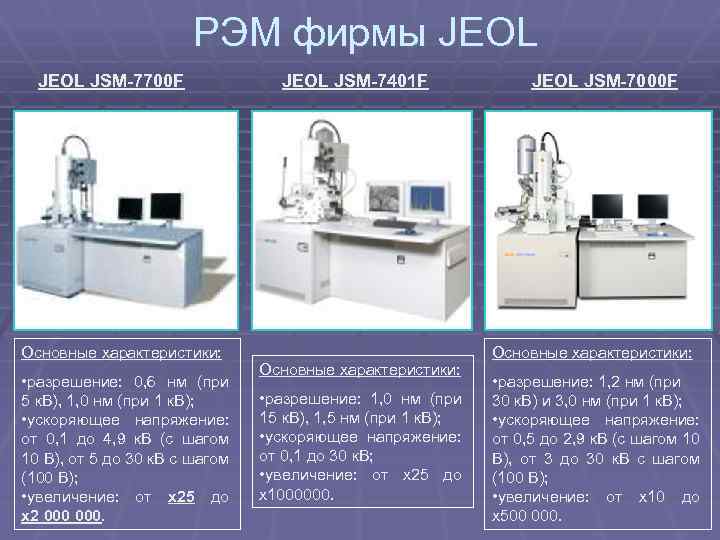
РЭМ фирмы JEOL JSM-7700 F Основные характеристики: • разрешение: 0, 6 нм (при 5 к. В), 1, 0 нм (при 1 к. В); • ускоряющее напряжение: от 0, 1 до 4, 9 к. В (с шагом 10 В), от 5 до 30 к. В с шагом (100 В); • увеличение: от х25 до х2 000. JEOL JSM-7401 F Основные характеристики: • разрешение: 1, 0 нм (при 15 к. В), 1, 5 нм (при 1 к. В); • ускоряющее напряжение: от 0, 1 до 30 к. В; • увеличение: от х25 до х1000000. JEOL JSM-7000 F Основные характеристики: • разрешение: 1, 2 нм (при 30 к. В) и 3, 0 нм (при 1 к. В); • ускоряющее напряжение: от 0, 5 до 2, 9 к. В (с шагом 10 В), от 3 до 30 к. В с шагом (100 В); • увеличение: от х10 до х500 000.
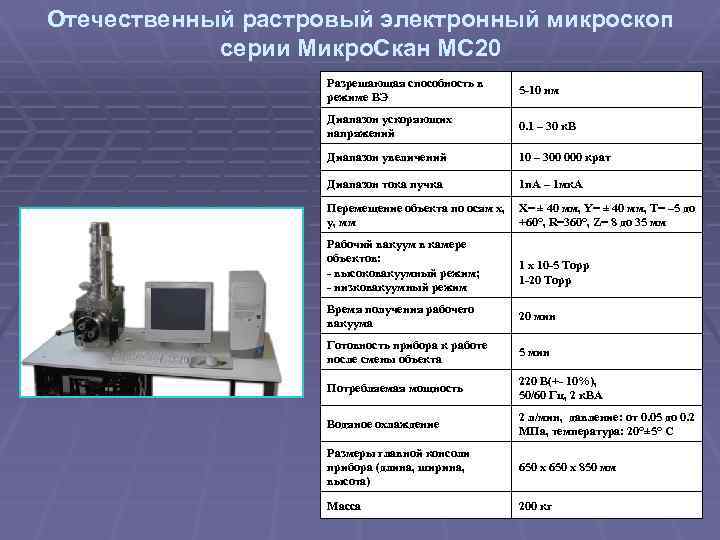
Отечественный растровый электронный микроскоп серии Микро. Скан МС 20 Разрешающая способность в режиме ВЭ 5 -10 нм Диапазон ускоряющих напряжений 0. 1 – 30 к. В Диапазон увеличений 10 – 300 000 крат Диапазон тока пучка 1 п. А – 1 мк. А Перемещение объекта по осям x, X= ± 40 мм, Y= ± 40 мм, Т= – 5 до y, мм +60°, R=360°, Z= 8 до 35 мм Рабочий вакуум в камере объектов: - высоковакуумный режим; - низковакуумный режим 1 х 10 -5 Торр 1 -20 Торр Время получения рабочего вакуума 20 мин Готовность прибора к работе после смены объекта 5 мин Потребляемая мощность 220 В(+- 10%), 50/60 Гц, 2 к. ВА Водяное охлаждение 2 л/мин, давление: от 0. 05 до 0. 2 МПа, температура: 20°± 5° С Размеры главной консоли прибора (длина, ширина, высота) 650 х 850 мм Масса 200 кг

Технические возможности растрового электронного микроскопа : • Непосредственно исследовать большие площади поверхностей на массивных образцах и даже деталях в широком диапазоне увеличений от 10 до 50000 и выше с достаточно высоким разрешением. При этом не требуется как для ПЭМ выполнение сложных и длительных операций по изготовлению специальных объектов - реплик, прозрачных для электронного луча. Исключается возможность погрешностей вследствие деформации реплик при снятии их с объекта и под действием электронного луча. • На РЭМ можно исследовать общий характер структуры всей поверхности объекта при малых увеличениях и детально изучить любой интересующий исследователя участок при больших увеличениях. При этом отпадает необходимость в разработке специальных прицельных методов. Переход от малых увеличений к большим на РЭМ осуществляется быстро и просто. Возможность быстрого изменения увеличения в процессе работы микроскопа от 10 до 50000 позволяет легко устанавливать полезное увеличение. • РЭМ имеет большую глубину фокуса, что позволяет наблюдать объемное изображение структуры с возможностью ее количественной оценки. Создаются условия прямого изучения структуры поверхностей с сильно развитым рельефом, например, изломов. • РЭМ обычно снабжен микроанализаторами химического состава, что позволяет получать более полную информацию о поверхности изделия.
Презентация _МАРТ.ppt