Микроскопия.ppt
- Количество слайдов: 27
 Микроскопия Оптическая и электронная – основные принципы
Микроскопия Оптическая и электронная – основные принципы
 Принцип действия микроскопа Характеристики 1. Увеличение 2. Разрешающая способность 3. Контраст 4. Глубина фокуса 5. Искажения (абберации)
Принцип действия микроскопа Характеристики 1. Увеличение 2. Разрешающая способность 3. Контраст 4. Глубина фокуса 5. Искажения (абберации)
 Разрешающая способность микроскопа Числовая апертура объектива: Na=R/f R - радиус входного зрачка объектива f - фокусное расстояние Разрешающая способность: минимальное расстояние между двумя точками, выглядящими отдельно на полученном изображении (числовая апертура микроскопа) D=(n )/(2 Na) n - показатель преломления среды между объектом и объективом - длина волны света
Разрешающая способность микроскопа Числовая апертура объектива: Na=R/f R - радиус входного зрачка объектива f - фокусное расстояние Разрешающая способность: минимальное расстояние между двумя точками, выглядящими отдельно на полученном изображении (числовая апертура микроскопа) D=(n )/(2 Na) n - показатель преломления среды между объектом и объективом - длина волны света
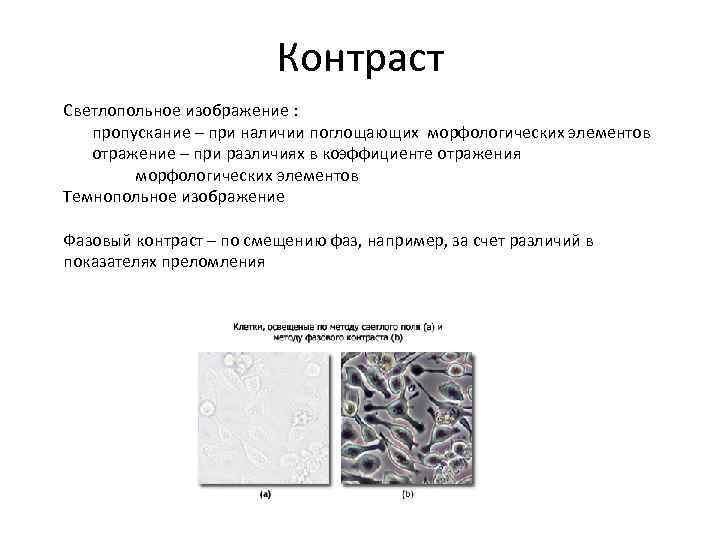 Контраст Светлопольное изображение : пропускание – при наличии поглощающих морфологических элементов отражение – при различиях в коэффициенте отражения морфологических элементов Темнопольное изображение Фазовый контраст – по смещению фаз, например, за счет различий в показателях преломления
Контраст Светлопольное изображение : пропускание – при наличии поглощающих морфологических элементов отражение – при различиях в коэффициенте отражения морфологических элементов Темнопольное изображение Фазовый контраст – по смещению фаз, например, за счет различий в показателях преломления
 Абберации Условия, необходимые для формирования идеального изображения i. Все лучи света, падают через одну точку, проходят через оптическую систему, формируя изображение, и сходятся в одной точке. ii. Точки изображения соответствуют точкам объекта в той же плоскости, перпендикулярно оптической оси и находятся в плоскости изображения. iii. Плоскость объекта и плоскость изображения расположены перпендикулярно относительно оптической оси и идентичны.
Абберации Условия, необходимые для формирования идеального изображения i. Все лучи света, падают через одну точку, проходят через оптическую систему, формируя изображение, и сходятся в одной точке. ii. Точки изображения соответствуют точкам объекта в той же плоскости, перпендикулярно оптической оси и находятся в плоскости изображения. iii. Плоскость объекта и плоскость изображения расположены перпендикулярно относительно оптической оси и идентичны.
 Классификация аберраций Сферическая аберрация Пучок света, исходит из точки, принадлежащей главной оптической оси линзы, и прохождении через линзу, пересекается не в одной, а в нескольких точках. Изображение получается нечетким (а). сферические аберрации пропорциональны числовой апертуре (N. A. ). Это означает, что линзы объективов с большей числовой апертурой имеют большее разрешение, но наихудшую аберрацию. Кома аберрация лучи света выходят из точек вне оптической оси линзы и не концентрируются в одной точке на плоскости изображения, а создают асимметрию. Получается расплывчатое пятно, как показано на рисунке b. Такое явление может быть устранено или скорректировано. Астигматизм пучок света из точечного источника на оптической оси проходит через линзу и собирается не в одной точке, а превращается в два взаимно перпендикулярных прямолинейных отрезка, которые расположены на некотором расстоянии друг от друга (Рис. с). Кривизна поля изображения Даже когда свет из каждой точки формирует четкое изображение, точки, в которые они переходят после фокусировки, могут лежать на искривленной поверхности, несмотря на ровную плоскость. Когда присутствует кривизна поля изображения, образ смещен тем больше, чем ближе он краю визуального поля. Однако когда происходит фокусировка центра, края становятся размытыми. Чтобы получить полное изображение, включая четкие края, необходимо корректировать этот вид аберрации. Искажение Когда нет соответствующей зависимости между плоскостью объекта и плоскостью изображения, имеет место явление искажения. При наличии искажения, квадратное изображение появляется в форме бочки или подушечки для булавок, как показано на рисунке d.
Классификация аберраций Сферическая аберрация Пучок света, исходит из точки, принадлежащей главной оптической оси линзы, и прохождении через линзу, пересекается не в одной, а в нескольких точках. Изображение получается нечетким (а). сферические аберрации пропорциональны числовой апертуре (N. A. ). Это означает, что линзы объективов с большей числовой апертурой имеют большее разрешение, но наихудшую аберрацию. Кома аберрация лучи света выходят из точек вне оптической оси линзы и не концентрируются в одной точке на плоскости изображения, а создают асимметрию. Получается расплывчатое пятно, как показано на рисунке b. Такое явление может быть устранено или скорректировано. Астигматизм пучок света из точечного источника на оптической оси проходит через линзу и собирается не в одной точке, а превращается в два взаимно перпендикулярных прямолинейных отрезка, которые расположены на некотором расстоянии друг от друга (Рис. с). Кривизна поля изображения Даже когда свет из каждой точки формирует четкое изображение, точки, в которые они переходят после фокусировки, могут лежать на искривленной поверхности, несмотря на ровную плоскость. Когда присутствует кривизна поля изображения, образ смещен тем больше, чем ближе он краю визуального поля. Однако когда происходит фокусировка центра, края становятся размытыми. Чтобы получить полное изображение, включая четкие края, необходимо корректировать этот вид аберрации. Искажение Когда нет соответствующей зависимости между плоскостью объекта и плоскостью изображения, имеет место явление искажения. При наличии искажения, квадратное изображение появляется в форме бочки или подушечки для булавок, как показано на рисунке d.
 Хроматические аберрации Показатель преломления зависит от длины волны. Различия между фокальными длинами волн образуют смещение плоскости при формировании изображения. Разделение оптической оси называется осевой хроматической аберрацией (или поперечной хроматической аберрацией), Смещение плоскости изображения называется «хроматической аберрацией величин » .
Хроматические аберрации Показатель преломления зависит от длины волны. Различия между фокальными длинами волн образуют смещение плоскости при формировании изображения. Разделение оптической оси называется осевой хроматической аберрацией (или поперечной хроматической аберрацией), Смещение плоскости изображения называется «хроматической аберрацией величин » .
 Электронная микроскопия Просвечивающая (ПЭМ, TEM) высокого разрешения ВРПЭМ, HRTEM Электронная линза - Ганс Буше 1926 Просвечивающий микроскоп – Макс Кнолл, Манфред фон Арденне 1932 Разрешение до 1 А Сканирующая (растровая) СЭМ (РЭМ), SEM Кнолл 1935, Арденне 1938 - зондирование электронным пучком Владимир Зворыкин 1942 – растровое изображение Коммерческий выпуск с 1965 Разрешение до 1 нм Туннельная микроскопия? ? ?
Электронная микроскопия Просвечивающая (ПЭМ, TEM) высокого разрешения ВРПЭМ, HRTEM Электронная линза - Ганс Буше 1926 Просвечивающий микроскоп – Макс Кнолл, Манфред фон Арденне 1932 Разрешение до 1 А Сканирующая (растровая) СЭМ (РЭМ), SEM Кнолл 1935, Арденне 1938 - зондирование электронным пучком Владимир Зворыкин 1942 – растровое изображение Коммерческий выпуск с 1965 Разрешение до 1 нм Туннельная микроскопия? ? ?
 Воздействие электронного пучка 1) 2) 3) 4) 5) 6) Поглощение с эмиссией вторичных электронов Упругое отражение Неупругое отражение Катодолюминесценция Тормозное излучение Рентгеновская флуоресценция
Воздействие электронного пучка 1) 2) 3) 4) 5) 6) Поглощение с эмиссией вторичных электронов Упругое отражение Неупругое отражение Катодолюминесценция Тормозное излучение Рентгеновская флуоресценция
 Схема генерации различных излучений при воздействии электронного пучка на образец Области сигналов и пространственное разрешение при облучении поверхности объекта сфокусированным пучком электронов диаметромd. Области генерации: 1 – Оже-электронов, 2 – вторичных электронов (9), 3 – отраженных электронов (10), 4 – характеристического рентгеновского излучения (7), 5 – тормозного рентгеновского излучения (8), 6 – катодолюминесценции (флуоресценции).
Схема генерации различных излучений при воздействии электронного пучка на образец Области сигналов и пространственное разрешение при облучении поверхности объекта сфокусированным пучком электронов диаметромd. Области генерации: 1 – Оже-электронов, 2 – вторичных электронов (9), 3 – отраженных электронов (10), 4 – характеристического рентгеновского излучения (7), 5 – тормозного рентгеновского излучения (8), 6 – катодолюминесценции (флуоресценции).
 Источники и детекторы Источник: электронная пушка (термоэмиссия) катод: вольфрамовая проволока или борид лантана Высоковольтный ускоритель Энергия электронов 100 - 5000 кэ. В Детекторы: фотопленка видеокамера с флуоресцентным экраном полупроводниковые датчики (матрицы диодов Шоттки)
Источники и детекторы Источник: электронная пушка (термоэмиссия) катод: вольфрамовая проволока или борид лантана Высоковольтный ускоритель Энергия электронов 100 - 5000 кэ. В Детекторы: фотопленка видеокамера с флуоресцентным экраном полупроводниковые датчики (матрицы диодов Шоттки)
 Электронные линзы Электрическое поле Магнитное поле 1 – электроды; 2 – силовые линии полей
Электронные линзы Электрическое поле Магнитное поле 1 – электроды; 2 – силовые линии полей
 Схема электронного ПЭМ микроскопа а — В режиме изображения; формируемое объективной линзой изображение переносится на экран системой проекционных линз. б — B режиме микродифракции; на экран переносится дифракционная картина; 1 — источник, 2 — конденсорная линза, 3 — объект, 4 — объективная линза, 5 — селекторная диафрагма, 6 — промежуточная линза, 7 — проекционная линза ТРЕБУЕТСЯ ВЫСОКИЙ ВАКУУМ 10 -6 Па!!!
Схема электронного ПЭМ микроскопа а — В режиме изображения; формируемое объективной линзой изображение переносится на экран системой проекционных линз. б — B режиме микродифракции; на экран переносится дифракционная картина; 1 — источник, 2 — конденсорная линза, 3 — объект, 4 — объективная линза, 5 — селекторная диафрагма, 6 — промежуточная линза, 7 — проекционная линза ТРЕБУЕТСЯ ВЫСОКИЙ ВАКУУМ 10 -6 Па!!!
 Устройство электронного ПЭМ микроскопа 1 — высоковольтный кабель, 2 — изолятор, 3 — механизм юстировки пушки, 4 — механизм наклона осветительной системы, 5 — ручка юстировки и смены диафрагм конденсора, 6 — ручка плоскопараллельного перемещения конденсатора, 7 — шлюз объекта, 8 — ручка юстировки диафрагмы объектива, 9 — ручка сменных микродифракционных диафрагм, 10 — ручка юстировки объектива, 11 — ручка для удаления полюсного наконечника проекционной линзы, 12 — окно для наблюдения изображения, 13 —фотокамера, 14 — ручка шлюза фотокамеры, 15 —тубус проекционной линзы, 16 — крышка шлюза фотокамеры, 17 — штанга для перемещения объекта, 18 — штанга юстировки осветительной системы, 19 —штанга для юстировки пушки
Устройство электронного ПЭМ микроскопа 1 — высоковольтный кабель, 2 — изолятор, 3 — механизм юстировки пушки, 4 — механизм наклона осветительной системы, 5 — ручка юстировки и смены диафрагм конденсора, 6 — ручка плоскопараллельного перемещения конденсатора, 7 — шлюз объекта, 8 — ручка юстировки диафрагмы объектива, 9 — ручка сменных микродифракционных диафрагм, 10 — ручка юстировки объектива, 11 — ручка для удаления полюсного наконечника проекционной линзы, 12 — окно для наблюдения изображения, 13 —фотокамера, 14 — ручка шлюза фотокамеры, 15 —тубус проекционной линзы, 16 — крышка шлюза фотокамеры, 17 — штанга для перемещения объекта, 18 — штанга юстировки осветительной системы, 19 —штанга для юстировки пушки
 Пробоподготовка для ПЭМ 1. Изготовление реплик: 1) напыление тонкого покрытия (углерод, золото) 2) химическое стравливание подложки 2. Нанесение ультрадисперсных частиц на металлические сетки
Пробоподготовка для ПЭМ 1. Изготовление реплик: 1) напыление тонкого покрытия (углерод, золото) 2) химическое стравливание подложки 2. Нанесение ультрадисперсных частиц на металлические сетки
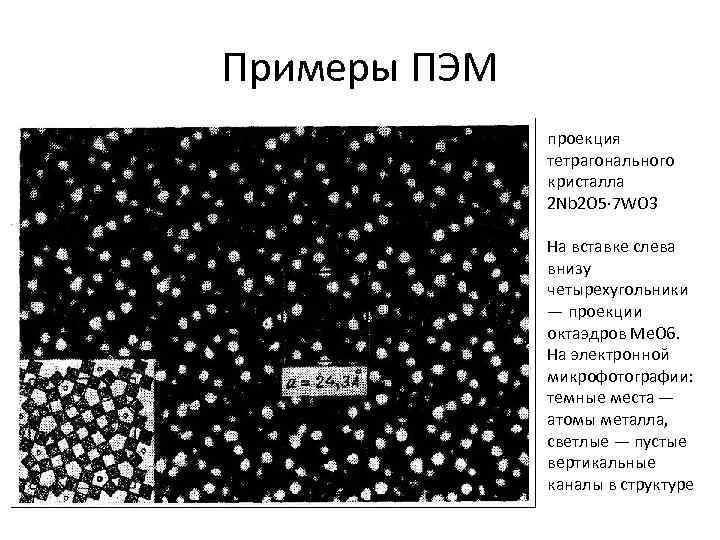 Примеры ПЭМ проекция тетрагонального кристалла 2 Nb 2 O 5· 7 WO 3 На вставке слева внизу четырехугольники — проекции октаэдров Ме. О 6. На электронной микрофотографии: темные места — атомы металла, светлые — пустые вертикальные каналы в структуре
Примеры ПЭМ проекция тетрагонального кристалла 2 Nb 2 O 5· 7 WO 3 На вставке слева внизу четырехугольники — проекции октаэдров Ме. О 6. На электронной микрофотографии: темные места — атомы металла, светлые — пустые вертикальные каналы в структуре
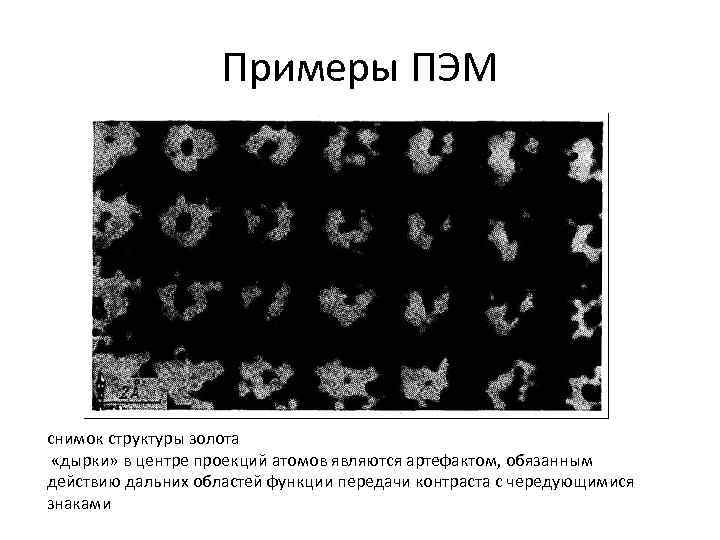 Примеры ПЭМ снимок структуры золота «дырки» в центре проекций атомов являются артефактом, обязанным действию дальних областей функции передачи контраста с чередующимися знаками
Примеры ПЭМ снимок структуры золота «дырки» в центре проекций атомов являются артефактом, обязанным действию дальних областей функции передачи контраста с чередующимися знаками
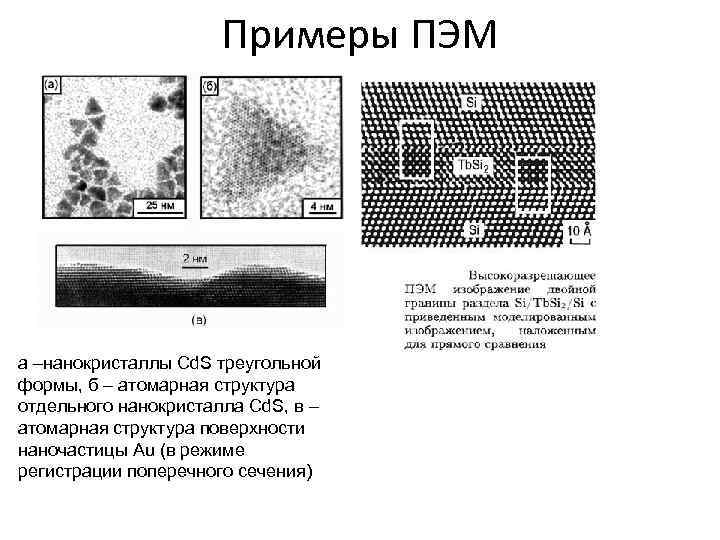 Примеры ПЭМ а –нанокристаллы Cd. S треугольной формы, б – атомарная структура отдельного нанокристалла Cd. S, в – атомарная структура поверхности наночастицы Au (в режиме регистрации поперечного сечения)
Примеры ПЭМ а –нанокристаллы Cd. S треугольной формы, б – атомарная структура отдельного нанокристалла Cd. S, в – атомарная структура поверхности наночастицы Au (в режиме регистрации поперечного сечения)
 Сканирующий электронныйй микроскоп
Сканирующий электронныйй микроскоп
 Режимы работы Детекция отраженных электронов (контраст по элементному составу) Детекция вторичных электронов (контраст по рельефу поверхности) Не требует специальной пробоподготовки
Режимы работы Детекция отраженных электронов (контраст по элементному составу) Детекция вторичных электронов (контраст по рельефу поверхности) Не требует специальной пробоподготовки
 Детекция вторичных электронов в СЭМ В РЭМ в качестве детектора вторичных электронов используется детектор Эверхарта-Торнли. Коллектор 1 имеет положительный потенциал ~250 В, траектории вторичных электронов искривляются и они попадают в коллектор. На первичные и отраженные электроны, имеющие высокие значения энергии, этот потенциал существенного влияния не оказывает. Вследствие ускорения вторичные электроны получают достаточную энергию, чтобы вызвать световое излучение материала сцинтиллятора, которое по световоду 2 попадает на фотоумножитель 4, где преобразуется в электрический сигнал. Мощность этого сигнала и, следовательно, яркость соответствующей точки на экране при использовании вторичных электронов определяется топографическим контрастом. Характерная особенность топографического контраста в РЭМ повышенная яркость изображения острых вершин и выступов рельефа поверхности образца, вызывается увеличением выхода электронов с этих участков.
Детекция вторичных электронов в СЭМ В РЭМ в качестве детектора вторичных электронов используется детектор Эверхарта-Торнли. Коллектор 1 имеет положительный потенциал ~250 В, траектории вторичных электронов искривляются и они попадают в коллектор. На первичные и отраженные электроны, имеющие высокие значения энергии, этот потенциал существенного влияния не оказывает. Вследствие ускорения вторичные электроны получают достаточную энергию, чтобы вызвать световое излучение материала сцинтиллятора, которое по световоду 2 попадает на фотоумножитель 4, где преобразуется в электрический сигнал. Мощность этого сигнала и, следовательно, яркость соответствующей точки на экране при использовании вторичных электронов определяется топографическим контрастом. Характерная особенность топографического контраста в РЭМ повышенная яркость изображения острых вершин и выступов рельефа поверхности образца, вызывается увеличением выхода электронов с этих участков.
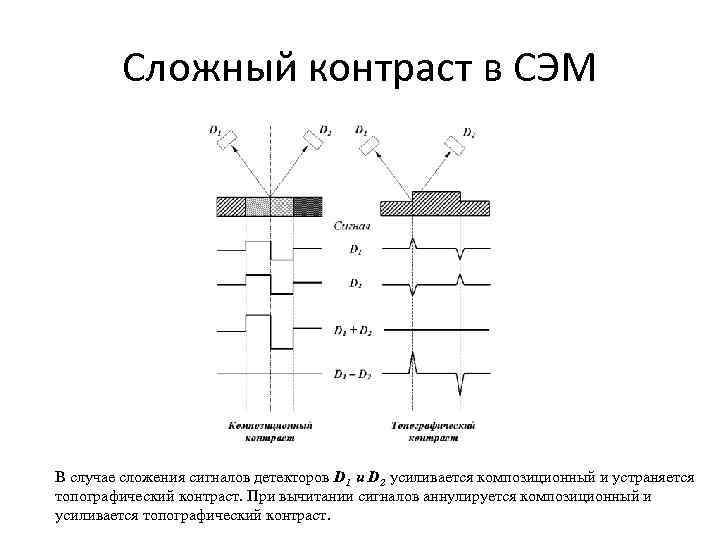 Сложный контраст в СЭМ В случае сложения сигналов детекторов D 1 и D 2 усиливается композиционный и устраняется топографический контраст. При вычитании сигналов аннулируется композиционный и усиливается топографический контраст.
Сложный контраст в СЭМ В случае сложения сигналов детекторов D 1 и D 2 усиливается композиционный и устраняется топографический контраст. При вычитании сигналов аннулируется композиционный и усиливается топографический контраст.
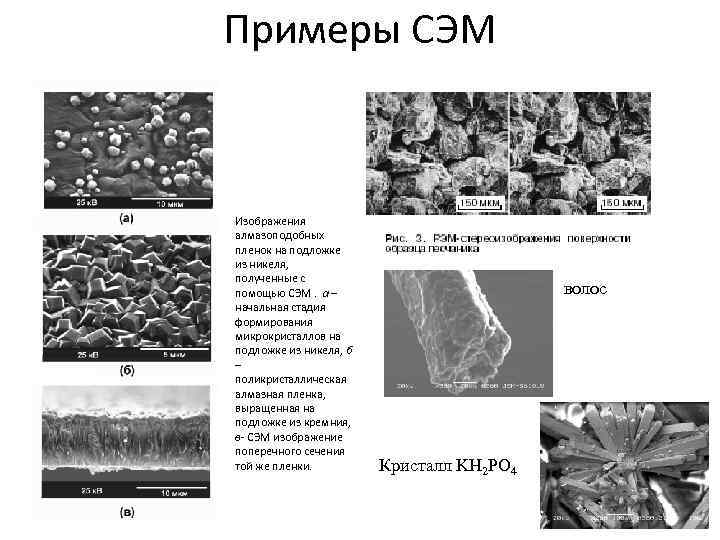 Примеры СЭМ Изображения алмазоподобных пленок на подложке из никеля, полученные с помощью СЭМ. а – начальная стадия формирования микрокристаллов на подложке из никеля, б – поликристаллическая алмазная пленка, выращенная на подложке из кремния, в- СЭМ изображение поперечного сечения той же пленки. волос Кристалл KH 2 PO 4
Примеры СЭМ Изображения алмазоподобных пленок на подложке из никеля, полученные с помощью СЭМ. а – начальная стадия формирования микрокристаллов на подложке из никеля, б – поликристаллическая алмазная пленка, выращенная на подложке из кремния, в- СЭМ изображение поперечного сечения той же пленки. волос Кристалл KH 2 PO 4
 Примеры СЭМ Топология микросхемы в СЭМ с элементным анализом
Примеры СЭМ Топология микросхемы в СЭМ с элементным анализом
 3 D-изображения СЭМ Большая глубина фокуса и высокая разрешающая способность СЭМ позволяют использовать стереоскопическую съемку для получения объемного изображения микрорельефа Для этого получают 2 СЭМизображеня одного и того же участка образца, наклоненного под разными углами (5 -10 гр).
3 D-изображения СЭМ Большая глубина фокуса и высокая разрешающая способность СЭМ позволяют использовать стереоскопическую съемку для получения объемного изображения микрорельефа Для этого получают 2 СЭМизображеня одного и того же участка образца, наклоненного под разными углами (5 -10 гр).
 4. Ядерная энергетика. Зазор твэла (микротрещина).
4. Ядерная энергетика. Зазор твэла (микротрещина).
 Области применения СЕМ. 1. Электронная техника. Отдельные атомы кобальта на ступенчатой платиновой подложке.
Области применения СЕМ. 1. Электронная техника. Отдельные атомы кобальта на ступенчатой платиновой подложке.


