L1-2009.ppt
- Количество слайдов: 10
 Методы мониторинга плазменных технолоогических процессов в микро- и наноэлектронике Константин Васильевич Руденко
Методы мониторинга плазменных технолоогических процессов в микро- и наноэлектронике Константин Васильевич Руденко
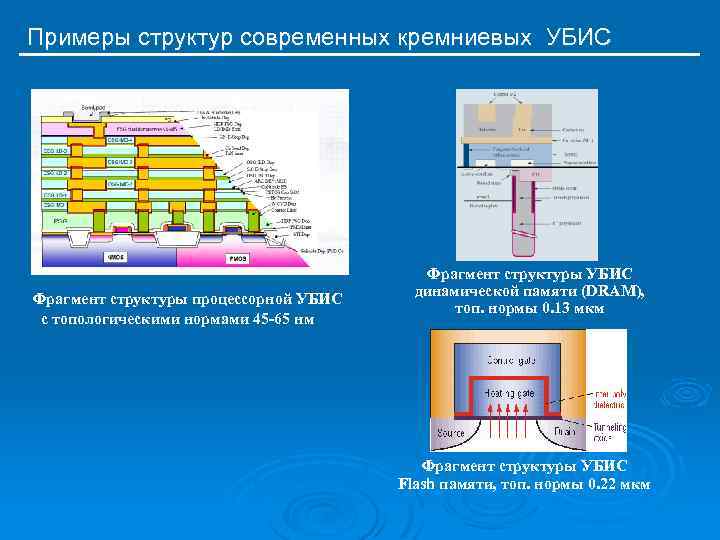 Примеры структур современных кремниевых УБИС Фрагмент структуры процессорной УБИС с топологическими нормами 45 -65 нм Фрагмент структуры УБИС динамической памяти (DRAM), топ. нормы 0. 13 мкм Фрагмент структуры УБИС Flash памяти, топ. нормы 0. 22 мкм
Примеры структур современных кремниевых УБИС Фрагмент структуры процессорной УБИС с топологическими нормами 45 -65 нм Фрагмент структуры УБИС динамической памяти (DRAM), топ. нормы 0. 13 мкм Фрагмент структуры УБИС Flash памяти, топ. нормы 0. 22 мкм
 Плазменные технологии в микро- и наноэлектронике
Плазменные технологии в микро- и наноэлектронике
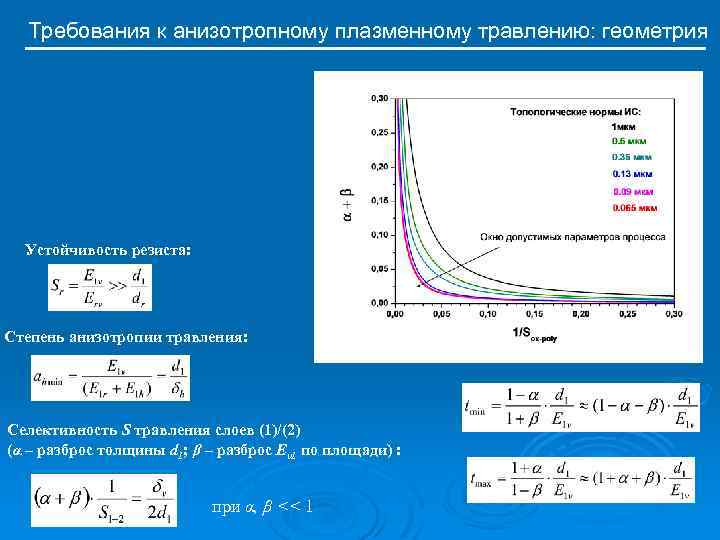 Требования к анизотропному плазменному травлению: геометрия Устойчивость резиста: Степень анизотропии травления: Селективность S травления слоев (1)/(2) (α – разброс толщины d 1; β – разброс Ev 1 по площади) : при α, β << 1
Требования к анизотропному плазменному травлению: геометрия Устойчивость резиста: Степень анизотропии травления: Селективность S травления слоев (1)/(2) (α – разброс толщины d 1; β – разброс Ev 1 по площади) : при α, β << 1
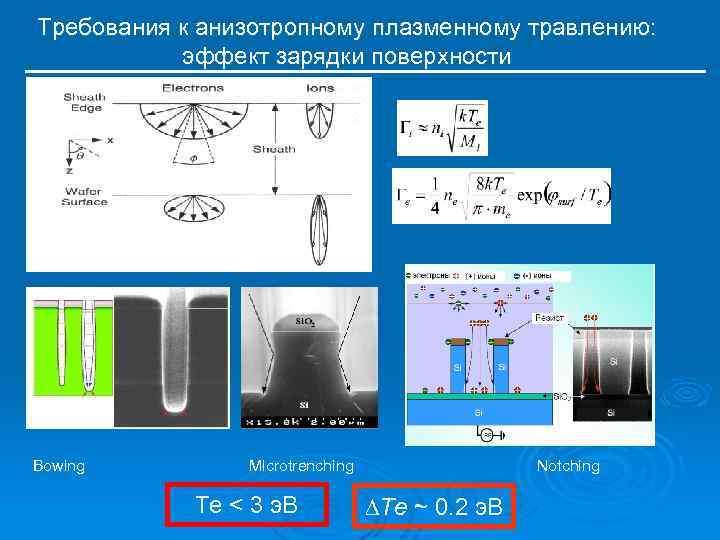 Требования к анизотропному плазменному травлению: эффект зарядки поверхности Bowing Microtrenching Te < 3 э. В Notching Te ~ 0. 2 э. В
Требования к анизотропному плазменному травлению: эффект зарядки поверхности Bowing Microtrenching Te < 3 э. В Notching Te ~ 0. 2 э. В
 От микро- к наноструктурированию плазмохимическими методами 1 мкм Vp ~ 100 – 400 B, автосмещение 0. 5 мкм ni, ne < 1011 cм-3 p ~ 100 – 500 м. Торр 0. 35 мкм 0. 25 мкм Tе ~ 1. 5 - 3 э. В Vp < 20 B 100 нм ni, ne > 1012 cм-3 p < 40 м. Торр 65 нм Tе ~ 3 - 5 э. В 45 нм
От микро- к наноструктурированию плазмохимическими методами 1 мкм Vp ~ 100 – 400 B, автосмещение 0. 5 мкм ni, ne < 1011 cм-3 p ~ 100 – 500 м. Торр 0. 35 мкм 0. 25 мкм Tе ~ 1. 5 - 3 э. В Vp < 20 B 100 нм ni, ne > 1012 cм-3 p < 40 м. Торр 65 нм Tе ~ 3 - 5 э. В 45 нм
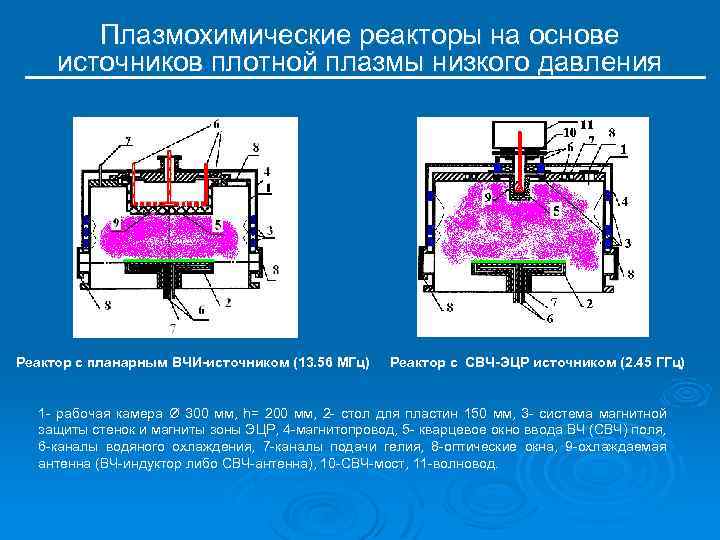 Плазмохимические реакторы на основе источников плотной плазмы низкого давления Реактор с планарным ВЧИ-источником (13. 56 МГц) Реактор с СВЧ-ЭЦР источником (2. 45 ГГц) 1 - рабочая камера Ø 300 мм, h= 200 мм, 2 - стол для пластин 150 мм, 3 - система магнитной защиты стенок и магниты зоны ЭЦР, 4 -магнитопровод, 5 - кварцевое окно ввода ВЧ (СВЧ) поля, 6 -каналы водяного охлаждения, 7 -каналы подачи гелия, 8 -оптические окна, 9 -охлаждаемая антенна (ВЧ-индуктор либо СВЧ-антенна), 10 -СВЧ-мост, 11 -волновод.
Плазмохимические реакторы на основе источников плотной плазмы низкого давления Реактор с планарным ВЧИ-источником (13. 56 МГц) Реактор с СВЧ-ЭЦР источником (2. 45 ГГц) 1 - рабочая камера Ø 300 мм, h= 200 мм, 2 - стол для пластин 150 мм, 3 - система магнитной защиты стенок и магниты зоны ЭЦР, 4 -магнитопровод, 5 - кварцевое окно ввода ВЧ (СВЧ) поля, 6 -каналы водяного охлаждения, 7 -каналы подачи гелия, 8 -оптические окна, 9 -охлаждаемая антенна (ВЧ-индуктор либо СВЧ-антенна), 10 -СВЧ-мост, 11 -волновод.
 Области применения диагностических методов Оптимизация конструкции реакторов • Максимизация ni, nrad • Минимизация Te, Vp • Пространственная однородность ni, nrad, Te в зоне обработки Разработка новых технологических процессов • Оптимизация внешних параметров процессов (p, f, Wpl, Wbias, Twaf) • Устранение дрейфа параметров в технологическом процессе • Устранение дрейфа параметров при обработке партии пластин (process drift) Мониторинг процессов (контроль в реальном времени) • Определение момента окончания процесса (end-point detection) • Контроль in situ скорости травления/осаждения слоев • Контроль in situ селективности травления • Контроль состояния камеры реактора в циклах очистки
Области применения диагностических методов Оптимизация конструкции реакторов • Максимизация ni, nrad • Минимизация Te, Vp • Пространственная однородность ni, nrad, Te в зоне обработки Разработка новых технологических процессов • Оптимизация внешних параметров процессов (p, f, Wpl, Wbias, Twaf) • Устранение дрейфа параметров в технологическом процессе • Устранение дрейфа параметров при обработке партии пластин (process drift) Мониторинг процессов (контроль в реальном времени) • Определение момента окончания процесса (end-point detection) • Контроль in situ скорости травления/осаждения слоев • Контроль in situ селективности травления • Контроль состояния камеры реактора в циклах очистки
 Методы, применяемые для диагностики плазменных процессов в технологии УБИС Диагностика плазмы в реакторе Диагностика поверхности пластины Оптическая спектроскопия Лазерная интерферометрия Mасс-спектрометрия ионов Эллипсометрия (в т. ч. спектральная) Зонд Ленгмюра Tермометрия пластины СВЧ-диагностика
Методы, применяемые для диагностики плазменных процессов в технологии УБИС Диагностика плазмы в реакторе Диагностика поверхности пластины Оптическая спектроскопия Лазерная интерферометрия Mасс-спектрометрия ионов Эллипсометрия (в т. ч. спектральная) Зонд Ленгмюра Tермометрия пластины СВЧ-диагностика
 Объединенный комплекс зондовой и спектральной диагностики плазмы Автоматизированный зонд Ленгмюра: Схема измерений: одиночный, двойной зонд Диапазон потенциалов Vpr : -90 (-180) ÷ +90 B Дискретность Vpr / Ipr : 20 м. В / 1 мк. А Допустимый потенциал плазмы Vpl: до 500 В Время измерения точки ВАХ: 10 мкс Резонансные LC фильтры: 13. 56 МГц, 27. 12 МГц Компенсация LF-колебаний Vpl : полоса 0 -100 к. Гц Скоростной акустооптический спектрометр Оптический ввод: согласованное оптоволокно Спектральный диапазон: 300 ÷ 855 нм Спектральное разрешение: 0. 15 ÷ 0. 35 нм Время измерения (1 спектр. точка): 16 мс Время перестройки по диапазону: 1 мс Динамический диапазон измерений: 47 д. Б Встроенная калибровка спектрометра по Отсутствие механических перемещений
Объединенный комплекс зондовой и спектральной диагностики плазмы Автоматизированный зонд Ленгмюра: Схема измерений: одиночный, двойной зонд Диапазон потенциалов Vpr : -90 (-180) ÷ +90 B Дискретность Vpr / Ipr : 20 м. В / 1 мк. А Допустимый потенциал плазмы Vpl: до 500 В Время измерения точки ВАХ: 10 мкс Резонансные LC фильтры: 13. 56 МГц, 27. 12 МГц Компенсация LF-колебаний Vpl : полоса 0 -100 к. Гц Скоростной акустооптический спектрометр Оптический ввод: согласованное оптоволокно Спектральный диапазон: 300 ÷ 855 нм Спектральное разрешение: 0. 15 ÷ 0. 35 нм Время измерения (1 спектр. точка): 16 мс Время перестройки по диапазону: 1 мс Динамический диапазон измерений: 47 д. Б Встроенная калибровка спектрометра по Отсутствие механических перемещений


