Lecture4_2012_электронная микроскопия.ppt
- Количество слайдов: 53

Методы диагностики наноструктур Лекция 4 1. Методы изображения • Электронная микроскопия • Растровая микроскопия (РЭМ) • Просвечивающая микроскопия (ПЭМ) • Зондовая микроскопия • Оптическая микроскопия 2. Методы структурного анализа • Дифракция рентгеновских лучей • Дифракция электронов 3. Спектроскопия • Инфракрасная спектроскопия • Рамановская спектроскопия • Флуоресцетная и люминесцентная • Фотоэмиссионная (ФЭС, Оже, …) • Магнитная (ЭПР, ЯМР) 4. Масс спектрометрия

Предел разрешения Электроны Свет =400 nm n=1. 7 (oil immersion) r=150 nm V=20 к. В n=1 r=0. 02 нм


Типы электронных микроскопов • Растровый – РЭМ (Scanning Electron Microscope (SEM)) • Просвечивающий – ПЭМ (Transmission Electron Microscope (TEM) ) Растр — в телевидении, технике видеозаписи, в системах отображения графической информации — последовательность параллельных другу видеострок на экране электронно-лучевой трубки или иного оборудования, возникающая в результате работы системы развёртки. Растр — изображение, построенное из отдельных элементов (точек), как правило, расположенных регулярно. В большинстве приложений компьютерной графики, растровое изображение представляется двумерным массивом точек, цвет и яркость каждой из которых задаются независимо;

РЭМ: принципиальная схема • Электронная пушка – создает пучок электронов • Первая конденсорная линза формирует пучок и ограничивает ток (грубая настройка) • Конденсорная диафрагма ограничивает электроны, летящие под большими углами • Вторая конденсорная линза формирует коллимированный когерентный пучок (тонкая настройка) • Вторая и третья диафрагма еще больше ограничивают электроны, летящие под большими углами • Отклоняющие катушки сканируют пучок и формируют изображение • Фокусирующая линза фокусирует пучок на образце Электронная пушка Диафрагма Конденсорная линза Стигматор Отклоняющие катушки Фокусирующая линза Диафрагма

Взаимодействие электронов с образцом Падающие e– Отраженные e– X-rays Катодлюминесценция Оже e– Вторичные e– Неупруго рассеянные e– Упруго рассеянные e– Нерассеянные e–

Электромагнитная линза Фокусное расстояние эм линзы зависит от силы тока

Упругое рассеяние (elastically scattered electrons). Упругие столкновения – это такие, при которых энергия не расходуется на возбуждение атомов среды. Направление движения электрона может изменяться, но энергия практически не изменяется, т. е. Е ≈ Е 0. Упругое рассеяние на малые углы обычно вызвано рассеянием на электронах, а на большие углы – на ядрах Неупругое рассеяние (inelastically scattered electrons). Энергия таких электронов Е<Е 0 - (energy loss electrons) теряется на а) коллективное взаимодействие с многими атомами; б) генерацию процессов, приводящих к вылету вторичных электронов; в) генерацию рентгеновских лучей

Генерация вторичных электронов Вторичные электроны (BЭ, secondary electrons=SEs) можно разделить на три группы: • Медленные ВЭ = МВЭ (<50 э. В) (slow SEs), выбитые из валентной зоны или зоны проводимости. • Быстрые БВЭ (fast SEs=FSEs), выбитые из внутренних оболочек атомов. Вероятность выбивания быстрых ВЭ мала, но если это происходит, то они забирают до 50% энергии исходных эл-в. • Электроны Оже (Auger electrons).
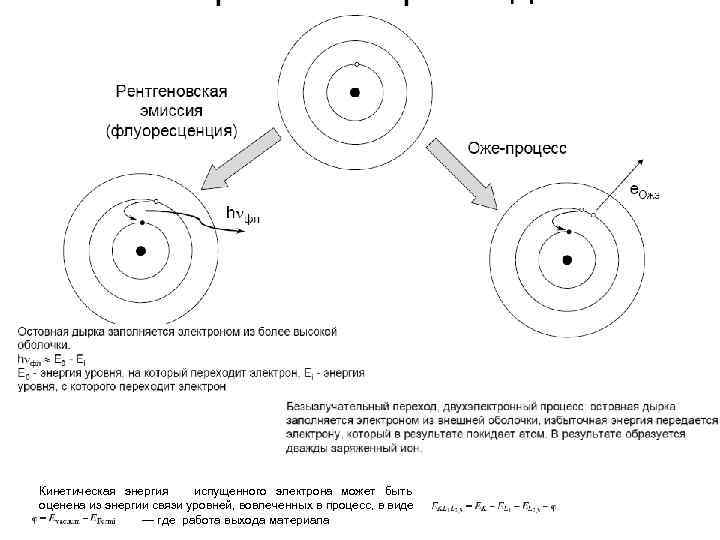
Кинетическая энергия испущенного электрона может быть оценена из энергии связи уровней, вовлеченных в процесс, в виде — где работа выхода материала

Медленные вторичные электроны (МВЭ- SE). МВЭ (SE) дают наименьший вклад в неупругие процессы, однако, этот процесс достаточно интенсивен, чтобы его можно было использовать в ПЭМ. Большую часть МВЭ составляют свободные электроны, т. е. не связанные с определенным атомом. Поскольку энергия МВЭ мала, то они могут вылетать только из приповерхностных слоев. Поэтому, МВЭ используются в ПЭМ для изображения поверхности образца. Это стандартная методика для РЭМ находит все большее применение и в сканирующей ПЭМ (СПЭМ= STEM), где с помощью МВЭ, получают изображение топографии поверхности с очень высоким разрешением. СПЭМ изображение поверхности с помощью МВЭ имеет гораздо более высокое разрешение, чем СЭМ!

Быстрые вторичные электроны ( БВЭ=FSE). БВЭ получают значительную долю электронов пучка. Сечение генерации БВЭ на порядок больше, чем сечение для МВЭ. Для РЭМ, где Е 0<30 кэ. В, это не вызывает проблем, однако, в ПЭМ БВЭ могут иметь энергии ~50 -200 кэ. В, так что БВЭ вылетают из больших глубин из образце. Это приводит к ухудшению пространственного разрешения при микроанализе в аналитических электронных микроскопах (АЕМ), а также к генерации ХРИ, усложняя интерпретацию данных по ХРИ. Таким образом, БВЭ, не представляя проблемы для изображения в ПЭМ, являются проблемой для химического анализа. БВЭ в ПЭМ нежелательны и, вместе с тем, неизбежны. Они не используются для формирования изображения или для спектроскопии, но они ухудшают разрешение в обоих случаях. Возможно, что БВЭ будут являются главным ограничением возможностей ПЭМ.

Оже-электроны (ОЭ=Auger electrons), конкурируют с ХРИ и обычно имеют энергию до 10 э. В. На первом электрон пучка выбивает электрон К -оболочки. На втором, образующаяся вакансия заполняется L 3 - электроном, избыток же энергии ∆Е = ЕК-ЕL испускается в виде (3 -го) L 2 ОЭ. Это излучение называется излучением K-L 3, L 2 ОЭ. Образующаяся вакансия на L-оболочке заполняется электроном из внешней ( валентной) оболочки, например М-оболочки (если она есть у атома) и остаток энергии излучается в виде низкоэнергетичного фотона. ОЭ имеют характеристический спектр, зависящий от электронной структуры атома и почти полностью идентичный спектру ХРИ. Оже-процесс более вероятен в атомах с малой энергией связи электронов, т. е. в легких элементах. Типичные энергии ОЭ находятся в интервале от нескольких сот э. В до нескольких кэ. В. ОЭ сильно поглощаются в образце. Следовательно, регистрируемые ОЭ вылетают из приповерхностных слоев. Поэтому Оже-электронная спектроскопия ( ОЭС, AES-Auger electron spectroscopy) признанный метод химического анализа поверхности. ХРИ не может конкурировать, поскольку слабее поглощается и вылетает со всей толщи образца. .
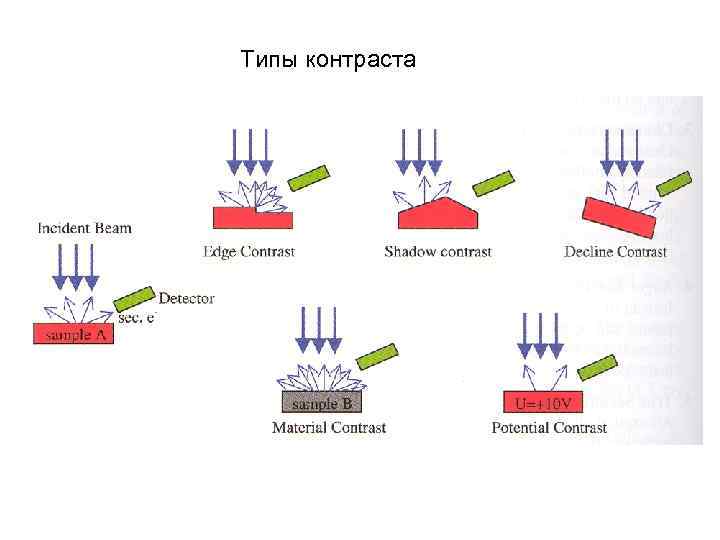
Типы контраста

Вторичные электроны Большее количество вылетевших вторичных электронов Меньшее количество FEWER вылетевших secondary e– вторичных escape электронов • Вызваны падающими электронами, которые, пролетая «мимо» атомов образца, ионизуют (выбивают) из него вторичные электроны (неупругий процесс); каждый падающий электрон может произвести несколько вторичных электронов • Ионизованные электроны покидают образец с очень маленькой кинетической энергией (5 э. В) • Выход вторичных электронов связан с топографией поверхности: только вторичные электроны, возникшие в непосредственной близости у поверхности (<10 нм) могут покинуть образец.

Электроны, рассеянные назад • Упругий процесс, рассеяние назад на 180 град • Выход электронов, рассеянных назад, зависит от атомного номера • Атомы с большими номерами рассеивают более эффективно, изображение получается ярче • Результирующее изображение имеет контраст по материалу
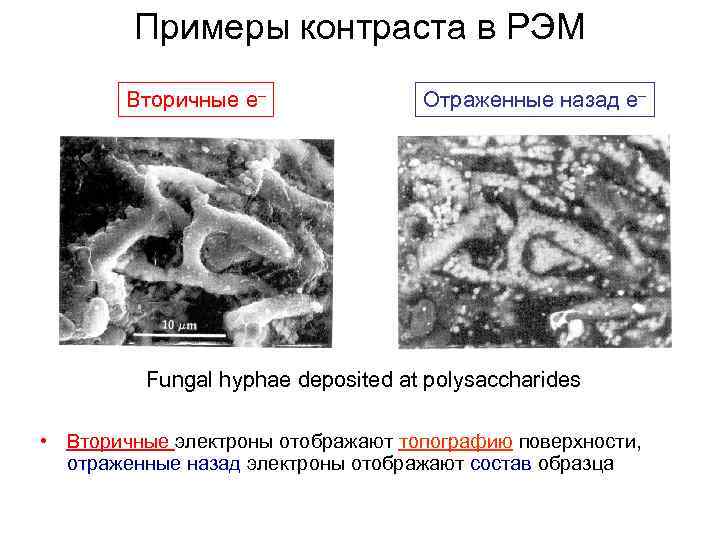
Примеры контраста в РЭМ Вторичные e– Отраженные назад e– Fungal hyphae deposited at polysaccharides • Вторичные электроны отображают топографию поверхности, отраженные назад электроны отображают состав образца
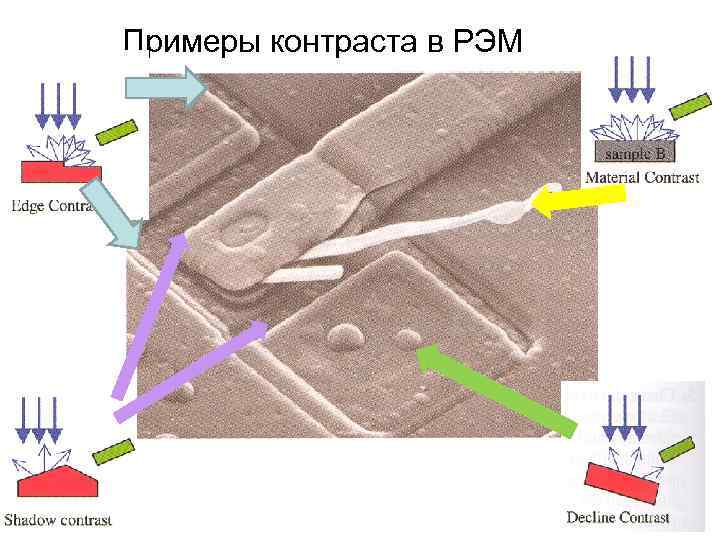
Примеры контраста в РЭМ

ПЭМ Электронная пушка Диафрагма Конденсорная линза Образец Конденсорная линза Диафрагма Ход лучей в моде изображения Промежуточная диафрагма Промежуточная линза Диафрагма Фокусирующая линза Экран Ход лучей в дифракционной моде

Подготовка образцов Изображение в плоскости пленки Исследуемый материал Подложка травление Cross-sectional изображение Толщина пленки до 100 нм Для ПЭМ высокого разрешения – 10 нм
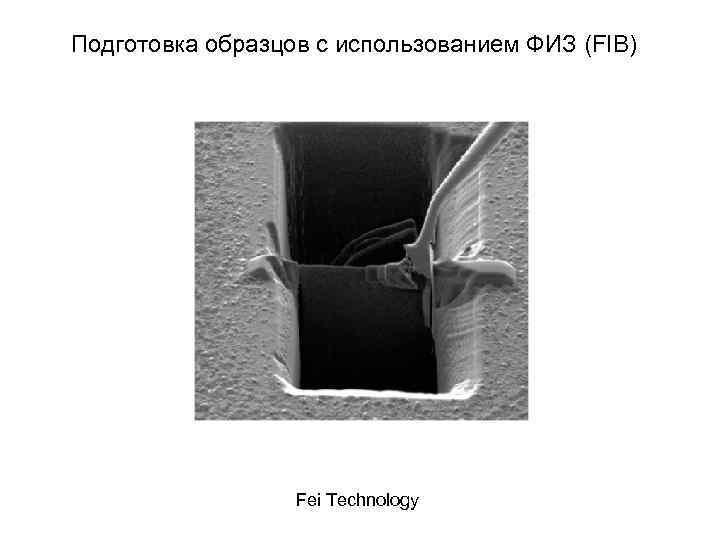
Подготовка образцов с использованием ФИЗ (FIB) Fei Technology

ПЭМ: пример 1
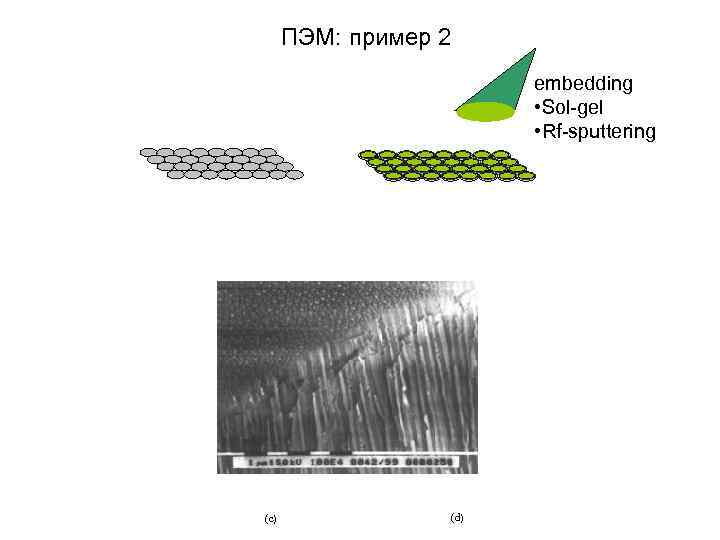
ПЭМ: пример 2 embedding • Sol-gel • Rf-sputtering (c) (d)

HREM image of Py particles TEM cross sectional image of membrane. Dark field image of pyrochlore and perovskite particle E. D. Mishina, et al, Ferroelectrics, 2006, vol. 336, p. 247 -254
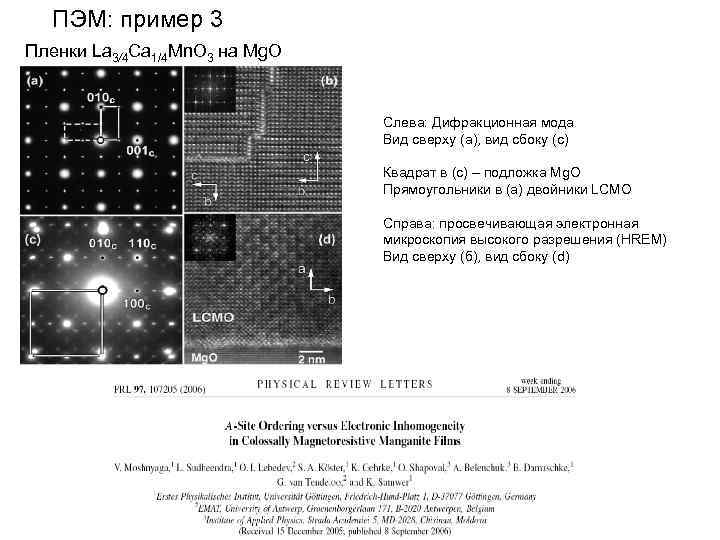
ПЭМ: пример 3 Пленки La 3/4 Ca 1/4 Mn. O 3 на Mg. O Слева: Дифракционная мода Вид сверху (а), вид сбоку (с) Квадрат в (с) – подложка Mg. O Прямоугольники в (а) двойники LCMO Справа: просвечивающая электронная микроскопия высокого разрешения (HREM) Вид сверху (б), вид сбоку (d)
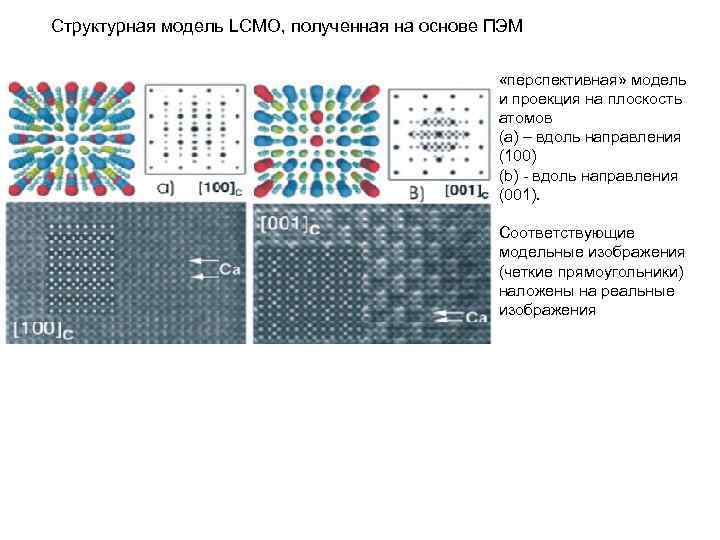
Структурная модель LCMO, полученная на основе ПЭМ «перспективная» модель и проекция на плоскость атомов (а) – вдоль направления (100) (b) - вдоль направления (001). Соответствующие модельные изображения (четкие прямоугольники) наложены на реальные изображения

Интерпретация: роль фокусировки (HRTEM) Si(110) Первые два ряда H-терминированной поверхности FEI technology, homepage

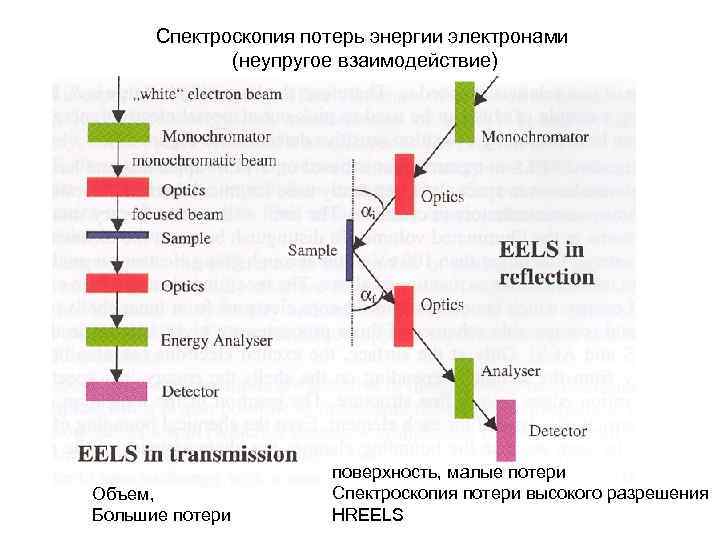
Спектроскопия потерь энергии электронами (неупругое взаимодействие) Объем, Большие потери поверхность, малые потери Спектроскопия потери высокого разрешения HREELS

Электроны взаимодействуют с поверхностью и теряют энергию, величина которой определяется энергий возбуждаемыхчастиц 10 -100 м. Эв фононы (решетка) 1 -50 э. В плазмоны – электронная плотность в исследуемом объекте – одноэлектронные возбуждения между зонами валентной и проводимости – плотность электронных состояний > 100 э. В внутренние электроны атома – в зону проводимости, тонкая структура – характеристика элемента Требования к электронному пучку – монохроматичность W DW – Определяет разрешение


250 мэ. В HREELS Ni (111) Pt (111) (4 x 2) CO
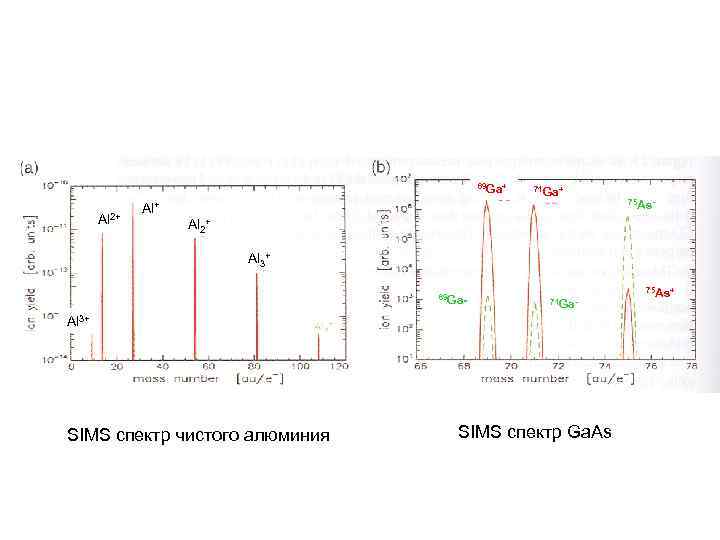
69 Ga+ Al 2+ 71 Ga+ Al+ 75 As- Al 2+ Al 3+ 69 Ga- 71 Ga- Al 3+ SIMS спектр чистого алюминия SIMS спектр Ga. As 75 As+
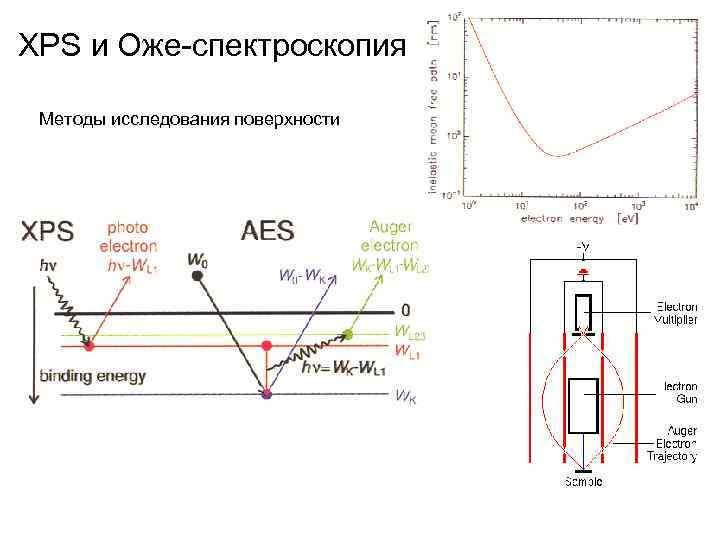
XPS и Оже-спектроскопия Методы исследования поверхности

Оже спектры легких элементов. Основные пики соответствуют KL 23 переходам


Идеальный XPS спектр
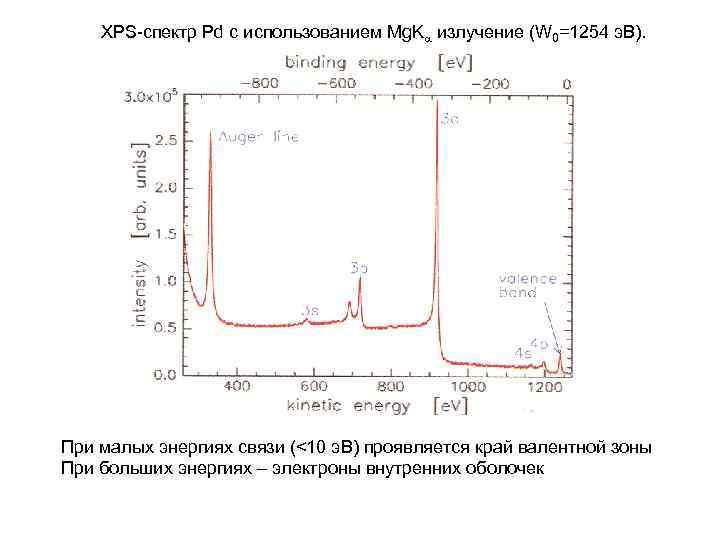
XPS-спектр Pd с использованием Mg. K излучение (W 0=1254 э. В). При малых энергиях связи (<10 э. В) проявляется край валентной зоны При больших энергиях – электроны внутренних оболочек
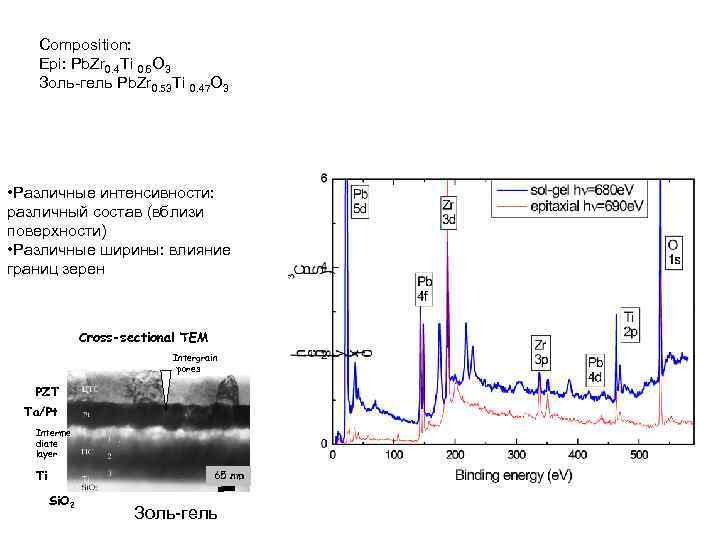
Composition: Epi: Pb. Zr 0. 4 Ti 0. 6 O 3 Золь-гель Pb. Zr 0. 53 Ti 0. 47 O 3 • Различные интенсивности: различный состав (вблизи поверхности) • Различные ширины: влияние границ зерен Cross-sectional TEM Intergrain pores PZT Ta/Pt Interme diate layer Ti 65 nm Si. O 2 Золь-гель

1. Методы изображения • Электронная микроскопия • Зондовая микроскопия • Оптическая микроскопия 2. Методы структурного анализа • Дифракция рентгеновских лучей • Дифракция электронов 3. Спектроскопия • Инфракрасная спектроскопия • Рамановская спектроскопия • Флуоресцетная и люминесцентная • Фотоэмиссионная (ФЭС, Оже, …) • Магнитная (ЭПР, ЯМР) 4. Масс спектрометрия

LEED: принципиальная схема Grid 1: retarding voltage (selects only elastic electrons) Флуоресцирующий экран Sample Grid 2: accelerating voltage (creates fluorescence on screen)

RHEED: Принципиальная схема k-Space Real Space • RHEED has higher energy (ke. V) and lower angle (2°) vs. LEED. • Real-time data acquisition possible, but diffraction pattern is distorted.

К-пространство: Сфера Эвальда для LEED Дифрагированный e-пучок LEED spots Линии обратной решетки Сфера Эвальда Падающий e-пучок Направление дифракционных максимумов определяется точками пересечения сферы Эвальда радиусом ki с линиями обратной решетки образец
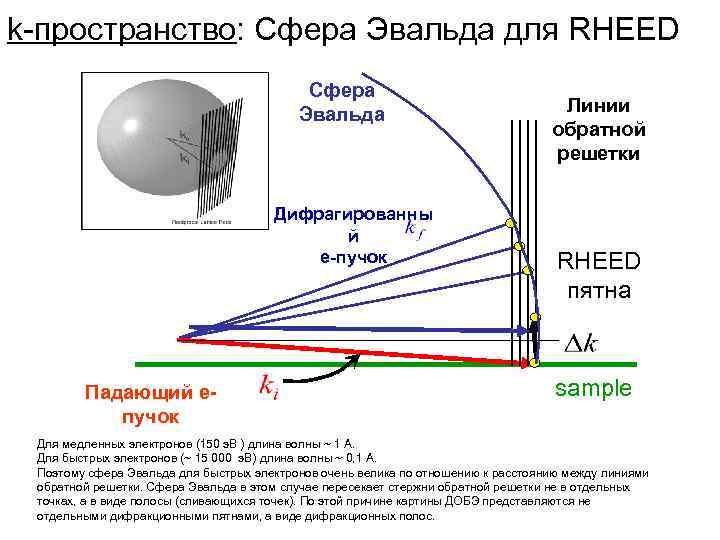
k-пространство: Сфера Эвальда для RHEED Сфера Эвальда Дифрагированны й e-пучок Падающий eпучок Линии обратной решетки RHEED пятна sample Для медленных электронов (150 э. В ) длина волны ~ 1 А. Для быстрых электронов (~ 15 000 э. В) длина волны ~ 0, 1 А. Поэтому сфера Эвальда для быстрых электронов очень велика по отношению к расстоянию между линиями обратной решетки. Сфера Эвальда в этом случае пересекает стержни обратной решетки не в отдельных точках, а в виде полосы (сливающихся точек). По этой причине картины ДОБЭ представляются не отдельными дифракционными пятнами, а виде дифракционных полос.

Методы электронной дифракции • LEED = Low Energy Electron Diffraction ДМЭ (Дифракця медленных электронов) – Падающий электронный пучок (< 100 e. V) перпендикулярен поверхности образца. (В ДМЭ энергия сравнима по абсолютной величине с энергией внешних оболочек атомов, длина свободного пробега 0. 5 -1 нм) – Невозмущенная обратная элементарная ячейка, но невозможность получать real-time данные. • RHEED = Reflection High Energy Electron Diffraction ДОБЭ (Дифракция быстрых электронов на отражение) – Падающий электронный пучок(~ke. V) падает под скользящим углом к поверхности – Получение real-time данных, однако ячейка возмущена LEED RHEED Si 7 x 7
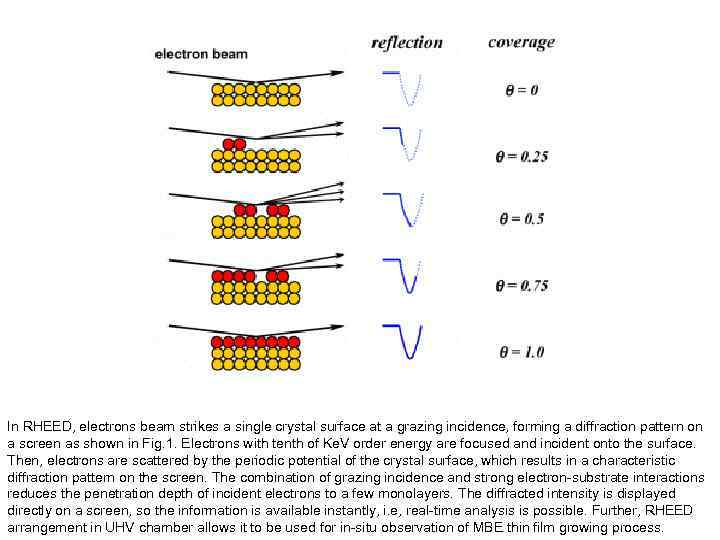
In RHEED, electrons beam strikes a single crystal surface at a grazing incidence, forming a diffraction pattern on a screen as shown in Fig. 1. Electrons with tenth of Ke. V order energy are focused and incident onto the surface. Then, electrons are scattered by the periodic potential of the crystal surface, which results in a characteristic diffraction pattern on the screen. The combination of grazing incidence and strong electron-substrate interactions reduces the penetration depth of incident electrons to a few monolayers. The diffracted intensity is displayed directly on a screen, so the information is available instantly, i. e, real-time analysis is possible. Further, RHEED arrangement in UHV chamber allows it to be used for in-situ observation of MBE thin film growing process.

Реконструкция поверхности – образование на чистой поверхности монокристалла структуры, элементарная ячейка которой имеет период, отличающийся от периода в объеме кристалла. В общем случае реконструированная ячейка имеет размер (n x m) ( - угол между поверхностными векторами трансляций, n и m – коэффициенты пропорциональности между объемными и поверхностными векторами трансляций) Реконструкция поверхности возникает вследствие наличия на сколе кристалла ненасыщенных (оборванных) ковалентных связей, которые замыкаются при перемещении атомов на поверхности.

Реконструкция поверхности: кубическая решетка Объемная элементарная ячейка 1 x 1, c(2 x 2), 2 x 2 реконструкция
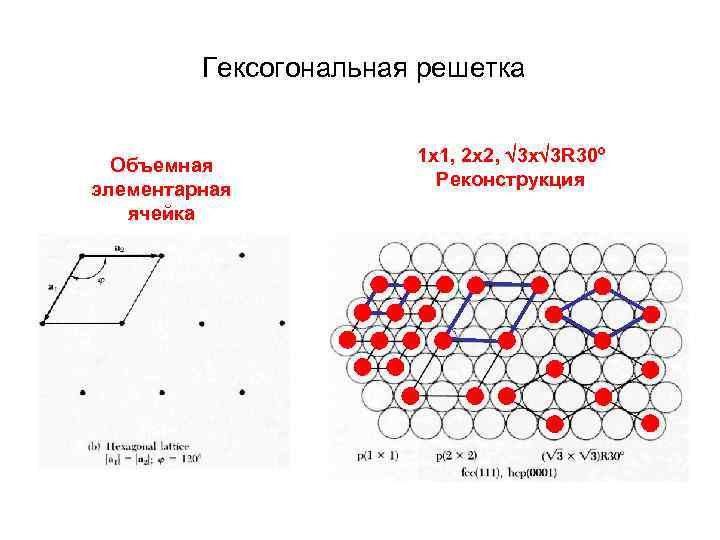
Гексогональная решетка Объемная элементарная ячейка 1 x 1, 2 x 2, 3 x 3 R 30º Реконструкция
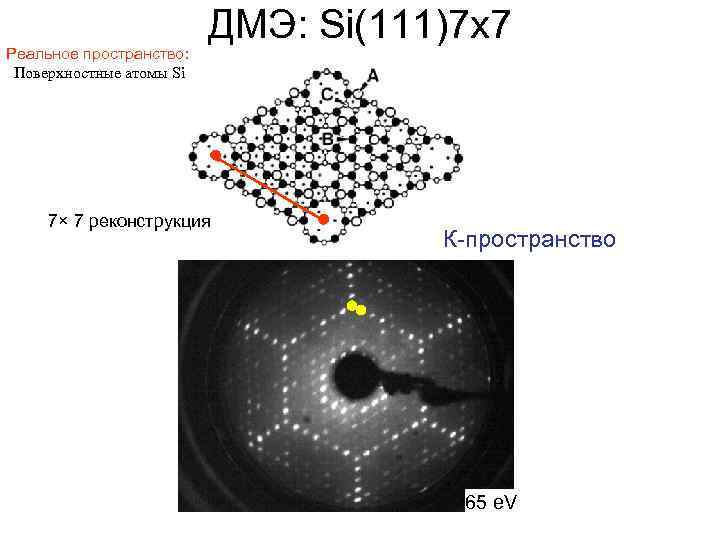
Реальное пространство: Поверхностные атомы Si ДМЭ: Si(111)7 x 7 7× 7 реконструкция К-пространство 65 e. V

ДМЭ: расчет поверхностной структуры Sample Electron Gun f Spacing D R x LEED spot

RHEED: Si(111)-7 x 7 E-beam Real Space: Smaller period e-beam k-Space: Larger period e-beam Real Space: Larger period e-beam k-Space: Smaller period e-beam

Примеры контрольных вопросов к лекции 4 • Каков предел разрешения электронного микроскопа при ускоряющем напряжении 20 к. В • Нарисуйте схему переходов электрона при рентгеновской эмиссии; при Оже процессе • Как осуществляется подготовка образцов для просвечивающей электронной микроскопии для вида сверху? Для вида сбоку (crossection)?
Lecture4_2012_электронная микроскопия.ppt