Методи зондування поверхні іонними пучками Підготував Студент 514


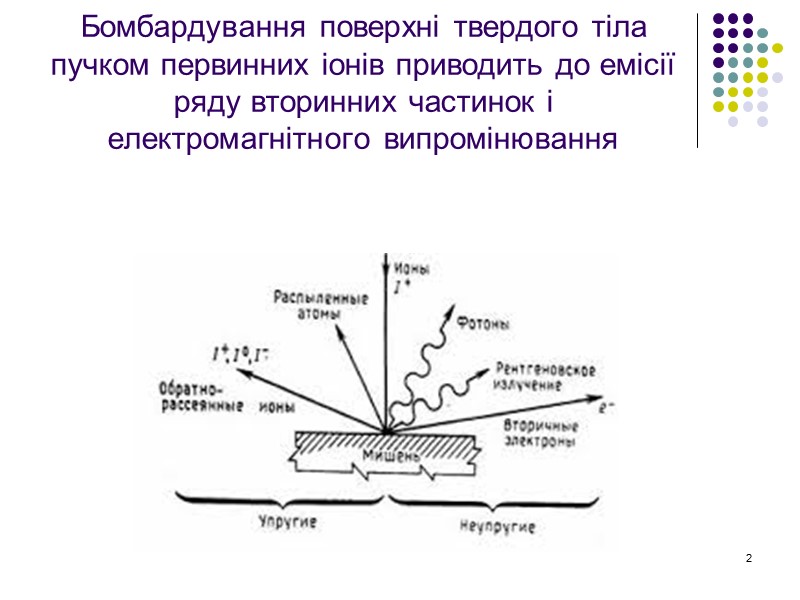
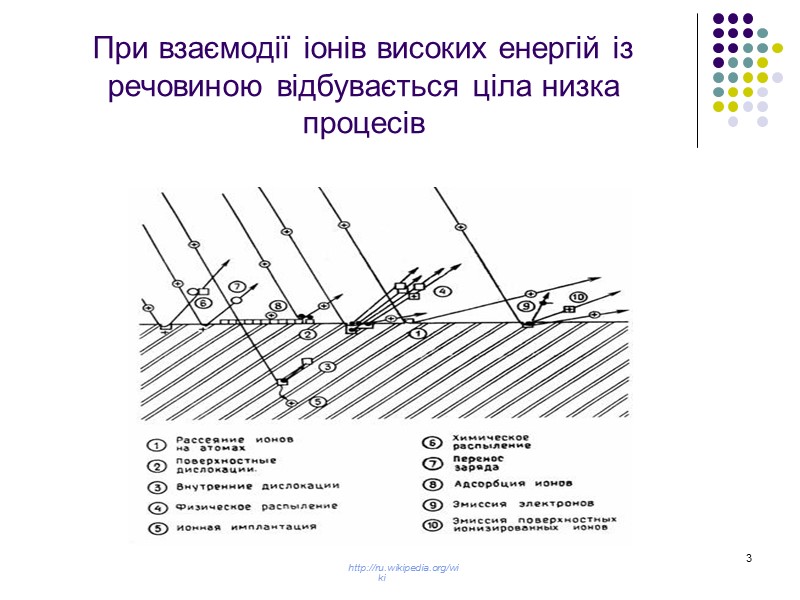

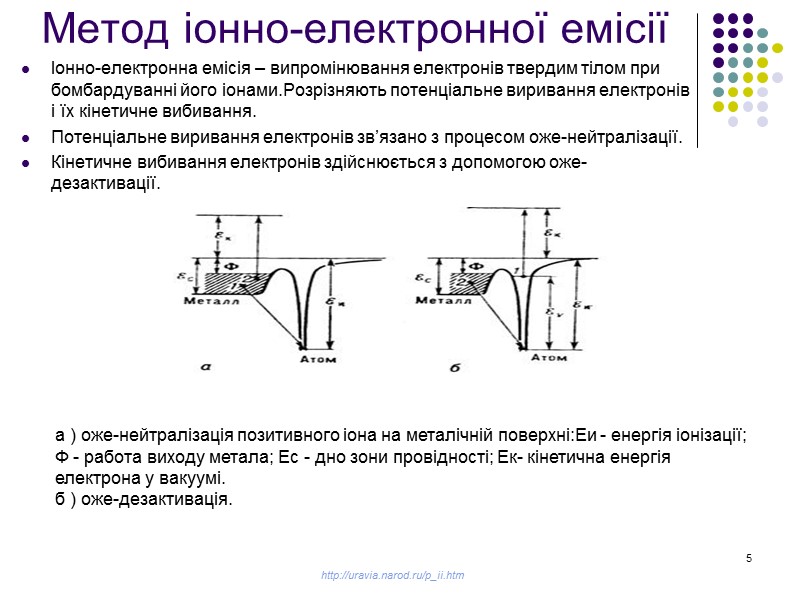


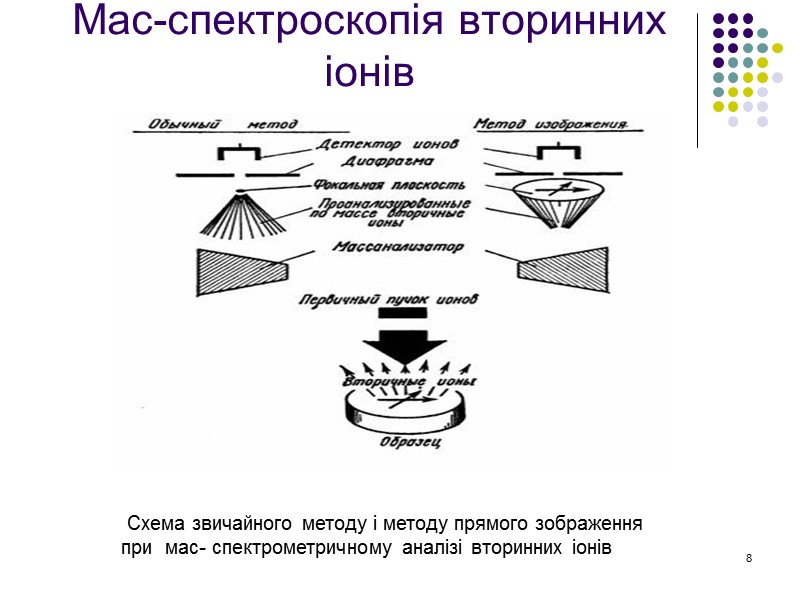


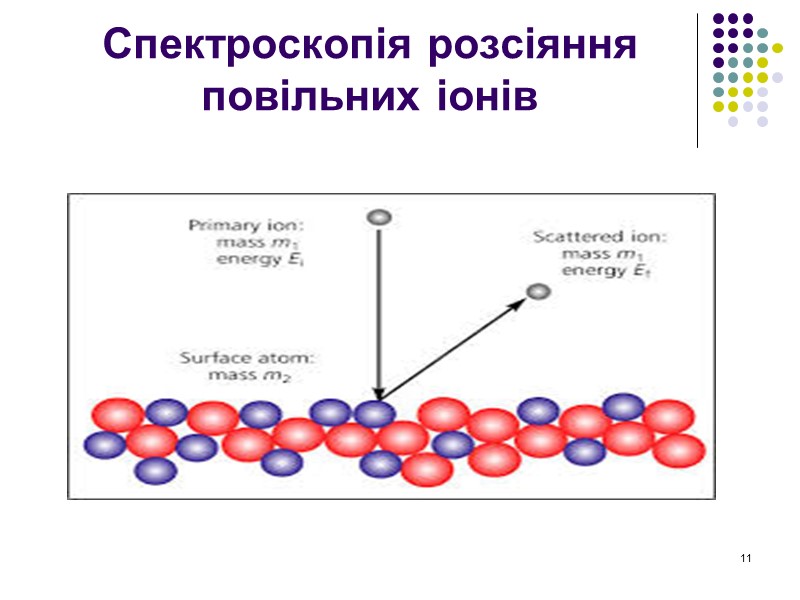

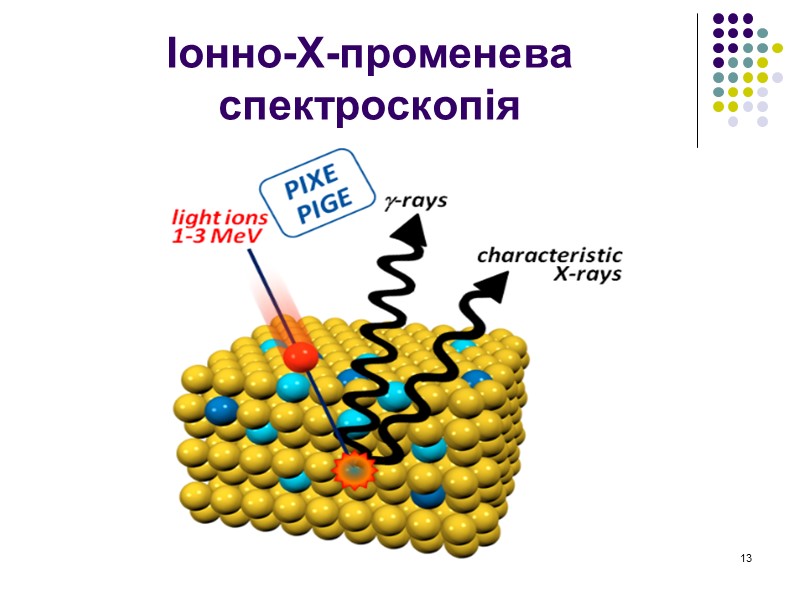

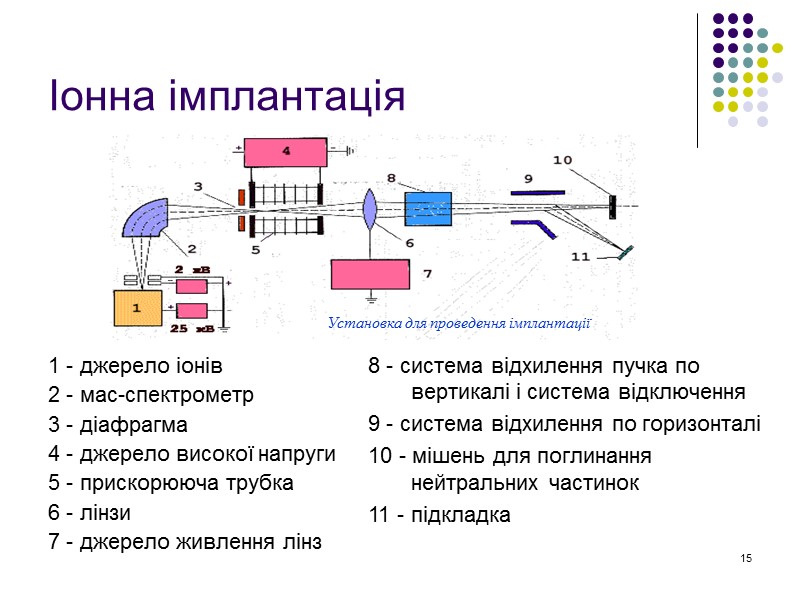
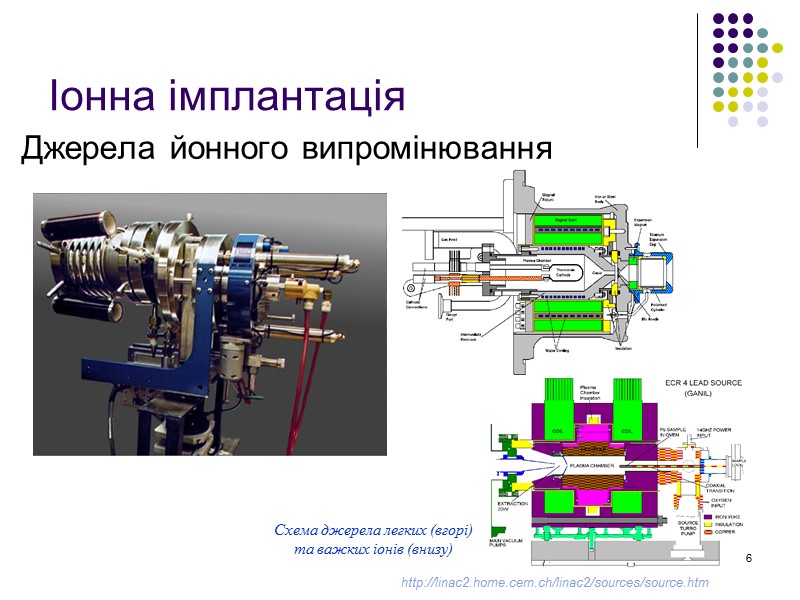
26796-roman.ppt
- Количество слайдов: 16
 Методи зондування поверхні іонними пучками Підготував Студент 514 М групи Роман Юрій Презентація з курсу “Фізика поверхневих явищ” на тему: Чернівецький Національний Університет ім. Ю.Федьковича Інститут фізико –технічних і комп’ютерних наук Кафедра фізики твердого тіла Чернівці 2013
Методи зондування поверхні іонними пучками Підготував Студент 514 М групи Роман Юрій Презентація з курсу “Фізика поверхневих явищ” на тему: Чернівецький Національний Університет ім. Ю.Федьковича Інститут фізико –технічних і комп’ютерних наук Кафедра фізики твердого тіла Чернівці 2013
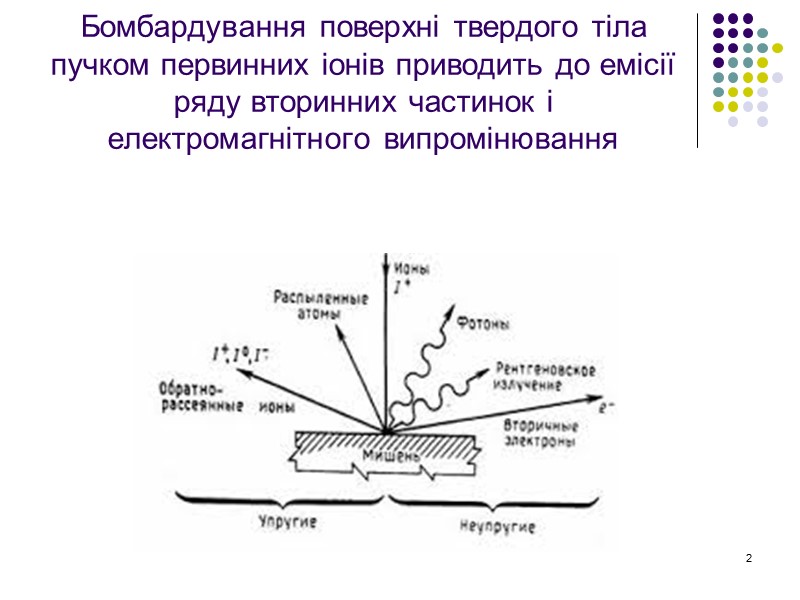 2 Бомбардування поверхні твердого тіла пучком первинних іонів приводить до емісії ряду вторинних частинок і електромагнітного випромінювання
2 Бомбардування поверхні твердого тіла пучком первинних іонів приводить до емісії ряду вторинних частинок і електромагнітного випромінювання
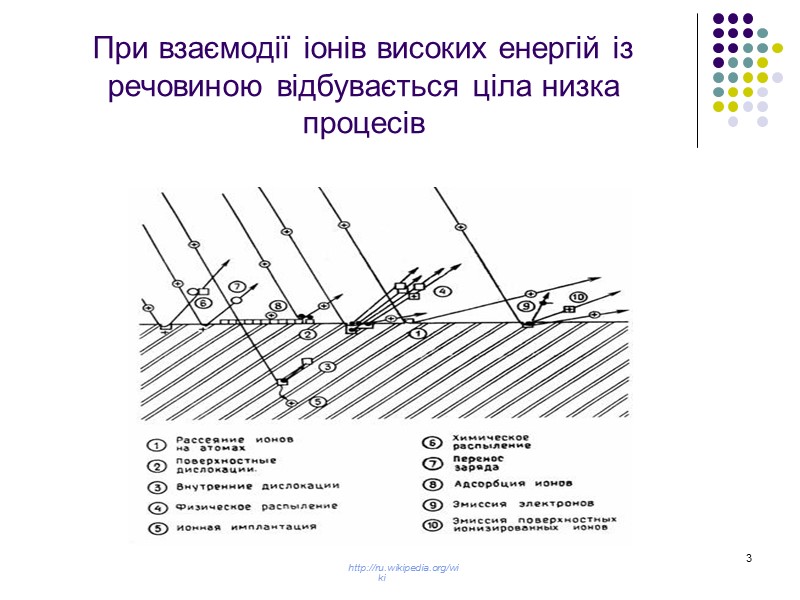 3 При взаємодії іонів високих енергій із речовиною відбувається ціла низка процесів http://ru.wikipedia.org/wiki
3 При взаємодії іонів високих енергій із речовиною відбувається ціла низка процесів http://ru.wikipedia.org/wiki
 4 Методи зондування поверхні іонними пучками 1.Іонно-електронна емісія. 2.Мас-спектроскопія вторинних іонів. 3.Спектроскопія розсіяння повільних іонів. 4.Іонно –Х-променева спектроскопія.
4 Методи зондування поверхні іонними пучками 1.Іонно-електронна емісія. 2.Мас-спектроскопія вторинних іонів. 3.Спектроскопія розсіяння повільних іонів. 4.Іонно –Х-променева спектроскопія.
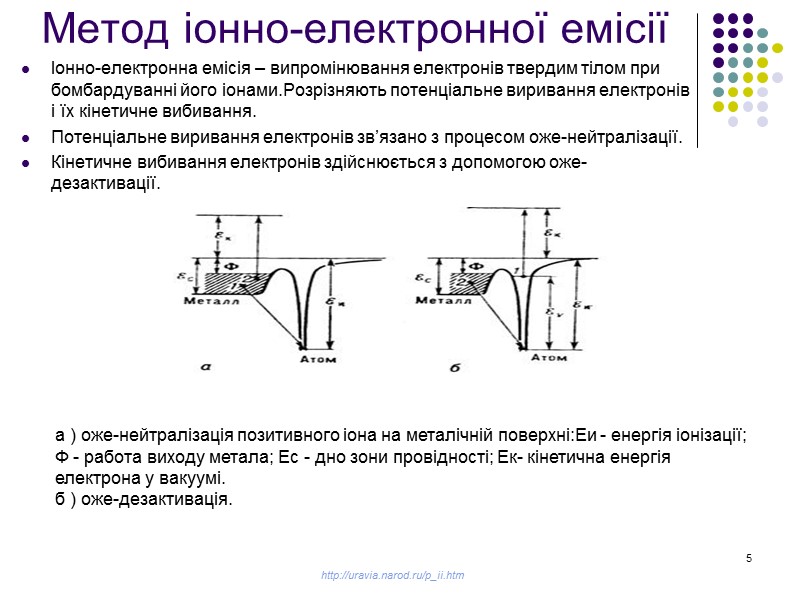 5 Метод іонно-електронної емісії http://uravia.narod.ru/p_ii.htm Іонно-електронна емісія – випромінювання електронів твердим тілом при бомбардуванні його іонами.Розрізняють потенціальне виривання електронів і їх кінетичне вибивання. Потенціальне виривання електронів зв’язано з процесом оже-нейтралізації. Кінетичне вибивання електронів здійснюється з допомогою оже- дезактивації. а ) оже-нейтралізація позитивного іона на металічній поверхні:Eи - енергія іонізації; Ф - работа виходу метала; Eс - дно зони провідності; Eк- кінетична енергія електрона у вакуумі. б ) оже-дезактивація.
5 Метод іонно-електронної емісії http://uravia.narod.ru/p_ii.htm Іонно-електронна емісія – випромінювання електронів твердим тілом при бомбардуванні його іонами.Розрізняють потенціальне виривання електронів і їх кінетичне вибивання. Потенціальне виривання електронів зв’язано з процесом оже-нейтралізації. Кінетичне вибивання електронів здійснюється з допомогою оже- дезактивації. а ) оже-нейтралізація позитивного іона на металічній поверхні:Eи - енергія іонізації; Ф - работа виходу метала; Eс - дно зони провідності; Eк- кінетична енергія електрона у вакуумі. б ) оже-дезактивація.
 6 Енергетичний спектр електронів при потенціальному вириванні їх іонами Не+ з энергиєю 5 еВ. Залежність коефіцєнта потенціального виривання електронів gп із Мо від енергії E іонів інертних газів. Параметри поверхневого шару визначаються з аналізу кутового і енергетичного розподілу вторинних електронів
6 Енергетичний спектр електронів при потенціальному вириванні їх іонами Не+ з энергиєю 5 еВ. Залежність коефіцєнта потенціального виривання електронів gп із Мо від енергії E іонів інертних газів. Параметри поверхневого шару визначаються з аналізу кутового і енергетичного розподілу вторинних електронів
 7 Мас-спектроскопія вторинних іонів У даному методі матеріал аналізується з допомогою мас-спектрометра . Первинні іони взаємодіють із поверхнею й вибивають вторинні іони, які й аналізуються. Енергії первинних іонів лежать в інтервалі 1-20 кеВ.Для аналізу площа поверхні , з якої відбиваються розпилені атоми або молекули,змінюється від 1 мкм у діаметрі при густині струму 0,01 А/ См2 , до 0,1 См2 , при густині струму іонів 10-9 А/ См2 .
7 Мас-спектроскопія вторинних іонів У даному методі матеріал аналізується з допомогою мас-спектрометра . Первинні іони взаємодіють із поверхнею й вибивають вторинні іони, які й аналізуються. Енергії первинних іонів лежать в інтервалі 1-20 кеВ.Для аналізу площа поверхні , з якої відбиваються розпилені атоми або молекули,змінюється від 1 мкм у діаметрі при густині струму 0,01 А/ См2 , до 0,1 См2 , при густині струму іонів 10-9 А/ См2 .
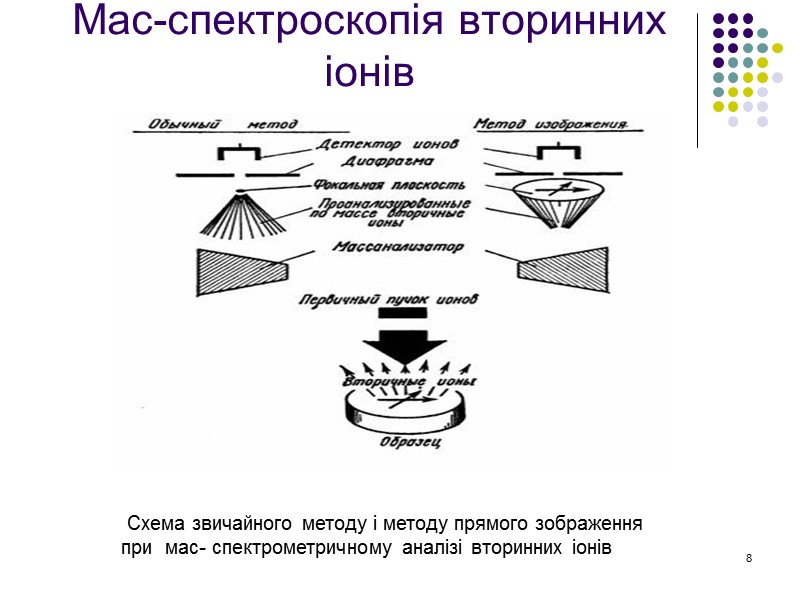 Мас-спектроскопія вторинних іонів 8 Схема звичайного методу і методу прямого зображення при мас- спектрометричному аналізі вторинних іонів
Мас-спектроскопія вторинних іонів 8 Схема звичайного методу і методу прямого зображення при мас- спектрометричному аналізі вторинних іонів
 Мас-спектроскопія вторинних іонів 9 Схема масс-спектрального іонного мікроскопа
Мас-спектроскопія вторинних іонів 9 Схема масс-спектрального іонного мікроскопа
 Мас-спектроскопія вторинних іонів 10 Вплив аналізованої площі на граничну розрізнювальну здатність
Мас-спектроскопія вторинних іонів 10 Вплив аналізованої площі на граничну розрізнювальну здатність
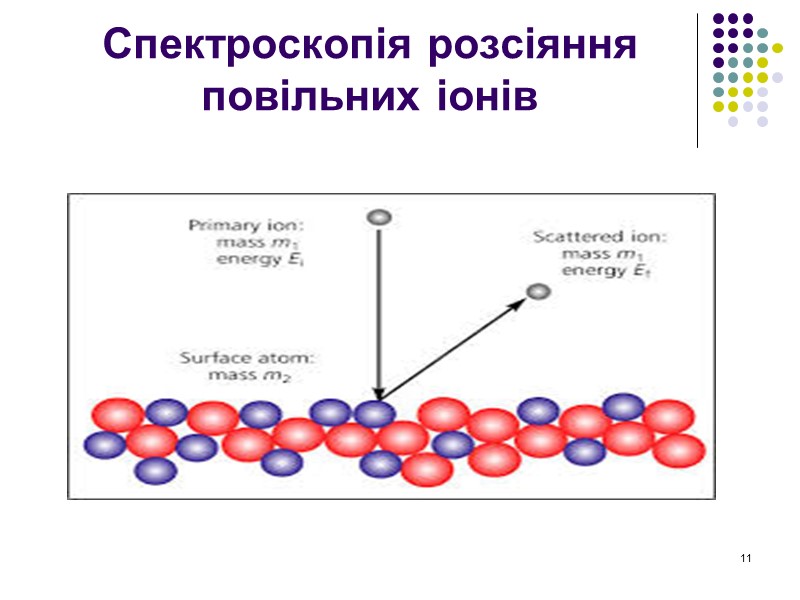 Спектроскопія розсіяння повільних іонів 11
Спектроскопія розсіяння повільних іонів 11
 Спектроскопія розсіяння повільних іонів В основі СРПІ лежить явище розсіяння пучка повільних первинних іонів з енергіями 0,1- 10 кеВ при взаємодії його з поверхнею твердого тіла . Вимірюючи енергорозподіл розсіяних іонів, можна отримати їх енергетичний спектр, зумовлений однократним або послідовними пружними зіткненнями первинних іонів з окремими атомами поверхневого шару. Енергія розсіяного іона при однократному парному зіткненні визначається із співвідношення 12 За допомогою цього методу можна визначити поелементний склад поверхневого шару
Спектроскопія розсіяння повільних іонів В основі СРПІ лежить явище розсіяння пучка повільних первинних іонів з енергіями 0,1- 10 кеВ при взаємодії його з поверхнею твердого тіла . Вимірюючи енергорозподіл розсіяних іонів, можна отримати їх енергетичний спектр, зумовлений однократним або послідовними пружними зіткненнями первинних іонів з окремими атомами поверхневого шару. Енергія розсіяного іона при однократному парному зіткненні визначається із співвідношення 12 За допомогою цього методу можна визначити поелементний склад поверхневого шару
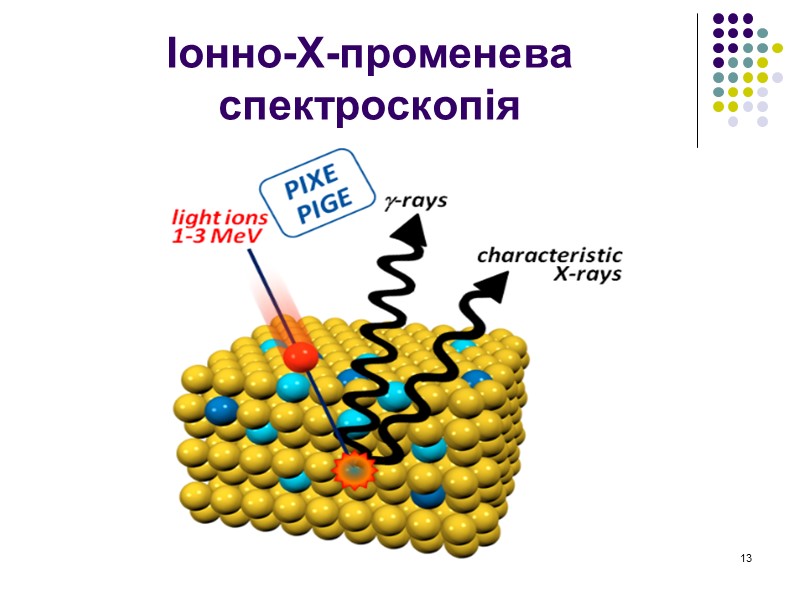 Іонно-Х-променева спектроскопія 13
Іонно-Х-променева спектроскопія 13
 Іонно-Х-променева спектроскопія Іхс заснована на збудженні характеристичного Х-випромінювання при бомбардуванні твердих тіл пучком іонів з енергіями від десятків кеВ до десятків МеВ. Отримані спектри характеристичного випромінювання використовуються для хімічного аналізу поверхневого шару. 14
Іонно-Х-променева спектроскопія Іхс заснована на збудженні характеристичного Х-випромінювання при бомбардуванні твердих тіл пучком іонів з енергіями від десятків кеВ до десятків МеВ. Отримані спектри характеристичного випромінювання використовуються для хімічного аналізу поверхневого шару. 14
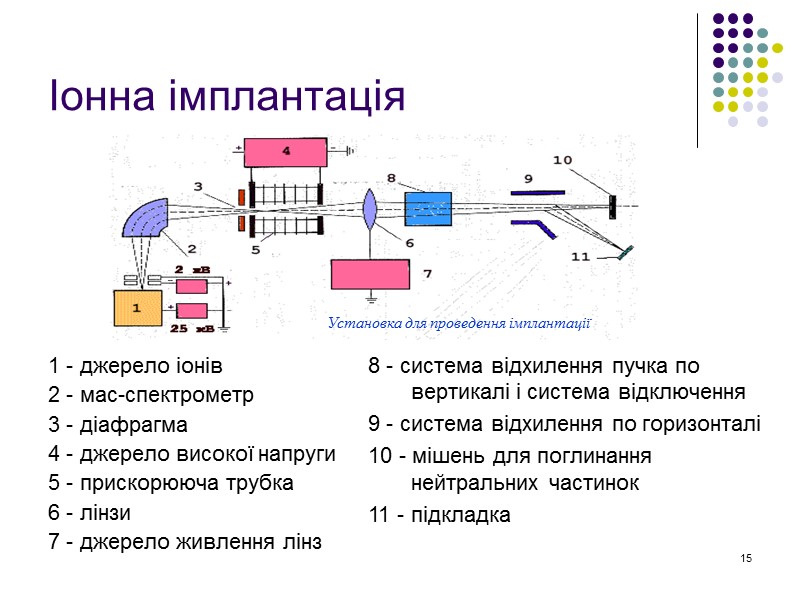 15 Іонна імплантація 1 - джерело іонів 2 - мас-спектрометр 3 - діафрагма 4 - джерело високої напруги 5 - прискорююча трубка 6 - лінзи 7 - джерело живлення лінз 8 - система відхилення пучка по вертикалі і система відключення 9 - система відхилення по горизонталі 10 - мішень для поглинання нейтральних частинок 11 - підкладка
15 Іонна імплантація 1 - джерело іонів 2 - мас-спектрометр 3 - діафрагма 4 - джерело високої напруги 5 - прискорююча трубка 6 - лінзи 7 - джерело живлення лінз 8 - система відхилення пучка по вертикалі і система відключення 9 - система відхилення по горизонталі 10 - мішень для поглинання нейтральних частинок 11 - підкладка
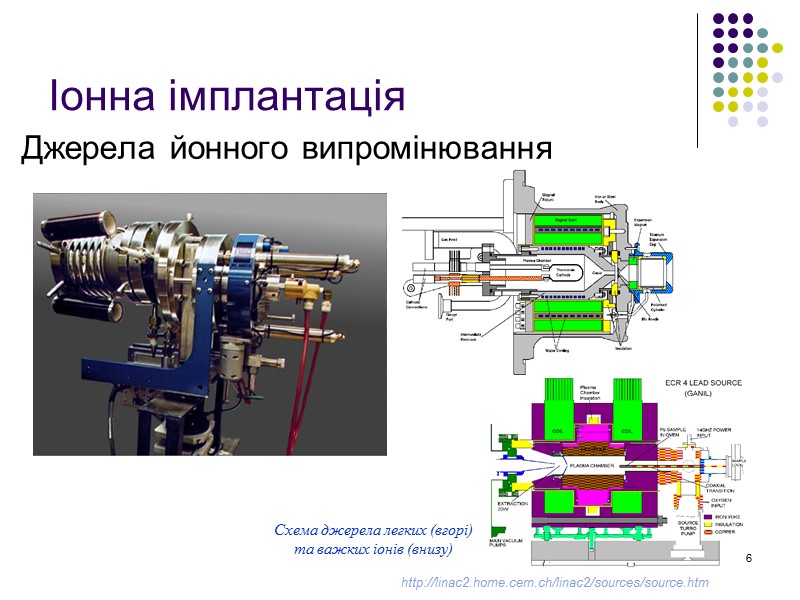 16 Іонна імплантація Джерела йонного випромінювання http://linac2.home.cern.ch/linac2/sources/source.htm Схема джерела легких (вгорі) та важких іонів (внизу)
16 Іонна імплантація Джерела йонного випромінювання http://linac2.home.cern.ch/linac2/sources/source.htm Схема джерела легких (вгорі) та важких іонів (внизу)

