ЛИТОГРАФИЯ ПРОЦЕСС СОЗДАНИЯ ЗАЩИТНОЙ МАСКИ, НЕОБХОДИМОЙ


ЛИТОГРАФИЯ ПРОЦЕСС СОЗДАНИЯ ЗАЩИТНОЙ МАСКИ, НЕОБХОДИМОЙ ДЛЯ ЛОКАЛЬНОЙ ОБРАБОТКИ ПЛАСТИНЫ ПРИ ФОРМИРОВАНИИ СТРУКТУРЫ ИМС ПО ПЛАНАРНОЙ ТЕХНОЛОГИИ

ВИДЫ ЛИТОГРАФИИ ► ФОТОЛИТОГРАФИЯ 300 -400 НМ ► ЭЛЕКТРОНОЛИТОГРАФИЯ 0, 1 НМ ► РЕНТГЕНОЛИТОГРАФИЯ 0, 1 -1 НМ ► ИОННО-ЛУЧЕВАЯ 0, 05 - 0, 1 НМ

СХЕМА ПРОЦЕССА ФОТОЛИТОГРАФИИ

ФОТОРЕЗИСТЫ - ПОЛИМЕРНЫЕ ВЕЩЕСТВА, ЧУВСТВИТЕЛЬНЫЕ К УФО ► ПОЗИТИВНЫЕ ► НЕГАТИВНЫЕ

ПОЗИТИВНЫЕ (НАФТОХИНОНДИАЗИН)

НЕГАТИВНЫЕ (ПОЛИВИНИЛАЦИННАМАТ)

ФОТОРЕЗИСТЫ основные параметры ► ЧУВСТВИТЕЛЬНОСТЬ S=1/H=1/(E*t) E– освещенность, t – время экспозиции ► КИСЛОТОСТОЙКОСТЬ K=h/x ► РАЗРЕШАЮЩАЯ СПОСОБНОСТЬ R=100/(2*l)

ФОТОШАБЛОНЫ ► ПЛОСКОПАРАЛЛЕЛЬНЫЕ ПЛАСТИНЫ ИЗ ПРОЗРАЧНОГО К УФО МАТЕРИАЛА С НАНЕСЕННЫМ РИСУНКОМ СЛОЯ СХЕМЫ. ► ЭММУЛЬСИОННЫЕ ► МЕТАЛЛИЗИРОВАННЫЕ ► ЦВЕТНЫЕ

ТЕХНОЛОГИЯ ФОТОЛИТОГРАФИЧЕСКОГО ПРОЦЕССА ► ОЧИСТКА ПОВЕРХНОСТИ ► НАНЕСЕНИЕ ФОТОРЕЗИСТА ► СУШКА ФОТОРЕЗИСТА (2 ЭТАПА 15 МИН. ПРИ 25 ГРАДУСОВ, 30 -60 МИН. ПРИ 100 ГРАДУСАХ ЦЕЛЬСИЯ) ► СОВМЕЩЕНИЕ ФОТОШАБЛОНА С ПОДЛОЖКОЙ ► ЭКСПОНИРОВАНИЕ ► ПРОЯВЛЕНИЕ (ПОЗИТИВНЫЕ – Na. OH, НЕГАТИВНЕ – ХЛОРБЕНЗОЛ, ТОЛУОЛ И ДР. ) ► ЗАДУБЛИВАНИЕ (20 МИН. ПРИ 120 гр. Ц) ► ТРАВЛЕНИЕ ОКСИДА КРЕМНИЯ (ПЛАВИКОВАЯ КИСЛОТА HF + KF+Na. F) ► УДАЛЕНИЕ ФОТОРЕЗИСТА (КИПЯЧЕНИЕ В СЕРНОЙ КИСЛОТЕ ИЛИ ТРИХЛОРЭТАН, ОБРАБОТКА ХОЛОДНЫМ KOH – ДЛЯ ПОЗИТИВНЫХ)

ПРОБЛЕМЫ ФОТОЛИТОГРАФИИ ► СЛОЖНОСТЬ РАЗРАБОТКИ ВЫСОКОРАЗРЕШАЮЩИХ ОБЪЕКТИВОВ НА БОЛЬШИЕ ПОЛЯ ИЗОБРАЖЕНИЯ. ► ПРЕДЕЛ РАЗРЕШАЮЩЕЙ СПОСОБНОСТИ ОКОЛО 0, 5 МКМ

ЭЛЕКТРОНОЛИТОГРАФИЯ ► ПРОЕКЦИОННАЯ

► СКАНИРУЮЩАЯ РАСТРОВАЯ ВЕКТОРНАЯ

►В качестве резиста обычно используют позитивные резисты, полученные на основе полиметилметакрилата (ПММА). Для позитивных резистов экспонирование электронным пучком вызывает уменьшение его молекулярного веса при разрыве связей между молекулами, увеличивая их растворимость. Разрешающая способность менее 0. 1 мкм.

Проблемы ЭЛЕКТРОНОЛИТОГРАФИИ ► РАССЕЯНИЕ ЭЛЕКТРОНОВ И ИСКАЖЕНИЕ РИСУНКА
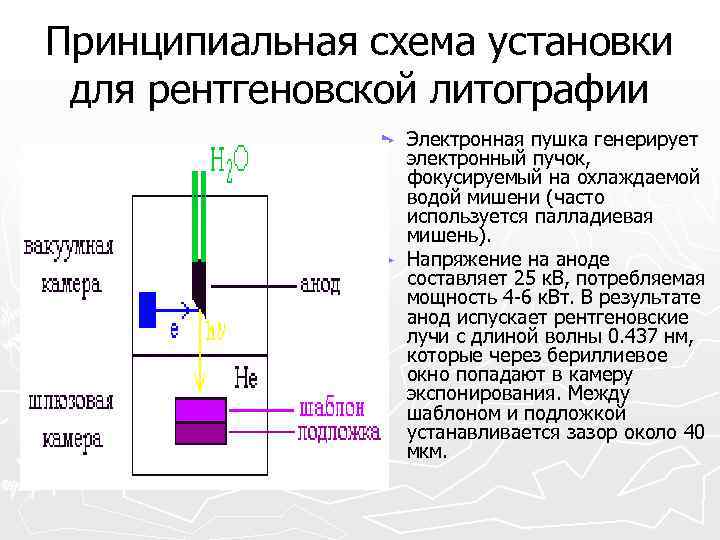
Принципиальная схема установки для рентгеновской литографии ► Электронная пушка генерирует электронный пучок, фокусируемый на охлаждаемой водой мишени (часто используется палладиевая мишень). ► Напряжение на аноде составляет 25 к. В, потребляемая мощность 4 -6 к. Вт. В результате анод испускает рентгеновские лучи с длиной волны 0. 437 нм, которые через бериллиевое окно попадают в камеру экспонирования. Между шаблоном и подложкой устанавливается зазор около 40 мкм. ►
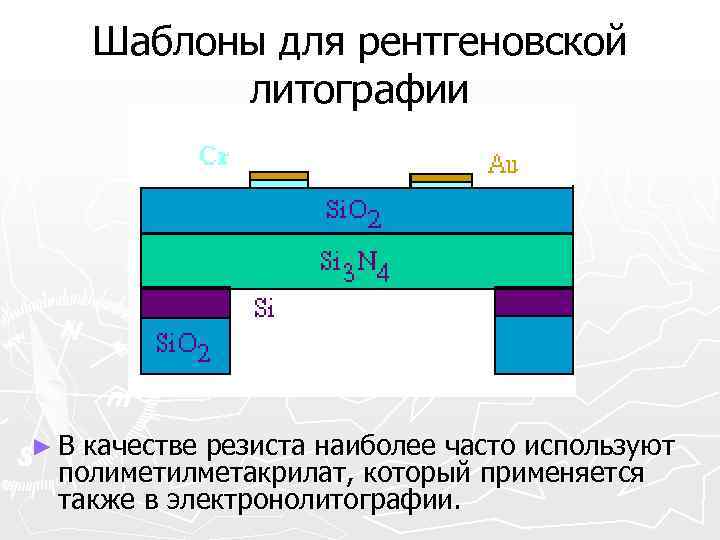
Шаблоны для рентгеновской литографии ►В качестве резиста наиболее часто используют полиметилметакрилат, который применяется также в электронолитографии.
4 ЛИТОГРАФИЯ 1.ppt
- Количество слайдов: 16

