Lektsia_8_2010.ppt
- Количество слайдов: 21
 Лекция 8 (09. 11. 2010) I. Рентгенография II. Современная метрология в химии нанообъектов 1. Электронная микроскопия: ПЭМ СЭМ 2. Сканирующая зондовая микроскопия СТМ АСМ СОМБП
Лекция 8 (09. 11. 2010) I. Рентгенография II. Современная метрология в химии нанообъектов 1. Электронная микроскопия: ПЭМ СЭМ 2. Сканирующая зондовая микроскопия СТМ АСМ СОМБП
 Мёссбауэровская спектроскопия Для совпадения частот -поглощения и излучения (резонанса) наряду с кристаллическим состоянием (h отд=(h 0)2/2 m. Nс2) используется эффект Доплера: изменение частоты излучения движущегося источника: допл= 0/(1 /c): частота увеличивается приближении источника и уменьшается при его удалении от наблюдателя • • • h изл+ h допл=h погл, допл= допл- 0 При допл=2 отд, наблюдается -резонанс. Если создать доплеровский сдвиг с помощью движения излучающего образца, тогда можно наблюдать эффект ЯГР: при некоторой скорости 0 движения источника (57 Fe, 129 I, 119 Sn) относительно образца, содержащего ядра этого же изотопа, наблюдается резонанс: пропускание образцом -излучения уменьшается за счет резонансного поглощения (ЯГР резонанс для ядер 57 Fe достигнут за счет эффекта Доплера (при 0 1 мм/с EД=4. 8 10 -8 э. В=3. 9 10 -4 см-1, а 1/2=5 10 -9 см-1) Если выбрать шкалу, в которой 0 =0, то можно получить ЯГР для этого ядра в другом соединении при других скоростях, которые характеризуют электрическое, магнитное и квадрупольное взаимодействие в окружении поглощающего ядра: мультиплеты свидетельствуют о расщеплении энергетических уровней в ядре в результате взаимодействия с неоднородной электронной плотностью. (по ЯГР-спектрам определяется электроотрицательность – способность ядра притягивать электронную плотность, степень окисления, распределение электронной плотности в
Мёссбауэровская спектроскопия Для совпадения частот -поглощения и излучения (резонанса) наряду с кристаллическим состоянием (h отд=(h 0)2/2 m. Nс2) используется эффект Доплера: изменение частоты излучения движущегося источника: допл= 0/(1 /c): частота увеличивается приближении источника и уменьшается при его удалении от наблюдателя • • • h изл+ h допл=h погл, допл= допл- 0 При допл=2 отд, наблюдается -резонанс. Если создать доплеровский сдвиг с помощью движения излучающего образца, тогда можно наблюдать эффект ЯГР: при некоторой скорости 0 движения источника (57 Fe, 129 I, 119 Sn) относительно образца, содержащего ядра этого же изотопа, наблюдается резонанс: пропускание образцом -излучения уменьшается за счет резонансного поглощения (ЯГР резонанс для ядер 57 Fe достигнут за счет эффекта Доплера (при 0 1 мм/с EД=4. 8 10 -8 э. В=3. 9 10 -4 см-1, а 1/2=5 10 -9 см-1) Если выбрать шкалу, в которой 0 =0, то можно получить ЯГР для этого ядра в другом соединении при других скоростях, которые характеризуют электрическое, магнитное и квадрупольное взаимодействие в окружении поглощающего ядра: мультиплеты свидетельствуют о расщеплении энергетических уровней в ядре в результате взаимодействия с неоднородной электронной плотностью. (по ЯГР-спектрам определяется электроотрицательность – способность ядра притягивать электронную плотность, степень окисления, распределение электронной плотности в
 Дифракция рентгеновских лучей • на кристаллических решетках • • • При прохождении когерентного излучения через вещество происходит его рассеяние: каждая точка пространства становится источником вторичного эл-магнитного излучения той же частоты. Усиление рассеянного (вторичного) излучения наблюдается только для тех направлений, где все рассеянные волны совпадают по фазе, т. е. возникает избирательное рассеяние, совпадающее с отражением. Возникновение интенсивного избирательного рассеяния излучения в рентгеновском диапазоне спектра при его взаимодействии с периодической структурой называется дифракцией рентгеновских лучей. В результате такого взаимодействия образуется дифракционная картина – чередование светлых и темных полос или пятен Рассеяние возникает при взаимодействии рентгеновского излучения с электронами, находящимися во внутренних слоях электрон. оболочек (не валентными). Интенсивность рассеяния ионами Сs больше, чем ионами Сl, т. к. у последнего меньше электронов.
Дифракция рентгеновских лучей • на кристаллических решетках • • • При прохождении когерентного излучения через вещество происходит его рассеяние: каждая точка пространства становится источником вторичного эл-магнитного излучения той же частоты. Усиление рассеянного (вторичного) излучения наблюдается только для тех направлений, где все рассеянные волны совпадают по фазе, т. е. возникает избирательное рассеяние, совпадающее с отражением. Возникновение интенсивного избирательного рассеяния излучения в рентгеновском диапазоне спектра при его взаимодействии с периодической структурой называется дифракцией рентгеновских лучей. В результате такого взаимодействия образуется дифракционная картина – чередование светлых и темных полос или пятен Рассеяние возникает при взаимодействии рентгеновского излучения с электронами, находящимися во внутренних слоях электрон. оболочек (не валентными). Интенсивность рассеяния ионами Сs больше, чем ионами Сl, т. к. у последнего меньше электронов.
 Уравнение Вульфа-Брэгга • 1. Рассеяние на ионах Cs: • Рассеянные верхней и нижней плоскостями волны будут интерферировать, если они имеют ту же фазу ( -угол падения и рассеяния), т. е. когерентны. Разность хода этих двух волн: =d sin +d sin =2 d sin • При =n , где - длина волны падающего излучения, n=1, 2, 3. . . интерференция этих волн дает максимум, • при n=1/2, 3/2, 5/2. . . - минимум. В остальных случаях – промежуточная интенсивность рассеяния. Уравнение Вульфа-Брэгга: n =2 d sin • При известных =1. 54 А (Cu-трубка) и измеренных углах , при которых наблюдается максимум рассеяния рефлексы, можно определять d-межатомное (Cs-Cs) расстояние: d=n /2 sin =4. 11 А. (n=1, sin =0. 1873). Условие определения d: sin =n /2 d 0, 1, при =1. 54 А и d= 4. 11 А таких углов и рефлексов может быть 5: • 10. 8 ; 22 ; 34, 19 ; 48, 52 ; 69, 47 • n 1 2 3 4 5 • При d=2. 9 А существует 3 угла для максимумов: 15. 34 , 31. 95 , 52. 56 -3 рефлекса •
Уравнение Вульфа-Брэгга • 1. Рассеяние на ионах Cs: • Рассеянные верхней и нижней плоскостями волны будут интерферировать, если они имеют ту же фазу ( -угол падения и рассеяния), т. е. когерентны. Разность хода этих двух волн: =d sin +d sin =2 d sin • При =n , где - длина волны падающего излучения, n=1, 2, 3. . . интерференция этих волн дает максимум, • при n=1/2, 3/2, 5/2. . . - минимум. В остальных случаях – промежуточная интенсивность рассеяния. Уравнение Вульфа-Брэгга: n =2 d sin • При известных =1. 54 А (Cu-трубка) и измеренных углах , при которых наблюдается максимум рассеяния рефлексы, можно определять d-межатомное (Cs-Cs) расстояние: d=n /2 sin =4. 11 А. (n=1, sin =0. 1873). Условие определения d: sin =n /2 d 0, 1, при =1. 54 А и d= 4. 11 А таких углов и рефлексов может быть 5: • 10. 8 ; 22 ; 34, 19 ; 48, 52 ; 69, 47 • n 1 2 3 4 5 • При d=2. 9 А существует 3 угла для максимумов: 15. 34 , 31. 95 , 52. 56 -3 рефлекса •
 Проявление разных фаз (атомов) в дифракционной картине: рассеяние на ионах Сl • • Интенсивность максимумов (рефлексов) содержит информацию о структуре, разном фазовом составе: Cl расположен на расстоянии d/2 от плоскости Cs, но расстояние между атомами Сl такое же как для Cs =d, т. е. дифракционная картина будет аналогичная, но «растянутая» и уменьшенная по интенсивности по сравнению с Сl: при sin =n /d максимумы будут наблюдаться только для четных n=2 и 4, т. е. эти максимумы будут усиливать максимумы, полученные от Cs. При нечетных n=1, 3, 5 для рассеяния на атомах Сl будут наблюдаться минимумы, т. е. в общей дифракционной картине «рефлексы» от Сs будут либо усиливаться, либо ослабляться – различие интенсивностей «рефлексов» указывает на наличие разных атомов (фаз) в кристаллической решетке, т. е. дает информацию о структуре кристалла.
Проявление разных фаз (атомов) в дифракционной картине: рассеяние на ионах Сl • • Интенсивность максимумов (рефлексов) содержит информацию о структуре, разном фазовом составе: Cl расположен на расстоянии d/2 от плоскости Cs, но расстояние между атомами Сl такое же как для Cs =d, т. е. дифракционная картина будет аналогичная, но «растянутая» и уменьшенная по интенсивности по сравнению с Сl: при sin =n /d максимумы будут наблюдаться только для четных n=2 и 4, т. е. эти максимумы будут усиливать максимумы, полученные от Cs. При нечетных n=1, 3, 5 для рассеяния на атомах Сl будут наблюдаться минимумы, т. е. в общей дифракционной картине «рефлексы» от Сs будут либо усиливаться, либо ослабляться – различие интенсивностей «рефлексов» указывает на наличие разных атомов (фаз) в кристаллической решетке, т. е. дает информацию о структуре кристалла.
 Схема рентгеновского дифрактометра • Дифрактометр: • 1 - рентгеновская трубка, 2, 3 коллиматор. 4 – образец, 5 - вращающийся столик, 6, 7 – гониометр со сцинтилляционным счетчиком, 8 – центральное пятно, 9 – максимум измеряется с точностью до долей минут. Информация об углах, под которыми наблюдаются дифракционные максимумы (рефлексы), позволяет определять размеры кристаллов, межатомные расстояния и т. д. • • • Возможность определения предельных размеров дифракционными методами: • • =1. 54 А (Cu-трубка), d=4. 11 A d=n /2 sin : при sin =1 можно определить наименьшее значение d=n /2, где n=1. При d< /2 таких углов нет, т. е. нельзя определить дифракцион. методами расстояние, размеры которого меньше /2 – это дифракционный предел измерений: электронным пучком ( эл=0. 005 нм) можно определять меньшие размеры. •
Схема рентгеновского дифрактометра • Дифрактометр: • 1 - рентгеновская трубка, 2, 3 коллиматор. 4 – образец, 5 - вращающийся столик, 6, 7 – гониометр со сцинтилляционным счетчиком, 8 – центральное пятно, 9 – максимум измеряется с точностью до долей минут. Информация об углах, под которыми наблюдаются дифракционные максимумы (рефлексы), позволяет определять размеры кристаллов, межатомные расстояния и т. д. • • • Возможность определения предельных размеров дифракционными методами: • • =1. 54 А (Cu-трубка), d=4. 11 A d=n /2 sin : при sin =1 можно определить наименьшее значение d=n /2, где n=1. При d< /2 таких углов нет, т. е. нельзя определить дифракцион. методами расстояние, размеры которого меньше /2 – это дифракционный предел измерений: электронным пучком ( эл=0. 005 нм) можно определять меньшие размеры. •
 Метрология
Метрология

 Устройство и принцип действия просвечивающего электронного микроскопа • • Строился по примеру оптического микроскопа – получение увеличенного изображения предмета с помощью системы электронных линз, управляющих движением электронов. Принцип получения изображения – дифракция электронного пучка (волны Де Бройля =h/(mv=0. 005 нм) на образце, т. е. получение дифракционной картины. Толщина образца не более 1 мкм Высокий вакуум в камере (10 -8 атм. ) Изображение фотографируется (или подается на экран), темные и светлые пятна сопоставляют со структурой. Разрешение 0. 2 нм Недостаток – сложная подготовка образца.
Устройство и принцип действия просвечивающего электронного микроскопа • • Строился по примеру оптического микроскопа – получение увеличенного изображения предмета с помощью системы электронных линз, управляющих движением электронов. Принцип получения изображения – дифракция электронного пучка (волны Де Бройля =h/(mv=0. 005 нм) на образце, т. е. получение дифракционной картины. Толщина образца не более 1 мкм Высокий вакуум в камере (10 -8 атм. ) Изображение фотографируется (или подается на экран), темные и светлые пятна сопоставляют со структурой. Разрешение 0. 2 нм Недостаток – сложная подготовка образца.
 Сканирующий электронный микроскоп • • • Принцип получения изображения – сканирование поверхности образца узким высокоэнергетичным (десятки КЭВ) пучком электронов, под действием которого образуются вторичные электроны, либо кванты излучения (происходит дифракция электронов на поверхности образца). Затем вторичное излучение считывается (сканируется) другим пучком электронов, сигнал от детектирования которых подается на осциллограф. Увеличение определяется соотношением параметров первичного и вторичного электронных пучков, скоростей их сканирования. В камере необходим высокий вакуум. Достоинства: Образцы не требуют специальной подготовки, объемное изображение на экране электронно-лучевой трубки, мониторе компьютера. Разрешение 0. 5 нм Принцип сканирования поверхности получил развитие:
Сканирующий электронный микроскоп • • • Принцип получения изображения – сканирование поверхности образца узким высокоэнергетичным (десятки КЭВ) пучком электронов, под действием которого образуются вторичные электроны, либо кванты излучения (происходит дифракция электронов на поверхности образца). Затем вторичное излучение считывается (сканируется) другим пучком электронов, сигнал от детектирования которых подается на осциллограф. Увеличение определяется соотношением параметров первичного и вторичного электронных пучков, скоростей их сканирования. В камере необходим высокий вакуум. Достоинства: Образцы не требуют специальной подготовки, объемное изображение на экране электронно-лучевой трубки, мониторе компьютера. Разрешение 0. 5 нм Принцип сканирования поверхности получил развитие:
 Туннельный эффект, принцип действия сканирующего туннельного микроскопа (СТМ) • • Поток электронов (электрический ток) может с некоторой вероятностью проникать через изолятор сохраняя свойства начального электронного пучка (тот же самый электрон, но вероятность его обнаружения за изолятором намного меньше) – туннельный эффект. Для характеристики поверхности используется туннельный ток (н. А) между зондом, на который подается напряжение, и проводящей поверхностью образца (изолятор – воздушная прослойка)
Туннельный эффект, принцип действия сканирующего туннельного микроскопа (СТМ) • • Поток электронов (электрический ток) может с некоторой вероятностью проникать через изолятор сохраняя свойства начального электронного пучка (тот же самый электрон, но вероятность его обнаружения за изолятором намного меньше) – туннельный эффект. Для характеристики поверхности используется туннельный ток (н. А) между зондом, на который подается напряжение, и проводящей поверхностью образца (изолятор – воздушная прослойка)
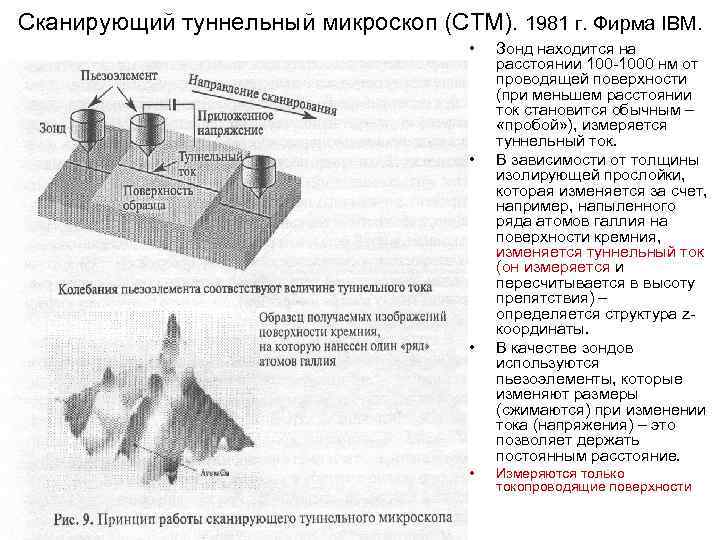 Сканирующий туннельный микроскоп (СТМ). 1981 г. Фирма IBM. • • Зонд находится на расстоянии 100 -1000 нм от проводящей поверхности (при меньшем расстоянии ток становится обычным – «пробой» ), измеряется туннельный ток. В зависимости от толщины изолирующей прослойки, которая изменяется за счет, например, напыленного ряда атомов галлия на поверхности кремния, изменяется туннельный ток (он измеряется и пересчитывается в высоту препятствия) – определяется структура zкоординаты. В качестве зондов используются пьезоэлементы, которые изменяют размеры (сжимаются) при изменении тока (напряжения) – это позволяет держать постоянным расстояние. Измеряются только токопроводящие поверхности
Сканирующий туннельный микроскоп (СТМ). 1981 г. Фирма IBM. • • Зонд находится на расстоянии 100 -1000 нм от проводящей поверхности (при меньшем расстоянии ток становится обычным – «пробой» ), измеряется туннельный ток. В зависимости от толщины изолирующей прослойки, которая изменяется за счет, например, напыленного ряда атомов галлия на поверхности кремния, изменяется туннельный ток (он измеряется и пересчитывается в высоту препятствия) – определяется структура zкоординаты. В качестве зондов используются пьезоэлементы, которые изменяют размеры (сжимаются) при изменении тока (напряжения) – это позволяет держать постоянным расстояние. Измеряются только токопроводящие поверхности
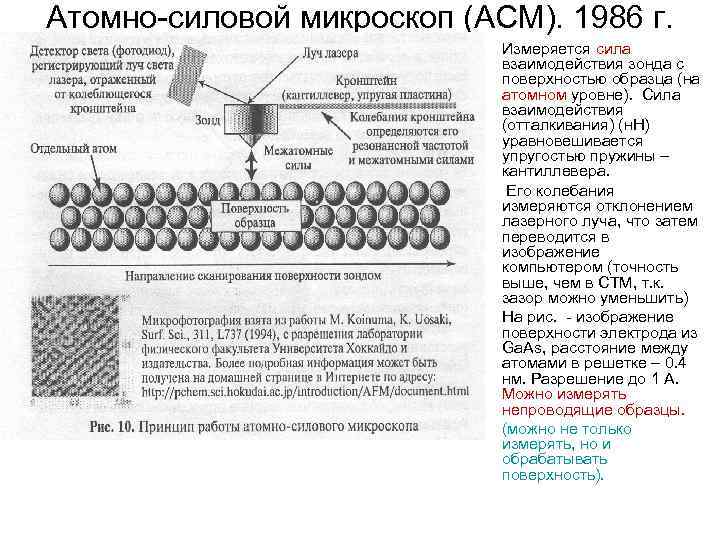 Атомно-силовой микроскоп (АСМ). 1986 г. • • Измеряется сила взаимодействия зонда с поверхностью образца (на атомном уровне). Сила взаимодействия (отталкивания) (н. Н) уравновешивается упругостью пружины – кантиллевера. Его колебания измеряются отклонением лазерного луча, что затем переводится в изображение компьютером (точность выше, чем в СТМ, т. к. зазор можно уменьшить) На рис. - изображение поверхности электрода из Ga. As, расстояние между атомами в решетке – 0. 4 нм. Разрешение до 1 А. Можно измерять непроводящие образцы. (можно не только измерять, но и обрабатывать поверхность).
Атомно-силовой микроскоп (АСМ). 1986 г. • • Измеряется сила взаимодействия зонда с поверхностью образца (на атомном уровне). Сила взаимодействия (отталкивания) (н. Н) уравновешивается упругостью пружины – кантиллевера. Его колебания измеряются отклонением лазерного луча, что затем переводится в изображение компьютером (точность выше, чем в СТМ, т. к. зазор можно уменьшить) На рис. - изображение поверхности электрода из Ga. As, расстояние между атомами в решетке – 0. 4 нм. Разрешение до 1 А. Можно измерять непроводящие образцы. (можно не только измерять, но и обрабатывать поверхность).
 «Nano. Educator» - базовый прибор для образовательного процесса Удобный, простой в работе, дешевый в эксплуатации СЗМ Приложения: биология, материаловедение, полимеры, нанолитография, полупроводники Базовые моды: Атомно-силовая микроскопия(АСМ) Отображение рельефа, отображение фазы, отображение силы, силовая спектроскопия Сканирующая туннельная микроскопия(СТМ) Отображение рельефа, отображение тока (метод постоянной высоты), туннельная спектроскопия (d. I/dz измерения) Динамическая силовая литография
«Nano. Educator» - базовый прибор для образовательного процесса Удобный, простой в работе, дешевый в эксплуатации СЗМ Приложения: биология, материаловедение, полимеры, нанолитография, полупроводники Базовые моды: Атомно-силовая микроскопия(АСМ) Отображение рельефа, отображение фазы, отображение силы, силовая спектроскопия Сканирующая туннельная микроскопия(СТМ) Отображение рельефа, отображение тока (метод постоянной высоты), туннельная спектроскопия (d. I/dz измерения) Динамическая силовая литография
 Зонды для СЗМ Nano. Educator
Зонды для СЗМ Nano. Educator
 Diamond-like material nanotips Such ultra-sharp tips are considered to be good for Raman enhancement Produced by NT-MDT : Whisker tips probes NTEGRA Spectra
Diamond-like material nanotips Such ultra-sharp tips are considered to be good for Raman enhancement Produced by NT-MDT : Whisker tips probes NTEGRA Spectra
 Биологические объекты (клетки, вирусы, бактерии) Эритроцит Размер скана: 11. 75 x 11. 75 мкм
Биологические объекты (клетки, вирусы, бактерии) Эритроцит Размер скана: 11. 75 x 11. 75 мкм
 Материаловедение Металлы, полупроводники, диэлектрики, композитные материалы, полимеры поверхность полимера Scan: 100 x 100 nm Пленка Al на Si. O 2 Scan: 6 x 6 x 0. 5 um Золотая пленка на Si. O 2 Scan: 0. 6 x 0. 6 um
Материаловедение Металлы, полупроводники, диэлектрики, композитные материалы, полимеры поверхность полимера Scan: 100 x 100 nm Пленка Al на Si. O 2 Scan: 6 x 6 x 0. 5 um Золотая пленка на Si. O 2 Scan: 0. 6 x 0. 6 um
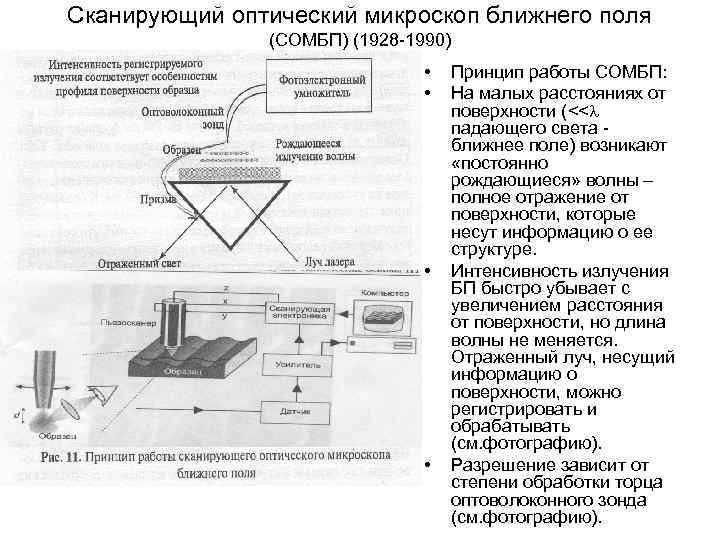 Сканирующий оптический микроскоп ближнего поля (СОМБП) (1928 -1990) • • Принцип работы СОМБП: На малых расстояниях от поверхности (<< падающего света ближнее поле) возникают «постоянно рождающиеся» волны – полное отражение от поверхности, которые несут информацию о ее структуре. Интенсивность излучения БП быстро убывает с увеличением расстояния от поверхности, но длина волны не меняется. Отраженный луч, несущий информацию о поверхности, можно регистрировать и обрабатывать (см. фотографию). Разрешение зависит от степени обработки торца оптоволоконного зонда (см. фотографию).
Сканирующий оптический микроскоп ближнего поля (СОМБП) (1928 -1990) • • Принцип работы СОМБП: На малых расстояниях от поверхности (<< падающего света ближнее поле) возникают «постоянно рождающиеся» волны – полное отражение от поверхности, которые несут информацию о ее структуре. Интенсивность излучения БП быстро убывает с увеличением расстояния от поверхности, но длина волны не меняется. Отраженный луч, несущий информацию о поверхности, можно регистрировать и обрабатывать (см. фотографию). Разрешение зависит от степени обработки торца оптоволоконного зонда (см. фотографию).
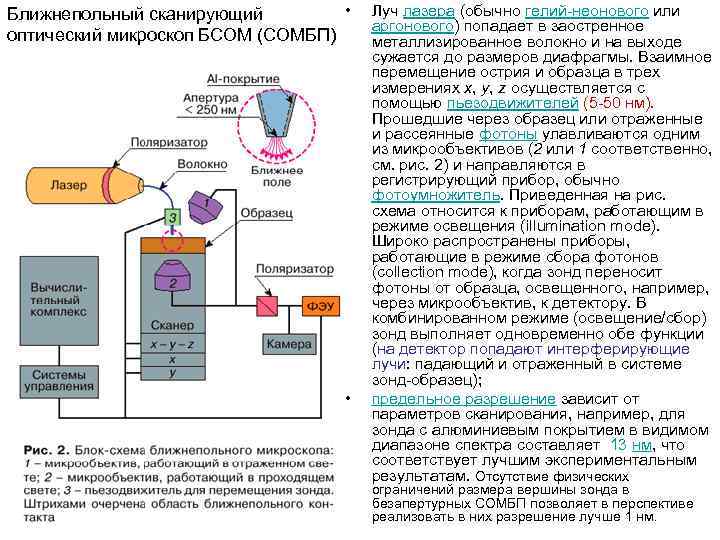 • Ближнепольный сканирующий оптический микроскоп БСОМ (СОМБП) • Луч лазера (обычно гелий-неонового или аргонового) попадает в заостренное металлизированное волокно и на выходе сужается до размеров диафрагмы. Взаимное перемещение острия и образца в трех измерениях x, y, z осуществляется с помощью пьезодвижителей (5 -50 нм). Прошедшие через образец или отраженные и рассеянные фотоны улавливаются одним из микрообъективов (2 или 1 соответственно, см. рис. 2) и направляются в регистрирующий прибор, обычно фотоумножитель. Приведенная на рис. схема относится к приборам, работающим в режиме освещения (illumination mode). Широко распространены приборы, работающие в режиме сбора фотонов (collection mode), когда зонд переносит фотоны от образца, освещенного, например, через микрообъектив, к детектору. В комбинированном режиме (освещение/сбор) зонд выполняет одновременно обе функции (на детектор попадают интерферирующие лучи: падающий и отраженный в системе зонд-образец); предельное разрешение зависит от параметров сканирования, например, для зонда с алюминиевым покрытием в видимом диапазоне спектра составляет 13 нм, что соответствует лучшим экспериментальным результатам. Отсутствие физических ограничений размера вершины зонда в безапертурных СОМБП позволяет в перспективе реализовать в них разрешение лучше 1 нм.
• Ближнепольный сканирующий оптический микроскоп БСОМ (СОМБП) • Луч лазера (обычно гелий-неонового или аргонового) попадает в заостренное металлизированное волокно и на выходе сужается до размеров диафрагмы. Взаимное перемещение острия и образца в трех измерениях x, y, z осуществляется с помощью пьезодвижителей (5 -50 нм). Прошедшие через образец или отраженные и рассеянные фотоны улавливаются одним из микрообъективов (2 или 1 соответственно, см. рис. 2) и направляются в регистрирующий прибор, обычно фотоумножитель. Приведенная на рис. схема относится к приборам, работающим в режиме освещения (illumination mode). Широко распространены приборы, работающие в режиме сбора фотонов (collection mode), когда зонд переносит фотоны от образца, освещенного, например, через микрообъектив, к детектору. В комбинированном режиме (освещение/сбор) зонд выполняет одновременно обе функции (на детектор попадают интерферирующие лучи: падающий и отраженный в системе зонд-образец); предельное разрешение зависит от параметров сканирования, например, для зонда с алюминиевым покрытием в видимом диапазоне спектра составляет 13 нм, что соответствует лучшим экспериментальным результатам. Отсутствие физических ограничений размера вершины зонда в безапертурных СОМБП позволяет в перспективе реализовать в них разрешение лучше 1 нм.
 Сканирующие зондовые микроскопы Нанофабы 30 -08 -2007 Нанолабы
Сканирующие зондовые микроскопы Нанофабы 30 -08 -2007 Нанолабы


