Лекция 1 ВВЕДЕНИЕ Основные



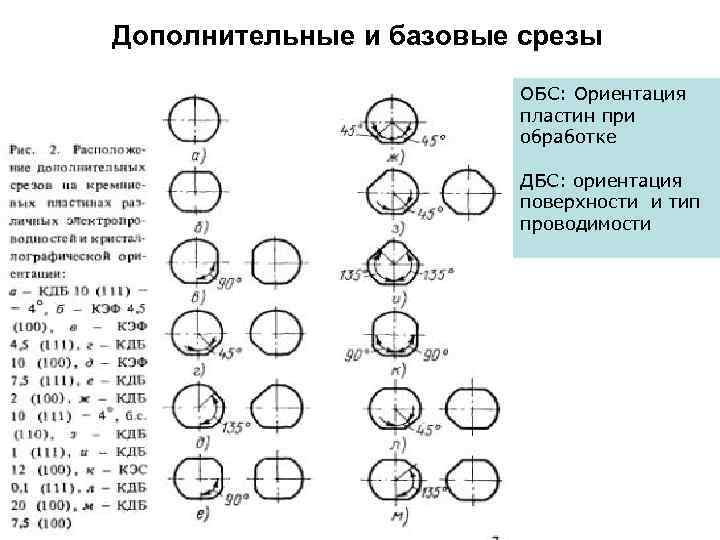
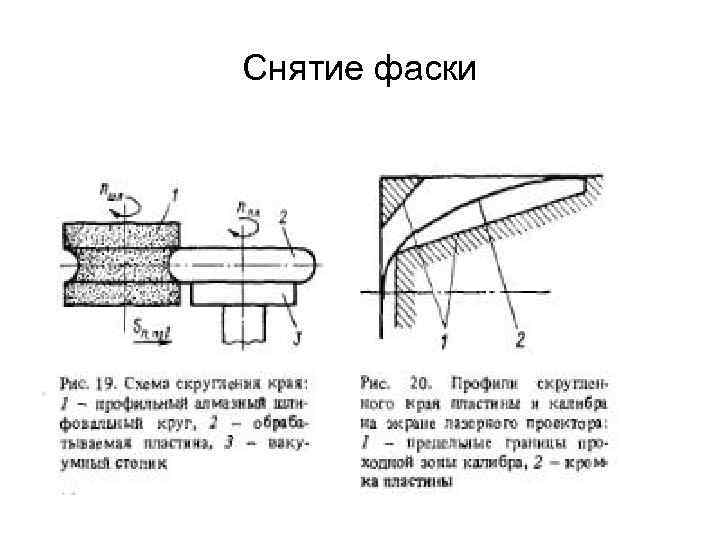
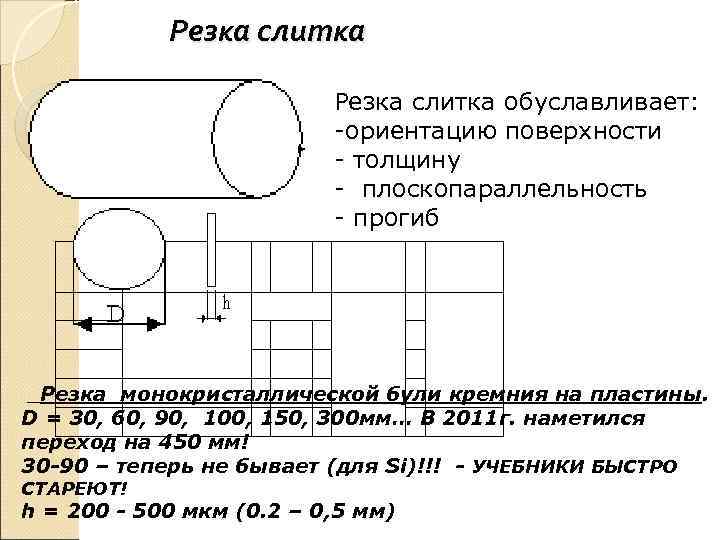





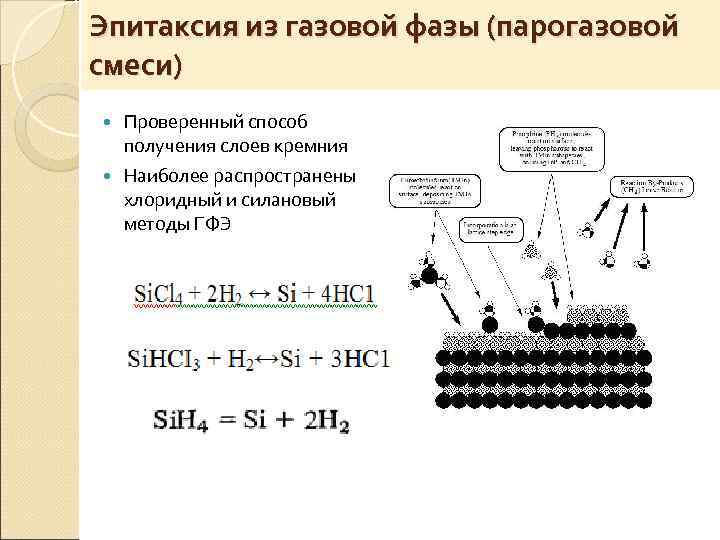


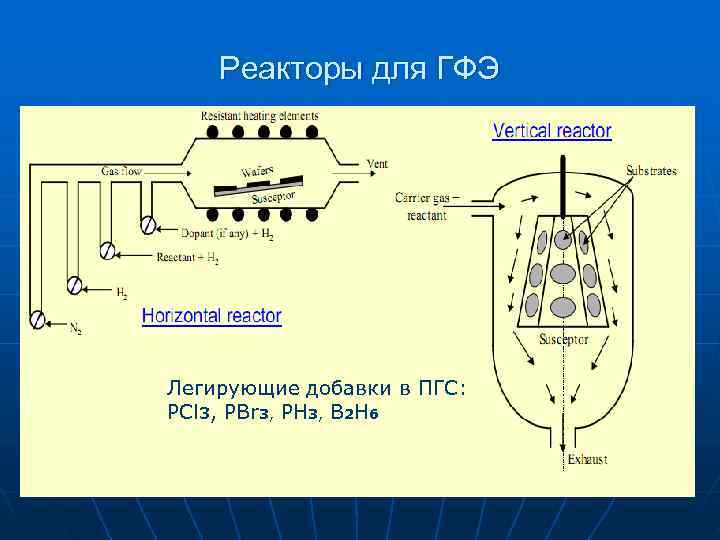




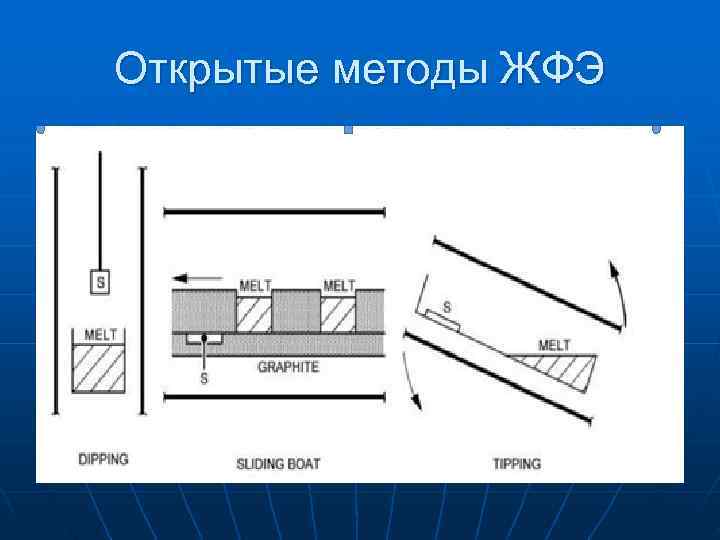





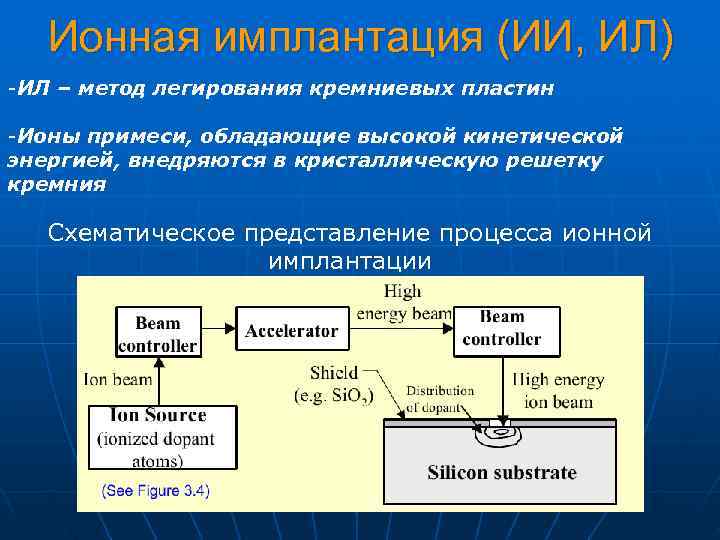


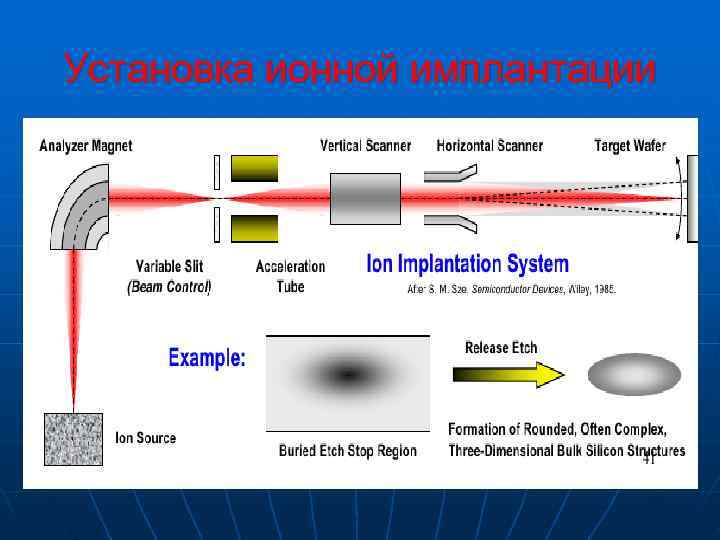





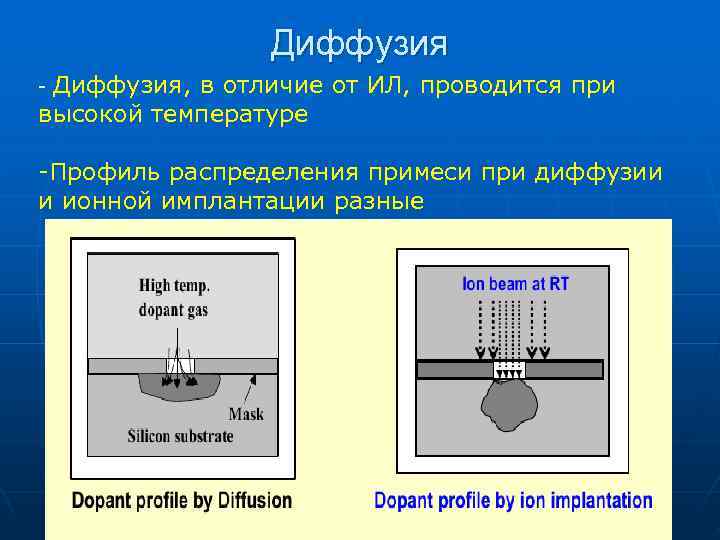










Основные технологич. операции ИС.ppt
- Количество слайдов: 44
 Лекция 1 ВВЕДЕНИЕ Основные технологические процессы изготовления кремниевых ИС
Лекция 1 ВВЕДЕНИЕ Основные технологические процессы изготовления кремниевых ИС
 Технологические операции получения пластин из слитка Обрезание затравочной и хвостовой части слитка-були Обдирка боковой поверхности до нужного диаметра Шлифовка одного или нескольких базовых срезов Резка слитка на пластины Снятие фаски с боковых поверхностей пластин Обработка поверхности пластин
Технологические операции получения пластин из слитка Обрезание затравочной и хвостовой части слитка-були Обдирка боковой поверхности до нужного диаметра Шлифовка одного или нескольких базовых срезов Резка слитка на пластины Снятие фаски с боковых поверхностей пластин Обработка поверхности пластин
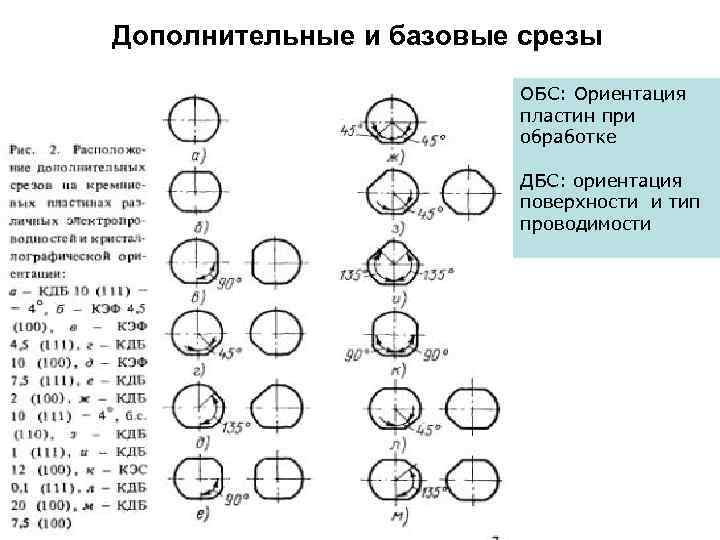 Дополнительные и базовые срезы ОБС: Ориентация пластин при обработке ДБС: ориентация поверхности и тип проводимости
Дополнительные и базовые срезы ОБС: Ориентация пластин при обработке ДБС: ориентация поверхности и тип проводимости
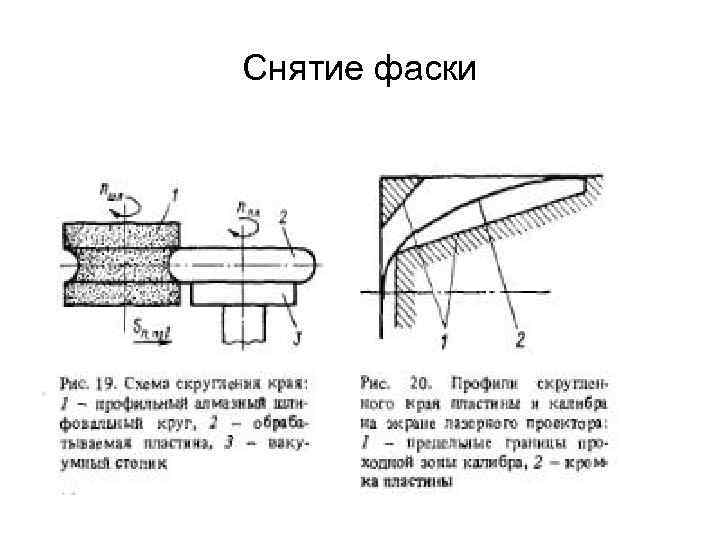 Снятие фаски
Снятие фаски
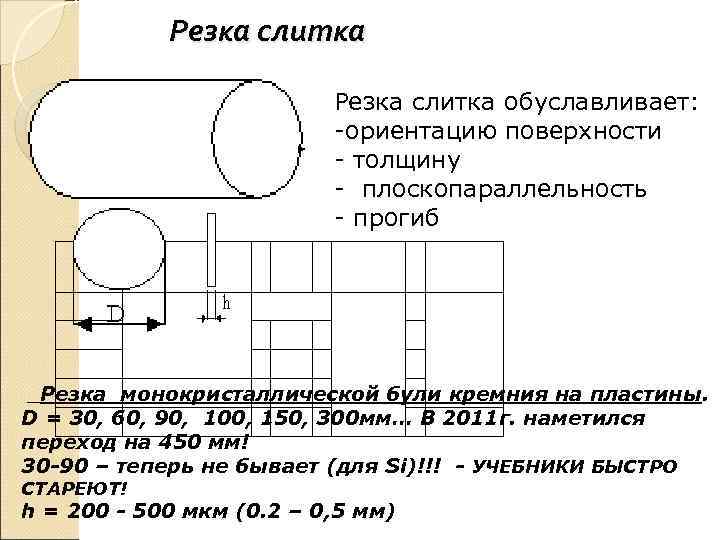 Резка слитка обуславливает: -ориентацию поверхности - толщину - плоскопараллельность - прогиб Резка монокристаллической були кремния на пластины. D = 30, 60, 90, 100, 150, 300 мм… В 2011 г. наметился переход на 450 мм! 30 -90 – теперь не бывает (для Si)!!! - УЧЕБНИКИ БЫСТРО СТАРЕЮТ! h = 200 - 500 мкм (0. 2 – 0, 5 мм)
Резка слитка обуславливает: -ориентацию поверхности - толщину - плоскопараллельность - прогиб Резка монокристаллической були кремния на пластины. D = 30, 60, 90, 100, 150, 300 мм… В 2011 г. наметился переход на 450 мм! 30 -90 – теперь не бывает (для Si)!!! - УЧЕБНИКИ БЫСТРО СТАРЕЮТ! h = 200 - 500 мкм (0. 2 – 0, 5 мм)
 Резка слитка на пластины
Резка слитка на пластины
 Нарушенный слой на поверхности пластин образуется после резки 1 – рельефный 2 – трещиноватый 3 - напряженный
Нарушенный слой на поверхности пластин образуется после резки 1 – рельефный 2 – трещиноватый 3 - напряженный
 Удаление остатков нарушенного слоя и загрязнений
Удаление остатков нарушенного слоя и загрязнений
 Параметры пластин
Параметры пластин
 Часть 2. Эпитаксия – процесс наращивания тонких монокристаллических слоев на монокристаллических подложках Рост кристаллической пленки происходит при температуре ниже температуры плавления Гомоэпитаксия (автоэпитаксия) – материал слоя идентичен материалу подложки Гетероэпитаксия – материал слоя и подложки различаются Эпитаксия из газовой фазы (ГФЭ), из жидкой фазы (ЖФЭ), эпитаксия из молекулярных пучков в вакууме (МЛЭ), эпитаксия из твердой фазы (ТФЭ)
Часть 2. Эпитаксия – процесс наращивания тонких монокристаллических слоев на монокристаллических подложках Рост кристаллической пленки происходит при температуре ниже температуры плавления Гомоэпитаксия (автоэпитаксия) – материал слоя идентичен материалу подложки Гетероэпитаксия – материал слоя и подложки различаются Эпитаксия из газовой фазы (ГФЭ), из жидкой фазы (ЖФЭ), эпитаксия из молекулярных пучков в вакууме (МЛЭ), эпитаксия из твердой фазы (ТФЭ)
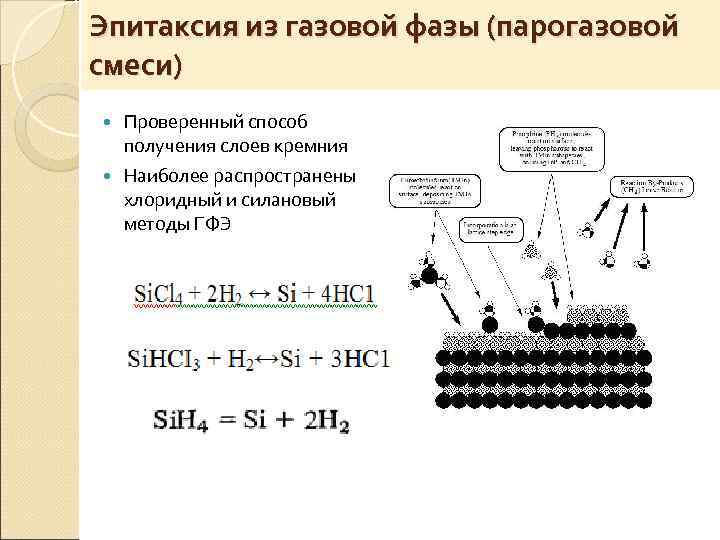 Эпитаксия из газовой фазы (парогазовой смеси) Проверенный способ получения слоев кремния Наиболее распространены хлоридный и силановый методы ГФЭ
Эпитаксия из газовой фазы (парогазовой смеси) Проверенный способ получения слоев кремния Наиболее распространены хлоридный и силановый методы ГФЭ
 Модели эпитаксиального роста
Модели эпитаксиального роста
 Зависимость скорости роста ЭС от различных параметров при ГФЭ Re<2000 – ламинарное течение, Re>2000 – турбулентное течение
Зависимость скорости роста ЭС от различных параметров при ГФЭ Re<2000 – ламинарное течение, Re>2000 – турбулентное течение
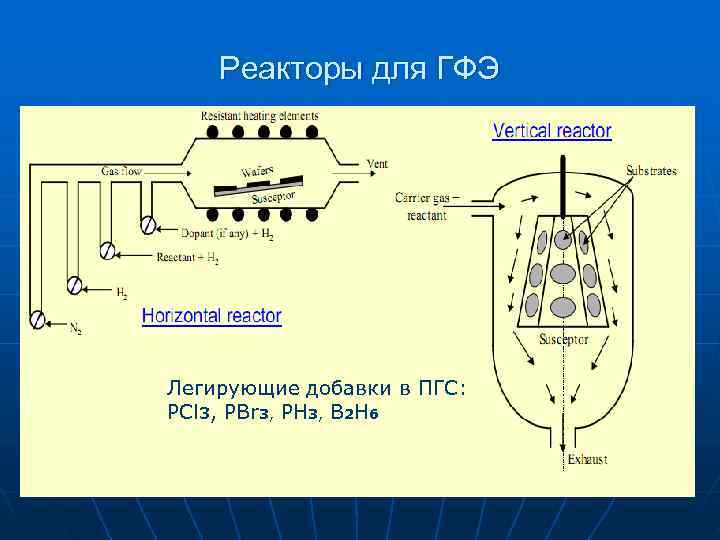 Реакторы для ГФЭ Легирующие добавки в ПГС: PCl 3, PBr 3, PH 3, B 2 H 6
Реакторы для ГФЭ Легирующие добавки в ПГС: PCl 3, PBr 3, PH 3, B 2 H 6
 Автолегирование при эпитаксии
Автолегирование при эпитаксии
 Автолегирование при наличии скрытых слоев
Автолегирование при наличии скрытых слоев
 Жидкофазная эпитаксия
Жидкофазная эпитаксия
 ЖФЭ: кристаллизация монокристаллических слоев осуществляется из растворов-расплавов полупроводника в легкоплавком металле-растворителе n Реализуется в изотермических (испарение растворителя, изотермическое смешивание) и неизотермических (принудительное охлаждение, переохлаждение раствора- расплава) условиях n Используется для получения многослойных структур на основе соединений АIIIВV n используется при изготовлении инжекционных лазеров, источников спонтанного излучения, туннельных диодов
ЖФЭ: кристаллизация монокристаллических слоев осуществляется из растворов-расплавов полупроводника в легкоплавком металле-растворителе n Реализуется в изотермических (испарение растворителя, изотермическое смешивание) и неизотермических (принудительное охлаждение, переохлаждение раствора- расплава) условиях n Используется для получения многослойных структур на основе соединений АIIIВV n используется при изготовлении инжекционных лазеров, источников спонтанного излучения, туннельных диодов
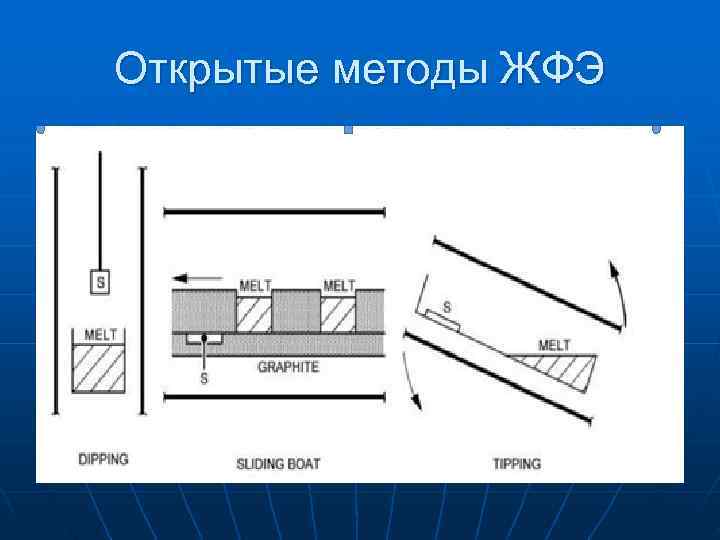 Открытые методы ЖФЭ
Открытые методы ЖФЭ
 Открытые методы ЖФЭ
Открытые методы ЖФЭ
 Открытые методы ЖФЭ
Открытые методы ЖФЭ
 Молекулярно-лучевая эпитаксия, или эпитаксия из молекулярных пучков в вакууме
Молекулярно-лучевая эпитаксия, или эпитаксия из молекулярных пучков в вакууме
 Часть 3 Основные методы легирования в микроэлектронике Цель процессов легирования – создание областей разного типа проводимости
Часть 3 Основные методы легирования в микроэлектронике Цель процессов легирования – создание областей разного типа проводимости
 Ионная имплантация, или Ионное легирование
Ионная имплантация, или Ионное легирование
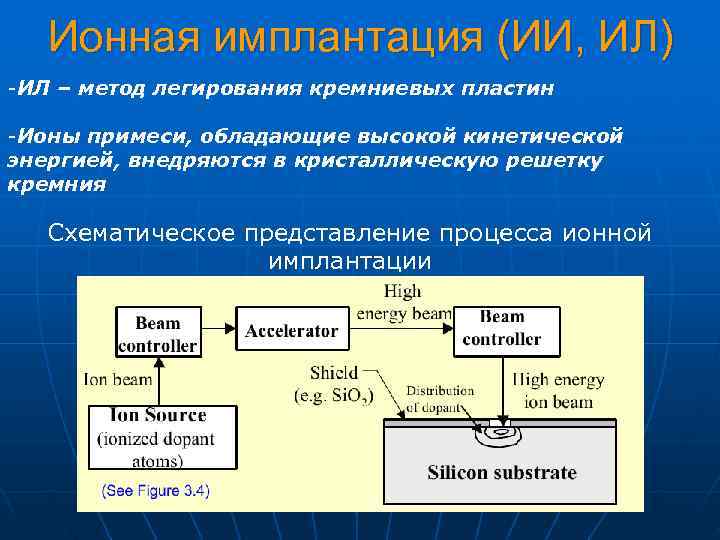 Ионная имплантация (ИИ, ИЛ) -ИЛ – метод легирования кремниевых пластин -Ионы примеси, обладающие высокой кинетической энергией, внедряются в кристаллическую решетку кремния Схематическое представление процесса ионной имплантации
Ионная имплантация (ИИ, ИЛ) -ИЛ – метод легирования кремниевых пластин -Ионы примеси, обладающие высокой кинетической энергией, внедряются в кристаллическую решетку кремния Схематическое представление процесса ионной имплантации
 Ионное легирование Достоинства метода: n Контролируемое введение примеси n Полная совместимость с процессами планарной технологии n Однородность легирования n Возможность создания малой области легирования на заданной глубине, в том числе мелкозалегающих слоев n Особо чистые условия процесса Недостатки метода: n Нарушение кристаллической структуры n Эффект каналирования
Ионное легирование Достоинства метода: n Контролируемое введение примеси n Полная совместимость с процессами планарной технологии n Однородность легирования n Возможность создания малой области легирования на заданной глубине, в том числе мелкозалегающих слоев n Особо чистые условия процесса Недостатки метода: n Нарушение кристаллической структуры n Эффект каналирования
 Оборудование для ИЛ
Оборудование для ИЛ
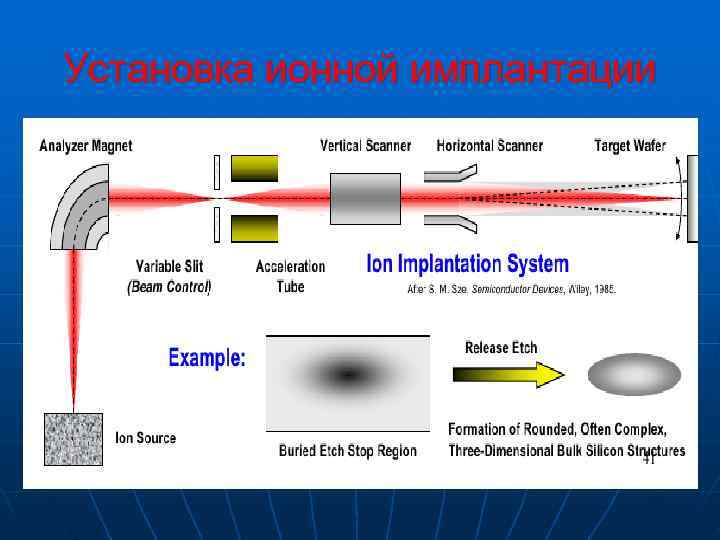 Установка ионной имплантации
Установка ионной имплантации
 Ионная имплантация Системы сканирования пучка ионов
Ионная имплантация Системы сканирования пучка ионов
 Ионная имплантация
Ионная имплантация
 Ионная имплантация Теория Линдхарда, Шарфа, Шиотта
Ионная имплантация Теория Линдхарда, Шарфа, Шиотта
 Эффект каналирования В определенном диапазоне углов падения ионов возможно движение ионов между атомными плоскостями
Эффект каналирования В определенном диапазоне углов падения ионов возможно движение ионов между атомными плоскостями
 Диффузия - - Это процесс переноса примесей из области с высокой в область с низкой концентрацией, стимулированный высокой температурой - Методом диффузии формируют активные, пассивные элементы ИС и изоляцию - Источники легирующих примесей могут быть твердые, жидкие и газообразные
Диффузия - - Это процесс переноса примесей из области с высокой в область с низкой концентрацией, стимулированный высокой температурой - Методом диффузии формируют активные, пассивные элементы ИС и изоляцию - Источники легирующих примесей могут быть твердые, жидкие и газообразные
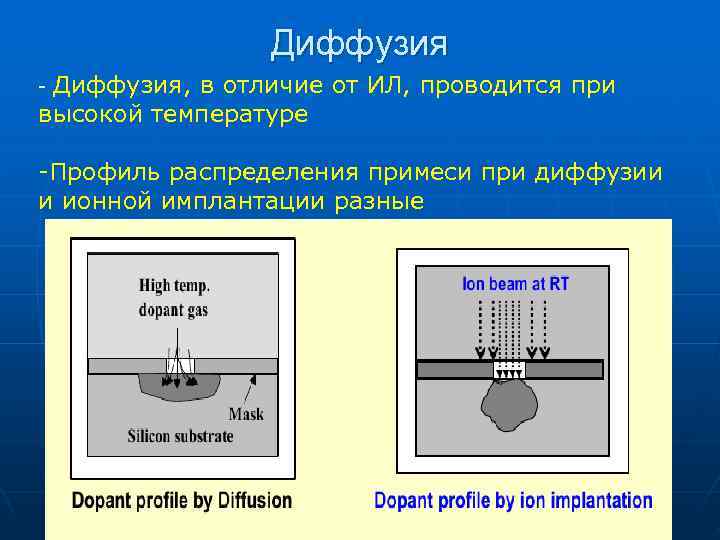 Диффузия - Диффузия, в отличие от ИЛ, проводится при высокой температуре -Профиль распределения примеси при диффузии и ионной имплантации разные
Диффузия - Диффузия, в отличие от ИЛ, проводится при высокой температуре -Профиль распределения примеси при диффузии и ионной имплантации разные
 Доноры и акцепторы
Доноры и акцепторы
 Кривые Ирвина
Кривые Ирвина
 Особенности процесса диффузии -акцепторные диффундируют быстрее, чем донорные, из-за меньшего радиуса -Твердые источники примесей могут находиться на поверхности пластины, могут вне на небольшом расстоянии - газообразные примеси подают по магистралям из баллонов в потоке газа-носителя
Особенности процесса диффузии -акцепторные диффундируют быстрее, чем донорные, из-за меньшего радиуса -Твердые источники примесей могут находиться на поверхности пластины, могут вне на небольшом расстоянии - газообразные примеси подают по магистралям из баллонов в потоке газа-носителя
 Механизмы диффузии Закон Фика Уравнение диффузии Граничные и начальные условия
Механизмы диффузии Закон Фика Уравнение диффузии Граничные и начальные условия
 Решение уравнения диффузии Из неограниченного источника Из ограниченного источника
Решение уравнения диффузии Из неограниченного источника Из ограниченного источника
 Две стадии диффузии Источник примеси – примесно-силикатное стекло (БСС, ФСС) или газ 1 -я стадия – загонка примеси, 2 - разгонка
Две стадии диффузии Источник примеси – примесно-силикатное стекло (БСС, ФСС) или газ 1 -я стадия – загонка примеси, 2 - разгонка
 Оборудование для диффузии
Оборудование для диффузии
 Оборудование для диффузии
Оборудование для диффузии
 Установка термической диффузии
Установка термической диффузии
 Спасибо за внимание!
Спасибо за внимание!

