Конструкторско- технологическое обеспечение производства ЭВМ


Конструкторско- технологическое обеспечение производства ЭВМ

Темы 1. Полупроводниковые интегральные микросхемы 2. Гибридные интегральные микросхемы 3. Основные операции в производстве интегральных микросхем 4. Базовые технологические маршруты изготовления интегральных микросхем 5. Цели и задачи конструирования 6. Конструкторская документация 7. Конструирование ячеек ЭВМ 2

Темы 8. Технология изготовления печатных плат 9. Конструкции блоков ЭВМ 10. Электрический монтаж в ЭВМ 11. Показатели надежности ЭВМ 12. Расчет надежности ЭВМ 13. Обеспечение нормальных тепловых режимов ЭВМ 14. Основы обеспечения помехоустойчивости ЭВС 15. Помехи во взаимодействующих линиях связи ЭВМ 16. Основы защиты конструкций ЭВС от механических воздействий 17. Тенденции развития конструкторско- технологического обеспечения производства ЭВМ 3

Тема 1. Полупроводниковые интегральные микросхемы 1. 1 Классификация ИМС по конструкторско- технологическому исполнению 1. 2 Конструкции элементов полупроводниковых ИМС 1. 3 Конструктивно-технологические варианты межэлементной изоляции 1. 4 Системы коммутации в полупроводниковых ИМС 4

1. 1 Классификация интегральных микросхем по конструкторско-технологическому исполнению Полупроводниковые микросхемы 5

1. 1 Классификация интегральных микросхем по конструкторско-технологическому исполнению Пленочные микросхемы 6
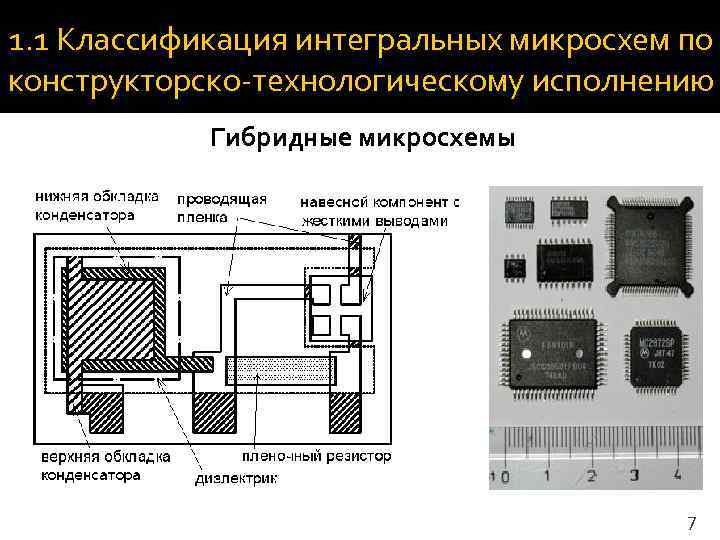
1. 1 Классификация интегральных микросхем по конструкторско-технологическому исполнению Гибридные микросхемы 7

Степень интеграции K=lg. N K-степень интеграции N-число элементов и компонентов в схеме По степени интеграции различают: малые интегральные схемы (до 100 элементов) средние интегральные схемы (от 100 до 1000 элементов) большие интегральные схемы (от 103 до 104 элементов) сверх большие интегральные схемы (от 105 элементов) 8
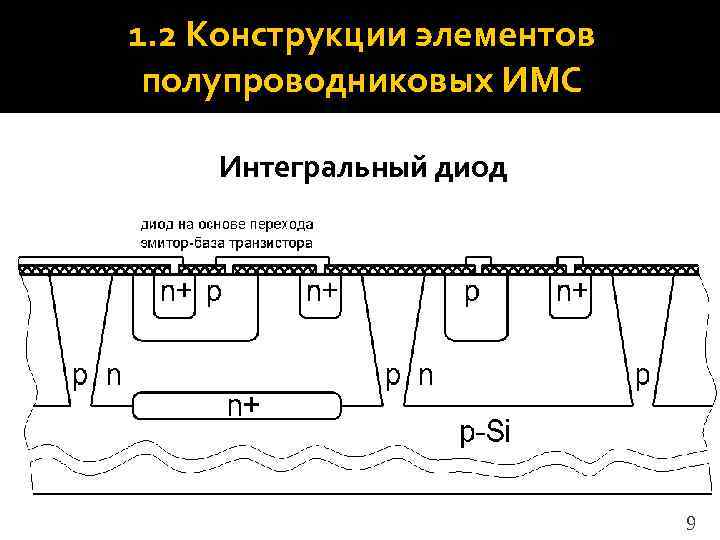
1. 2 Конструкции элементов полупроводниковых ИМС Интегральный диод 9

1. 2 Конструкции элементов полупроводниковых ИМС Интегральные транзисторы а) Структура планарно-эпитаксиального биполярного транзистора n+-p-n типа со скрытым подколлекторным слоем 10

1. 2 Конструкции элементов полупроводниковых ИМС Интегральные транзисторы б) Структура планарно-эпитаксиального биполярного транзистора n+-p-n типа со скрытым подколлекторным слоем 11

1. 2 Конструкции элементов полупроводниковых ИМС Интегральные транзисторы в) Структура горизонтального транзистора p-n-p типа 12

1. 2 Конструкции элементов полупроводниковых ИМС Интегральные транзисторы г) Структура дрейфового бокового транзистора p-n-p типа 13

1. 2 Конструкции элементов полупроводниковых ИМС Интегральные транзисторы д) Структура вертикального транзистора p-n-p типа 14

1. 2 Конструкции элементов полупроводниковых ИМС Диод Шоттки 15

1. 2 Конструкции элементов полупроводниковых ИМС Интегральные резисторы а) Резистор на основе базовой диффузии 16

1. 2 Конструкции элементов полупроводниковых ИМС Интегральные резисторы б) Высокоомный резистор 17
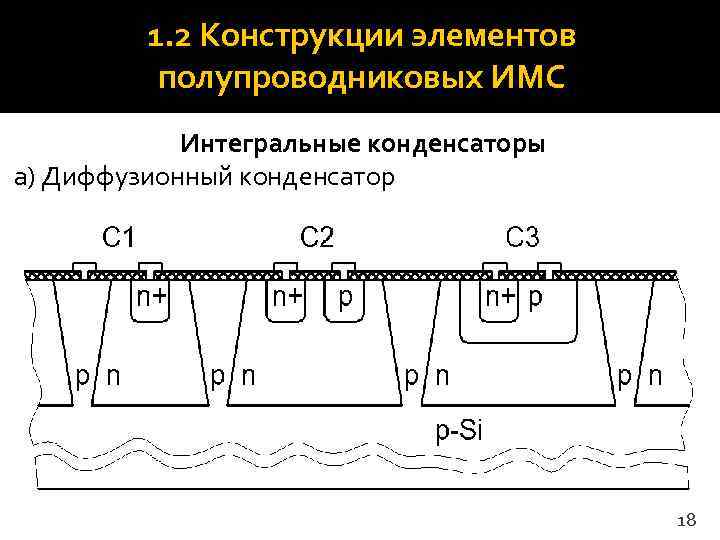
1. 2 Конструкции элементов полупроводниковых ИМС Интегральные конденсаторы а) Диффузионный конденсатор 18
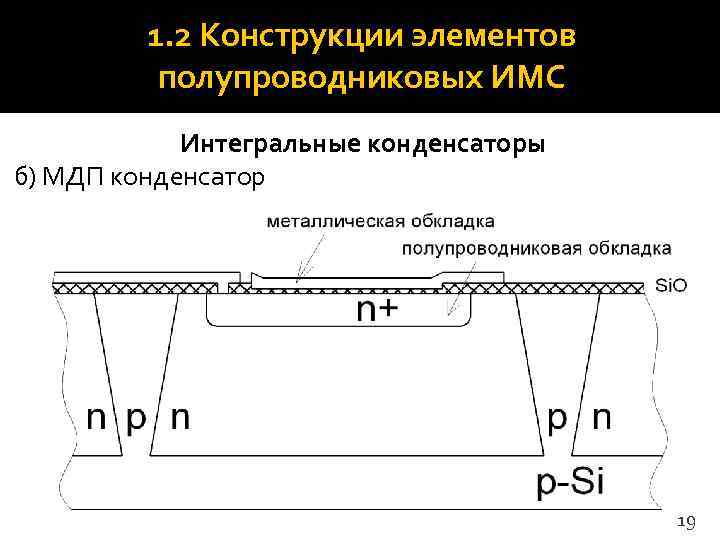
1. 2 Конструкции элементов полупроводниковых ИМС Интегральные конденсаторы б) МДП конденсатор 19

1. 2 Конструкции элементов полупроводниковых ИМС КМДП структура 20

1. 3 Конструктивно-технологические варианты межэлементной изоляции Межэлементная изоляция обратно смещенным p-n-переходом 21

1. 3 Конструктивно-технологические варианты межэлементной изоляции Изоляция диэлектриком а) кремний в диэлектрике б) кремний на диэлектрике 22
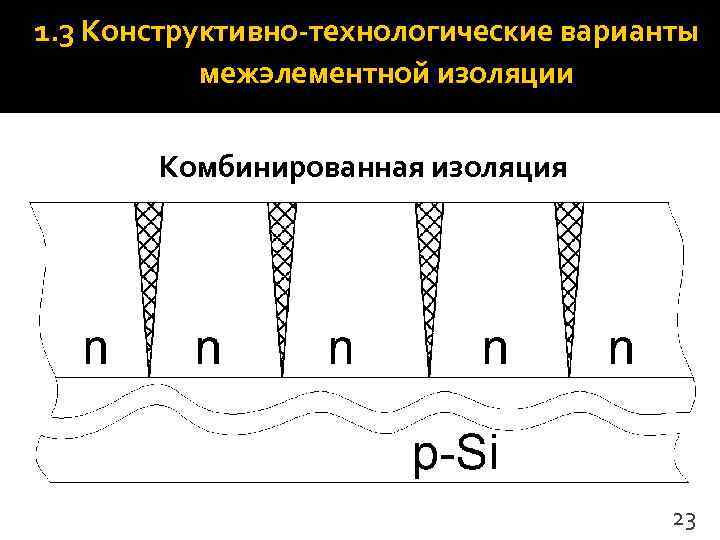
1. 3 Конструктивно-технологические варианты межэлементной изоляции Комбинированная изоляция 23

Тема 2. Гибридные интегральные микросхемы 2. 1 Конструкции пленочных элементов 2. 2 Компоненты гибридных ИМС 2. 3 Коммутация в гибридных ИМС 24

2. 1 Конструкции пленочных элементов Сопротивление резистора - 25

2. 1 Конструкции пленочных элементов Подгонка пленочных резисторов а) ступенчатая б) плавная 26

2. 1 Конструкции пленочных элементов Пленочные конденсаторы с активной площадью перекрытия с S = 1– 5 мм 2 обкладок S>5 мм 2; 27

2. 1 Конструкции пленочных элементов Пленочные индуктивности а) в виде круглой спирали б) в виде прямоугольной спирали 28

2. 2 Компоненты гибридных ИМС Разновидности выводов компонентов а) транзистор с гибкими выводами 29

2. 2 Компоненты гибридных ИМС Разновидности выводов компонентов б) транзистор с жесткими выводами 30

2. 2 Компоненты гибридных ИМС Разновидности выводов компонентов в) микросхема с шариковыми выводами 31

2. 2 Компоненты гибридных ИМС Разновидности выводов компонентов г) микросхема со столбиковыми выводами 32

Тема 3. Основные операции в производстве интегральных микросхем 3. 1 Методы получения пленок 3. 2 Методы введения примесей в полупроводниковые кристаллы 3. 3 Методы формирования топологического рисунка микросхем 33

Вопрос 3. 1. Методы получения пленок 3. 1. 1 Термическое окисление кремния 3. 1. 2 Осаждение пленок из парогазовой фазы 3. 1. 3 Термическое вакуумное напыление тонких пленок 3. 1. 4 Методы ионного распыления 3. 1. 5 Методы получения толстых пленок 34

3. 1. 1 Термическое окисление кремния Способы термического окисления кремния а) окисление кремния в сухом кислороде 35

3. 1. 1 Термическое окисление кремния Способы термического окисления кремния б) нагревание пластинки кремния в парах воды 36

3. 1. 3 Термическое вакуумное напыление тонких пленок Рабочая камера установки для термического вакуумного распыления 37

3. 1. 4 Методы ионного распыления Рабочая камера установки для катодного распыления 38

3. 1. 4 Методы ионного распыления Рабочая камера установки для ионно- плазменного распыления 39

3. 1. 5 Методы получения толстых пленок Бесконтактный метод формирования толстых пленок (трафаретная печать) 40

3. 1. 5 Методы получения толстых пленок Контактный метод формирования толстых пленок 41

Вопрос 3. 2. Методы введения примесей в полупроводниковые кристаллы 3. 2. 1 Диффузия 3. 2. 2 Ионное легирование 3. 2. 3 Легирование в процессе наращивания эпитаксиальной пленки 42

3. 2. 1 Диффузия Распределение примеси при диффузии из неограниченного источника Время диффузии t 3 > t 2 > t 1 глубина 43

3. 2. 1 Диффузия Распределение примеси при диффузии из ограниченного источника Время диффузии t 3 > t 2 > t 1 44

3. 2. 1 Диффузия Схема диффузионной камеры 1 — верхнее стекло; 2 — металлическое корытце с метиловым спиртом 9; 3 — стеклянный цилиндр (боковая поверхность камеры); 4 — металлическое дно камеры, охлаждаемой твёрдой углекислотой 5; 6 — поршень из термоизолирующего материала; 7 — сжатая пружина; 8 — параболическое зеркало; 10 — фотоаппарат; 11 — металлическое кольцо с редкой сеткой из тонкой проволоки для создания очищающего от ионов электрического поля; S — источник света. 45

3. 2. 2 Ионное легирование График распределения примесей с учетом каналирования I – область, в которой распределение имеет такой же вид, как и в аморфной мишени II – область деканалирования III – область распределения атомов, создаваемого каналированием 46

3. 2. 2 Ионное легирование Схема установки для ионного легирования 1 – источник ионов 2 – ионный ускоритель 3 – магнитный сепаратор 4 – система сканирования пучком ионов 5 – мишень 47

3. 2. 3 Легирование в процессе наращивания эпитаксиальной пленки Виды эпитаксии: Автоэпитаксия (гомоэпитаксия) – слой и подложка не отличаются по химическому составу Гетероэпитаксия – слой отличается по химическому составу от вещества подложки и не образует с ней химических соединений Хемоэпитаксия – эпитаксиальный слой представляет собой химическое соединение осаждаемого вещества и слоя подложки 48

Вопрос 3. 3. Методы формирования топологического рисунка интегральных микросхем 3. 3. 1 Классификация методов 3. 3. 2 Основные операции фотолитографии 3. 3. 3 Электронолитография, рентгенолитография, ионолитография 49

3. 3. 1 Классификация методов 1) Метод свободной маски 2) Метод контактной пленки 3) Локальная обработка без масок 50

3. 3. 1 Классификация методов Метод свободной маски 51

3. 3. 1 Классификация методов Метод контактной маски Виды литографии: Фотолитография (оптическая литография) - длина волны от 250 до 440 нм Рентгенолитография - длина волны от 0. 5 до 2 нм Электронолитография- длина волны от 0. 05 нм Ионолитография- длина волны от 0. 05 до 0. 1 нм 52

3. 3. 1 Классификация методов Локальная обработка без масок Конфигурацию элементов получают с помощью остросфокусированных лазерного или электронного лучей, которые путем испарения локально удаляют участки в слое 53

3. 3. 2 Основные операции фотолитографии Фотошаблон 54

3. 3. 2 Основные операции фотолитографии 1. Подготовка поверхности подложки 2. Нанесение фоторезиста 55

3. 3. 2 Основные операции фотолитографии 3. Сушка 4. Совмещение и экспонирование 56

3. 3. 2 Основные операции фотолитографии 5. Проявление 6. Термическая обработка 57

3. 3. 2 Основные операции фотолитографии 7. Травление пленки Si. O 2 8. Удаление фоторезистивной маски 58

Перспективные виды фотолитографии Фотолитография с использованием дальнего ультрафиолета(Extreme Ultra Violet lithography - EUV) Иммерсионная фотолитография Проекционная фотолитография «Двойная» фотолитография Фотолитография с подслоем Негативно-позитивная фотолитография Взрывная фотолитография 59

Тема 4 Базовые технологические маршруты изготовления ИМС 4. 1 Планарно-эпитаксиальная технология 4. 2 МДП - технология 60

4. 1 Планарно-эпитаксиальная технология 1. Подготовка поверхности 61

4. 1 Планарно-эпитаксиальная технология 2. Термическое окисление кремния 62

4. 1 Планарно-эпитаксиальная технология 3. Фотолитография 63

4. 1 Планарно-эпитаксиальная технология 4. Диффузия примеси n+-типа 64

4. 1 Планарно-эпитаксиальная технология 5. Удаление оксидной пленки 65

4. 1 Планарно-эпитаксиальная технология 6. Эпитаксиальное наращивание кремния n-типа 66

4. 1 Планарно-эпитаксиальная технология 7. Термическое окисление кремния 67

4. 1 Планарно-эпитаксиальная технология 8. Фотолитография 68

4. 1 Планарно-эпитаксиальная технология 9. Диффузия примесей p-типа 69

4. 1 Планарно-эпитаксиальная технология 10. Фотолитография 70

4. 1 Планарно-эпитаксиальная технология 11. Диффузия примеси p-типа 71

4. 1 Планарно-эпитаксиальная технология 12. Осаждение оксидной пленки 72

4. 1 Планарно-эпитаксиальная технология 13. Фотолитография 73

4. 1 Планарно-эпитаксиальная технология 14. Диффузия примеси n-типа 74

4. 1 Планарно-эпитаксиальная технология 15. Осаждение оксидной пленки 75

4. 1 Планарно-эпитаксиальная технология 16. Фотолитография 76

4. 1 Планарно-эпитаксиальная технология 17. Нанесение пленки металла 77

4. 1 Планарно-эпитаксиальная технология 18. Фотолитография по металлической пленке 78

Конструкция биполярного транзистора, изготовленного по планарно-эпитаксиальной технологии 79

4. 2 МДП - технология 1. Окисление кремниевой пластины n-типа 80

4. 2 МДП - технология 2. Фотолитография для снятия окисла 81

4. 2 МДП - технология 3. Ионное внедрение бора во вскрытые области 82

4. 2 МДП - технология 4. Фотолитография 83

4. 2 МДП - технология 5. Формирование подзатворного диэлектрика окислением в сухом кислороде. 84

4. 2 МДП - технология 6. Нанесение пленки поликристаллического кремния из газовой фазы 85

4. 2 МДП - технология 7. Дифузионное легирование фосфором, фотолитография 86

4. 2 МДП - технология 8. Ионное легирование и разгонка фосфора 87

4. 2 МДП - технология 9. Нанесение межслойной изоляции 88

4. 2 МДП - технология 10. Фотолитография 89

4. 2 МДП - технология 11. Напыление пленки алюминия 90

Тема 5. Цели и задачи конструирования 5. 1 Основные этапы проектирования и производства ЭВМ 5. 2 Показатели качества ЭВМ 5. 3 Условия эксплуатации и воздействующие факторы 91

5. 1 Основные этапы проектирования и производства ЭВМ 92

5. 1 Основные этапы проектирования и производства ЭВМ Конструкторское проектирование Исходные данные Процесс Результаты схема электрическая выбор формы изделия, конструкторская документация структурная; компоновки; на бумажном или электронном схема электрическая выбор механического носителе; функциональная; соединения деталей; управляющая программа для схема электрическая обеспечение нормального электронного оборудования. принципиальная; теплового режима; показатели качества; обеспечение требуемой условия эксплуатации; надежности и условия производства; помехоустойчивости. Подкрепляется соответствующими расчетами 93

5. 2 Показатели качества ЭВМ 1. Показатели назначения: быстродействие, производительность, объем памяти и др. 2. Конструктивные: точность компоновки ( ), коэффициент дезинтеграции 3. Эргономические показатели: - гигиенические - антропометрические - физиологические - психологические 4. Показатели надежности: безотказность, ремонтопригодность, долговечность, сохраняемость 94

5. 2 Показатели качества ЭВМ 5. Показатели технологичности 6. Эстетические 7. Патентно-правовые 8. Показатели транспортабельности 9. Экологические 10. Показатели безопасности 95

Тема 6. Конструкторская документация 6. 1 Основные принципы конструирования ЭВМ. Элементная база ЭВМ 6. 2 Стадии конструирования ЭВМ 6. 3 ЕСКД. Виды конструкторской документации 96

6. 1 Основные принципы конструирования ЭВС Уровни конструкторской иерархии ЭВМ 0 – микросхема 1 – ячейка 2 – блок 3 – стойка, тумба, шкаф 4 – ЭВМ 97

6. 2 Стадии конструирования ЭВС 98

Тема 7. Конструирование ячеек ЭВМ 7. 1 Конструкции ячеек ЭВМ 7. 2 Типы и классы точности печатных плат 7. 3 Основные этапы конструирования печатных плат 99

7. 2 Конструкции ячейки Каркас Монтажная (печатная) плата Установленные на плате микросхемы и другие компоненты Элементы внутренней электрической коммутации (печатные проводники) Элементы внешней коммутации Лицевая панель с элементами индикации и контроля 100
КТО ЭВМ.ppt
- Количество слайдов: 100

