 Глава 6. Масс-спектрометрия вторичных ионов. SIMS – Secondary Ion Mass Spectroscopy. Ip Ai+ Ya ~ 1 Yi+ ~ 10 -3 Yi+ = Ya Ri+ вторичная ионная эмиссия – ионная составляющая распыления Выход ионов определяется процессами, происходящими при отрыве частицы от поверхности. 1. Схема метода и устройство прибора. 2. Режимы работы: динамический и статический. 3. Масс спектр вторичных ионов. 4. Основная формула МСВИ 5. Чувствительность метода 6. Факторы, оказывающие влияние на анализ: -зависимость R+ от матрицы (Ga. As) -химический эффект -угловое и энергетическое распределение -эффект кратера - эффекты вбивания и перемешивания 7. Ионный зонд, ионный микроскоп. 8. Примеры применения метода.
Глава 6. Масс-спектрометрия вторичных ионов. SIMS – Secondary Ion Mass Spectroscopy. Ip Ai+ Ya ~ 1 Yi+ ~ 10 -3 Yi+ = Ya Ri+ вторичная ионная эмиссия – ионная составляющая распыления Выход ионов определяется процессами, происходящими при отрыве частицы от поверхности. 1. Схема метода и устройство прибора. 2. Режимы работы: динамический и статический. 3. Масс спектр вторичных ионов. 4. Основная формула МСВИ 5. Чувствительность метода 6. Факторы, оказывающие влияние на анализ: -зависимость R+ от матрицы (Ga. As) -химический эффект -угловое и энергетическое распределение -эффект кратера - эффекты вбивания и перемешивания 7. Ионный зонд, ионный микроскоп. 8. Примеры применения метода.
 Масс-спектры вторичных ионов
Масс-спектры вторичных ионов
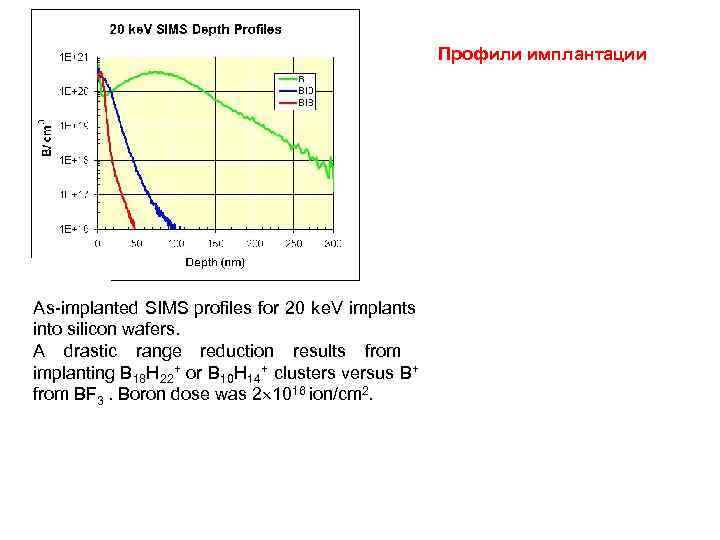 Профили имплантации As-implanted SIMS profiles for 20 ke. V implants into silicon wafers. A drastic range reduction results from implanting B 18 H 22+ or B 10 H 14+ clusters versus B+ from BF 3. Boron dose was 2 1016 ion/cm 2.
Профили имплантации As-implanted SIMS profiles for 20 ke. V implants into silicon wafers. A drastic range reduction results from implanting B 18 H 22+ or B 10 H 14+ clusters versus B+ from BF 3. Boron dose was 2 1016 ion/cm 2.
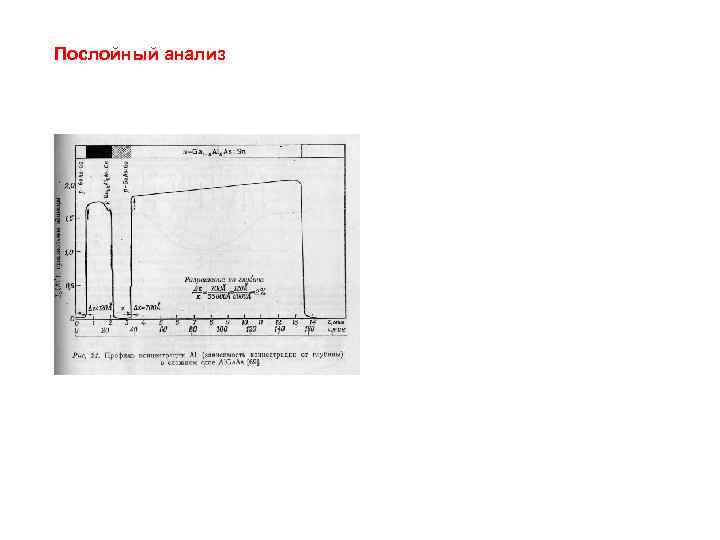 Послойный анализ
Послойный анализ
 Анализ кристаллической структуры
Анализ кристаллической структуры
