E&E_lectures-part2.2(ФПП).ppt
- Количество слайдов: 21
 “Электротехника и электроника Часть 2. Электроника. Основы Физики полупроводников q Основы зонной теории q Кинетические явления в полупроводниках q Электрические переходы
“Электротехника и электроника Часть 2. Электроника. Основы Физики полупроводников q Основы зонной теории q Кинетические явления в полупроводниках q Электрические переходы
 2 Электроника. Основы физики полупроводников Основы зонной теории Полупроводники – это материалы с проводимостью 10 5 … 1010 Ом*см, сильно зависящей от различных факторов. Типичные полупроводники, используемые в электронике – Ge, Si, Ga. As, Se, Te, а также оксиды, сульфиды и нитриды некоторых Разрешенные зоны металлов, а сегодня есть даже органические полупроводники Основы квантовой теории: Запрещенная зона Выделение и поглощение – квантами; Валентная зона Энергетические уровни – фиксированы. Ev. Акцепторы p≈Nакц. В кристаллическое решетке уровни расщепляются, образуя зоны Свободная зона. Ec. Доноры n≈Nдон. EFo Виды энергетических зон Зонные диаграммы – семейство диаграмм вида E(x). Разрешенные зоны – уровни энергии, которые могут принимать или имеют электроны. Запрещенная зона – диапазоны энергии, которые не могут иметь электроны. Валентная зона самая верхняя зона, уровни которой (все или часть) заняты электронами при Т=0. Зона проводимости – уровни энергии, имея которые, электроны могут перемещаться по кристаллической решетке. Свободная зона – зона, уровни которой полностью свободны при T=0. В полупроводниках свободная зона следует за валентной и расстояние ΔE между валентной и свободной зоной равно 0. 1 3 э. В и до 6 э. В, причем свободная зона является зоной проводимости. В металлах обе зоны перекрываются. e Виды проводимости Собственная проводимость – проводимость в чистом полупроводнике. Создается дырками и электронами Дырка – нестабильное вакантное энергетическое состояние атома, вызванное уходом. Примесная проводимость – при наличии акцепторной или донорной примеси. Для Ge акцепторная примесь = In, а доноры и донорная примесь – P, As. Виды примесной проводимости: Ge Ge In Ge Ge As Электронная проводимость – проводимость в п/п, имеющих донорную примесь. Дырочная проводимость – возникает в п/п, имеющих акцепторную примесь. Акцепторы для Ge – Р, As. Основные носители: дырки в полупроводниках p – типа, электроны в полупроводниках n – типа. Неосновные носители: p в n и n в p. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. e
2 Электроника. Основы физики полупроводников Основы зонной теории Полупроводники – это материалы с проводимостью 10 5 … 1010 Ом*см, сильно зависящей от различных факторов. Типичные полупроводники, используемые в электронике – Ge, Si, Ga. As, Se, Te, а также оксиды, сульфиды и нитриды некоторых Разрешенные зоны металлов, а сегодня есть даже органические полупроводники Основы квантовой теории: Запрещенная зона Выделение и поглощение – квантами; Валентная зона Энергетические уровни – фиксированы. Ev. Акцепторы p≈Nакц. В кристаллическое решетке уровни расщепляются, образуя зоны Свободная зона. Ec. Доноры n≈Nдон. EFo Виды энергетических зон Зонные диаграммы – семейство диаграмм вида E(x). Разрешенные зоны – уровни энергии, которые могут принимать или имеют электроны. Запрещенная зона – диапазоны энергии, которые не могут иметь электроны. Валентная зона самая верхняя зона, уровни которой (все или часть) заняты электронами при Т=0. Зона проводимости – уровни энергии, имея которые, электроны могут перемещаться по кристаллической решетке. Свободная зона – зона, уровни которой полностью свободны при T=0. В полупроводниках свободная зона следует за валентной и расстояние ΔE между валентной и свободной зоной равно 0. 1 3 э. В и до 6 э. В, причем свободная зона является зоной проводимости. В металлах обе зоны перекрываются. e Виды проводимости Собственная проводимость – проводимость в чистом полупроводнике. Создается дырками и электронами Дырка – нестабильное вакантное энергетическое состояние атома, вызванное уходом. Примесная проводимость – при наличии акцепторной или донорной примеси. Для Ge акцепторная примесь = In, а доноры и донорная примесь – P, As. Виды примесной проводимости: Ge Ge In Ge Ge As Электронная проводимость – проводимость в п/п, имеющих донорную примесь. Дырочная проводимость – возникает в п/п, имеющих акцепторную примесь. Акцепторы для Ge – Р, As. Основные носители: дырки в полупроводниках p – типа, электроны в полупроводниках n – типа. Неосновные носители: p в n и n в p. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. e
 3 Электроника. Основы физики полупроводников Основные соотношения для определения концентраций носителей заряда Эффективная плотность состояний N в зонах Ev и Ec равна Nv и Nc и для чистых полупроводников равна N=2*(2π m k. T /h 2)3/2, где h – постоянная Планка, m – эффективная масса. Для примесных полупроводников концентрация электронов и дырок Ec. Eд EF Ev. Eд Ev. EF n тип p тип Уровень Ферми равновероятное состояние при любой Т: EFo=(Ec+Ev)/2 EFn=EFo+k. T*ln(n/ni), EFp=EFo k. T*ln(p/pi), n/ni=Nд/Nc. p/pi=Nа/NV. Потенциалом Ферми называют величину EF/q. В чистом полупроводнике n≈p, и для любого полупроводника всегда np=const. В легированном полупроводнике потенциал Ферми EF смещен и находится между уровнем примеси и дном валентной зоны Ec для n – полупроводников и потолком валентной зоны Ev для p полупроводников. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
3 Электроника. Основы физики полупроводников Основные соотношения для определения концентраций носителей заряда Эффективная плотность состояний N в зонах Ev и Ec равна Nv и Nc и для чистых полупроводников равна N=2*(2π m k. T /h 2)3/2, где h – постоянная Планка, m – эффективная масса. Для примесных полупроводников концентрация электронов и дырок Ec. Eд EF Ev. Eд Ev. EF n тип p тип Уровень Ферми равновероятное состояние при любой Т: EFo=(Ec+Ev)/2 EFn=EFo+k. T*ln(n/ni), EFp=EFo k. T*ln(p/pi), n/ni=Nд/Nc. p/pi=Nа/NV. Потенциалом Ферми называют величину EF/q. В чистом полупроводнике n≈p, и для любого полупроводника всегда np=const. В легированном полупроводнике потенциал Ферми EF смещен и находится между уровнем примеси и дном валентной зоны Ec для n – полупроводников и потолком валентной зоны Ev для p полупроводников. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 Электроника. Основы физики полупроводников 4 Проводимость в полупроводниках. Генерационно рекомбинационный процесс Ток в полупроводниках j пропорционален напряженности E, концентрации C и градиенту ее изменения в пространстве и времени, которое описывается уравнением непрерывности: ∂C/∂t = (C Co)/τ + D*∂2 C/∂x 2 μ (E *∂2 C/∂x 2 +C∂E/∂x 2). В концентрации можно выделить статический и динамический компонент, обусловленный наличием неравновесных носителей: С=Со+ΔС(0), где ΔС = ΔС(0) * В уравнении непрерывности первый член определяет рекомбинационную составляющую тока, 2 й – диффузионную и третий – дрейфовую. Для квазистатического случая дрейфовая составляющая тока jдрейф=C*μ*q*E. Генерация – процесс создания электронно дырочной пары под действием, например, тепла или излучения. Рекомбинация – обратный процесс восстановления оборванных валентных связей. М. б. межзонная и через рекомбинационные центры (ловушки). В полупроводнике непрерывно идет рекомбинационно e генерационный процесс. По времени жизни различают следующие носители заряда Равновесные (установившийся режим) Неравновесные (сразу после какого либо воздействия). Продолжительность неравновесного состояния может составлять от 3 до 5 τε, где τε время диэлектрической релаксации (переход от одного состояния к другому). τε =ε * εо /(q*(noμn +poμp))≈10 12 с, где – no и po – равновесные концентрации, μn, μp – подвижности (средняя скорость носителя заряда при Е=1 В/м) и определяет среднее время жизни носителя заряда τ, которое связано с средней диффузионной длиной и коэффициентом диффузии выражением: . Размерность D= м 2/c. D=μ*k. T/q. Для дырок и электронов все входящие в уравнения коэффициенты (кроме q, ε ) свои, для своего типа заряда. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
Электроника. Основы физики полупроводников 4 Проводимость в полупроводниках. Генерационно рекомбинационный процесс Ток в полупроводниках j пропорционален напряженности E, концентрации C и градиенту ее изменения в пространстве и времени, которое описывается уравнением непрерывности: ∂C/∂t = (C Co)/τ + D*∂2 C/∂x 2 μ (E *∂2 C/∂x 2 +C∂E/∂x 2). В концентрации можно выделить статический и динамический компонент, обусловленный наличием неравновесных носителей: С=Со+ΔС(0), где ΔС = ΔС(0) * В уравнении непрерывности первый член определяет рекомбинационную составляющую тока, 2 й – диффузионную и третий – дрейфовую. Для квазистатического случая дрейфовая составляющая тока jдрейф=C*μ*q*E. Генерация – процесс создания электронно дырочной пары под действием, например, тепла или излучения. Рекомбинация – обратный процесс восстановления оборванных валентных связей. М. б. межзонная и через рекомбинационные центры (ловушки). В полупроводнике непрерывно идет рекомбинационно e генерационный процесс. По времени жизни различают следующие носители заряда Равновесные (установившийся режим) Неравновесные (сразу после какого либо воздействия). Продолжительность неравновесного состояния может составлять от 3 до 5 τε, где τε время диэлектрической релаксации (переход от одного состояния к другому). τε =ε * εо /(q*(noμn +poμp))≈10 12 с, где – no и po – равновесные концентрации, μn, μp – подвижности (средняя скорость носителя заряда при Е=1 В/м) и определяет среднее время жизни носителя заряда τ, которое связано с средней диффузионной длиной и коэффициентом диффузии выражением: . Размерность D= м 2/c. D=μ*k. T/q. Для дырок и электронов все входящие в уравнения коэффициенты (кроме q, ε ) свои, для своего типа заряда. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 Электроника. Основы физики полупроводников Кинетические явления в полупроводниках 5 Физическое явление Контактные Кинетические (электрические переходы) (особенности движения зарядов) Термоэлектрические явления Гальваномагнитные явления Терморезистивный эффект Продольные эффекты (Гаусса, Нернста) Эффект Пельтье (термопара) Поперечные (Холла, Эттингсгаузена) Эффект Зеебека (холодильник) Создают ЭДС, градиент температуры, изменяют проводимость Эффект Томпсона (неравномерный нагрев) Создают ЭДС, изменяют температуру, поглощают или выделяют тепло Оптические (поглощение и испускание света ) Термомагнитные явления Прочие эффекты Теплопроводность =f(Т) Продольные эффекты (Маджи Риги Ледюка, Нернста – Эттингсгаузена ) Эффекты сильных электрических полей: электропроводность =f(Т), эффект Ганна, ударная ионизация, туннельный эффект, электростатич. эффект Поперечные (Риги Ледюка, Нернста – Эттингсгаузена) Создают ЭДС, градиент температуры, изменяют проводимость Акустомеханические явления: поглощение или усиление акустических волн Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
Электроника. Основы физики полупроводников Кинетические явления в полупроводниках 5 Физическое явление Контактные Кинетические (электрические переходы) (особенности движения зарядов) Термоэлектрические явления Гальваномагнитные явления Терморезистивный эффект Продольные эффекты (Гаусса, Нернста) Эффект Пельтье (термопара) Поперечные (Холла, Эттингсгаузена) Эффект Зеебека (холодильник) Создают ЭДС, градиент температуры, изменяют проводимость Эффект Томпсона (неравномерный нагрев) Создают ЭДС, изменяют температуру, поглощают или выделяют тепло Оптические (поглощение и испускание света ) Термомагнитные явления Прочие эффекты Теплопроводность =f(Т) Продольные эффекты (Маджи Риги Ледюка, Нернста – Эттингсгаузена ) Эффекты сильных электрических полей: электропроводность =f(Т), эффект Ганна, ударная ионизация, туннельный эффект, электростатич. эффект Поперечные (Риги Ледюка, Нернста – Эттингсгаузена) Создают ЭДС, градиент температуры, изменяют проводимость Акустомеханические явления: поглощение или усиление акустических волн Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 Электроника. Основы физики полупроводников Термоэлектрические явления Терморезистивный эффект : σ=q(niμn+piμp)=AT 3/2+pexp((Ev Eс)/2 k. T), где A, p– некоторые константы. Для не очень высоких температур при (Ev Eс)>>k. T можно считать, что σ= σoexp((Ev Eс)/2 k. T). Причины возникновения: Различная зависимость средней энергии электронов от температуры в различных веществах Различная зависимость от температуры контактной разности потенциалов Фононное увлечение Эффект Зеебека: Vo= . Vо=α*(T 2 Т 1), α =10 5… 10 4. Эффект Пельтье: Qτ =П*I*t, Эффект Томпсона: Qτ = тепло поглощается, если ток направлен навстречу grad. T Связь коэффициентов d. П/dt=α+τ1 τ2, и П=αТ, откуда dα/d. T=( τ1 τ2)/T, где τ1 τ2 – коэффициенты Томсона для двух приведенных в контакт полупроводников. Зная коэффициенты τ1 и τ2, можно найти значения всех остальных коэффициентов. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. 6
Электроника. Основы физики полупроводников Термоэлектрические явления Терморезистивный эффект : σ=q(niμn+piμp)=AT 3/2+pexp((Ev Eс)/2 k. T), где A, p– некоторые константы. Для не очень высоких температур при (Ev Eс)>>k. T можно считать, что σ= σoexp((Ev Eс)/2 k. T). Причины возникновения: Различная зависимость средней энергии электронов от температуры в различных веществах Различная зависимость от температуры контактной разности потенциалов Фононное увлечение Эффект Зеебека: Vo= . Vо=α*(T 2 Т 1), α =10 5… 10 4. Эффект Пельтье: Qτ =П*I*t, Эффект Томпсона: Qτ = тепло поглощается, если ток направлен навстречу grad. T Связь коэффициентов d. П/dt=α+τ1 τ2, и П=αТ, откуда dα/d. T=( τ1 τ2)/T, где τ1 τ2 – коэффициенты Томсона для двух приведенных в контакт полупроводников. Зная коэффициенты τ1 и τ2, можно найти значения всех остальных коэффициентов. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. 6
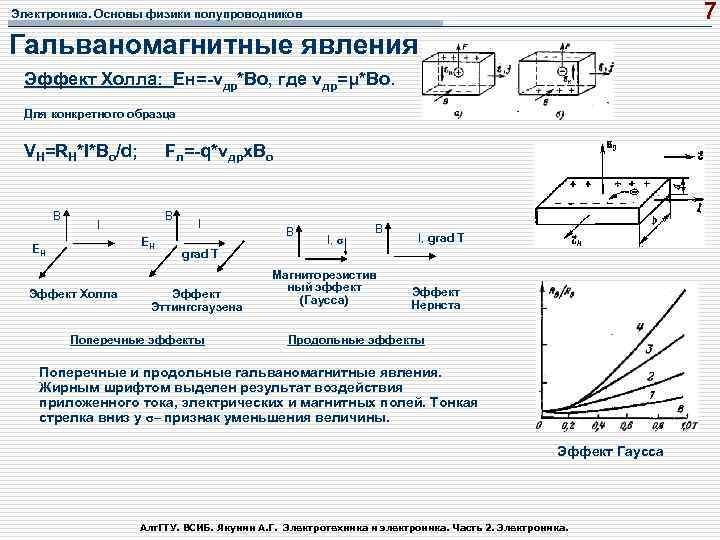 7 Электроника. Основы физики полупроводников Гальваномагнитные явления Эффект Холла: Eн= vдр*Bo, где vдр=μ*Во. Для конкретного образца VH=RH*I*Bo/d; B Fл= q*vдрх. Bo B I ЕH ЕH Эффект Холла I B I, σ B I, grad T Эффект Эттингсгаузена Поперечные эффекты Магниторезистив ный эффект (Гаусса) Эффект Нернста Продольные эффекты Поперечные и продольные гальваномагнитные явления. Жирным шрифтом выделен результат воздействия приложенного тока, электрических и магнитных полей. Тонкая стрелка вниз у σ– признак уменьшения величины. Эффект Гаусса Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
7 Электроника. Основы физики полупроводников Гальваномагнитные явления Эффект Холла: Eн= vдр*Bo, где vдр=μ*Во. Для конкретного образца VH=RH*I*Bo/d; B Fл= q*vдрх. Bo B I ЕH ЕH Эффект Холла I B I, σ B I, grad T Эффект Эттингсгаузена Поперечные эффекты Магниторезистив ный эффект (Гаусса) Эффект Нернста Продольные эффекты Поперечные и продольные гальваномагнитные явления. Жирным шрифтом выделен результат воздействия приложенного тока, электрических и магнитных полей. Тонкая стрелка вниз у σ– признак уменьшения величины. Эффект Гаусса Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 8 Электроника. Основы физики полупроводников Термогальваномагнитные и термомагнитные явления. Теплопроводность Поперечные и продольные термомагнитные явления. Жирным шрифтом выделен результат воздействия приложенного тока , электрических и магнитных полей, и градиента температуры. Тонкая стрелка внизу σ– признак возрастания величины. B B Grad T ЕH grad n Grad ΔT Эффект Риги Ледюка Эффект Нернста Эттингсгаузена Поперечные эффекты B B Grad. T σ Эффект Маджи Риги Ледюка Grad T термо. ЭДС Эффект Нернста Эттингсгаузена Продольные эффекты Температурная зависимость теплопроводности для чистых германия, кремния, арсенида галлия, меди и алмаза (типа II). Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
8 Электроника. Основы физики полупроводников Термогальваномагнитные и термомагнитные явления. Теплопроводность Поперечные и продольные термомагнитные явления. Жирным шрифтом выделен результат воздействия приложенного тока , электрических и магнитных полей, и градиента температуры. Тонкая стрелка внизу σ– признак возрастания величины. B B Grad T ЕH grad n Grad ΔT Эффект Риги Ледюка Эффект Нернста Эттингсгаузена Поперечные эффекты B B Grad. T σ Эффект Маджи Риги Ледюка Grad T термо. ЭДС Эффект Нернста Эттингсгаузена Продольные эффекты Температурная зависимость теплопроводности для чистых германия, кремния, арсенида галлия, меди и алмаза (типа II). Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 9 Электроника. Основы физики полупроводников Электропроводность в сильных полях В сильных электрических полях имеет место нарушение закона Ома. Это может происходить по двум причинам. Во первых, в силь ных электрических полях скорость дрейфа носителей заряда ста новится соизмеримой с их тепловой скоростью. Это скажется на процессе рассеяния, что проявляется в изменении времени релак сации, а следовательно, и подвижности, приводящее, в конечном итоге, к явлению «разогрева» электронно дырочного газа и эффекту. Ганна. Во вторых, сильные электрические поля могут вызвать изменение концентрации носителей заряда. При этом рост концентрации носителей заряда может обу словливаться рядом причин. Такими причинами могут являться удар ная ионизация, эффект Зинера (Zener) и электро статическая ионизация Разогрев е газа Эффект Ганна Дж. Ганн, 1963, Ga. As, In. P, f = (0. 2 20)· 1010 Гц F=k*U/L. L=50 300 мкм Зависимость скорости носителей заряда и плотности тока от электрического поля для чистых германия и кремния L=25 мкм, f=4. 5 ГГц, U=16 В, τ =16 нс Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
9 Электроника. Основы физики полупроводников Электропроводность в сильных полях В сильных электрических полях имеет место нарушение закона Ома. Это может происходить по двум причинам. Во первых, в силь ных электрических полях скорость дрейфа носителей заряда ста новится соизмеримой с их тепловой скоростью. Это скажется на процессе рассеяния, что проявляется в изменении времени релак сации, а следовательно, и подвижности, приводящее, в конечном итоге, к явлению «разогрева» электронно дырочного газа и эффекту. Ганна. Во вторых, сильные электрические поля могут вызвать изменение концентрации носителей заряда. При этом рост концентрации носителей заряда может обу словливаться рядом причин. Такими причинами могут являться удар ная ионизация, эффект Зинера (Zener) и электро статическая ионизация Разогрев е газа Эффект Ганна Дж. Ганн, 1963, Ga. As, In. P, f = (0. 2 20)· 1010 Гц F=k*U/L. L=50 300 мкм Зависимость скорости носителей заряда и плотности тока от электрического поля для чистых германия и кремния L=25 мкм, f=4. 5 ГГц, U=16 В, τ =16 нс Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 Электроника. Основы физики полупроводников Электропроводность в сильных полях 2 Туннельный эффект – квантово – механической природы. Переход между зонами идет не по А Б, а через А В И, если расстояние А В – мало. Требует высоких уровней напряженности электрического поля. Ударная ионизация (эффект Зенера) – процесс лавинообразного размножения носителей при превышении напряженности поля некоторого критического значения, достаточного для сообщения носителю заряда энергии, достаточной для генерации электронно дырочной пары при столкновении с атомом. Электростатическая ионизация внешнее электрическое поле понижает потенциальный барьер в направлении, противоположном направлению электрического поля. Уменьшение энергии ионизации донора увеличивает вероятность термического возбуждения согласно статистике Больцмана. Напряженность электрического поля, при которой имеет место заметное возрастание концентрации электронов, обычно составляет 104— 105 В/см. Этот механизм образования свободных носителей заряда проявляется только в том случае, когда концентрация неионизированной донорной примеси значительно превышает концентрацию свободных электронов. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. 10
Электроника. Основы физики полупроводников Электропроводность в сильных полях 2 Туннельный эффект – квантово – механической природы. Переход между зонами идет не по А Б, а через А В И, если расстояние А В – мало. Требует высоких уровней напряженности электрического поля. Ударная ионизация (эффект Зенера) – процесс лавинообразного размножения носителей при превышении напряженности поля некоторого критического значения, достаточного для сообщения носителю заряда энергии, достаточной для генерации электронно дырочной пары при столкновении с атомом. Электростатическая ионизация внешнее электрическое поле понижает потенциальный барьер в направлении, противоположном направлению электрического поля. Уменьшение энергии ионизации донора увеличивает вероятность термического возбуждения согласно статистике Больцмана. Напряженность электрического поля, при которой имеет место заметное возрастание концентрации электронов, обычно составляет 104— 105 В/см. Этот механизм образования свободных носителей заряда проявляется только в том случае, когда концентрация неионизированной донорной примеси значительно превышает концентрацию свободных электронов. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. 10
 Электроника. Основы физики полупроводников Акусто – механические явления Основными факторами, вызывающими акусто механические эффекты, являются пьезоэлектрический эффект, взаимодействие акустической волны с кристаллической решеткой и деформация решетки под действием механических напряжений. В первом случае – появляется электрическое поле, влияющее на поведение носителей заряда, во втором – возникают дополнительные колебания кристаллической решетки (фононы), влияющие на подвижность заряда, а в третьем – тоже меняется концентрация носителей заряда. Из всех явлений данной группы наиболее интересным является эффект поглощения и/или усиления звуковых волн. Усиление и поглощение волн возникает в диапазоне частот свыше 1 10 МГц. Характер взаимодействия определяется соотношением скоростей носителей заряда, равных μЕ, и звуковой волны. Если носители отстают – происходит поглощение, иначе – усиление акустических колебаний. Если же внешнего поля нет, то звуковые упругие волны могут сами захватывать электроны, что приводит к возникновению электрического тока. Для точного описания данных и ранее рассмотренных явлений применяются уравнения электродинамики и механики сплошных сред (гидродинамическое приближение), а в отдельных случаях – уравнения квантовой механики. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. 11
Электроника. Основы физики полупроводников Акусто – механические явления Основными факторами, вызывающими акусто механические эффекты, являются пьезоэлектрический эффект, взаимодействие акустической волны с кристаллической решеткой и деформация решетки под действием механических напряжений. В первом случае – появляется электрическое поле, влияющее на поведение носителей заряда, во втором – возникают дополнительные колебания кристаллической решетки (фононы), влияющие на подвижность заряда, а в третьем – тоже меняется концентрация носителей заряда. Из всех явлений данной группы наиболее интересным является эффект поглощения и/или усиления звуковых волн. Усиление и поглощение волн возникает в диапазоне частот свыше 1 10 МГц. Характер взаимодействия определяется соотношением скоростей носителей заряда, равных μЕ, и звуковой волны. Если носители отстают – происходит поглощение, иначе – усиление акустических колебаний. Если же внешнего поля нет, то звуковые упругие волны могут сами захватывать электроны, что приводит к возникновению электрического тока. Для точного описания данных и ранее рассмотренных явлений применяются уравнения электродинамики и механики сплошных сред (гидродинамическое приближение), а в отдельных случаях – уравнения квантовой механики. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. 11
 Электроника. Основы физики полупроводников 12 Электропроводность в сильных полях 1. По справочным данным определить основные параметры исследуемого стабилитрона. 2. Экспериментально с помощью тестера идентифицировать выводы стабилитрона и убедиться в их соответствии справочным данным. 3. Для полученного по заданию стабилитрона найти его вольтамперные характеристики для прямой и обратной ветви. 4. Аппроксимировать обратную ветвь стабилитрона с помощью кусочно линейной аппроксимации. Оценить величину динамического (дифференциального) сопротивления стабилитрона и его минимальный ток стабилизации. 5. Оценить изменение ВАХ стабилитрона при его работе в условиях повышенной до 70 о. С температуры. Найти величину ТКН стабилитрона. 6. Собрать схему простейшего параметрического стабилизатора, предварительно рассчитав его для случая, когда ток нагрузки меняется от 0 до величины, при которой ток стабилизации близок к минимальному значению, а входное напряжение превышает напряжение стабилизации в 1. 5 … 2 раза. 7. Снять нагрузочные характеристики стабилизатора для случаев, когда входное напряжение превышает напряжение стабилизации соответственно в 1. 2 и 1. 5 раза. 8. По полученным нагрузочным кривым оценить величину максимального тока нагрузки для случая минимальной величины входного напряжения. 9. Снять экспериментально зависимость Uвых(Uвх) при постоянной величине нагрузочного сопротивления для случая, когда при максимальном подаваемом на стабилитрон входном напряжении величина тока нагрузки составляет 50 80% от найденного в предыдущем опыте его максимально возможного значения. 10. Рассчитать коэффициент стабилизации выходного напряжения параметрического стабилизатора по току нагрузки и по входному напряжению. 11. Рассчитать нагрузочную кривую для случая максимального входного напряжения и вид функции Uвых(Uвх) для использованных в предыдущем пункте условий и сравнить полученный результат с экспериментальными данными. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
Электроника. Основы физики полупроводников 12 Электропроводность в сильных полях 1. По справочным данным определить основные параметры исследуемого стабилитрона. 2. Экспериментально с помощью тестера идентифицировать выводы стабилитрона и убедиться в их соответствии справочным данным. 3. Для полученного по заданию стабилитрона найти его вольтамперные характеристики для прямой и обратной ветви. 4. Аппроксимировать обратную ветвь стабилитрона с помощью кусочно линейной аппроксимации. Оценить величину динамического (дифференциального) сопротивления стабилитрона и его минимальный ток стабилизации. 5. Оценить изменение ВАХ стабилитрона при его работе в условиях повышенной до 70 о. С температуры. Найти величину ТКН стабилитрона. 6. Собрать схему простейшего параметрического стабилизатора, предварительно рассчитав его для случая, когда ток нагрузки меняется от 0 до величины, при которой ток стабилизации близок к минимальному значению, а входное напряжение превышает напряжение стабилизации в 1. 5 … 2 раза. 7. Снять нагрузочные характеристики стабилизатора для случаев, когда входное напряжение превышает напряжение стабилизации соответственно в 1. 2 и 1. 5 раза. 8. По полученным нагрузочным кривым оценить величину максимального тока нагрузки для случая минимальной величины входного напряжения. 9. Снять экспериментально зависимость Uвых(Uвх) при постоянной величине нагрузочного сопротивления для случая, когда при максимальном подаваемом на стабилитрон входном напряжении величина тока нагрузки составляет 50 80% от найденного в предыдущем опыте его максимально возможного значения. 10. Рассчитать коэффициент стабилизации выходного напряжения параметрического стабилизатора по току нагрузки и по входному напряжению. 11. Рассчитать нагрузочную кривую для случая максимального входного напряжения и вид функции Uвых(Uвх) для использованных в предыдущем пункте условий и сравнить полученный результат с экспериментальными данными. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 Электроника. Основы физики полупроводников 13 Электрические переходы: классификация Гомогенные переходы контакт двух областей с разными типами проводимости в одном и том же кристалле полупроводника. Различают: • электронно дырочный переход (p n) переход • электронный переход (n+ n или n+ n переход) • дырочно дырочный переход (p+ p или p+ p переход) • p – i – n – переход, аналогичный p n – переходу, но содержащий в области перехода достаточно широкую область с собственной проводимостью. Зоной p n перехода называется область полупроводника, в которой имеет место пространственное изменение типа проводимости от электронной n к дырочной p. Создаются (кроме p i n переходов) путем легирования полупроводника с исходной n или p – проводимостью примесью, создающей противоположный тип проводимости. Если p –n переход получают вплавлением примесей в монокристаллический полупроводник, то переход происходит скачком (резкий, ступенчатый, сплавной, точечный переход). Если используется диффузия примесей, то образуется плавный (диффузионный) переход. Кроме того, переход может быть симметричным и несимметричным. В несимметричных переходах неоднородность концентраций примесей может достигать 103 104. Гетеропереходы – возникают в месте контакта двух различных полупроводников (в многослойных полупроводниковых структурах, называемых еще гетероструктурами) с различной шириной запрещенной зоны. Переходы металл – полупроводник. Приводят к возникновению либо омического контакта, либо барьера Шоттки потенциального барьера в приконтактном слое, равного разности работ выходов металла и полупроводника. Потенциальный барьер создаётся неподвижным пространственным зарядом в полупроводнике, а не за счёт возникновения между металлом и полупроводником промежуточного химического слоя: φк = φм φп. Для возникновения барьера Шоттки в полупроводнике с дырочной проводимостью необходимо, чтобы φм > φp, а для полупроводника с электронной проводимостью – наоборот, чтобы φм < φn. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
Электроника. Основы физики полупроводников 13 Электрические переходы: классификация Гомогенные переходы контакт двух областей с разными типами проводимости в одном и том же кристалле полупроводника. Различают: • электронно дырочный переход (p n) переход • электронный переход (n+ n или n+ n переход) • дырочно дырочный переход (p+ p или p+ p переход) • p – i – n – переход, аналогичный p n – переходу, но содержащий в области перехода достаточно широкую область с собственной проводимостью. Зоной p n перехода называется область полупроводника, в которой имеет место пространственное изменение типа проводимости от электронной n к дырочной p. Создаются (кроме p i n переходов) путем легирования полупроводника с исходной n или p – проводимостью примесью, создающей противоположный тип проводимости. Если p –n переход получают вплавлением примесей в монокристаллический полупроводник, то переход происходит скачком (резкий, ступенчатый, сплавной, точечный переход). Если используется диффузия примесей, то образуется плавный (диффузионный) переход. Кроме того, переход может быть симметричным и несимметричным. В несимметричных переходах неоднородность концентраций примесей может достигать 103 104. Гетеропереходы – возникают в месте контакта двух различных полупроводников (в многослойных полупроводниковых структурах, называемых еще гетероструктурами) с различной шириной запрещенной зоны. Переходы металл – полупроводник. Приводят к возникновению либо омического контакта, либо барьера Шоттки потенциального барьера в приконтактном слое, равного разности работ выходов металла и полупроводника. Потенциальный барьер создаётся неподвижным пространственным зарядом в полупроводнике, а не за счёт возникновения между металлом и полупроводником промежуточного химического слоя: φк = φм φп. Для возникновения барьера Шоттки в полупроводнике с дырочной проводимостью необходимо, чтобы φм > φp, а для полупроводника с электронной проводимостью – наоборот, чтобы φм < φn. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 Электроника. Основы физики полупроводников 14 p n переход Энергетическая диаграмма p — n перехода. a) Состояние равновесия b) При приложенном прямом напряжении c) При приложенном обратном напряжении Область пространственного заряда (ОПЗ) или обедненная область состоит из двух разноимённо заряженных слоёв. Ширина такой области определяется дебаевской длиной (расстояние, на которое распространяется действие электрического поля отдельного заряда в нейтральной электропроводной среде) и составляет 10 4… 10 6 см. Контактная разность потенциалов – возникает в ОПЗ из за электрического поля и определяет высоту потенциального барьера. Ширина ОПЗ зависит от приложенного напряжения. Прямое смещение (плюс – к р области, течет прямой ток) – снижает барьер, и наоборот: обратное смещение и обратный ток Инжекцией называют процесс введения через p n переход основных носителей в область с противоположным типом проводимости, где они будут являться неосновными. В несимметричных переходах область, из которой идет инжекция, имеет большую концентрацию примесей (соответственно, и меньшее удельное сопротивление), называется эмиттером, а слой, в который идет инжекция – базой. Суммарный ток образуется диффузионной и дрейфовой составляющей I=I *(e Uk/φT 1) ВАХ перехода: o Здесь Io – равновесный обратный ток, или ток насыщения, φT – потенциальный барьер, Uk контактная разность потенциалов в переходе, равная φT*ln(Na*Nd/ni 2), где ni 2= npo* ppo = nno* pno – равновесные концентрации собственных, основных и неосновных носителей заряда в соответствующем типе полупроводника Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
Электроника. Основы физики полупроводников 14 p n переход Энергетическая диаграмма p — n перехода. a) Состояние равновесия b) При приложенном прямом напряжении c) При приложенном обратном напряжении Область пространственного заряда (ОПЗ) или обедненная область состоит из двух разноимённо заряженных слоёв. Ширина такой области определяется дебаевской длиной (расстояние, на которое распространяется действие электрического поля отдельного заряда в нейтральной электропроводной среде) и составляет 10 4… 10 6 см. Контактная разность потенциалов – возникает в ОПЗ из за электрического поля и определяет высоту потенциального барьера. Ширина ОПЗ зависит от приложенного напряжения. Прямое смещение (плюс – к р области, течет прямой ток) – снижает барьер, и наоборот: обратное смещение и обратный ток Инжекцией называют процесс введения через p n переход основных носителей в область с противоположным типом проводимости, где они будут являться неосновными. В несимметричных переходах область, из которой идет инжекция, имеет большую концентрацию примесей (соответственно, и меньшее удельное сопротивление), называется эмиттером, а слой, в который идет инжекция – базой. Суммарный ток образуется диффузионной и дрейфовой составляющей I=I *(e Uk/φT 1) ВАХ перехода: o Здесь Io – равновесный обратный ток, или ток насыщения, φT – потенциальный барьер, Uk контактная разность потенциалов в переходе, равная φT*ln(Na*Nd/ni 2), где ni 2= npo* ppo = nno* pno – равновесные концентрации собственных, основных и неосновных носителей заряда в соответствующем типе полупроводника Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 Электроника. Основы физики полупроводников 15 ВАХ p n перехода Суммарный ток образуется диффузионной и дрейфовой составляющей I = I *(e Uk/φT 1) ВАХ перехода: o Здесь Io – равновесный обратный ток, или ток насыщения, φT – потенциальный барьер, Uk контактная разность потенциалов в переходе, равная φT*ln(Na*Nd/ni 2), где ni 2= npo* ppo = nno* pno – равновесные концентрации собственных, основных и неосновных носителей заряда в соответствующем типе полупроводника Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
Электроника. Основы физики полупроводников 15 ВАХ p n перехода Суммарный ток образуется диффузионной и дрейфовой составляющей I = I *(e Uk/φT 1) ВАХ перехода: o Здесь Io – равновесный обратный ток, или ток насыщения, φT – потенциальный барьер, Uk контактная разность потенциалов в переходе, равная φT*ln(Na*Nd/ni 2), где ni 2= npo* ppo = nno* pno – равновесные концентрации собственных, основных и неосновных носителей заряда в соответствующем типе полупроводника Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 Электроника. Основы физики полупроводников Барьер Шоттки (W. Schottky, 1939) Уравнение Ричардсона для тока термогенерации: Jт=АТ 2 e Ф/k. T Условия возникновения барьера: n – тип: ФMe>Фп/п j. Me
Электроника. Основы физики полупроводников Барьер Шоттки (W. Schottky, 1939) Уравнение Ричардсона для тока термогенерации: Jт=АТ 2 e Ф/k. T Условия возникновения барьера: n – тип: ФMe>Фп/п j. Me
 Электроника. Основы физики полупроводников 17 Барьерная емкость электрического перехода С=d. Q/d. U общее определение C=4π о. S/d – емкость плоского конденсатора, где S – его площадь перехода, d – толщина Инжектируемый заряд неравновесных носителей и ширина р п перехода изменяются в зависимости от величины и полярности внешнего напряжения и протекающего через переход тока. Емкость p n перехода складывается из двух составляющих: барьерной , отражающей изменение толщины перехода, и диффузионной (зарядной), отражающей изменение зарядов в базовой области: С = Сбар + Сдиф Барьерная емкость – это емкость закрытого перехода, определяемая его толщиной и вызванная изменением зарядов в обедненной области р п перехода. Толщина равна d=sqrt(2 0 к(nn+pp)/nnpp/q), откуда Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
Электроника. Основы физики полупроводников 17 Барьерная емкость электрического перехода С=d. Q/d. U общее определение C=4π о. S/d – емкость плоского конденсатора, где S – его площадь перехода, d – толщина Инжектируемый заряд неравновесных носителей и ширина р п перехода изменяются в зависимости от величины и полярности внешнего напряжения и протекающего через переход тока. Емкость p n перехода складывается из двух составляющих: барьерной , отражающей изменение толщины перехода, и диффузионной (зарядной), отражающей изменение зарядов в базовой области: С = Сбар + Сдиф Барьерная емкость – это емкость закрытого перехода, определяемая его толщиной и вызванная изменением зарядов в обедненной области р п перехода. Толщина равна d=sqrt(2 0 к(nn+pp)/nnpp/q), откуда Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 Электроника. Основы физики полупроводников Диффузионная емкость электрического перехода Диффузионная емкость преобладает при прямом включении и связана с процессами накопления и рассасывания неравновесного заряда в базе. Она характеризует инерционность движения неравновесных зарядов в области базы. Диффузионная ёмкость обусловлена тем, что увеличение напряжения на p—n переходе приводит к увеличению концентрации основных и неосновных носителей, то есть к изменению заряда. На рисунке показаны распределения дырок, инжектированных при двух разных напряжениях, подтверждающие наличие диффузионной емкости, которая дляприведенного примера может быть рассчитана как Cдиф = ΔQp/ΔU, где ΔU = U 2 U 1 , Δpn(0) = pn 0(e. U/UT – 1) Cдиф = J τ/UT: диффузионная емкость зависит от величины прямого тока через p n переход и времени жизни носителей заряда, которая определяет глубину проникновения носителей заряда в соседнюю область: чем больше время жизни инжектированных носителей заряда, тем на большую глубину они проникают, и тем больше величина инжектированного заряда. При подаче прямого смещения значение диффузионной ёмкости может достигать десятков тысяч пикофарад. Диффузионная емкость значительно больше барьерной, но использовать ее для практических целей нельзя, так как она зашунтирована малым сопротивлением прямосмещенного p n перехода. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. 18
Электроника. Основы физики полупроводников Диффузионная емкость электрического перехода Диффузионная емкость преобладает при прямом включении и связана с процессами накопления и рассасывания неравновесного заряда в базе. Она характеризует инерционность движения неравновесных зарядов в области базы. Диффузионная ёмкость обусловлена тем, что увеличение напряжения на p—n переходе приводит к увеличению концентрации основных и неосновных носителей, то есть к изменению заряда. На рисунке показаны распределения дырок, инжектированных при двух разных напряжениях, подтверждающие наличие диффузионной емкости, которая дляприведенного примера может быть рассчитана как Cдиф = ΔQp/ΔU, где ΔU = U 2 U 1 , Δpn(0) = pn 0(e. U/UT – 1) Cдиф = J τ/UT: диффузионная емкость зависит от величины прямого тока через p n переход и времени жизни носителей заряда, которая определяет глубину проникновения носителей заряда в соседнюю область: чем больше время жизни инжектированных носителей заряда, тем на большую глубину они проникают, и тем больше величина инжектированного заряда. При подаче прямого смещения значение диффузионной ёмкости может достигать десятков тысяч пикофарад. Диффузионная емкость значительно больше барьерной, но использовать ее для практических целей нельзя, так как она зашунтирована малым сопротивлением прямосмещенного p n перехода. Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. 18
 19 Электроника. Основы физики полупроводников Частотные свойства p n перехода То, что в формулу для диффузионной емкости входит время жизни инжектированных носителей, свидетельствует о том, что диффузионная емкость имеет частотную зависимость, Действительно на частотах, для которых период меньше времени жизни, носители не будут успевать проникать вглубь материала, и, соответственно, диффузионная емкость будет падать. На рисунке приведен график, характеризующий частотную зависимость емкости p n перехода, включенного в прямом направлении. Как видно из графика, частотная зависимость емкости перехода определяется частотной зависимостью двух составляющих диффузионной и барьерной. Частотная зависимость барьерной емкости проявляется на частотах значительно более высоких по сравнению с диффузионной. То, какая из емкостей больше, зависит от технологических параметров диода (значений времен жизни) и величины прямого тока. Уменьшение с частотой глубины проникновения носителей заряда формально можно описать, введя частотно зависимую диффузионную длину: Lp(ω)=Lp/(1+i ωτp) где Lp рассмотренное ранее низкочастотное значение диффузионной длины. Соответственно для модуля Lp(ω) можно записать: Формулы для Lp(ω) позволяют получить частотно зависимые решения для зависимости протекающего через p n переход тока от частоты, произведя в решении, полученном на основе решения уравнения непрерывности, замену величин Lp, Ln на величины Lp(ω), Ln(ω). Зависимость емкости включенного в прямом направлении p n перехода от частоты: 1 общая емкость, 2 диффузионная емкость, 3 барьерная емкость Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
19 Электроника. Основы физики полупроводников Частотные свойства p n перехода То, что в формулу для диффузионной емкости входит время жизни инжектированных носителей, свидетельствует о том, что диффузионная емкость имеет частотную зависимость, Действительно на частотах, для которых период меньше времени жизни, носители не будут успевать проникать вглубь материала, и, соответственно, диффузионная емкость будет падать. На рисунке приведен график, характеризующий частотную зависимость емкости p n перехода, включенного в прямом направлении. Как видно из графика, частотная зависимость емкости перехода определяется частотной зависимостью двух составляющих диффузионной и барьерной. Частотная зависимость барьерной емкости проявляется на частотах значительно более высоких по сравнению с диффузионной. То, какая из емкостей больше, зависит от технологических параметров диода (значений времен жизни) и величины прямого тока. Уменьшение с частотой глубины проникновения носителей заряда формально можно описать, введя частотно зависимую диффузионную длину: Lp(ω)=Lp/(1+i ωτp) где Lp рассмотренное ранее низкочастотное значение диффузионной длины. Соответственно для модуля Lp(ω) можно записать: Формулы для Lp(ω) позволяют получить частотно зависимые решения для зависимости протекающего через p n переход тока от частоты, произведя в решении, полученном на основе решения уравнения непрерывности, замену величин Lp, Ln на величины Lp(ω), Ln(ω). Зависимость емкости включенного в прямом направлении p n перехода от частоты: 1 общая емкость, 2 диффузионная емкость, 3 барьерная емкость Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
 Электроника. Основы физики полупроводников Пробой электрического перехода Пробой p n перехода— явление резкого увеличения обратного тока при достижении обратным напряжением некоторого критического для данного перехода значения. Туннельный пробой электрический пробой перехода, вызванный квантовомеханическим туннелированием носителей заряда сквозь запрещённую зону полупроводника без изменения их энергии. Условия для туннелирования возникают только при определённой напряжённости электрического поля или при определённой напряженности поля на р n переходе. Ее значение составляет около 8∙ 10 5 В/см для кремниевых переходов и 3∙ 10 5 В/см — для германиевых. Лавинный пробой (ударная ионизация) наиболее важный механизмом пробоя p—n перехода. Напряжение лавинного пробоя определяет верхний предел обратного напряжения большинства диодов. Пробой связан с образованием лавины носителей заряда под действием сильного электрического поля, при котором носители приобретают энергии, достаточные для образования новых электронно дырочных пар в результате ударной ионизации атомов полупроводника. Поверхостный пробой (ток утечки) – обусловлен влиянием поверхностных зарядов и диэлектрических свойств среды или покрытия на форму потенциального барьера и на условия возникновения ударной ионизации. Реальные p n переходы имеют участки, выходящие на поверхность полупроводника. Вследствие возможного загрязнения и наличия поверхостных зарядов между p и n областями могут образовываться проводящие пленки и проводящие каналы, по которым идет ток утечки I ут. Этот ток увеличивается с ростом обратного напряжения и может превысить тепловой ток I 0 и ток генерации I ген. Ток Iут слабо зависит от температуры. Для уменьшения Iут применяют защитные пленочные покрытия. Тепловой пробой — это пробой, развитие которого обусловлено выделением в электрическом переходе тепла вследствие прохождения тока через переход. При подаче обратного напряжения практически всё оно падает на p — n переходе, через который идёт, хотя и небольшой, обратный ток. Действительно, Р пр=1 А*0, 5 В=0, 5 Вт, а Робр=10 4 А*100 В=10 2 Вт! Выделяющаяся мощность вызывает разогрев p n перехода в узкой обедненной области и при недостаточном теплоотводе вызывает дальнейшее увеличение тока, что приводит к лавинообразному пробою. Тепловой пробой – это необратимый процесс, обусловленный саморазогревом зоны р п перехода обратным током. Имеет участок ВАХ с отрицательным сопротивлением. Необратимость теплового пробоя существенно отличает его от остальных, ранее рассмотренных типов пробоя Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. 20
Электроника. Основы физики полупроводников Пробой электрического перехода Пробой p n перехода— явление резкого увеличения обратного тока при достижении обратным напряжением некоторого критического для данного перехода значения. Туннельный пробой электрический пробой перехода, вызванный квантовомеханическим туннелированием носителей заряда сквозь запрещённую зону полупроводника без изменения их энергии. Условия для туннелирования возникают только при определённой напряжённости электрического поля или при определённой напряженности поля на р n переходе. Ее значение составляет около 8∙ 10 5 В/см для кремниевых переходов и 3∙ 10 5 В/см — для германиевых. Лавинный пробой (ударная ионизация) наиболее важный механизмом пробоя p—n перехода. Напряжение лавинного пробоя определяет верхний предел обратного напряжения большинства диодов. Пробой связан с образованием лавины носителей заряда под действием сильного электрического поля, при котором носители приобретают энергии, достаточные для образования новых электронно дырочных пар в результате ударной ионизации атомов полупроводника. Поверхостный пробой (ток утечки) – обусловлен влиянием поверхностных зарядов и диэлектрических свойств среды или покрытия на форму потенциального барьера и на условия возникновения ударной ионизации. Реальные p n переходы имеют участки, выходящие на поверхность полупроводника. Вследствие возможного загрязнения и наличия поверхостных зарядов между p и n областями могут образовываться проводящие пленки и проводящие каналы, по которым идет ток утечки I ут. Этот ток увеличивается с ростом обратного напряжения и может превысить тепловой ток I 0 и ток генерации I ген. Ток Iут слабо зависит от температуры. Для уменьшения Iут применяют защитные пленочные покрытия. Тепловой пробой — это пробой, развитие которого обусловлено выделением в электрическом переходе тепла вследствие прохождения тока через переход. При подаче обратного напряжения практически всё оно падает на p — n переходе, через который идёт, хотя и небольшой, обратный ток. Действительно, Р пр=1 А*0, 5 В=0, 5 Вт, а Робр=10 4 А*100 В=10 2 Вт! Выделяющаяся мощность вызывает разогрев p n перехода в узкой обедненной области и при недостаточном теплоотводе вызывает дальнейшее увеличение тока, что приводит к лавинообразному пробою. Тепловой пробой – это необратимый процесс, обусловленный саморазогревом зоны р п перехода обратным током. Имеет участок ВАХ с отрицательным сопротивлением. Необратимость теплового пробоя существенно отличает его от остальных, ранее рассмотренных типов пробоя Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника. 20
 21 Электроника. Основы физики полупроводников Модели p n перехода (эквивалентные схемы замещения) Упрощенная модель: r – динамическое сопротивление базы (возрастающий участок прямой ветви) Ra – динамическое сопротивление утечек на поверхности перехода (наклон обратной ветви) Cб – барьерная емкость CД – диффузионная емкость. а) идеализированная; б) Эберса—Молла; в) кусочно линейная; г) линеаризованная ВАХ диода; д) Лиувилла; е) — Бьюфэу—Спаркса Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.
21 Электроника. Основы физики полупроводников Модели p n перехода (эквивалентные схемы замещения) Упрощенная модель: r – динамическое сопротивление базы (возрастающий участок прямой ветви) Ra – динамическое сопротивление утечек на поверхности перехода (наклон обратной ветви) Cб – барьерная емкость CД – диффузионная емкость. а) идеализированная; б) Эберса—Молла; в) кусочно линейная; г) линеаризованная ВАХ диода; д) Лиувилла; е) — Бьюфэу—Спаркса Алт. ГТУ. ВСИБ. Якунин А. Г. Электротехника и электроника. Часть 2. Электроника.


