През курса Электронная микроскопия.ppt
- Количество слайдов: 103
 Электронная микроскопия Курск 2014
Электронная микроскопия Курск 2014
 2 Цель курса: формирование * представлений о физике, технике и возможностях электронномикроскопического анализа; * практических навыков работы с аппаратурой и анализа электронномикроскопических изображений. Задачи дисциплины: * ознакомление основными методами растровой и просвечивающей электронной микроскопии, устройством и принципом работы микроскопов; * обучение теории формирования изображения электронно-оптической системой; * обучение физике взаимодействия электронов с твердым телом; * формирование навыков работы на растровом и просвечивающем электронных микроскопах.
2 Цель курса: формирование * представлений о физике, технике и возможностях электронномикроскопического анализа; * практических навыков работы с аппаратурой и анализа электронномикроскопических изображений. Задачи дисциплины: * ознакомление основными методами растровой и просвечивающей электронной микроскопии, устройством и принципом работы микроскопов; * обучение теории формирования изображения электронно-оптической системой; * обучение физике взаимодействия электронов с твердым телом; * формирование навыков работы на растровом и просвечивающем электронных микроскопах.
 ЛЕКЦИЯ № 1 История развития и возможности электронной микроскопии. Область применения. Сущность физических основ электронной микроскопии. Электронная микроскопия – универсальный инструмент исследования тонкой структуры материала Разрешающая способность – как основная характеристика микроскопии Для оптического микроскопа
ЛЕКЦИЯ № 1 История развития и возможности электронной микроскопии. Область применения. Сущность физических основ электронной микроскопии. Электронная микроскопия – универсальный инструмент исследования тонкой структуры материала Разрешающая способность – как основная характеристика микроскопии Для оптического микроскопа
 2 Электронный микроскоп Ускоряющее напряжение, к. В Длина волны, λ, пм (10 -12 м) Скорость, (108 м/с) 100 3. 7 1. 644 120 3. 35 1. 759 200 2. 51 2. 086 300 1. 97 2. 330 400 1. 64 2. 484 1000 0. 87 2. 823
2 Электронный микроскоп Ускоряющее напряжение, к. В Длина волны, λ, пм (10 -12 м) Скорость, (108 м/с) 100 3. 7 1. 644 120 3. 35 1. 759 200 2. 51 2. 086 300 1. 97 2. 330 400 1. 64 2. 484 1000 0. 87 2. 823
 История создания • 1927 г. Дэвиссон и Джермер (дифракция электронов) • 1926 -27 гг. Буш (фокусировка электронных пучков) • 1898 г. Штарк (взаимодействие ускоренных электронов с мет. фольгами и изм. токов утечки ) 1932 г. Нем. физики М. Кнолль и Э. Руск Первый просвечивающий электронный микроскоп (ПЭМ), увеличение ~ 17 раз. Первое серийное производство немецкой компанией Siemens, под маркой Elmiskop. Ускоряющее напряжение 80 к. В Разрешение 10 нм. 1935 г. М. Кнолль Растровый эл. микроскоп 3
История создания • 1927 г. Дэвиссон и Джермер (дифракция электронов) • 1926 -27 гг. Буш (фокусировка электронных пучков) • 1898 г. Штарк (взаимодействие ускоренных электронов с мет. фольгами и изм. токов утечки ) 1932 г. Нем. физики М. Кнолль и Э. Руск Первый просвечивающий электронный микроскоп (ПЭМ), увеличение ~ 17 раз. Первое серийное производство немецкой компанией Siemens, под маркой Elmiskop. Ускоряющее напряжение 80 к. В Разрешение 10 нм. 1935 г. М. Кнолль Растровый эл. микроскоп 3
 Виды генерации процессов в массивном образце 3
Виды генерации процессов в массивном образце 3
 Виды генерации процессов в тонком образце 4
Виды генерации процессов в тонком образце 4
 5 Виды получаемой информации
5 Виды получаемой информации
 Тормозное (сплошное) рентгеновское излучение 6
Тормозное (сплошное) рентгеновское излучение 6
 Характеристическое рентгеновское излучение 7
Характеристическое рентгеновское излучение 7
 Генерация оже-электронов 8
Генерация оже-электронов 8
 Пространственное разрешение 9
Пространственное разрешение 9
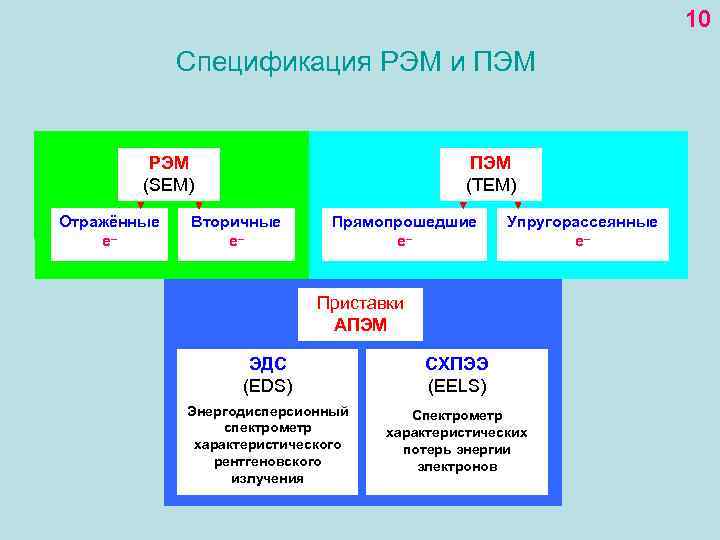 10 Спецификация РЭМ и ПЭМ РЭМ (SEM) Отражённые е– ПЭМ Вторичные е– Прямопрошедшие е– ПЭМ (ТEM) Прямопрошедшие е– Упругорассеянные е– Приставки АПЭМ ЭДС (EDS) СХПЭЭ (EЕLS) Энергодисперсионный спектрометр характеристического рентгеновского излучения Спектрометр характеристических потерь энергии электронов
10 Спецификация РЭМ и ПЭМ РЭМ (SEM) Отражённые е– ПЭМ Вторичные е– Прямопрошедшие е– ПЭМ (ТEM) Прямопрошедшие е– Упругорассеянные е– Приставки АПЭМ ЭДС (EDS) СХПЭЭ (EЕLS) Энергодисперсионный спектрометр характеристического рентгеновского излучения Спектрометр характеристических потерь энергии электронов
 Описание процессов рассеяния е– Сечение рассеяния Длина свободного пробега Несколько процессов рассеяния Барн 11
Описание процессов рассеяния е– Сечение рассеяния Длина свободного пробега Несколько процессов рассеяния Барн 11
 рассеяние упругое неупругое Средняя длина свободного пробега е– при упр. расс. (нм) 12
рассеяние упругое неупругое Средняя длина свободного пробега е– при упр. расс. (нм) 12
 Механизмы потери энергии е– 13 1. Возбуждение фононов (кристал. решётки); 2. Возбуждение е– с внешних оболочек атомов и е– проводимости (эмиссия вторичных е– ); 3. Возбуждение е– с внутренних оболочек атомов (эмиссия ХРИ или оже- е– ); 4. Тормозное рентгеновское излучение (непрерывное); 5. Возбуждение плазмонов (плазменные колеб. е– газа). Учёт всех механизмов рассеяния е– Скорость потери энергии е– по Бете
Механизмы потери энергии е– 13 1. Возбуждение фононов (кристал. решётки); 2. Возбуждение е– с внешних оболочек атомов и е– проводимости (эмиссия вторичных е– ); 3. Возбуждение е– с внутренних оболочек атомов (эмиссия ХРИ или оже- е– ); 4. Тормозное рентгеновское излучение (непрерывное); 5. Возбуждение плазмонов (плазменные колеб. е– газа). Учёт всех механизмов рассеяния е– Скорость потери энергии е– по Бете
 14 Средний потенциал ионизации атома (Блох) Применяется при Е > 3 кэ. В Длина пробега е– (по Бете) по ломаной линии Глубина проникновения е– (Эмп. формулы Поттса) Ширина области возбуждения
14 Средний потенциал ионизации атома (Блох) Применяется при Е > 3 кэ. В Длина пробега е– (по Бете) по ломаной линии Глубина проникновения е– (Эмп. формулы Поттса) Ширина области возбуждения
 15 Длины пробега е– в веществах (мкм)
15 Длины пробега е– в веществах (мкм)
 Вторичная электронная эмиссия (ВЭЭ) 16 ВЭЭ - 1902 г. Л. Остин, Г. Штарке Движение к поверхности и выход упруго, неупруго рассеянных и истинно вторичных е– Спектр энергий вторичных е– Истинно вторичные е– Неупругоотражённые е– 50 э. В Е 0 – энергия первичных е– ( 0. 1 – 1 кэ. В)
Вторичная электронная эмиссия (ВЭЭ) 16 ВЭЭ - 1902 г. Л. Остин, Г. Штарке Движение к поверхности и выход упруго, неупруго рассеянных и истинно вторичных е– Спектр энергий вторичных е– Истинно вторичные е– Неупругоотражённые е– 50 э. В Е 0 – энергия первичных е– ( 0. 1 – 1 кэ. В)
 Коэффициент истинно вторичной электронной эмиссии Вклад обратноотражённых е– в генерацию вторичных е– 17
Коэффициент истинно вторичной электронной эмиссии Вклад обратноотражённых е– в генерацию вторичных е– 17
 18 Отражённые е– имеют меньшую энергию чем первичные о. э. / o ~ 3 Отражённые е– имеют больший путь в приповерхностном слое Отражённые е– могут выбивать вторичные е– со стенок раб. камеры Зависимость вероятности выхода истинно вторичных (медленных) е– с глубины z
18 Отражённые е– имеют меньшую энергию чем первичные о. э. / o ~ 3 Отражённые е– имеют больший путь в приповерхностном слое Отражённые е– могут выбивать вторичные е– со стенок раб. камеры Зависимость вероятности выхода истинно вторичных (медленных) е– с глубины z
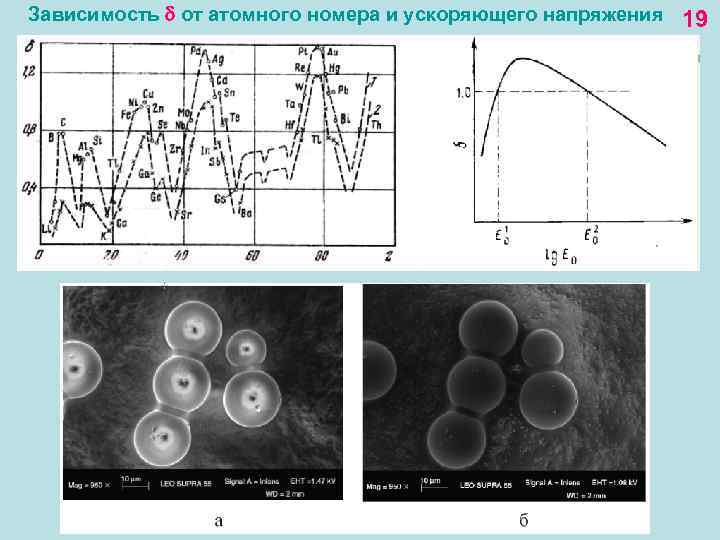 Зависимость от атомного номера и ускоряющего напряжения 19
Зависимость от атомного номера и ускоряющего напряжения 19
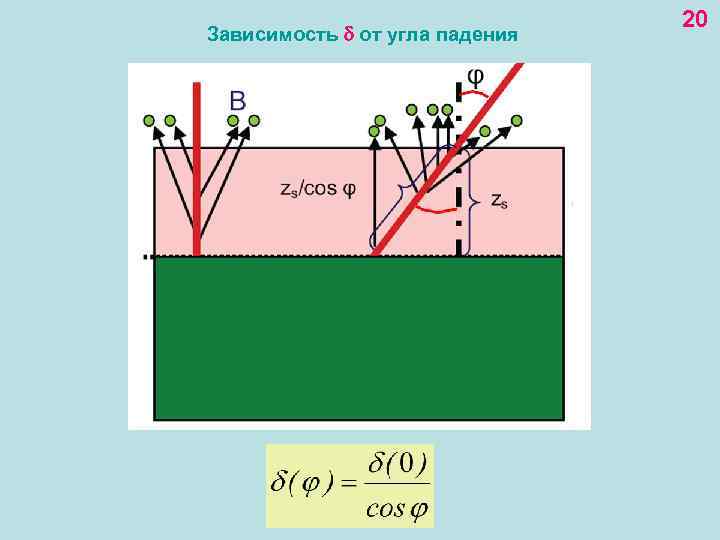 Зависимость от угла падения 20
Зависимость от угла падения 20
 Усиление эмиссии на краях структуры (Кантен-эффект) 21
Усиление эмиссии на краях структуры (Кантен-эффект) 21
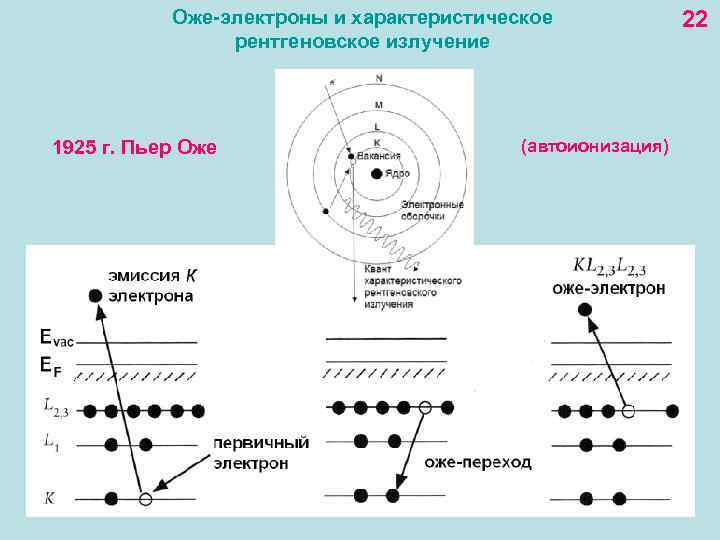 Оже-электроны и характеристическое рентгеновское излучение 1925 г. Пьер Оже (автоионизация) 22
Оже-электроны и характеристическое рентгеновское излучение 1925 г. Пьер Оже (автоионизация) 22
 23 Явление контаминации – появление углеродосодержащей плёнки под действием вторичных е– ПЭМ РЭМ Длина пробега е– в образце (Канае-Окаяма)
23 Явление контаминации – появление углеродосодержащей плёнки под действием вторичных е– ПЭМ РЭМ Длина пробега е– в образце (Канае-Окаяма)
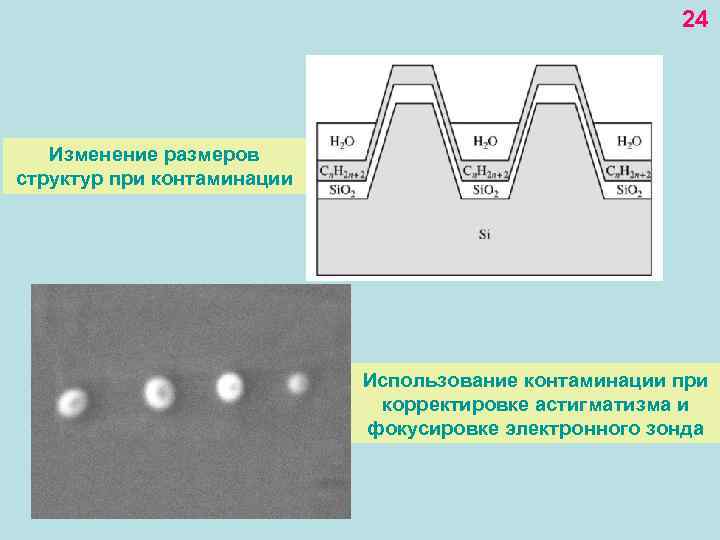 24 Изменение размеров структур при контаминации Использование контаминации при корректировке астигматизма и фокусировке электронного зонда
24 Изменение размеров структур при контаминации Использование контаминации при корректировке астигматизма и фокусировке электронного зонда
 Явление нагрева мишени е– - зондом Повышение температуры для ускоряющего напряжения 15 к. В 25
Явление нагрева мишени е– - зондом Повышение температуры для ускоряющего напряжения 15 к. В 25
 26
26
 27
27
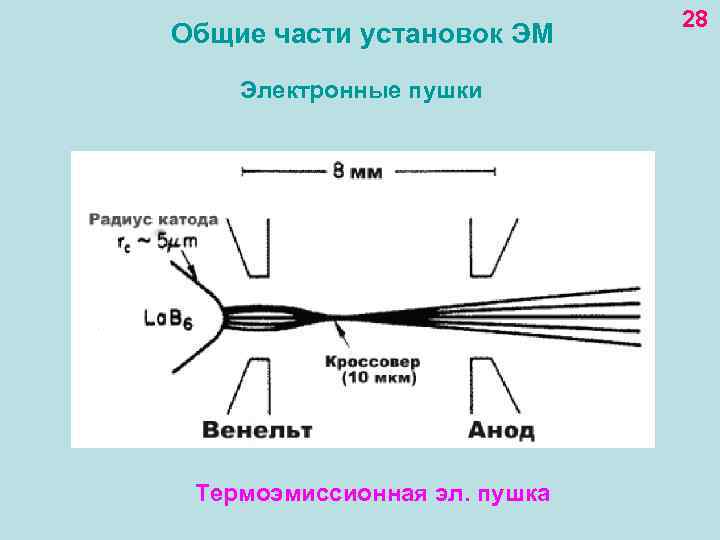 Общие части установок ЭМ Электронные пушки Термоэмиссионная эл. пушка 28
Общие части установок ЭМ Электронные пушки Термоэмиссионная эл. пушка 28
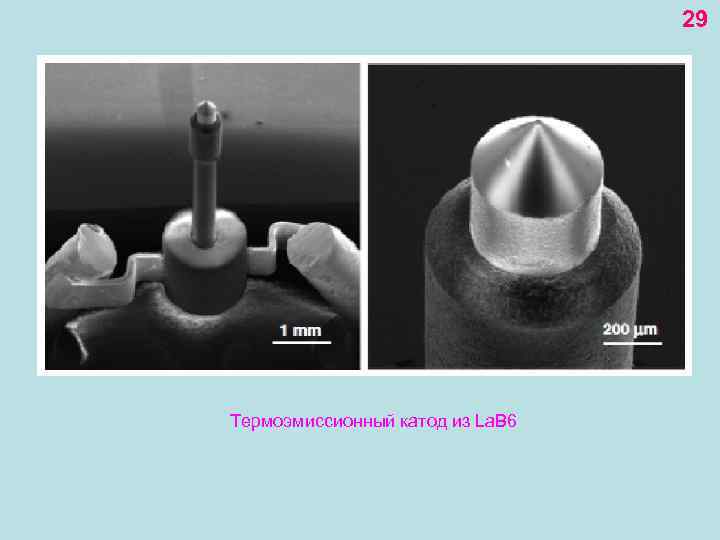 29 Термоэмиссионный катод из La. B 6
29 Термоэмиссионный катод из La. B 6
 30 Автоэмиссионная эл. пушка
30 Автоэмиссионная эл. пушка
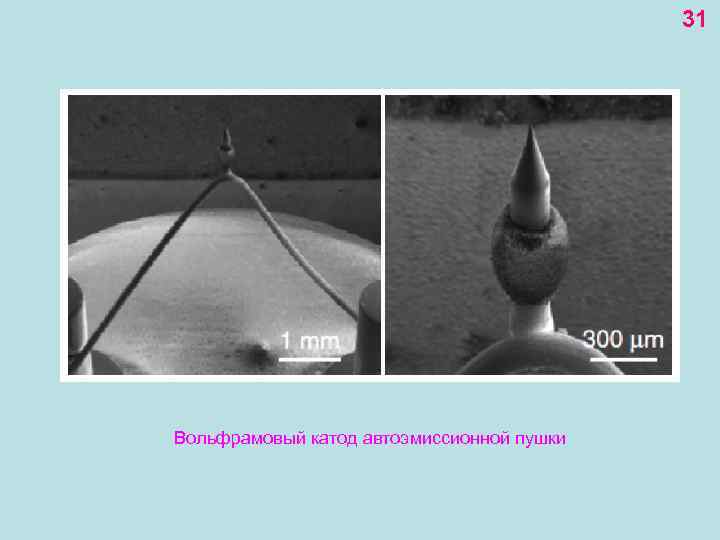 31 Вольфрамовый катод автоэмиссионной пушки
31 Вольфрамовый катод автоэмиссионной пушки
 Сравнительная характеристика катодов Характеристики катодов: Стабильность, Яркость, Интенсивность, Монохроматичность 32
Сравнительная характеристика катодов Характеристики катодов: Стабильность, Яркость, Интенсивность, Монохроматичность 32
 Схем. изображение термоэлектронной пушки 33
Схем. изображение термоэлектронной пушки 33
 34 Диаметр кроссовера Напряжение смещения (на Венельте)
34 Диаметр кроссовера Напряжение смещения (на Венельте)
 35 Яркость пучка е– термокатода Временная когерентность Длина когерентности пучка е– ~ 100 нм Пространственная когерентность Критический размер области эмиссии е– ~ 1 нм
35 Яркость пучка е– термокатода Временная когерентность Длина когерентности пучка е– ~ 100 нм Пространственная когерентность Критический размер области эмиссии е– ~ 1 нм
 Электромагнитные линзы 36
Электромагнитные линзы 36
 Траектории электронов в ЭМ-линзах 37
Траектории электронов в ЭМ-линзах 37

 38 Управление током в конденсорной линзе (Размер пятна - Spot Size) Измерение тока цилиндром Фарадея
38 Управление током в конденсорной линзе (Размер пятна - Spot Size) Измерение тока цилиндром Фарадея
 Аберации электромагнитных линз 1) Сферическая аберрация Плоскость Гаусса f ~ Cs Коэфф. сфер. аберрации 39
Аберации электромагнитных линз 1) Сферическая аберрация Плоскость Гаусса f ~ Cs Коэфф. сфер. аберрации 39
 40 2) Хроматическая аберрация ΔЕ ~ 25 э. В для ПЭМ Коэфф. хром. аберр.
40 2) Хроматическая аберрация ΔЕ ~ 25 э. В для ПЭМ Коэфф. хром. аберр.
 3) Дифракционная аберрация 41
3) Дифракционная аберрация 41
 42 Угол обзора апертуры линзы на оптимальной дистанции Совокупное влияние аберраций
42 Угол обзора апертуры линзы на оптимальной дистанции Совокупное влияние аберраций
 4) Астигматизм 43
4) Астигматизм 43
 Стигматор 44
Стигматор 44
 Вакуумная система Ионные насосы Турбомолекулярные Форвакуумные
Вакуумная система Ионные насосы Турбомолекулярные Форвакуумные
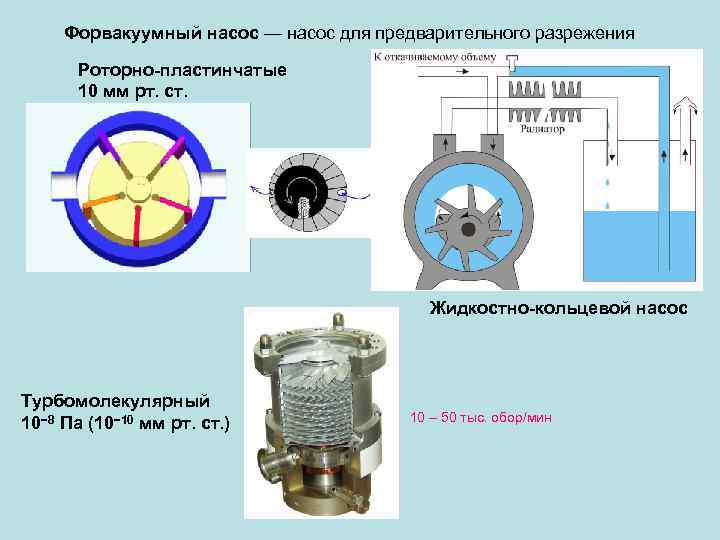 Форвакуумный насос — насос для предварительного разрежения Роторно-пластинчатые 10 мм рт. ст. Жидкостно-кольцевой насос Турбомолекулярный 10− 8 Па (10− 10 мм рт. ст. ) 10 – 50 тыс. обор/мин
Форвакуумный насос — насос для предварительного разрежения Роторно-пластинчатые 10 мм рт. ст. Жидкостно-кольцевой насос Турбомолекулярный 10− 8 Па (10− 10 мм рт. ст. ) 10 – 50 тыс. обор/мин
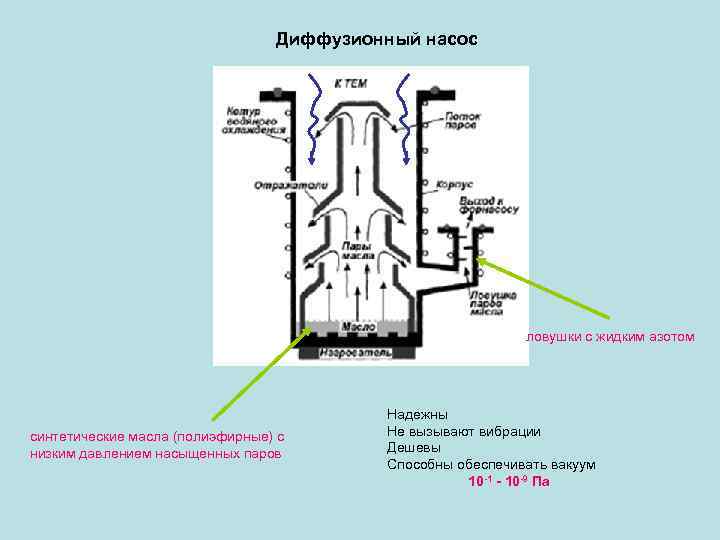 Диффузионный насос ловушки с жидким азотом синтетические масла (полиэфирные) с низким давлением насыщенных паров Надежны Не вызывают вибрации Дешевы Способны обеспечивать вакуум 10 -1 - 10 -9 Па
Диффузионный насос ловушки с жидким азотом синтетические масла (полиэфирные) с низким давлением насыщенных паров Надежны Не вызывают вибрации Дешевы Способны обеспечивать вакуум 10 -1 - 10 -9 Па
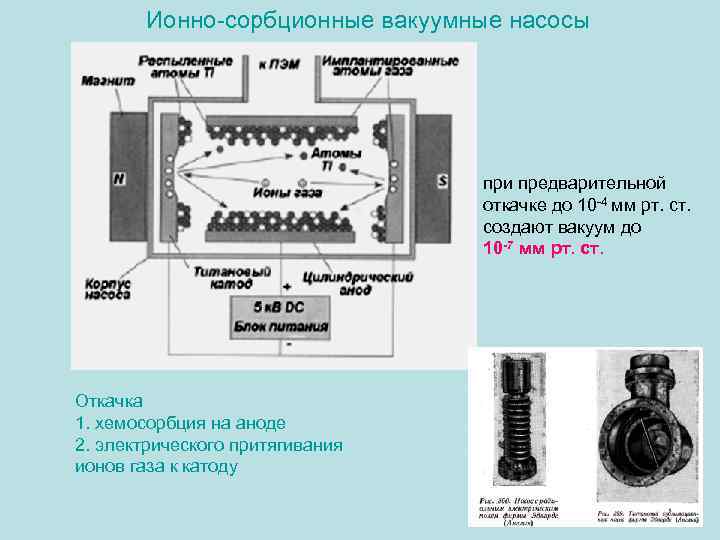 Ионно-сорбционные вакуумные насосы при предварительной откачке до 10 -4 мм рт. создают вакуум до 10 -7 мм рт. ст. Откачка 1. хемосорбция на аноде 2. электрического притягивания ионов газа к катоду
Ионно-сорбционные вакуумные насосы при предварительной откачке до 10 -4 мм рт. создают вакуум до 10 -7 мм рт. ст. Откачка 1. хемосорбция на аноде 2. электрического притягивания ионов газа к катоду
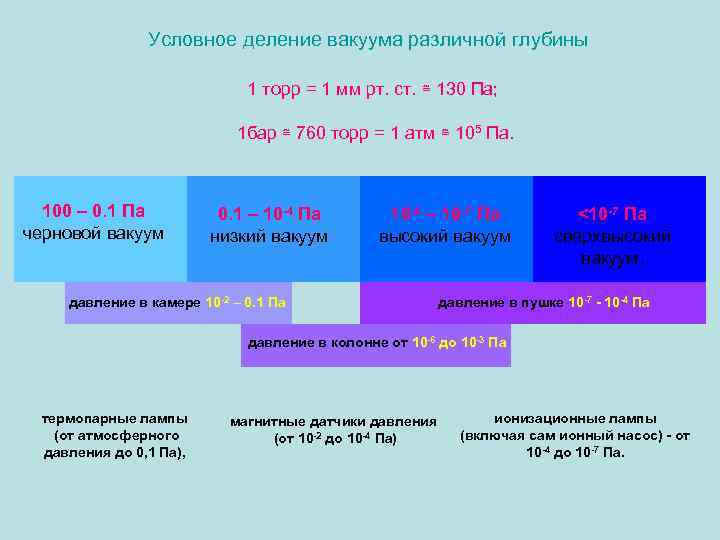 Условное деление вакуума различной глубины 1 торр = 1 мм рт. ст. ≅ 130 Па; 1 бар ≅ 760 торр = 1 атм ≅ 105 Па. 100 – 0. 1 Па черновой вакуум 0. 1 – 10 -4 Па низкий вакуум 10 -4 – 10 -7 Па высокий вакуум давление в камере 10 -2 – 0. 1 Па <10 -7 Па сверхвысокий вакуум. давление в пушке 10 -7 - 10 -4 Па давление в колонне от 10 -6 до 10 -3 Па термопарные лампы (от атмосферного давления до 0, 1 Па), магнитные датчики давления (от 10 -2 до 10 -4 Па) ионизационные лампы (включая сам ионный насос) - от 10 -4 до 10 -7 Па.
Условное деление вакуума различной глубины 1 торр = 1 мм рт. ст. ≅ 130 Па; 1 бар ≅ 760 торр = 1 атм ≅ 105 Па. 100 – 0. 1 Па черновой вакуум 0. 1 – 10 -4 Па низкий вакуум 10 -4 – 10 -7 Па высокий вакуум давление в камере 10 -2 – 0. 1 Па <10 -7 Па сверхвысокий вакуум. давление в пушке 10 -7 - 10 -4 Па давление в колонне от 10 -6 до 10 -3 Па термопарные лампы (от атмосферного давления до 0, 1 Па), магнитные датчики давления (от 10 -2 до 10 -4 Па) ионизационные лампы (включая сам ионный насос) - от 10 -4 до 10 -7 Па.
 Держатели образцов (гониометры) S- Положение образца (2 позиции) 1 - Драйвер X-сдвига. 2 -Драйвер Z- сдвига. 3 -Драйвер Y-сдвига (не виден). 4 - Драйвер эвцентрического наклона Θ. 5 -Драйвер угла наклона Φ или вращения ε. 6 -Смена образцов. 7 -Подшипники для эвцентрического наклона. 8 -Механическая центровка эвцентрической оси. 9 -Механическая центровка контр-подшипников. 10 -Объектные линзы. 11 -Колонна
Держатели образцов (гониометры) S- Положение образца (2 позиции) 1 - Драйвер X-сдвига. 2 -Драйвер Z- сдвига. 3 -Драйвер Y-сдвига (не виден). 4 - Драйвер эвцентрического наклона Θ. 5 -Драйвер угла наклона Φ или вращения ε. 6 -Смена образцов. 7 -Подшипники для эвцентрического наклона. 8 -Механическая центровка эвцентрической оси. 9 -Механическая центровка контр-подшипников. 10 -Объектные линзы. 11 -Колонна
 Гониометр верхней загрузки Держатели боковой загрузки: ротационный, с нагреванием, с охлаждением, с двойным вращением
Гониометр верхней загрузки Держатели боковой загрузки: ротационный, с нагреванием, с охлаждением, с двойным вращением
 Система регистрации изображения ОБЫЧНЫЙ РЕЖИМ (ПЭМ): Люминесцентный экран покрыт зернами Zn. S от 10 до 50 мкм (450 нм, примеси - 550 нм) СКАНИРУЮЩИЙ РЕЖИМ (СПЭМ, АПЭМ, СЭМ): 2 типа детекторов: 1. Полупроводниковый детектор (пластина n-Si, с p-n переходом) 2. Система сцинтиллятор-фотоумножитель (сцинтилляторы легированные церием (Се) кристаллы иттрий-алюминиевого граната (ИАГ или YAG) ) Цифровые камеры
Система регистрации изображения ОБЫЧНЫЙ РЕЖИМ (ПЭМ): Люминесцентный экран покрыт зернами Zn. S от 10 до 50 мкм (450 нм, примеси - 550 нм) СКАНИРУЮЩИЙ РЕЖИМ (СПЭМ, АПЭМ, СЭМ): 2 типа детекторов: 1. Полупроводниковый детектор (пластина n-Si, с p-n переходом) 2. Система сцинтиллятор-фотоумножитель (сцинтилляторы легированные церием (Се) кристаллы иттрий-алюминиевого граната (ИАГ или YAG) ) Цифровые камеры
 Растровая электронная микроскопия Первые коммерческие РЭМ: ≪Стереоскан≫, Cambridge Instruments, 1965 г. JSM-1 компании JEOL, 1966 г.
Растровая электронная микроскопия Первые коммерческие РЭМ: ≪Стереоскан≫, Cambridge Instruments, 1965 г. JSM-1 компании JEOL, 1966 г.
 Низковакуумная модель РЭМ JSM-6610 LV, JEOL (Япония)
Низковакуумная модель РЭМ JSM-6610 LV, JEOL (Япония)
 ТИПИЧНЫЕ ЗАДАЧИ РЭМ: – проведение измерений геометрических параметров нанообъектов; – определение локального элементного состава, построение элементных карт (электронно-зондовый рентгеновский микроанализ, оже-спектроскопия); – определение границ кристаллических зерен (анализ картин дифракции обратнорассеянных электронов); – исследование зонной структуры и состава полупроводников (катодолюминесценция). ХАРАКТЕРИСТИКИ РЭМ: Разрешение определяется: диаметром электронного зонда; ускоряющим напряжением; током пучка; скоростью развертки (соотношение сигнал-шум).
ТИПИЧНЫЕ ЗАДАЧИ РЭМ: – проведение измерений геометрических параметров нанообъектов; – определение локального элементного состава, построение элементных карт (электронно-зондовый рентгеновский микроанализ, оже-спектроскопия); – определение границ кристаллических зерен (анализ картин дифракции обратнорассеянных электронов); – исследование зонной структуры и состава полупроводников (катодолюминесценция). ХАРАКТЕРИСТИКИ РЭМ: Разрешение определяется: диаметром электронного зонда; ускоряющим напряжением; током пучка; скоростью развертки (соотношение сигнал-шум).
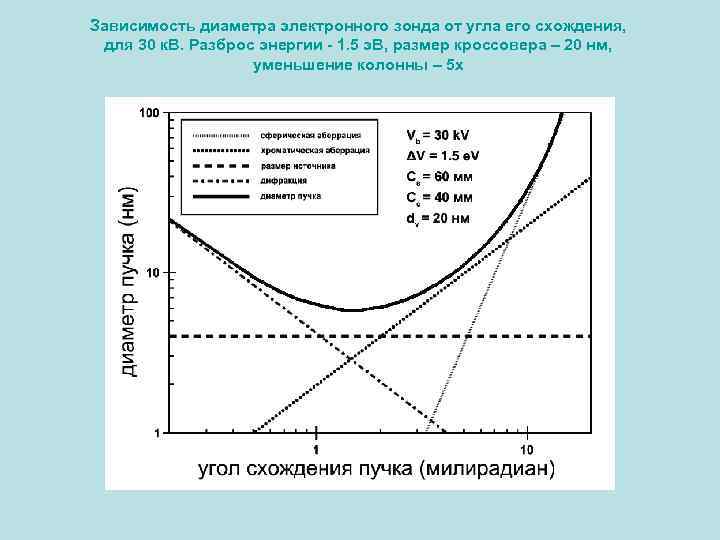 Зависимость диаметра электронного зонда от угла его схождения, для 30 к. В. Разброс энергии - 1. 5 э. В, размер кроссовера – 20 нм, уменьшение колонны – 5 х
Зависимость диаметра электронного зонда от угла его схождения, для 30 к. В. Разброс энергии - 1. 5 э. В, размер кроссовера – 20 нм, уменьшение колонны – 5 х
 Диаметр зонда определяется: • Размером кроссовера dv : d g= d v / M (M - степень уменьшения электронной колонны) • Сферической аберрацией: ds = 2 Cs 3 • Хроматической аберрацией: dc = Cc d. Е/Е (Cs – коэффициент сферической аберрации, – угол схождения пучка на подложке) (Cc – коэффициент хроматической аберрации, d. Е – разброс энергии электронов, Е – средняя энергия электронов в пучке) • Дифракцией электронов: = 0. 5/√V (нм) Теоретический диаметр пучка: dd= 0. 6 / (нм) d = (dg 2 + ds 2 + dc 2 + dd 2)1/2
Диаметр зонда определяется: • Размером кроссовера dv : d g= d v / M (M - степень уменьшения электронной колонны) • Сферической аберрацией: ds = 2 Cs 3 • Хроматической аберрацией: dc = Cc d. Е/Е (Cs – коэффициент сферической аберрации, – угол схождения пучка на подложке) (Cc – коэффициент хроматической аберрации, d. Е – разброс энергии электронов, Е – средняя энергия электронов в пучке) • Дифракцией электронов: = 0. 5/√V (нм) Теоретический диаметр пучка: dd= 0. 6 / (нм) d = (dg 2 + ds 2 + dc 2 + dd 2)1/2
 Основные части РЭМ
Основные части РЭМ
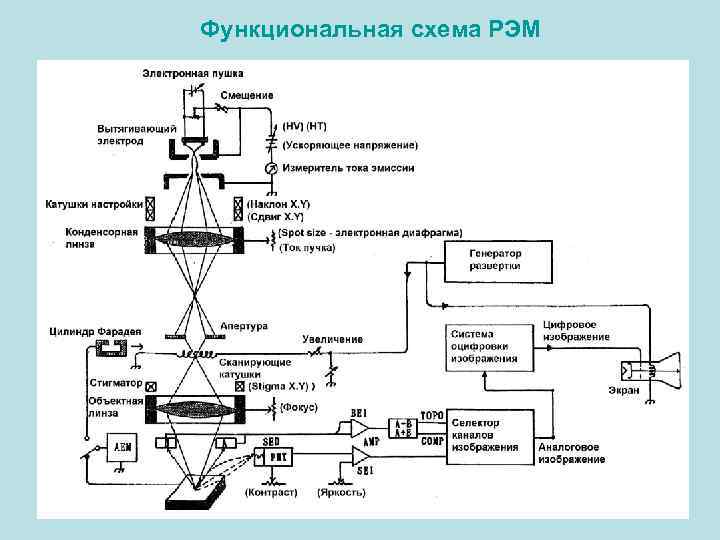 Функциональная схема РЭМ
Функциональная схема РЭМ




 Схема работы вакуумной системы
Схема работы вакуумной системы


 ток отклоняющих катушек и сформированный растр и тик оп М оты РЭ раб ого и а ск ем Сх тиче оп Классическая электромагнитная линза Иммерсионная электромагнитная линза (доп. фок. )
ток отклоняющих катушек и сформированный растр и тик оп М оты РЭ раб ого и а ск ем Сх тиче оп Классическая электромагнитная линза Иммерсионная электромагнитная линза (доп. фок. )
 Разрешение РЭМ Разрешение d. R определяется диаметром зонда dз = (dg 2 + ds 2 + dc 2 + dd 2)1/2 Диаметр зонда - диаметр диска, в котором сосредоточено 80 % всех электронов
Разрешение РЭМ Разрешение d. R определяется диаметром зонда dз = (dg 2 + ds 2 + dc 2 + dd 2)1/2 Диаметр зонда - диаметр диска, в котором сосредоточено 80 % всех электронов
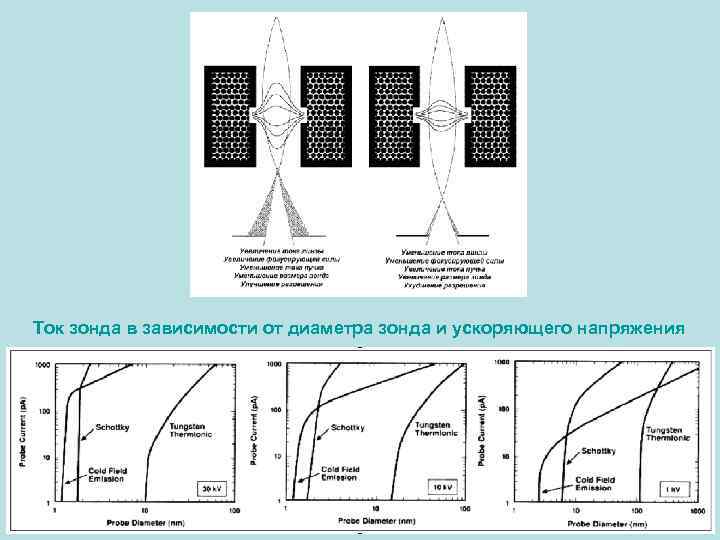 Ток зонда в зависимости от диаметра зонда и ускоряющего напряжения
Ток зонда в зависимости от диаметра зонда и ускоряющего напряжения
 Глубина фокуса DF
Глубина фокуса DF
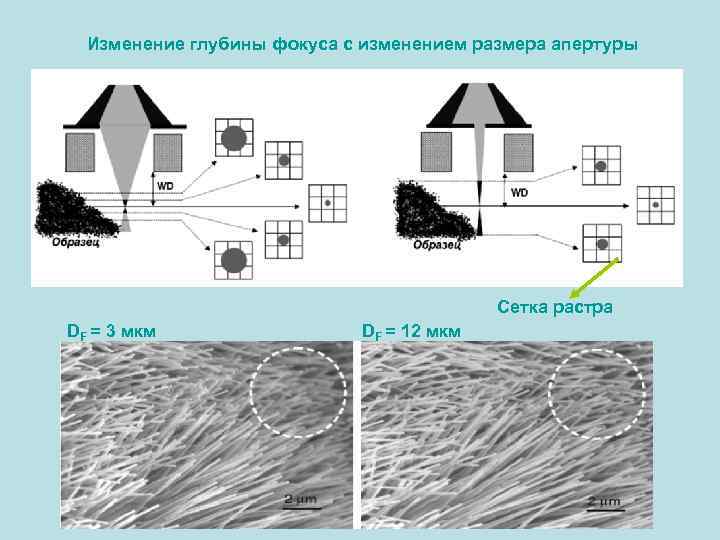 Изменение глубины фокуса с изменением размера апертуры Сетка растра DF = 3 мкм DF = 12 мкм
Изменение глубины фокуса с изменением размера апертуры Сетка растра DF = 3 мкм DF = 12 мкм
 Детектирующая аппаратура – детектор вторичных электронов – детектор отражённых электронов – детектор дифракции отражённых электронов (рентгеновский спектрометр) – оптический спектрометр для изучения катодолюминесценции – CCD-камера для анализа дифракции обратнорассеянных электронов и др. 1. Регистрация вторичных электронов (Класс. или модиф. детектор Эверхарта-Торнли, полупроводниковые детекторы « in lense» ) (Сетка Фарадея) Детектор вторичных электронов Эверхарта-Торнли (классич. )
Детектирующая аппаратура – детектор вторичных электронов – детектор отражённых электронов – детектор дифракции отражённых электронов (рентгеновский спектрометр) – оптический спектрометр для изучения катодолюминесценции – CCD-камера для анализа дифракции обратнорассеянных электронов и др. 1. Регистрация вторичных электронов (Класс. или модиф. детектор Эверхарта-Торнли, полупроводниковые детекторы « in lense» ) (Сетка Фарадея) Детектор вторичных электронов Эверхарта-Торнли (классич. )

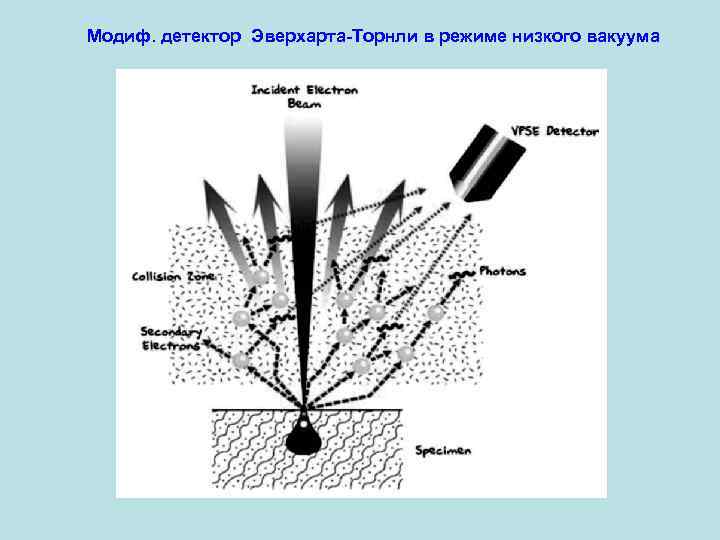 Модиф. детектор Эверхарта-Торнли в режиме низкого вакуума
Модиф. детектор Эверхарта-Торнли в режиме низкого вакуума
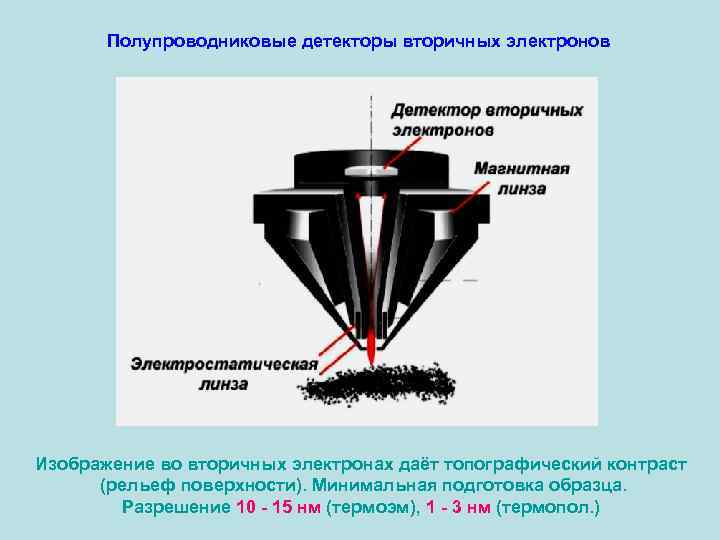 Полупроводниковые детекторы вторичных электронов Изображение во вторичных электронах даёт топографический контраст (рельеф поверхности). Минимальная подготовка образца. Разрешение 10 - 15 нм (термоэм), 1 - 3 нм (термопол. )
Полупроводниковые детекторы вторичных электронов Изображение во вторичных электронах даёт топографический контраст (рельеф поверхности). Минимальная подготовка образца. Разрешение 10 - 15 нм (термоэм), 1 - 3 нм (термопол. )
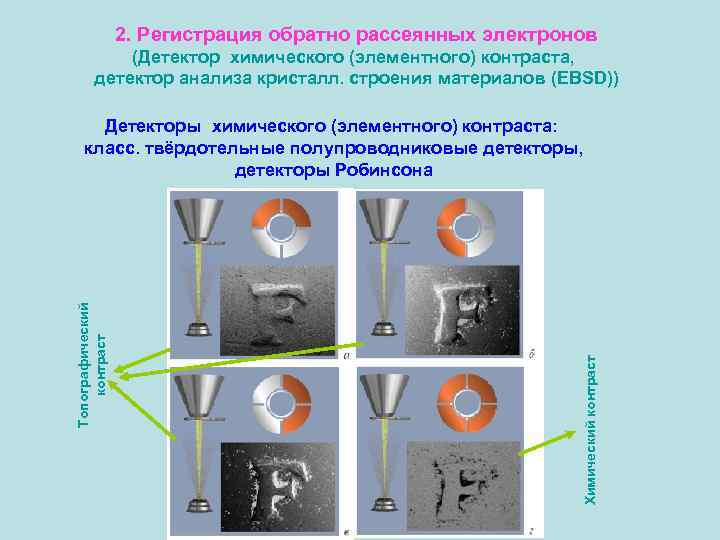 2. Регистрация обратно рассеянных электронов (Детектор химического (элементного) контраста, детектор анализа кристалл. строения материалов (EBSD)) Химический контраст Топографический контраст Детекторы химического (элементного) контраста: класс. твёрдотельные полупроводниковые детекторы, детекторы Робинсона
2. Регистрация обратно рассеянных электронов (Детектор химического (элементного) контраста, детектор анализа кристалл. строения материалов (EBSD)) Химический контраст Топографический контраст Детекторы химического (элементного) контраста: класс. твёрдотельные полупроводниковые детекторы, детекторы Робинсона
 Полупроводниковый детектор обратнорассеянных (отраженных) электронов (Датчик Кимото) Латеральное разрешение 50 нм – 1 -2 мкм, Разрешение по хим. составу 0. 1 а. е. м. для Z = 30
Полупроводниковый детектор обратнорассеянных (отраженных) электронов (Датчик Кимото) Латеральное разрешение 50 нм – 1 -2 мкм, Разрешение по хим. составу 0. 1 а. е. м. для Z = 30
 Виды контраста в РЭМ Режим регистрации истинно вторичных электронов зависимость от локального рельефа изображение волокон Zn. О Влияют на контраст (в режиме и. в. э. ): – микрорельеф поверхности; – значение коэффициента вторичной эмиссии (зависит от материала); – наличие электрических полей на поверхности (заряд, потенциал); – наличие магнитных полей на поверхности
Виды контраста в РЭМ Режим регистрации истинно вторичных электронов зависимость от локального рельефа изображение волокон Zn. О Влияют на контраст (в режиме и. в. э. ): – микрорельеф поверхности; – значение коэффициента вторичной эмиссии (зависит от материала); – наличие электрических полей на поверхности (заряд, потенциал); – наличие магнитных полей на поверхности
 Режим регистрации обратноотражённых электронов Рельефный образец Плоский образец IA = I 0 + 1 IB = I 0 + 2 IA+B = 2 I 0 + ( 1 - 2) IA-B = 1 + 2 Влияют на контраст (в режиме о. о. э. ): – эффективный атомный номер микрообъема образца; – микрорельеф поверхности; – локальная плотность; – кристаллическая структура; – электрические и магнитные поля на поверхности
Режим регистрации обратноотражённых электронов Рельефный образец Плоский образец IA = I 0 + 1 IB = I 0 + 2 IA+B = 2 I 0 + ( 1 - 2) IA-B = 1 + 2 Влияют на контраст (в режиме о. о. э. ): – эффективный атомный номер микрообъема образца; – микрорельеф поверхности; – локальная плотность; – кристаллическая структура; – электрические и магнитные поля на поверхности
 Сравнение режимов работы РЭМ на примере изображения интерметаллического сплава Cu. Cr истинно вторичные электроны элементный контраст (упругоотраженные электроны) топографический контраст (упругоотраженные электроны) Наличие электрических полей на поверхности – искажает изображения и влияет на контраст Приёмы удаления заряда: – закрепление заземляющего контакт на верхней стороне исследуемого образца для использования эффекта поверхностной проводимости; – понижение ускоряющего напряжения для повышения коэффициента вторичной эмиссии; – переход в режим низкого вакуума (молекулы и атомы снимают накопленный заряд с поверхности образца; – запыление поверхности тонкой проводящей плёнкой (толщиной по рядка 10 -20 нм)
Сравнение режимов работы РЭМ на примере изображения интерметаллического сплава Cu. Cr истинно вторичные электроны элементный контраст (упругоотраженные электроны) топографический контраст (упругоотраженные электроны) Наличие электрических полей на поверхности – искажает изображения и влияет на контраст Приёмы удаления заряда: – закрепление заземляющего контакт на верхней стороне исследуемого образца для использования эффекта поверхностной проводимости; – понижение ускоряющего напряжения для повышения коэффициента вторичной эмиссии; – переход в режим низкого вакуума (молекулы и атомы снимают накопленный заряд с поверхности образца; – запыление поверхности тонкой проводящей плёнкой (толщиной по рядка 10 -20 нм)

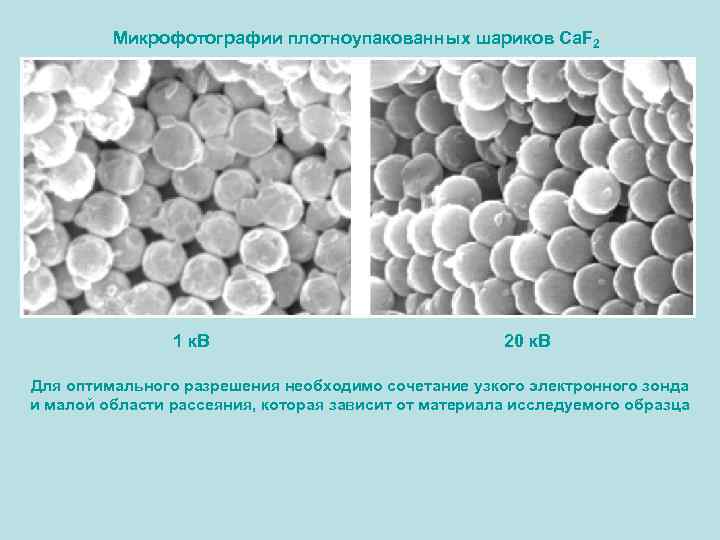 Микрофотографии плотноупакованных шариков Ca. F 2 1 к. В 20 к. В Для оптимального разрешения необходимо сочетание узкого электронного зонда и малой области рассеяния, которая зависит от материала исследуемого образца
Микрофотографии плотноупакованных шариков Ca. F 2 1 к. В 20 к. В Для оптимального разрешения необходимо сочетание узкого электронного зонда и малой области рассеяния, которая зависит от материала исследуемого образца
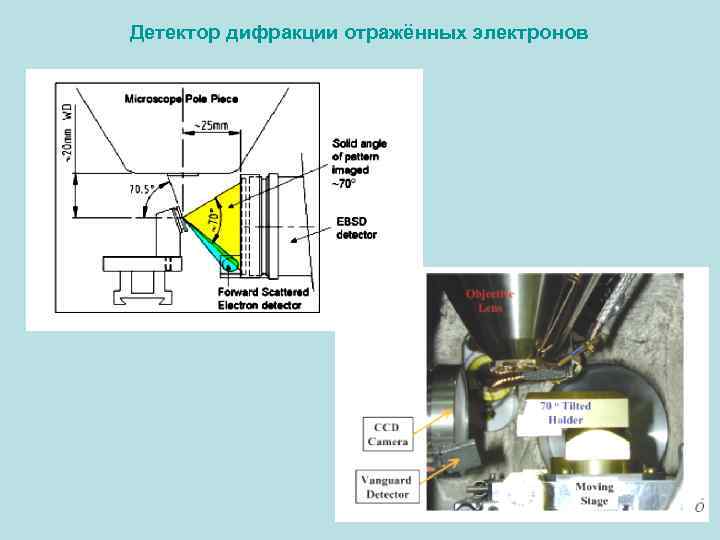 Детектор дифракции отражённых электронов
Детектор дифракции отражённых электронов
 Ge Преобразование Хуга ((х cos θ) + (у sin θ)) = ρ Разрешение – 0. 3 мкм
Ge Преобразование Хуга ((х cos θ) + (у sin θ)) = ρ Разрешение – 0. 3 мкм
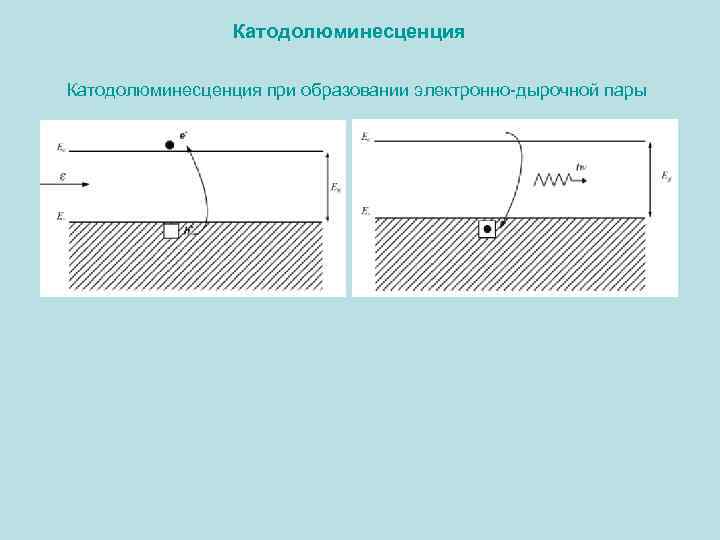 Катодолюминесценция при образовании электронно-дырочной пары
Катодолюминесценция при образовании электронно-дырочной пары
 Детектор видимого, УФ и ИК излучения Во вторичных электронах Катодолюминесценция
Детектор видимого, УФ и ИК излучения Во вторичных электронах Катодолюминесценция
 Виды рекомбинации • «Зона-зона» (обычно излучательная) • Хотя может быть безизлучательной, если концентрации носителей невелики. • Через промежуточный уровень (ловушку) (обычно безизлучательная) – Ловушка захватывает электрон, который в последствии переходит в Vзону. – Ловушка захватывает носитель одного знака, затем она захватывает носитель другого знака, который рекомбинирует с локализованным и переводит ловушку в нейтральное положение. – Но захват ловушкой носителя ещё не означает, что он прорекомбинирует, возможен вариант, когда он благополучно вернётся в свою зону (явление эмиссии). EC h ~Eg EV EC 1 2 3 3 Er EV
Виды рекомбинации • «Зона-зона» (обычно излучательная) • Хотя может быть безизлучательной, если концентрации носителей невелики. • Через промежуточный уровень (ловушку) (обычно безизлучательная) – Ловушка захватывает электрон, который в последствии переходит в Vзону. – Ловушка захватывает носитель одного знака, затем она захватывает носитель другого знака, который рекомбинирует с локализованным и переводит ловушку в нейтральное положение. – Но захват ловушкой носителя ещё не означает, что он прорекомбинирует, возможен вариант, когда он благополучно вернётся в свою зону (явление эмиссии). EC h ~Eg EV EC 1 2 3 3 Er EV
 Отличия прямозонного полупроводника от непрямозонного В прямозонном полупроводнике квазиимпульс электрона в минимуме Cзоны равен квазиимпульсу дырки в максимуме V-зоны. В непрямозонных полупроводниках они неравны и это приводит к некоторым отличиям. Так, например, в непрямозонных полупроводниках вероятность излучательной рекомбинации мала, для её увеличения рядом с C-зоной вводят электронный уровень захвата Er, с помощью которого выравниваются импульсы носителей. EC E hν~Eg-Er Eg Eg Er hν~Eg EV Прямозонный полупроводник EV Непрямозонный полупроводник
Отличия прямозонного полупроводника от непрямозонного В прямозонном полупроводнике квазиимпульс электрона в минимуме Cзоны равен квазиимпульсу дырки в максимуме V-зоны. В непрямозонных полупроводниках они неравны и это приводит к некоторым отличиям. Так, например, в непрямозонных полупроводниках вероятность излучательной рекомбинации мала, для её увеличения рядом с C-зоной вводят электронный уровень захвата Er, с помощью которого выравниваются импульсы носителей. EC E hν~Eg-Er Eg Eg Er hν~Eg EV Прямозонный полупроводник EV Непрямозонный полупроводник
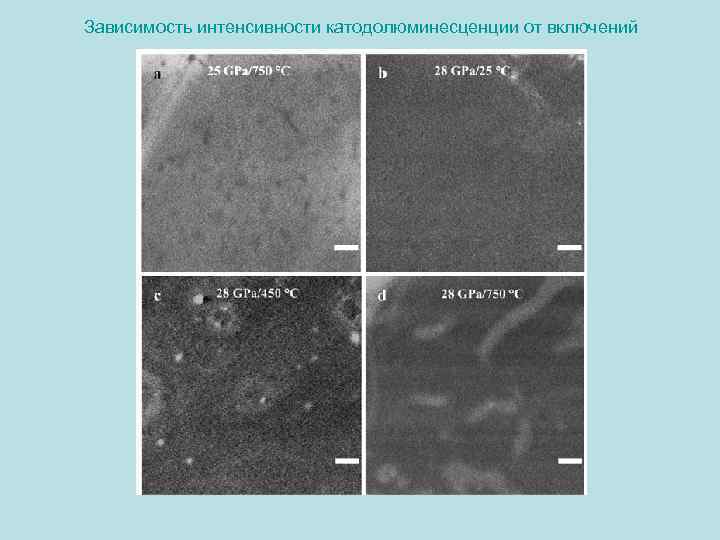 Зависимость интенсивности катодолюминесценции от включений
Зависимость интенсивности катодолюминесценции от включений
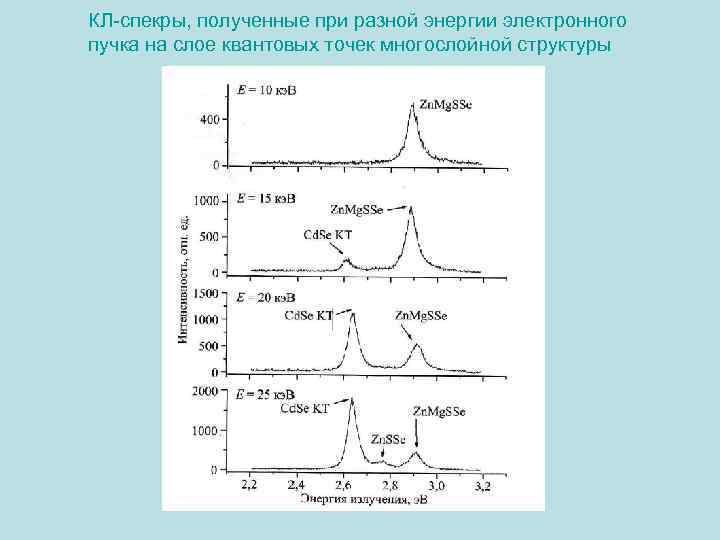 КЛ-спекры, полученные при разной энергии электронного пучка на слое квантовых точек многослойной структуры
КЛ-спекры, полученные при разной энергии электронного пучка на слое квантовых точек многослойной структуры
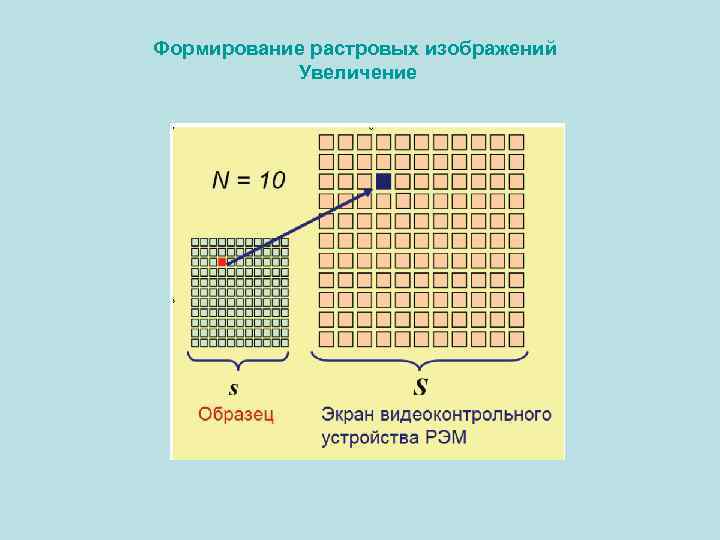 Формирование растровых изображений Увеличение
Формирование растровых изображений Увеличение
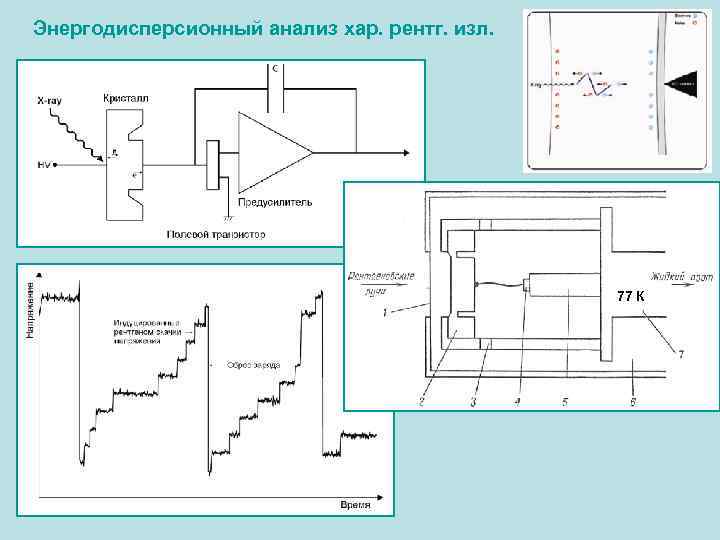 Энергодисперсионный анализ хар. рентг. изл. 77 К
Энергодисперсионный анализ хар. рентг. изл. 77 К
 «Мертвое время» энергодисперсионного детектора определяется: 1. Временем, затрачиваемым прибором на регистрацию рентгеновских квантов одной энергии 2. Временем, затрачиваемым на приведение кристалла в начальное положение, когда потенциал между его противоположными сторонами приводится к некоторому нулевому значению. Разрешение спектрометра тем лучше, чем длиннее время измерения количества рентгеновских квантов одной энергии На интенсивность пиков характеристического рентгеновского излучения влияют: 1. Угол падения первичного электронного пучка на образец. 2. Распределение элементов по поверхности. 3. Расположение детектора относительно образца в камере РЭМ. 4. Энергия бомбардирующего электронного пучка. 5. Ток бомбардирующего электронного пучка. 6. Длительность снятия спектра.
«Мертвое время» энергодисперсионного детектора определяется: 1. Временем, затрачиваемым прибором на регистрацию рентгеновских квантов одной энергии 2. Временем, затрачиваемым на приведение кристалла в начальное положение, когда потенциал между его противоположными сторонами приводится к некоторому нулевому значению. Разрешение спектрометра тем лучше, чем длиннее время измерения количества рентгеновских квантов одной энергии На интенсивность пиков характеристического рентгеновского излучения влияют: 1. Угол падения первичного электронного пучка на образец. 2. Распределение элементов по поверхности. 3. Расположение детектора относительно образца в камере РЭМ. 4. Энергия бомбардирующего электронного пучка. 5. Ток бомбардирующего электронного пучка. 6. Длительность снятия спектра.
 Схема переходов при ХРИ
Схема переходов при ХРИ

 Волновой спектрометр ХРИ
Волновой спектрометр ХРИ
 Форма кристалла по Йохансону
Форма кристалла по Йохансону
 Использование волновых детекторов с разными кристаллами
Использование волновых детекторов с разными кристаллами
 СПАСИБО ЗА ВНИМАНИЕ! КУРСК 2012
СПАСИБО ЗА ВНИМАНИЕ! КУРСК 2012


