Лекция 09 Измерение толщины тонких плёнок.pptx
- Количество слайдов: 40

Брянский Государственный Технический Университет Кафедра ЭРЭ и ЭС МЕТОДЫ ИССЛЕДОВАНИЯ МАТЕРИАЛОВ И СТРУКТУР ЭЛЕКТРОНИКИ Лекция 09 Измерение глубины залегания pn-переходов, толщины эпитаксиальных слоёв и тонких плёнок Доцент Сахаров Ю. Г. Курс лекций Брянск 2011

План 1. Измерение толщины пленок в процессе нанесения 1. 1 Дифракция быстрых электронов 1. 2 Ионизационный измеритель скорости напыления 1. 3 Кварцевый измеритель толщины осаждаемых пленок 1. 4 Интерферометрический контроль толщины напыляемых пленок 2. Измерение толщины нанесенных пленок 2. 1 Метод окрашенных шлифов 2. 2 Профилометрический метод 2. 3 Интерференционные методы 2. 3. 1 Двухлучевая интерферометрия 2. 3. 2 Интерферометрия фазового контраста 2. 3. 3 Интерференционная спектроскопия 2. 4 Эллипсометрия 2. 5 Рентгенофлуоресцентные методы 2. 6 Радиоизотопные методы

1. Измерение толщины пленок в процессе нанесения

Возможности контроля и анализа процесса МЛЭ in situ - масс-анализ состава и интенсивности пучков; - дифракция быстрых электронов на отражение (RHEED reflection high energy electron diffraction); -лазерная эллипсометрия;

1. 1 Дифракция быстрых электронов (ДБЭ) на поверхности образца

Картины ДБЭ на поверхности кремния Si(100)-(2 1) Si(111)-(7 7)

Контроль процесса роста монослоёв

1. 2 Ионизационный манометр б) а) устройство; б) принцип действия; в) диаграмма распределения потенциалов. 1 – катод; 2 - анод; 3 – коллектор ионов. в) а)

1. 3 Кварцевый измеритель толщины пленки in situ Оптическая ось а) кристаллы природного кварца; б) АТ-срез, отличающийся высокой термостабильностью; в) кварцевый резонатор; г) сдвиговые колебания пластины кварцевого резонатора С = 17, 7∙ 10 -12 кг∙Гц-1∙см-2 для 5 МГц кварца

Кварцевый измеритель толщины пленки «MICRON-5» MICRON-5

1. 4 Интерферометрический контроль толщины осаждаемых прозрачных пленок Интерференционная картина R = f(λ)
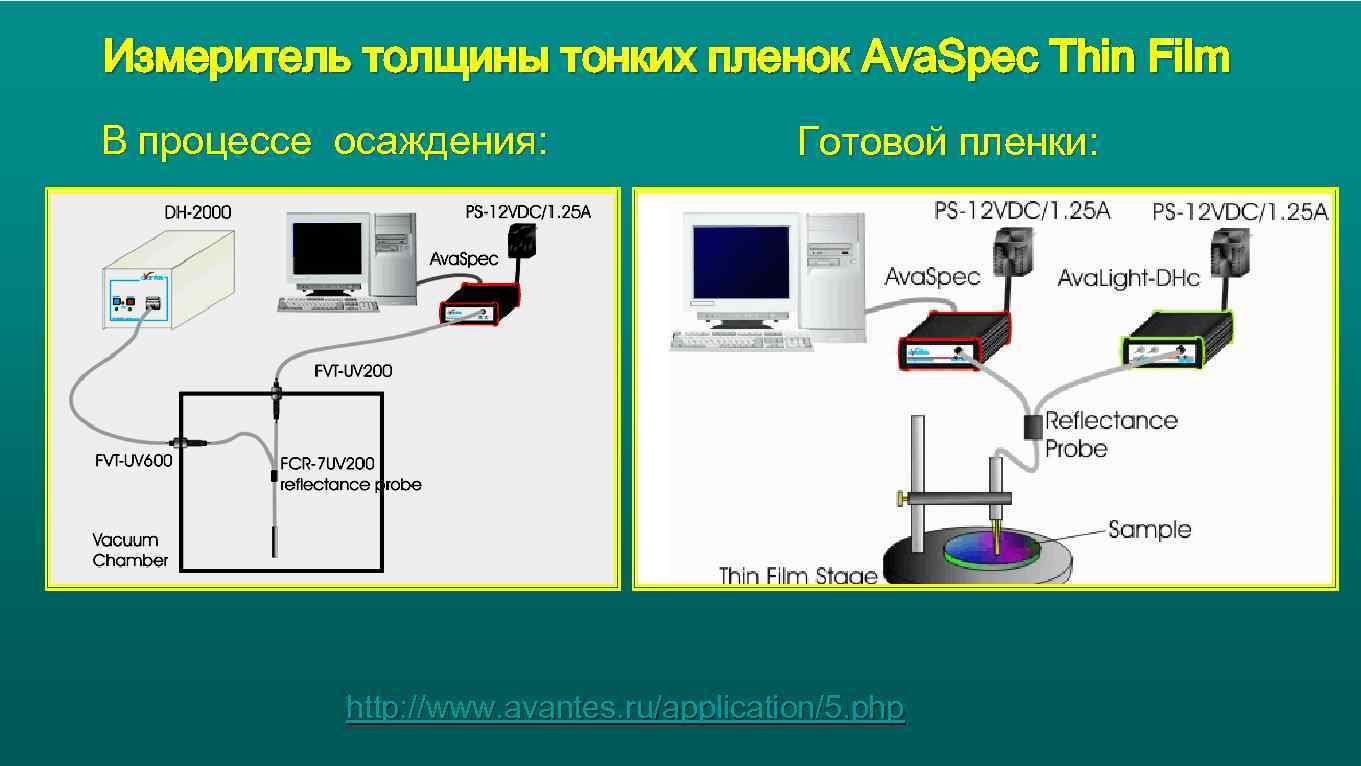
Измеритель толщины тонких пленок Ava. Spec Thin Film В процессе осаждения: Готовой пленки: http: //www. avantes. ru/application/5. php

Измеритель толщины тонких пленок Ava. Spec Thin Film Программное обеспечение: Характеристики комплекса: Применяется для контроля процессов плазменного травления и осаждения пленок. Измерение толщины тонких пленок производят также для оптически прозрачных пленок на металлах или стекле. http: //www. avantes. ru/application/5. php

2. Измерение толщины нанесенных пленок

2. 1. Метод окрашенных шлифов
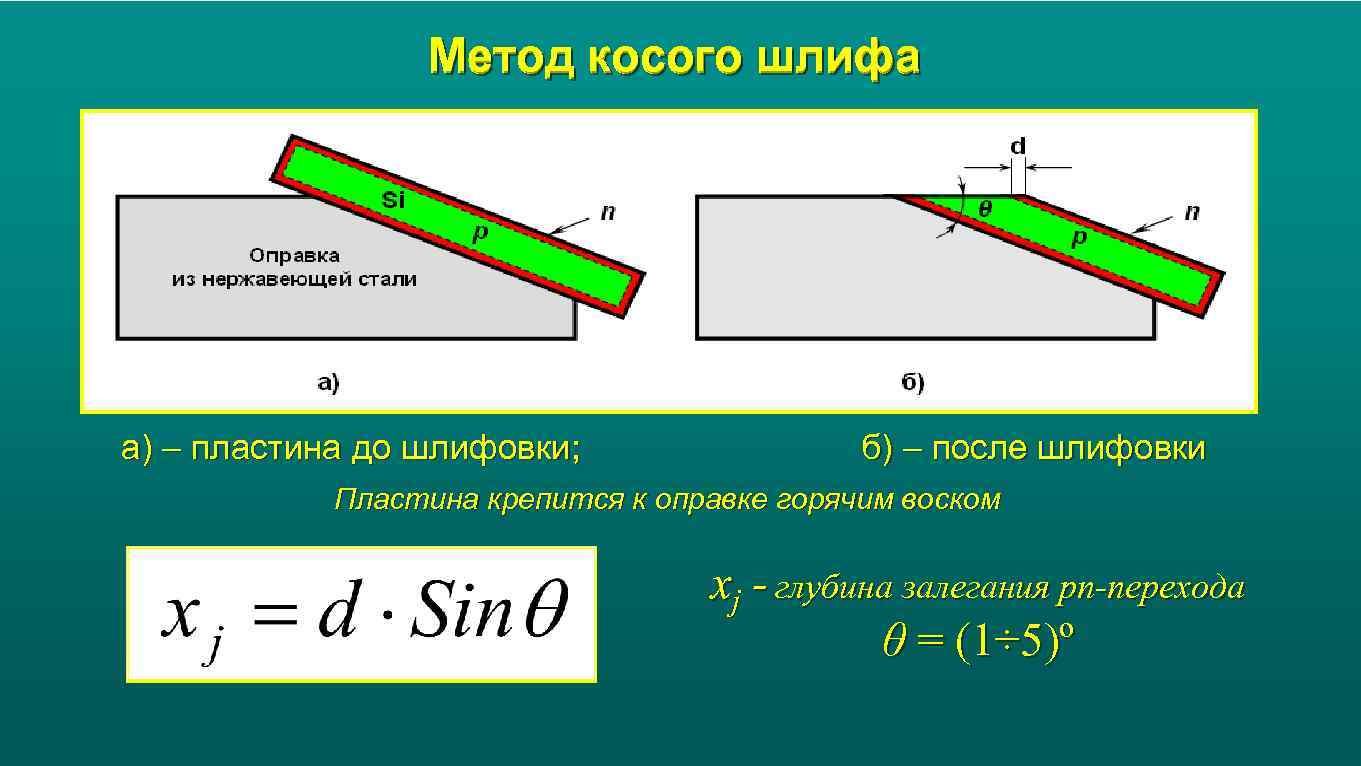
Метод косого шлифа а) – пластина до шлифовки; б) – после шлифовки Пластина крепится к оправке горячим воском xj - глубина залегания pn-перехода θ = (1÷ 5)º

Метод косого шлифа Полировка производится на стеклянной пластине, с мелкодисперсной окисью алюминия (0, 05 ÷ 0, 1) мкм. Используется химическое окрашивание или осаждение металлов, действующие на область одного типа проводимости и не оказывающие воздействия на область другого типа проводимости. Погрешность измерения: В диапазоне (1 ÷ 25) мкм погрешность измерения Δ = ±(0, 15 xj + 0, 5)мкм при α = 0, 99 где xj – толщина (глубина залегания) измеряемого слоя Недостатки метода косого шлифа: 1. Погрешность определения угла θ может достигать 0, 5º 2. Невозможно определить однородность толщины эпитаксиального слоя по площади эпитаксиальной структуры.
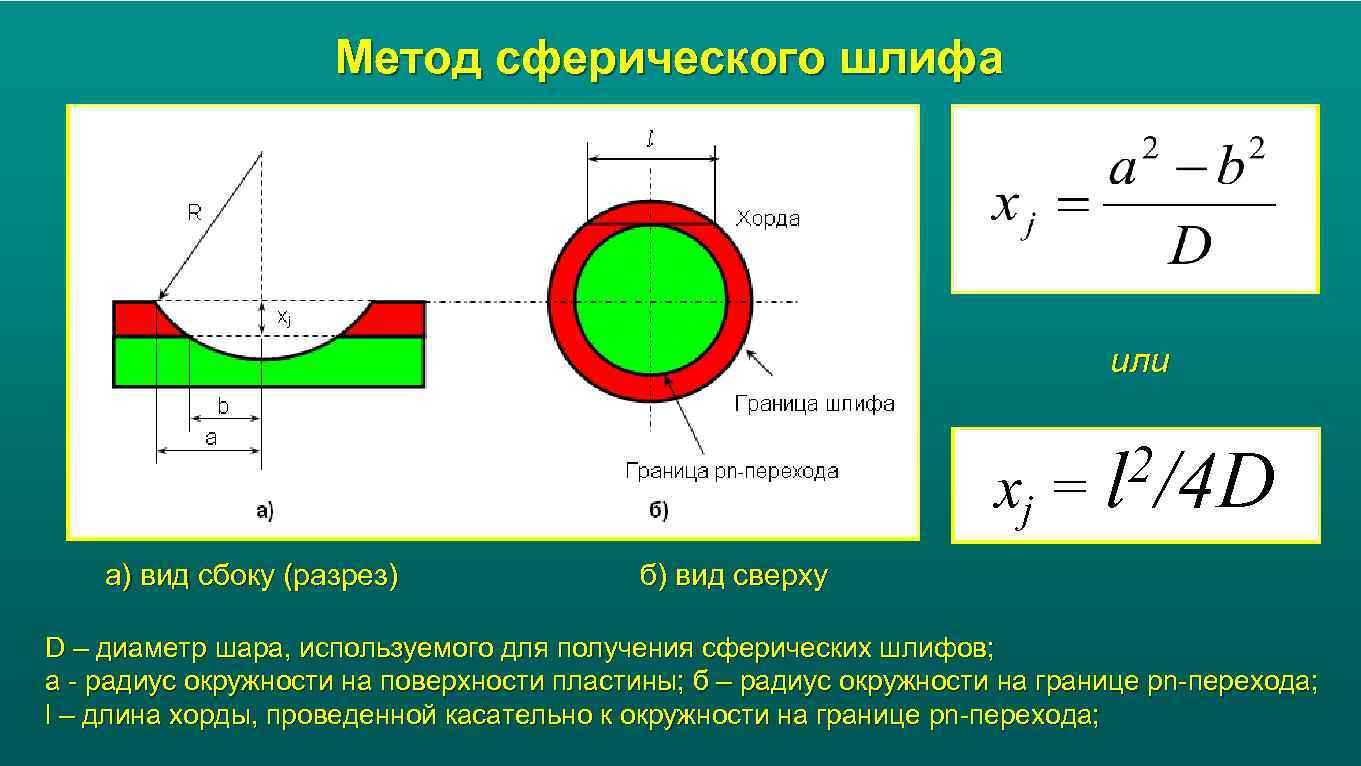
Метод сферического шлифа или 2/4 D xj = l а) вид сбоку (разрез) б) вид сверху D – диаметр шара, используемого для получения сферических шлифов; а - радиус окружности на поверхности пластины; б – радиус окружности на границе pn-перехода; l – длина хорды, проведенной касательно к окружности на границе pn-перехода;

Метод сферического шлифа Достоинства метода: 1. Отсутствует необходимость измерения углов среза; 2. Более высокая контрастность изображения; 3. Более высокая точность определения глубины залегания pn-перехода и толщины эпитаксиального слоя; 4. Возможность определения однородности эпитаксиального слоя по пластине Погрешность измерения: В диапазоне (0, 5 ÷ 20) мкм погрешность измерения Δ = ±(2 ÷ 9)% при α = 0, 95

Травители для окрашивания Травители для pn-переходов: 1. Концентрированная HF + 0, 1 % HNO 3 2. HF с добавкой Na. NO 2, H 3 PO 4, NO 2 3. Чистая концентрированная HF + сильное освещение р-область – темнеет, n-область – остаётся неизменной. При приложении обратного смещения картина меняется на противоположную – темнеет n-область, р – нет. Причина – рост пленок Si. O (Si. H 4, H 2 Si. F 6) Травители для nn+ и рр+ переходов: 1. HF + H 2 O 2 (2: 1) 2. HF + HNO 3 +Ag. NO 3

Электрохимическое осаждение 1. Cu, Ag, Au с небольшим добавлением HF Осаждение металла происходит на кремнии n-типа 2. Раствор KAu(CN)2 + KOH

2. 2 Профилометрический метод

Принцип действия профилометра Алмазная игла последовательно ощупывает контролируемую поверхность. Колебания иглы преобразуются в электрические сигналы. 1 – кантилевер (консоль); 2 - алмазная игла Ø (2 -12) мкм; 3 – горизонтальное перемещение; 4 – вертикальное перемещение; 5 – исследуемая поверхность; 6 – записываемый профиль Сигналы записываются на светочувствительную плёнку, металлизированную бумагу или выводятся на монитор компьютера.

Профилограф-профилометр модели 202 (Калибр) 1 - профилограмма; 2 - стойка; 3 - привод; 4 - датчик; 5 - деталь; 6 - измерительный столик; 7 - показывающее устройство электронного блока. I - станина с измерительным столиком и приводом; II - электронный блок; III - записывающее устройство. Диапазон измерений высоты неровностей – (0, 03 ÷ 80) мкм; Вертикальное увеличение – 400 ÷ 200 000; горизонтальное увеличение – до 100 000

Профилограф-профилометр Профи-130 Индуктивный датчик чувствительность - 2∙ 10 -4 мкм; радиус алмазной иглы – 5 мкм. Возможно описывать рельеф, образованный бугорком всего лишь из 2 -3 атомов

2. 3 Интерференционные методы

Усиление и гашение волн при интерференции

2. 3. 1 Интерференция в тонких пленках i d – толщина пленки; n – показатель преломления пленки; i – угол падения; λ – длина волны; m - целое число.

Цветовая таблица пленок Si. O 2 и Si 3 N 4 Показатель преломления n Si. O 2 = 1, 46 n Si 3 N 4 = 2, 05
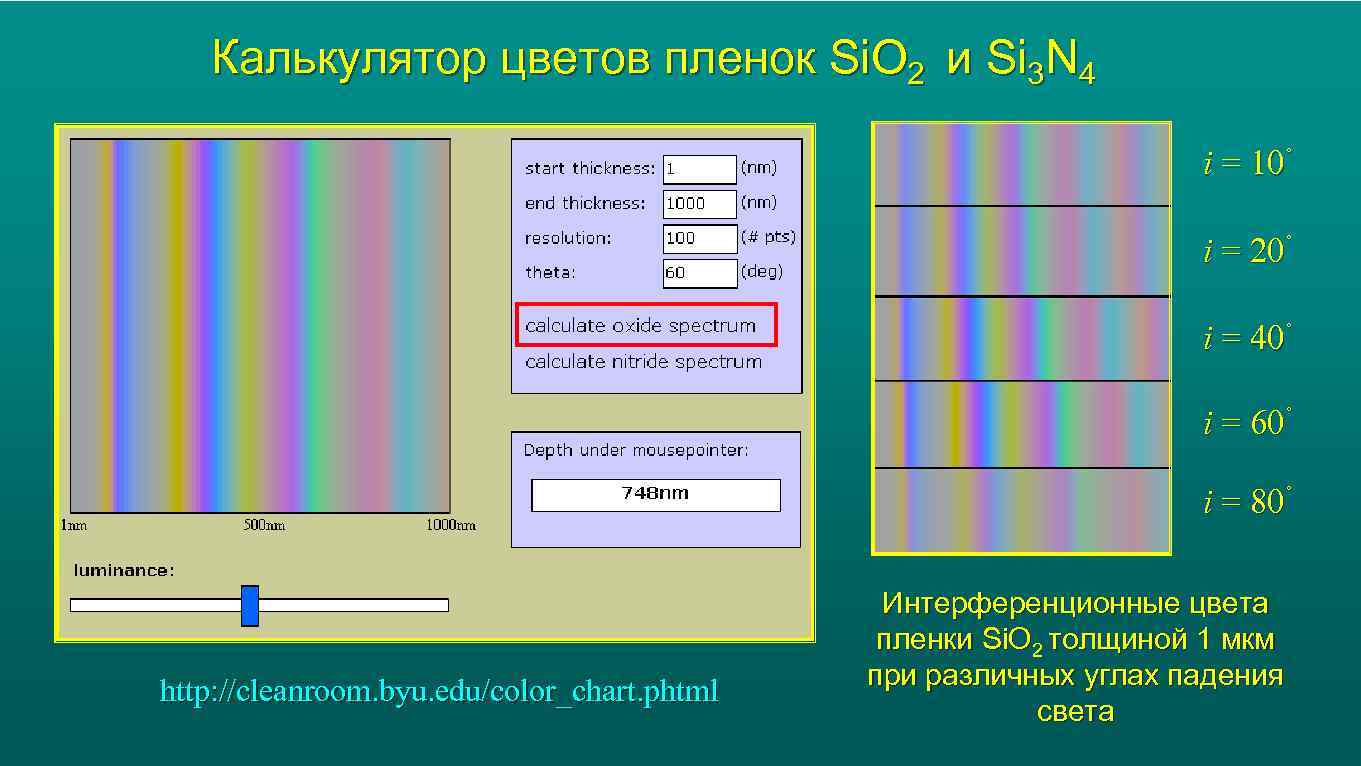
Калькулятор цветов пленок Si. O 2 и Si 3 N 4 i = 10˚ i = 20˚ i = 40˚ i = 60˚ i = 80˚ http: //cleanroom. byu. edu/color_chart. phtml Интерференционные цвета пленки Si. O 2 толщиной 1 мкм при различных углах падения света

2. 3. 2 Двухлучевая интерферометрия
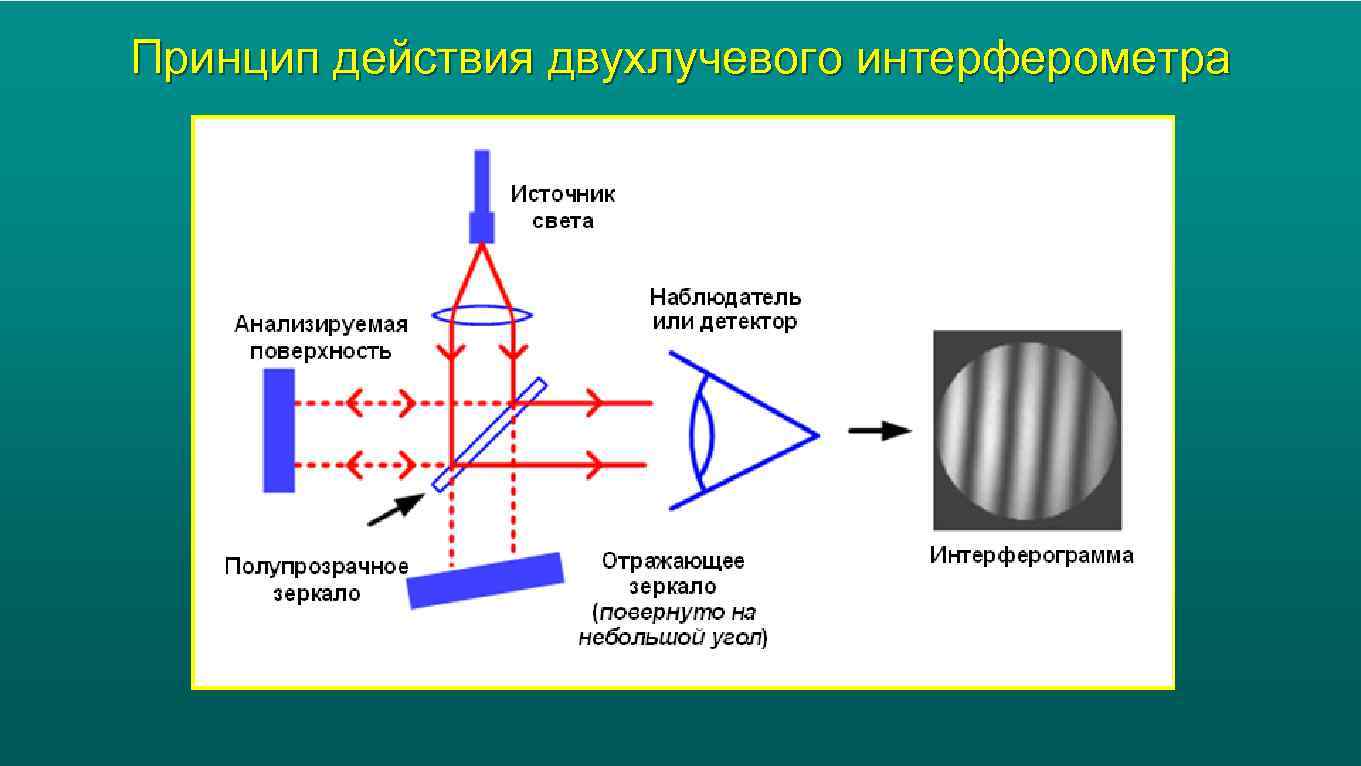
Принцип действия двухлучевого интерферометра

Интерферограмма, наблюдаемая в МИИ-4

Определение толщины пленки по интерферограмме Диапазон измерений – (0, 1 ÷ 0, 8) мкм

Автоматизированный интерференционный профилометр АИМ • Осветитель – полупроводниковый лазер λ = 0, 65 мкм; • Максимальная погрешность по глубине - λ/200 → 3, 3 нм • Опорное зеркало размещено на пьезоэлементе • Псевдоцветное трехмерное изображение профиля • Протокол с таблицей значений высоты профиля

2. 3. 3 Интерфометрия фазового сдвига

Оптическая схема фазосдвигающего профилометра Разрешающая способность Micro. Xam: • 1 нм – стандартная модель; • 0, 1 нм – прецизионная модель; • 0, 05 нм – модель с монохроматическим источником Фазосдвигающий интерферометр. avi

Примеры изображений в оптических профилометрах Высота профиля – 3 нм 90 мкм 120 мкм Металл Полупроводник МЭМС Микролинзы

Оптические фазосдвигающие профилометры NT 9300 Veeco Micro. Xam

Благодарю за внимание
Лекция 09 Измерение толщины тонких плёнок.pptx