15cfca14b363047ebbb2af6ad54b6530.ppt
- Количество слайдов: 37
 3. Исследование наноразмерных полимерных материалов методами сканирующей электронной микроскопии В. Я. Шур Уральский Центр Коллективного Пользования “СОВРЕМЕННЫЕ НАНОТЕХНОЛОГИИ” Ур. ГУ
3. Исследование наноразмерных полимерных материалов методами сканирующей электронной микроскопии В. Я. Шур Уральский Центр Коллективного Пользования “СОВРЕМЕННЫЕ НАНОТЕХНОЛОГИИ” Ур. ГУ
 Электронный микроскоп (ЭМ) 2 Ø Оптическая микроскопия – нанотехнологии? ð Имеет дифракционный предел разрешения ð Без учета аберраций ð Критерий Релея Ø Электронная микроскопия ð Использование пучка электронов вместо света ð Корпускулярно волновой дуализм • Поток электронов – волна – использование принципов оптики • Поток электронов – поток частиц при взаимодействии с объектом или детектором ð Длина волны много меньше чем для света le = 0. 01 - 0. 001 нм ð Прямое развитие оптической микроскопии ð Чрезвычайно широкий спектр методик • Микроскопические – локальные данные о свойствах или рельефе • Аналитические – локальные данные о составе и структуре – не возможно в оптической или сканирующей зондовой микроскопии
Электронный микроскоп (ЭМ) 2 Ø Оптическая микроскопия – нанотехнологии? ð Имеет дифракционный предел разрешения ð Без учета аберраций ð Критерий Релея Ø Электронная микроскопия ð Использование пучка электронов вместо света ð Корпускулярно волновой дуализм • Поток электронов – волна – использование принципов оптики • Поток электронов – поток частиц при взаимодействии с объектом или детектором ð Длина волны много меньше чем для света le = 0. 01 - 0. 001 нм ð Прямое развитие оптической микроскопии ð Чрезвычайно широкий спектр методик • Микроскопические – локальные данные о свойствах или рельефе • Аналитические – локальные данные о составе и структуре – не возможно в оптической или сканирующей зондовой микроскопии
 3 Длина волны Ø Ø Ø Заряд e = 1. 6· 10 -19 Кл Масса покоя me = 9· 10 -31 кг Ускоряющее напряжение V Дополнительная энергия e·V=(m-me)·c 2 m = me/(1 -u 2/c 2)1/2 Длина волны l = h/mu – соотношение де-Бройля Без учета поправок l = [1. 5/V]1/2 нм Релятивистское приближение l = [1. 5/(V+10 -6 V 2)]1/2 нм Поправки до 25% V, к. В l, нм 20 1000 0. 0086 0. 0037 0. 0009
3 Длина волны Ø Ø Ø Заряд e = 1. 6· 10 -19 Кл Масса покоя me = 9· 10 -31 кг Ускоряющее напряжение V Дополнительная энергия e·V=(m-me)·c 2 m = me/(1 -u 2/c 2)1/2 Длина волны l = h/mu – соотношение де-Бройля Без учета поправок l = [1. 5/V]1/2 нм Релятивистское приближение l = [1. 5/(V+10 -6 V 2)]1/2 нм Поправки до 25% V, к. В l, нм 20 1000 0. 0086 0. 0037 0. 0009
 История электронной микроскопии Ø 1926 г. де Бройль - корпускулярно-волновой дуализм Ø 1931 г. Эрнст Руска (Ruska) и Макс Кнолл (Knoll) ð Первый электронный микроскоп с увеличением около 400 Ø 1931 г. Рейнольд Руденберг (Rudenberg), директор исследовательского подразделения Siemens ð Патент на электронный микроскоп Ø 1935 г. Макс Кнолл ð Изобретение сканирующего электронного микроскопа Ø 1937 г. Компания Siemens ð Финансирует Эрнста Руску для развития электронной микроскопии Ø 1938 г. Манфред вон Арден (Manfred von Ardenne) ð Изобретение сканирующего просвечивающего электронного микроскопа Ø 1938 г. Показано разрешение в 10 нм Ø 1945 г. Продемонстрировано разрешение в 1 нм Ø 1986 г. Нобелевская премия по физике - Эрнст Руска ð «For his fundamental work in electron optics, and for the design of the first electron microscope» ð Совместно с изобретателями сканирующего туннельного микроскопа Бинингом и Роером 4
История электронной микроскопии Ø 1926 г. де Бройль - корпускулярно-волновой дуализм Ø 1931 г. Эрнст Руска (Ruska) и Макс Кнолл (Knoll) ð Первый электронный микроскоп с увеличением около 400 Ø 1931 г. Рейнольд Руденберг (Rudenberg), директор исследовательского подразделения Siemens ð Патент на электронный микроскоп Ø 1935 г. Макс Кнолл ð Изобретение сканирующего электронного микроскопа Ø 1937 г. Компания Siemens ð Финансирует Эрнста Руску для развития электронной микроскопии Ø 1938 г. Манфред вон Арден (Manfred von Ardenne) ð Изобретение сканирующего просвечивающего электронного микроскопа Ø 1938 г. Показано разрешение в 10 нм Ø 1945 г. Продемонстрировано разрешение в 1 нм Ø 1986 г. Нобелевская премия по физике - Эрнст Руска ð «For his fundamental work in electron optics, and for the design of the first electron microscope» ð Совместно с изобретателями сканирующего туннельного микроскопа Бинингом и Роером 4
 Эрнст Руска 5
Эрнст Руска 5
 Особенности ЭМ 6 Ø Рассеяние электронов в газе ðРабота в вакууме Ø Электроны – заряженные частицы Ø Управление электростатическими и магнитными полями ðРазгон до нужной энергии • Изменение длины волны ðЛегкая перенастройка в процессе работы • Простое изменение масштаба ðЛегко осуществляется сканирование Ø Возможны различные типы взаимодействия пучка электронов с образцом
Особенности ЭМ 6 Ø Рассеяние электронов в газе ðРабота в вакууме Ø Электроны – заряженные частицы Ø Управление электростатическими и магнитными полями ðРазгон до нужной энергии • Изменение длины волны ðЛегкая перенастройка в процессе работы • Простое изменение масштаба ðЛегко осуществляется сканирование Ø Возможны различные типы взаимодействия пучка электронов с образцом
 Элементы ЭМ Ø Получение пучка электронов с заданными параметрами ðЭлектронная пушка Ø Фокусировка пучков и сбор пучка после образца ðМагнитные линзы Ø Сканирование ðОтклоняющие катушки (переменное электромагнитное поле) Ø Детектирование ðЭкран или фото/видео камера ðДетектор • Много различных вариантов 7
Элементы ЭМ Ø Получение пучка электронов с заданными параметрами ðЭлектронная пушка Ø Фокусировка пучков и сбор пучка после образца ðМагнитные линзы Ø Сканирование ðОтклоняющие катушки (переменное электромагнитное поле) Ø Детектирование ðЭкран или фото/видео камера ðДетектор • Много различных вариантов 7
 Электронная пушка 8 Генерация, ускорение и формирование пучка электронов Термическая эмиссия (thermionic) Полевая эмиссия (field emission - FEG) Монокристалл W с острием Нить W или La. B 6 Сильное электрическое поле – Нагрев электрическим током эмиссия электронов за счет Термическая эмиссия электронов туннельного эффекта Сетка – отрицательное смещение Два анода – вытягивающий – ускоряющий Анод – положительное смещение
Электронная пушка 8 Генерация, ускорение и формирование пучка электронов Термическая эмиссия (thermionic) Полевая эмиссия (field emission - FEG) Монокристалл W с острием Нить W или La. B 6 Сильное электрическое поле – Нагрев электрическим током эмиссия электронов за счет Термическая эмиссия электронов туннельного эффекта Сетка – отрицательное смещение Два анода – вытягивающий – ускоряющий Анод – положительное смещение
 Характеристики 9
Характеристики 9
 Магнитные линзы Ø Аксиально-симметричное магнитное поле Ø Сила Лоренца ðПерпендикулярна к скорости электрона ðПерпендикулярна к направлению магнитной индукции Ø Не действует на электроны движущиеся вдоль оси линзы Ø Движение по спирали – фокусировка 10
Магнитные линзы Ø Аксиально-симметричное магнитное поле Ø Сила Лоренца ðПерпендикулярна к скорости электрона ðПерпендикулярна к направлению магнитной индукции Ø Не действует на электроны движущиеся вдоль оси линзы Ø Движение по спирали – фокусировка 10
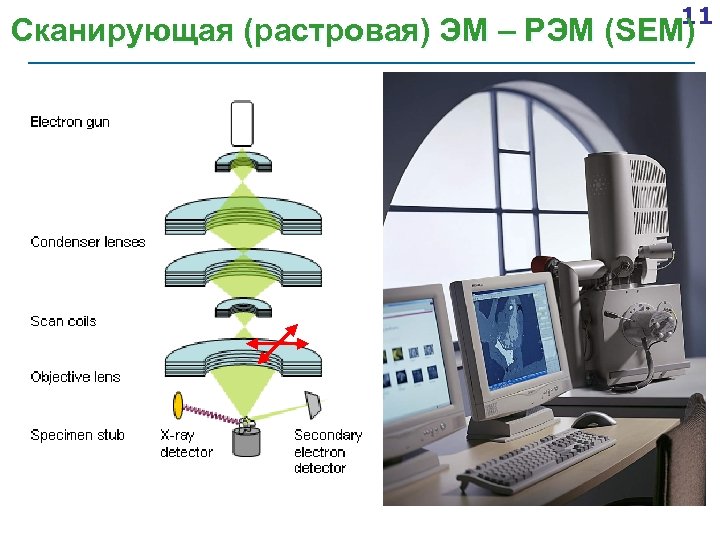 11 Сканирующая (растровая) ЭМ – РЭМ (SEM)
11 Сканирующая (растровая) ЭМ – РЭМ (SEM)
 Основные параметры РЭМ Ø Сканирование сфокусированным пучком электронов по поверхности образца Ø Построение изображения по растру с помощью различного рода детекторов Ø Комбинирование различных методов Ø Типичное разрешение ~ 2 -3 нм ð Есть модификации с разрешением ~ 1 нм Ø Возможен локальный элементный и структурный анализ ð Микрозондовые методики Ø Возможна модификация поверхности с высоким разрешением ð Нанолитография Ø Энергия пучка ~ 1 -30 кэ. В 12
Основные параметры РЭМ Ø Сканирование сфокусированным пучком электронов по поверхности образца Ø Построение изображения по растру с помощью различного рода детекторов Ø Комбинирование различных методов Ø Типичное разрешение ~ 2 -3 нм ð Есть модификации с разрешением ~ 1 нм Ø Возможен локальный элементный и структурный анализ ð Микрозондовые методики Ø Возможна модификация поверхности с высоким разрешением ð Нанолитография Ø Энергия пучка ~ 1 -30 кэ. В 12
 Контраст в ЭМ 13 Ø Что мы можем увидеть в электронный микроскоп? Ø Контраст в оптической микроскопии ð Поглощение, рассеяние, изменение фазы, поворот плоскости поляризации Ø Контраст в электронной микроскопии ð Энергия электронов намного больше чем фотонов ð Взаимодействие с атомами и молекулами ð Различные процессы Ø Для понимания контраста необходимо рассматривать взаимодействие электронов с веществом
Контраст в ЭМ 13 Ø Что мы можем увидеть в электронный микроскоп? Ø Контраст в оптической микроскопии ð Поглощение, рассеяние, изменение фазы, поворот плоскости поляризации Ø Контраст в электронной микроскопии ð Энергия электронов намного больше чем фотонов ð Взаимодействие с атомами и молекулами ð Различные процессы Ø Для понимания контраста необходимо рассматривать взаимодействие электронов с веществом
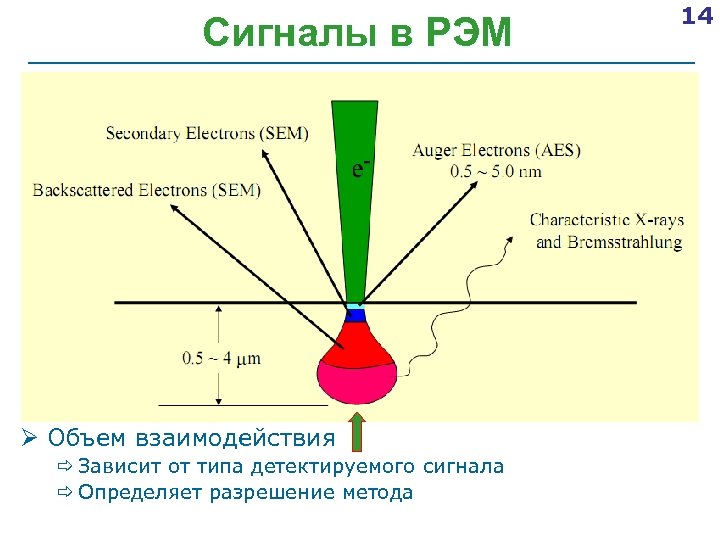 Сигналы в РЭМ Ø Объем взаимодействия ð Зависит от типа детектируемого сигнала ð Определяет разрешение метода 14
Сигналы в РЭМ Ø Объем взаимодействия ð Зависит от типа детектируемого сигнала ð Определяет разрешение метода 14
 15 Взаимодействие электронов с веществом Ø Неупругое рассеяние ð Любой процесс взаимодействия с потерей энергией DE ð Изменения DE > ~ 0. 1 э. В можно детектировать • Рассеяние на фононах – колебаниях решетки • Рассеяние на плазмонах – волнах электронов в зоне проводимости • Возбуждение валентного электрона • Возбуждение внутренних оболочек Ø Неупругое рассеяние и поглощение ð Возможно многократное рассеяние с потерей энергии, особенно в толстых образцах вплоть до «остановки» ð Объем взаимодействия - объем в котором поглощается ~ 95% падающих электронов ð В дополнение к поглощению – электроны вылетающие под большими углами и не попадающие в детектор Ø Обратнорассеянные электроны ð Первичные электроны, вылетающие в обратном направлении ð Сохраняют значительную часть энергии ð Коэффициент выхода < 1
15 Взаимодействие электронов с веществом Ø Неупругое рассеяние ð Любой процесс взаимодействия с потерей энергией DE ð Изменения DE > ~ 0. 1 э. В можно детектировать • Рассеяние на фононах – колебаниях решетки • Рассеяние на плазмонах – волнах электронов в зоне проводимости • Возбуждение валентного электрона • Возбуждение внутренних оболочек Ø Неупругое рассеяние и поглощение ð Возможно многократное рассеяние с потерей энергии, особенно в толстых образцах вплоть до «остановки» ð Объем взаимодействия - объем в котором поглощается ~ 95% падающих электронов ð В дополнение к поглощению – электроны вылетающие под большими углами и не попадающие в детектор Ø Обратнорассеянные электроны ð Первичные электроны, вылетающие в обратном направлении ð Сохраняют значительную часть энергии ð Коэффициент выхода < 1
 Вторичные эффекты 16 Ø Вторичные электроны ðПокидающие поверхность образца с энергией ~50 э. В • Первичные электроны передавшие большую часть энергии • Электроны, возбуждаемые в результате неупругого рассеяния вблизи поверхности и покидающие образец ðОдин из основных источников сигнала в ЭМ ðКоэффициент выхода может быть > 1 Ø Релаксация возбужденных атомов • Излучение части энергии в виде фотонов катодолюминесценция • Характеристическое рентгеновское излучение • Оже-электроны
Вторичные эффекты 16 Ø Вторичные электроны ðПокидающие поверхность образца с энергией ~50 э. В • Первичные электроны передавшие большую часть энергии • Электроны, возбуждаемые в результате неупругого рассеяния вблизи поверхности и покидающие образец ðОдин из основных источников сигнала в ЭМ ðКоэффициент выхода может быть > 1 Ø Релаксация возбужденных атомов • Излучение части энергии в виде фотонов катодолюминесценция • Характеристическое рентгеновское излучение • Оже-электроны
 Сигналы в РЭМ - Электроны Вторичные Ø Энергия < 50 э. В Ø Ускорение к детектору Ø Детектор Эверхарта-Торнли ð Сцинтиллятор + ФЭУ ð Очень эффективен Обратнорассеянные Ø Более направлены Ø Детектор Робинсона ð Кольцевой сцинтиллятор большой площадь + ФЭУ Ø Полупроводниковые детекторы 17
Сигналы в РЭМ - Электроны Вторичные Ø Энергия < 50 э. В Ø Ускорение к детектору Ø Детектор Эверхарта-Торнли ð Сцинтиллятор + ФЭУ ð Очень эффективен Обратнорассеянные Ø Более направлены Ø Детектор Робинсона ð Кольцевой сцинтиллятор большой площадь + ФЭУ Ø Полупроводниковые детекторы 17
 Методы РЭМ - Топография Ø Топография формируется с помощью вторичных и обратнорассеянных электронов Ø Наклон поверхности – важный параметр Ø Вторичные электроны (SE) ð Контраст как если бы глаз смотрел сверху на объект, освещаемый диффузным светом Ø Обратнорассеянные электроды (BSE) ð Контраст как если бы глаз смотрел сверху на объект, освещаемый параллельным пучком света Ø Большая глубина фокуса по сравнению с оптической микроскопией SE Al на границах зерен SE Полимер SE+BSE Болт 18
Методы РЭМ - Топография Ø Топография формируется с помощью вторичных и обратнорассеянных электронов Ø Наклон поверхности – важный параметр Ø Вторичные электроны (SE) ð Контраст как если бы глаз смотрел сверху на объект, освещаемый диффузным светом Ø Обратнорассеянные электроды (BSE) ð Контраст как если бы глаз смотрел сверху на объект, освещаемый параллельным пучком света Ø Большая глубина фокуса по сравнению с оптической микроскопией SE Al на границах зерен SE Полимер SE+BSE Болт 18
 Химический и структурный анализ 19 Ø Микроанализ (микрозонд) – анализ характеристического рентгеновского излучения ð Качественный локальный анализ состава (количественный сложнее) ð Объем взаимодействия ~ 1 мкм 3 – определяет разрешение ð Либо обычный РЭМ с детектором, либо спец микроскоп ð EDS – Energy Dispersion Analysis – энергодисперсионный анализ ð WDS – Wavelength Dispersion Analysis – спектральнодисперсионный анализ ð Оже спектроскопия
Химический и структурный анализ 19 Ø Микроанализ (микрозонд) – анализ характеристического рентгеновского излучения ð Качественный локальный анализ состава (количественный сложнее) ð Объем взаимодействия ~ 1 мкм 3 – определяет разрешение ð Либо обычный РЭМ с детектором, либо спец микроскоп ð EDS – Energy Dispersion Analysis – энергодисперсионный анализ ð WDS – Wavelength Dispersion Analysis – спектральнодисперсионный анализ ð Оже спектроскопия
 Структурный анализ Ø Дифракция обратнорассеянных электронов ð Наклон ~ 70 градусов ð Проецирование дифракционной картины на экран ð Структурная информация с разрешением ~ 10 нм ð Ориентация кристаллитов 20
Структурный анализ Ø Дифракция обратнорассеянных электронов ð Наклон ~ 70 градусов ð Проецирование дифракционной картины на экран ð Структурная информация с разрешением ~ 10 нм ð Ориентация кристаллитов 20
 21 Дифракция обратно рассеянных электронов Ø Дифракция от кристаллических плоскостей Ø Закон Брегга: nλ = 2 d sinθ Ø Образование линий высокой интенсивности – Кикучи линии
21 Дифракция обратно рассеянных электронов Ø Дифракция от кристаллических плоскостей Ø Закон Брегга: nλ = 2 d sinθ Ø Образование линий высокой интенсивности – Кикучи линии
 22 Дифракция обратно рассеянных электронов Ø Разрешение метода до 10 нм Ø Кристаллографическая информация: ð Текстура ð Размеры и границы зерен ð Фазовый состав
22 Дифракция обратно рассеянных электронов Ø Разрешение метода до 10 нм Ø Кристаллографическая информация: ð Текстура ð Размеры и границы зерен ð Фазовый состав
 Энергодисперсионный анализ ØРаспределение гамма-квантов по энергиям ØУниверсальный, простой и доступный ØОбщая картина, но не дает мелких деталей спектра ØСложно детектировать легкие элементы – только до Na 23
Энергодисперсионный анализ ØРаспределение гамма-квантов по энергиям ØУниверсальный, простой и доступный ØОбщая картина, но не дает мелких деталей спектра ØСложно детектировать легкие элементы – только до Na 23
 Спектральнодисперсионный анализ 24 ØВыделение гамма-квантов с определенной длиной волны § Закон Брегга: nλ = 2 d sinθ ØБолее точный для разрешения отдельных линий ØАнализ вплоть до B и Be
Спектральнодисперсионный анализ 24 ØВыделение гамма-квантов с определенной длиной волны § Закон Брегга: nλ = 2 d sinθ ØБолее точный для разрешения отдельных линий ØАнализ вплоть до B и Be
 25 Химический анализ Частички пороховой сажи Фазы Ba, Pb, Sb Ba (барий) Pb (свинец) Sb (сурьма) 5 µm
25 Химический анализ Частички пороховой сажи Фазы Ba, Pb, Sb Ba (барий) Pb (свинец) Sb (сурьма) 5 µm
 Химический анализ 26 Характеристики WDS EDS Эффективность сбора рентгеновского излучения Низкая – типичный телесный угол около 0. 001 стерадиан Более высокая – обычно 0. 005 -0. 1 стерадиан. ЭД детектор можно приблизить к образцу. Требуемый ток зонда Высокий – обычно не менее 10 н. A из-за низкой эффективности сбора Низкий – вплоть до значений менее 0. 1 н. A Спектральное разрешение Хорошее – зависит от кристалла, обычно порядка 510 э. В Хуже – зависит от энергии, обычно <133 э. В на линииt Mn Ka, <65 э. В на линии С Ka Пределы обнаружения элементов <0. 01%. В зависимости от матрицы и элемента могут Хуже, обычно 0. 1 - 0. 5% достигать нескольких частей на миллион (0, 000 n%) Скорость выполнения анализа Медленная – элементы анализируются последовательно один за другим. Последовательный анализ. Быстрая – все элементы анализируются одновременно. Параллельный анализ. Количественный анализ Легко - измеряется пик и вычитается фон Сложно – для деконволюции перекрывающихся пиков и вычитания фона требуются сложные алгоритмы Применение Требует более высокой квалификации и большего внимания от оператора. Относительно прост в применении благодаря высокой степени автоматизации
Химический анализ 26 Характеристики WDS EDS Эффективность сбора рентгеновского излучения Низкая – типичный телесный угол около 0. 001 стерадиан Более высокая – обычно 0. 005 -0. 1 стерадиан. ЭД детектор можно приблизить к образцу. Требуемый ток зонда Высокий – обычно не менее 10 н. A из-за низкой эффективности сбора Низкий – вплоть до значений менее 0. 1 н. A Спектральное разрешение Хорошее – зависит от кристалла, обычно порядка 510 э. В Хуже – зависит от энергии, обычно <133 э. В на линииt Mn Ka, <65 э. В на линии С Ka Пределы обнаружения элементов <0. 01%. В зависимости от матрицы и элемента могут Хуже, обычно 0. 1 - 0. 5% достигать нескольких частей на миллион (0, 000 n%) Скорость выполнения анализа Медленная – элементы анализируются последовательно один за другим. Последовательный анализ. Быстрая – все элементы анализируются одновременно. Параллельный анализ. Количественный анализ Легко - измеряется пик и вычитается фон Сложно – для деконволюции перекрывающихся пиков и вычитания фона требуются сложные алгоритмы Применение Требует более высокой квалификации и большего внимания от оператора. Относительно прост в применении благодаря высокой степени автоматизации
 Оже спектроскопия ØЭмиссия электронов из тонкого (несколько монослоев) приповерхностного слоя ØПозволяет анализировать химический состав в приповерхностном слое ØПрименение: процессы адсорбции и десорбции на поверхностях твердых тел, коррозии и т. д. 27
Оже спектроскопия ØЭмиссия электронов из тонкого (несколько монослоев) приповерхностного слоя ØПозволяет анализировать химический состав в приповерхностном слое ØПрименение: процессы адсорбции и десорбции на поверхностях твердых тел, коррозии и т. д. 27
 Сопутствующие методики 28 Ø Ионный и электронный полевой проекционный микроскоп ð Автополевая эмиссия с острой иголки при подаче высокого напряжения ð Эмитированные ионы или электроны проецируются на фосфоресцирующий экран Ø Сфокусированный ионный пучок ð Ионная пушка ð Высокоэнергетичные ионы Ga ð Позволяет делать 3 D реконструкцию и модифицировать поверхность Острие W Ионный проекционный микроскоп
Сопутствующие методики 28 Ø Ионный и электронный полевой проекционный микроскоп ð Автополевая эмиссия с острой иголки при подаче высокого напряжения ð Эмитированные ионы или электроны проецируются на фосфоресцирующий экран Ø Сфокусированный ионный пучок ð Ионная пушка ð Высокоэнергетичные ионы Ga ð Позволяет делать 3 D реконструкцию и модифицировать поверхность Острие W Ионный проекционный микроскоп
 Сопутствующие методики 29 Сечение частицы осадка Острие W Ионный проекционный микроскоп
Сопутствующие методики 29 Сечение частицы осадка Острие W Ионный проекционный микроскоп
 Наблюдение непроводящих объектов Ø Суммарный коэффициент выхода обратнорассеянных и вторичных электронов ð Равен 1 только при определенном значении ускоряющего потенциала (зависит от образца) Ø Вообще говоря, образец будет заряжаться ð Отклонения пучка и искажения Ø Проводящие образцы заземляются Ø Непроводящие? ? ? – нельзя использовать! ð Напыление тонкого слоя Au, Pt или углерода – возможны артефакты, повреждающая методика Ø Биологические объекты? Ø Образцы чувствительные к влаге или атмосфере? 30
Наблюдение непроводящих объектов Ø Суммарный коэффициент выхода обратнорассеянных и вторичных электронов ð Равен 1 только при определенном значении ускоряющего потенциала (зависит от образца) Ø Вообще говоря, образец будет заряжаться ð Отклонения пучка и искажения Ø Проводящие образцы заземляются Ø Непроводящие? ? ? – нельзя использовать! ð Напыление тонкого слоя Au, Pt или углерода – возможны артефакты, повреждающая методика Ø Биологические объекты? Ø Образцы чувствительные к влаге или атмосфере? 30
 Низковольтная РЭМ Зависимость выхода вторичных электронов от энергии исходного пучка 31
Низковольтная РЭМ Зависимость выхода вторичных электронов от энергии исходного пучка 31
 32 Низковакуумные РЭМ Ø Низковакуммный микроскоп ð Остаточное давление ~ до 200 Па ð Специальная конструкция камеры и детекторов Ø Микроскоп с режимом естественной среды (ESEM) ð Специальная конструкция ð Газовые буферы ð Остаточное давление до 4000 Па ð Влажность до 100% High Vacuum Region Lower Vacuu m Region Gas flow Ø FEI Quanta 200 3 D пример сочетающий все режимы в одном РЭМ без изменения конфигурации Conical Objective len GSED Gas flow Sample High Pressure Region
32 Низковакуумные РЭМ Ø Низковакуммный микроскоп ð Остаточное давление ~ до 200 Па ð Специальная конструкция камеры и детекторов Ø Микроскоп с режимом естественной среды (ESEM) ð Специальная конструкция ð Газовые буферы ð Остаточное давление до 4000 Па ð Влажность до 100% High Vacuum Region Lower Vacuu m Region Gas flow Ø FEI Quanta 200 3 D пример сочетающий все режимы в одном РЭМ без изменения конфигурации Conical Objective len GSED Gas flow Sample High Pressure Region
 Низковакуумная РЭМ 33
Низковакуумная РЭМ 33
 Локальная компенсация заряда 34
Локальная компенсация заряда 34
 Литография в РЭМ 35
Литография в РЭМ 35
 Литография в РЭМ 36
Литография в РЭМ 36
 Литография в РЭМ Системы RAITH для электроннолучевой литографии ELPHY Quantum e_Li. NE plus RAITH 150 -TWO 37
Литография в РЭМ Системы RAITH для электроннолучевой литографии ELPHY Quantum e_Li. NE plus RAITH 150 -TWO 37


