КРЭМ для студентов 2009.ppt
- Количество слайдов: 133
 1 Кристаллическое строение металлов Металлы в твердом состоянии имеют кристаллическое строение, которое характеризуется упорядоченным расположением атомов в виде трехмерной кристаллической решетки имеющей правильную геометрическую форму. Для описания кристаллического строения металлов часто используют такие понятия как элементарная ячейка, основные типы кристаллической решетки, кристаллографические плоскости и направления, а также представления о симметрии кристаллических структур.
1 Кристаллическое строение металлов Металлы в твердом состоянии имеют кристаллическое строение, которое характеризуется упорядоченным расположением атомов в виде трехмерной кристаллической решетки имеющей правильную геометрическую форму. Для описания кристаллического строения металлов часто используют такие понятия как элементарная ячейка, основные типы кристаллической решетки, кристаллографические плоскости и направления, а также представления о симметрии кристаллических структур.
 2 Элементарная ячейка Элементарные ячейки представляют собой геометрические фигуры, содержащие изображение атомов, перемещением которых можно воспроизвести кристаллическую решетку всего кристалла в целом. При этом атомы в узлах элементарной ячейки, часто представляют в виде точек различного диаметра (рис. 1, а), тогда как в действительности они имеют определенный атомный радиус, вследствие которого располагаются в виде соприкасающихся шаров (рис. 1, б). Элементарную ячейку одного и того же кристалла можно выбрать различными способами (рис. 1, а). В частности все пространство кристалла можно заполнить ячейками с минимальным объемом. Такие ячейки называются примитивными элементарными ячейками. Представление о примитивных элементарных ячейках, часто используется в кристаллографии и физике конденсированного состояния при анализе решеток Бравэ. В физическом металловедении при рассмотрении структуры металлов обычно используют понятие условной элементарной ячейки, которая имеет размер больше чем примитивная ячейка, но в тоже время нагляднее отражает симметрию кристаллической решетки. (а) (б) Рис. 1. (а) Примеры выбора условной и примитивной элементарных ячеек для объемно-центрированной кубической решетки; (б) расположение атомов в виде соприкасающихся шаров для объемно-центрированной кубической решетки.
2 Элементарная ячейка Элементарные ячейки представляют собой геометрические фигуры, содержащие изображение атомов, перемещением которых можно воспроизвести кристаллическую решетку всего кристалла в целом. При этом атомы в узлах элементарной ячейки, часто представляют в виде точек различного диаметра (рис. 1, а), тогда как в действительности они имеют определенный атомный радиус, вследствие которого располагаются в виде соприкасающихся шаров (рис. 1, б). Элементарную ячейку одного и того же кристалла можно выбрать различными способами (рис. 1, а). В частности все пространство кристалла можно заполнить ячейками с минимальным объемом. Такие ячейки называются примитивными элементарными ячейками. Представление о примитивных элементарных ячейках, часто используется в кристаллографии и физике конденсированного состояния при анализе решеток Бравэ. В физическом металловедении при рассмотрении структуры металлов обычно используют понятие условной элементарной ячейки, которая имеет размер больше чем примитивная ячейка, но в тоже время нагляднее отражает симметрию кристаллической решетки. (а) (б) Рис. 1. (а) Примеры выбора условной и примитивной элементарных ячеек для объемно-центрированной кубической решетки; (б) расположение атомов в виде соприкасающихся шаров для объемно-центрированной кубической решетки.
 Элементарная ячейка Всегда можно выбрать такую примитивную ячейку, которая обладала бы полной симметрией относительно кристаллической решетки. Наиболее известным примером такого выбора является ячейка Вигнера-Зейтца. Для построения ячейки Вигнера-Зейтца с центром в некоторой исходной точке нужно провести прямые, соединяющие эту точку со всеми другими точками решетки, после чего построить плоскости, перпендикулярные к этим прямым и делящие их пополам, и выбрать наименьший многогранник, ограниченный построенными плоскостями и содержащий исходную точку. Полученная таким образом ячейка Вигнера-Зейтца для объемно-центрированной кубической решетки имеет вид усеченного октаэдра (рис. 2). Рис. 2. Примитивная элементарная ячейка Вигнера-Зейтца (усеченный октаэдр) в окружении условной элементарной ячейки для объемно-центрированной кубической решетки. 3
Элементарная ячейка Всегда можно выбрать такую примитивную ячейку, которая обладала бы полной симметрией относительно кристаллической решетки. Наиболее известным примером такого выбора является ячейка Вигнера-Зейтца. Для построения ячейки Вигнера-Зейтца с центром в некоторой исходной точке нужно провести прямые, соединяющие эту точку со всеми другими точками решетки, после чего построить плоскости, перпендикулярные к этим прямым и делящие их пополам, и выбрать наименьший многогранник, ограниченный построенными плоскостями и содержащий исходную точку. Полученная таким образом ячейка Вигнера-Зейтца для объемно-центрированной кубической решетки имеет вид усеченного октаэдра (рис. 2). Рис. 2. Примитивная элементарная ячейка Вигнера-Зейтца (усеченный октаэдр) в окружении условной элементарной ячейки для объемно-центрированной кубической решетки. 3
 Основные типы кристаллических решеток 4 Для металлов наиболее распространенными являются три основных типа кристаллической решетки: объемно-центрированная кубическая (ОЦК), гранецентрированная кубическая (ГЦК) и гексагональная плотноупакованная (ГПУ). В ГЦК решетке атомы расположены в вершинах куба и в центре каждой грани (рис. 3, а). Эту упаковку имеют следующие металлы: Cu, Al, -Ni, -Fe и другие. В ОЦК решетке атомы расположены в вершинах куба, а один атом - в центре его объема (рис. 3, б). Эта решетка характерна для Mo, W, Ta, Nb, V, -Fe и других металлов. В ГПУ решетке атомы расположены в вершинах и центре шестигранных оснований призмы, а три атома в средней плоскости призмы (рис. 3, в). Эту решетку имеют Mg, Zn, -Ti, Cd и другие металлы. (а) (б) (в) Рис. 3. Элементарные ячейки основных типов кристаллической решетки металлов: (а) гранецентрированная кубическая; (б) объемно-центрированная кубическая; (в) гексагональная плотноупакованная.
Основные типы кристаллических решеток 4 Для металлов наиболее распространенными являются три основных типа кристаллической решетки: объемно-центрированная кубическая (ОЦК), гранецентрированная кубическая (ГЦК) и гексагональная плотноупакованная (ГПУ). В ГЦК решетке атомы расположены в вершинах куба и в центре каждой грани (рис. 3, а). Эту упаковку имеют следующие металлы: Cu, Al, -Ni, -Fe и другие. В ОЦК решетке атомы расположены в вершинах куба, а один атом - в центре его объема (рис. 3, б). Эта решетка характерна для Mo, W, Ta, Nb, V, -Fe и других металлов. В ГПУ решетке атомы расположены в вершинах и центре шестигранных оснований призмы, а три атома в средней плоскости призмы (рис. 3, в). Эту решетку имеют Mg, Zn, -Ti, Cd и другие металлы. (а) (б) (в) Рис. 3. Элементарные ячейки основных типов кристаллической решетки металлов: (а) гранецентрированная кубическая; (б) объемно-центрированная кубическая; (в) гексагональная плотноупакованная.
 Основные типы кристаллических решеток Расстояние а между атомами по ребру элементарной ячейки называется параметром или постоянной решетки (рис. 4). Важной характеристикой является координационное число, которое представляет собой число атомов находящихся на равном и наименьшем расстоянии от данного атома. В кубической объемно-центрированной решетке на равном и ближайшем расстоянии от центрального атома находится 8 атомов, расположенных в вершинах куба (рис. 4). То есть, координационное число для этой решетки равно 8. Для гранецентрированной кубической и гексагональной плотноупакованной решеток координационное число составляет величину равную 12. d a Рис. 4. Схема, иллюстрирующая число атомов, находящихся на равном и наименьшем расстоянии d от центрального атома в объёмноцентрированной кубической решётке c параметром а. 5
Основные типы кристаллических решеток Расстояние а между атомами по ребру элементарной ячейки называется параметром или постоянной решетки (рис. 4). Важной характеристикой является координационное число, которое представляет собой число атомов находящихся на равном и наименьшем расстоянии от данного атома. В кубической объемно-центрированной решетке на равном и ближайшем расстоянии от центрального атома находится 8 атомов, расположенных в вершинах куба (рис. 4). То есть, координационное число для этой решетки равно 8. Для гранецентрированной кубической и гексагональной плотноупакованной решеток координационное число составляет величину равную 12. d a Рис. 4. Схема, иллюстрирующая число атомов, находящихся на равном и наименьшем расстоянии d от центрального атома в объёмноцентрированной кубической решётке c параметром а. 5
 Плотность упаковки атомов В кристаллической решетке атомы имеют различную плотность упаковки в разных направлениях, вследствие которого появляется зависимость свойств кристалла от направления (рис. 5). Такое явление, когда свойства вещества зависят от направления, называется анизотропией. Для описания явления анизотропии, обычно используют понятия кристаллографической плоскости и кристаллографического направления. (а) (б) Рис. 5. Схема, поясняющая различную плотность атомов в двух плоскостях ОЦК решётки: в плоскости проходящей через боковую грань куба (слева) и в плоскости, проходящей через атом находящейся в центре куба (справа). 6
Плотность упаковки атомов В кристаллической решетке атомы имеют различную плотность упаковки в разных направлениях, вследствие которого появляется зависимость свойств кристалла от направления (рис. 5). Такое явление, когда свойства вещества зависят от направления, называется анизотропией. Для описания явления анизотропии, обычно используют понятия кристаллографической плоскости и кристаллографического направления. (а) (б) Рис. 5. Схема, поясняющая различную плотность атомов в двух плоскостях ОЦК решётки: в плоскости проходящей через боковую грань куба (слева) и в плоскости, проходящей через атом находящейся в центре куба (справа). 6
 Кристаллографические плоскости Плоскости, проведенные через узлы (атомы) кристаллической решетки называются кристаллографическими плоскостями. Для обозначения кристаллографических плоскостей и направлений обычно используют индексы Миллера. Они представляют собой целые числа h, k, l, которые обратно пропорциональны длинам отрезков, отсекаемых кристаллографической плоскостью на осях координат. При этом числа h, k, l выбираются с наименьшим значением не имеющим общего множителя. Другими словами индексы Миллера можно представить следующим образом: где a, b, c длины отрезков отсекаемых плоскостью на координатных осях X, Y, Z (рис. 6). Для того чтобы наглядно представить индексы Миллера, элементарную ячейку кристалла изображают на фоне пространственной системы координат (рис. 6). За единицу измерения вдоль каждой оси принимается период решетки, т. е. длина ребер элементарной ячейки. Индексы Миллера принято обозначать в скобках (hkl). Например Миллера для плоскости, пересекающей оси координат в точках х= 1, у= , z= , индексы Миллера будут(100). (а) (б) Рис. 6. Кристаллографические плоскости в простой кубической решетке: (а) (100); (б) (101). 7
Кристаллографические плоскости Плоскости, проведенные через узлы (атомы) кристаллической решетки называются кристаллографическими плоскостями. Для обозначения кристаллографических плоскостей и направлений обычно используют индексы Миллера. Они представляют собой целые числа h, k, l, которые обратно пропорциональны длинам отрезков, отсекаемых кристаллографической плоскостью на осях координат. При этом числа h, k, l выбираются с наименьшим значением не имеющим общего множителя. Другими словами индексы Миллера можно представить следующим образом: где a, b, c длины отрезков отсекаемых плоскостью на координатных осях X, Y, Z (рис. 6). Для того чтобы наглядно представить индексы Миллера, элементарную ячейку кристалла изображают на фоне пространственной системы координат (рис. 6). За единицу измерения вдоль каждой оси принимается период решетки, т. е. длина ребер элементарной ячейки. Индексы Миллера принято обозначать в скобках (hkl). Например Миллера для плоскости, пересекающей оси координат в точках х= 1, у= , z= , индексы Миллера будут(100). (а) (б) Рис. 6. Кристаллографические плоскости в простой кубической решетке: (а) (100); (б) (101). 7
 8 Кристаллографические направления Прямые, проведенные через узлы решетки, называются кристаллографическими направлениями. Для индицирования кристаллографических направлений используют аналогичные обозначения, но при этом применяют квадратные, а не круглые скобки. Так, например, пространственная диагональ простой кубической решетки имеет направление [111] (рис. 7). При этом в кубической решетке индексы направления, перпендикулярного плоскости (hkl) имеют те же индексы, т. е. [hkl]. Кристаллографические плоскости, имеющие одинаковое атомное строение, например, (001) и (100) или (110) и (011) являются эквивалентными в силу симметрии кристалла. В совокупности их обозначают как плоскости {100} и {110}, соответственно. В общем случае для обозначения плоскостей (hkl) и эквивалентных им в силу симметрии кристалла используют символ {hkl}. Аналогичное правило применяют в отношении кристаллографических направлений. Например, эквивалентные направления [100], [010], [001] в кубическом кристалле обозначают как направление 100. Рис. 7. Изображение кристаллографической плоскости (111) и кристаллографического направления [111] в простой кубической решетке. перпендикулярного ей
8 Кристаллографические направления Прямые, проведенные через узлы решетки, называются кристаллографическими направлениями. Для индицирования кристаллографических направлений используют аналогичные обозначения, но при этом применяют квадратные, а не круглые скобки. Так, например, пространственная диагональ простой кубической решетки имеет направление [111] (рис. 7). При этом в кубической решетке индексы направления, перпендикулярного плоскости (hkl) имеют те же индексы, т. е. [hkl]. Кристаллографические плоскости, имеющие одинаковое атомное строение, например, (001) и (100) или (110) и (011) являются эквивалентными в силу симметрии кристалла. В совокупности их обозначают как плоскости {100} и {110}, соответственно. В общем случае для обозначения плоскостей (hkl) и эквивалентных им в силу симметрии кристалла используют символ {hkl}. Аналогичное правило применяют в отношении кристаллографических направлений. Например, эквивалентные направления [100], [010], [001] в кубическом кристалле обозначают как направление 100. Рис. 7. Изображение кристаллографической плоскости (111) и кристаллографического направления [111] в простой кубической решетке. перпендикулярного ей
 Элементы симметрии кристаллических структур 9 В 1848 году французский ученый О. Бравэ путем математического анализа вывел 14 возможных вариантов пространственных решеток, с помощью которых можно построить структуру любого кристаллического вещества. Эти пространственные решетки получили название решеток Бравэ. Решетка Бравэ является математической моделью, отражающей симметрию кристалла, и она может не совпадать с решеткой реального кристалла. Поэтому следует отличать кристаллическую решетку и решетку Бравэ. В общем случае элементарная ячейка решетки Бравэ имеет вид параллелепипеда, который характеризуется шестью параметрами, трансляциями (переносами) a, b, c, являющими его ребрами и углами между ними , , (рис. 8). Все кристаллические структуры описываются 14 решетками Бравэ, которые подразделяются на 7 кристаллических систем (сингоний) различающихся симметрией элементарных ячеек и кристаллографической системой осей координат: триклинную, моноклинную, ромбическую, тетрагональную, тригональную, гексагональную и кубическую. Каждая система имеет свои соотношения между величинами a, b, c и , , . Рис. 8. Элементарная ячейка решетки Бравэ изображенная в виде параллелепипеда с трансляциями a, b, c и углами между ними , , .
Элементы симметрии кристаллических структур 9 В 1848 году французский ученый О. Бравэ путем математического анализа вывел 14 возможных вариантов пространственных решеток, с помощью которых можно построить структуру любого кристаллического вещества. Эти пространственные решетки получили название решеток Бравэ. Решетка Бравэ является математической моделью, отражающей симметрию кристалла, и она может не совпадать с решеткой реального кристалла. Поэтому следует отличать кристаллическую решетку и решетку Бравэ. В общем случае элементарная ячейка решетки Бравэ имеет вид параллелепипеда, который характеризуется шестью параметрами, трансляциями (переносами) a, b, c, являющими его ребрами и углами между ними , , (рис. 8). Все кристаллические структуры описываются 14 решетками Бравэ, которые подразделяются на 7 кристаллических систем (сингоний) различающихся симметрией элементарных ячеек и кристаллографической системой осей координат: триклинную, моноклинную, ромбическую, тетрагональную, тригональную, гексагональную и кубическую. Каждая система имеет свои соотношения между величинами a, b, c и , , . Рис. 8. Элементарная ячейка решетки Бравэ изображенная в виде параллелепипеда с трансляциями a, b, c и углами между ними , , .
 10 Кристаллические системы Все кристаллические структуры описываются 14 решетками Бравэ, которые подразделяются на 7 кристаллических систем (сингоний) различающихся симметрией элементарных ячеек и кристаллографической системой осей координат: триклинную, моноклинную, ромбическую, тетрагональную, тригональную, гексагональную и кубическую. Каждая система имеет свои соотношения между величинами a, b, c и , , (рис. 9). Кристаллическая система Характеристики элементарной ячейки Кубическая а b c = = 90 o Триклинная а b c 90 o Тригональная Гранецентрированная а b c = = = 90 o Моноклинная Объемноцентрированная а = b c = = = 90 o Ромбическая Базоцентрированная а = b c = = 90 o ; = 120 o Тетрагональная Примитивная а = b = c = = = 90 o Гексагональная Тип решетки a = b = c = = 90 o Рис. 9. 14 решеток Бравэ распределенных по 7 кристаллическим системам.
10 Кристаллические системы Все кристаллические структуры описываются 14 решетками Бравэ, которые подразделяются на 7 кристаллических систем (сингоний) различающихся симметрией элементарных ячеек и кристаллографической системой осей координат: триклинную, моноклинную, ромбическую, тетрагональную, тригональную, гексагональную и кубическую. Каждая система имеет свои соотношения между величинами a, b, c и , , (рис. 9). Кристаллическая система Характеристики элементарной ячейки Кубическая а b c = = 90 o Триклинная а b c 90 o Тригональная Гранецентрированная а b c = = = 90 o Моноклинная Объемноцентрированная а = b c = = = 90 o Ромбическая Базоцентрированная а = b c = = 90 o ; = 120 o Тетрагональная Примитивная а = b = c = = = 90 o Гексагональная Тип решетки a = b = c = = 90 o Рис. 9. 14 решеток Бравэ распределенных по 7 кристаллическим системам.
 Кристаллические системы 11 Кубическая система имеет самые симметричные решетки в форме куба. Ячейка кубической системы может быть примитивной, объемно-центрированная и гране-центрированная. Гексагональная система имеет ячейку в форме прямой призмы с ромбом в основании, причем угол в ромбе равен 60 градусам. Часто рассматривают утроенную ячейку, имеющую вид правильной шестигранной призмы с осью симметрии шестого порядка. В тетрагональной системе ячейка имеет форму прямоугольного параллелепипеда с квадратным основанием. Ячейка может быть примитивной и объемно-центрированной. В ромбической системе ячейка имеет форму прямоугольного параллелепипеда с ребрами разной длины. Ячейка имеет все 4 разновидности. В моноклинной системе ячейка имеет форму прямой призмы с ребрами разной длины. Ячейка может быть с центрированными основаниями прямой призмы и примитивной. В триклинной системе все углы и все длины сторон не равны другу. Данная решетка имеет центр симметрии в центре элементарной ячейки. В тригональной системе ячейку принято выбирать в виде ромбоэдра, все грани которого одинаковые ромбы с углом при вершине 90 о.
Кристаллические системы 11 Кубическая система имеет самые симметричные решетки в форме куба. Ячейка кубической системы может быть примитивной, объемно-центрированная и гране-центрированная. Гексагональная система имеет ячейку в форме прямой призмы с ромбом в основании, причем угол в ромбе равен 60 градусам. Часто рассматривают утроенную ячейку, имеющую вид правильной шестигранной призмы с осью симметрии шестого порядка. В тетрагональной системе ячейка имеет форму прямоугольного параллелепипеда с квадратным основанием. Ячейка может быть примитивной и объемно-центрированной. В ромбической системе ячейка имеет форму прямоугольного параллелепипеда с ребрами разной длины. Ячейка имеет все 4 разновидности. В моноклинной системе ячейка имеет форму прямой призмы с ребрами разной длины. Ячейка может быть с центрированными основаниями прямой призмы и примитивной. В триклинной системе все углы и все длины сторон не равны другу. Данная решетка имеет центр симметрии в центре элементарной ячейки. В тригональной системе ячейку принято выбирать в виде ромбоэдра, все грани которого одинаковые ромбы с углом при вершине 90 о.
 12 Дефекты кристаллического строения металлов В кристаллографии предполагается, что кристаллическое строение металлов характеризуется упорядоченным расположением атомов в виде трехмерной кристаллической решетки имеющей правильную геометрическую форму. Вместе с тем экспериментальные исследования методом просвечивающей электронной микроскопии свидетельствуют, что структура металлов содержит многочисленные дефекты, нарушающие периодичность расположения атомов в кристаллической решетке. Среди них обычно выделяют четыре группы дефектов: - точечные - линейные - поверхностные - объемные
12 Дефекты кристаллического строения металлов В кристаллографии предполагается, что кристаллическое строение металлов характеризуется упорядоченным расположением атомов в виде трехмерной кристаллической решетки имеющей правильную геометрическую форму. Вместе с тем экспериментальные исследования методом просвечивающей электронной микроскопии свидетельствуют, что структура металлов содержит многочисленные дефекты, нарушающие периодичность расположения атомов в кристаллической решетке. Среди них обычно выделяют четыре группы дефектов: - точечные - линейные - поверхностные - объемные
 Точечные дефекты 13 К точечным дефектам относятся дефекты, имеющие малый размер во всех трех измерениях, не превышающий нескольких атомных диаметров (вакансии, междоузельные атомы, примесные атомы). Вакансии представляют собой узлы в кристаллической решетке, свободные от атомов; междоузельные атомы находятся вне узлов кристаллической решетки; примесными атомами называют атомы, которые могут находиться как в междоузлиях (атом внедрения), так и в узлах кристаллической решетки (атом замещения). При образовании точечных дефектов происходит заметное смещение атомов из положения равновесия, что приводит к возникновению внутренних упругих напряжений. Вокруг вакансий смещения соседних атомов невелики и достигают 0, 84% от межатомного расстояния, тогда как вокруг междоузельного атома смещение может быть более значительным, достигая 20% от межатомного расстояния. Это означает, что для образования междоузельного атома требуется значительно больше энергии, чем для образования вакансий. Поэтому основными точечными дефектами в чистых металлах являются вакансии, а концентрация междоузельных атомов по сравнению с концентрацией вакансий невелика. Рис. 10. Точечные дефекты в кристаллической решетке: (а) вакансия; (б) междоузельный атом; (3) примесной атом внедрения; (4) примесной атом замещения.
Точечные дефекты 13 К точечным дефектам относятся дефекты, имеющие малый размер во всех трех измерениях, не превышающий нескольких атомных диаметров (вакансии, междоузельные атомы, примесные атомы). Вакансии представляют собой узлы в кристаллической решетке, свободные от атомов; междоузельные атомы находятся вне узлов кристаллической решетки; примесными атомами называют атомы, которые могут находиться как в междоузлиях (атом внедрения), так и в узлах кристаллической решетки (атом замещения). При образовании точечных дефектов происходит заметное смещение атомов из положения равновесия, что приводит к возникновению внутренних упругих напряжений. Вокруг вакансий смещения соседних атомов невелики и достигают 0, 84% от межатомного расстояния, тогда как вокруг междоузельного атома смещение может быть более значительным, достигая 20% от межатомного расстояния. Это означает, что для образования междоузельного атома требуется значительно больше энергии, чем для образования вакансий. Поэтому основными точечными дефектами в чистых металлах являются вакансии, а концентрация междоузельных атомов по сравнению с концентрацией вакансий невелика. Рис. 10. Точечные дефекты в кристаллической решетке: (а) вакансия; (б) междоузельный атом; (3) примесной атом внедрения; (4) примесной атом замещения.
 Точечные дефекты 14 Концентрация вакансий зависит от температуры, повышение которой ведет к усилению теплового движения атомов вокруг положения равновесия. Для каждой температуры существует своя равновесная концентрация вакансий, которая зависит от температуры как (n/N)~e-E/(k. T), где N общее число атомов в единице объема кристалла, n число вакансий в том же объеме, k постоянная Больцмана, равная 8, 617 х105 э. В/К, Е энергия активации вакансии. Теоретические расчеты показывают, что энергия образования вакансии, например, в чистой меди составляет около 1 э. В, а междоузельного атома от 2. 5 до 3. 5 э. В. Вследствие этого, для меди при Т~103 K относительная доля вакансий составляет примерно 10 -5, т. е. на каждые 105 узлов решетки приходится по одной вакансии. Повышенная концентраций вакансий в металлах может образовываться не только при нагреве, но и в процессе больших пластических деформаций. Например, методом позитронной аннигиляции было показано, что в наноструктурной меди чистотой 99, 99% со средним размером зерен 150 нм, полученной интенсивной пластической деформации кручением, наблюдается образование вакансионных комплексов (состоящих из нескольких вакансий), концентрация которых при комнатной температуре также достигает величины примерно 10 -5 (рис. 10). Рис. 11. Зависимость (1) концентрации и (2) объема вакансионных комплексов от температуры отжига (30 мин) в наноструктурной меди полученной методом интенсивной пластической деформации. Объем вакансионных комплексов выражен в единицах объема моновакансии.
Точечные дефекты 14 Концентрация вакансий зависит от температуры, повышение которой ведет к усилению теплового движения атомов вокруг положения равновесия. Для каждой температуры существует своя равновесная концентрация вакансий, которая зависит от температуры как (n/N)~e-E/(k. T), где N общее число атомов в единице объема кристалла, n число вакансий в том же объеме, k постоянная Больцмана, равная 8, 617 х105 э. В/К, Е энергия активации вакансии. Теоретические расчеты показывают, что энергия образования вакансии, например, в чистой меди составляет около 1 э. В, а междоузельного атома от 2. 5 до 3. 5 э. В. Вследствие этого, для меди при Т~103 K относительная доля вакансий составляет примерно 10 -5, т. е. на каждые 105 узлов решетки приходится по одной вакансии. Повышенная концентраций вакансий в металлах может образовываться не только при нагреве, но и в процессе больших пластических деформаций. Например, методом позитронной аннигиляции было показано, что в наноструктурной меди чистотой 99, 99% со средним размером зерен 150 нм, полученной интенсивной пластической деформации кручением, наблюдается образование вакансионных комплексов (состоящих из нескольких вакансий), концентрация которых при комнатной температуре также достигает величины примерно 10 -5 (рис. 10). Рис. 11. Зависимость (1) концентрации и (2) объема вакансионных комплексов от температуры отжига (30 мин) в наноструктурной меди полученной методом интенсивной пластической деформации. Объем вакансионных комплексов выражен в единицах объема моновакансии.
 Точечные дефекты 15 При отжиге наноструктурной меди выше температуры 200 о. С происходит значительное уменьшение концентрации вакансионных комплексов с одновременным увеличением их объема. В частности после отжига при температуре 400 о. С средний размер вакансионных комплексов достигает размера, соответствующего суммарному объему примерно 25 моновакансий. Этот средний размер вакансионных комплексов складывается из определенного распределения по размерам. При этом наиболее крупные вакансионные комплексы в наноструктурной чистой меди можно видеть на светлопольном изображении в просвечивающем электронном микроскопе в виде редко встречающихся темных точек круглой формы с размером примерно до 5 нм (рис. 11). Рис. 12. Светлопольное изображение в просвечивающем электронном микроскопе наноструктурной меди чистотой 99, 99% после интенсивной пластической деформации кручением и отжига при 190 о. С (30 мин). Съемки структуры сделаны внутри аномально выросшего зерна в областях свободных от дислокаций. Черные точки представляют редко встречающиеся наиболее крупные вакансионные комплексы с размером до 5 нм.
Точечные дефекты 15 При отжиге наноструктурной меди выше температуры 200 о. С происходит значительное уменьшение концентрации вакансионных комплексов с одновременным увеличением их объема. В частности после отжига при температуре 400 о. С средний размер вакансионных комплексов достигает размера, соответствующего суммарному объему примерно 25 моновакансий. Этот средний размер вакансионных комплексов складывается из определенного распределения по размерам. При этом наиболее крупные вакансионные комплексы в наноструктурной чистой меди можно видеть на светлопольном изображении в просвечивающем электронном микроскопе в виде редко встречающихся темных точек круглой формы с размером примерно до 5 нм (рис. 11). Рис. 12. Светлопольное изображение в просвечивающем электронном микроскопе наноструктурной меди чистотой 99, 99% после интенсивной пластической деформации кручением и отжига при 190 о. С (30 мин). Съемки структуры сделаны внутри аномально выросшего зерна в областях свободных от дислокаций. Черные точки представляют редко встречающиеся наиболее крупные вакансионные комплексы с размером до 5 нм.
 Линейные 16 дефекты Наиболее важным видом линейных дефектов являются дислокации, среди которых обычно различают краевые и винтовые дислокации. Краевую дислокацию можно представить в виде края оборванной полуплоскости, которая расположена в верхней части идеального кристалла (рис. 12). Осью или линией краевой дислокации является край оборванной полуплоскости, который иногда называют экстраплоскостью. Рис. 13. Схема краевой дислокации. Светлыми кружочками обозначены атомы. Символ обозначает линию краевой дислокации. Стрелкой указано направление сдвига.
Линейные 16 дефекты Наиболее важным видом линейных дефектов являются дислокации, среди которых обычно различают краевые и винтовые дислокации. Краевую дислокацию можно представить в виде края оборванной полуплоскости, которая расположена в верхней части идеального кристалла (рис. 12). Осью или линией краевой дислокации является край оборванной полуплоскости, который иногда называют экстраплоскостью. Рис. 13. Схема краевой дислокации. Светлыми кружочками обозначены атомы. Символ обозначает линию краевой дислокации. Стрелкой указано направление сдвига.
 Экспериментальное наблюдение дислокаций Ниже представлен пример экспериментального наблюдения дислокаций в виде экстраплоскостей кристаллической решетки в наноструктурном сплаве Al-3%Mg полученном методом интенсивной пластической деформации. На изображении структуры полученной методом высокоразрешающей электронной микроскопии видны некоторые кристаллические плоскости в приграничной области, которые заканчиваются в точках обозначенных символом, что предполагает наличие дислокаций на этих участках. Рис. 14. Электронномикроскопическое изображение высокого разрешения дислокаций в виде экстраплоскостей, отмеченных символом вблизи границы зерна в наноструктурном сплаве Al-3%Mg. 17
Экспериментальное наблюдение дислокаций Ниже представлен пример экспериментального наблюдения дислокаций в виде экстраплоскостей кристаллической решетки в наноструктурном сплаве Al-3%Mg полученном методом интенсивной пластической деформации. На изображении структуры полученной методом высокоразрешающей электронной микроскопии видны некоторые кристаллические плоскости в приграничной области, которые заканчиваются в точках обозначенных символом, что предполагает наличие дислокаций на этих участках. Рис. 14. Электронномикроскопическое изображение высокого разрешения дислокаций в виде экстраплоскостей, отмеченных символом вблизи границы зерна в наноструктурном сплаве Al-3%Mg. 17
 Винтовая дислокация 18 Винтовая дислокация возникает при сдвиге на период решетки одной части кристалла относительно другой вдоль некоторой полуплоскости (рис. 15). Эта полуплоскость обозначена в виде заштрихованной части кристалла. Линия винтовой дислокации, отделяющая сдвинутую часть кристалла от несдвинутой, проходит по направлению АО, отделяя ту часть плоскости скольжения, где сдвиг уже произошел, от той части, где сдвиг еще не происходил. Перемещение от атома к атому вокруг линии дислокации происходит вдоль винтовой линии, что указывает на происхождение термина винтовой дислокации. Из сравнения рис. 13 и рис. 15 видно, что линия краевой дислокации перпендикулярна вектору сдвига, тогда как линия винтовой дислокации параллельна ему. Рис. 15. Схема винтовой дислокации. Линия винтовой дислокации проходит вдоль направления АО. Стрелкой указано направление сдвига.
Винтовая дислокация 18 Винтовая дислокация возникает при сдвиге на период решетки одной части кристалла относительно другой вдоль некоторой полуплоскости (рис. 15). Эта полуплоскость обозначена в виде заштрихованной части кристалла. Линия винтовой дислокации, отделяющая сдвинутую часть кристалла от несдвинутой, проходит по направлению АО, отделяя ту часть плоскости скольжения, где сдвиг уже произошел, от той части, где сдвиг еще не происходил. Перемещение от атома к атому вокруг линии дислокации происходит вдоль винтовой линии, что указывает на происхождение термина винтовой дислокации. Из сравнения рис. 13 и рис. 15 видно, что линия краевой дислокации перпендикулярна вектору сдвига, тогда как линия винтовой дислокации параллельна ему. Рис. 15. Схема винтовой дислокации. Линия винтовой дислокации проходит вдоль направления АО. Стрелкой указано направление сдвига.
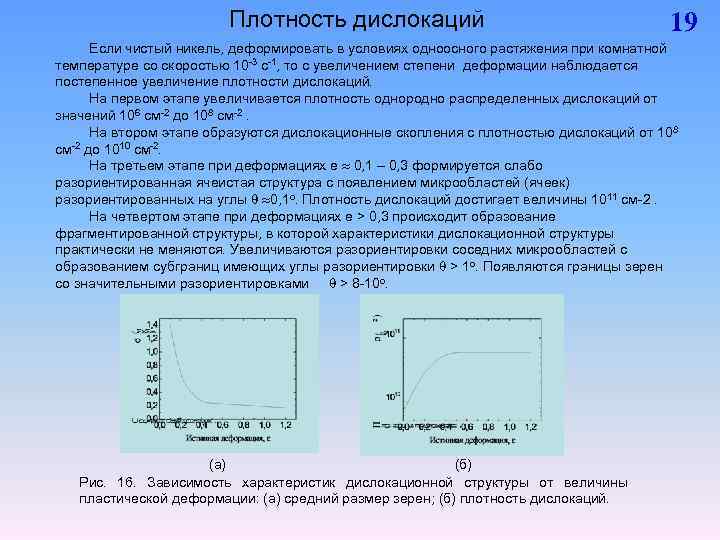 Плотность дислокаций 19 Если чистый никель, деформировать в условиях одноосного растяжения при комнатной температуре со скоростью 10 -3 с-1, то с увеличением степени деформации наблюдается постепенное увеличение плотности дислокаций. На первом этапе увеличивается плотность однородно распределенных дислокаций от значений 106 см-2 до 108 см-2. На втором этапе образуются дислокационные скопления с плотностью дислокаций от 108 см-2 до 1010 см-2. На третьем этапе при деформациях е 0, 1 – 0, 3 формируется слабо разориентированная ячеистая структура с появлением микрообластей (ячеек) разориентированных на углы 0, 1 о. Плотность дислокаций достигает величины 1011 см-2. На четвертом этапе при деформациях е > 0, 3 происходит образование фрагментированной структуры, в которой характеристики дислокационной структуры практически не меняются. Увеличиваются разориентировки соседних микрообластей с образованием субграниц имеющих углы разориентировки > 1 о. Появляются границы зерен со значительными разориентировками > 8 -10 о. (а) (б) Рис. 16. Зависимость характеристик дислокационной структуры от величины пластической деформации: (а) средний размер зерен; (б) плотность дислокаций.
Плотность дислокаций 19 Если чистый никель, деформировать в условиях одноосного растяжения при комнатной температуре со скоростью 10 -3 с-1, то с увеличением степени деформации наблюдается постепенное увеличение плотности дислокаций. На первом этапе увеличивается плотность однородно распределенных дислокаций от значений 106 см-2 до 108 см-2. На втором этапе образуются дислокационные скопления с плотностью дислокаций от 108 см-2 до 1010 см-2. На третьем этапе при деформациях е 0, 1 – 0, 3 формируется слабо разориентированная ячеистая структура с появлением микрообластей (ячеек) разориентированных на углы 0, 1 о. Плотность дислокаций достигает величины 1011 см-2. На четвертом этапе при деформациях е > 0, 3 происходит образование фрагментированной структуры, в которой характеристики дислокационной структуры практически не меняются. Увеличиваются разориентировки соседних микрообластей с образованием субграниц имеющих углы разориентировки > 1 о. Появляются границы зерен со значительными разориентировками > 8 -10 о. (а) (б) Рис. 16. Зависимость характеристик дислокационной структуры от величины пластической деформации: (а) средний размер зерен; (б) плотность дислокаций.
 Экспериментальное наблюдение дислокаций 20 Плотность дислокаций экспериментально определяется, как среднее число линий дислокаций, приходящихся на единицу площади. Ее размерность выражается как суммарная длина всех линий дислокаций в единице объема кристалла см/см 3 или см-2. Для экспериментального определения плотности дислокаций наиболее часто используют метод просвечивающей электронной микроскопии. Для примера на рисунке 17 приведены микрофотографии структуры алюминиевого сплава 1420 со средним размером зерен 1 мкм, на отдельных участках которого наблюдается повышенная плотность дислокаций, достигающая величины более 10 10 см-2. (а) (б) Рис. 17. Электронномикроскопические изображения структуры сплава 1420 со средним размером зерен 1 мкм, содержащей дислокации: (а) светлое поле; (б) темное поле.
Экспериментальное наблюдение дислокаций 20 Плотность дислокаций экспериментально определяется, как среднее число линий дислокаций, приходящихся на единицу площади. Ее размерность выражается как суммарная длина всех линий дислокаций в единице объема кристалла см/см 3 или см-2. Для экспериментального определения плотности дислокаций наиболее часто используют метод просвечивающей электронной микроскопии. Для примера на рисунке 17 приведены микрофотографии структуры алюминиевого сплава 1420 со средним размером зерен 1 мкм, на отдельных участках которого наблюдается повышенная плотность дислокаций, достигающая величины более 10 10 см-2. (а) (б) Рис. 17. Электронномикроскопические изображения структуры сплава 1420 со средним размером зерен 1 мкм, содержащей дислокации: (а) светлое поле; (б) темное поле.
 21 Дефекты кристаллического строения металлов Линейные дефекты Рис. 18. Разомкнутый контур 1 -2 -3 -4 -5 вокруг линии краевой дислокации. Вектор Бюргерса обозначен стрелкой 5 -1.
21 Дефекты кристаллического строения металлов Линейные дефекты Рис. 18. Разомкнутый контур 1 -2 -3 -4 -5 вокруг линии краевой дислокации. Вектор Бюргерса обозначен стрелкой 5 -1.
 22 Дефекты кристаллического строения металлов Линейные дефекты Рис. 19. Пример генерации дислокаций источником Франка-Рида. Линия дислокации лежит в плоскости скольжения, которая совпадает с плоскостью рисунка: (а) – первоначальное положение линии дислокации; (б) - изгиб дислокации под приложенным напряжением; (в) - радиус петли дислокации достигает величины L/2; (г, д) - петля дислокации огибает точки ее крепления; (е, ж) - процесс изгиба новой дислокации.
22 Дефекты кристаллического строения металлов Линейные дефекты Рис. 19. Пример генерации дислокаций источником Франка-Рида. Линия дислокации лежит в плоскости скольжения, которая совпадает с плоскостью рисунка: (а) – первоначальное положение линии дислокации; (б) - изгиб дислокации под приложенным напряжением; (в) - радиус петли дислокации достигает величины L/2; (г, д) - петля дислокации огибает точки ее крепления; (е, ж) - процесс изгиба новой дислокации.
 23 Дефекты кристаллического строения металлов Линейные дефекты (а) (б) Рис. 20. Микрофотография структуры нанокристаллического образца Ni 3 Al полученного методом интенсивной пластической деформации кручением: (а) светлопольное изображение; (б) микрофотография высокого разрешения двойниковой границы.
23 Дефекты кристаллического строения металлов Линейные дефекты (а) (б) Рис. 20. Микрофотография структуры нанокристаллического образца Ni 3 Al полученного методом интенсивной пластической деформации кручением: (а) светлопольное изображение; (б) микрофотография высокого разрешения двойниковой границы.
 24 Дефекты кристаллического строения металлов Поверхностные дефекты Рис. 21. Разориентировка кристаллов с образование границ: (а) наклона; (б) кручения.
24 Дефекты кристаллического строения металлов Поверхностные дефекты Рис. 21. Разориентировка кристаллов с образование границ: (а) наклона; (б) кручения.
 25 Дефекты кристаллического строения металлов Поверхностные дефекты (а) (б) Рис. 22. Структура наблюдаемая методом дифракции отраженных электронов в образцах никеля подвергнутых: (а) интенсивной пластической деформации кручением; (б) равноканальному угловому прессованию. Цветной треугольник представляет собой обратную полюсную фигуру как базис для определения кристаллографического направления в зерне, параллельного нормали к поверхности образца.
25 Дефекты кристаллического строения металлов Поверхностные дефекты (а) (б) Рис. 22. Структура наблюдаемая методом дифракции отраженных электронов в образцах никеля подвергнутых: (а) интенсивной пластической деформации кручением; (б) равноканальному угловому прессованию. Цветной треугольник представляет собой обратную полюсную фигуру как базис для определения кристаллографического направления в зерне, параллельного нормали к поверхности образца.
 26 Дефекты кристаллического строения металлов Поверхностные дефекты (а) (б) Рис. 23. Распределение углов разориентировок в никеле после: (а) интенсивной пластической деформации кручением; (б) равноканального углового прессования.
26 Дефекты кристаллического строения металлов Поверхностные дефекты (а) (б) Рис. 23. Распределение углов разориентировок в никеле после: (а) интенсивной пластической деформации кручением; (б) равноканального углового прессования.
 27 Дефекты кристаллического строения металлов Поверхностные дефекты (а) (б) Рис. 24. Структура никеля после холодной деформации со степенью обжатия 98%: (а) светлопольное изображение; (б) распределение углов разориентировок
27 Дефекты кристаллического строения металлов Поверхностные дефекты (а) (б) Рис. 24. Структура никеля после холодной деформации со степенью обжатия 98%: (а) светлопольное изображение; (б) распределение углов разориентировок
 28 Дефекты кристаллического строения металлов Поверхностные дефекты Рис. 25. Распределение углов разориентировок в магниевом сплаве АМ 60 подвергнутом РКУП при температуре 150 о. С.
28 Дефекты кристаллического строения металлов Поверхностные дефекты Рис. 25. Распределение углов разориентировок в магниевом сплаве АМ 60 подвергнутом РКУП при температуре 150 о. С.
 29 Дефекты кристаллического строения металлов Поверхностные дефекты (а) (б) Рис. 26. Распределение зерен по размерам по результатам исследований методом дифракции отраженных электронов для никеля после: (а) интенсивной пластической деформации кручением; (б) равноканального углового прессования
29 Дефекты кристаллического строения металлов Поверхностные дефекты (а) (б) Рис. 26. Распределение зерен по размерам по результатам исследований методом дифракции отраженных электронов для никеля после: (а) интенсивной пластической деформации кручением; (б) равноканального углового прессования
 30 Дефекты кристаллического строения металлов Объемные дефекты Рис. 27. Поры наблюдаемые в оптическом микроскопе в ультрамелкозернистом сплаве 7075 деформированном при температуре 480 о. С при скорости растяжения 10 -2 с-1 до истинной деформации: (а) 1, 0; (b) 1, 3; (c) 1, 5; (d) 1, 8 (ось растяжения вертикальна).
30 Дефекты кристаллического строения металлов Объемные дефекты Рис. 27. Поры наблюдаемые в оптическом микроскопе в ультрамелкозернистом сплаве 7075 деформированном при температуре 480 о. С при скорости растяжения 10 -2 с-1 до истинной деформации: (а) 1, 0; (b) 1, 3; (c) 1, 5; (d) 1, 8 (ось растяжения вертикальна).
 31 Дефекты кристаллического строения металлов Объемные дефекты Рис. 28. Зависимость объемной доли пор от истинной деформации для ультрамелкозернистого алюминиевого сплава 7075 с различным размером зерен.
31 Дефекты кристаллического строения металлов Объемные дефекты Рис. 28. Зависимость объемной доли пор от истинной деформации для ультрамелкозернистого алюминиевого сплава 7075 с различным размером зерен.
 32 Дефекты кристаллического строения металлов Объемные дефекты Рис. 29. Зависимость объемной доли пор в ультрамелкозернистом алюминиевом сплаве 7075 от величины деформации: (а) при различных скоростях деформации; (б) при различных температурах.
32 Дефекты кристаллического строения металлов Объемные дефекты Рис. 29. Зависимость объемной доли пор в ультрамелкозернистом алюминиевом сплаве 7075 от величины деформации: (а) при различных скоростях деформации; (б) при различных температурах.
 33 Дефекты кристаллического строения металлов Объемные дефекты Рис. 30. Зависимость напряжения от истинной деформации для алюминиевого сплава 7075 с различным размером зерна, и, соответственно с различной объемной долей пор образующейся в процессе сверхпластического течения.
33 Дефекты кристаллического строения металлов Объемные дефекты Рис. 30. Зависимость напряжения от истинной деформации для алюминиевого сплава 7075 с различным размером зерна, и, соответственно с различной объемной долей пор образующейся в процессе сверхпластического течения.
 1 Возможности рентгеноструктурного анализа Одним из важнейших методов изучения внутреннего строения кристаллических веществ является рентгеноструктурный анализ. В основе этого метода лежит явление взаимодействие рентгеновского излучения с электронами вещества, в результате которого возникает дифракция рентгеновских лучей. Используя РСА можно получать информацию о: - фазовом составе, - среднем размере зерен, - внутренних упругих напряжениях, - постоянной решетки, - кристаллографической текстуре
1 Возможности рентгеноструктурного анализа Одним из важнейших методов изучения внутреннего строения кристаллических веществ является рентгеноструктурный анализ. В основе этого метода лежит явление взаимодействие рентгеновского излучения с электронами вещества, в результате которого возникает дифракция рентгеновских лучей. Используя РСА можно получать информацию о: - фазовом составе, - среднем размере зерен, - внутренних упругих напряжениях, - постоянной решетки, - кристаллографической текстуре
 2 Открытие рентгеновских лучей Свое название рентгеновские лучи получили в честь немецкого физика Вильгельма Рентгена, который открыл их в 1895 году. Он заметил, что ранее неизвестные лучи засвечивают фотопластины, защищенные от воздействия света. Он установил также, что эти лучи возникают при столкновении электронов с веществом и не отклоняются магнитным полем. Но в те времена ученым не удалось получить экспериментальных свидетельств об электромагнитной природе рентгеновских лучей, поскольку не удавалось обнаружить связанных с ними волновых явлений: отражения, преломления, поляризации и дифракции. Рентгеновская фотография (рентгенограмма) руки своей жены, сделанная В. К. Рентгеном
2 Открытие рентгеновских лучей Свое название рентгеновские лучи получили в честь немецкого физика Вильгельма Рентгена, который открыл их в 1895 году. Он заметил, что ранее неизвестные лучи засвечивают фотопластины, защищенные от воздействия света. Он установил также, что эти лучи возникают при столкновении электронов с веществом и не отклоняются магнитным полем. Но в те времена ученым не удалось получить экспериментальных свидетельств об электромагнитной природе рентгеновских лучей, поскольку не удавалось обнаружить связанных с ними волновых явлений: отражения, преломления, поляризации и дифракции. Рентгеновская фотография (рентгенограмма) руки своей жены, сделанная В. К. Рентгеном
 Дифракция рентгеновских лучей 3 В 1912 немецкими физиками М. Лауэ, В. Фридрихом и П. Книппингом была открыта дифракция рентгеновских лучей в кристаллических веществах. Направив узкий пучок рентгеновских лучей на неподвижный кристалл, они зарегистрировали на фотопластинке дифракционную картину, Рентенограмма, полученная таким методом, получила название лауэграммы. В этом методе используется непрерывный спектр рентгеновского излучения, которое направляется на неподвижный монокристалл. Характерной особенностью лауэграммы является наличие центрального пятна, образованного неотклонённым рентгеновским пучком, а также большого количества пятен (рефлексов) число и расположение которых зависит от ориентации кристаллографических плоскостей относительно пучка. Лауэграмма ориентированного монокристалла берилла (3 Ве. О • Аl 2 О 3 • 6 Si. O 2). Каждое пятно представляет собой след рентгеновского дифракционного отражения.
Дифракция рентгеновских лучей 3 В 1912 немецкими физиками М. Лауэ, В. Фридрихом и П. Книппингом была открыта дифракция рентгеновских лучей в кристаллических веществах. Направив узкий пучок рентгеновских лучей на неподвижный кристалл, они зарегистрировали на фотопластинке дифракционную картину, Рентенограмма, полученная таким методом, получила название лауэграммы. В этом методе используется непрерывный спектр рентгеновского излучения, которое направляется на неподвижный монокристалл. Характерной особенностью лауэграммы является наличие центрального пятна, образованного неотклонённым рентгеновским пучком, а также большого количества пятен (рефлексов) число и расположение которых зависит от ориентации кристаллографических плоскостей относительно пучка. Лауэграмма ориентированного монокристалла берилла (3 Ве. О • Аl 2 О 3 • 6 Si. O 2). Каждое пятно представляет собой след рентгеновского дифракционного отражения.
 Дифракция рентгеновских лучей 4 В 1913 г. австралийский физик У. Л. Брэгг и одновременно российский ученый Г. В. Вульф предложили наглядную трактовку возникновения дифракционных лучей в кристалле. Они показали, что дифракцию рентгеновских лучей можно объяснить, считая кристалл состоящим из параллельных плоскостей атомов, отстоящих друг от друга на межплоскостное расстояние d. При этом должны соблюдаться два условия. Во-первых, рентгеновские лучи должны испытывать зеркальное отражение, при котором угол падения равен углу отражения. Во-вторых, необходимо, чтобы лучи отраженные от соседних плоскостей взаимно усиливали друга в результате интерференции. В этом случае лучи испытавшие зеркальное отражение от двух соседних плоскостей имеют разность хода равную 2 dsin , где угол падения. Интерференция с усилением будет происходить только в том случае, если разность хода будет составлять целое число волн, что приводит к знаменитому соотношению Вульфа-Брэгга: 2 dhklsin = n где dhkl – межплоскостное расстояние для семейства плоскостей с индексами (hkl); n – порядок отражения; λ – длина волны; θ – угол между падающим лучом и поверхностью образца. Отражение рентгеновских лучей от определенного семейства кристаллографических плоскостей, отстоящих на расстоянии d
Дифракция рентгеновских лучей 4 В 1913 г. австралийский физик У. Л. Брэгг и одновременно российский ученый Г. В. Вульф предложили наглядную трактовку возникновения дифракционных лучей в кристалле. Они показали, что дифракцию рентгеновских лучей можно объяснить, считая кристалл состоящим из параллельных плоскостей атомов, отстоящих друг от друга на межплоскостное расстояние d. При этом должны соблюдаться два условия. Во-первых, рентгеновские лучи должны испытывать зеркальное отражение, при котором угол падения равен углу отражения. Во-вторых, необходимо, чтобы лучи отраженные от соседних плоскостей взаимно усиливали друга в результате интерференции. В этом случае лучи испытавшие зеркальное отражение от двух соседних плоскостей имеют разность хода равную 2 dsin , где угол падения. Интерференция с усилением будет происходить только в том случае, если разность хода будет составлять целое число волн, что приводит к знаменитому соотношению Вульфа-Брэгга: 2 dhklsin = n где dhkl – межплоскостное расстояние для семейства плоскостей с индексами (hkl); n – порядок отражения; λ – длина волны; θ – угол между падающим лучом и поверхностью образца. Отражение рентгеновских лучей от определенного семейства кристаллографических плоскостей, отстоящих на расстоянии d
 5 Длина волны рентгеновских лучей В спектре электромагнитных волн рентгеновские лучи лежат в диапазоне от величины примерно 0, 1 ангстрема до длины волны примерно 300 ангстрем. Малая длина волны рентгеновского излучения по сравнению со световыми волнами, имеющими диапазон (400 -760 нм), обуславливает их способность проникать сквозь непрозрачные для световых лучей объекты и вызывать, например, засвечивание фотопленки защищенные от воздействие света. Длины волн электромагнитного излучения Гамма излучение Рентгеновское излучение Ультрафиолетовое Видимое излучение Инфракрасное излучение Радиоволны < 10− 2 нм 10− 2 – 30 нм 30 - 400 нм 760 нм - 2 мм > 2 мм 400 -760 нм Длина волн рентгеновских лучей, имеющая величину порядка 2 ангстрема сравнима с межатомными расстояниями в кристаллах и размерами атомов. Поэтому рентгеновские лучи часто используются для изучения структуры кристаллических веществ с помощью рентгеноструктурного анализа.
5 Длина волны рентгеновских лучей В спектре электромагнитных волн рентгеновские лучи лежат в диапазоне от величины примерно 0, 1 ангстрема до длины волны примерно 300 ангстрем. Малая длина волны рентгеновского излучения по сравнению со световыми волнами, имеющими диапазон (400 -760 нм), обуславливает их способность проникать сквозь непрозрачные для световых лучей объекты и вызывать, например, засвечивание фотопленки защищенные от воздействие света. Длины волн электромагнитного излучения Гамма излучение Рентгеновское излучение Ультрафиолетовое Видимое излучение Инфракрасное излучение Радиоволны < 10− 2 нм 10− 2 – 30 нм 30 - 400 нм 760 нм - 2 мм > 2 мм 400 -760 нм Длина волн рентгеновских лучей, имеющая величину порядка 2 ангстрема сравнима с межатомными расстояниями в кристаллах и размерами атомов. Поэтому рентгеновские лучи часто используются для изучения структуры кристаллических веществ с помощью рентгеноструктурного анализа.
 Энергия рентгеновского излучения 6 Энергия рентгеновского излучения равна: E = hc/ где: h - постоянная Планка, равная 6, 6262. 10 -34 Дж. с, c - скорость света в вакууме c = 2, 9979. 108 м/c. Энергию жестких рентгеновских лучей традиционно выражают в электронвольтах (э. В), единицей которого является 1 э. В равный 1, 6022. 10 -19 Дж. Если длину волны выразить в ангстремах, а ее энергию в электронвольтах, то энергия рентгеновского излучения будет равна, Е=12, 4/. Следовательно, рентгеновский диапазон длин волн 0, 1 – 300 ангстрем соответствует примерно диапазону энергий 4, 1 - 124 кэ. В. Эти значения энергии рентгеновских лучей примерно в 1000 раз выше, чем для волн видимого света, и сравнимы по величине с энергией связи внутренних электронов атома с ядром. Эта особенность рентгеновских лучей привела к быстрому развитию рентгеновской спектроскопии, позволяющей получить сведения о строении электронных оболочек атомов, а также рентгеноспектральному анализу, с помощью которого можно быстро и надежно определить элементный состав самых разнообразных материалов.
Энергия рентгеновского излучения 6 Энергия рентгеновского излучения равна: E = hc/ где: h - постоянная Планка, равная 6, 6262. 10 -34 Дж. с, c - скорость света в вакууме c = 2, 9979. 108 м/c. Энергию жестких рентгеновских лучей традиционно выражают в электронвольтах (э. В), единицей которого является 1 э. В равный 1, 6022. 10 -19 Дж. Если длину волны выразить в ангстремах, а ее энергию в электронвольтах, то энергия рентгеновского излучения будет равна, Е=12, 4/. Следовательно, рентгеновский диапазон длин волн 0, 1 – 300 ангстрем соответствует примерно диапазону энергий 4, 1 - 124 кэ. В. Эти значения энергии рентгеновских лучей примерно в 1000 раз выше, чем для волн видимого света, и сравнимы по величине с энергией связи внутренних электронов атома с ядром. Эта особенность рентгеновских лучей привела к быстрому развитию рентгеновской спектроскопии, позволяющей получить сведения о строении электронных оболочек атомов, а также рентгеноспектральному анализу, с помощью которого можно быстро и надежно определить элементный состав самых разнообразных материалов.
 Спектр рентгеновского излучения Обычный рентгеновский спектр состоит из непрерывного спектра, вызванного тормозным излучением, и характеристических линий (острые пики К ), которые возникают вследствие взаимодействий ускоренных электронов с электронами внутренней К-оболочки 7
Спектр рентгеновского излучения Обычный рентгеновский спектр состоит из непрерывного спектра, вызванного тормозным излучением, и характеристических линий (острые пики К ), которые возникают вследствие взаимодействий ускоренных электронов с электронами внутренней К-оболочки 7
 8 Спектр рентгеновского излучения При обычном способе получения рентгеновского излучения, например, с помощью рентгеновских трубок, получают широкий диапазон длин волн, который называют рентгеновским спектром, который состоит из тормозной и характеристической составляющих. Тормозное излучение имеет широкий непрерывный спектр, появление которого вызвано торможением электронов на материале анода. Мощность тормозного рентгеновского излучения P зависит от порядкового атомного номера материала анода Z, силы тока I, протекающего через трубку, квадрата приложенного напряжения U, и выражается формулой где k = 1, 5 106. P = k I Z U 2 , Коэффициент полезного действия трубки h= P/I U составляет примерно 2% для трубки с анодом из вольфрама при напряжении 200 к. В.
8 Спектр рентгеновского излучения При обычном способе получения рентгеновского излучения, например, с помощью рентгеновских трубок, получают широкий диапазон длин волн, который называют рентгеновским спектром, который состоит из тормозной и характеристической составляющих. Тормозное излучение имеет широкий непрерывный спектр, появление которого вызвано торможением электронов на материале анода. Мощность тормозного рентгеновского излучения P зависит от порядкового атомного номера материала анода Z, силы тока I, протекающего через трубку, квадрата приложенного напряжения U, и выражается формулой где k = 1, 5 106. P = k I Z U 2 , Коэффициент полезного действия трубки h= P/I U составляет примерно 2% для трубки с анодом из вольфрама при напряжении 200 к. В.
 Спектр рентгеновского излучения Другой особенностью рентгеновского спектра является наличие отчетливо выраженных пиков характеристического излучения, которое возникает вследствие взаимодействий ускоренных электронов с электронами внутренней К-оболочки. Как известно, атомы состоят из ядер, окруженных электронами, энергии которых имеет дискретные значения. Энергетические уровни электронов сгруппированы по электронным оболочкам, которые обозначаются символами K, L, M и т. д. Когда налетающий электрон сталкивается с одним из электронов, находящимся, например, на K-оболочке, он выбивает его. Опустевшее место занимает электрон с другой L- или M-оболочки, которой соответствует большая энергия. В этом случае возникает К излучение, а во втором К излучение характеристического спектра. Поскольку электроны оболочек имеют дискретные значения энергии, возникающие рентгеновские фотоны тоже обладают дискретным спектром. Этому соответствуют острые пики для определенных длин волн, конкретные значения которых зависят от атомного номера элементов входящих в состав материала мишени. Характеристические линии образуют K-, L- и M-серии, в зависимости от того, с какой оболочки (K, L или M) был удален электрон. 9
Спектр рентгеновского излучения Другой особенностью рентгеновского спектра является наличие отчетливо выраженных пиков характеристического излучения, которое возникает вследствие взаимодействий ускоренных электронов с электронами внутренней К-оболочки. Как известно, атомы состоят из ядер, окруженных электронами, энергии которых имеет дискретные значения. Энергетические уровни электронов сгруппированы по электронным оболочкам, которые обозначаются символами K, L, M и т. д. Когда налетающий электрон сталкивается с одним из электронов, находящимся, например, на K-оболочке, он выбивает его. Опустевшее место занимает электрон с другой L- или M-оболочки, которой соответствует большая энергия. В этом случае возникает К излучение, а во втором К излучение характеристического спектра. Поскольку электроны оболочек имеют дискретные значения энергии, возникающие рентгеновские фотоны тоже обладают дискретным спектром. Этому соответствуют острые пики для определенных длин волн, конкретные значения которых зависят от атомного номера элементов входящих в состав материала мишени. Характеристические линии образуют K-, L- и M-серии, в зависимости от того, с какой оболочки (K, L или M) был удален электрон. 9
 Закон Мозли 10 Соотношение между длиной волны характеристического излучения и атомным номером называется законом Мозли. В общем виде оно имеет следующий вид: = 1/R(Z- 1)2(n 1 -2 – no-2) где R – постоянная Ридберга; n – целое число, которое характеризует положение электрона на электронной оболочке (квантовое число); 1 – постоянная экранирования, Z – атомный номер элемента анода. Длина волны характеристического рентгеновского излучения, испускаемого химическими элементами, зависит от атомного номера элемента. Кривая соответствует закону Мозли: чем больше атомный номер элемента, тем меньше длина волны характеристической линии.
Закон Мозли 10 Соотношение между длиной волны характеристического излучения и атомным номером называется законом Мозли. В общем виде оно имеет следующий вид: = 1/R(Z- 1)2(n 1 -2 – no-2) где R – постоянная Ридберга; n – целое число, которое характеризует положение электрона на электронной оболочке (квантовое число); 1 – постоянная экранирования, Z – атомный номер элемента анода. Длина волны характеристического рентгеновского излучения, испускаемого химическими элементами, зависит от атомного номера элемента. Кривая соответствует закону Мозли: чем больше атомный номер элемента, тем меньше длина волны характеристической линии.
 Энергодисперсионный анализ По длине волны характеристического излучения можно определять атомный номер любого химического элемента с применением энергодисперсионного анализа. Например, ниже представлены спектры энергодисперсионного анализа двух частиц выделений в ультрамелкозернистом магниевом сплаве АМ 60 полученном методом равноканального углового прессования. Видно, что частицы размером 0, 5 мкм содержат Al и Mg, тогда как частицы с размером менее 30 нм дополнительно содержат Mn. (а) (б) (а) Микроструктура магниевого сплава AM 60 после РКУП при температуре 150 o. C; (б) энерго-дисперсионный анализ частиц в РКУ прессованных образцах исследуемого АМ 60 сплава. 11
Энергодисперсионный анализ По длине волны характеристического излучения можно определять атомный номер любого химического элемента с применением энергодисперсионного анализа. Например, ниже представлены спектры энергодисперсионного анализа двух частиц выделений в ультрамелкозернистом магниевом сплаве АМ 60 полученном методом равноканального углового прессования. Видно, что частицы размером 0, 5 мкм содержат Al и Mg, тогда как частицы с размером менее 30 нм дополнительно содержат Mn. (а) (б) (а) Микроструктура магниевого сплава AM 60 после РКУП при температуре 150 o. C; (б) энерго-дисперсионный анализ частиц в РКУ прессованных образцах исследуемого АМ 60 сплава. 11
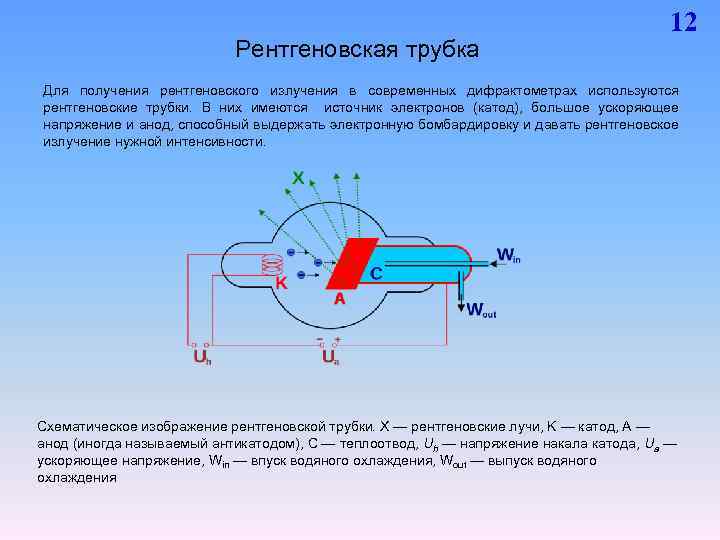 Рентгеновская трубка 12 Для получения рентгеновского излучения в современных дифрактометрах используются рентгеновские трубки. В них имеются источник электронов (катод), большое ускоряющее напряжение и анод, способный выдержать электронную бомбардировку и давать рентгеновское излучение нужной интенсивности. Схематическое изображение рентгеновской трубки. X — рентгеновские лучи, K — катод, А — анод (иногда называемый антикатодом), С — теплоотвод, Uh — напряжение накала катода, Ua — ускоряющее напряжение, Win — впуск водяного охлаждения, Wout — выпуск водяного охлаждения
Рентгеновская трубка 12 Для получения рентгеновского излучения в современных дифрактометрах используются рентгеновские трубки. В них имеются источник электронов (катод), большое ускоряющее напряжение и анод, способный выдержать электронную бомбардировку и давать рентгеновское излучение нужной интенсивности. Схематическое изображение рентгеновской трубки. X — рентгеновские лучи, K — катод, А — анод (иногда называемый антикатодом), С — теплоотвод, Uh — напряжение накала катода, Ua — ускоряющее напряжение, Win — впуск водяного охлаждения, Wout — выпуск водяного охлаждения
 Рентгеновская трубка 13 В современной рентгеновской трубке (рис. 35) в качестве источника электронов используется вольфрамовый катод, нагреваемый до высокой температуры. Для ускорения электронов накладывается большая разность потенциалов между анодом (или антикатодом) и катодом. Поскольку электроны должны достичь анода без столкновений с атомами, необходим очень высокий вакуум, для чего нужно хорошо откачать трубку. Этим также снижаются вероятность ионизации оставшихся атомов газа и обусловленные ею побочные токи. Схема рентгеновской трубки: 1 – металлический анодный стакан; 2 – окна из бериллия для выхода рентгеновского излучения; 3 – термоэмиссионный катод; 4 – стеклянная трубка, изолирующая анодную часть трубки от катодной; 5 – выводы катода, к которым подводится напряжение накала, а также высокое (относительно анода) напряжение; 6 – электростатическая система фокусировки электронов; 7 – анод (антикатод); 8 – патрубки для ввода и вывода проточной воды, охлаждающей анодный стакан.
Рентгеновская трубка 13 В современной рентгеновской трубке (рис. 35) в качестве источника электронов используется вольфрамовый катод, нагреваемый до высокой температуры. Для ускорения электронов накладывается большая разность потенциалов между анодом (или антикатодом) и катодом. Поскольку электроны должны достичь анода без столкновений с атомами, необходим очень высокий вакуум, для чего нужно хорошо откачать трубку. Этим также снижаются вероятность ионизации оставшихся атомов газа и обусловленные ею побочные токи. Схема рентгеновской трубки: 1 – металлический анодный стакан; 2 – окна из бериллия для выхода рентгеновского излучения; 3 – термоэмиссионный катод; 4 – стеклянная трубка, изолирующая анодную часть трубки от катодной; 5 – выводы катода, к которым подводится напряжение накала, а также высокое (относительно анода) напряжение; 6 – электростатическая система фокусировки электронов; 7 – анод (антикатод); 8 – патрубки для ввода и вывода проточной воды, охлаждающей анодный стакан.
 14 Рентгеновская трубка В рентгеноструктурном анализе используются трубки с анодами из Cr, Fe, Co, Ni, Cu, Mo, Ag. Kα Kα 1 Kα 2 Kβ 1 Kβ 2 Fe 0, 193735 0, 193604 0, 193998 0, 17566 0, 17442 Cu 0, 154184 0, 154056 0, 154439 0, 139222 0, 138109 Ag 0, 0560834 0, 0559363 0, 0563775 Cr 0, 2291 0, 22897 0, 229361 Co 0, 179026 0, 178897 0, 179285 Mo 0, 071073 0, 07093 0, 071359 0, 165791 0, 166175 0, 15001 0, 14886 Ni
14 Рентгеновская трубка В рентгеноструктурном анализе используются трубки с анодами из Cr, Fe, Co, Ni, Cu, Mo, Ag. Kα Kα 1 Kα 2 Kβ 1 Kβ 2 Fe 0, 193735 0, 193604 0, 193998 0, 17566 0, 17442 Cu 0, 154184 0, 154056 0, 154439 0, 139222 0, 138109 Ag 0, 0560834 0, 0559363 0, 0563775 Cr 0, 2291 0, 22897 0, 229361 Co 0, 179026 0, 178897 0, 179285 Mo 0, 071073 0, 07093 0, 071359 0, 165791 0, 166175 0, 15001 0, 14886 Ni
 Методы рентгеноструктурного анализа 15 Методы рентгеноструктурного анализа подразделяются на: - методы исследования монокристаллов - методы исследования поликристаллов В зависимости от способа регистрации дифракционной картины выделяют фотографические и дифракционные методы исследования. В фотографических методах съемка производится в рентгеновских камерах с регистрацией на фотопленку (рентгенограмму). В дифракционных методах для съемки используют дифрактометры, в которых регистрация интенсивности рентгеновского лучей производится с помощью счетчиков (детекторов) излучения. В свою очередь, среди методов исследования монокристалла выделяют метод неподвижного монокристалла (метод Лауэ) и метод вращающегося монокристалла.
Методы рентгеноструктурного анализа 15 Методы рентгеноструктурного анализа подразделяются на: - методы исследования монокристаллов - методы исследования поликристаллов В зависимости от способа регистрации дифракционной картины выделяют фотографические и дифракционные методы исследования. В фотографических методах съемка производится в рентгеновских камерах с регистрацией на фотопленку (рентгенограмму). В дифракционных методах для съемки используют дифрактометры, в которых регистрация интенсивности рентгеновского лучей производится с помощью счетчиков (детекторов) излучения. В свою очередь, среди методов исследования монокристалла выделяют метод неподвижного монокристалла (метод Лауэ) и метод вращающегося монокристалла.
 Метод Лауэ 16 В методе Лауэ пучок рентгеновских лучей, имеющий непрерывный спектр, направляют на неподвижный монокристалл. Лучи прошедшие через кристалл, в результате интерференции отклоняются от центрального пятна, образуя дифракционную картину в виде серии пятен на установленной за образцом пленке. Расположение дифракционных пятен на лауэграммах зависит от симметрии кристалла и его ориентации относительно падающего луча. Метод Лауэ позволяет определить кристаллографическое направление в кристалле, установить его симметрию и выявить дефекты кристаллической структуры. При этом, однако, утрачивается информация о межплоскостных расстояниях. Поэтому этот метод используют в основном для проверки качества монокристаллов при выборе образца для его более полного структурного исследования. Схема съемки рентгенограмм по методу Лауэ: 1 - направление падения рентгеновских лучей; 2 – коллиматор; 3 – монокристаллический образец; 4 – дифрагированные лучи; 5 – плоская фотоплёнка.
Метод Лауэ 16 В методе Лауэ пучок рентгеновских лучей, имеющий непрерывный спектр, направляют на неподвижный монокристалл. Лучи прошедшие через кристалл, в результате интерференции отклоняются от центрального пятна, образуя дифракционную картину в виде серии пятен на установленной за образцом пленке. Расположение дифракционных пятен на лауэграммах зависит от симметрии кристалла и его ориентации относительно падающего луча. Метод Лауэ позволяет определить кристаллографическое направление в кристалле, установить его симметрию и выявить дефекты кристаллической структуры. При этом, однако, утрачивается информация о межплоскостных расстояниях. Поэтому этот метод используют в основном для проверки качества монокристаллов при выборе образца для его более полного структурного исследования. Схема съемки рентгенограмм по методу Лауэ: 1 - направление падения рентгеновских лучей; 2 – коллиматор; 3 – монокристаллический образец; 4 – дифрагированные лучи; 5 – плоская фотоплёнка.
 Метод вращающегося кристалла 17 В методе вращающегося кристалла используют монохроматическое рентгеновское излучение и вращающийся образец. Вращение образца необходимо, чтобы выполнялось условие отражения Вульфа-Брэгга, так как при неподвижном кристалле монохроматический луч может не составить требуемого угла. Вращение производится вокруг оси, совпадающей с кристаллографическим направлением, вдоль которого исследуют межплоскостные расстояния. Метод вращающего монокристалла используют для определения формы и размера элементарной ячейки. В частности, он позволяет, установить параметры а, b, с элементарной ячейки кристалла. Схема съемки рентгенограммы по методу вращения: 1 – направление падения рентгеновских лучей; 2 – вращающийся образец; 3 – фотоплёнка цилиндрической формы; 4 – дифрагированные лучи.
Метод вращающегося кристалла 17 В методе вращающегося кристалла используют монохроматическое рентгеновское излучение и вращающийся образец. Вращение образца необходимо, чтобы выполнялось условие отражения Вульфа-Брэгга, так как при неподвижном кристалле монохроматический луч может не составить требуемого угла. Вращение производится вокруг оси, совпадающей с кристаллографическим направлением, вдоль которого исследуют межплоскостные расстояния. Метод вращающего монокристалла используют для определения формы и размера элементарной ячейки. В частности, он позволяет, установить параметры а, b, с элементарной ячейки кристалла. Схема съемки рентгенограммы по методу вращения: 1 – направление падения рентгеновских лучей; 2 – вращающийся образец; 3 – фотоплёнка цилиндрической формы; 4 – дифрагированные лучи.
 Метод Дебая-Шерера 18 Метод Дебая-Шерера предназначен для исследования поликристаллических материалов. В этом методе используют монохроматическое излучение, поскольку в поликристаллическом образце всегда присутствуют многочисленные мелкие кристаллиты случайной ориентации, которые удовлетворяют условию Вульфа-Брэгга. Для съемки обычно используется узкая полоска рентгеновской пленки в цилиндрической кассете, а рентгеновские лучи распространяются по диаметру через отверстия в пленке. Схема съемки рентгенограммы по методу Дебая-Шерера: 1 - направление падения рентгеновских лучей образец, 2 – порошковый образец, 3 – фотопленка, 4 - дифрагированные лучи, 5 – линии на фотопленке.
Метод Дебая-Шерера 18 Метод Дебая-Шерера предназначен для исследования поликристаллических материалов. В этом методе используют монохроматическое излучение, поскольку в поликристаллическом образце всегда присутствуют многочисленные мелкие кристаллиты случайной ориентации, которые удовлетворяют условию Вульфа-Брэгга. Для съемки обычно используется узкая полоска рентгеновской пленки в цилиндрической кассете, а рентгеновские лучи распространяются по диаметру через отверстия в пленке. Схема съемки рентгенограммы по методу Дебая-Шерера: 1 - направление падения рентгеновских лучей образец, 2 – порошковый образец, 3 – фотопленка, 4 - дифрагированные лучи, 5 – линии на фотопленке.
 Метод Дебая-Шерера 19 Рентгенограмма поликристаллов полученная методом Дебая-Шерера представляет собой несколько линий соответствующих различным межплоскостным расстояниям. Рентгенограммы различных веществ имеют индивидуальный характер и широко используются для идентификации фазового состава, определения размеров кристаллитов, внутренних напряжений и кристаллографической текстуры. Вид рентгенограммы снятой по методу Дебая-Шерера. Каждая линия обусловлена дифракцией рентгеновского излучения на одной конкретной плоскости атомов образца.
Метод Дебая-Шерера 19 Рентгенограмма поликристаллов полученная методом Дебая-Шерера представляет собой несколько линий соответствующих различным межплоскостным расстояниям. Рентгенограммы различных веществ имеют индивидуальный характер и широко используются для идентификации фазового состава, определения размеров кристаллитов, внутренних напряжений и кристаллографической текстуры. Вид рентгенограммы снятой по методу Дебая-Шерера. Каждая линия обусловлена дифракцией рентгеновского излучения на одной конкретной плоскости атомов образца.
 Рентгеноструктурный анализ объемных наноматериалов 20 Рентгноструктурный анализ (РСА) является одним из методов дающих важную информацию о структуре объемных наноматериалов. В частности, методом РСА показано, что общий вид рентгенограмм наноструктурных материалов, полученных методоми ИПД существенно отличается от рентгенограмм соответствующих крупнокристаллических материалов. Эти отличия проявляются, прежде всего: - в изменении интегральной интенсивности фона, - в изменении ширины и интенсивности рентгеновских пиков, - в появлении кристаллографической текстуры. Рентгенограмма меди: (а) крупнокристаллический образец; (б) ультрамелкозернистый образец полученный методом равноканального углового прессования.
Рентгеноструктурный анализ объемных наноматериалов 20 Рентгноструктурный анализ (РСА) является одним из методов дающих важную информацию о структуре объемных наноматериалов. В частности, методом РСА показано, что общий вид рентгенограмм наноструктурных материалов, полученных методоми ИПД существенно отличается от рентгенограмм соответствующих крупнокристаллических материалов. Эти отличия проявляются, прежде всего: - в изменении интегральной интенсивности фона, - в изменении ширины и интенсивности рентгеновских пиков, - в появлении кристаллографической текстуры. Рентгенограмма меди: (а) крупнокристаллический образец; (б) ультрамелкозернистый образец полученный методом равноканального углового прессования.
 Интегральная интенсивность фона 21 Фон на рентгенограмме является результатом диффузного рассеяния рентгеновских лучей. Причинами появления фона в чистых металлах могут быть тепловое диффузное рассеяние, а также отсутствие дальнего и (или) ближнего порядка в расположении атомов. Поскольку в наноструктурных материалов значительный объем принадлежит границам зерен, то смещение атомов в границах зерен из равновесных положений в кристаллической решетке, должно существенно влиять на интенсивность диффузного рассеяния рентгеновских лучей. Результаты расчетов показали, что интегральная интенсивность фона на рентгенограмме наноструктурных образцов Cu, полученных ИПДК и РКУП, превышает соответствующее значение для крупнокристаллической Cu на величины 6 3 % и 6, 1 2, 7 %, соответственно. Повышение интегральной интенсивности диффузного фона указывает на повышенную концентрацию дефектов кристаллического строения и возможно увеличенные амплитуды тепловых колебаний в наноструктурной меди.
Интегральная интенсивность фона 21 Фон на рентгенограмме является результатом диффузного рассеяния рентгеновских лучей. Причинами появления фона в чистых металлах могут быть тепловое диффузное рассеяние, а также отсутствие дальнего и (или) ближнего порядка в расположении атомов. Поскольку в наноструктурных материалов значительный объем принадлежит границам зерен, то смещение атомов в границах зерен из равновесных положений в кристаллической решетке, должно существенно влиять на интенсивность диффузного рассеяния рентгеновских лучей. Результаты расчетов показали, что интегральная интенсивность фона на рентгенограмме наноструктурных образцов Cu, полученных ИПДК и РКУП, превышает соответствующее значение для крупнокристаллической Cu на величины 6 3 % и 6, 1 2, 7 %, соответственно. Повышение интегральной интенсивности диффузного фона указывает на повышенную концентрацию дефектов кристаллического строения и возможно увеличенные амплитуды тепловых колебаний в наноструктурной меди.
 Уширение рентгеновских пиков Другой особенностью рентгеновских дифрактограмм в наноструктурных ИПД материалах, является значительное уменьшение интенсивности и сильное уширение рентгеновских пиков. Об этом свидетельствует, в частности, сравнение профилей рентгеновских пиков в наноструктурной и отожженной меди. Сравнение профиля рентгеновских пиков 400 для меди: (1) после деформации кручением; (2) после дополнительного отжига при 175 о. С. 22
Уширение рентгеновских пиков Другой особенностью рентгеновских дифрактограмм в наноструктурных ИПД материалах, является значительное уменьшение интенсивности и сильное уширение рентгеновских пиков. Об этом свидетельствует, в частности, сравнение профилей рентгеновских пиков в наноструктурной и отожженной меди. Сравнение профиля рентгеновских пиков 400 для меди: (1) после деформации кручением; (2) после дополнительного отжига при 175 о. С. 22
 Уширение рентгеновских пиков Профили рентгеновских пиков для отражения 220 в германии: (1) после деформации кручением; (2, 3, 4) после дополнительных отжигов при (2) 300 о. С; (3) 400 о. С; (4) 800 о. С. 23
Уширение рентгеновских пиков Профили рентгеновских пиков для отражения 220 в германии: (1) после деформации кручением; (2, 3, 4) после дополнительных отжигов при (2) 300 о. С; (3) 400 о. С; (4) 800 о. С. 23
 Анализ уширения рентгеновских пиков 24 Анализ уширения рентгеновских пиков дает ценную информацию о величине упругих деформаций и размере зерен-кристаллитов в поликристаллических материалах. Для определения этих величин было развито несколько подходов, наибольшее распространение из которых получили методы Уоррена-Авербаха и Вильямсона-Холла. Суть метода Уоррена-Авербаха состоит в разделении вкладов размера зерен и упругих деформаций в уширение пиков, основанном на их различной зависимости от порядка отражения. При этом, используется апроксимация физического профиля рядом Фурье и определяются коэффициенты этого разложения. Метод Уоррена-Авербаха дает усредненный по поверхности размер зерен. Метод Вильямсона-Холла применяют в тех случаях, когда рентгеновские пики, соответствующие отражениям разного порядка от одного семейства плоскостей, отсутствуют или не обладают формой, благоприятной для разложения в ряд Фурье. Размер зерен получают путем экстраполяции графика зависимости интегральной ширины от величины вектора рассеяния на значение последнего, равное нулю. При этом, получаемый размер зерен усреднен по объему.
Анализ уширения рентгеновских пиков 24 Анализ уширения рентгеновских пиков дает ценную информацию о величине упругих деформаций и размере зерен-кристаллитов в поликристаллических материалах. Для определения этих величин было развито несколько подходов, наибольшее распространение из которых получили методы Уоррена-Авербаха и Вильямсона-Холла. Суть метода Уоррена-Авербаха состоит в разделении вкладов размера зерен и упругих деформаций в уширение пиков, основанном на их различной зависимости от порядка отражения. При этом, используется апроксимация физического профиля рядом Фурье и определяются коэффициенты этого разложения. Метод Уоррена-Авербаха дает усредненный по поверхности размер зерен. Метод Вильямсона-Холла применяют в тех случаях, когда рентгеновские пики, соответствующие отражениям разного порядка от одного семейства плоскостей, отсутствуют или не обладают формой, благоприятной для разложения в ряд Фурье. Размер зерен получают путем экстраполяции графика зависимости интегральной ширины от величины вектора рассеяния на значение последнего, равное нулю. При этом, получаемый размер зерен усреднен по объему.
 Анализ уширения рентгеновских пиков 25 В целом компьютерные программы обработки рентгеновских данных, предназначенные для разделения вкладов областей когерентного рассеяния и среднеквадратичного микроискажений кристаллической решетки, основаны на использовании уравнения Шеррера-Вильсона : = / Dhkl + < hkl 2>1/2 где равняется p cos / , p интегральная ширина физического профиля, - вектор рассеяния равный 4 sin /. Диаграммы, построенные по методу Вильямсона - Холла для определения величины полей упругих напряжений и областей когерентного рассеяния для наноструктурной меди.
Анализ уширения рентгеновских пиков 25 В целом компьютерные программы обработки рентгеновских данных, предназначенные для разделения вкладов областей когерентного рассеяния и среднеквадратичного микроискажений кристаллической решетки, основаны на использовании уравнения Шеррера-Вильсона : = / Dhkl + < hkl 2>1/2 где равняется p cos / , p интегральная ширина физического профиля, - вектор рассеяния равный 4 sin /. Диаграммы, построенные по методу Вильямсона - Холла для определения величины полей упругих напряжений и областей когерентного рассеяния для наноструктурной меди.
 1 Просвечивающая электронная микроскопия Электронная микроскопия является эффективным методом исследования структуры металлов и сплавов. В ее основе лежит явление дифракции ускоренных электронов на кристаллической решетке исследуемого материала. Вследствие очень малой длины волны электронов разрешающая способность современных электронных микроскопов составляет несколько ангстрем, что позволяет использовать их для получения изображения структурных элементов с увеличением до 2. 000, тогда как максимальное увеличение, получаемое методом оптической микроскопии, не превышает 2000.
1 Просвечивающая электронная микроскопия Электронная микроскопия является эффективным методом исследования структуры металлов и сплавов. В ее основе лежит явление дифракции ускоренных электронов на кристаллической решетке исследуемого материала. Вследствие очень малой длины волны электронов разрешающая способность современных электронных микроскопов составляет несколько ангстрем, что позволяет использовать их для получения изображения структурных элементов с увеличением до 2. 000, тогда как максимальное увеличение, получаемое методом оптической микроскопии, не превышает 2000.
 Взаимодействие электронов с веществом 2 В 1924 году французским физиком де Бройлем было сделано предположение, что все частицы, в том числе и электроны, обладают волновыми свойствами. Согласно де Бройлю, длина волны электрона связана с его импульсом P соотношением: = h/Р (1) где: h – постоянная Планка. В свою очередь импульс электрона P равен: P = mv (2) где: m – масса электрона, v – скорость электрона. Если электрон поместить в электрическое поле, то его кинетическая энергия mv 2/2 будет равна работе, совершаемой полем по ускорению электрона e. U, где e – заряд электронов, U - разность потенциалов ускоряющего напряжения. Отсюда получаем соотношение: mv 2/2 = e. U (3)
Взаимодействие электронов с веществом 2 В 1924 году французским физиком де Бройлем было сделано предположение, что все частицы, в том числе и электроны, обладают волновыми свойствами. Согласно де Бройлю, длина волны электрона связана с его импульсом P соотношением: = h/Р (1) где: h – постоянная Планка. В свою очередь импульс электрона P равен: P = mv (2) где: m – масса электрона, v – скорость электрона. Если электрон поместить в электрическое поле, то его кинетическая энергия mv 2/2 будет равна работе, совершаемой полем по ускорению электрона e. U, где e – заряд электронов, U - разность потенциалов ускоряющего напряжения. Отсюда получаем соотношение: mv 2/2 = e. U (3)
 Взаимодействие электронов с веществом Из уравнений 1, 2, 3 вытекает, что длина волны электрона зависит от ускоряющего напряжения следующим образом: 0 = h/ 2 me. U (4) Отсюда следует, что чем больше ускоряющее напряжение, тем меньше длина волны электронов. Более точное выражение должно учитывать релятивисткое изменение массы электрона при скоростях движения близких к скорости света: m = m 0 1 -(v/c)2 (5) С учетом релятивисткой поправки длина волны электрона будет равна: = 0/ 1 + e. U/2 m 0 c 2 (6) 3
Взаимодействие электронов с веществом Из уравнений 1, 2, 3 вытекает, что длина волны электрона зависит от ускоряющего напряжения следующим образом: 0 = h/ 2 me. U (4) Отсюда следует, что чем больше ускоряющее напряжение, тем меньше длина волны электронов. Более точное выражение должно учитывать релятивисткое изменение массы электрона при скоростях движения близких к скорости света: m = m 0 1 -(v/c)2 (5) С учетом релятивисткой поправки длина волны электрона будет равна: = 0/ 1 + e. U/2 m 0 c 2 (6) 3
 Длина волны электронов для различных ускоряющих напряжений Ускоряющее напряжение, к. В 50 100 200 400 1000 Длина волны без учета 0, 124 релятивисткой поправки, ангстрем 0, 0386 0, 0273 0, 0193 0, 0122 Скорость электронов относительно скорости света, (v/c) 0, 4127 0, 5482 0, 6953 0, 8279 0, 9411 Длина волны с учетом 0, 122 релятивисткой поправки, ангстрем 0, 037 0, 0251 0, 0164 4 0, 0087 Вычисления показывают, что при ускоряющем напряжении 100 к. В длина волны электронов равна 0, 037 ангстрема, то есть имеет величину намного меньшую по сравнению с межатомным расстояниям в кристаллах. Релятивисткая поправка к длине волны при ускоряющем напряжении 50 к. В составляет 2%, тогда как при 200 к. В она достигает 10%.
Длина волны электронов для различных ускоряющих напряжений Ускоряющее напряжение, к. В 50 100 200 400 1000 Длина волны без учета 0, 124 релятивисткой поправки, ангстрем 0, 0386 0, 0273 0, 0193 0, 0122 Скорость электронов относительно скорости света, (v/c) 0, 4127 0, 5482 0, 6953 0, 8279 0, 9411 Длина волны с учетом 0, 122 релятивисткой поправки, ангстрем 0, 037 0, 0251 0, 0164 4 0, 0087 Вычисления показывают, что при ускоряющем напряжении 100 к. В длина волны электронов равна 0, 037 ангстрема, то есть имеет величину намного меньшую по сравнению с межатомным расстояниям в кристаллах. Релятивисткая поправка к длине волны при ускоряющем напряжении 50 к. В составляет 2%, тогда как при 200 к. В она достигает 10%.
 Первые электронные микроскопы 5 Немецкие учёные М. Кнолль и Э. Руска в 1932 году впервые использовали магнитные линзы для получения изображения в электронном микроскопе. В 1933 году им удалось построить электронный микроскоп, разрешающая способность которого позволяла определять детали размером в 500 ангстремов, то есть в десять раз меньше по сравнению с деталями, которые могли разрешить самые мощные оптические микроскопы. В 1939 г. фирмой «Сименс» был разработан и выпущен на рынок первый просвечивающий электронный микроскоп, который имел разрешающую способность 100 ангстремов. В настоящее время большинство серийно выпускаемых просвечивающих электронных микроскопов имеет разрешение примерно 1, 5 ангстрема. Схема иллюстрирующая прохождение электронного пучка через магнитную линзу: 1 – оболочка из магнитомягкого материала; 2 – воздушный зазор; 3 – объект; 4 – изображение; 5 – траектория электронов; 6 – полюсный наконечник.
Первые электронные микроскопы 5 Немецкие учёные М. Кнолль и Э. Руска в 1932 году впервые использовали магнитные линзы для получения изображения в электронном микроскопе. В 1933 году им удалось построить электронный микроскоп, разрешающая способность которого позволяла определять детали размером в 500 ангстремов, то есть в десять раз меньше по сравнению с деталями, которые могли разрешить самые мощные оптические микроскопы. В 1939 г. фирмой «Сименс» был разработан и выпущен на рынок первый просвечивающий электронный микроскоп, который имел разрешающую способность 100 ангстремов. В настоящее время большинство серийно выпускаемых просвечивающих электронных микроскопов имеет разрешение примерно 1, 5 ангстрема. Схема иллюстрирующая прохождение электронного пучка через магнитную линзу: 1 – оболочка из магнитомягкого материала; 2 – воздушный зазор; 3 – объект; 4 – изображение; 5 – траектория электронов; 6 – полюсный наконечник.
 6 Просвечивающий электронный микроскоп При работе просвечивающего микроскопа тонкая фольга исследуемого материала бомбардируется узким пучком электронов. Проникая в материал, электроны испытывают дифракцию на кристаллической решетке образца. Качество полученного изображения структуры во многом определяется характеристиками составляющих электронного микроскопа, в частности работой электромагнитных линз. Вследствие этого ниже рассмотрено устройство электронного микроскопа и функциональное назначение его составляющих оказывающих существенное влияние на разрешающую способность.
6 Просвечивающий электронный микроскоп При работе просвечивающего микроскопа тонкая фольга исследуемого материала бомбардируется узким пучком электронов. Проникая в материал, электроны испытывают дифракцию на кристаллической решетке образца. Качество полученного изображения структуры во многом определяется характеристиками составляющих электронного микроскопа, в частности работой электромагнитных линз. Вследствие этого ниже рассмотрено устройство электронного микроскопа и функциональное назначение его составляющих оказывающих существенное влияние на разрешающую способность.
 Устройство просвечивающего электронного микроскопа 1 - электронная пушка; 2 - конденсорные линзы; 3 – объективная линза; 4 – промежуточные и проекционные линзы; 5 - оптический микроскоп, дополнительно увеличивающий изображение, наблюдаемое на экране; 6 - смотровые окна, через которые можно наблюдать изображение; 7 - высоковольтный кабель; 8 - вакуумная система; 9 - пульт управления; 10 - стенд; 11 - высоковольтное питающее устройство; 12 - источник питания линз. Основными составляющими ПЭМ являются электронная пушка, линзы, фотокамера и вакуумная система. 7
Устройство просвечивающего электронного микроскопа 1 - электронная пушка; 2 - конденсорные линзы; 3 – объективная линза; 4 – промежуточные и проекционные линзы; 5 - оптический микроскоп, дополнительно увеличивающий изображение, наблюдаемое на экране; 6 - смотровые окна, через которые можно наблюдать изображение; 7 - высоковольтный кабель; 8 - вакуумная система; 9 - пульт управления; 10 - стенд; 11 - высоковольтное питающее устройство; 12 - источник питания линз. Основными составляющими ПЭМ являются электронная пушка, линзы, фотокамера и вакуумная система. 7
 8 Оптическая схема просвечивающего электронного микроскопа 1 - вольфрамовый катод; 2 – цилиндр Венельта; 3 - анод; 4 – первая конденсорная линза, создающая уменьшенное изображение источника электронов; 5 – вторая конденсорная линза, которая переносит уменьшенное изображение источника электронов на образец; 6 - образец; 7 - апертурная диафрагма объективной линзы; 8 – объективная линза; 9, 10, 11 система промежуточных и проекционной линз; 12 - люминесцентный экран, на котором формируется изображение.
8 Оптическая схема просвечивающего электронного микроскопа 1 - вольфрамовый катод; 2 – цилиндр Венельта; 3 - анод; 4 – первая конденсорная линза, создающая уменьшенное изображение источника электронов; 5 – вторая конденсорная линза, которая переносит уменьшенное изображение источника электронов на образец; 6 - образец; 7 - апертурная диафрагма объективной линзы; 8 – объективная линза; 9, 10, 11 система промежуточных и проекционной линз; 12 - люминесцентный экран, на котором формируется изображение.
 Электронная пушка 9 В электронной пушке, в качестве источника электронов обычно используют один из трех вариантов: вольфрамовый катод, катод из гексаборида лантана, катод полевой эмиссии. По принципу работы, первые два из них относятся к термоэмиссионным источникам, тогда как третий называется автоэмиссионным. В термоэмиссионных катодах испускание электронов начинается после нагрева материала катода до такой температуры, при которой электроны преодолевают потенциальный барьер, разделяющий поверхность и вакуум. Этот барьер называется «работой выхода» и имеет величину несколько электронвольт. Зависимость плотности тока J от температуры T (в градусах Кельвина) описывается законом Ричардсона: J = AT 2 exp(-Ф/k. T) где к – постоянная Больцмана (8, 6 х10 -5 э. В/K); А – «константа» Ричардсона в единицах А/м 2 К 2, зависящая от материала, Ф – энергия потенциального барьера в электронвольтах. Из этого соотношения следует, что испускание электронов и формирование электронного пучка начинается только тогда, когда источник нагрет до такой температуры, при которой величина k. T сопоставима с энергией потенциального барьера. Однако, если величина k. T достигает несколько электронвольт, то большинство материалов либо плавится, либо испаряется. Поэтому, в термоэмиссионных источниках используют либо материалы с высокой температурой плавления, либо с очень малой работой выхода. На практике применяют либо вольфрам имеющую высокую температуру плавления 3660 К, либо гексаборид лантана (La. B 6), имеющий низкую работу выхода.
Электронная пушка 9 В электронной пушке, в качестве источника электронов обычно используют один из трех вариантов: вольфрамовый катод, катод из гексаборида лантана, катод полевой эмиссии. По принципу работы, первые два из них относятся к термоэмиссионным источникам, тогда как третий называется автоэмиссионным. В термоэмиссионных катодах испускание электронов начинается после нагрева материала катода до такой температуры, при которой электроны преодолевают потенциальный барьер, разделяющий поверхность и вакуум. Этот барьер называется «работой выхода» и имеет величину несколько электронвольт. Зависимость плотности тока J от температуры T (в градусах Кельвина) описывается законом Ричардсона: J = AT 2 exp(-Ф/k. T) где к – постоянная Больцмана (8, 6 х10 -5 э. В/K); А – «константа» Ричардсона в единицах А/м 2 К 2, зависящая от материала, Ф – энергия потенциального барьера в электронвольтах. Из этого соотношения следует, что испускание электронов и формирование электронного пучка начинается только тогда, когда источник нагрет до такой температуры, при которой величина k. T сопоставима с энергией потенциального барьера. Однако, если величина k. T достигает несколько электронвольт, то большинство материалов либо плавится, либо испаряется. Поэтому, в термоэмиссионных источниках используют либо материалы с высокой температурой плавления, либо с очень малой работой выхода. На практике применяют либо вольфрам имеющую высокую температуру плавления 3660 К, либо гексаборид лантана (La. B 6), имеющий низкую работу выхода.
 Схема работы электронной пушки с вольфрамовым катодом 10 При включении накала катода происходит его разогрев, который приводит к эмиссии электронов. Под воздействием высокого напряжения приложенного между Венельтом и дном анодной камеры электроны устремляются вниз к конденсорным линзам. Проходя через Венельт электроны встречают отрицательное напряжение смещения, вследствие которого электронный пучок собирается в некоторой точке между анодом и Венельтом, которая называется кроссовером.
Схема работы электронной пушки с вольфрамовым катодом 10 При включении накала катода происходит его разогрев, который приводит к эмиссии электронов. Под воздействием высокого напряжения приложенного между Венельтом и дном анодной камеры электроны устремляются вниз к конденсорным линзам. Проходя через Венельт электроны встречают отрицательное напряжение смещения, вследствие которого электронный пучок собирается в некоторой точке между анодом и Венельтом, которая называется кроссовером.
 Устройство вольфрамового катода Внешний вид вольфрамового катода просвечивающего электронного микроскопа: сверху – катод; снизу держатель катода (Венельт). 11
Устройство вольфрамового катода Внешний вид вольфрамового катода просвечивающего электронного микроскопа: сверху – катод; снизу держатель катода (Венельт). 11
 Основы просвечивающей электронной микроскопии Устройство электронного микроскопа Яркость излучения электронов (плотность тока в единице телесного угла) определяется наименьшим диаметром кроссовера do, плотностью тока эмиссии через кроссовер ie, и углом расхождения пучка , через уравнение: = 4 iе /( do )2 Типичная зависимость тока эмиссии от тока накала нити катода изображена на рисунке ниже. Начиная с некоторого значения ток эмиссии выходит на режим насыщения. На практике в качестве оптимального режима работы обычно используют режим не достигающий насыщения, поскольку именно он обеспечивает долговечность и достаточную яркость источника электронов. Зависимость тока эмиссии от тока накала катода 12
Основы просвечивающей электронной микроскопии Устройство электронного микроскопа Яркость излучения электронов (плотность тока в единице телесного угла) определяется наименьшим диаметром кроссовера do, плотностью тока эмиссии через кроссовер ie, и углом расхождения пучка , через уравнение: = 4 iе /( do )2 Типичная зависимость тока эмиссии от тока накала нити катода изображена на рисунке ниже. Начиная с некоторого значения ток эмиссии выходит на режим насыщения. На практике в качестве оптимального режима работы обычно используют режим не достигающий насыщения, поскольку именно он обеспечивает долговечность и достаточную яркость источника электронов. Зависимость тока эмиссии от тока накала катода 12
 13 Режим работы катода Режим работы термоэмиссионного катода определяется также напряжением смещения на цилиндре Венельта. Если смещение мало, то расходимость и размеры пучка в кроссовере велики, и соответственно яркость мала (режим А), если смещение слишком велико, то ток падает до нуля (режим В). Оптимальное смещение (режим Б) устанавливается по изображению катода на экране микроскопа Влияние напряжения смещения на цилиндре Венельта на характеристики пучка.
13 Режим работы катода Режим работы термоэмиссионного катода определяется также напряжением смещения на цилиндре Венельта. Если смещение мало, то расходимость и размеры пучка в кроссовере велики, и соответственно яркость мала (режим А), если смещение слишком велико, то ток падает до нуля (режим В). Оптимальное смещение (режим Б) устанавливается по изображению катода на экране микроскопа Влияние напряжения смещения на цилиндре Венельта на характеристики пучка.
 Режимы работы катода 14 Оптимальный режим работы катода устанавливается по изображению ореола (кроссовера) на экране ПЭМ. как показано на рисунке ниже. Для центрирования изображения ореола, используют наклон пушки, чтобы изменить ее ориентацию относительно оптической оси микроскопа. Отличительной особенностью катода на основе La. B 6 является его недостаточная стойкость при быстром нагреве, поэтому он требует медленного увеличения тока пучка при включении с паузами в течение 10 -20 сек. (а) (б) Режимы работы катодов термоэмиссионного типа: (а) – вольфрамовый катод (а – внешний вид нити, б – пучок смещен относительно ореола и ток накала понижен, в – пучок отцентрирован и ток накала понижен, г – пучок отцентрирован и ток накала в оптимальном режиме); (б) катод на основе La. B 6 (а - внешний вид нити, б - пучок отцентрирован и ток накала понижен, в - ток накала в оптимальном режиме)
Режимы работы катода 14 Оптимальный режим работы катода устанавливается по изображению ореола (кроссовера) на экране ПЭМ. как показано на рисунке ниже. Для центрирования изображения ореола, используют наклон пушки, чтобы изменить ее ориентацию относительно оптической оси микроскопа. Отличительной особенностью катода на основе La. B 6 является его недостаточная стойкость при быстром нагреве, поэтому он требует медленного увеличения тока пучка при включении с паузами в течение 10 -20 сек. (а) (б) Режимы работы катодов термоэмиссионного типа: (а) – вольфрамовый катод (а – внешний вид нити, б – пучок смещен относительно ореола и ток накала понижен, в – пучок отцентрирован и ток накала понижен, г – пучок отцентрирован и ток накала в оптимальном режиме); (б) катод на основе La. B 6 (а - внешний вид нити, б - пучок отцентрирован и ток накала понижен, в - ток накала в оптимальном режиме)
 Катод полевой эмиссии 15 Катод полевой эмиссии представляет собой вольфрамовую нить, конец которой сильно вытянут и заострен. Анод состоит из двух частей. Первый из них имеет положительный потенциал относительно катода порядка нескольких киловольт и служит для притягивания электронов испущенных острием катода. Второй электрод создает ускоряющее напряжение необходимое для прохождения электронов через исследуемый образец. Для работы катода полевой эмиссии требуется вакуум на 3 порядка более высокий по сравнению с вакуумом необходимым для вольфрамового катода. Такой высокий вакуум необходим, поскольку при длительной работе катода полевой эмиссии образуется загрязнение поверхности острия катода. Вследствие этого падает ток эмиссии, что ведет к необходимости увеличивать положительный потенциал первого анода. В частности, если имеется вакуум 10 -7 мм. рт. ст. , то один монослой загрязнений нарастает менее чем через минуту, а при вакууме 10 -10 мм. рт. ст. – за 7 часов. Поэтому, время от времени требуется «очистка» катода полевой эмиссии путем реверсирования потенциала катода, либо кратковременного нагрева до высокой температуры для испарения загрязнений. (а) (б) Катод полевой эмиссии: (а) внешний вид; (б) схема работы
Катод полевой эмиссии 15 Катод полевой эмиссии представляет собой вольфрамовую нить, конец которой сильно вытянут и заострен. Анод состоит из двух частей. Первый из них имеет положительный потенциал относительно катода порядка нескольких киловольт и служит для притягивания электронов испущенных острием катода. Второй электрод создает ускоряющее напряжение необходимое для прохождения электронов через исследуемый образец. Для работы катода полевой эмиссии требуется вакуум на 3 порядка более высокий по сравнению с вакуумом необходимым для вольфрамового катода. Такой высокий вакуум необходим, поскольку при длительной работе катода полевой эмиссии образуется загрязнение поверхности острия катода. Вследствие этого падает ток эмиссии, что ведет к необходимости увеличивать положительный потенциал первого анода. В частности, если имеется вакуум 10 -7 мм. рт. ст. , то один монослой загрязнений нарастает менее чем через минуту, а при вакууме 10 -10 мм. рт. ст. – за 7 часов. Поэтому, время от времени требуется «очистка» катода полевой эмиссии путем реверсирования потенциала катода, либо кратковременного нагрева до высокой температуры для испарения загрязнений. (а) (б) Катод полевой эмиссии: (а) внешний вид; (б) схема работы
 Система линз 16 Система линз в просвечивающем электронном микроскопе отвечает за многие важные функции, такие как освещенность объекта исследований, увеличение и фокусировка изображения, формирование светлопольного и темнопольного изображений, получение картины микродифракции, а также за разрешение микроскопа. Вследствие этого знание особенностей работы системы линз важно для понимания путей повышения качества изображений.
Система линз 16 Система линз в просвечивающем электронном микроскопе отвечает за многие важные функции, такие как освещенность объекта исследований, увеличение и фокусировка изображения, формирование светлопольного и темнопольного изображений, получение картины микродифракции, а также за разрешение микроскопа. Вследствие этого знание особенностей работы системы линз важно для понимания путей повышения качества изображений.
 Электронная оптика Для иллюстрации путей прохождения лучей через электромагнитную линзу обычно используют аналогию с прохождением света через выпуклую оптическую линзу. При таком подходе изображение электронного пучка проходящее через совершенную линзу точно фокусируется в фокальной плоскости, где регистрируется изображение. Вместе с тем в реальной линзе апертурный угол , в отличие от изображенного на рисунке, имеет очень малую величину порядка нескольких градусов. Поэтому реальный электронный пучок, проходящий через магнитную линзу, имеет намного меньший диаметр, по сравнению с изображением, представленным на рисунке. Ход лучей в идеальной линзе с диафрагмой. 17
Электронная оптика Для иллюстрации путей прохождения лучей через электромагнитную линзу обычно используют аналогию с прохождением света через выпуклую оптическую линзу. При таком подходе изображение электронного пучка проходящее через совершенную линзу точно фокусируется в фокальной плоскости, где регистрируется изображение. Вместе с тем в реальной линзе апертурный угол , в отличие от изображенного на рисунке, имеет очень малую величину порядка нескольких градусов. Поэтому реальный электронный пучок, проходящий через магнитную линзу, имеет намного меньший диаметр, по сравнению с изображением, представленным на рисунке. Ход лучей в идеальной линзе с диафрагмой. 17
 Электронная оптика Реальные линзы, используемые в электронном микроскопе, являются несовершенными вследствие наличия аберраций, которые приводят к размытию изображения и снижению разрешающей способности. Основными аберрациями, оказывающими наибольшее влияние на разрешающую способность, являются сферическая аберрация, хроматическая аберрация и астигматизм. 18
Электронная оптика Реальные линзы, используемые в электронном микроскопе, являются несовершенными вследствие наличия аберраций, которые приводят к размытию изображения и снижению разрешающей способности. Основными аберрациями, оказывающими наибольшее влияние на разрешающую способность, являются сферическая аберрация, хроматическая аберрация и астигматизм. 18
 Сферическая аберрация 19 Появление сферической аберрации вызвано тем, что лучи вышедшие под разными апертурными углами из точки О на оптической оси линзы фокусируются в различных местах О' и О'' вдоль оптической оси, то есть они не собираются в одну точку как это должно было в идеальной линзе изображенной на рисунке. Следовательно, в реальной линзе изображение точки O будет представлено в виде диска рассеяния минимальным диаметром dmin , что ограничивает разрешающую способность микроскопа. При небольших апертурных углах справедливо следующее выражение для минимального радиуса диска рассеяния, вызванного сферической аберрацией: rmin = С 1 3 Здесь С 1 – коэффициент сферической аберрации, являющийся характеристикой электронной линзы. Он имеет размерность длины. В большинстве современных микроскопов его величина составляет примерно 3 мм, тогда как в лучших линзах используемых в микроскопах высокого разрешения она может достигать значения 1 мм. Ход лучей в линзе, проявляющей сферическую аберрацию
Сферическая аберрация 19 Появление сферической аберрации вызвано тем, что лучи вышедшие под разными апертурными углами из точки О на оптической оси линзы фокусируются в различных местах О' и О'' вдоль оптической оси, то есть они не собираются в одну точку как это должно было в идеальной линзе изображенной на рисунке. Следовательно, в реальной линзе изображение точки O будет представлено в виде диска рассеяния минимальным диаметром dmin , что ограничивает разрешающую способность микроскопа. При небольших апертурных углах справедливо следующее выражение для минимального радиуса диска рассеяния, вызванного сферической аберрацией: rmin = С 1 3 Здесь С 1 – коэффициент сферической аберрации, являющийся характеристикой электронной линзы. Он имеет размерность длины. В большинстве современных микроскопов его величина составляет примерно 3 мм, тогда как в лучших линзах используемых в микроскопах высокого разрешения она может достигать значения 1 мм. Ход лучей в линзе, проявляющей сферическую аберрацию
 Хроматическая аберрация 20 Хроматическая аберрация в линзах используемых в электронной микроскопии имеет ту же природу, что и в оптических микроскопах. В ее основе лежит зависимость фокусного расстояния линзы от длины волны падающих лучей. Кроме этого при прохождении электронного пучка через исследуемый образец происходят потери энергии электронов, что приводит к размытию их энергетического спектра. Очевидно, что электроны, имеющие меньшую энергию, будут фокусироваться ближе к линзе, тогда как более быстрые электроны будут фокусироваться дальше вдоль оптической оси. При наличии хроматической аберрации изображение точки О формируется в виде диска, наименьший радиус которого дается следующим выражением: rmin = С 2 Е/Ео Ход лучей в линзе при наличии хроматической аберрации. В точках О' и О'' фокусируются электроны с меньшей и большей энергией, соответственно. где: С 2 – коэффициент хроматической аберрации равный примерно фокусному расстоянию, - апертурный угол, Е – потери энергии электронов при прохождении через объект исследования (тонкую фольгу), Ео - первоначальная энергия электронов испускаемых электронной пушкой. Величина Е для электронов испускаемых электронной пушкой обычно не превышает 1 электронвольт и достигает значения 15 -25 э. В для электронов прошедших через типичную тонкую фольгу толщиной 50 -100 нм.
Хроматическая аберрация 20 Хроматическая аберрация в линзах используемых в электронной микроскопии имеет ту же природу, что и в оптических микроскопах. В ее основе лежит зависимость фокусного расстояния линзы от длины волны падающих лучей. Кроме этого при прохождении электронного пучка через исследуемый образец происходят потери энергии электронов, что приводит к размытию их энергетического спектра. Очевидно, что электроны, имеющие меньшую энергию, будут фокусироваться ближе к линзе, тогда как более быстрые электроны будут фокусироваться дальше вдоль оптической оси. При наличии хроматической аберрации изображение точки О формируется в виде диска, наименьший радиус которого дается следующим выражением: rmin = С 2 Е/Ео Ход лучей в линзе при наличии хроматической аберрации. В точках О' и О'' фокусируются электроны с меньшей и большей энергией, соответственно. где: С 2 – коэффициент хроматической аберрации равный примерно фокусному расстоянию, - апертурный угол, Е – потери энергии электронов при прохождении через объект исследования (тонкую фольгу), Ео - первоначальная энергия электронов испускаемых электронной пушкой. Величина Е для электронов испускаемых электронной пушкой обычно не превышает 1 электронвольт и достигает значения 15 -25 э. В для электронов прошедших через типичную тонкую фольгу толщиной 50 -100 нм.
 Астигматизм Появление астигматизма обусловлено отклонением формы полюсных наконечников от формы идеального цилиндра. Аналогом астигматизма в оптическом микроскопе является отклонение формы линзы от идеальной сферической с появлением ее эллипсоидности. Оценки показывают, что для того чтобы астигматизм не влиял на разрешение линзы, точность обработки полюсных наконечников должна быть порядка 0, 02 мкм, что недостижимо при современных методах обработки металлов. Другой причиной появления астигматизма является отклонение центра апертурной диафрагмы относительно оптической оси, что искажает магнитное поле линзы. В дополнение к этому, в процессе работы микроскопа поверхность диафрагм и полюсных наконечников подвергается загрязнению, что вызывает накопление на них электростатического заряда отклоняющего пучок электронов. Таким образом, существует несколько причин вызывающих появление астигматизма. 21
Астигматизм Появление астигматизма обусловлено отклонением формы полюсных наконечников от формы идеального цилиндра. Аналогом астигматизма в оптическом микроскопе является отклонение формы линзы от идеальной сферической с появлением ее эллипсоидности. Оценки показывают, что для того чтобы астигматизм не влиял на разрешение линзы, точность обработки полюсных наконечников должна быть порядка 0, 02 мкм, что недостижимо при современных методах обработки металлов. Другой причиной появления астигматизма является отклонение центра апертурной диафрагмы относительно оптической оси, что искажает магнитное поле линзы. В дополнение к этому, в процессе работы микроскопа поверхность диафрагм и полюсных наконечников подвергается загрязнению, что вызывает накопление на них электростатического заряда отклоняющего пучок электронов. Таким образом, существует несколько причин вызывающих появление астигматизма. 21
 Астигматизм При наличии астигматизма электронные лучи проходящие через разные сечения линзы А 1 А и В 1 В фокусируются в различных точках оптической оси О''. Возникающее при этом размытие изображения будет иметь следующий минимальный размер: rmin = f Ход лучей в линзе при наличии астигматизма. где f – максимальная разница в фокусном расстоянии возникающая вследствие наличия астигматизма, - апертурный угол. Для устранения астигматизма в электронных микроскопах используют специальные устройства – стигматоры. Они представляют собой небольшие электромагнитные катушки, вставляющиеся на полюсные наконечники. Их роль заключается в создании дополнительных полей компенсирующих неоднородность, вызванную астигматизмом. 22
Астигматизм При наличии астигматизма электронные лучи проходящие через разные сечения линзы А 1 А и В 1 В фокусируются в различных точках оптической оси О''. Возникающее при этом размытие изображения будет иметь следующий минимальный размер: rmin = f Ход лучей в линзе при наличии астигматизма. где f – максимальная разница в фокусном расстоянии возникающая вследствие наличия астигматизма, - апертурный угол. Для устранения астигматизма в электронных микроскопах используют специальные устройства – стигматоры. Они представляют собой небольшие электромагнитные катушки, вставляющиеся на полюсные наконечники. Их роль заключается в создании дополнительных полей компенсирующих неоднородность, вызванную астигматизмом. 22
 23 Основы просвечивающей электронной микроскопии Электронная оптика В соответствии с критерием Рэлея две точки можно разрешить, если максимум интенсивности изображения одной из точек перекрывается с минимумом интенсивности от изображения другой точки. В этом случае можно различить два раздельных изображения со следующим разрешением: rmin = 0, 61 /nsin Профили интенсивности изображения от двух источников Р 1 и Р 2: (а) разрешение линзы позволяет различить два изображения; (б) два изображения перекрываются друг с другом таким образом, что они неразличимы; (в) максимум одного изображения перекрывается с минимумом другого, что является критерием Рэлея для разрешения изображения от двух источников Р 1 и Р 2. где - длина волны, n – показатель преломления, - апертурный угол. Учитывая, что показатель преломления для электронов в вакууме практически равен единице, а величина имеет очень малые значения порядка нескольких градусов, то для электронных лучей эта формула может быть представлена в следующем виде: rmin = 0, 61 /
23 Основы просвечивающей электронной микроскопии Электронная оптика В соответствии с критерием Рэлея две точки можно разрешить, если максимум интенсивности изображения одной из точек перекрывается с минимумом интенсивности от изображения другой точки. В этом случае можно различить два раздельных изображения со следующим разрешением: rmin = 0, 61 /nsin Профили интенсивности изображения от двух источников Р 1 и Р 2: (а) разрешение линзы позволяет различить два изображения; (б) два изображения перекрываются друг с другом таким образом, что они неразличимы; (в) максимум одного изображения перекрывается с минимумом другого, что является критерием Рэлея для разрешения изображения от двух источников Р 1 и Р 2. где - длина волны, n – показатель преломления, - апертурный угол. Учитывая, что показатель преломления для электронов в вакууме практически равен единице, а величина имеет очень малые значения порядка нескольких градусов, то для электронных лучей эта формула может быть представлена в следующем виде: rmin = 0, 61 /
 Разрешение микроскопа 24 Разрешение изображения полученного в электронном микроскопе определяется ограничением, которое накладывается критерием Рэлея и сферической аберрацией. То есть разрешение r можно представить как среднеквадратичное значение двух составляющих: r = (r 12 +r 22)1/2 где: r 1 – разрешение обусловленное критерием Рэлея; r 2 – разрешение ограниченное сферической аберрацией. Подставляя выражения r 1 = 0, 61 / и r 2 = С 1 3 получим зависимость разрешения r от апертурного угла : r( ) = (0, 61 / )2 +(С 1 3)2 1/2 Значение угла при, котором значение параметра r имеет минимальное значение находится из условия равенства производной нулю, то есть dr( )/d =0. Из этого условия вытекает, что оптимальное значение , при котором величина r минимальна составляет: = 0, 77( /С 1)1/4 Если эту величину подставить в уравнении для r 1 = 0, 61 / то мы получим следующее выражение для минимального значения r( ), то есть для разрешающей способности электронного микроскопа: rmin = 0, 91(С 1 3)1/4 Типичные значения для rmin в современных просвечивающих микроскопах лежат в пределах 0, 25 – 0, 3 нм. Вместе с тем в микроскопах высокого разрешения rmin составляет примерно 0, 15 нм.
Разрешение микроскопа 24 Разрешение изображения полученного в электронном микроскопе определяется ограничением, которое накладывается критерием Рэлея и сферической аберрацией. То есть разрешение r можно представить как среднеквадратичное значение двух составляющих: r = (r 12 +r 22)1/2 где: r 1 – разрешение обусловленное критерием Рэлея; r 2 – разрешение ограниченное сферической аберрацией. Подставляя выражения r 1 = 0, 61 / и r 2 = С 1 3 получим зависимость разрешения r от апертурного угла : r( ) = (0, 61 / )2 +(С 1 3)2 1/2 Значение угла при, котором значение параметра r имеет минимальное значение находится из условия равенства производной нулю, то есть dr( )/d =0. Из этого условия вытекает, что оптимальное значение , при котором величина r минимальна составляет: = 0, 77( /С 1)1/4 Если эту величину подставить в уравнении для r 1 = 0, 61 / то мы получим следующее выражение для минимального значения r( ), то есть для разрешающей способности электронного микроскопа: rmin = 0, 91(С 1 3)1/4 Типичные значения для rmin в современных просвечивающих микроскопах лежат в пределах 0, 25 – 0, 3 нм. Вместе с тем в микроскопах высокого разрешения rmin составляет примерно 0, 15 нм.
 Устройство микроскопа JEM-100 B 1 Формирование изображения в просвечивающем электронном микроскопе происходит с помощью системы линз, в которую входят конденсорные, объективная, промежуточные и проекционная линзы. В процессе работы микроскопа электронные лучи, испускаемые пушкой, попадают в систему иллюминации, состоящей из двух конденсорных линз обеспечивающих освещенность объекта. Первая конденсорная линза является короткофокусной и имеет ступенчатую регулировку тока линзы, переключение которой приводит к сильному изменению освещенности изображения. Вторая конденсорная линза является длиннофокусной и служит для плавной регулировки освещенности объекта в широких пределах. Апертурная диафрагма, вводимая чуть ниже второй конденсорной линзы, способствует уменьшению апертурного угла, что повышает когерентность электронных лучей. Вместе с тем, она ограничивает количество электронов падающих на объект, снижая тем самым его освещенность.
Устройство микроскопа JEM-100 B 1 Формирование изображения в просвечивающем электронном микроскопе происходит с помощью системы линз, в которую входят конденсорные, объективная, промежуточные и проекционная линзы. В процессе работы микроскопа электронные лучи, испускаемые пушкой, попадают в систему иллюминации, состоящей из двух конденсорных линз обеспечивающих освещенность объекта. Первая конденсорная линза является короткофокусной и имеет ступенчатую регулировку тока линзы, переключение которой приводит к сильному изменению освещенности изображения. Вторая конденсорная линза является длиннофокусной и служит для плавной регулировки освещенности объекта в широких пределах. Апертурная диафрагма, вводимая чуть ниже второй конденсорной линзы, способствует уменьшению апертурного угла, что повышает когерентность электронных лучей. Вместе с тем, она ограничивает количество электронов падающих на объект, снижая тем самым его освещенность.
 Формирование изображения В последнее время в конструкции современных микроскопах используются три конденсорные линзы. В частности, третью конденсорную линзу применяют для фокусировки электронного пучка на малом участке фольги диаметром до 10 нм, с тем, чтобы на нем можно было проводить энергодисперсионный анализ. Ход лучей через конденсорные линзы в микроскопе JEM-2100: а в режиме просвечивающей электронной мироскопии; б в режиме энергодисперсионного анализа 2
Формирование изображения В последнее время в конструкции современных микроскопах используются три конденсорные линзы. В частности, третью конденсорную линзу применяют для фокусировки электронного пучка на малом участке фольги диаметром до 10 нм, с тем, чтобы на нем можно было проводить энергодисперсионный анализ. Ход лучей через конденсорные линзы в микроскопе JEM-2100: а в режиме просвечивающей электронной мироскопии; б в режиме энергодисперсионного анализа 2
 Формирование изображения 3 После прохождения конденсорных линз и образца в виде тонкой фольги электронные лучи попадают в объективную линзу, которая является самой важной с точки зрения формирования изображения и реализации высокой разрешающей способности. Именно эта линза в первую очередь должна иметь минимальные значения сферической аберрации и астигматизма. За объективной линзой следуют две промежуточные и проекционная линзы, которые обеспечивают увеличение изображения структуры. Меняя режим работы системы линз можно получать светлопольное изображение, темнопольное изображение и картину микродифракции с одного и того же участка структуры. Схема формирования изображения в микроскопе JEM-100 B: 1 в режиме светлого, 2 темного поля, 3 в режиме дифракции
Формирование изображения 3 После прохождения конденсорных линз и образца в виде тонкой фольги электронные лучи попадают в объективную линзу, которая является самой важной с точки зрения формирования изображения и реализации высокой разрешающей способности. Именно эта линза в первую очередь должна иметь минимальные значения сферической аберрации и астигматизма. За объективной линзой следуют две промежуточные и проекционная линзы, которые обеспечивают увеличение изображения структуры. Меняя режим работы системы линз можно получать светлопольное изображение, темнопольное изображение и картину микродифракции с одного и того же участка структуры. Схема формирования изображения в микроскопе JEM-100 B: 1 в режиме светлого, 2 темного поля, 3 в режиме дифракции
 Формирование изображения 4 При работе в режиме светлопольного изображения вставляют апертурную диафрагму объективной линзы, которая ограничивает апертурный угол электронного пучка для реализации наибольшей разрешающей способности микроскопа. Переключение в режим микродифракции приводит к изменению тока промежуточных линз. При этом использование селекторной диафрагмы позволяет получать картину микродифракции с избранного участка фольги. Путем перемещения выбранного точечного рефлекса на место центрального рефлекса на электронограмме и выделения его апертурной диафрагмой объективной линзы можно получить темнопольное изображение структуры. (а) (б) Микрофотография структуры алюминиевого сплава 1420 после закалки и интенсивной пластической деформации кручением: (а) светлопольное изображение и картина микродифракции; (б) темнопольное изображение
Формирование изображения 4 При работе в режиме светлопольного изображения вставляют апертурную диафрагму объективной линзы, которая ограничивает апертурный угол электронного пучка для реализации наибольшей разрешающей способности микроскопа. Переключение в режим микродифракции приводит к изменению тока промежуточных линз. При этом использование селекторной диафрагмы позволяет получать картину микродифракции с избранного участка фольги. Путем перемещения выбранного точечного рефлекса на место центрального рефлекса на электронограмме и выделения его апертурной диафрагмой объективной линзы можно получить темнопольное изображение структуры. (а) (б) Микрофотография структуры алюминиевого сплава 1420 после закалки и интенсивной пластической деформации кручением: (а) светлопольное изображение и картина микродифракции; (б) темнопольное изображение
 Виды дифракционного контраста На изображениях структуры полученных в обычном просвечивающем электронном микроскопе часто наблюдаются различные виды дифракционного контраста, такие как толщинные контура экстинкции, изгибные контура экстинкции, муаровые узоры, Кикучи линии, контраст на дислокациях и другие. Рассмотрим природу и происхождение различных видов дифракционного контраста. Светлопольные изображения структуры алюминиевых сплавов 6061 и 6061+Mg+Zr подвергнутых ИПДК и отжигу при температуре 300 o. C, 30 мин 5
Виды дифракционного контраста На изображениях структуры полученных в обычном просвечивающем электронном микроскопе часто наблюдаются различные виды дифракционного контраста, такие как толщинные контура экстинкции, изгибные контура экстинкции, муаровые узоры, Кикучи линии, контраст на дислокациях и другие. Рассмотрим природу и происхождение различных видов дифракционного контраста. Светлопольные изображения структуры алюминиевых сплавов 6061 и 6061+Mg+Zr подвергнутых ИПДК и отжигу при температуре 300 o. C, 30 мин 5
 6 Толщинные контура экстинкции Согласно теории дифракционного контраста, толщинные контура экстинкции на наклонных границах зерен являются контурами одинаковой глубины зерен в тонкой фольге и появляются на электронномикроскопическом изображении, когда некоторое семейство плоскостей данного зерна находится в брэгговских условиях отражения. В этом случае, толщинные контура экстинкции выглядят в виде чередующихся темно-светлых полос, а их интенсивность определяется выражением: sin 2 ( ts) I ------( s)2 где: t - толщина кристалла, s - величина отклонения отражающей плоскости от точного брэгговского положения.
6 Толщинные контура экстинкции Согласно теории дифракционного контраста, толщинные контура экстинкции на наклонных границах зерен являются контурами одинаковой глубины зерен в тонкой фольге и появляются на электронномикроскопическом изображении, когда некоторое семейство плоскостей данного зерна находится в брэгговских условиях отражения. В этом случае, толщинные контура экстинкции выглядят в виде чередующихся темно-светлых полос, а их интенсивность определяется выражением: sin 2 ( ts) I ------( s)2 где: t - толщина кристалла, s - величина отклонения отражающей плоскости от точного брэгговского положения.
 Толщинные контура экстинкции Для понимания происхождения параметра s введем понятие обратной решетки кристалла. Если в кристаллической решетке любой вектор r соединяющий два атома можно представить в виде: r = n 1 a 1 + n 2 a 2 + n 3 a 3 , где ni – целые числа, ai – единичные вектора трансляции в кристалле, то в обратной решетке ему соответствует вектор g, который определяется g = hb 1 + kb 2 + lb 3 , где bi – единичные вектора, удовлетворяющие соотношению: 1, если i = j, b i х aj = 0, если i j. 7
Толщинные контура экстинкции Для понимания происхождения параметра s введем понятие обратной решетки кристалла. Если в кристаллической решетке любой вектор r соединяющий два атома можно представить в виде: r = n 1 a 1 + n 2 a 2 + n 3 a 3 , где ni – целые числа, ai – единичные вектора трансляции в кристалле, то в обратной решетке ему соответствует вектор g, который определяется g = hb 1 + kb 2 + lb 3 , где bi – единичные вектора, удовлетворяющие соотношению: 1, если i = j, b i х aj = 0, если i j. 7
 Толщинные контура экстинкции 8 Важнейшим свойством обратной решетки является то, что вектор g приведенный из ее начала координат в узел с координатами h, k, l, нормален к плоскости решетки кристалла с индексами Миллера hkl. Кроме этого выполняется соотношение: g = 1/dhkl Схема иллюстрирующая построение сферы Эвальда с радиусом 1/. Вектор ОО 1 представляет собой к – волновой вектор первичной волны, вектор к 1 является волновым вектором дифрагированной волны, вектор g соединяет центральный рефлекс на электронограмме с рефлексом hkl, вектор s показывает отклонение между рефлексом hkl и сферой Эвальда. где: dhkl – межплоскостное расстояние для плоскостей hkl. Если из начала координат обратной решетки (узел О 1 ) провести вектор падающей волны к , а из его конца описать сферу отражения ( сферу Эвальда) радиусом 1/ , то брэгговские условия отражения будут удовлетворяться если сфера Эвальда будет проходить точно через узел обратной решетки.
Толщинные контура экстинкции 8 Важнейшим свойством обратной решетки является то, что вектор g приведенный из ее начала координат в узел с координатами h, k, l, нормален к плоскости решетки кристалла с индексами Миллера hkl. Кроме этого выполняется соотношение: g = 1/dhkl Схема иллюстрирующая построение сферы Эвальда с радиусом 1/. Вектор ОО 1 представляет собой к – волновой вектор первичной волны, вектор к 1 является волновым вектором дифрагированной волны, вектор g соединяет центральный рефлекс на электронограмме с рефлексом hkl, вектор s показывает отклонение между рефлексом hkl и сферой Эвальда. где: dhkl – межплоскостное расстояние для плоскостей hkl. Если из начала координат обратной решетки (узел О 1 ) провести вектор падающей волны к , а из его конца описать сферу отражения ( сферу Эвальда) радиусом 1/ , то брэгговские условия отражения будут удовлетворяться если сфера Эвальда будет проходить точно через узел обратной решетки.
 9 Основы просвечивающей электронной микроскопии Толщинные контура экстинкции Схема иллюстрирующая построение сферы Эвальда с радиусом 1/. Вектор ОО 1 представляет собой к – волновой вектор первичной волны, вектор к 1 является волновым вектором дифрагированной волны, вектор g соединяет центральный рефлекс на электронограмме с рефлексом hkl, вектор s показывает отклонение между рефлексом hkl и сферой Эвальда. При дифракции электронов с энергией 100 кэ. В длина волны равна 0, 0037 нм и величина 1/ составляет 270 нм-1, тогда как величина периода обратной решетки g = 1/d составляет примерно 3 нм-1. Поэтому сферу отражения проходящую через начало координат обратной решетки (точка О 1) можно приближенно аппроксимировать плоскостью, которая может пересекаться с несколькими узлами обратной решетки (точечными рефлексами на электронограмме). В случае если сфера Эвальда не пересекает узел обратной решетки, то отклонение между ними характеризуется параметром s.
9 Основы просвечивающей электронной микроскопии Толщинные контура экстинкции Схема иллюстрирующая построение сферы Эвальда с радиусом 1/. Вектор ОО 1 представляет собой к – волновой вектор первичной волны, вектор к 1 является волновым вектором дифрагированной волны, вектор g соединяет центральный рефлекс на электронограмме с рефлексом hkl, вектор s показывает отклонение между рефлексом hkl и сферой Эвальда. При дифракции электронов с энергией 100 кэ. В длина волны равна 0, 0037 нм и величина 1/ составляет 270 нм-1, тогда как величина периода обратной решетки g = 1/d составляет примерно 3 нм-1. Поэтому сферу отражения проходящую через начало координат обратной решетки (точка О 1) можно приближенно аппроксимировать плоскостью, которая может пересекаться с несколькими узлами обратной решетки (точечными рефлексами на электронограмме). В случае если сфера Эвальда не пересекает узел обратной решетки, то отклонение между ними характеризуется параметром s.
 Толщинные контура экстинкции 10 Из теории дифракционного контраста следует, что интенсивность толщинных контуров экстинкции на наклонных границах зерен определяется выражением: sin 2 ( ts) I ------( s)2 где: t - толщина кристалла, s - величина отклонения отражающей плоскости от точного брэгговского положения. Из этого выражения и нижеприведенного рисунка следует, что интенсивность электронного пучка при прохождении кристалла меняется с периодичностью g (кси), которая называется экстинкционной длиной. Схема формирования толщинных контуров экстинкции: (а) интенсивность падающего и дифрагированного волн в условиях брэгговского отражения (s = 0); (б) клиновидный образец кристалла в котором электронная волна проходит разное расстояние в зависимости от толщины кристалла; (в) схема взаимного расположения толщинных контуров экстинкции: (1) на краю образца; (2) при толщине t = 1/2 g; (3) при толщине t = 3/2 g.
Толщинные контура экстинкции 10 Из теории дифракционного контраста следует, что интенсивность толщинных контуров экстинкции на наклонных границах зерен определяется выражением: sin 2 ( ts) I ------( s)2 где: t - толщина кристалла, s - величина отклонения отражающей плоскости от точного брэгговского положения. Из этого выражения и нижеприведенного рисунка следует, что интенсивность электронного пучка при прохождении кристалла меняется с периодичностью g (кси), которая называется экстинкционной длиной. Схема формирования толщинных контуров экстинкции: (а) интенсивность падающего и дифрагированного волн в условиях брэгговского отражения (s = 0); (б) клиновидный образец кристалла в котором электронная волна проходит разное расстояние в зависимости от толщины кристалла; (в) схема взаимного расположения толщинных контуров экстинкции: (1) на краю образца; (2) при толщине t = 1/2 g; (3) при толщине t = 3/2 g.
 Толщинные контура экстинкции 11 4 1 3 2 200 nm Микрофотография структуры алюминиевого сплава 1420 подвергнутого равноканальному угловому прессованию, стрелками указаны частицы упрочняющей фазы, цифрами 1 -4 показаны толщинные контура экстинкции на наклонной границе зерна. Экстинкционная длина имеет разное значение для различных отражений и материалов с разной кристаллической решеткой. Например, экстинкционная длина для меди, имеющей ГЦК решетку, для отражений (111) и (222) составляет 24, 2 нм и 53, 5 нм, соответственно. В железе, имеющем ОЦК решетку, для отражений (110) и (220) она равна 27, 0 нм и 60, 6 нм, соответственно. Для материалов с ГПУ решеткой экстинкционная длина имеет гораздо большие значения. Например, в магнии для отражений 1100 и 2200 она составляет 150, 9 нм и 334, 8 нм, соответственно. Вследствие этого в различных материалах при одной и той же толщине фольги может встречаться различное количество толщинных контуров экстинкции.
Толщинные контура экстинкции 11 4 1 3 2 200 nm Микрофотография структуры алюминиевого сплава 1420 подвергнутого равноканальному угловому прессованию, стрелками указаны частицы упрочняющей фазы, цифрами 1 -4 показаны толщинные контура экстинкции на наклонной границе зерна. Экстинкционная длина имеет разное значение для различных отражений и материалов с разной кристаллической решеткой. Например, экстинкционная длина для меди, имеющей ГЦК решетку, для отражений (111) и (222) составляет 24, 2 нм и 53, 5 нм, соответственно. В железе, имеющем ОЦК решетку, для отражений (110) и (220) она равна 27, 0 нм и 60, 6 нм, соответственно. Для материалов с ГПУ решеткой экстинкционная длина имеет гораздо большие значения. Например, в магнии для отражений 1100 и 2200 она составляет 150, 9 нм и 334, 8 нм, соответственно. Вследствие этого в различных материалах при одной и той же толщине фольги может встречаться различное количество толщинных контуров экстинкции.
 Толщинные контура экстинкции 12 Общее выражение для зависимости между толщиной t кристалла, количеством толщинных контуров экстинкции N и экстинкционной длиной g имеет следующий вид: t = N (1 + s 2 2)-1/2 В случае, когда отражающие плоскости находятся в точном брэгговском положении, то есть при параметре s = 0 эта формула превращается в выражение: t = N Зная количество толщинных контуров экстинкции, а также экстинкционную длину для соответствующей отражающей плоскости, последнию формулу можно использовать для определения толщины фольги или зерна на месте наклонной границы. Например, на наклонной границе зерна, обозначенной цифрой 2 на предыдущем рисунке имеется три темно-светлые чередующиеся полосы толщинных контуров экстинкции. Для отражения (111) в алюминии величина экстинкционной длины составляет 55, 6 нм. Следовательно, на месте последней третьей светлой полосы толщина зерна составляет, примерно, 167 нм.
Толщинные контура экстинкции 12 Общее выражение для зависимости между толщиной t кристалла, количеством толщинных контуров экстинкции N и экстинкционной длиной g имеет следующий вид: t = N (1 + s 2 2)-1/2 В случае, когда отражающие плоскости находятся в точном брэгговском положении, то есть при параметре s = 0 эта формула превращается в выражение: t = N Зная количество толщинных контуров экстинкции, а также экстинкционную длину для соответствующей отражающей плоскости, последнию формулу можно использовать для определения толщины фольги или зерна на месте наклонной границы. Например, на наклонной границе зерна, обозначенной цифрой 2 на предыдущем рисунке имеется три темно-светлые чередующиеся полосы толщинных контуров экстинкции. Для отражения (111) в алюминии величина экстинкционной длины составляет 55, 6 нм. Следовательно, на месте последней третьей светлой полосы толщина зерна составляет, примерно, 167 нм.
 Изгибные контура экстинкции 13 Рассмотрим случай, когда в формуле sin 2 ( ts) I ------( s)2 толщина t постоянна, а параметр отклонения s непрерывно меняется, что характерно для изогнутых кристаллов. В этом случае зависимость интенсивности от величины параметра s иллюстрируется схемой представленной на рисунке слева. Как следует из приведенной формулы максимум интенсивности должен быть при s = 0. С увеличением параметра s наблюдается появление последующих максимумов, но при этом их интенсивность уменьшается. При этом первый максимум должен вызвать Схема иллюстрирующая изображение наибольшее почернение на фотопленке, и изогнутого кристалла и соответствующее соответственно, центральную светлую полосу на распределение интенсивности прошедшей светлопольном изображении структуры, по краям электронной волны. которой располагаются темные полосы,
Изгибные контура экстинкции 13 Рассмотрим случай, когда в формуле sin 2 ( ts) I ------( s)2 толщина t постоянна, а параметр отклонения s непрерывно меняется, что характерно для изогнутых кристаллов. В этом случае зависимость интенсивности от величины параметра s иллюстрируется схемой представленной на рисунке слева. Как следует из приведенной формулы максимум интенсивности должен быть при s = 0. С увеличением параметра s наблюдается появление последующих максимумов, но при этом их интенсивность уменьшается. При этом первый максимум должен вызвать Схема иллюстрирующая изображение наибольшее почернение на фотопленке, и изогнутого кристалла и соответствующее соответственно, центральную светлую полосу на распределение интенсивности прошедшей светлопольном изображении структуры, по краям электронной волны. которой располагаются темные полосы,
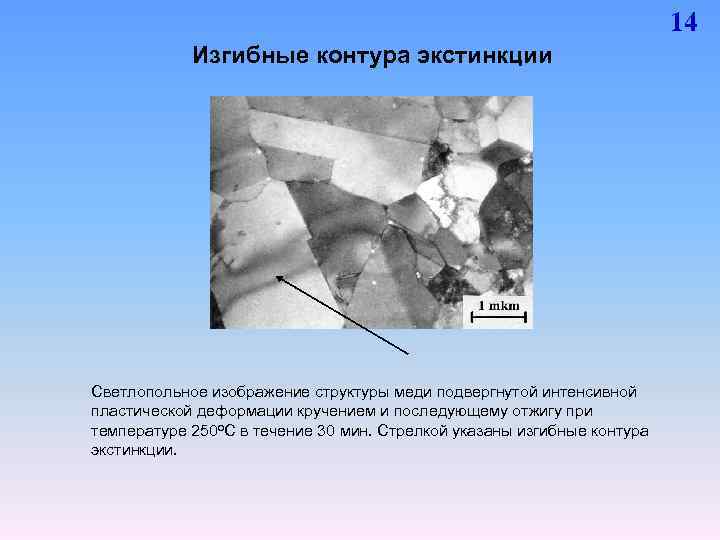 14 Изгибные контура экстинкции Светлопольное изображение структуры меди подвергнутой интенсивной пластической деформации кручением и последующему отжигу при температуре 250 о. С в течение 30 мин. Стрелкой указаны изгибные контура экстинкции.
14 Изгибные контура экстинкции Светлопольное изображение структуры меди подвергнутой интенсивной пластической деформации кручением и последующему отжигу при температуре 250 о. С в течение 30 мин. Стрелкой указаны изгибные контура экстинкции.
 Наложение 15 изгибных и толщинных контуров экстинкции Выше были рассмотрены толщинные и изгибные контура экстинкции, которые наблюдаются в условиях постоянства параметра отклонения s или толщины фольги t, соответственно. В общем случае на изображениях структуры может наблюдаться наложение этих двух эффектов. Это возможность возникает, например, при изучении структуры клиновидного края фольги изогнутого под влиянием внутренних напряжений. Так ниже на рисунке видны одновременно эффекты связанные с изменение толщины (чередование темно-светлых полос толщинных контуров экстинкции) и изгиба фольги (постоянство расстояния между линиями изгибных контуров расположенных вдоль отражающей плоскости обозначенной через hkl). Экстинкционные контуры на клиновидном крае изогнутой фольги
Наложение 15 изгибных и толщинных контуров экстинкции Выше были рассмотрены толщинные и изгибные контура экстинкции, которые наблюдаются в условиях постоянства параметра отклонения s или толщины фольги t, соответственно. В общем случае на изображениях структуры может наблюдаться наложение этих двух эффектов. Это возможность возникает, например, при изучении структуры клиновидного края фольги изогнутого под влиянием внутренних напряжений. Так ниже на рисунке видны одновременно эффекты связанные с изменение толщины (чередование темно-светлых полос толщинных контуров экстинкции) и изгиба фольги (постоянство расстояния между линиями изгибных контуров расположенных вдоль отражающей плоскости обозначенной через hkl). Экстинкционные контуры на клиновидном крае изогнутой фольги
 Муаровы узоры 16 Дифракционный контраст в виде муаровых узоров представляет собой набор светло-темных полос с периодом примерно несколько десятков ангстрем. Они возникают при последовательном прохождении электронной волны через два зерна, которые слегка различаются по следующим двум признакам: (1) межплоскостными расстояниями при параллельно расположенных плоскостях отражения (параллельный муаровый узор); (2) углом разворота одних и тех же плоскостей отражения имеющих небольшую разориентировку (муаровый узор вращения). В общем случае, если два зерна различаются межплоскостными расстояниями d 1 и d 2, а также углом разворота плоскостей , период муара определяется выражением: D = d 1 d 2/(d 12 + d 22 – 2 d 1 d 2 cos )1/2
Муаровы узоры 16 Дифракционный контраст в виде муаровых узоров представляет собой набор светло-темных полос с периодом примерно несколько десятков ангстрем. Они возникают при последовательном прохождении электронной волны через два зерна, которые слегка различаются по следующим двум признакам: (1) межплоскостными расстояниями при параллельно расположенных плоскостях отражения (параллельный муаровый узор); (2) углом разворота одних и тех же плоскостей отражения имеющих небольшую разориентировку (муаровый узор вращения). В общем случае, если два зерна различаются межплоскостными расстояниями d 1 и d 2, а также углом разворота плоскостей , период муара определяется выражением: D = d 1 d 2/(d 12 + d 22 – 2 d 1 d 2 cos )1/2
 Муаровы 17 узоры Для параллельного муара, когда = 0, выражение D = d 1 d 2/(d 12 + d 22 – 2 d 1 d 2 cos )1/2 приводится к следующему виду: D = d 1 d 2/(d 1 - d 2) Для муара вращения, когда d 1 = d 2 следует, что D = d/
Муаровы 17 узоры Для параллельного муара, когда = 0, выражение D = d 1 d 2/(d 12 + d 22 – 2 d 1 d 2 cos )1/2 приводится к следующему виду: D = d 1 d 2/(d 1 - d 2) Для муара вращения, когда d 1 = d 2 следует, что D = d/
 Муаровы узоры 18 Cветлопольное изображение структуры сильнодеформированного сплава содержит муаровые узоры в виде параллельных чередующихся темно-светлых полос с периодом ~50 Å. На электронограмме, снятой с участка фольги, где обнаружен муаровый узор, видны эффекты двойной дифракции, являющиеся результатом наложения по плоскостям базиса {0001} двух кристаллов с одинаковыми элементарными ячейками, взаимно разориентированных относительно их общей оси. В процессе деформации при комнатной температуре у магниевых сплавов активизируются базисные системы скольжения {0001} <1120>. В условиях ИПДК в них облегчена деформация в первую очередь тех кристаллитов, у которых плоскости базиса оказались параллельными поверхностям наковален. Поэтому в структуре деформированного сплава должны часто выявляться случаи близкого расположения зерен с плоскостями {0001}. В этих случаях на участках фольги где плоскости отражения {0001} двух зерен были разориентированы на малый угол , можно наблюдать муаровый узор вращения А 0. 1 мкм Муаровый узор в магниевом сплаве МА 8 после интенсивной пластической деформации кручением.
Муаровы узоры 18 Cветлопольное изображение структуры сильнодеформированного сплава содержит муаровые узоры в виде параллельных чередующихся темно-светлых полос с периодом ~50 Å. На электронограмме, снятой с участка фольги, где обнаружен муаровый узор, видны эффекты двойной дифракции, являющиеся результатом наложения по плоскостям базиса {0001} двух кристаллов с одинаковыми элементарными ячейками, взаимно разориентированных относительно их общей оси. В процессе деформации при комнатной температуре у магниевых сплавов активизируются базисные системы скольжения {0001} <1120>. В условиях ИПДК в них облегчена деформация в первую очередь тех кристаллитов, у которых плоскости базиса оказались параллельными поверхностям наковален. Поэтому в структуре деформированного сплава должны часто выявляться случаи близкого расположения зерен с плоскостями {0001}. В этих случаях на участках фольги где плоскости отражения {0001} двух зерен были разориентированы на малый угол , можно наблюдать муаровый узор вращения А 0. 1 мкм Муаровый узор в магниевом сплаве МА 8 после интенсивной пластической деформации кручением.
 Муаровы узоры 19 Ниже представлены электронограммы, в которых видны основные различия между параллельными муарами вращения. В случае параллельного муара точечные рефлексы от первого и второго зерна смещены относительно друга в радиальном направлении вследствие небольшого различия в межплоскостных расстояниях. На электронограмме от муара вращения точечные рефлексы от первого и второго зерна смещены относительно друга в азимутальном направлении свидетельствуя о том, что они имеют одинаковые по величине межплоскостные расстояния, которые слегка развернуты относительно друга. (а) (б) Картина дифракции для кристаллов, имеющих ориентировку (111): (а) для параллельных муаров от наложенных друг на друга кристаллов Ni и Au; (б) для муаров вращения от двух наложенных и разориентированных кристаллов Au.
Муаровы узоры 19 Ниже представлены электронограммы, в которых видны основные различия между параллельными муарами вращения. В случае параллельного муара точечные рефлексы от первого и второго зерна смещены относительно друга в радиальном направлении вследствие небольшого различия в межплоскостных расстояниях. На электронограмме от муара вращения точечные рефлексы от первого и второго зерна смещены относительно друга в азимутальном направлении свидетельствуя о том, что они имеют одинаковые по величине межплоскостные расстояния, которые слегка развернуты относительно друга. (а) (б) Картина дифракции для кристаллов, имеющих ориентировку (111): (а) для параллельных муаров от наложенных друг на друга кристаллов Ni и Au; (б) для муаров вращения от двух наложенных и разориентированных кристаллов Au.
 Кикучи-линии 20 Если точечные рефлексы на электронограмме являются следствием упругого рассеяния электронов на плоскостях находящихся в брэгговских условиях отражения, то Кикучилинии появляются в результате неупругого (диффузного) рассеяния электронов в объеме достаточно толстого образца с последующим упругим рассеянием. Эти электроны диффузно рассеянные в объеме образца при своем дальнейшем движении встречают плоскости, от которых они дополнительно отражаются в соответствии с законом Вульфа-Брэгга. Поскольку от источника диффузного рассеяния до отражающих плоскостей hkl и hkl может быть различное геометрическое расстояние, то возникающая пара Кикучи-линий будет иметь различные интенсивности. Одна из них будет иметь избыточную интенсивность по сравнению с фоном, другая пониженную интенсивность, как это показано ниже на рисунке. Первая из них дает светлую линию на экране микроскопа, Схема иллюстрирующая происхождение Кикучи-линий: (1) вторая – темную. При наблюдении в просвечивающем электронном микроскопе, светлая Кикучи-линия, имеющая и (3) светлая и темная Кикучилинии; (2) отражающая плоскость; избыточную интенсивность, расположена дальше от центрального рефлекса, по сравнению с темной линией. nhkl нормаль к отражающей плоскости; - угол брэгговского отражения
Кикучи-линии 20 Если точечные рефлексы на электронограмме являются следствием упругого рассеяния электронов на плоскостях находящихся в брэгговских условиях отражения, то Кикучилинии появляются в результате неупругого (диффузного) рассеяния электронов в объеме достаточно толстого образца с последующим упругим рассеянием. Эти электроны диффузно рассеянные в объеме образца при своем дальнейшем движении встречают плоскости, от которых они дополнительно отражаются в соответствии с законом Вульфа-Брэгга. Поскольку от источника диффузного рассеяния до отражающих плоскостей hkl и hkl может быть различное геометрическое расстояние, то возникающая пара Кикучи-линий будет иметь различные интенсивности. Одна из них будет иметь избыточную интенсивность по сравнению с фоном, другая пониженную интенсивность, как это показано ниже на рисунке. Первая из них дает светлую линию на экране микроскопа, Схема иллюстрирующая происхождение Кикучи-линий: (1) вторая – темную. При наблюдении в просвечивающем электронном микроскопе, светлая Кикучи-линия, имеющая и (3) светлая и темная Кикучилинии; (2) отражающая плоскость; избыточную интенсивность, расположена дальше от центрального рефлекса, по сравнению с темной линией. nhkl нормаль к отражающей плоскости; - угол брэгговского отражения
 Кикучи-линии Картина микродифракции содержащая Кикучи-линии от образца алюминия при почти точном брэгговском положении плоскостей (311). 21
Кикучи-линии Картина микродифракции содержащая Кикучи-линии от образца алюминия при почти точном брэгговском положении плоскостей (311). 21
 22 Кикучи-линии Положение Кикучи-линий: (а) в точном брэгговском положении (s=0); (б) при отрицательном знаке параметра отклонения (s<0); (в) при положительном знаке параметра отклонения (s>0). КТ – темная кикучи -линия, КС – светлая кикучи-линия. В точном брэгговском положении светлая Кикучи-линия (на позитивном изображении) проходит через точечный рефлекс hkl на электронограмме. При смещении Кикучи-линии от точечного рефлекса hkl происходит изменение знака параметра отклонения s. Эта особенность лежит в основе определения величины и знака отклонения параметра s от точных брэгговских условий. В этой методике вначале индицируют точечные рефлексы и соответствующие Кикучилинии на электронограмме. Затем измеряют радиус-вектор R (расстояние между точечным рефлексом hkl и центральным рефлексом), а также расстояние l между светлой Кикучи-линии (на позитиве) до точечного рефлекса hkl. Зная значение межплоскостного расстояния d, проводят расчет величины параметра s по формуле: s = l /Rd 2
22 Кикучи-линии Положение Кикучи-линий: (а) в точном брэгговском положении (s=0); (б) при отрицательном знаке параметра отклонения (s<0); (в) при положительном знаке параметра отклонения (s>0). КТ – темная кикучи -линия, КС – светлая кикучи-линия. В точном брэгговском положении светлая Кикучи-линия (на позитивном изображении) проходит через точечный рефлекс hkl на электронограмме. При смещении Кикучи-линии от точечного рефлекса hkl происходит изменение знака параметра отклонения s. Эта особенность лежит в основе определения величины и знака отклонения параметра s от точных брэгговских условий. В этой методике вначале индицируют точечные рефлексы и соответствующие Кикучилинии на электронограмме. Затем измеряют радиус-вектор R (расстояние между точечным рефлексом hkl и центральным рефлексом), а также расстояние l между светлой Кикучи-линии (на позитиве) до точечного рефлекса hkl. Зная значение межплоскостного расстояния d, проводят расчет величины параметра s по формуле: s = l /Rd 2
 Кикучи-линии 23 В последнее время широкое распространение получил метод дифракции отраженных электронов, в частности, для определения спектра разориентировок ультрамелкозернистых материалов. В его основе лежит применение картин Кикучи-линий для точного определения ориентации исследуемого участка. Для реализации этого метода разработаны специальные приставки к растровым электронным микроскопам оснащенные компьютерными программами обработки пошаговых картин изображения Кикучи-линий возникающих при сканировании поверхности образца. Использование этих компьютерных программ позволяет автоматически строить распределение по размерам зерен, спектр разориентировок и полюсные фигуры в исследуемом материале используя большой массив данных до 1000 зерен для каждого образца. Погрешность в определении разориентировок в лучших приборах составляет примерно 0, 1 градуса. Типичные изображения наблюдаемые методом дифракции отраженных электронов: (а) с отдельного участка: (б) с различных зерен.
Кикучи-линии 23 В последнее время широкое распространение получил метод дифракции отраженных электронов, в частности, для определения спектра разориентировок ультрамелкозернистых материалов. В его основе лежит применение картин Кикучи-линий для точного определения ориентации исследуемого участка. Для реализации этого метода разработаны специальные приставки к растровым электронным микроскопам оснащенные компьютерными программами обработки пошаговых картин изображения Кикучи-линий возникающих при сканировании поверхности образца. Использование этих компьютерных программ позволяет автоматически строить распределение по размерам зерен, спектр разориентировок и полюсные фигуры в исследуемом материале используя большой массив данных до 1000 зерен для каждого образца. Погрешность в определении разориентировок в лучших приборах составляет примерно 0, 1 градуса. Типичные изображения наблюдаемые методом дифракции отраженных электронов: (а) с отдельного участка: (б) с различных зерен.
 Контраст на изображении дислокаций 1 Присутствие дислокаций вызывает появление внутренних упругих напряжений в кристалле вследствие смещения атомов из равновесного положения. Соответственно, амплитуда электронной волны проходящей через дислокацию в общем случае будет зависеть от величины от направления вектора смещения R, а также от вида дислокации (винтовой, краевой, смешанной). Для винтовой дислокации с вектором Бюргерса b выражение для вектора смещения R имеет следующий вид: Кристалл, содержащий винтовую дислокацию АВ на глубине y параллельно поверхности фольги. b z-y R = ----- arctg (-------) 2 x где физический смысл величин x, y, z разъясняется на рисунке слева: x – расстояние между дислокацией и колонкой CD, через которую проходит электронная волна; y – расстояние от линии дислокации до верхней поверхности фольги, z - расстояние, которое проходит электронная волна вдоль колонки. После появления дислокации колонка CD с совершенной структурой приобретает вид колонки EF, содержащей искажения кристаллической решетки. Соответственно, электронная волна, проходящая через эту колонку в кристалле, испытывает влияние несовершенства кристаллической решетки, что приводит к появлению дифракционного контраста от дислокации.
Контраст на изображении дислокаций 1 Присутствие дислокаций вызывает появление внутренних упругих напряжений в кристалле вследствие смещения атомов из равновесного положения. Соответственно, амплитуда электронной волны проходящей через дислокацию в общем случае будет зависеть от величины от направления вектора смещения R, а также от вида дислокации (винтовой, краевой, смешанной). Для винтовой дислокации с вектором Бюргерса b выражение для вектора смещения R имеет следующий вид: Кристалл, содержащий винтовую дислокацию АВ на глубине y параллельно поверхности фольги. b z-y R = ----- arctg (-------) 2 x где физический смысл величин x, y, z разъясняется на рисунке слева: x – расстояние между дислокацией и колонкой CD, через которую проходит электронная волна; y – расстояние от линии дислокации до верхней поверхности фольги, z - расстояние, которое проходит электронная волна вдоль колонки. После появления дислокации колонка CD с совершенной структурой приобретает вид колонки EF, содержащей искажения кристаллической решетки. Соответственно, электронная волна, проходящая через эту колонку в кристалле, испытывает влияние несовершенства кристаллической решетки, что приводит к появлению дифракционного контраста от дислокации.
 Контраст на изображении дислокаций 2 В общем случае изображение дислокации не совпадает с положением проекции линии дислокации на экран. Распределение интенсивности в зависимости от расстояния до дислокации имеет вид кривой с максимумом смещенным в сторону от проекции линии дислокации. Схема иллюстрирующая интенсивность электронной волны после прохождения краевой дислокации: (а) образец содержащий краевую дислокацию; (б) положение отражающих плоскостей; (в) профиль интенсивности изображения дислокации.
Контраст на изображении дислокаций 2 В общем случае изображение дислокации не совпадает с положением проекции линии дислокации на экран. Распределение интенсивности в зависимости от расстояния до дислокации имеет вид кривой с максимумом смещенным в сторону от проекции линии дислокации. Схема иллюстрирующая интенсивность электронной волны после прохождения краевой дислокации: (а) образец содержащий краевую дислокацию; (б) положение отражающих плоскостей; (в) профиль интенсивности изображения дислокации.
 Контраст на изображении дислокаций 3 Из предыдущего рисунка следует, что увеличение интенсивности рассеянных электронов приводит к уменьшению интенсивности прошедших электронов. Поэтому дифракционный контраст от дислокаций на светлопольном и темнопольном изображениях выглядит в виде темных и светлых линий, соответственно, с шириной лежащей в пределах 1 -10 нм как изображено на рисунке ниже. Ширина изображения зависит от величины отклонения параметра s от точного брэгговского положения. Она уменьшается при возрастании s, например, при съемке темнопольных изображении в рефлексах 600, 400, по сравнении с изображением, полученным в рефлексе 200. При больших значениях параметра s разрешение значительно увеличивается, хотя интенсивность прошедшей электронной волны становится очень малой. Метод изучения структуры при больших значениях параметра s был назван методом слабых пучков. а б Электронномикроскопические изображения структуры сплава 1420 со средним размером зерен 1 мкм, содержащей дислокации: а - светлое поле; б - темное поле.
Контраст на изображении дислокаций 3 Из предыдущего рисунка следует, что увеличение интенсивности рассеянных электронов приводит к уменьшению интенсивности прошедших электронов. Поэтому дифракционный контраст от дислокаций на светлопольном и темнопольном изображениях выглядит в виде темных и светлых линий, соответственно, с шириной лежащей в пределах 1 -10 нм как изображено на рисунке ниже. Ширина изображения зависит от величины отклонения параметра s от точного брэгговского положения. Она уменьшается при возрастании s, например, при съемке темнопольных изображении в рефлексах 600, 400, по сравнении с изображением, полученным в рефлексе 200. При больших значениях параметра s разрешение значительно увеличивается, хотя интенсивность прошедшей электронной волны становится очень малой. Метод изучения структуры при больших значениях параметра s был назван методом слабых пучков. а б Электронномикроскопические изображения структуры сплава 1420 со средним размером зерен 1 мкм, содержащей дислокации: а - светлое поле; б - темное поле.
 Контраст на изображении дислокаций 4 Из рисунка на слайде 2 следует, что если вектор R меняет свой знак (соответственно, меняет знак произведение g R), то изображение дислокации сместится в другую сторону от проекции линии дислокации. Аналогичное изменение положения изображения дислокации происходит также при изменении знака параметра отклонения s. Эти две особенности изображения дислокаций вместе могут быть представлены на рисунке ниже, используя обобщенное выражение (g b)s. Схема иллюстрирующая смещение изображений (1) и (2) одной и той же дислокации при изменении знака выражения (g b)s.
Контраст на изображении дислокаций 4 Из рисунка на слайде 2 следует, что если вектор R меняет свой знак (соответственно, меняет знак произведение g R), то изображение дислокации сместится в другую сторону от проекции линии дислокации. Аналогичное изменение положения изображения дислокации происходит также при изменении знака параметра отклонения s. Эти две особенности изображения дислокаций вместе могут быть представлены на рисунке ниже, используя обобщенное выражение (g b)s. Схема иллюстрирующая смещение изображений (1) и (2) одной и той же дислокации при изменении знака выражения (g b)s.
 Контраст на изображении дислокаций 5 При этом нужно учитывать, что при g b = 0 дифракционный контраст от винтовой дислокации отсутствует. Это условие называется критерием невидимости дислокации. Оно имеет простой физический смысл. Контраст отсутствует если вектор Бюргерса лежит параллельно отражающей плоскости. В этом случае атомные смещения, параллельные отражающим плоскостям не меняют интенсивности электронной волны. На практике для определения плоскости, в которой лежит вектор Бюргерса, используют гониометр, наклоняя объект до полного исчезновения дифракционного контраста. Затем, переходя к электронограмме, при данном положении объекта, определяют индексы действующего точечного рефлекса. То есть, выполнение условия невидимости для одного вектора g позволяет определить плоскость, в которой лежит вектор Бюргерса. Если идентифицированы два точечных рефлекса g 1 и g 2, для которых выполняется правило g b=0, то это означает, что g 1 g 2 параллельно b, что позволяет однозначно определить направление вектора b как общее направление плоскостей определяемых векторами g 1 и g 2. Критерий невидимости дислокаций сформулированный выше, как g b = 0, справедлив для винтовых дислокаций. Для краевой дислокации дифракционный контраст полностью исчезает, когда линия дислокации расположена перпендикулярно отражающей плоскости, поскольку основные смещения атомов лежат в этой плоскости. Это соответствует дополнительному (к g b = 0) условию исчезновения контраста для краевой дислокации (g b)l = 0, где l – вектор направления линии краевой дислокации (для винтовой дислокации вектор l лежит параллельно вектору b, поэтому достаточно условия g b = 0)
Контраст на изображении дислокаций 5 При этом нужно учитывать, что при g b = 0 дифракционный контраст от винтовой дислокации отсутствует. Это условие называется критерием невидимости дислокации. Оно имеет простой физический смысл. Контраст отсутствует если вектор Бюргерса лежит параллельно отражающей плоскости. В этом случае атомные смещения, параллельные отражающим плоскостям не меняют интенсивности электронной волны. На практике для определения плоскости, в которой лежит вектор Бюргерса, используют гониометр, наклоняя объект до полного исчезновения дифракционного контраста. Затем, переходя к электронограмме, при данном положении объекта, определяют индексы действующего точечного рефлекса. То есть, выполнение условия невидимости для одного вектора g позволяет определить плоскость, в которой лежит вектор Бюргерса. Если идентифицированы два точечных рефлекса g 1 и g 2, для которых выполняется правило g b=0, то это означает, что g 1 g 2 параллельно b, что позволяет однозначно определить направление вектора b как общее направление плоскостей определяемых векторами g 1 и g 2. Критерий невидимости дислокаций сформулированный выше, как g b = 0, справедлив для винтовых дислокаций. Для краевой дислокации дифракционный контраст полностью исчезает, когда линия дислокации расположена перпендикулярно отражающей плоскости, поскольку основные смещения атомов лежат в этой плоскости. Это соответствует дополнительному (к g b = 0) условию исчезновения контраста для краевой дислокации (g b)l = 0, где l – вектор направления линии краевой дислокации (для винтовой дислокации вектор l лежит параллельно вектору b, поэтому достаточно условия g b = 0)
 Межплоскостное расстояние Связь между межплоскостным расстоянием dhkl и расстоянием от точечного рефлекса hkl до центрального рефлекса можно вывести, используя схему представленную слева. Из треугольника OO P следует: tg 2 = R/L где R – расстояние от точечного рефлекса до центрального рефлекса на электронограмме; L – дифракционная длина прибора (расстояние между образцом и фотопластинкой); 2 - угол между направлением первичного пучка электронов и дифрагированной электронной волной. С другой стороны, в соответствии с уравнением Вульфа. Брэгга (при n=1): Схема формирования электронограммы. = 2 dsin При этом вследствие малой длины волны электронов ( = 0, 0037 нм для ускоряющего напряжения 100 к. В) угол имеет значения менее 2 о. Поэтому в первом приближении можно считать, что tg 2 2 , а также sin . Следовательно, из приведенных выше выражений следует, что R/L= /d, или: Rd = L 6
Межплоскостное расстояние Связь между межплоскостным расстоянием dhkl и расстоянием от точечного рефлекса hkl до центрального рефлекса можно вывести, используя схему представленную слева. Из треугольника OO P следует: tg 2 = R/L где R – расстояние от точечного рефлекса до центрального рефлекса на электронограмме; L – дифракционная длина прибора (расстояние между образцом и фотопластинкой); 2 - угол между направлением первичного пучка электронов и дифрагированной электронной волной. С другой стороны, в соответствии с уравнением Вульфа. Брэгга (при n=1): Схема формирования электронограммы. = 2 dsin При этом вследствие малой длины волны электронов ( = 0, 0037 нм для ускоряющего напряжения 100 к. В) угол имеет значения менее 2 о. Поэтому в первом приближении можно считать, что tg 2 2 , а также sin . Следовательно, из приведенных выше выражений следует, что R/L= /d, или: Rd = L 6
 6 Пример анализа электронограммы 500 nm (а) (б) Микроструктура титана ВТ 1 -0 после интенсивной пластической деформации кручением: (а) светлопольное изображение; (б) картина микродифракции иллюстрирующая, что практически все точечные рефлексы кроме (100) расположены в виде колец соответствующих межплоскостным расстояниям -фазы.
6 Пример анализа электронограммы 500 nm (а) (б) Микроструктура титана ВТ 1 -0 после интенсивной пластической деформации кручением: (а) светлопольное изображение; (б) картина микродифракции иллюстрирующая, что практически все точечные рефлексы кроме (100) расположены в виде колец соответствующих межплоскостным расстояниям -фазы.
 Фазы присутствующие в титане ВТ 1 -0 пр данным рентгеноструктурного анализа (101/110) α (002) α (101) Рентгенограммы иллюстрирующие появление -фазы в титане ВТ 1 -0 чистотой 99, 84% в результате воздействия интенсивной пластической деформации кручением под давлением выше 3 ГПа при постоянном количестве оборотов n = 5. 7
Фазы присутствующие в титане ВТ 1 -0 пр данным рентгеноструктурного анализа (101/110) α (002) α (101) Рентгенограммы иллюстрирующие появление -фазы в титане ВТ 1 -0 чистотой 99, 84% в результате воздействия интенсивной пластической деформации кручением под давлением выше 3 ГПа при постоянном количестве оборотов n = 5. 7
 8 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов (а) (б) Частицы наблюдаемые в закаленном сплаве при нагреве в in-situ в просвечивающем электронном микроскопе: (a) светлопольное изображение частиц Al 3 Zr фазы при 20 o. C; (б) электронограмма с частиц Al 3 Zr фазы где индексы обозначают точечные рефлексы, соответствующие межплоскостным расстояниям приведенным в таблице.
8 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов (а) (б) Частицы наблюдаемые в закаленном сплаве при нагреве в in-situ в просвечивающем электронном микроскопе: (a) светлопольное изображение частиц Al 3 Zr фазы при 20 o. C; (б) электронограмма с частиц Al 3 Zr фазы где индексы обозначают точечные рефлексы, соответствующие межплоскостным расстояниям приведенным в таблице.
 9 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов Таблица. Межплоскостные расстояния, соответствующие точечным рефлексам идентифицированным на рисунке 78. hkl Расчетные значения d, нм Табличные значения d, нм* 110 0, 288 0, 283 114 0, 233 0, 237 220 0, 143 0, 142 228 0, 126 0, 122 1112 0, 129 0, 128 422 0, 4109 711 0, 2870 0, 2831 731 0, 2610 0, 2623 800 0, 2498 0, 2519 664 0, 2168 0, 2146 842 0, 2212 0, 2204 933 0, 2013 0, 2024 Фазы Фаза (Al 3 Zr) Фаза S(Al 2 Li. Mg)
9 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов Таблица. Межплоскостные расстояния, соответствующие точечным рефлексам идентифицированным на рисунке 78. hkl Расчетные значения d, нм Табличные значения d, нм* 110 0, 288 0, 283 114 0, 233 0, 237 220 0, 143 0, 142 228 0, 126 0, 122 1112 0, 129 0, 128 422 0, 4109 711 0, 2870 0, 2831 731 0, 2610 0, 2623 800 0, 2498 0, 2519 664 0, 2168 0, 2146 842 0, 2212 0, 2204 933 0, 2013 0, 2024 Фазы Фаза (Al 3 Zr) Фаза S(Al 2 Li. Mg)
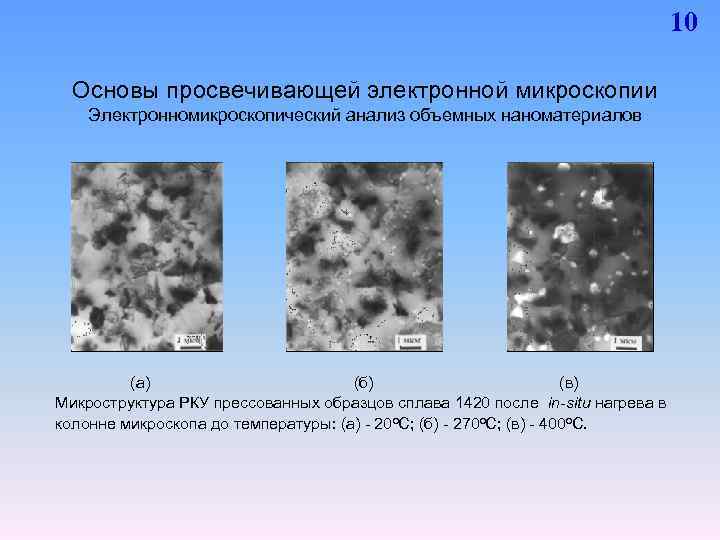 10 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов (a) (б) (в) Микроструктура РКУ прессованных образцов сплава 1420 после in-situ нагрева в колонне микроскопа до температуры: (а) - 20 o. C; (б) - 270 o. C; (в) - 400 o. C.
10 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов (a) (б) (в) Микроструктура РКУ прессованных образцов сплава 1420 после in-situ нагрева в колонне микроскопа до температуры: (а) - 20 o. C; (б) - 270 o. C; (в) - 400 o. C.
 11 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов (а) (б) Спектр разориентировок в сплаве 1420 подвергнутом РКУП по режим 1: (a) поперечное сечение; (б) сечение вдоль оси РКУП.
11 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов (а) (б) Спектр разориентировок в сплаве 1420 подвергнутом РКУП по режим 1: (a) поперечное сечение; (б) сечение вдоль оси РКУП.
 12 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов Энегодисперсионный анализ светлой и темной частиц расположенных, соответственно в центре и справа на следующем слайде.
12 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов Энегодисперсионный анализ светлой и темной частиц расположенных, соответственно в центре и справа на следующем слайде.
 13 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов (a) (б) Частицы в РКУП образцах сплава 1420 после отжига при 400 o. C, 5 мин, для которых выполнен энергодисперсионный анализ на предыдущем слайде: (a) - в центре расположена светлая частица Al. Li фазы, справа – темные частицы Al 2 Mg. Li фазы; (б) электронограмма с темной частицы где обозначены индексы точечных рефлексов, соответствующих межплоскостным расстояниям Al 2 Mg. Li фазы представленным на выше приведенной таблице.
13 Основы просвечивающей электронной микроскопии Электронномикроскопический анализ объемных наноматериалов (a) (б) Частицы в РКУП образцах сплава 1420 после отжига при 400 o. C, 5 мин, для которых выполнен энергодисперсионный анализ на предыдущем слайде: (a) - в центре расположена светлая частица Al. Li фазы, справа – темные частицы Al 2 Mg. Li фазы; (б) электронограмма с темной частицы где обозначены индексы точечных рефлексов, соответствующих межплоскостным расстояниям Al 2 Mg. Li фазы представленным на выше приведенной таблице.
 Дифракционные картины 1 Типичной особенностью дифракционных картин является: - большое количество точечных рефлексов - различие в их размере и интенсивности При первом знакомстве с дифракционной картиной обычно возникают вопросы: - что они представляют собой? - что влияет на расстояние между ними? - от чего зависит их количество и интенсивность? - какую информацию о структуре можно извлечь из анализа дифракционной картины? Типичная электронограмма крупнозернистого образца алюминиевого сплава 6061
Дифракционные картины 1 Типичной особенностью дифракционных картин является: - большое количество точечных рефлексов - различие в их размере и интенсивности При первом знакомстве с дифракционной картиной обычно возникают вопросы: - что они представляют собой? - что влияет на расстояние между ними? - от чего зависит их количество и интенсивность? - какую информацию о структуре можно извлечь из анализа дифракционной картины? Типичная электронограмма крупнозернистого образца алюминиевого сплава 6061
 Дифракционные картины В общем случае анализ дифракционной картины позволяет ответить на следующие вопросы: - является ли структура образца аморфной или кристаллической? - является ли структура крупнозернистой или ультрамелкозернистой? - присутствуют ли в образце частицы выделений? - каковы межплоскостные расстояния в кристалле? - какова симметрия кристаллической решетки? - какова ориентация зерна относительно направления электронного пучка? Типичная электронограмма ультрамелкозернистого образца алюминиевого сплава 6061 полученного методом ИПДК 2
Дифракционные картины В общем случае анализ дифракционной картины позволяет ответить на следующие вопросы: - является ли структура образца аморфной или кристаллической? - является ли структура крупнозернистой или ультрамелкозернистой? - присутствуют ли в образце частицы выделений? - каковы межплоскостные расстояния в кристалле? - какова симметрия кристаллической решетки? - какова ориентация зерна относительно направления электронного пучка? Типичная электронограмма ультрамелкозернистого образца алюминиевого сплава 6061 полученного методом ИПДК 2
 Влияние размера селективной диафрагмы на вид электронограммы 3 В общем случае количество точечных рефлексов появляющихся на электронограмме зависит от количества зерен охваченных селективной диафрагмой, то есть от размера участка вырезанного селективной диафрагмой на светлопольном изображении структуры. а б Светлопольное изображение и электронограммы для УМЗ меди после ИПДК: (а) светлопольное изображение; (б) картины микродифракции с участков, обозначенных на (а). Например, на фотографии (а) сверху справа представлена электронограмма снятая с площади 2 мкм 2 (диаметр участка выделенного на изображении структуры равен 1, 6 мкм), тогда как на электронограмме справа изображены 6 электронограмм снятых с площади 0, 1 мкм 2 (диаметр выделенного участка равен 0, 37 мкм).
Влияние размера селективной диафрагмы на вид электронограммы 3 В общем случае количество точечных рефлексов появляющихся на электронограмме зависит от количества зерен охваченных селективной диафрагмой, то есть от размера участка вырезанного селективной диафрагмой на светлопольном изображении структуры. а б Светлопольное изображение и электронограммы для УМЗ меди после ИПДК: (а) светлопольное изображение; (б) картины микродифракции с участков, обозначенных на (а). Например, на фотографии (а) сверху справа представлена электронограмма снятая с площади 2 мкм 2 (диаметр участка выделенного на изображении структуры равен 1, 6 мкм), тогда как на электронограмме справа изображены 6 электронограмм снятых с площади 0, 1 мкм 2 (диаметр выделенного участка равен 0, 37 мкм).
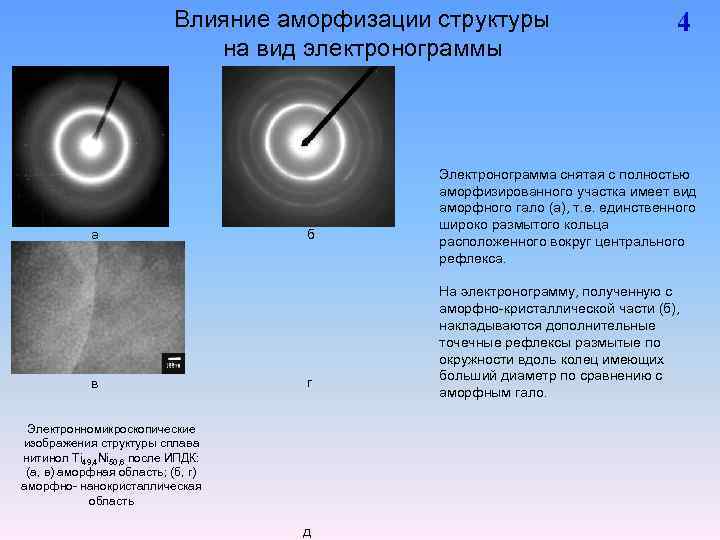 Влияние аморфизации структуры на вид электронограммы а б в г Электронномикроскопические изображения структуры сплава нитинол Ti 49, 4 Ni 50, 6 после ИПДК: (а, в) аморфная область; (б, г) аморфно- нанокристаллическая область д 4 Электронограмма снятая с полностью аморфизированного участка имеет вид аморфного гало (а), т. е. единственного широко размытого кольца расположенного вокруг центрального рефлекса. На электронограмму, полученную с аморфно-кристаллической части (б), накладываются дополнительные точечные рефлексы размытые по окружности вдоль колец имеющих больший диаметр по сравнению с аморфным гало.
Влияние аморфизации структуры на вид электронограммы а б в г Электронномикроскопические изображения структуры сплава нитинол Ti 49, 4 Ni 50, 6 после ИПДК: (а, в) аморфная область; (б, г) аморфно- нанокристаллическая область д 4 Электронограмма снятая с полностью аморфизированного участка имеет вид аморфного гало (а), т. е. единственного широко размытого кольца расположенного вокруг центрального рефлекса. На электронограмму, полученную с аморфно-кристаллической части (б), накладываются дополнительные точечные рефлексы размытые по окружности вдоль колец имеющих больший диаметр по сравнению с аморфным гало.
 Влияние среднего размера зерна 5 на вид электронограммы а б Вид электронограммы для алюминиевого сплава 6061 снятой с одной и той же селективной диафрагмы площадью 2 мкм 2. Для электронограммы слева (а), в поле выделенное селективной диафрагмой попало одно микронное зерно (размером более 1, 6 мкм) находящееся в положении Вольфа-Брэгга. На ближайшем расстоянии от центрального рефлекса находятся 4 точечных рефлекса от отражения (111) для гцк решетки алюминия. Для электронограммы справа (б), в этот же размер селективной диафрагмы попало примерно 15 зерен, находящихся в положении Вольфа-Брэгга. поскольку в первом кольце находится примерно 60 точечных рефлексов от отражения (111).
Влияние среднего размера зерна 5 на вид электронограммы а б Вид электронограммы для алюминиевого сплава 6061 снятой с одной и той же селективной диафрагмы площадью 2 мкм 2. Для электронограммы слева (а), в поле выделенное селективной диафрагмой попало одно микронное зерно (размером более 1, 6 мкм) находящееся в положении Вольфа-Брэгга. На ближайшем расстоянии от центрального рефлекса находятся 4 точечных рефлекса от отражения (111) для гцк решетки алюминия. Для электронограммы справа (б), в этот же размер селективной диафрагмы попало примерно 15 зерен, находящихся в положении Вольфа-Брэгга. поскольку в первом кольце находится примерно 60 точечных рефлексов от отражения (111).
 Расположение точечных рефлексов на электронограмме При первом знакомстве с электронограммой часто возникает вопрос: почему точечные рефлексы расположены в строгом геометрическом порядке, и каким образом их расположение связано с кристаллической структурой исследуемого образца? Для визуального представления о взаимосвязи между расположением точечных рефлексов и кристаллической структурой материала используют понятие о стереографической проекции Стереографическая проекция. Кристалл находится в центре. Нормали к плоскостям кристаллической решетки пересекают сферу в точках обозначенных соответствующимb индексами Миллера (001), (101), (010) и т. д. В общем случае все эти нормали пересекают большую горизонтальную плоскость, которая может рассматриваться как аналог плоскости экрана в микроскопе (на рисунке обозначена как “Primitive great circle”. Эти точки пересечения будут выглядеть как точечные рефлексы на электронограмме. 6
Расположение точечных рефлексов на электронограмме При первом знакомстве с электронограммой часто возникает вопрос: почему точечные рефлексы расположены в строгом геометрическом порядке, и каким образом их расположение связано с кристаллической структурой исследуемого образца? Для визуального представления о взаимосвязи между расположением точечных рефлексов и кристаллической структурой материала используют понятие о стереографической проекции Стереографическая проекция. Кристалл находится в центре. Нормали к плоскостям кристаллической решетки пересекают сферу в точках обозначенных соответствующимb индексами Миллера (001), (101), (010) и т. д. В общем случае все эти нормали пересекают большую горизонтальную плоскость, которая может рассматриваться как аналог плоскости экрана в микроскопе (на рисунке обозначена как “Primitive great circle”. Эти точки пересечения будут выглядеть как точечные рефлексы на электронограмме. 6
 7 Расположение точечных рефлексов на электронограмме Некоторые стандартные стереографические проекции. Обозначения в центре определяют каждую проекцию 001, 011 и 111, соответственно.
7 Расположение точечных рефлексов на электронограмме Некоторые стандартные стереографические проекции. Обозначения в центре определяют каждую проекцию 001, 011 и 111, соответственно.
 8 Формирование дифракционной картины Схема формирования изображения в ПЭМ: (А) дифракционной картины; (В) светлопольного изображения. Переход от дифракционной картины к светлопольному изображению осуществляется за счет изменения режима работы 1 промежуточной линзы, подбирая их таким образом, чтобы увеличить или уменьшить ее фокусное расстояние.
8 Формирование дифракционной картины Схема формирования изображения в ПЭМ: (А) дифракционной картины; (В) светлопольного изображения. Переход от дифракционной картины к светлопольному изображению осуществляется за счет изменения режима работы 1 промежуточной линзы, подбирая их таким образом, чтобы увеличить или уменьшить ее фокусное расстояние.
 Вид электронограммы при работе в светлопольном и темнопольном изображения Положение диафрагмы объективной линзы на электронограмме при котором получают: (а) светлопольное изображение; (б) темнопольное изображение в случае когда на исследуемый рефлекс смещена диафрагма OL; (в) темнопольное изображение в случае когда иследуемый рефлекс перемещен на место центрального рефлекса. 9
Вид электронограммы при работе в светлопольном и темнопольном изображения Положение диафрагмы объективной линзы на электронограмме при котором получают: (а) светлопольное изображение; (б) темнопольное изображение в случае когда на исследуемый рефлекс смещена диафрагма OL; (в) темнопольное изображение в случае когда иследуемый рефлекс перемещен на место центрального рефлекса. 9
 Последовательность действий при получении электронограммы Для получения изображения дифракционной картины на экране ПЭМ нужно использовать следующую последовательность действий: 1. 2. 3. 4. 5. Вставить селективную диафрагму Удалить диафрагму объективной линзы Переключить в режим дифракции Отрегулировать яркость точечных рефлексов фокусируя конденсорную линзу С 2 Сфокусировать точечные рефлексы на электронограмме с помощью промежуточной линзы используя «diffraction focus» 10
Последовательность действий при получении электронограммы Для получения изображения дифракционной картины на экране ПЭМ нужно использовать следующую последовательность действий: 1. 2. 3. 4. 5. Вставить селективную диафрагму Удалить диафрагму объективной линзы Переключить в режим дифракции Отрегулировать яркость точечных рефлексов фокусируя конденсорную линзу С 2 Сфокусировать точечные рефлексы на электронограмме с помощью промежуточной линзы используя «diffraction focus» 10
 Использование индексов на электронограмме 11 Как известно для обозначения кристаллографических плоскостей обычно используют индексы Миллера, которые принято обозначать в скобках (hkl). Например Миллера для плоскости, Для совокупности кристаллографических плоскостей, имеющие одинаковое атомное строение, например, (001) и (100) используют обозначначение {100}. При анализе электронограмм в ПЭМ для первичного пучка (центрального рефлекса) обычно используют обозначение 000, а для пучка дифрагированного от какой-либо кристаллографической плоскости применяют обозначение hkl, которое пишется обычно без скобок. Схемы иллюстрирующие стандартные положение точечных рефлексов на электронограмме от о. ц. к. решетки. На схемах приведены углы между направлениями от центрального рефлекса до соответствующих точечных рефлексов. Представлены также относительные расстояния от центрально рефлекса до точечных рефлексов. Символом В обозначена ось зоны, то есть направление, которое является общим для всех плоскостей от которых произошла дифракция. Запрещенные рефлексы обозначены символом х.
Использование индексов на электронограмме 11 Как известно для обозначения кристаллографических плоскостей обычно используют индексы Миллера, которые принято обозначать в скобках (hkl). Например Миллера для плоскости, Для совокупности кристаллографических плоскостей, имеющие одинаковое атомное строение, например, (001) и (100) используют обозначначение {100}. При анализе электронограмм в ПЭМ для первичного пучка (центрального рефлекса) обычно используют обозначение 000, а для пучка дифрагированного от какой-либо кристаллографической плоскости применяют обозначение hkl, которое пишется обычно без скобок. Схемы иллюстрирующие стандартные положение точечных рефлексов на электронограмме от о. ц. к. решетки. На схемах приведены углы между направлениями от центрального рефлекса до соответствующих точечных рефлексов. Представлены также относительные расстояния от центрально рефлекса до точечных рефлексов. Символом В обозначена ось зоны, то есть направление, которое является общим для всех плоскостей от которых произошла дифракция. Запрещенные рефлексы обозначены символом х.
 Типичное расположение точечных рефлексов на электронограмме от г. ц. к. решетки Схемы иллюстрирующие стандартные положение точечных рефлексов на электронограмме от г. ц. к. решетки. На схемах приведены углы между направлениями от центрального рефлекса до соответствующих точечных рефлексов. Представлены также относительные расстояния от центрально рефлекса до точечных рефлексов. Символом В обозначена ось зоны, то есть направление, которое является общим для всех плоскостей от которых произошла дифракция 12
Типичное расположение точечных рефлексов на электронограмме от г. ц. к. решетки Схемы иллюстрирующие стандартные положение точечных рефлексов на электронограмме от г. ц. к. решетки. На схемах приведены углы между направлениями от центрального рефлекса до соответствующих точечных рефлексов. Представлены также относительные расстояния от центрально рефлекса до точечных рефлексов. Символом В обозначена ось зоны, то есть направление, которое является общим для всех плоскостей от которых произошла дифракция 12
 Типичное расположение точечных рефлексов на электронограмме от г. п. у. решетки 13
Типичное расположение точечных рефлексов на электронограмме от г. п. у. решетки 13
 Эффекты двойной дифракции Двойная дифракция появляется когда дифрагированный пучок на пути движения по кристаллу испытывает дополнительную дифракцию от тех же самых кристаллографических плоскостей или же от плоскостей соседнего кристалла. Если вектор начального дифрагированного пучка характеризовался точечным рефлексом g 1, а после дополнительной дифракции – рефлексом g 2, то в результате появляется дополнительный точечный рефлекс от двойной дифракции g 1 – g 2. Рисунок иллюстрирующий появление двойной дифракции на электронограмме от частицы Fe 2 O 3 на Al 2 O 3, на примере точечных рефлексов 1120 и 3300. На нижних рисунках приведены увеличенные изображения этих точечных рефлексов, а справа схематичное расположение точечных рефлексов от двойной дифракции. 14
Эффекты двойной дифракции Двойная дифракция появляется когда дифрагированный пучок на пути движения по кристаллу испытывает дополнительную дифракцию от тех же самых кристаллографических плоскостей или же от плоскостей соседнего кристалла. Если вектор начального дифрагированного пучка характеризовался точечным рефлексом g 1, а после дополнительной дифракции – рефлексом g 2, то в результате появляется дополнительный точечный рефлекс от двойной дифракции g 1 – g 2. Рисунок иллюстрирующий появление двойной дифракции на электронограмме от частицы Fe 2 O 3 на Al 2 O 3, на примере точечных рефлексов 1120 и 3300. На нижних рисунках приведены увеличенные изображения этих точечных рефлексов, а справа схематичное расположение точечных рефлексов от двойной дифракции. 14


