Тема 5 ДИФФУЗИОННЫЙ МЕТОД СОЗДАНИЯ АКТИВНЫХ И ПАССИВНЫХ














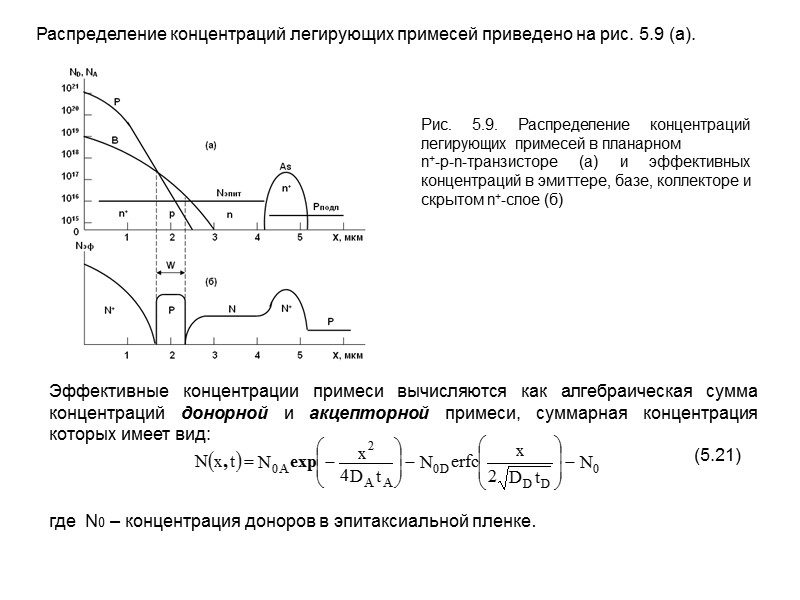










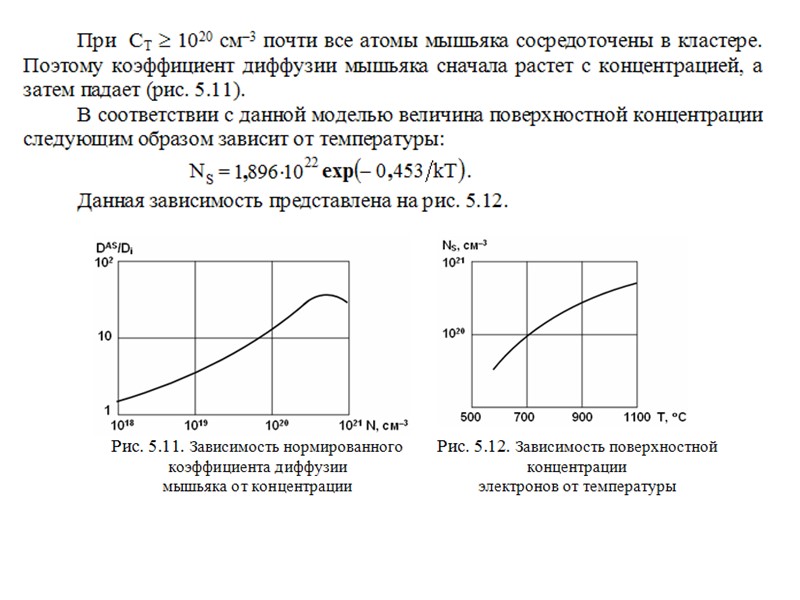





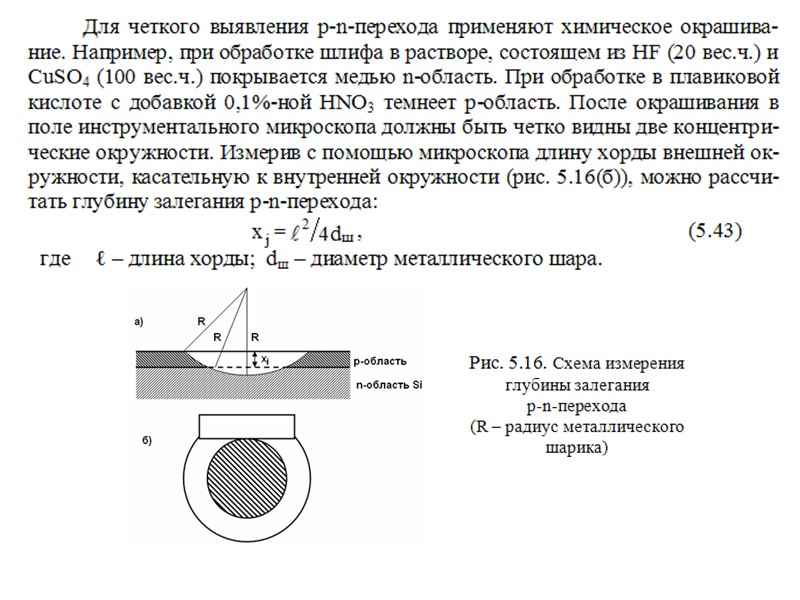









16-5-_diffuziya.ppt
- Количество слайдов: 40
 Тема 5 ДИФФУЗИОННЫЙ МЕТОД СОЗДАНИЯ АКТИВНЫХ И ПАССИВНЫХ СТРУКТУР ИНТЕГРАЛЬНЫХ СХЕМ Введение Диффузия примесей в монокристаллический материал является одной из основных технологических операций при создании полупроводниковых приборов и интегральных схем. При помощи диффузии формируются области с определенным типом проводимости и градиентом концентрации в различных областях полупроводниковой пластины, создаются диодные и транзисторные структуры, резисторы, конденсаторы и другие элементы интегральных схем. Диффузией называется направленное движение атомов под действием градиента концентрации или температуры. Если атом является собственным, то процесс диффузии называется самодиффузией, если примесным – примесной диффузией (гетеродиффузией). Причины диффузии, т.е. ее движущие силы, можно объяснить законами термодинамики. Процессы диффузии возможны, если при этом уменьшается свободная энергия системы или повышается энтропия. Так как диффузионные процессы связаны с повышением энтропии, они необратимы. Следует, однако, подчеркнуть, что термодинамика устанавливает только принципиальную возможность или невозможность процесса диффузии. Реально протекающие процессы в основном определяются кинетическими факторами. В реальных кристаллах могут существовать три механизма диффузии: – взаимный обмен атомов, являющихся ближайшими соседями; – по междоузлиям; – по вакансиям.
Тема 5 ДИФФУЗИОННЫЙ МЕТОД СОЗДАНИЯ АКТИВНЫХ И ПАССИВНЫХ СТРУКТУР ИНТЕГРАЛЬНЫХ СХЕМ Введение Диффузия примесей в монокристаллический материал является одной из основных технологических операций при создании полупроводниковых приборов и интегральных схем. При помощи диффузии формируются области с определенным типом проводимости и градиентом концентрации в различных областях полупроводниковой пластины, создаются диодные и транзисторные структуры, резисторы, конденсаторы и другие элементы интегральных схем. Диффузией называется направленное движение атомов под действием градиента концентрации или температуры. Если атом является собственным, то процесс диффузии называется самодиффузией, если примесным – примесной диффузией (гетеродиффузией). Причины диффузии, т.е. ее движущие силы, можно объяснить законами термодинамики. Процессы диффузии возможны, если при этом уменьшается свободная энергия системы или повышается энтропия. Так как диффузионные процессы связаны с повышением энтропии, они необратимы. Следует, однако, подчеркнуть, что термодинамика устанавливает только принципиальную возможность или невозможность процесса диффузии. Реально протекающие процессы в основном определяются кинетическими факторами. В реальных кристаллах могут существовать три механизма диффузии: – взаимный обмен атомов, являющихся ближайшими соседями; – по междоузлиям; – по вакансиям.
 Скорость диффузии примесных атомов в полупроводниках обратно пропорциональна их растворимости. Энергия связи примесного атома в решетке кристалла меньше, чем собственных атомов, поэтому образование вакансий около примесных атомов облегчается, и диффузия часто происходит в виде движения комплекса (атом примеси + вакансия). Примеси, диффундирующие по междоузельному механизму в кремнии, принадлежат к примесям внедрения. К ним относятся элементы I и VIII групп периодической системы элементов Менделеева: водород, натрий, калий, хлор, аргон, гелий. Обычно эти примеси электрически неактивны. Примеси, диффундирующие по вакансионному механизму, относятся к примесям замещения, являются электрически активными и используются для изготовления легированных слоев. Их движение зависит от количества и заряда вакансий в кристаллической решетке. К ним относятся примеси, принадлежащие к III и V группам Периодической системы элементов. В микроэлектронике в основном используются бор, сурьма, мышьяк и фосфор. Некоторые примеси, такие как кобальт, медь, золото, серебро и платина, диффундируют по сложному диссоциативному механизму и относятся к примесям как внедрения, так и замещения. Эти примеси уменьшают время жизни неосновных носителей в кремнии и считаются поэтому основными загрязняющими примесями.
Скорость диффузии примесных атомов в полупроводниках обратно пропорциональна их растворимости. Энергия связи примесного атома в решетке кристалла меньше, чем собственных атомов, поэтому образование вакансий около примесных атомов облегчается, и диффузия часто происходит в виде движения комплекса (атом примеси + вакансия). Примеси, диффундирующие по междоузельному механизму в кремнии, принадлежат к примесям внедрения. К ним относятся элементы I и VIII групп периодической системы элементов Менделеева: водород, натрий, калий, хлор, аргон, гелий. Обычно эти примеси электрически неактивны. Примеси, диффундирующие по вакансионному механизму, относятся к примесям замещения, являются электрически активными и используются для изготовления легированных слоев. Их движение зависит от количества и заряда вакансий в кристаллической решетке. К ним относятся примеси, принадлежащие к III и V группам Периодической системы элементов. В микроэлектронике в основном используются бор, сурьма, мышьяк и фосфор. Некоторые примеси, такие как кобальт, медь, золото, серебро и платина, диффундируют по сложному диссоциативному механизму и относятся к примесям как внедрения, так и замещения. Эти примеси уменьшают время жизни неосновных носителей в кремнии и считаются поэтому основными загрязняющими примесями.
 5.1. Теоретические основы процесса диффузии Математическое описание диффузионных процессов было впервые дано в 1885 г. А. Фиком в виде двух законов. Первый закон Фика определяет, что скорость переноса растворенного вещества через сечение единичной площади за единицу времени пропорциональна градиенту концентрации диффузанта: (5.1) где J(x) – вектор плотности потока диффузанта (см2с); D – коэффициент диффузии (см2/с); N – концентрация растворенного вещества (см–3); х – координата (см); dN/dx – градиент концентрации примеси (см–4). Знак минус в правой части уравнения (5.1) означает, что процесс переноса вещества происходит в направлении уменьшения концентрации растворенного вещества. Второй закон Фика определяет изменение концентрации диффундирующей примеси в зависимости от времени и координаты: (5.2) где – изменение концентрации диффундирующего вещества во времени.
5.1. Теоретические основы процесса диффузии Математическое описание диффузионных процессов было впервые дано в 1885 г. А. Фиком в виде двух законов. Первый закон Фика определяет, что скорость переноса растворенного вещества через сечение единичной площади за единицу времени пропорциональна градиенту концентрации диффузанта: (5.1) где J(x) – вектор плотности потока диффузанта (см2с); D – коэффициент диффузии (см2/с); N – концентрация растворенного вещества (см–3); х – координата (см); dN/dx – градиент концентрации примеси (см–4). Знак минус в правой части уравнения (5.1) означает, что процесс переноса вещества происходит в направлении уменьшения концентрации растворенного вещества. Второй закон Фика определяет изменение концентрации диффундирующей примеси в зависимости от времени и координаты: (5.2) где – изменение концентрации диффундирующего вещества во времени.
 В формуле (5.2) учитывается зависимость коэффициента диффузии от концентрации примеси и, следовательно, координаты. При малой концентрации диффундирующей примеси (менее 1018 см–3) зависимостью коэффициента диффузии от концентрации можно пренебречь и (2) принимает вид: (5.3) Коэффициент диффузии является экспоненциальной функцией температуры (5.4) где D0 – постоянная, численно равная коэффициенту диффузии при бесконечно большой температуре; Е – энергия активации диффузии. На рис. 5.1 приведена температурная зависимость коэффициентов диффузии примесей, применяемых в микроэлектронике. Рис. 5.1. Зависимость коэффициентов диффузии примесей в кремнии от температуры
В формуле (5.2) учитывается зависимость коэффициента диффузии от концентрации примеси и, следовательно, координаты. При малой концентрации диффундирующей примеси (менее 1018 см–3) зависимостью коэффициента диффузии от концентрации можно пренебречь и (2) принимает вид: (5.3) Коэффициент диффузии является экспоненциальной функцией температуры (5.4) где D0 – постоянная, численно равная коэффициенту диффузии при бесконечно большой температуре; Е – энергия активации диффузии. На рис. 5.1 приведена температурная зависимость коэффициентов диффузии примесей, применяемых в микроэлектронике. Рис. 5.1. Зависимость коэффициентов диффузии примесей в кремнии от температуры
 5.1.1. Диффузия из источника бесконечной мощности (с постоянной поверхностной концентрацией) В данном случае предполагается, что примесь непрерывно поступает через поверхность кристалла из внешнего источника с целью введения в полупроводник точно контролируемого количества примеси Q и поток ее все время одинаков. Начальные и граничные условия в этом случае записываются в виде: (5.5) Уравнение (5.3) с граничными условиями (5.5) имеет решение: (5.6) где erfc(y) – дополнительная функция ошибок Гаусса или интеграл вероятности, значения которого табулированы: (5.7) При малых (у 1) и больших (у 3) значениях аргумента могут быть использованы следующие аппроксимации: (5.8) (5.9)
5.1.1. Диффузия из источника бесконечной мощности (с постоянной поверхностной концентрацией) В данном случае предполагается, что примесь непрерывно поступает через поверхность кристалла из внешнего источника с целью введения в полупроводник точно контролируемого количества примеси Q и поток ее все время одинаков. Начальные и граничные условия в этом случае записываются в виде: (5.5) Уравнение (5.3) с граничными условиями (5.5) имеет решение: (5.6) где erfc(y) – дополнительная функция ошибок Гаусса или интеграл вероятности, значения которого табулированы: (5.7) При малых (у 1) и больших (у 3) значениях аргумента могут быть использованы следующие аппроксимации: (5.8) (5.9)
 Распределение легирующей примеси при различных временах диффузии показано на рис. 5.2. Рис. 5.2. Распределение примеси при различных временах диффузии из бесконечного источника (загонка). t1 < t2 < t3 < t4 Подставляя (5.8) в (5.1) после дифференцирования получаем плотность потока через поверхность кристалла (при х = 0): (5.10) Количество введенного диффузанта (Q) на первом этапе (при загонке примеси) равно: (5.11) В выражение (5.11) входит величина , имеющая размерность длины, которая называется длиной диффузии (h). При постоянной поверхностной концентрации величина h определяет количество примеси, введенное в кристалл за время диффузии через площадку единичной площади.
Распределение легирующей примеси при различных временах диффузии показано на рис. 5.2. Рис. 5.2. Распределение примеси при различных временах диффузии из бесконечного источника (загонка). t1 < t2 < t3 < t4 Подставляя (5.8) в (5.1) после дифференцирования получаем плотность потока через поверхность кристалла (при х = 0): (5.10) Количество введенного диффузанта (Q) на первом этапе (при загонке примеси) равно: (5.11) В выражение (5.11) входит величина , имеющая размерность длины, которая называется длиной диффузии (h). При постоянной поверхностной концентрации величина h определяет количество примеси, введенное в кристалл за время диффузии через площадку единичной площади.
 Если NS равна предельной растворимости примеси при выбранной температуре диффузии, то поверхностная концентрация не зависит от времени процесса диффузии, что дает возможность воспроизводимого получения параметров диффузионного слоя. Зависимость предельных растворимостей основных легирующих примесей в кремнии от температуры приведена на рис. 5.3. Рис. 5.3. Зависимости растворимостей примесей в кремнии от температуры
Если NS равна предельной растворимости примеси при выбранной температуре диффузии, то поверхностная концентрация не зависит от времени процесса диффузии, что дает возможность воспроизводимого получения параметров диффузионного слоя. Зависимость предельных растворимостей основных легирующих примесей в кремнии от температуры приведена на рис. 5.3. Рис. 5.3. Зависимости растворимостей примесей в кремнии от температуры
 5.1.2. Диффузия из источников ограниченной мощности Источником примеси в этом случае является высоколегированный поверхностный слой полупроводника, полученный путем диффузии из бесконечной мощности или ионной имплантацией. В идеальном случае поток примеси извне и испарение из пластины отсутствуют и граничные условия можно записать в следующем виде: (5.12) Согласно (5.11) (5.13) и начальные условия для решения уравнения (5.3) могут быть записаны следующим образом: (5.14) Решение уравнения (5.3) с учетом (5.12) и (5.14) выглядит так: . (5.15)
5.1.2. Диффузия из источников ограниченной мощности Источником примеси в этом случае является высоколегированный поверхностный слой полупроводника, полученный путем диффузии из бесконечной мощности или ионной имплантацией. В идеальном случае поток примеси извне и испарение из пластины отсутствуют и граничные условия можно записать в следующем виде: (5.12) Согласно (5.11) (5.13) и начальные условия для решения уравнения (5.3) могут быть записаны следующим образом: (5.14) Решение уравнения (5.3) с учетом (5.12) и (5.14) выглядит так: . (5.15)
 Т.к. время загонки (t1), как правило, значительно меньше времени разгонки (t2), то характеристическая длина загонки мала по сравнению с характеристической длиной разгонки . В этом случае выражение (5.15) существенно упрощается и принимает вид: (5.16) Выражение (6.16) представляет собой распределение Гаусса и показывает зависимость концентрации примеси от координаты и времени. Распределение примеси при диффузии из слоя конечной толщины h при различных значениях Dt на рис. 5.4. Рис. 5.4. Распределение примеси при диффузии из слоя конечной толщины (h) при различных значениях Dt: 1 – Dt = 0; 2 – Dt = 1/16; 3 – Dt = 1/4; 4 – Dt = 1; 5 – Dt = 4; 6 – Dt = При выполнении условия D1t1 << D2t2 форма профиля распределения примеси на стадии загонки не влияет на профиль распределения после разгонки. Однако, если глубина диффузии на стадии разгонки сравнима с глубиной диффузии на стадии загонки, то получается комбинированное распределение между распределением Гаусса и интегралом вероятности.
Т.к. время загонки (t1), как правило, значительно меньше времени разгонки (t2), то характеристическая длина загонки мала по сравнению с характеристической длиной разгонки . В этом случае выражение (5.15) существенно упрощается и принимает вид: (5.16) Выражение (6.16) представляет собой распределение Гаусса и показывает зависимость концентрации примеси от координаты и времени. Распределение примеси при диффузии из слоя конечной толщины h при различных значениях Dt на рис. 5.4. Рис. 5.4. Распределение примеси при диффузии из слоя конечной толщины (h) при различных значениях Dt: 1 – Dt = 0; 2 – Dt = 1/16; 3 – Dt = 1/4; 4 – Dt = 1; 5 – Dt = 4; 6 – Dt = При выполнении условия D1t1 << D2t2 форма профиля распределения примеси на стадии загонки не влияет на профиль распределения после разгонки. Однако, если глубина диффузии на стадии разгонки сравнима с глубиной диффузии на стадии загонки, то получается комбинированное распределение между распределением Гаусса и интегралом вероятности.
 Как правило, этап разгонки проводят в окислительной среде. Окисная пленка SiO2 предохраняет введенную примесь от испарения из кристалла. Однако в реальных условиях допущение, что величина Q остается постоянной, как правило, не выполняется. В процессе термического окисления происходит перераспределение примесей между оксидной пленкой и полупроводником. Последнее определяется величиной коэффициента сегрегации: (5.17) Если m < 1 (для бора m = 0,33), то примесь переходит в растущую пленку и приповерхностный слой обедняется примесью. Если m > 0 (для фосфора m = 10), то растущая пленка диоксида оттесняет примесь, увеличивая ее концентрацию в приповерхностной области кремния. В случае диффузии из легированных диэлектрических пленок (примесных покрытий), когда толщина диэлектрика значительно больше характеристической диффузионной длины примеси в нем, распределение концентрации введенной в полупроводник примеси имеет вид: (5.18) где N0 – исходная концентрация примеси в оксиде; D1, D2 – коэффициенты диффузии примеси в легированном оксиде и полупроводнике соответственно; х0 – толщина барьерного нелегированного слоя диэлектрика; m – коэффициент сегрегации; коэффициент
Как правило, этап разгонки проводят в окислительной среде. Окисная пленка SiO2 предохраняет введенную примесь от испарения из кристалла. Однако в реальных условиях допущение, что величина Q остается постоянной, как правило, не выполняется. В процессе термического окисления происходит перераспределение примесей между оксидной пленкой и полупроводником. Последнее определяется величиной коэффициента сегрегации: (5.17) Если m < 1 (для бора m = 0,33), то примесь переходит в растущую пленку и приповерхностный слой обедняется примесью. Если m > 0 (для фосфора m = 10), то растущая пленка диоксида оттесняет примесь, увеличивая ее концентрацию в приповерхностной области кремния. В случае диффузии из легированных диэлектрических пленок (примесных покрытий), когда толщина диэлектрика значительно больше характеристической диффузионной длины примеси в нем, распределение концентрации введенной в полупроводник примеси имеет вид: (5.18) где N0 – исходная концентрация примеси в оксиде; D1, D2 – коэффициенты диффузии примеси в легированном оксиде и полупроводнике соответственно; х0 – толщина барьерного нелегированного слоя диэлектрика; m – коэффициент сегрегации; коэффициент
 В табл. 5.1 приведены некоторые данные для расчета параметров диффузии легирующих примесей в кремний. Загонка примесей, как правило, производится в окна в слое диоксида кремния. Разгонка под слоем SiО2. При этом возникает проблема диффузии примесей в SiО2. Алюминий, галлий и индий имеют малый атомный радиус и, как следствие, большой коэффициент диффузии в диоксиде. Бор, фосфор, мышьяк и сурьма, напротив, имеют малый коэффициент диффузии, проникают в диоксид на небольшую глубину, что иллюстрируется данными табл. 5.2.
В табл. 5.1 приведены некоторые данные для расчета параметров диффузии легирующих примесей в кремний. Загонка примесей, как правило, производится в окна в слое диоксида кремния. Разгонка под слоем SiО2. При этом возникает проблема диффузии примесей в SiО2. Алюминий, галлий и индий имеют малый атомный радиус и, как следствие, большой коэффициент диффузии в диоксиде. Бор, фосфор, мышьяк и сурьма, напротив, имеют малый коэффициент диффузии, проникают в диоксид на небольшую глубину, что иллюстрируется данными табл. 5.2.
 Таким образом слой окисла толщиной 0,4–0,6 мкм может быть использован в качестве маски при диффузии бора, фосфора, мышьяка и сурьмы, но не выполняет роль последней при диффузии алюминия, галлия и индия. Поэтому эти примеси в технологии интегральных схем не используются. Кроме диффузии легирующих примесей может происходить диффузия неконтролируемых примесей (меди, железа, марганца и др.), которые, как правило, снижают время жизни и формируют компенсированные слои высокого удельного сопротивления. Данные по диффузии этих примесей приведены в табл. 5.3. Из сравнения данных табл. 5.1 и 5.3 нетрудно установить, что коэффициент диффузии неконтролируемых примесей существенно выше, чем легирующих, и они могут значительно ухудшить свойства легированных слоев.
Таким образом слой окисла толщиной 0,4–0,6 мкм может быть использован в качестве маски при диффузии бора, фосфора, мышьяка и сурьмы, но не выполняет роль последней при диффузии алюминия, галлия и индия. Поэтому эти примеси в технологии интегральных схем не используются. Кроме диффузии легирующих примесей может происходить диффузия неконтролируемых примесей (меди, железа, марганца и др.), которые, как правило, снижают время жизни и формируют компенсированные слои высокого удельного сопротивления. Данные по диффузии этих примесей приведены в табл. 5.3. Из сравнения данных табл. 5.1 и 5.3 нетрудно установить, что коэффициент диффузии неконтролируемых примесей существенно выше, чем легирующих, и они могут значительно ухудшить свойства легированных слоев.
 5.2. Методы осуществления диффузии Источником примеси в процессе диффузии являются соединения (диффузанты), содержащие легирующий элемент. В зависимости от их состояния при нормальной температуре различают твердые, жидкие и газообразные диффузанты. В табл. 5.4. приведены характеристики диффузантов.
5.2. Методы осуществления диффузии Источником примеси в процессе диффузии являются соединения (диффузанты), содержащие легирующий элемент. В зависимости от их состояния при нормальной температуре различают твердые, жидкие и газообразные диффузанты. В табл. 5.4. приведены характеристики диффузантов.
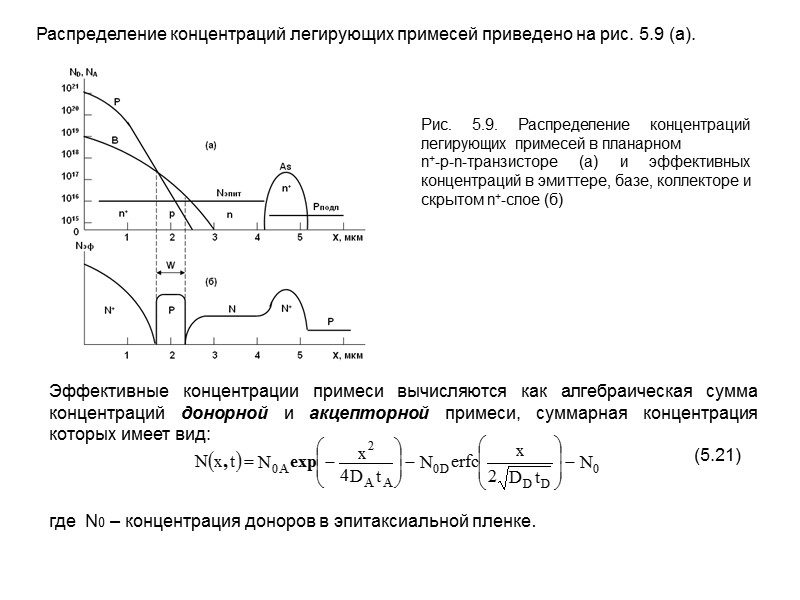 Существуют различные методы и способы проведения диффузионных процессов. Наиболее широкое распространение получили методы закрытой трубы и открытой трубы. По методу закрытой трубы полупроводниковые пластины и твердый источник примеси помещают в кварцевую ампулу, которую либо откачивают до давления 1,3310–2 Па, либо заполняют инертным газом и после этого запаивают. Затем ампулу помещают в печь, нагретую до заданной температуры диффузии (1000–1250С). По методу открытой трубы при диффузии из твердого источника используются двухзонные печи. Источник примеси, помещенный в низкотемпературную зону, испаряясь, захватывается газом-носителем (аргоном, азотом), и пары примеси переносятся в высокотемпературную зону, где находятся пластины. Общим недостатком твердых диффузантов является трудность регулирования давления паров и, как следствие, пониженная воспроизводимость результатов. Кроме того, они требуют высокой температуры источника, что усложняет и удорожает оборудование. Широкое распространение получили жидкие диффузанты, обладающие высокой упругостью пара при низких температурах. Это позволяет вынести источник за пределы диффузионной печи и применять более простые однозонные печи. На рис. 5.5 представлена схема установки для проведения диффузии из жидкого диффузанта. Для переноса паров диффузанта в зону диффузии используют азот, аргон и другие газы, взаимодействующие с кремнием и практически не диффундирующие в него.
Существуют различные методы и способы проведения диффузионных процессов. Наиболее широкое распространение получили методы закрытой трубы и открытой трубы. По методу закрытой трубы полупроводниковые пластины и твердый источник примеси помещают в кварцевую ампулу, которую либо откачивают до давления 1,3310–2 Па, либо заполняют инертным газом и после этого запаивают. Затем ампулу помещают в печь, нагретую до заданной температуры диффузии (1000–1250С). По методу открытой трубы при диффузии из твердого источника используются двухзонные печи. Источник примеси, помещенный в низкотемпературную зону, испаряясь, захватывается газом-носителем (аргоном, азотом), и пары примеси переносятся в высокотемпературную зону, где находятся пластины. Общим недостатком твердых диффузантов является трудность регулирования давления паров и, как следствие, пониженная воспроизводимость результатов. Кроме того, они требуют высокой температуры источника, что усложняет и удорожает оборудование. Широкое распространение получили жидкие диффузанты, обладающие высокой упругостью пара при низких температурах. Это позволяет вынести источник за пределы диффузионной печи и применять более простые однозонные печи. На рис. 5.5 представлена схема установки для проведения диффузии из жидкого диффузанта. Для переноса паров диффузанта в зону диффузии используют азот, аргон и другие газы, взаимодействующие с кремнием и практически не диффундирующие в него.
 Рис. 5.5. Схема установки для проведения диффузии из жидкого источника Для насыщения парами диффузанта транспортирующий газ пропускают либо над поверхностью диффузанта, либо через диффузант, в зависимости от требуемой концентрации. При постоянном расходе газа концентрация диффузанта в нем регулируется температурой источника. В установке предусмотрена подача кислорода в смеси с транспортирующим газом для создания на поверхности защитной пленки при разгонке примеси. Широко используются в практике газообразные диффузанты. Источником диффузанта в этом случае служит баллон со сжатым газом. Регулирование концентрации достигается более простыми средствами и результаты диффузии характеризуются высокой воспроизводимостью. Достаточно перспективным является реализация процесса диффузии с использованием примесных покрытий, предварительно сформированных на поверхности пластины. Это позволяет избежать многих недостатков, присущих методам с использованием внешних источников примеси. В качестве примесных покрытий обычно применяют легированные окислы SiO2, содержащие малые количества В2О3, Р2О5, AsO3 и Sb2О3, которые получают методами газотранспортных реакций, пиролиза металлоорганических соединений, реактивного распыления в окисляющей атмосфере и осаждением из растворов. После нанесения необходимого легированного окисла на поверхность пластины, покрытой нелегированным окислом (барьер), проводят отжиг при температуре (11001)С в атмосфере азота. Профили распределения примесей, введенных из легированных окислов, хорошо аппроксимируются дополнительной функцией ошибок.
Рис. 5.5. Схема установки для проведения диффузии из жидкого источника Для насыщения парами диффузанта транспортирующий газ пропускают либо над поверхностью диффузанта, либо через диффузант, в зависимости от требуемой концентрации. При постоянном расходе газа концентрация диффузанта в нем регулируется температурой источника. В установке предусмотрена подача кислорода в смеси с транспортирующим газом для создания на поверхности защитной пленки при разгонке примеси. Широко используются в практике газообразные диффузанты. Источником диффузанта в этом случае служит баллон со сжатым газом. Регулирование концентрации достигается более простыми средствами и результаты диффузии характеризуются высокой воспроизводимостью. Достаточно перспективным является реализация процесса диффузии с использованием примесных покрытий, предварительно сформированных на поверхности пластины. Это позволяет избежать многих недостатков, присущих методам с использованием внешних источников примеси. В качестве примесных покрытий обычно применяют легированные окислы SiO2, содержащие малые количества В2О3, Р2О5, AsO3 и Sb2О3, которые получают методами газотранспортных реакций, пиролиза металлоорганических соединений, реактивного распыления в окисляющей атмосфере и осаждением из растворов. После нанесения необходимого легированного окисла на поверхность пластины, покрытой нелегированным окислом (барьер), проводят отжиг при температуре (11001)С в атмосфере азота. Профили распределения примесей, введенных из легированных окислов, хорошо аппроксимируются дополнительной функцией ошибок.
 5.3. Методы расчета режимов диффузии при создании диодных структур При создании диодных структур концентрация диффундирующей примеси должна превосходить концентрацию легирующей примеси в исходном кристалле. Поэтому при диффузии образуется слой инверсной проводимости глубиной xj. В точке равенства концентраций донорной и акцепторной примеси образуется p-n-переход. Реальный процесс диффузии, как правило, осуществляется в два этапа. Первый этап (загонка) осуществляется диффузией из источника бесконечной мощности, когда на поверхности пластины поддерживается постоянная концентрация диффундирующей примеси NS. Второй этап (разгонка) осуществляется из источника ограниченной мощности. При расчете режимов диффузии, как правило, задаются: – концентрация примеси на поверхности (NS) – концентрация примеси в исходной пластине (N0) – коэффициент диффузии примеси (D) – толщина легированной области, т.е. глубина залегания p-n-перехода (xj) – режим диффузии, т.е. загонка и разгонка. Ниже приведены примеры расчетов глубины диффузии и количества введенной примеси при загонке и разгонке. При расчете использованы графики зависимости от при загонке и разгонке примеси (рис. 5.6).
5.3. Методы расчета режимов диффузии при создании диодных структур При создании диодных структур концентрация диффундирующей примеси должна превосходить концентрацию легирующей примеси в исходном кристалле. Поэтому при диффузии образуется слой инверсной проводимости глубиной xj. В точке равенства концентраций донорной и акцепторной примеси образуется p-n-переход. Реальный процесс диффузии, как правило, осуществляется в два этапа. Первый этап (загонка) осуществляется диффузией из источника бесконечной мощности, когда на поверхности пластины поддерживается постоянная концентрация диффундирующей примеси NS. Второй этап (разгонка) осуществляется из источника ограниченной мощности. При расчете режимов диффузии, как правило, задаются: – концентрация примеси на поверхности (NS) – концентрация примеси в исходной пластине (N0) – коэффициент диффузии примеси (D) – толщина легированной области, т.е. глубина залегания p-n-перехода (xj) – режим диффузии, т.е. загонка и разгонка. Ниже приведены примеры расчетов глубины диффузии и количества введенной примеси при загонке и разгонке. При расчете использованы графики зависимости от при загонке и разгонке примеси (рис. 5.6).
 Рис. 5.6. Распределение примеси в кремниевой пластине при диффузии из бесконечного источника (1) и источника ограниченной мощности (2) Пример 1. Предположим, что нам необходимо сформировать p-n-переход на глубине 1 мкм путем диффузии бора при температуре 1200С в пластинку кремния n-типа с концентрацией доноров N0 = 1016 см–3. Оценить время диффузии и количество введенной примеси. Решение. При температуре 1200С коэффициент диффузии бора равняется 210–12 см–3, а поверхностная концентрация 51020 см–3 (табл. 5.1). P-n-переход будет сформирован при . Подставляя в (6) NS и N0, получаем: . Из графика рис. 5.6 имеем у = 2,75. Время диффузии мин. .
Рис. 5.6. Распределение примеси в кремниевой пластине при диффузии из бесконечного источника (1) и источника ограниченной мощности (2) Пример 1. Предположим, что нам необходимо сформировать p-n-переход на глубине 1 мкм путем диффузии бора при температуре 1200С в пластинку кремния n-типа с концентрацией доноров N0 = 1016 см–3. Оценить время диффузии и количество введенной примеси. Решение. При температуре 1200С коэффициент диффузии бора равняется 210–12 см–3, а поверхностная концентрация 51020 см–3 (табл. 5.1). P-n-переход будет сформирован при . Подставляя в (6) NS и N0, получаем: . Из графика рис. 5.6 имеем у = 2,75. Время диффузии мин. .
 Пример 2. В приповерхностный слой путем загонки или ионной имплантации примеси введено 21016 см–2 бора. Исходная концентрация доноров в подложке n-типа 1017 см–3. Определить глубину перехода, полученного после диффузии в течение двух часов при температуре 1200С. Решение. Перепишем уравнение (5.16) в следующем виде: Подставляя параметры, получаем ; из графика рис. 5.6 имеем Подставляя значения D и t, получаем xj = 7,0 мкм. В общем случае глубину p-n-перехода при разгонке примеси можно определить из выражения (5.16): (5.19) При заданной величине xj, используя выражение (5.19) можно оценить время разгонки. Однако найти решение (5.19) относительно t не легко. Подставляя типичные значения параметров: NS = 1020 см–3; h = 10–14 см; N0 = 1017 cм–3; D = 210–12 см2/с; t = 5 ч. = 2104 с получаем следующее приближенное выражение: (5.20) Если, например, задано значение xj = 5 мкм, то время диффузии составляет около 3,4103 с.
Пример 2. В приповерхностный слой путем загонки или ионной имплантации примеси введено 21016 см–2 бора. Исходная концентрация доноров в подложке n-типа 1017 см–3. Определить глубину перехода, полученного после диффузии в течение двух часов при температуре 1200С. Решение. Перепишем уравнение (5.16) в следующем виде: Подставляя параметры, получаем ; из графика рис. 5.6 имеем Подставляя значения D и t, получаем xj = 7,0 мкм. В общем случае глубину p-n-перехода при разгонке примеси можно определить из выражения (5.16): (5.19) При заданной величине xj, используя выражение (5.19) можно оценить время разгонки. Однако найти решение (5.19) относительно t не легко. Подставляя типичные значения параметров: NS = 1020 см–3; h = 10–14 см; N0 = 1017 cм–3; D = 210–12 см2/с; t = 5 ч. = 2104 с получаем следующее приближенное выражение: (5.20) Если, например, задано значение xj = 5 мкм, то время диффузии составляет около 3,4103 с.
 Для точного расчета времени разгонки зададим 4–5 значений времени разгонки, бóльших и мéньших величины, определенной по приближенной формуле (5.20), и рассчитаем значения по формуле (5.19). Они представлены на графике рис. 5.7. Зависимость близка к линейной и точное время разгонки, определенное по данному графику, составляет 2,9103 с, что на 14% меньше приближенного значения. Рис. 5.7. Зависимость от времени разгонки, рассчитанная по точной формуле (5.19)
Для точного расчета времени разгонки зададим 4–5 значений времени разгонки, бóльших и мéньших величины, определенной по приближенной формуле (5.20), и рассчитаем значения по формуле (5.19). Они представлены на графике рис. 5.7. Зависимость близка к линейной и точное время разгонки, определенное по данному графику, составляет 2,9103 с, что на 14% меньше приближенного значения. Рис. 5.7. Зависимость от времени разгонки, рассчитанная по точной формуле (5.19)
 5.4. Методы расчета диффузии при создании биполярных транзисторных структур Транзисторные структуры могут изготавливаться либо одновременной диффузией донорной и акцепторной примеси, если их поверхностные концентрации и коэффициенты диффузии существенно различаются, или последовательной диффузией этих примесей. На рис. 5.8 показана транзисторная структура, полученная диффузией мышьяка в подложку кремния р-типа для создания скрытого n+-слоя, эпитаксиальным наращиванием пленки n-типа на подложку для создания комплексного слоя, диффузией бора в эпитаксиальную пленку для формирования базы транзистора и разделительного слоя, диффузией фосфора или мышьяка для получения эмиттера и контактной площадки коллектора. Рис. 5. 8. Поперечный разрез планарного n-p-n-транзистора – основного элемента биполярных интегральных схем. 1 – исходная пластинка кремния; 2 – скрытый слой; 3 – эпитаксиальный слой; 4 – базовая область; 5 – контактная область; 6 – разделительный слой; 7 – диэлектрическая пленка; 8 – контакты к эмиттеру, базе, коллектору и разделительному слою
5.4. Методы расчета диффузии при создании биполярных транзисторных структур Транзисторные структуры могут изготавливаться либо одновременной диффузией донорной и акцепторной примеси, если их поверхностные концентрации и коэффициенты диффузии существенно различаются, или последовательной диффузией этих примесей. На рис. 5.8 показана транзисторная структура, полученная диффузией мышьяка в подложку кремния р-типа для создания скрытого n+-слоя, эпитаксиальным наращиванием пленки n-типа на подложку для создания комплексного слоя, диффузией бора в эпитаксиальную пленку для формирования базы транзистора и разделительного слоя, диффузией фосфора или мышьяка для получения эмиттера и контактной площадки коллектора. Рис. 5. 8. Поперечный разрез планарного n-p-n-транзистора – основного элемента биполярных интегральных схем. 1 – исходная пластинка кремния; 2 – скрытый слой; 3 – эпитаксиальный слой; 4 – базовая область; 5 – контактная область; 6 – разделительный слой; 7 – диэлектрическая пленка; 8 – контакты к эмиттеру, базе, коллектору и разделительному слою
 Распределение концентраций легирующих примесей приведено на рис. 5.9 (а). Рис. 5.9. Распределение концентраций легирующих примесей в планарном n+-p-n-транзисторе (а) и эффективных концентраций в эмиттере, базе, коллекторе и скрытом n+-слое (б) Эффективные концентрации примеси вычисляются как алгебраическая сумма концентраций донорной и акцепторной примеси, суммарная концентрация которых имеет вид: (5.21) где N0 – концентрация доноров в эпитаксиальной пленке.
Распределение концентраций легирующих примесей приведено на рис. 5.9 (а). Рис. 5.9. Распределение концентраций легирующих примесей в планарном n+-p-n-транзисторе (а) и эффективных концентраций в эмиттере, базе, коллекторе и скрытом n+-слое (б) Эффективные концентрации примеси вычисляются как алгебраическая сумма концентраций донорной и акцепторной примеси, суммарная концентрация которых имеет вид: (5.21) где N0 – концентрация доноров в эпитаксиальной пленке.
 Проанализируем наиболее ответственные операции создания активной области транзистора – эмиттерного, базового и коллекторного слоев. Коллектор создается путем эпитаксиального наращивания слоя n-типа на подложке р-типа, в которой предварительно путем диффузии мышьяка или сурьмы создается сильно легированный скрытый слой. Первая диффузия для создания активной области проводится при относительно низкой поверхностной концентрации на большую глубину. При этом создается базовая область и коллекторный p-n-переход. Эту диффузию называют базовой. Вторую диффузию с более высокой поверхностной концентрацией и малой глубиной называют эмиттерной. Базовую диффузию осуществляют в два этапа (загонка и разгонка) и поэтому окончательное распределение акцепторов описывается функцией Гаусса. Эмиттерную диффузию, как правило, осуществляют в одну стадию (загонка примеси) и распределение доноров описывается erfc-функцией. При проведении эмиттерной диффузии для расчета распределения концентрации примеси и определении глубины эмиттерного p-n-перехода можно воспользоваться выражением (5.21). Т.к. концентрация диффузантов намного превышает концентрацию доноров в эпитаксиальной пленке, то величиной N0 в правой части выражения (5.21) можно пренебречь, а эмиттерный p-n-переход образуется в точке, где алгебраическая сумма концентраций доноров и акцепторов равняется нулю.
Проанализируем наиболее ответственные операции создания активной области транзистора – эмиттерного, базового и коллекторного слоев. Коллектор создается путем эпитаксиального наращивания слоя n-типа на подложке р-типа, в которой предварительно путем диффузии мышьяка или сурьмы создается сильно легированный скрытый слой. Первая диффузия для создания активной области проводится при относительно низкой поверхностной концентрации на большую глубину. При этом создается базовая область и коллекторный p-n-переход. Эту диффузию называют базовой. Вторую диффузию с более высокой поверхностной концентрацией и малой глубиной называют эмиттерной. Базовую диффузию осуществляют в два этапа (загонка и разгонка) и поэтому окончательное распределение акцепторов описывается функцией Гаусса. Эмиттерную диффузию, как правило, осуществляют в одну стадию (загонка примеси) и распределение доноров описывается erfc-функцией. При проведении эмиттерной диффузии для расчета распределения концентрации примеси и определении глубины эмиттерного p-n-перехода можно воспользоваться выражением (5.21). Т.к. концентрация диффузантов намного превышает концентрацию доноров в эпитаксиальной пленке, то величиной N0 в правой части выражения (5.21) можно пренебречь, а эмиттерный p-n-переход образуется в точке, где алгебраическая сумма концентраций доноров и акцепторов равняется нулю.
 С учетом вышеизложенного выражение (5.21) можно переписать следующим образом: (5.22) Воспользовавшись аппроксимацией erfc-функции (выражение (5.9)) перепишем (5.23) следующим образом: (5.23) Воспользовавшись (5.23), глубину залегания эмиттерного перехода можно записать в следующем виде: (5.24) Решим это уравнение методом итерации, принимая за начальное значение . (5.25) Т.к. первое слагаемое в круглых скобках выражения (5.24) существенно превышает второе, то . (5.26)
С учетом вышеизложенного выражение (5.21) можно переписать следующим образом: (5.22) Воспользовавшись аппроксимацией erfc-функции (выражение (5.9)) перепишем (5.23) следующим образом: (5.23) Воспользовавшись (5.23), глубину залегания эмиттерного перехода можно записать в следующем виде: (5.24) Решим это уравнение методом итерации, принимая за начальное значение . (5.25) Т.к. первое слагаемое в круглых скобках выражения (5.24) существенно превышает второе, то . (5.26)
 Уточненное значение глубины залегания эмиттерного p-n-перехода (5.27) Глубина залегания коллекторного p-n-перехода определяется следующим соотношением: (5.28) где DA и tA – коэффициент диффузии и время разгонки акцепторов (бора), а D*А и tD – коэффициент диффузии и время дополнительной разгонки бора при эмиттерной диффузии. Толщина базовой области равняется . (5.29) Воспользовавшись приведенными соотношениями можно построить распределения доноров и акцепторов в активной области и оценить параметры легированных слоев. Оценим размеры легированных слоев, полагая, что концентрация доноров в эпитаксиальном слое N0 = 51016 см–3, температуры диффузии бора и фосфора составляют 1200 и 1100С, время разгонки бора составляет 1 ч., а загонки фосфора 2 ч. Поверхностная концентрация атомов бора после разгонки составляет 51014 см–2, а фосфора соответствует пределу растворимости (NSD =1,21021 см–3). Подставляя в (5.25) – (5.29) параметры, получаем:
Уточненное значение глубины залегания эмиттерного p-n-перехода (5.27) Глубина залегания коллекторного p-n-перехода определяется следующим соотношением: (5.28) где DA и tA – коэффициент диффузии и время разгонки акцепторов (бора), а D*А и tD – коэффициент диффузии и время дополнительной разгонки бора при эмиттерной диффузии. Толщина базовой области равняется . (5.29) Воспользовавшись приведенными соотношениями можно построить распределения доноров и акцепторов в активной области и оценить параметры легированных слоев. Оценим размеры легированных слоев, полагая, что концентрация доноров в эпитаксиальном слое N0 = 51016 см–3, температуры диффузии бора и фосфора составляют 1200 и 1100С, время разгонки бора составляет 1 ч., а загонки фосфора 2 ч. Поверхностная концентрация атомов бора после разгонки составляет 51014 см–2, а фосфора соответствует пределу растворимости (NSD =1,21021 см–3). Подставляя в (5.25) – (5.29) параметры, получаем: