Полупроводниковые диоды МОСКВА
























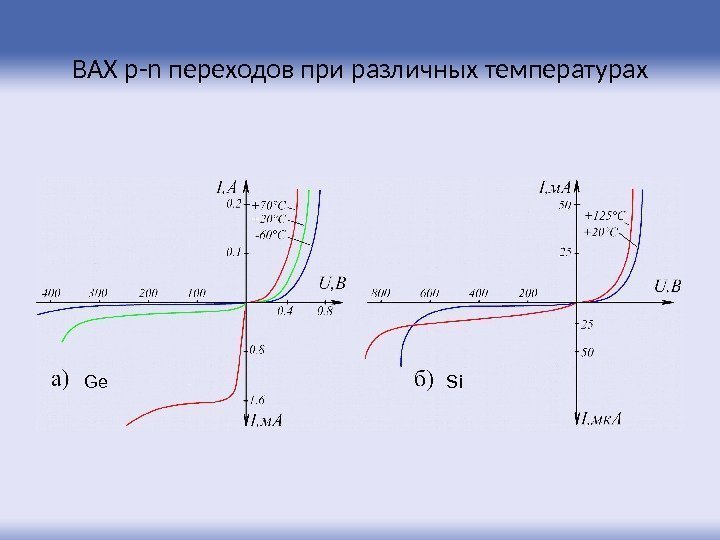













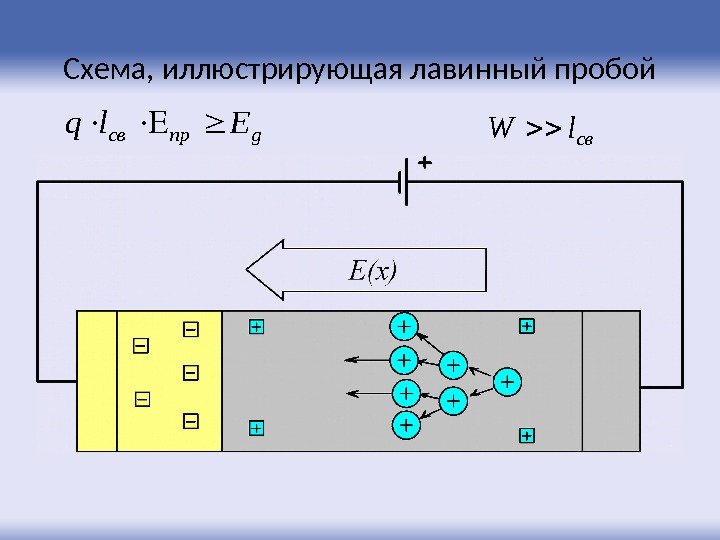
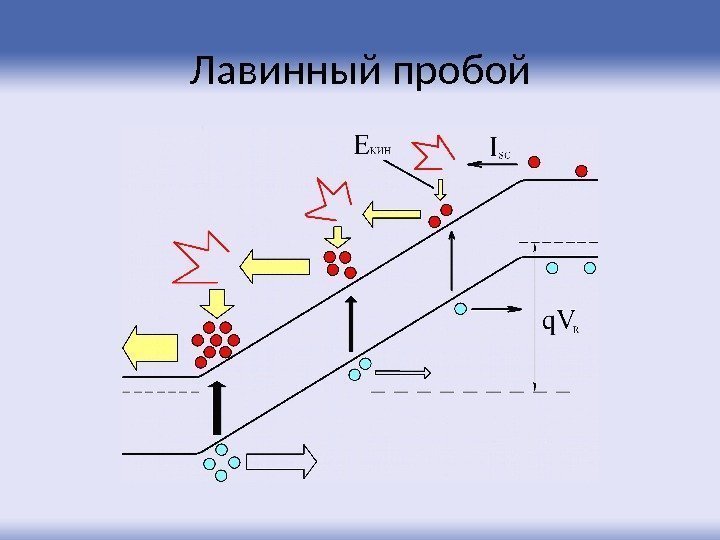





















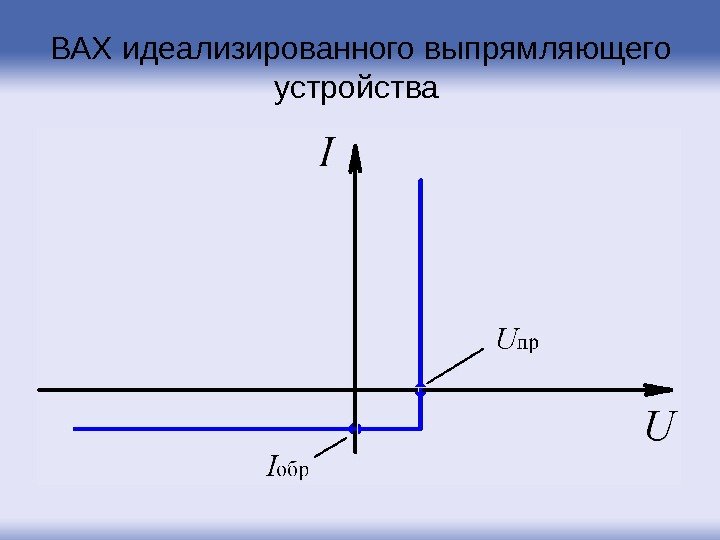












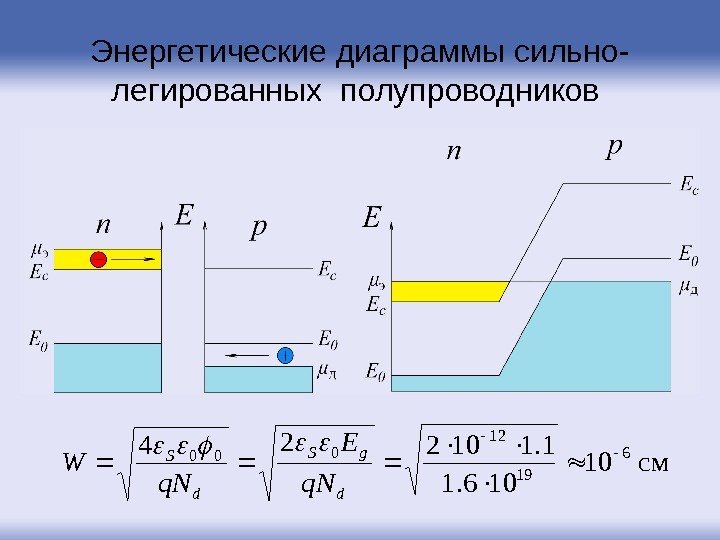

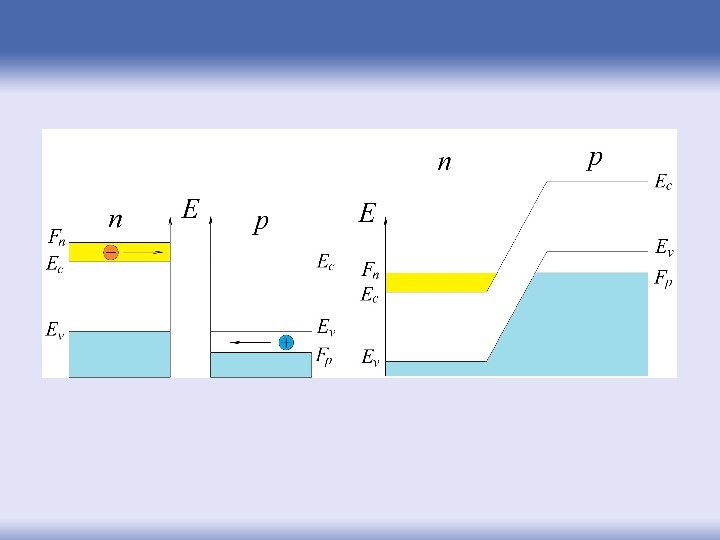









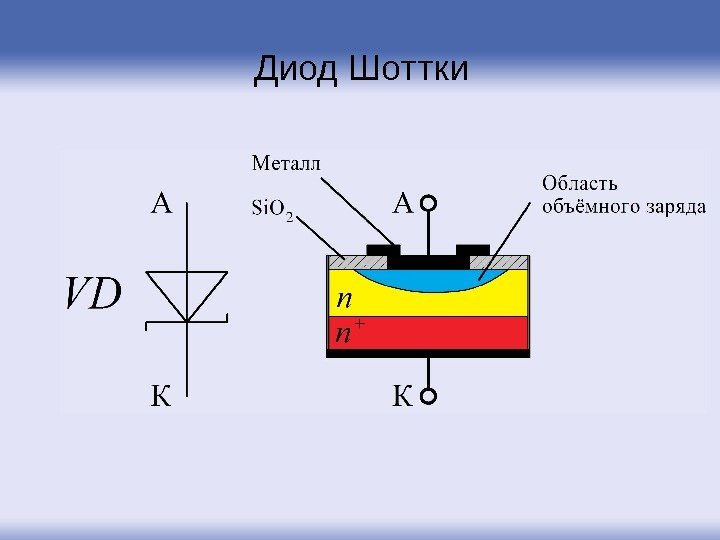

7_poluprovodnikovye_diody.ppt
- Размер: 3.4 Мб
- Автор:
- Количество слайдов: 87
Описание презентации Полупроводниковые диоды МОСКВА по слайдам
 Полупроводниковые диоды МОСКВА 2016 НИУ «МЭИ» Презентации к лекционному курсу. Твердотельная электроника. Электронный учебно-методический комплекс
Полупроводниковые диоды МОСКВА 2016 НИУ «МЭИ» Презентации к лекционному курсу. Твердотельная электроника. Электронный учебно-методический комплекс
 Уравнения непрерывности
Уравнения непрерывности
 ПРИНЯТЫЕ ДОПУЩЕНИЯ ПРИ РАСЧЁТЕ ВАХ • Модель электронно-дырочного перехода одномерная; p — и n -области имеют бесконечную протяженность. • Переход тонкий, носители заряда пролетают через ОПЗ без рекомбинации (ОПЗ стянут в линию). • Обе квазинейтральные области сильно легированы, падением напряжения на них можно пренебречь. Вся внешняя разность потенциалов приложена к pn -переходу. • Рекомбинацию считаем линейной. • Уровень инжекции мал (Δ n p << p p 0 , Δ p n << n n 0 ).
ПРИНЯТЫЕ ДОПУЩЕНИЯ ПРИ РАСЧЁТЕ ВАХ • Модель электронно-дырочного перехода одномерная; p — и n -области имеют бесконечную протяженность. • Переход тонкий, носители заряда пролетают через ОПЗ без рекомбинации (ОПЗ стянут в линию). • Обе квазинейтральные области сильно легированы, падением напряжения на них можно пренебречь. Вся внешняя разность потенциалов приложена к pn -переходу. • Рекомбинацию считаем линейной. • Уровень инжекции мал (Δ n p << p p 0 , Δ p n << n n 0 ).
 Но в квазинейтральной области напряженность внешнего электрического поля равна нулю! Таким образом, плотность тока в n -области определяется диффузионным током дырок, зависящим от их градиента концентрации: 0 2 2 0 x p D pp t pn p p nnn ppp. DL 022 2 p nn L p dx pd Общее решение такого уравнения имеет вид: ppn. Lx. BLx. Apexpexp
Но в квазинейтральной области напряженность внешнего электрического поля равна нулю! Таким образом, плотность тока в n -области определяется диффузионным током дырок, зависящим от их градиента концентрации: 0 2 2 0 x p D pp t pn p p nnn ppp. DL 022 2 p nn L p dx pd Общее решение такого уравнения имеет вид: ppn. Lx. BLx. Apexpexp
 pnnnn. Lx. Appppexp 00 Концентрация неравновесных дырок на границе ОПЗ при x = W n равна: T см nonn V p. Wp exp При x = W n : . exp 1 exp p n T см no L WV p.
pnnnn. Lx. Appppexp 00 Концентрация неравновесных дырок на границе ОПЗ при x = W n равна: T см nonn V p. Wp exp При x = W n : . exp 1 exp p n T см no L WV p.
 Окончательно закон изменения концентрации неравновесных дырок в n -области при x > W n принимает вид: p n nnnnnn L Wx pppppxpexp 0000 p n Tсм n L Wx. V pexp 11 exp 0 p n Tсм nn L Wx. V pp exp 1 exp
Окончательно закон изменения концентрации неравновесных дырок в n -области при x > W n принимает вид: p n nnnnnn L Wx pppppxpexp 0000 p n Tсм n L Wx. V pexp 11 exp 0 p n Tсм nn L Wx. V pp exp 1 exp
 dxdp Dqjj p дифpp p n T см p npn p L Wx. V L p. Dq jexp 1 exp 0 На границе ОПЗ при x = W n , получим: . 1 exp| 0 Tсм p np Wxn p V L p. Dq j n
dxdp Dqjj p дифpp p n T см p npn p L Wx. V L p. Dq jexp 1 exp 0 На границе ОПЗ при x = W n , получим: . 1 exp| 0 Tсм p np Wxn p V L p. Dq j n
 Аналогично для p -области при x < — W p : n p T см ppp L Wx. V nnxnexp 1 exp 00 n p T см n pnp n L Wx V L n. Dq j exp 1 exp 0 n p Tсм p L Wx V n exp 11 exp
Аналогично для p -области при x < — W p : n p T см ppp L Wx. V nnxnexp 1 exp 00 n p T см n pnp n L Wx V L n. Dq j exp 1 exp 0 n p Tсм p L Wx V n exp 11 exp
 Решение уравнения для ВАХ
Решение уравнения для ВАХ
 ВАХ тонкого pn -перехода описывается уравнением: . 1 exp 00 T см s T см p np n pn. V J V L p. D L n. D qj dp p an n i p np n pn spsns NL D nq L p. Dq L n. Dq jjj 2 известным как формула Шокли. где p pn n np Lp. Ln q
ВАХ тонкого pn -перехода описывается уравнением: . 1 exp 00 T см s T см p np n pn. V J V L p. D L n. D qj dp p an n i p np n pn spsns NL D nq L p. Dq L n. Dq jjj 2 известным как формула Шокли. где p pn n np Lp. Ln q
 Распределение носителей в p-n переходе
Распределение носителей в p-n переходе
 pp np n p L x L p. Dq jexp 0 nn pnp n L x L n. Dq jexp 0. p np n pn spsns L p. Dq L n. Dq jjj
pp np n p L x L p. Dq jexp 0 nn pnp n L x L n. Dq jexp 0. p np n pn spsns L p. Dq L n. Dq jjj
 18 10 apo. Np 15 10 dno. Nn 5 10 nop 2 10 pon. Расчет для кремниевого p-n — перехода c м -3 При прямом смещении: B 6. 0 см. V Пусть , тогда 15 10 exp Т см nonn V p. Wp non c м -3 и равна 10 10 26 600 expexp Т см. V 1210 exp Тсм popp V n. Wn c м -3 Пусть c м -3 , Тогда c м -3 ,
18 10 apo. Np 15 10 dno. Nn 5 10 nop 2 10 pon. Расчет для кремниевого p-n — перехода c м -3 При прямом смещении: B 6. 0 см. V Пусть , тогда 15 10 exp Т см nonn V p. Wp non c м -3 и равна 10 10 26 600 expexp Т см. V 1210 exp Тсм popp V n. Wn c м -3 Пусть c м -3 , Тогда c м -3 ,
 05. 03 -exp м. B 783 Tсм. V pponnnnopp. Уже при т. е. граничные концентрации составляют 5% от исходных. и p. T см nn L x. V pxp exp 1 exp 0 n. Т см pp L x. V nxnexp 1 exp 0 При обратном смещении:
05. 03 -exp м. B 783 Tсм. V pponnnnopp. Уже при т. е. граничные концентрации составляют 5% от исходных. и p. T см nn L x. V pxp exp 1 exp 0 n. Т см pp L x. V nxnexp 1 exp 0 При обратном смещении:
 p np p. S L p. Dq j 0 n pn n. S L n. Dq j 0 5. 2 p. D 25 n. D 4 1014 p. L 4 1020 n. L 10 103. 0 p. Sj 13 102 n. Sjсм 2 /с см А/см 2 3. 010103. 0 exp 1010 T см p. Sp V jj 31013 10210103. 2 exp T см n. Sn V jj см 2 /с см А/см
p np p. S L p. Dq j 0 n pn n. S L n. Dq j 0 5. 2 p. D 25 n. D 4 1014 p. L 4 1020 n. L 10 103. 0 p. Sj 13 102 n. Sjсм 2 /с см А/см 2 3. 010103. 0 exp 1010 T см p. Sp V jj 31013 10210103. 2 exp T см n. Sn V jj см 2 /с см А/см
 ВАХ p-n -перехода
ВАХ p-n -перехода
 nl 121519 108, 430010106, 1 см. Оценим, насколько справедливо в нашем примере предположение, что напряжение смещения приложено только к pn -переходу. Для полученного полного тока определим падение напряжения на толще n — и p -областей, приняв длину n -области =0, 01 см, длину p -области за 1 мкм=10 -4 см. Проводимости σ n = q ∙ μ n ∙ n , σ p = q ∙ μ p ∙ p. Подвижности μ n и μ p зависят от концентраций примеси в полупроводниках, исходя из данных, приведенных в литературе : μ n = 300 см 2 /В∙с, μ p = 100 см 2 /В∙с. σ n = q ∙ μ n ∙ n = σ p = q ∙ μ p ∙ p = 11819 1610010106, 1 см. Ом Падение напряжения на n — и p -слоях Вl j Vn n n 0625, 0 8, 4 01, 0103, 02 Вl j Vp p p 0002, 0 16 10103,
nl 121519 108, 430010106, 1 см. Оценим, насколько справедливо в нашем примере предположение, что напряжение смещения приложено только к pn -переходу. Для полученного полного тока определим падение напряжения на толще n — и p -областей, приняв длину n -области =0, 01 см, длину p -области за 1 мкм=10 -4 см. Проводимости σ n = q ∙ μ n ∙ n , σ p = q ∙ μ p ∙ p. Подвижности μ n и μ p зависят от концентраций примеси в полупроводниках, исходя из данных, приведенных в литературе : μ n = 300 см 2 /В∙с, μ p = 100 см 2 /В∙с. σ n = q ∙ μ n ∙ n = σ p = q ∙ μ p ∙ p = 11819 1610010106, 1 см. Ом Падение напряжения на n — и p -слоях Вl j Vn n n 0625, 0 8, 4 01, 0103, 02 Вl j Vp p p 0002, 0 16 10103,
 Прямое смещение p-n -перехода
Прямое смещение p-n -перехода
 Обратное смещение p-n -перехода
Обратное смещение p-n -перехода
 Энергетические диаграммы при прямом и обратном смещении p-n- перехода
Энергетические диаграммы при прямом и обратном смещении p-n- перехода
 Влияние различных факторов на ВАХ pn -перехода k. T ТE ТNТNn g vci 2 exp. 2 dp p an n i p np n pn spsns NL D nq L p. Dq L n. Dq jjj 2 ln i n NNad Тk
Влияние различных факторов на ВАХ pn -перехода k. T ТE ТNТNn g vci 2 exp. 2 dp p an n i p np n pn spsns NL D nq L p. Dq L n. Dq jjj 2 ln i n NNad Тk
 Качественное сравнение ВАХ германиевого и кремниевого диода (масштабы прямого и обратного токов различны) dp p an n is NL D nqj 2 2 ln i ad k n NN k. Tq
Качественное сравнение ВАХ германиевого и кремниевого диода (масштабы прямого и обратного токов различны) dp p an n is NL D nqj 2 2 ln i ad k n NN k. Tq
 При повышении температуры изменяются практически все электрофизические свойства полупроводников, поэтому изменяются и параметры полупроводниковых приборов, в частности, значение контактной разности потенциалов уменьшается, а ток насыщения растет.
При повышении температуры изменяются практически все электрофизические свойства полупроводников, поэтому изменяются и параметры полупроводниковых приборов, в частности, значение контактной разности потенциалов уменьшается, а ток насыщения растет.
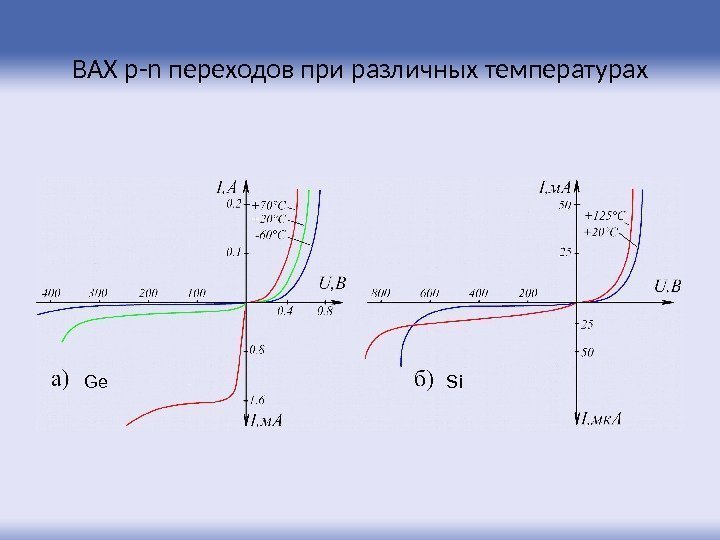 ВАХ p-n переходов при различных температурах Ge Si
ВАХ p-n переходов при различных температурах Ge Si
 Снижение влияния температуры добиваются путем введения специальных конструктивных элементов корпусов – радиаторов
Снижение влияния температуры добиваются путем введения специальных конструктивных элементов корпусов – радиаторов


 Влияние генерации-рекомбинации на ВАХ
Влияние генерации-рекомбинации на ВАХ
 it n p pneff. EEесли, ln – прямое смещение pn -перехода: pnпр – обратное смещение pn -перехода: pnобр
it n p pneff. EEесли, ln – прямое смещение pn -перехода: pnпр – обратное смещение pn -перехода: pnобр
 Емкостные свойства pn -перехода
Емкостные свойства pn -перехода
 ad ad k s NN NN q W 0 0 2 К расчету емкости p-n -перехода aad d смks p dad a смks n NNN N V q. W 00 2 ; 2 При нулевом смещении на рп-переходе: При обратном смещении: ad ad смk s обр NN NN V q W 02 aad d ks p dad a ks n. NNN N q W 002 ;
ad ad k s NN NN q W 0 0 2 К расчету емкости p-n -перехода aad d смks p dad a смks n NNN N V q. W 00 2 ; 2 При нулевом смещении на рп-переходе: При обратном смещении: ad ad смk s обр NN NN V q W 02 aad d ks p dad a ks n. NNN N q W 002 ;
 Из формулы для плоского конденсатора: ad ad смk ss бар NN NN V q S W S C 2 00 При Na>>Nd : d смk s бар. N V q S
Из формулы для плоского конденсатора: ad ad смk ss бар NN NN V q S W S C 2 00 При Na>>Nd : d смk s бар. N V q S
 Барьерная емкость диодаad ad смk s см s бар NN NN V q S VW S С 2 00 Для ступенчатого pn -перехода с площадью S :
Барьерная емкость диодаad ad смk s см s бар NN NN V q S VW S С 2 00 Для ступенчатого pn -перехода с площадью S :
 Емкость pn -перехода может изменяться в значительных пределах, что позволило использовать это свойство в варикапах. Варикап – нелинейный управляемый конденсатор, емкость которого изменяется в зависимости от обратного напряжения. В варикапах используется барьерная емкость, не зависящая от частоты вплоть до миллиметрового диапазона, имеющая малый температурный коэффициент емкости. Варикап обладает высокой стабильностью параметров во времени. В радиоэлектронных устройствах варикапы применяют в усилителях, умножителях частоты, смесителях, детекторах и в схемах с электронной настройкой.
Емкость pn -перехода может изменяться в значительных пределах, что позволило использовать это свойство в варикапах. Варикап – нелинейный управляемый конденсатор, емкость которого изменяется в зависимости от обратного напряжения. В варикапах используется барьерная емкость, не зависящая от частоты вплоть до миллиметрового диапазона, имеющая малый температурный коэффициент емкости. Варикап обладает высокой стабильностью параметров во времени. В радиоэлектронных устройствах варикапы применяют в усилителях, умножителях частоты, смесителях, детекторах и в схемах с электронной настройкой.
 Диффузионная емкость pn -перехода d. V d. Q Cдиф где Q – инжектированный заряд. T nnpp диф jj S II C )( Полная емкость pn -перехода равна сумме барьерной и диффузионной емкостей. При прямых напряжениях барьерная емкость много меньше диффузионной, а при обратных напряжениях она значительно превышает ее. Соотношения между барьерной и диффузионной емкостью определяют частотные зависимости pn -перехода.
Диффузионная емкость pn -перехода d. V d. Q Cдиф где Q – инжектированный заряд. T nnpp диф jj S II C )( Полная емкость pn -перехода равна сумме барьерной и диффузионной емкостей. При прямых напряжениях барьерная емкость много меньше диффузионной, а при обратных напряжениях она значительно превышает ее. Соотношения между барьерной и диффузионной емкостью определяют частотные зависимости pn -перехода.
 Пробой p — n — перехода
Пробой p — n — перехода
 Обратная ВАХ при различных видах пробоя
Обратная ВАХ при различных видах пробоя
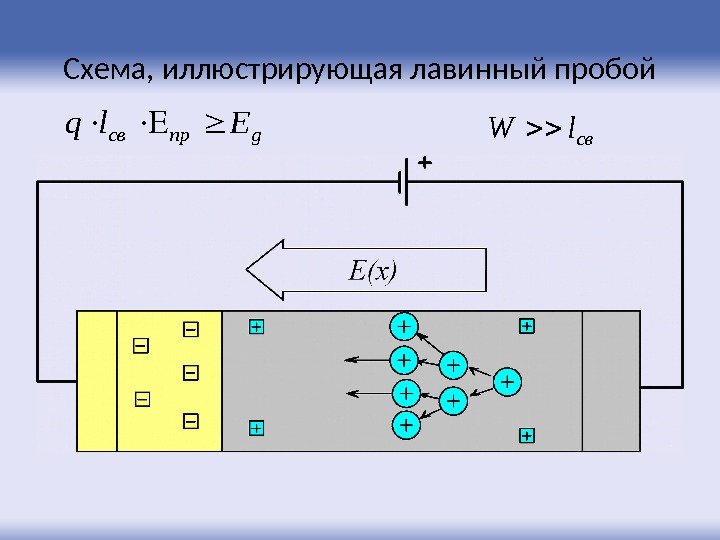 Схема, иллюстрирующая лавинный пробойgпрсв. Еlq свl. W
Схема, иллюстрирующая лавинный пробойgпрсв. Еlq свl. W
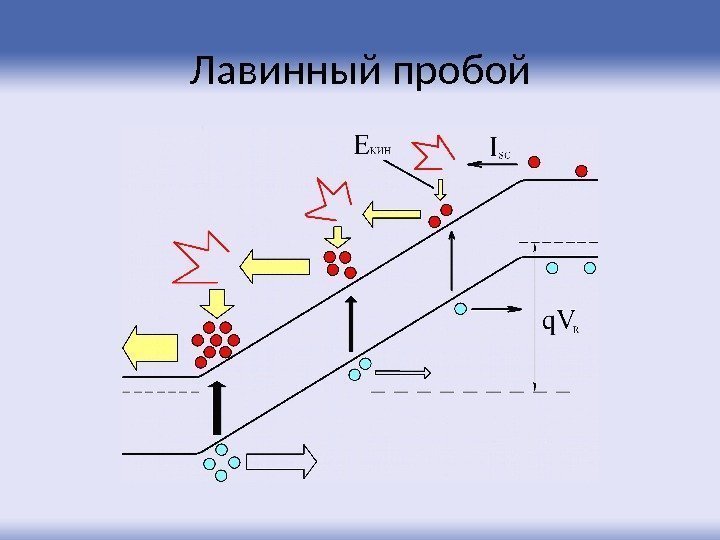 Лавинный пробой
Лавинный пробой
 1 0 1 n проб см V V J J MКоэффициент лавинного умножения M , определяемый как количество актов лавинного умножения в области сильного электрического поля , для которого справедливо следующее эмпирическое соотношение Миллера :
1 0 1 n проб см V V J J MКоэффициент лавинного умножения M , определяемый как количество актов лавинного умножения в области сильного электрического поля , для которого справедливо следующее эмпирическое соотношение Миллера :
 Напряжение лавинного пробоя зависит от степени легирования p — и n -областей. Так, например для резкого кремниевого p — n -перехода зависимость напряжения пробоя от степени легирования n -области имеет вид: 43 16 23 101. 1 60 NE V g проб Напряжение лавинного пробоя кремниевого pn -перехода с линейным распределением примеси (то есть при изменении примеси по линейному закону) определяется формулой: , 1031. 1 60 4, 0 20 2, 1 a. E V g проб где а – градиент концентрации примеси
Напряжение лавинного пробоя зависит от степени легирования p — и n -областей. Так, например для резкого кремниевого p — n -перехода зависимость напряжения пробоя от степени легирования n -области имеет вид: 43 16 23 101. 1 60 NE V g проб Напряжение лавинного пробоя кремниевого pn -перехода с линейным распределением примеси (то есть при изменении примеси по линейному закону) определяется формулой: , 1031. 1 60 4, 0 20 2, 1 a. E V g проб где а – градиент концентрации примеси
 Зависимость напряжения лавинного пробоя от концентрации примеси в низколегированной области для резкого pn -перехода
Зависимость напряжения лавинного пробоя от концентрации примеси в низколегированной области для резкого pn -перехода
 Температурная зависимость напряжения лавинного пробоя определяется уменьшением длины свободного пробега носителей заряда с увеличением температуры. При этом величина напряжения пробоя увеличивается, так как энергию, необходимую для разрыва ковалентных связей носители могут набрать при больших напряжениях.
Температурная зависимость напряжения лавинного пробоя определяется уменьшением длины свободного пробега носителей заряда с увеличением температуры. При этом величина напряжения пробоя увеличивается, так как энергию, необходимую для разрыва ковалентных связей носители могут набрать при больших напряжениях.
 Туннельный пробой pn — перехода
Туннельный пробой pn — перехода
 Зонная диаграмма сильнолегированного p-n- перехода при обратном смещении 238 210 exp g см. ТУН E VAI
Зонная диаграмма сильнолегированного p-n- перехода при обратном смещении 238 210 exp g см. ТУН E VAI
 Чтобы этот эффект имел место, электрическое поле должно быть настолько сильным, чтобы обеспечить такой наклон зон, при котором заполненные электронами уровни валентной зоны оказались напротив незаполненных энергетических уровней разрешенной зоны, а ширина потенциального барьера сравнима с длиной волны де Бройля электрона.
Чтобы этот эффект имел место, электрическое поле должно быть настолько сильным, чтобы обеспечить такой наклон зон, при котором заполненные электронами уровни валентной зоны оказались напротив незаполненных энергетических уровней разрешенной зоны, а ширина потенциального барьера сравнима с длиной волны де Бройля электрона.
 Напряжение туннельного пробоя сравнительно слабо зависит от температуры. Однако с ростом температуры ширина запрещенной зоны германия и кремния уменьшается, вероятность туннелирования возрастает, и величина критической напряженности поля уменьшается. Поэтому напряжение туннельного пробоя уменьшается. Поскольку напряжение, при котором возникает лавинный и туннельный пробой достаточно стабильно, этот эффект используется для создания приборов, падение напряжения на которых остается стабильным при изменении тока – стабилитронов.
Напряжение туннельного пробоя сравнительно слабо зависит от температуры. Однако с ростом температуры ширина запрещенной зоны германия и кремния уменьшается, вероятность туннелирования возрастает, и величина критической напряженности поля уменьшается. Поэтому напряжение туннельного пробоя уменьшается. Поскольку напряжение, при котором возникает лавинный и туннельный пробой достаточно стабильно, этот эффект используется для создания приборов, падение напряжения на которых остается стабильным при изменении тока – стабилитронов.
 Тепловой пробой pn — перехода При увеличении обратного напряжения увеличивается мощность, рассеиваемая в переходе в виде тепла, поэтому для pn -переходов со сравнительно высокими обратными токами возможен разогрев. Начавшийся разогрев, в свою очередь, приведет к увеличению обратного тока. Таким образом, в pn -переходе возникает положительная обратная связь, ведущая к возникновению тепловой неустойчивости – тепловому пробою.
Тепловой пробой pn — перехода При увеличении обратного напряжения увеличивается мощность, рассеиваемая в переходе в виде тепла, поэтому для pn -переходов со сравнительно высокими обратными токами возможен разогрев. Начавшийся разогрев, в свою очередь, приведет к увеличению обратного тока. Таким образом, в pn -переходе возникает положительная обратная связь, ведущая к возникновению тепловой неустойчивости – тепловому пробою.
 Влияние сопротивления базы на ВАХ
Влияние сопротивления базы на ВАХ
 Прямая ВАХ в полулогарифмическом масштабе
Прямая ВАХ в полулогарифмическом масштабе
 Толщина базы , в свою очередь, влияет на закон распределения инжектированных носителей и диффузионных токов. Экспоненциальное распределение, представленное в формулах справедливо для длинной базы, то есть при В случае короткой базы: cмnn. VWl pcмnn. LVWl p nn nnn L Wx sh L x. Wx sh ppxp 00 nn nnn Wx x ppxp
Толщина базы , в свою очередь, влияет на закон распределения инжектированных носителей и диффузионных токов. Экспоненциальное распределение, представленное в формулах справедливо для длинной базы, то есть при В случае короткой базы: cмnn. VWl pcмnn. LVWl p nn nnn L Wx sh L x. Wx sh ppxp 00 nn nnn Wx x ppxp
 Характеристическое сопротивление диода Различают два вида характеристического сопротивления диодов: дифференциальное сопротивление r d и сопротивление по постоянному току R D. Дифференциальное сопротивление определяется как 1 см см d d. V d. I d. V r s. T T s T s Т см T s IIIIIIVI 11 exp
Характеристическое сопротивление диода Различают два вида характеристического сопротивления диодов: дифференциальное сопротивление r d и сопротивление по постоянному току R D. Дифференциальное сопротивление определяется как 1 см см d d. V d. I d. V r s. T T s T s Т см T s IIIIIIVI 11 exp
 Определяется как отношение приложенного напряжения к протекающему току через диод: На прямой ВАХ сопротивление R D > r d , на обратной – R D < r d. 1 exp Тсм s смсм D V IV RСопротивление по постоянному току R D В точке вблизи нулевого значения напряжения qk. TV см значения сопротивлений совпадают. Действительно, разложив экспоненту, получаем: d ss TDr Iq k. T I R
Определяется как отношение приложенного напряжения к протекающему току через диод: На прямой ВАХ сопротивление R D > r d , на обратной – R D < r d. 1 exp Тсм s смсм D V IV RСопротивление по постоянному току R D В точке вблизи нулевого значения напряжения qk. TV см значения сопротивлений совпадают. Действительно, разложив экспоненту, получаем: d ss TDr Iq k. T I R
 Переходные процессы в полупроводниковых диодах При быстрых изменениях напряжения на полупроводниковом диоде значение тока через диод, соответствующее статической ВАХ, устанавливается не сразу. Процесс установления тока при таких переключениях называют переходным процессам. Переходные процессы в полупроводниковых диодах связаны с накоплением носителей в базе диода при его прямом включении и их рассасывании в базе при быстром изменении полярности напряжения на диоде. Так как электрическое поле в базе обычного диода отсутствует, то движение неосновных носителей в базе определяется законами диффузии и происходит относительно медленно. В результате кинетика накопления носителей в базе и их рассасывание влияют на динамические свойства диодов в режиме переключения.
Переходные процессы в полупроводниковых диодах При быстрых изменениях напряжения на полупроводниковом диоде значение тока через диод, соответствующее статической ВАХ, устанавливается не сразу. Процесс установления тока при таких переключениях называют переходным процессам. Переходные процессы в полупроводниковых диодах связаны с накоплением носителей в базе диода при его прямом включении и их рассасывании в базе при быстром изменении полярности напряжения на диоде. Так как электрическое поле в базе обычного диода отсутствует, то движение неосновных носителей в базе определяется законами диффузии и происходит относительно медленно. В результате кинетика накопления носителей в базе и их рассасывание влияют на динамические свойства диодов в режиме переключения.
 001 expn p nnnp L x ppxp С течением времени концентрация неравновесных носителей будет убывать, следовательно, будет убывать и обратный ток. За время τ 0 , называемое временем восстановления обратного сопротивления или временем рассасывания , обратный ток придет к значению, равному току насыщения. t pnn L x pp exp 1 0 При 0 t. При
001 expn p nnnp L x ppxp С течением времени концентрация неравновесных носителей будет убывать, следовательно, будет убывать и обратный ток. За время τ 0 , называемое временем восстановления обратного сопротивления или временем рассасывания , обратный ток придет к значению, равному току насыщения. t pnn L x pp exp 1 0 При 0 t. При
 Координатные зависимости p ( x , t ) в различные моменты времени
Координатные зависимости p ( x , t ) в различные моменты времени
 Обратный ток обусловлен только диффузией дырок к границе ОПЗ p — n -перехода: 0 | x n p dx dp q. Dj
Обратный ток обусловлен только диффузией дырок к границе ОПЗ p — n -перехода: 0 | x n p dx dp q. Dj
 Зависимость обратного тока при переключении диодаt=0, J бсмсрr. VI τ ср = τ р /
Зависимость обратного тока при переключении диодаt=0, J бсмсрr. VI τ ср = τ р /
 Полупроводниковые диоды В данном разделе будут рассмотрены следующие типы полупроводниковых диодов: — выпрямительные диоды на основе pn -перехода — стабилитроны, варикапы — туннельные и обращенные диоды
Полупроводниковые диоды В данном разделе будут рассмотрены следующие типы полупроводниковых диодов: — выпрямительные диоды на основе pn -перехода — стабилитроны, варикапы — туннельные и обращенные диоды
 Выпрямительные диоды Основная задача выпрямительного диода – выпрямление переменного (в частности синусоидального) тока, то есть выделение постоянной его составляющей. Применяется в цепях управления и коммутации, для развязок в электрических цепях, ограничения выбросов напряжений в цепях с индуктивными элементами, а также в цепях, где необходимы вентильные элементы и не предъявляется жестких требований к временным и частотным параметрам. Выпрямительные или вентильные свойства полупроводникового диода определяются его ВАХ
Выпрямительные диоды Основная задача выпрямительного диода – выпрямление переменного (в частности синусоидального) тока, то есть выделение постоянной его составляющей. Применяется в цепях управления и коммутации, для развязок в электрических цепях, ограничения выбросов напряжений в цепях с индуктивными элементами, а также в цепях, где необходимы вентильные элементы и не предъявляется жестких требований к временным и частотным параметрам. Выпрямительные или вентильные свойства полупроводникового диода определяются его ВАХ
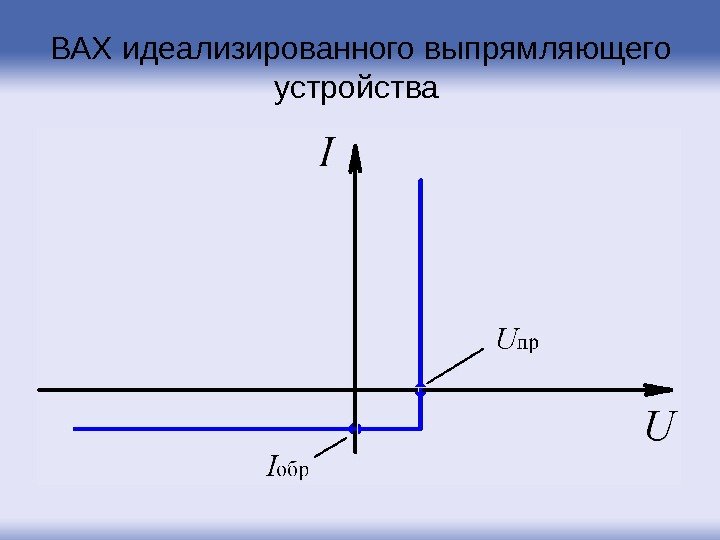 ВАХ идеализированного выпрямляющего устройства
ВАХ идеализированного выпрямляющего устройства
 ВАХ реального pn -перехода
ВАХ реального pn -перехода
 Выпрямительный, или силовой, диод – прибор, предназначенный для выпрямления переменного тока. Их применяют в цепях управления и коммутации, для развязок в электрических цепях, ограничения выбросов напряжений в цепях с индуктивными элементами, а также в цепях, где необходимы вентильные элементы и не предъявляется жестких требований к временным и частотным параметрам.
Выпрямительный, или силовой, диод – прибор, предназначенный для выпрямления переменного тока. Их применяют в цепях управления и коммутации, для развязок в электрических цепях, ограничения выбросов напряжений в цепях с индуктивными элементами, а также в цепях, где необходимы вентильные элементы и не предъявляется жестких требований к временным и частотным параметрам.
 Графики напряжения и выпрямленного тока (а). простейшая выпрямительная схема (б)
Графики напряжения и выпрямленного тока (а). простейшая выпрямительная схема (б)
 Стабилитроны Стабилитрон (опорный диод) – полупроводниковый диод, предназначенный для стабилизации напряжения. Стабилитроны используют также в качестве ограничителей постоянного или импульсного напряжения, элементов межкаскадной связи, источников эталонного напряжения и др.
Стабилитроны Стабилитрон (опорный диод) – полупроводниковый диод, предназначенный для стабилизации напряжения. Стабилитроны используют также в качестве ограничителей постоянного или импульсного напряжения, элементов межкаскадной связи, источников эталонного напряжения и др.
 ВАХ стабилитрона 2 minmax. IIIст
ВАХ стабилитрона 2 minmax. IIIст
 Основными характеристиками стабилитрона являются ток I ст и напряжение U ст стабилизации, дифференциальное напряжение стабилитрона r д и температурная зависимость этих параметров. Основное назначение стабилитрона – стабилизация напряжения на нагрузке ( R н ), при изменяющемся напряжении во внешней цепи. В неразветвленную часть цепи включают балластный резистор R 0 , сопротивление которого должно быть существенно больше дифференциального сопротивления стабилитрона.
Основными характеристиками стабилитрона являются ток I ст и напряжение U ст стабилизации, дифференциальное напряжение стабилитрона r д и температурная зависимость этих параметров. Основное назначение стабилитрона – стабилизация напряжения на нагрузке ( R н ), при изменяющемся напряжении во внешней цепи. В неразветвленную часть цепи включают балластный резистор R 0 , сопротивление которого должно быть существенно больше дифференциального сопротивления стабилитрона.


 стн. UU стн. БIII ББст. ББнн. RIURIRIU ст н ст Б ст I R UU н Б Бстст R R RIUU 1/ Бст. Б Бн ст. RIR RR UU
стн. UU стн. БIII ББст. ББнн. RIURIRIU ст н ст Б ст I R UU н Б Бстст R R RIUU 1/ Бст. Б Бн ст. RIR RR UU
 В режиме короткого замыкания ( )0 ст. U Б n КЗст R U II Бн нn ХХст RR RU UU . Нестабильность выходного напряжения вызывается двумя основными причинами: нестабильностью входного напряжения и нестабильностью входного тока (нестабильностью сопротивления нагрузки R н ). п. U
В режиме короткого замыкания ( )0 ст. U Б n КЗст R U II Бн нn ХХст RR RU UU . Нестабильность выходного напряжения вызывается двумя основными причинами: нестабильностью входного напряжения и нестабильностью входного тока (нестабильностью сопротивления нагрузки R н ). п. U
 стн. Бст. IIRUU d. Бн. Б ст r. RRR U U 1 d ст н ст Бст r U RU
стн. Бст. IIRUU d. Бн. Б ст r. RRR U U 1 d ст н ст Бст r U RU
 Туннельные диоды Туннельный диод был предложен в 1958 году Лео Исаки, который в 1973 году получил Нобелевскую премию по физике за открытие эффекта туннелирования электронов, применяемого в этих диодах. Туннельным диодом называют полупроводниковый диод на основе p+n+- перехода с сильнолегированными областями, на прямом участке ВАХ которого наблюдается N -образная зависимость тока от напряжения.
Туннельные диоды Туннельный диод был предложен в 1958 году Лео Исаки, который в 1973 году получил Нобелевскую премию по физике за открытие эффекта туннелирования электронов, применяемого в этих диодах. Туннельным диодом называют полупроводниковый диод на основе p+n+- перехода с сильнолегированными областями, на прямом участке ВАХ которого наблюдается N -образная зависимость тока от напряжения.
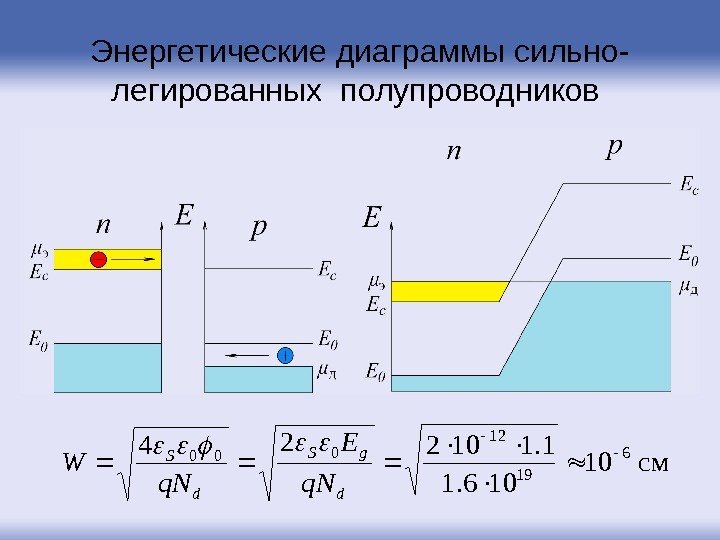 Энергетические диаграммы сильно- легированных полупроводников см 10 106. 1 1. 1102246 19 12 000 d g. S d S q. N E q. N W
Энергетические диаграммы сильно- легированных полупроводников см 10 106. 1 1. 1102246 19 12 000 d g. S d S q. N E q. N W
 76 3001038. 1101. 92 1063. 6 2331 234 k. T m k k. TE 2 2222 2 2 E ; 2 k. Tm h λ
76 3001038. 1101. 92 1063. 6 2331 234 k. T m k k. TE 2 2222 2 2 E ; 2 k. Tm h λ
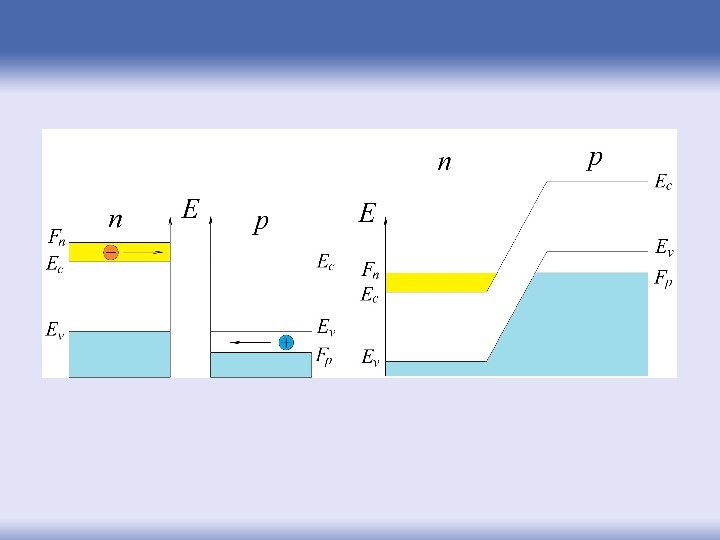
 ВАХ туннельного диода. EC E CE V E VF p Fn
ВАХ туннельного диода. EC E CE V E VF p Fn
 ВАХ туннельного диода EC E VE V F p F n
ВАХ туннельного диода EC E VE V F p F n
 ВАХ туннельного диода Fn F p. E CE V
ВАХ туннельного диода Fn F p. E CE V
 ВАХ туннельного диода EC E C EV E VF p F n
ВАХ туннельного диода EC E C EV E VF p F n
 ВАХ туннельного диода Fp F n. E C EV E V
ВАХ туннельного диода Fp F n. E C EV E V
 Обращенный диод EV E V E V EV E VE C E C E CF p F p Fn F n.
Обращенный диод EV E V E V EV E VE C E C E CF p F p Fn F n.
 Расчет ВАХ барьера Шоттки
Расчет ВАХ барьера Шоттки
 Расчет ВАХ барьера Шоттки d k Nq V W см 02 При приложении напряжения: 1 sмп. п T V e. JJJJ T b U e. TAJ 2 s 0 * 3 2* 120 4 m m h kqm Ann 22 см А Kгде — Постоянная Ричардсона
Расчет ВАХ барьера Шоттки d k Nq V W см 02 При приложении напряжения: 1 sмп. п T V e. JJJJ T b U e. TAJ 2 s 0 * 3 2* 120 4 m m h kqm Ann 22 см А Kгде — Постоянная Ричардсона
 ВАХ диода Шоттки
ВАХ диода Шоттки
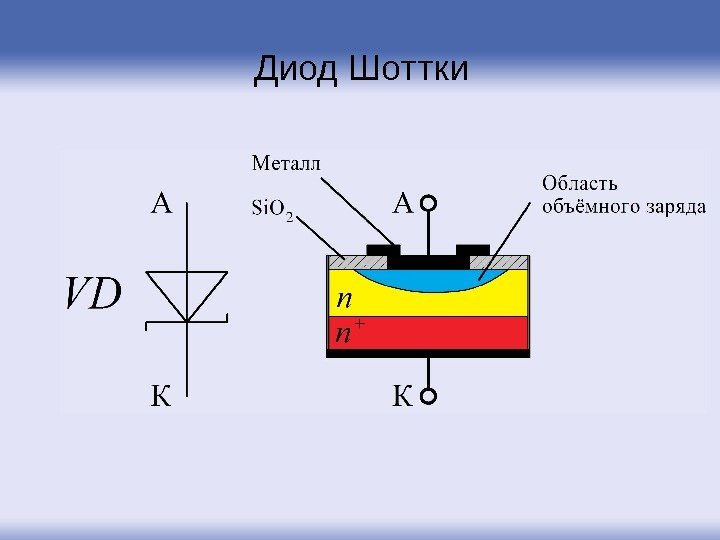 Диод Шоттки
Диод Шоттки
 • Диоды Шоттки характеризуются быстрой рекомбинацией инжектированных носителей (время жизни носителей крайне мало), а значит и высоким быстродействием. • Благодаря минимальному сопротивлению базы и отсутствию процессов накопления и рассасывания избыточных зарядов, быстро-действие получается достаточно высоким: граничная частота . Гц10 10 гр f
• Диоды Шоттки характеризуются быстрой рекомбинацией инжектированных носителей (время жизни носителей крайне мало), а значит и высоким быстродействием. • Благодаря минимальному сопротивлению базы и отсутствию процессов накопления и рассасывания избыточных зарядов, быстро-действие получается достаточно высоким: граничная частота . Гц10 10 гр f

