L03-SE-Evtukh-1.ppt
- Количество слайдов: 30
 НАПІВПРОВІДНИКОВА ЕЛЕКТРОНІКА Лекція 03 Контакт метал - напівпровідник Анатолій Євтух Інститут високих технологій Київського національного університету імені Тараса Шевченка
НАПІВПРОВІДНИКОВА ЕЛЕКТРОНІКА Лекція 03 Контакт метал - напівпровідник Анатолій Євтух Інститут високих технологій Київського національного університету імені Тараса Шевченка
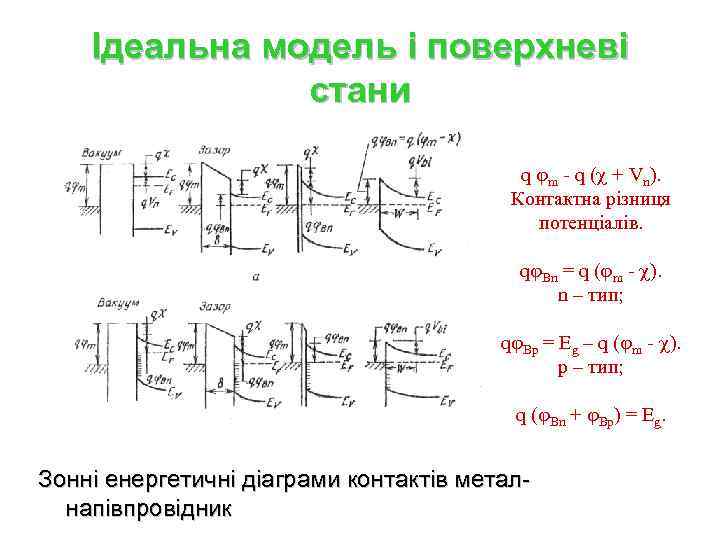 Ідеальна модель і поверхневі стани q m - q ( + Vn). Контактна різниця потенціалів. q Bn = q ( m - ). n – тип; q Bp = Eg – q ( m - ). p – тип; q ( Bn + Bp) = Eg. Зонні енергетичні діаграми контактів металнапівпровідник
Ідеальна модель і поверхневі стани q m - q ( + Vn). Контактна різниця потенціалів. q Bn = q ( m - ). n – тип; q Bp = Eg – q ( m - ). p – тип; q ( Bn + Bp) = Eg. Зонні енергетичні діаграми контактів металнапівпровідник
 Збіднений шар Зонні енергетичні діаграми контактів метала з напівпровідниками n- і p - типів при різних зміщеннях. а – при термодинамічній рівновазі; б- при прямому зміщенні; в- при оберненому зміщенні.
Збіднений шар Зонні енергетичні діаграми контактів метала з напівпровідниками n- і p - типів при різних зміщеннях. а – при термодинамічній рівновазі; б- при прямому зміщенні; в- при оберненому зміщенні.
 Рівняння Пуасона: 2 =- / 0 s Різкий несиметричний p-n перехід; Наближення різкої границі збідненого шару: ( q. ND при x
Рівняння Пуасона: 2 =- / 0 s Різкий несиметричний p-n перехід; Наближення різкої границі збідненого шару: ( q. ND при x
 Питома ємність збідненого шару Якщо концентрація ND постійна у всій області збідненого шару, то на графіку 1/C 2 від V отримаємо пряму лінію. Якщо концентрація ND не постійна, то, вимірюючи диференційну ємність можна визначити профіль легування.
Питома ємність збідненого шару Якщо концентрація ND постійна у всій області збідненого шару, то на графіку 1/C 2 від V отримаємо пряму лінію. Якщо концентрація ND не постійна, то, вимірюючи диференційну ємність можна визначити профіль легування.
 Ефект Шотткі Енергетична діаграма системи металвакуум. Ефективна робота виходу прикладанні зовнішнього електричного поля зменшується. Це зменшення є наслідком суперпозиції зовнішнього електричного поля і сили зображення.
Ефект Шотткі Енергетична діаграма системи металвакуум. Ефективна робота виходу прикладанні зовнішнього електричного поля зменшується. Це зменшення є наслідком суперпозиції зовнішнього електричного поля і сили зображення.
 Зниження енергетичного бар’єра як функція електричного поля в діодах Au – Si. Енергетичні діаграми бар’єра Шотткі між металом і напівпровідником n– типу при різних напругах зміщення.
Зниження енергетичного бар’єра як функція електричного поля в діодах Au – Si. Енергетичні діаграми бар’єра Шотткі між металом і напівпровідником n– типу при різних напругах зміщення.
 Теорія процесів переносу заряда 1. Надбар’єрний переніс. 2. Квантовомеханічне тунелювання електронів через бар’єр. 3. Рекомбінація в області просторового заряду. Чотири основні процеси переносу при прямому зміщенні. 4. Інжекція дірок із металу в напівпровідник.
Теорія процесів переносу заряда 1. Надбар’єрний переніс. 2. Квантовомеханічне тунелювання електронів через бар’єр. 3. Рекомбінація в області просторового заряду. Чотири основні процеси переносу при прямому зміщенні. 4. Інжекція дірок із металу в напівпровідник.
 1. Теорія термоелектронної емісії. Припущення: 1. Висота бар’єру q Bn набагато більша k. T 2. Область, що визначає термоелектронну емісію, знаходиться в термодинамічній рівновазі. 3. Протікання повного струму не порушує цієї рівноваги. Струм не залежить від форми бар’єра, а лише від його висоти.
1. Теорія термоелектронної емісії. Припущення: 1. Висота бар’єру q Bn набагато більша k. T 2. Область, що визначає термоелектронну емісію, знаходиться в термодинамічній рівновазі. 3. Протікання повного струму не порушує цієї рівноваги. Струм не залежить від форми бар’єра, а лише від його висоти.
 2. Дифузійна теорія Припущення: 1. Висота бар’єру q Bn набагато більша k. T шарі грає суттєву роль. 3. Концентрація носіїв при x=0 і x=W не залежить від 2. Розсіяння електронів при їх русі в збідненому струму. 4. Концентрація домішок в напівпровіднику досить мала, і виродження відсутнє. Необхідно враховувати дві компоненти струму (дифузійну та польову): Співвідношенняумови: Граничні Ейнштейна: Співвідношення Ейнштейна: Граничні умови:
2. Дифузійна теорія Припущення: 1. Висота бар’єру q Bn набагато більша k. T шарі грає суттєву роль. 3. Концентрація носіїв при x=0 і x=W не залежить від 2. Розсіяння електронів при їх русі в збідненому струму. 4. Концентрація домішок в напівпровіднику досить мала, і виродження відсутнє. Необхідно враховувати дві компоненти струму (дифузійну та польову): Співвідношенняумови: Граничні Ейнштейна: Співвідношення Ейнштейна: Граничні умови:
 Розподіл потенціалу в бар’єрі Шотткі: JSD сильніше залежить від напруги і менш чутлива до температури, ніж JST.
Розподіл потенціалу в бар’єрі Шотткі: JSD сильніше залежить від напруги і менш чутлива до температури, ніж JST.
 3. Термоемісійна- дифузійна теорія. В якості граничної умови використовується швидкість термоелектронної рекомбінації v. R на границі розділу метал-напівпровідник. n- густина електронів в точці х Між xm і x=0. Енергетична діаграма контакту з де урахуванням ефекту Шотткі. q (x)– потенціальна енергія електрона, q (x) - положення квазірівня Фермі. -ефективна швидкість дифузії.
3. Термоемісійна- дифузійна теорія. В якості граничної умови використовується швидкість термоелектронної рекомбінації v. R на границі розділу метал-напівпровідник. n- густина електронів в точці х Між xm і x=0. Енергетична діаграма контакту з де урахуванням ефекту Шотткі. q (x)– потенціальна енергія електрона, q (x) - положення квазірівня Фермі. -ефективна швидкість дифузії.
 Якщо v. D>>v. R, то передекспоненційному члені залишається лише v. R і справедлива теорія термоелектронної емісії. Якщо v. D<
Якщо v. D>>v. R, то передекспоненційному члені залишається лише v. R і справедлива теорія термоелектронної емісії. Якщо v. D<
 Ефективна постійна Річардсона Розрахункові значення ефективної постійної Річардсона як функціії електричного поля в бар’єрі метал-кремній.
Ефективна постійна Річардсона Розрахункові значення ефективної постійної Річардсона як функціії електричного поля в бар’єрі метал-кремній.
 4. Тунельний струм Дві компоненти струму: термоелектронна і тунельна. n- фактор неідеальності. При V>>k. T/q Тунельна компонента густини струму домінує при високому рівні легування і низьких температурах. Тунельний струм експоненційно залежить від
4. Тунельний струм Дві компоненти струму: термоелектронна і тунельна. n- фактор неідеальності. При V>>k. T/q Тунельна компонента густини струму домінує при високому рівні легування і низьких температурах. Тунельний струм експоненційно залежить від
 Теоретичні і експериментальні вольтамперні характеристики діодів Au-Si. Теоретичні і експериментальні вольт-амперні характеристики діодів Au-Si. Залежності густини струму насичення (а) и фактору неідеальності n (б) від концентрації легуючої домішки в діоді Au-Si при різних температурах. Відношення тунельного струму до струму термоелектронної емісії в діодах Au-Si.
Теоретичні і експериментальні вольтамперні характеристики діодів Au-Si. Теоретичні і експериментальні вольт-амперні характеристики діодів Au-Si. Залежності густини струму насичення (а) и фактору неідеальності n (б) від концентрації легуючої домішки в діоді Au-Si при різних температурах. Відношення тунельного струму до струму термоелектронної емісії в діодах Au-Si.
 5. Інжекція неосновних носіїв. Рівняння неперервності: Рівняння густини струму для неосновних носіїв: Енергетична діаграма епітаксійного бар’єру Шотткі. При низькому рівні інжекції можна знехтувати дрейфовим членом в порівнянні з дифузійним. Отримуємо: При збільшенні електричного поля домінуючою стає дрейфова компонента. - росте пропорційно густині струму.
5. Інжекція неосновних носіїв. Рівняння неперервності: Рівняння густини струму для неосновних носіїв: Енергетична діаграма епітаксійного бар’єру Шотткі. При низькому рівні інжекції можна знехтувати дрейфовим членом в порівнянні з дифузійним. Отримуємо: При збільшенні електричного поля домінуючою стає дрейфова компонента. - росте пропорційно густині струму.
 Висота бар’єра q m- робота виходу метала; q Bn- висота енергетичного барєру; q B 0 асимптотичне значення при нульовому електричному полі; 0 енергетичний рівень на поверхні; - зниження барєра за рахунок сил зображення; - падіння потенціалу на проміжному шарі; - електронна спорідненість напівпровідника; Vbiвбудований потенціал; s- діелектрична проникність напівпровідника; i- діелектрична проникність проміжного шару; товщина проміжного шару; Qscгустина обємного заряду в Детальна енергетична діаграма контакту напівпровіднику, метал-напівпровідник – типу при Qss- густина заряду на поверхневих станах наявності проміжного шару напівпровідника; Qm- густина товщиною порядку міжатомних поверхневого заряду в металі. відстаней.
Висота бар’єра q m- робота виходу метала; q Bn- висота енергетичного барєру; q B 0 асимптотичне значення при нульовому електричному полі; 0 енергетичний рівень на поверхні; - зниження барєра за рахунок сил зображення; - падіння потенціалу на проміжному шарі; - електронна спорідненість напівпровідника; Vbiвбудований потенціал; s- діелектрична проникність напівпровідника; i- діелектрична проникність проміжного шару; товщина проміжного шару; Qscгустина обємного заряду в Детальна енергетична діаграма контакту напівпровіднику, метал-напівпровідник – типу при Qss- густина заряду на поверхневих станах наявності проміжного шару напівпровідника; Qm- густина товщиною порядку міжатомних поверхневого заряду в металі. відстаней.
 Висота бар’єра Два припущення: 1. Товщина проміжного шару між металом і напівпровідником або дорівнює нулю, або порядку міжатомних розмірів і тому він є тунельно прозорим для електронів , а його вплив зводиться лише до падіння потенціалу на ньому. 2. Енергетична густина поверхневих станів не залежить від типу металу і визначається лише властивостями поверхні напівпровідника. Густина заряду на поверхневих станах: Поверхнева густина заряду збідненого шару напівпровідника: Закон Гауса: Виключим і отримуєм:
Висота бар’єра Два припущення: 1. Товщина проміжного шару між металом і напівпровідником або дорівнює нулю, або порядку міжатомних розмірів і тому він є тунельно прозорим для електронів , а його вплив зводиться лише до падіння потенціалу на ньому. 2. Енергетична густина поверхневих станів не залежить від типу металу і визначається лише властивостями поверхні напівпровідника. Густина заряду на поверхневих станах: Поверхнева густина заряду збідненого шару напівпровідника: Закон Гауса: Виключим і отримуєм:
 Вирішуємо відносно Bn і отримуємо: де При s 10 0, i= 0 і ND<1018 см-3 величина c 1 мала тому вираз для висоти бар’єру спрощується до виду Якщо c 1 і c 3 можна визначити експериментально, а значення відомо, то І із виразу для c 2:
Вирішуємо відносно Bn і отримуємо: де При s 10 0, i= 0 і ND<1018 см-3 величина c 1 мала тому вираз для висоти бар’єру спрощується до виду Якщо c 1 і c 3 можна визначити експериментально, а значення відомо, то І із виразу для c 2:
 Два граничні випадки: 1. Якщо Ds , то c 2 0 і В цьому випадку рівень Фермі на поверхні фіксується поверхневими станами на енергії, що перевищує край валентної зони на величину q 0. При цьому висота бар’єра не залежить від роботи виходу металу і повністю визначається ступенем легування і поверхневими властивостями напівпровідника. 2. Якщо Ds 0 , то c 2 1 і Висота енергетичного бар’єра ідеального діода Шотткі (при відсутності поверхневих станів).
Два граничні випадки: 1. Якщо Ds , то c 2 0 і В цьому випадку рівень Фермі на поверхні фіксується поверхневими станами на енергії, що перевищує край валентної зони на величину q 0. При цьому висота бар’єра не залежить від роботи виходу металу і повністю визначається ступенем легування і поверхневими властивостями напівпровідника. 2. Якщо Ds 0 , то c 2 1 і Висота енергетичного бар’єра ідеального діода Шотткі (при відсутності поверхневих станів).
 Виміри висоти бар’єру. 1. Метод вольт-амперної характеристики Залежність густини струму в діодах W-Si і W-Ga. As від прикладеної в прямому зміщенні напруги. Теоретичне значення A**=120 A cм-2 К-2 При прямому зміщенні з V>3 k. T/q
Виміри висоти бар’єру. 1. Метод вольт-амперної характеристики Залежність густини струму в діодах W-Si і W-Ga. As від прикладеної в прямому зміщенні напруги. Теоретичне значення A**=120 A cм-2 К-2 При прямому зміщенні з V>3 k. T/q
 2. Метод енергії активації. Ае- площа електрично активної області. При постійній напрузі прямого зміщення з тангенса кута нахилу залежності ln(IF/T 2) від 1/T знайдемо висоту бар’єра Bn. Залежність струму від температури в координатах, що використовуються для визначення висоти бар’єру.
2. Метод енергії активації. Ае- площа електрично активної області. При постійній напрузі прямого зміщення з тангенса кута нахилу залежності ln(IF/T 2) від 1/T знайдемо висоту бар’єра Bn. Залежність струму від температури в координатах, що використовуються для визначення висоти бар’єру.
 3. Метод вольт-фарадної характеристики 1/C 2 Залежність від прикладеної напруги для діодів W-Si і WGa. As. Напівпровідник з одним мілким і одним глибоким донорними рівнями. ND і NT– концентрації мілких і глибоких донорів, відповідно.
3. Метод вольт-фарадної характеристики 1/C 2 Залежність від прикладеної напруги для діодів W-Si і WGa. As. Напівпровідник з одним мілким і одним глибоким донорними рівнями. ND і NT– концентрації мілких і глибоких донорів, відповідно.
 Якщо концентрація ND постійна у всій області збідненого шару, то на графіку 1/C 2 від V отримаємо пряму лінію. Якщо концентрація ND не постійна, то, вимірюючи диференційну ємність можна визначити профіль легування. Висота бар’єра визначається із залежності 1/С 2 від V. де Vi - точка перетину з віссю напруг, а q. Vn - різниця енергій між рівнем Фермі і дном зони провідності напівпровіднику, яку можна вирахувати, якщо відома концентрація легуючої домішки. Останню можна знайти з тангенса кута нахилу залежності 1/С 2 від V.
Якщо концентрація ND постійна у всій області збідненого шару, то на графіку 1/C 2 від V отримаємо пряму лінію. Якщо концентрація ND не постійна, то, вимірюючи диференційну ємність можна визначити профіль легування. Висота бар’єра визначається із залежності 1/С 2 від V. де Vi - точка перетину з віссю напруг, а q. Vn - різниця енергій між рівнем Фермі і дном зони провідності напівпровіднику, яку можна вирахувати, якщо відома концентрація легуючої домішки. Останню можна знайти з тангенса кута нахилу залежності 1/С 2 від V.
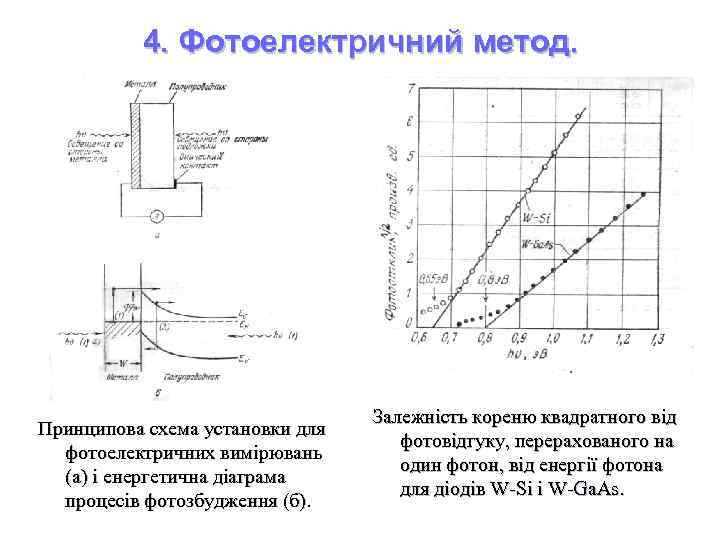 4. Фотоелектричний метод. Принципова схема установки для фотоелектричних вимірювань (а) і енергетична діаграма процесів фотозбудження (б). Залежність кореню квадратного від фотовідгуку, перерахованого на один фотон, від енергії фотона для діодів W-Si і W-Ga. As.
4. Фотоелектричний метод. Принципова схема установки для фотоелектричних вимірювань (а) і енергетична діаграма процесів фотозбудження (б). Залежність кореню квадратного від фотовідгуку, перерахованого на один фотон, від енергії фотона для діодів W-Si і W-Ga. As.
 Теорія Фаулера. Залежність квантового виходу R від енергії фотона h виражається формулою: де h 0=q Bn - висота бар’єру, Es - сума h 0 і енергії Фермі, відрахована від дна зони провідності металу, x=h( - 0)/k. T. При умові Es>> h і x>3 отримуємо спрощений вираз при або
Теорія Фаулера. Залежність квантового виходу R від енергії фотона h виражається формулою: де h 0=q Bn - висота бар’єру, Es - сума h 0 і енергії Фермі, відрахована від дна зони провідності металу, x=h( - 0)/k. T. При умові Es>> h і x>3 отримуємо спрощений вираз при або
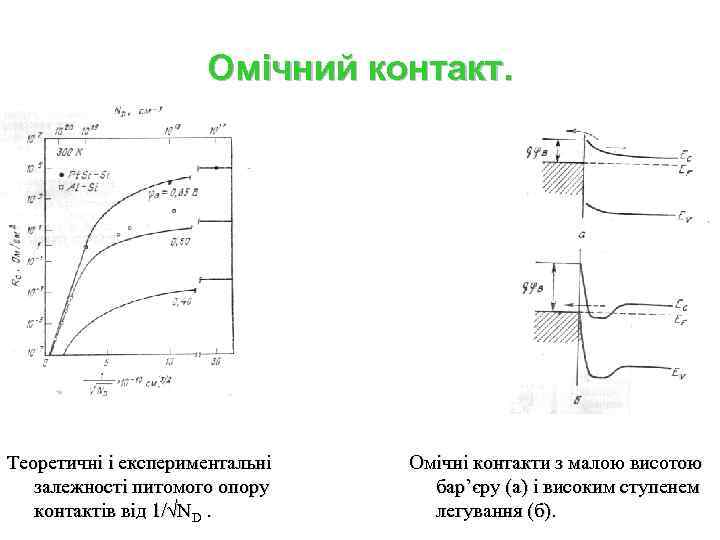 Омічний контакт. Теоретичні і експериментальні залежності питомого опору контактів від 1/ ND. Омічні контакти з малою висотою бар’єру (а) і високим ступенем легування (б).
Омічний контакт. Теоретичні і експериментальні залежності питомого опору контактів від 1/ ND. Омічні контакти з малою висотою бар’єру (а) і високим ступенем легування (б).
 Найбільш важливою характеристикою контакту є питомий опір при нульовому зміщенні 1. В контакті метал-напівпровідник з низьким рівнем легування домінує термоелектронна компонента струму В цьому випадку 2. В контакті метал-напівпровідник з більш високим рівнем легування домінує тунельна компонента струму При цьому Звідси видно, що в тунельній області питомий опір контакту експоненційно залежить від
Найбільш важливою характеристикою контакту є питомий опір при нульовому зміщенні 1. В контакті метал-напівпровідник з низьким рівнем легування домінує термоелектронна компонента струму В цьому випадку 2. В контакті метал-напівпровідник з більш високим рівнем легування домінує тунельна компонента струму При цьому Звідси видно, що в тунельній області питомий опір контакту експоненційно залежить від
 Дякую за увагу!
Дякую за увагу!


