SEM_lect.ppt
- Количество слайдов: 25
 Методы исследования материалов и структур. Растровая электронная микроскопия. ОНИ «Наноструктур и биосистем» Департамент нанотехнологий Отдел нанотехнологий ЛАБОРАТОРИЯ ДИАГНОСТИКИ НАНОМАТЕРИАЛОВ И СТРУКТУР
Методы исследования материалов и структур. Растровая электронная микроскопия. ОНИ «Наноструктур и биосистем» Департамент нанотехнологий Отдел нанотехнологий ЛАБОРАТОРИЯ ДИАГНОСТИКИ НАНОМАТЕРИАЛОВ И СТРУКТУР
 Растровый электронный микроскоп (РЭМ) = Сканирующий Электронный микроскоп (СЭМ) = Scanning Electron Microscop (SEM) анализа материалов в машиностроении электронной и полупроводниковой промышленности медицине биологии химии
Растровый электронный микроскоп (РЭМ) = Сканирующий Электронный микроскоп (СЭМ) = Scanning Electron Microscop (SEM) анализа материалов в машиностроении электронной и полупроводниковой промышленности медицине биологии химии
 Возможности РЭМ Ø Ø исследования массивных объектов Ø химический состав исследуемого объекта Ø кристаллическое строение Ø магнитные свойства объекта Ø электропроводности Ø катодолюминисценции Ø свойства объекта на просвет изучение рельефа (морфологии) поверхности объекта
Возможности РЭМ Ø Ø исследования массивных объектов Ø химический состав исследуемого объекта Ø кристаллическое строение Ø магнитные свойства объекта Ø электропроводности Ø катодолюминисценции Ø свойства объекта на просвет изучение рельефа (морфологии) поверхности объекта
 Преимущества РЭМ по сравнению с другими методами микроскопии Световой микроскопией РЭМ - большими разрешающей способностью и глубиной резкости РЭМ - относительной легкостью в интерпретации полученных изображений РЭМ - возможностью подключения дополнительных приборов для анализа в микродиапазоне при достаточной простоте в адаптации и управлении этими приборами Сканирующей зондовой микроскопии РЭМ - позволяет исследовать существенно большие участки поверхности; РЭМ - работать с сильно рельефными поверхностями; РЭМ - использовать значительно более широкий диапазон увеличений; РЭМ - получать информацию не только о поверхности, но и о прилегающих к поверхности «подповерхностных» слоях Просвечивающей электронной микроскопии РЭМ - использует не большие ускоряющие напряжения РЭМ - не приводит к нагреву образца вплоть до разрушения и испарения РЭМ - возможно использовать образцы различной толщины
Преимущества РЭМ по сравнению с другими методами микроскопии Световой микроскопией РЭМ - большими разрешающей способностью и глубиной резкости РЭМ - относительной легкостью в интерпретации полученных изображений РЭМ - возможностью подключения дополнительных приборов для анализа в микродиапазоне при достаточной простоте в адаптации и управлении этими приборами Сканирующей зондовой микроскопии РЭМ - позволяет исследовать существенно большие участки поверхности; РЭМ - работать с сильно рельефными поверхностями; РЭМ - использовать значительно более широкий диапазон увеличений; РЭМ - получать информацию не только о поверхности, но и о прилегающих к поверхности «подповерхностных» слоях Просвечивающей электронной микроскопии РЭМ - использует не большие ускоряющие напряжения РЭМ - не приводит к нагреву образца вплоть до разрушения и испарения РЭМ - возможно использовать образцы различной толщины
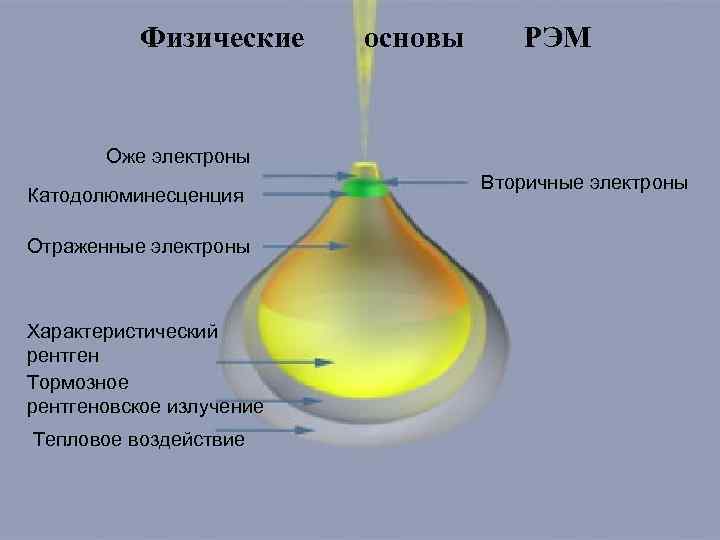 Физические основы РЭМ Оже электроны Катодолюминесценция Отраженные электроны Характеристический рентген Тормозное рентгеновское излучение Тепловое воздействие Вторичные электроны
Физические основы РЭМ Оже электроны Катодолюминесценция Отраженные электроны Характеристический рентген Тормозное рентгеновское излучение Тепловое воздействие Вторичные электроны
 Какие электроны наиболее часто используются при детектировании? ü вторичные электроны - SE ü обратно рассеянные (отраженные) электроны - BSE ü рентгеновские лучи - X-rays Вопрос о локальности метода или о размере груши ? Локальность рентгеноспектрального микроанализа обычных образцов составляет 1. . . 5 мкм. Зависит от свойств исследуемых образцов и параметров РЭМ. ОГРАНИЧЕНИЕ МЕТОДА РЭМ - при уменьшении глубины зоны возбуждения уменьшается объем материала, излучающего характеристическое рентгеновское излучение. Т. е. ослабевает полезный сигнал.
Какие электроны наиболее часто используются при детектировании? ü вторичные электроны - SE ü обратно рассеянные (отраженные) электроны - BSE ü рентгеновские лучи - X-rays Вопрос о локальности метода или о размере груши ? Локальность рентгеноспектрального микроанализа обычных образцов составляет 1. . . 5 мкм. Зависит от свойств исследуемых образцов и параметров РЭМ. ОГРАНИЧЕНИЕ МЕТОДА РЭМ - при уменьшении глубины зоны возбуждения уменьшается объем материала, излучающего характеристическое рентгеновское излучение. Т. е. ослабевает полезный сигнал.
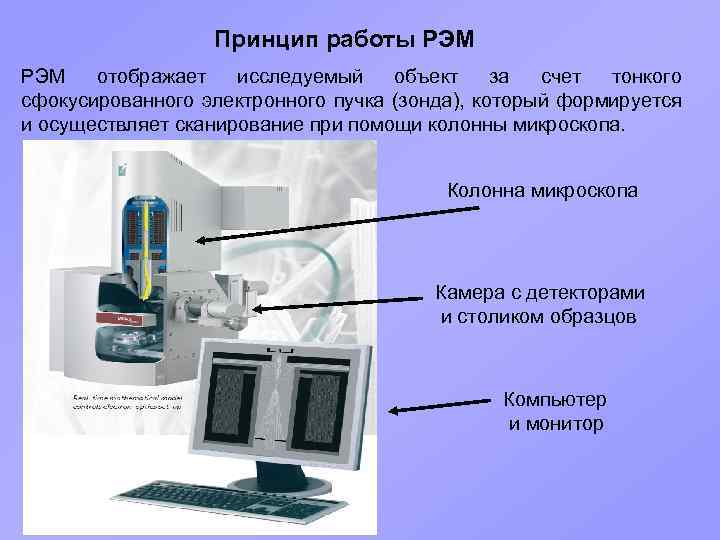 Принцип работы РЭМ отображает исследуемый объект за счет тонкого сфокусированного электронного пучка (зонда), который формируется и осуществляет сканирование при помощи колонны микроскопа. Колонна микроскопа Камера с детекторами и столиком образцов Компьютер и монитор
Принцип работы РЭМ отображает исследуемый объект за счет тонкого сфокусированного электронного пучка (зонда), который формируется и осуществляет сканирование при помощи колонны микроскопа. Колонна микроскопа Камера с детекторами и столиком образцов Компьютер и монитор
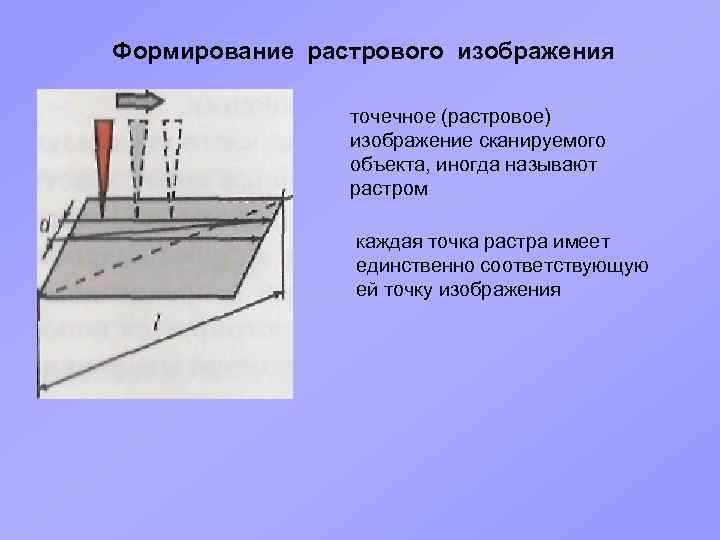 Формирование растрового изображения точечное (растровое) изображение сканируемого объекта, иногда называют растром каждая точка растра имеет единственно соответствующую ей точку изображения
Формирование растрового изображения точечное (растровое) изображение сканируемого объекта, иногда называют растром каждая точка растра имеет единственно соответствующую ей точку изображения
 Что такое увеличение и разрешение для РЭМ? во всех современных электронных микроскопах на полученных изображениях автоматически выводится масштабная линейка, что дает возможность оценить размеры структурных элементов, не задумываясь об увеличении. ОГРАНИЧЕНИЕ МЕТОДА РЭМ - дискретное представление изображения приводит к его искажениям, особенно заметным при работе с объектами, размеры которых близки к разрешающей способности микроскопа.
Что такое увеличение и разрешение для РЭМ? во всех современных электронных микроскопах на полученных изображениях автоматически выводится масштабная линейка, что дает возможность оценить размеры структурных элементов, не задумываясь об увеличении. ОГРАНИЧЕНИЕ МЕТОДА РЭМ - дискретное представление изображения приводит к его искажениям, особенно заметным при работе с объектами, размеры которых близки к разрешающей способности микроскопа.
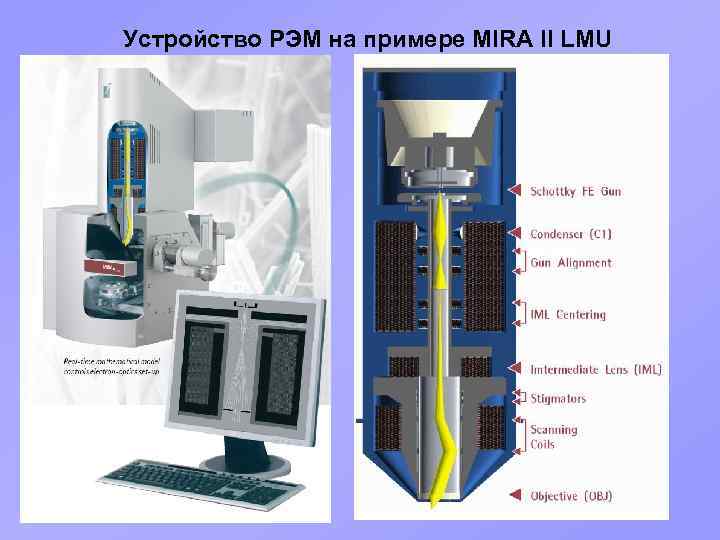 Устройство РЭМ на примере MIRA II LMU
Устройство РЭМ на примере MIRA II LMU
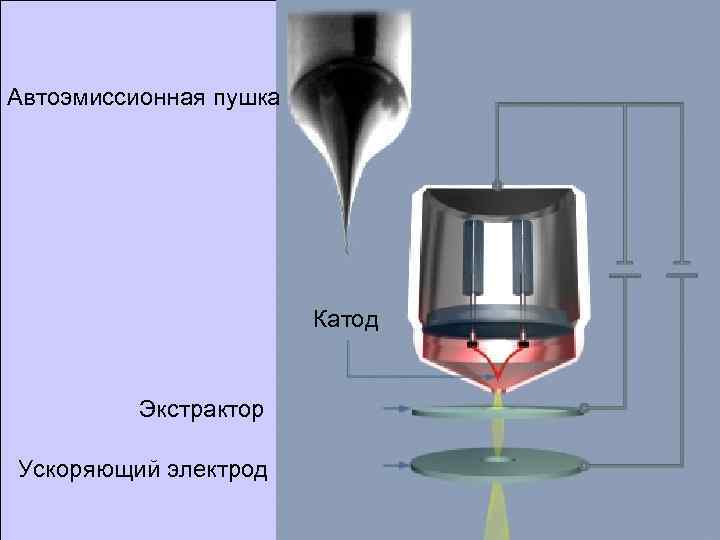 Автоэмиccионная пушка Катод Экстрактор Ускоряющий электрод
Автоэмиccионная пушка Катод Экстрактор Ускоряющий электрод
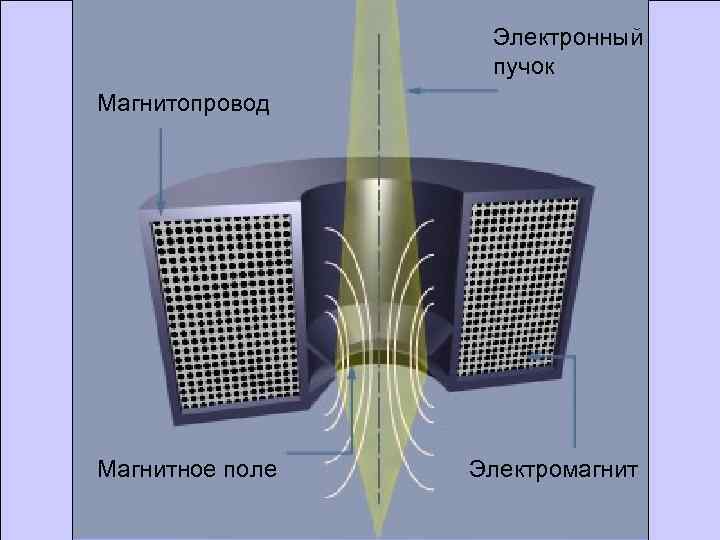 Электронный пучок Магнитопровод Магнитное поле Электромагнит
Электронный пучок Магнитопровод Магнитное поле Электромагнит
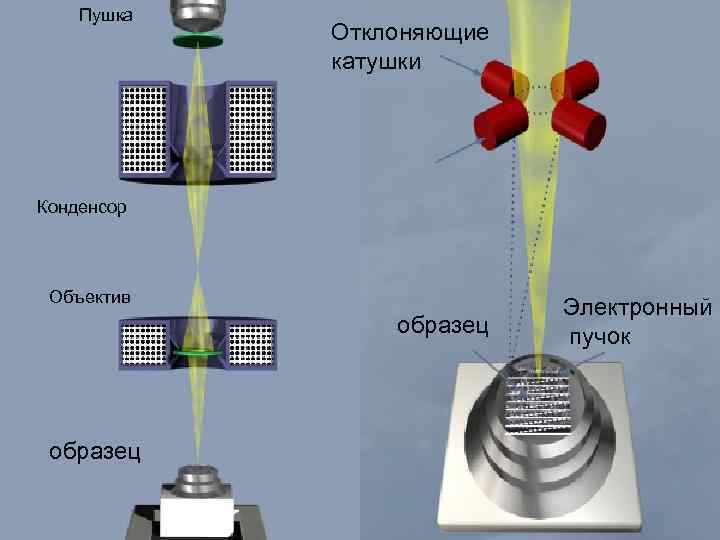 Пушка Отклоняющие катушки Конденсор Объектив образец Электронный пучок
Пушка Отклоняющие катушки Конденсор Объектив образец Электронный пучок
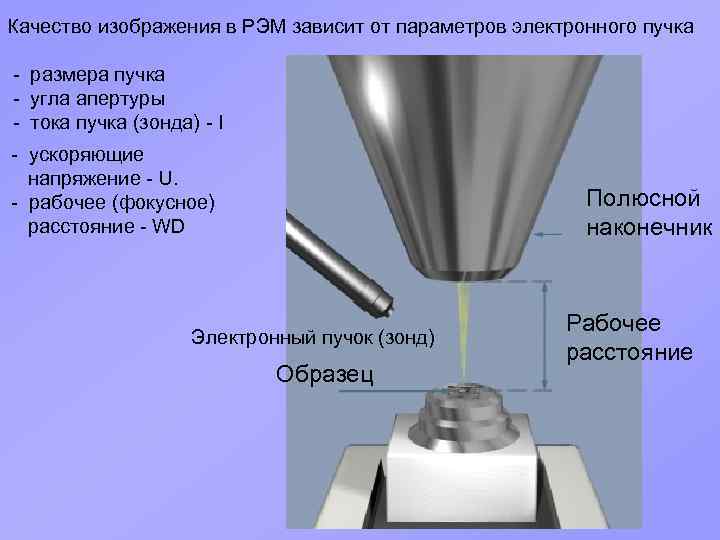 Качество изображения в РЭМ зависит от параметров электронного пучка - размера пучка - угла апертуры - тока пучка (зонда) - I - ускоряющие напряжение - U. - рабочее (фокусное) расстояние - WD Полюсной наконечник Электронный пучок (зонд) Образец Рабочее расстояние
Качество изображения в РЭМ зависит от параметров электронного пучка - размера пучка - угла апертуры - тока пучка (зонда) - I - ускоряющие напряжение - U. - рабочее (фокусное) расстояние - WD Полюсной наконечник Электронный пучок (зонд) Образец Рабочее расстояние
 Основный детекторы растрового электронного микроскопа на примере MIRA II LMU. - детектор вторичных (отраженных) электронов, или SE детектор (для MIRA II LMU –SE – типа Эверхардта-Торнлей, SE детектор, встроенный в полюсный наконечник колонны, SE для низкого вакуума) - детектор обратно рассеянных (обратно отраженных) электронов, или BSE детектор - детектор на кадолюминесценцию - детектор на просвет, или TE детектор (с режимами изображения в светлом и темном поле) - с системами энергодисперсионного микроанализа (INCA Energy ) - системой регистрации дифракции отраженных электронов В качестве добавочных детекторов: - датчик касания образцом частей камеры микроскопа (для защиты образца и детекторов) - ИК-камера обзора камеры образцов с возможностью цифрового увеличения.
Основный детекторы растрового электронного микроскопа на примере MIRA II LMU. - детектор вторичных (отраженных) электронов, или SE детектор (для MIRA II LMU –SE – типа Эверхардта-Торнлей, SE детектор, встроенный в полюсный наконечник колонны, SE для низкого вакуума) - детектор обратно рассеянных (обратно отраженных) электронов, или BSE детектор - детектор на кадолюминесценцию - детектор на просвет, или TE детектор (с режимами изображения в светлом и темном поле) - с системами энергодисперсионного микроанализа (INCA Energy ) - системой регистрации дифракции отраженных электронов В качестве добавочных детекторов: - датчик касания образцом частей камеры микроскопа (для защиты образца и детекторов) - ИК-камера обзора камеры образцов с возможностью цифрового увеличения.
 Детектор отраженных электронов ЭДС детектор Детектор вторичных электронов Зона взаимодействия электронов с материалом
Детектор отраженных электронов ЭДС детектор Детектор вторичных электронов Зона взаимодействия электронов с материалом
 Структурный анализ по дифракции отраженных электронов камера Экран
Структурный анализ по дифракции отраженных электронов камера Экран



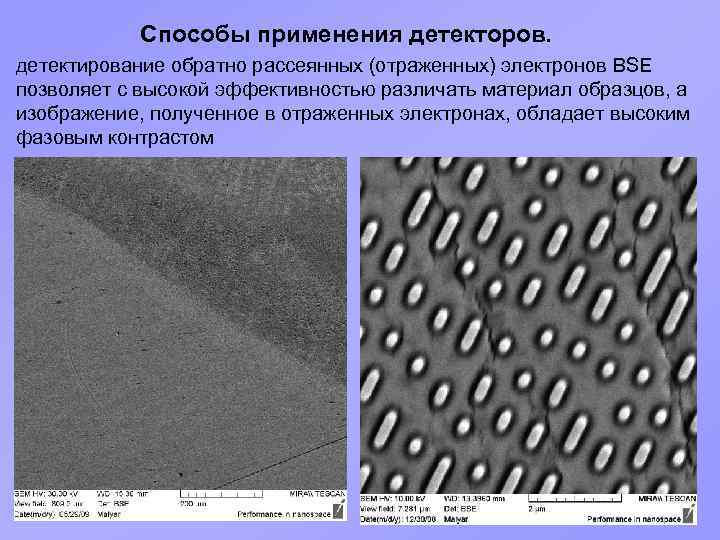 Способы применения детекторов. детектирование обратно рассеянных (отраженных) электронов BSE позволяет с высокой эффективностью различать материал образцов, а изображение, полученное в отраженных электронах, обладает высоким фазовым контрастом
Способы применения детекторов. детектирование обратно рассеянных (отраженных) электронов BSE позволяет с высокой эффективностью различать материал образцов, а изображение, полученное в отраженных электронах, обладает высоким фазовым контрастом
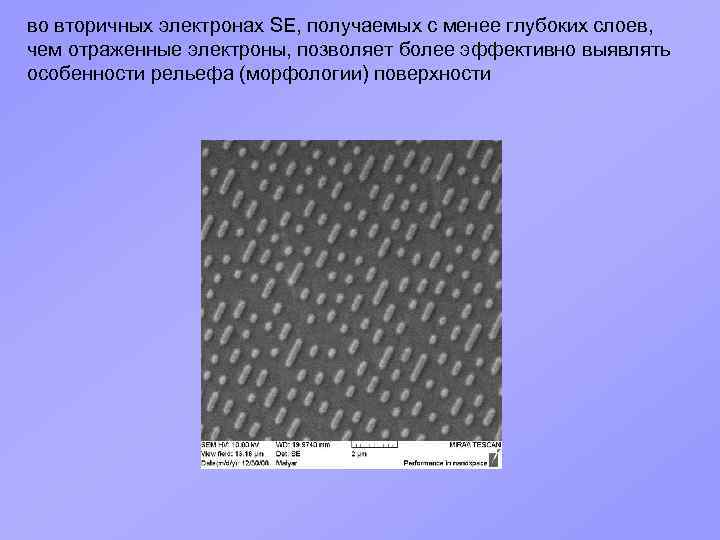 во вторичных электронах SE, получаемых с менее глубоких слоев, чем отраженные электроны, позволяет более эффективно выявлять особенности рельефа (морфологии) поверхности
во вторичных электронах SE, получаемых с менее глубоких слоев, чем отраженные электроны, позволяет более эффективно выявлять особенности рельефа (морфологии) поверхности
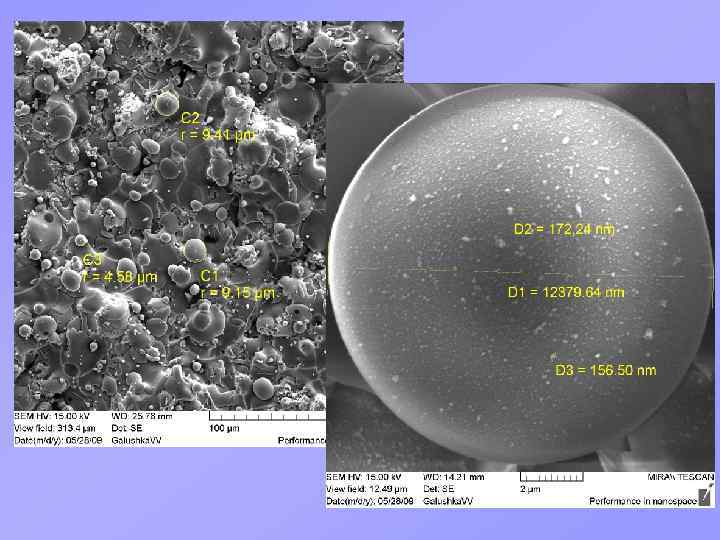
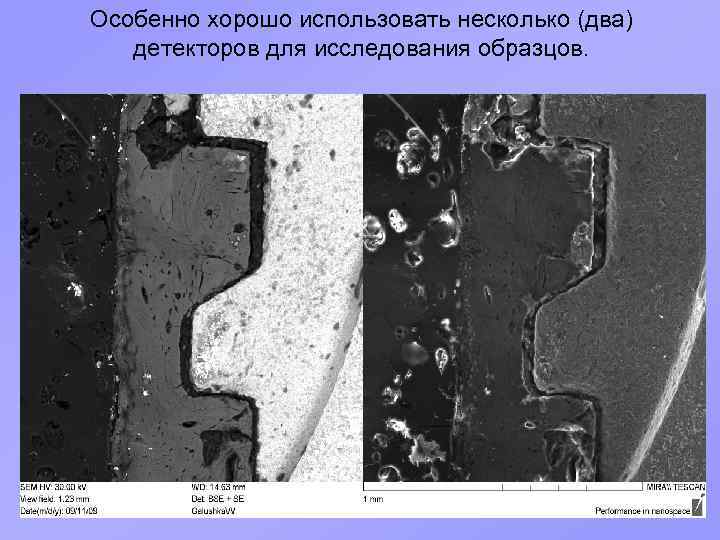 Особенно хорошо использовать несколько (два) детекторов для исследования образцов.
Особенно хорошо использовать несколько (два) детекторов для исследования образцов.
 Благодарим за внимание
Благодарим за внимание


