STM-AFM.ppt
- Количество слайдов: 81
 Исследование наноматериалов методами сканирующей зондовой микроскопии
Исследование наноматериалов методами сканирующей зондовой микроскопии
 2 Увеличение Рабочая среда Размерность изображения Повреждение образца Оптическая микроскопия 103 воздух, жидкость 2 D нет Лазерная конфокальная микроскопия 104 воздух 2 D/3 D минимальное Ионный микроскоп 105 вакуум 2 D сильное Сканирующая электронная микроскопия 106 вакуум 2 D слабое воздух, жидкость, вакуум 3 D минимальное или нет Методика Сканирующая зондовая микроскопия 10 8 Сравнительные характеристики
2 Увеличение Рабочая среда Размерность изображения Повреждение образца Оптическая микроскопия 103 воздух, жидкость 2 D нет Лазерная конфокальная микроскопия 104 воздух 2 D/3 D минимальное Ионный микроскоп 105 вакуум 2 D сильное Сканирующая электронная микроскопия 106 вакуум 2 D слабое воздух, жидкость, вакуум 3 D минимальное или нет Методика Сканирующая зондовая микроскопия 10 8 Сравнительные характеристики
 Классификация методов СЗМ Сканирующая зондовая микроскопия (СЗМ) Сканирующая туннельная микроскопия Сканирующая оптическая микроскопия ближнего поля Сканирующая силовая микроскопия Контактная атомно-силовая микроскопия Бесконтактная атомно-силовая микроскопия Микроскопия латеральных сил Магнитная силовая микроскопия Микроскопия модуляции силы Электрическая силовая микроскопия Силовая микроскопия пьезоотклика Сканирующая емкостная микроскопия Микроскопия зонда Кельвина Исследование наноматериалов методами сканирующей зондовой микроскопии 3
Классификация методов СЗМ Сканирующая зондовая микроскопия (СЗМ) Сканирующая туннельная микроскопия Сканирующая оптическая микроскопия ближнего поля Сканирующая силовая микроскопия Контактная атомно-силовая микроскопия Бесконтактная атомно-силовая микроскопия Микроскопия латеральных сил Магнитная силовая микроскопия Микроскопия модуляции силы Электрическая силовая микроскопия Силовая микроскопия пьезоотклика Сканирующая емкостная микроскопия Микроскопия зонда Кельвина Исследование наноматериалов методами сканирующей зондовой микроскопии 3
 4 Краткая история 1981 год – изобретение сканирующего туннельного микроскопа (СТМ) 1986 год – изобретение атомно-силового микроскопа (АСМ) 1986 год – Нобелевская премия по физике за создание СТМ 1990 год – создание промышленной технологии производства кантилеверов Heinrich Rohrer 1990 год – начало развития второго поколения зондовых микроскопов Gerd Binnig Исследование наноматериалов методами сканирующей зондовой микроскопии
4 Краткая история 1981 год – изобретение сканирующего туннельного микроскопа (СТМ) 1986 год – изобретение атомно-силового микроскопа (АСМ) 1986 год – Нобелевская премия по физике за создание СТМ 1990 год – создание промышленной технологии производства кантилеверов Heinrich Rohrer 1990 год – начало развития второго поколения зондовых микроскопов Gerd Binnig Исследование наноматериалов методами сканирующей зондовой микроскопии
 Физические основы сканирующей туннельной микроскопии туннельный ток чувствителен к: - зазору ΔZ между зондом и образцом (топография) - локальному потенциалу V - «локальной» работе выхода φ - локальной плотности электронных состояний ρ(ε) (спектроскопия)
Физические основы сканирующей туннельной микроскопии туннельный ток чувствителен к: - зазору ΔZ между зондом и образцом (топография) - локальному потенциалу V - «локальной» работе выхода φ - локальной плотности электронных состояний ρ(ε) (спектроскопия)
 Пространственное и энергетическое разрешение СТМ пространственное разрешение L достигает атомного масштаба при Rp ~ 1 nm φ ~ 4 e. V. энергетическое разрешение определяется размытием уровня Ферми зонда ~ k. T
Пространственное и энергетическое разрешение СТМ пространственное разрешение L достигает атомного масштаба при Rp ~ 1 nm φ ~ 4 e. V. энергетическое разрешение определяется размытием уровня Ферми зонда ~ k. T
 Изготовление зонда из W проволоки методом электрохимического травления Изготовление СТМ зондов ð электрохимическое травление вольфрамовой проволоки ð перерезание тонкой проволоки из Pt. Ir сплава
Изготовление зонда из W проволоки методом электрохимического травления Изготовление СТМ зондов ð электрохимическое травление вольфрамовой проволоки ð перерезание тонкой проволоки из Pt. Ir сплава
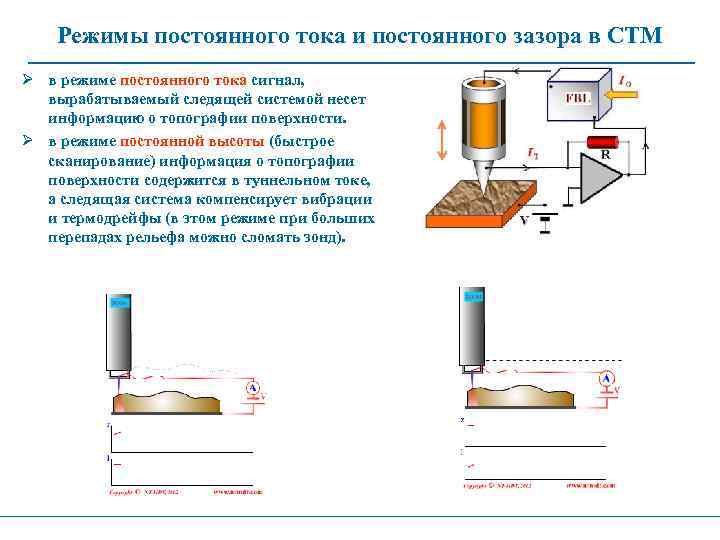 Режимы постоянного тока и постоянного зазора в СТМ в режиме постоянного тока сигнал, вырабатываемый следящей системой несет информацию о топографии поверхности. в режиме постоянной высоты (быстрое сканирование) информация о топографии поверхности содержится в туннельном токе, а следящая система компенсирует вибрации и термодрейфы (в этом режиме при больших перепадах рельефа можно сломать зонд).
Режимы постоянного тока и постоянного зазора в СТМ в режиме постоянного тока сигнал, вырабатываемый следящей системой несет информацию о топографии поверхности. в режиме постоянной высоты (быстрое сканирование) информация о топографии поверхности содержится в туннельном токе, а следящая система компенсирует вибрации и термодрейфы (в этом режиме при больших перепадах рельефа можно сломать зонд).
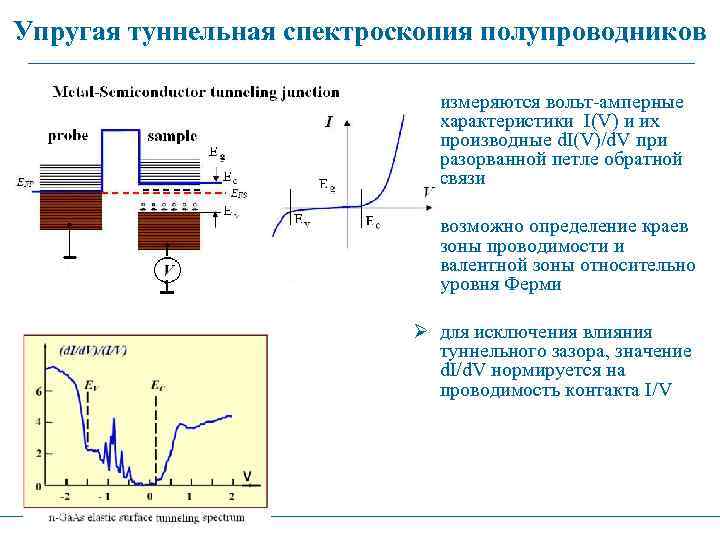 Упругая туннельная спектроскопия полупроводников измеряются вольт-амперные характеристики I(V) и их производные d. I(V)/d. V при разорванной петле обратной связи возможно определение краев зоны проводимости и валентной зоны относительно уровня Ферми для исключения влияния туннельного зазора, значение d. I/d. V нормируется на проводимость контакта I/V
Упругая туннельная спектроскопия полупроводников измеряются вольт-амперные характеристики I(V) и их производные d. I(V)/d. V при разорванной петле обратной связи возможно определение краев зоны проводимости и валентной зоны относительно уровня Ферми для исключения влияния туннельного зазора, значение d. I/d. V нормируется на проводимость контакта I/V
 Упругая туннельная спектроскопия сверхпроводников измеряются вольт-амперные характеристики I(V) и их производные d. I(V)/d. V при разорванной петле обратной связи можно измерить энергетическую щель в плотности электронных состояний сверхпроводника и ее пространственное распределение по поверхности образца
Упругая туннельная спектроскопия сверхпроводников измеряются вольт-амперные характеристики I(V) и их производные d. I(V)/d. V при разорванной петле обратной связи можно измерить энергетическую щель в плотности электронных состояний сверхпроводника и ее пространственное распределение по поверхности образца
 Неупругая электронная туннельная спектроскопия если энергия туннелирующих электронов e. V больше чем энергия ћω возбуждений, существующих в туннельном контакте, то открывается дополнительный неупругий канал туннелирования, изменяющий общий ток через контакт. можно измерить молекулярные спектры (аналог ИК спектров), энергию фононов, плазмонов и т. п.
Неупругая электронная туннельная спектроскопия если энергия туннелирующих электронов e. V больше чем энергия ћω возбуждений, существующих в туннельном контакте, то открывается дополнительный неупругий канал туннелирования, изменяющий общий ток через контакт. можно измерить молекулярные спектры (аналог ИК спектров), энергию фононов, плазмонов и т. п.
 Эффекты одноэлектронного туннелирования в локальных туннельных контактах в области между зондом и образцом локализована малая проводящая частица с малой емкостью туннелирующий электрон, попав на эту частицу, создает Куллоновскую блокаду для следующих за ним электронов, туннелирование электронов прекращается до тех пор, пока внешнее напряжение не снимет блокаду в результате на вольт-амперной характеристике появляются ступеньки ( пики на первой производной), количество ступенек коррелирует с количеством электронов, захваченных частицей.
Эффекты одноэлектронного туннелирования в локальных туннельных контактах в области между зондом и образцом локализована малая проводящая частица с малой емкостью туннелирующий электрон, попав на эту частицу, создает Куллоновскую блокаду для следующих за ним электронов, туннелирование электронов прекращается до тех пор, пока внешнее напряжение не снимет блокаду в результате на вольт-амперной характеристике появляются ступеньки ( пики на первой производной), количество ступенек коррелирует с количеством электронов, захваченных частицей.
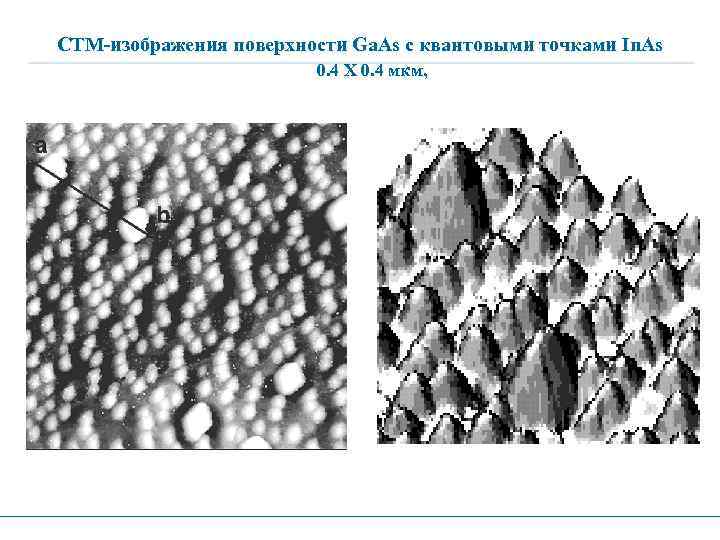 СТМ-изображения поверхности Ga. As с квантовыми точками In. As 0. 4 Х 0. 4 мкм,
СТМ-изображения поверхности Ga. As с квантовыми точками In. As 0. 4 Х 0. 4 мкм,
 STM Topographic Image of Si (100) Temperature: 63 K Field of View: 3 nm x 3 nm Dr. YOKOYAMA in Yokohama city Univ.
STM Topographic Image of Si (100) Temperature: 63 K Field of View: 3 nm x 3 nm Dr. YOKOYAMA in Yokohama city Univ.
 STM Topographic Image of Si (111 ) Tempetature: 4. 2 K Bias voltage: 0. 84 V Tunnel current: 1. 04 n. A Field of veiw: 10 nm x 10 nm Yutaka Miyatake Unisoku Co. , Ltd.
STM Topographic Image of Si (111 ) Tempetature: 4. 2 K Bias voltage: 0. 84 V Tunnel current: 1. 04 n. A Field of veiw: 10 nm x 10 nm Yutaka Miyatake Unisoku Co. , Ltd.
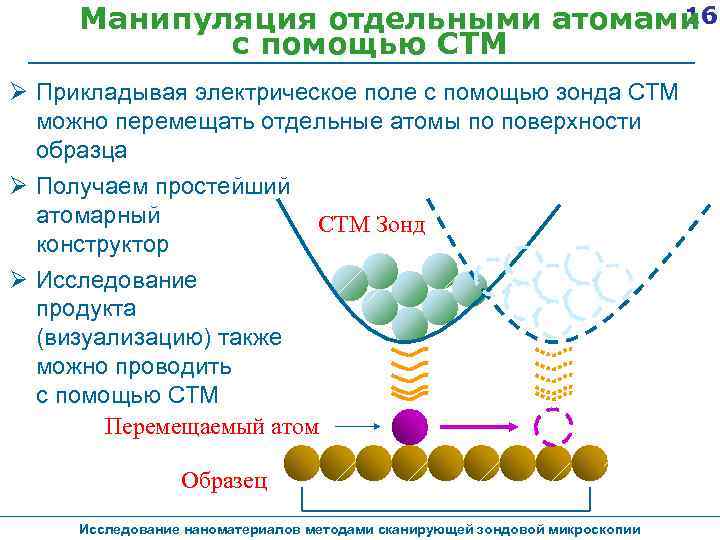 16 Манипуляция отдельными атомами с помощью СТМ Прикладывая электрическое поле с помощью зонда СТМ можно перемещать отдельные атомы по поверхности образца Получаем простейший атомарный СТМ Зонд конструктор Исследование продукта (визуализацию) также можно проводить с помощью СТМ Перемещаемый атом Образец Исследование наноматериалов методами сканирующей зондовой микроскопии
16 Манипуляция отдельными атомами с помощью СТМ Прикладывая электрическое поле с помощью зонда СТМ можно перемещать отдельные атомы по поверхности образца Получаем простейший атомарный СТМ Зонд конструктор Исследование продукта (визуализацию) также можно проводить с помощью СТМ Перемещаемый атом Образец Исследование наноматериалов методами сканирующей зондовой микроскопии
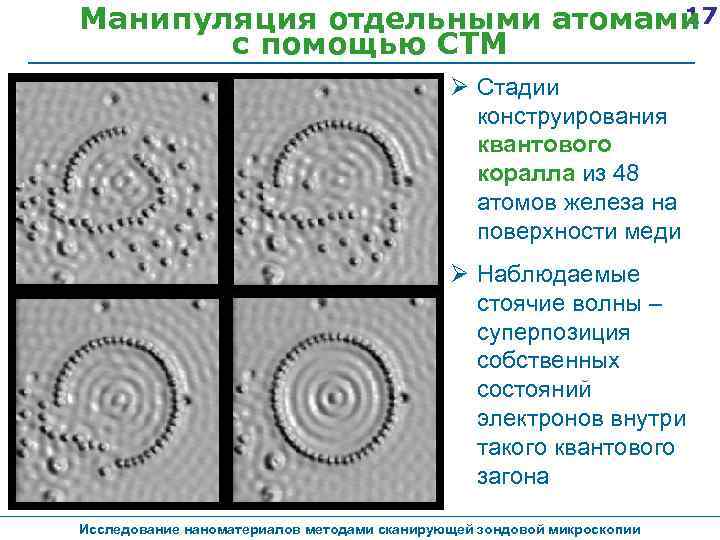 17 Манипуляция отдельными атомами с помощью СТМ Стадии конструирования квантового коралла из 48 атомов железа на поверхности меди Наблюдаемые стоячие волны – суперпозиция собственных состояний электронов внутри такого квантового загона Исследование наноматериалов методами сканирующей зондовой микроскопии
17 Манипуляция отдельными атомами с помощью СТМ Стадии конструирования квантового коралла из 48 атомов железа на поверхности меди Наблюдаемые стоячие волны – суперпозиция собственных состояний электронов внутри такого квантового загона Исследование наноматериалов методами сканирующей зондовой микроскопии
 18 Манипуляция отдельными атомами с помощью СТМ Еще квантовые кораллы… Исследование наноматериалов методами сканирующей зондовой микроскопии
18 Манипуляция отдельными атомами с помощью СТМ Еще квантовые кораллы… Исследование наноматериалов методами сканирующей зондовой микроскопии
 Принцип действия АСМ Межатомное взаимодействие (силы Ван-дер-Ваальса) Потенциал Леннарда-Джонса ð на больших расстояниях зонд испытывает притяжение со стороны образца бесконтактная АСМ ð на малых расстояниях – отталкивание контактная АСМ ULD(r) = –a/rm + b/rn Регистрация сил межатомного взаимодействия между концом зонда и поверхностью образца D=– F/k закон Гука связывает изгиб кантилевера D, силу взаимодействия F и упругость кантилевера k Исследование наноматериалов методами сканирующей зондовой микроскопии 19
Принцип действия АСМ Межатомное взаимодействие (силы Ван-дер-Ваальса) Потенциал Леннарда-Джонса ð на больших расстояниях зонд испытывает притяжение со стороны образца бесконтактная АСМ ð на малых расстояниях – отталкивание контактная АСМ ULD(r) = –a/rm + b/rn Регистрация сил межатомного взаимодействия между концом зонда и поверхностью образца D=– F/k закон Гука связывает изгиб кантилевера D, силу взаимодействия F и упругость кантилевера k Исследование наноматериалов методами сканирующей зондовой микроскопии 19
 Принципы работы СЗМ Исследование рельефа поверхности и ее локальных свойств проводится с помощью специальных зондов – игл с радиусом закругления ~ 10 нм Характерное расстояние между зондом и поверхностью ~ 0, 1 ÷ 10 нм Расстояние между зондом и образцом контролирует система обратной связи Исследование наноматериалов методами сканирующей зондовой микроскопии 20
Принципы работы СЗМ Исследование рельефа поверхности и ее локальных свойств проводится с помощью специальных зондов – игл с радиусом закругления ~ 10 нм Характерное расстояние между зондом и поверхностью ~ 0, 1 ÷ 10 нм Расстояние между зондом и образцом контролирует система обратной связи Исследование наноматериалов методами сканирующей зондовой микроскопии 20
 Принципы работы СЗМ 21 Система обратной связи (ОС) ð контролирует расстояние между зондом и образцом, используя параметр взаимодействия зонда и образца с взаимно однозначной зависимостью от расстояния Р(z) ð ОС поддерживает P постоянным P = P 0, изменяя напряжение на z-сканере Сигнал на Z-сканере пропорционален рельефу поверхности Точность удержания расстояния зонд-поверхность ~ 0, 01 Å Исследование наноматериалов методами сканирующей зондовой микроскопии
Принципы работы СЗМ 21 Система обратной связи (ОС) ð контролирует расстояние между зондом и образцом, используя параметр взаимодействия зонда и образца с взаимно однозначной зависимостью от расстояния Р(z) ð ОС поддерживает P постоянным P = P 0, изменяя напряжение на z-сканере Сигнал на Z-сканере пропорционален рельефу поверхности Точность удержания расстояния зонд-поверхность ~ 0, 01 Å Исследование наноматериалов методами сканирующей зондовой микроскопии
 Принципы работы СЗМ 22 Формирование СЗМ изображения ð сканирование в плоскости X, Y позволяет получить СЗМ изображение поверхности ð сканирующие элементы изготавливаются из пьезоэлектриков, которые изменяют свои размеры во внешнем электрическом поле Одновременно с рельефом можно получать распределения различных свойств поверхности ð ð механических электрических магнитных оптических Исследование наноматериалов методами сканирующей зондовой микроскопии
Принципы работы СЗМ 22 Формирование СЗМ изображения ð сканирование в плоскости X, Y позволяет получить СЗМ изображение поверхности ð сканирующие элементы изготавливаются из пьезоэлектриков, которые изменяют свои размеры во внешнем электрическом поле Одновременно с рельефом можно получать распределения различных свойств поверхности ð ð механических электрических магнитных оптических Исследование наноматериалов методами сканирующей зондовой микроскопии
 Зондовые датчики АСМ Зондовый датчик - упругий кантилевер (консоль) с острым зондом на конце ðсила, действующая на зонд со стороны поверхности, приводит к изгибу кантилевера ðрегистрация величины изгиба ðконтроль силы взаимодействия зонда с поверхностью Изготовление методами фотолитографии и травления из пластин кремния ðкантилевер формируется из тонких слоев Si, Si. O 2 или Si 3 N 4 ðодин конец жестко закреплен на кремниевом держателе ðна другом конце зонд Исследование наноматериалов методами сканирующей зондовой микроскопии 23
Зондовые датчики АСМ Зондовый датчик - упругий кантилевер (консоль) с острым зондом на конце ðсила, действующая на зонд со стороны поверхности, приводит к изгибу кантилевера ðрегистрация величины изгиба ðконтроль силы взаимодействия зонда с поверхностью Изготовление методами фотолитографии и травления из пластин кремния ðкантилевер формируется из тонких слоев Si, Si. O 2 или Si 3 N 4 ðодин конец жестко закреплен на кремниевом держателе ðна другом конце зонд Исследование наноматериалов методами сканирующей зондовой микроскопии 23
 Зондовые датчики АСМ Геометрические параметры зонда ð радиус закругления ð угол при вершине зонда 1 ÷ 50 нм 10 ÷ 20º Резонансная частота кантилеверов ð контактные ð бесконтакные 7÷ 28 к. Гц 90÷ 630 к. Гц Сила взаимодействия зонда с поверхностью F = k ⋅ ΔZ ΔZ – характеризует изгиб кантилевера k = 10 -3÷ 10 Н/м коэффициент жесткости кантилевера Проводящие покрытия для электрических измерений Au, Pt, Cr, W, Mo, Ti, W 2 C Ферромагнитные покрытия для магнитных измерений Co, Fe, Co. Cr, Fe. Cr, Co. Pt Исследование наноматериалов методами сканирующей зондовой микроскопии 24
Зондовые датчики АСМ Геометрические параметры зонда ð радиус закругления ð угол при вершине зонда 1 ÷ 50 нм 10 ÷ 20º Резонансная частота кантилеверов ð контактные ð бесконтакные 7÷ 28 к. Гц 90÷ 630 к. Гц Сила взаимодействия зонда с поверхностью F = k ⋅ ΔZ ΔZ – характеризует изгиб кантилевера k = 10 -3÷ 10 Н/м коэффициент жесткости кантилевера Проводящие покрытия для электрических измерений Au, Pt, Cr, W, Mo, Ti, W 2 C Ферромагнитные покрытия для магнитных измерений Co, Fe, Co. Cr, Fe. Cr, Co. Pt Исследование наноматериалов методами сканирующей зондовой микроскопии 24
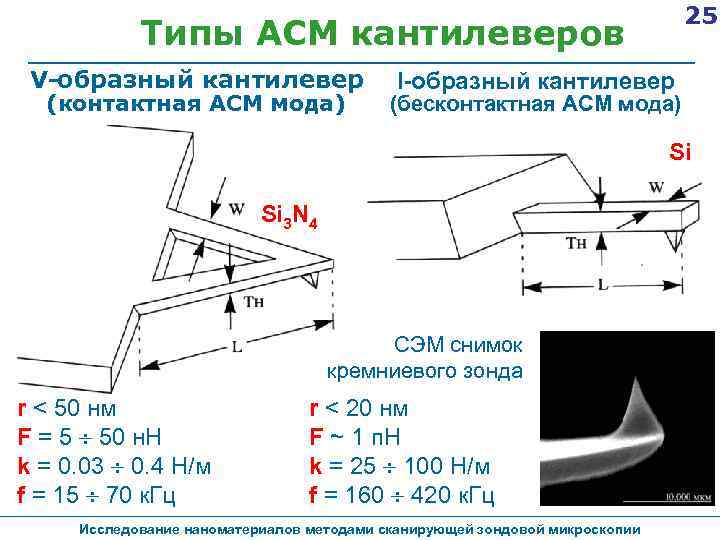 25 Типы АСМ кантилеверов V-образный кантилевер (контактная АСМ мода) I-образный кантилевер (бесконтактная АСМ мода) Si Si 3 N 4 СЭМ снимок кремниевого зонда r < 50 нм F = 5 50 н. Н k = 0. 03 0. 4 Н/м f = 15 70 к. Гц r < 20 нм F ~ 1 п. Н k = 25 100 Н/м f = 160 420 к. Гц Исследование наноматериалов методами сканирующей зондовой микроскопии
25 Типы АСМ кантилеверов V-образный кантилевер (контактная АСМ мода) I-образный кантилевер (бесконтактная АСМ мода) Si Si 3 N 4 СЭМ снимок кремниевого зонда r < 50 нм F = 5 50 н. Н k = 0. 03 0. 4 Н/м f = 15 70 к. Гц r < 20 нм F ~ 1 п. Н k = 25 100 Н/м f = 160 420 к. Гц Исследование наноматериалов методами сканирующей зондовой микроскопии
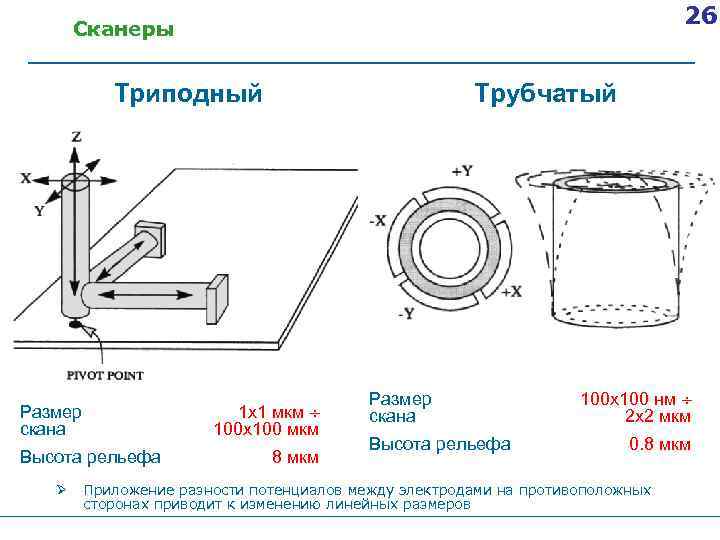 26 Сканеры Триподный 1 х1 мкм 100 х100 мкм Размер скана Высота рельефа Трубчатый 8 мкм Размер скана Высота рельефа 100 х100 нм 2 х2 мкм 0. 8 мкм Приложение разности потенциалов между электродами на противоположных сторонах приводит к изменению линейных размеров
26 Сканеры Триподный 1 х1 мкм 100 х100 мкм Размер скана Высота рельефа Трубчатый 8 мкм Размер скана Высота рельефа 100 х100 нм 2 х2 мкм 0. 8 мкм Приложение разности потенциалов между электродами на противоположных сторонах приводит к изменению линейных размеров
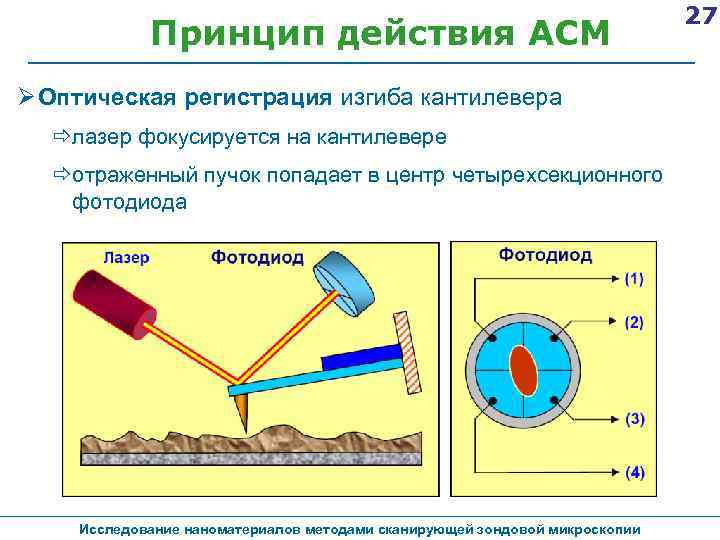 Принцип действия АСМ Оптическая регистрация изгиба кантилевера ðлазер фокусируется на кантилевере ðотраженный пучок попадает в центр четырехсекционного фотодиода Исследование наноматериалов методами сканирующей зондовой микроскопии 27
Принцип действия АСМ Оптическая регистрация изгиба кантилевера ðлазер фокусируется на кантилевере ðотраженный пучок попадает в центр четырехсекционного фотодиода Исследование наноматериалов методами сканирующей зондовой микроскопии 27
 Система обратной связи АСМ Система ОС обеспечивает ΔIz=const Z-сканер поддерживает изгиб кантилевера ΔZ = ΔZ 0, задаваемый оператором Напряжение на Z-сканере пропорционально рельефу поверхности Исследование наноматериалов методами сканирующей зондовой микроскопии 28
Система обратной связи АСМ Система ОС обеспечивает ΔIz=const Z-сканер поддерживает изгиб кантилевера ΔZ = ΔZ 0, задаваемый оператором Напряжение на Z-сканере пропорционально рельефу поверхности Исследование наноматериалов методами сканирующей зондовой микроскопии 28
 Роль обратной связи в АСМ Verr=V-VS VS VC=VP+VI+VD Пропорциональная компонента VP отвечает за отклик на резкие изменения сигнала ошибки Verr Интегральная компонента VI – низкочастотный отклик: крупные детали рельефа, общий наклон Дифференциальная компонента VD – стабилизация, гашение нежелательных осцилляций Исследование наноматериалов методами сканирующей зондовой микроскопии 29
Роль обратной связи в АСМ Verr=V-VS VS VC=VP+VI+VD Пропорциональная компонента VP отвечает за отклик на резкие изменения сигнала ошибки Verr Интегральная компонента VI – низкочастотный отклик: крупные детали рельефа, общий наклон Дифференциальная компонента VD – стабилизация, гашение нежелательных осцилляций Исследование наноматериалов методами сканирующей зондовой микроскопии 29
 Работа обратной связи АСМ Изменение сигнала ошибки и напряжения на Zсканере при измерении ступеньки рельефа Медленная ОС Быстрая ОС Исследование наноматериалов методами сканирующей зондовой микроскопии 30
Работа обратной связи АСМ Изменение сигнала ошибки и напряжения на Zсканере при измерении ступеньки рельефа Медленная ОС Быстрая ОС Исследование наноматериалов методами сканирующей зондовой микроскопии 30
 31 Оптический силовой сенсор АСМ Параметры, регистрируемые оптической системой ð изгиб кантилевера под действием Z-компонент сил притяжения или отталкивания (Fz) ΔIz=(ΔI 1+ΔI 2)−(ΔI 3+ΔI 4) ð кручение кантилевера под действием латеральных компонент сил (FL) ΔIL=(ΔI 1+ΔI 4)−(ΔI 2+ΔI 3) Исследование наноматериалов методами сканирующей зондовой микроскопии
31 Оптический силовой сенсор АСМ Параметры, регистрируемые оптической системой ð изгиб кантилевера под действием Z-компонент сил притяжения или отталкивания (Fz) ΔIz=(ΔI 1+ΔI 2)−(ΔI 3+ΔI 4) ð кручение кантилевера под действием латеральных компонент сил (FL) ΔIL=(ΔI 1+ΔI 4)−(ΔI 2+ΔI 3) Исследование наноматериалов методами сканирующей зондовой микроскопии
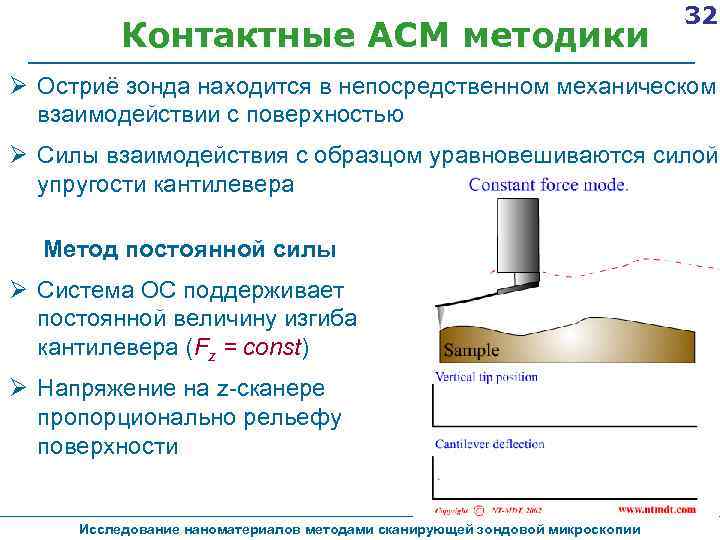 Контактные АСМ методики 32 Остриё зонда находится в непосредственном механическом взаимодействии с поверхностью Силы взаимодействия с образцом уравновешиваются силой упругости кантилевера Метод постоянной силы Система ОС поддерживает постоянной величину изгиба кантилевера (Fz = const) Напряжение на z-сканере пропорционально рельефу поверхности Исследование наноматериалов методами сканирующей зондовой микроскопии
Контактные АСМ методики 32 Остриё зонда находится в непосредственном механическом взаимодействии с поверхностью Силы взаимодействия с образцом уравновешиваются силой упругости кантилевера Метод постоянной силы Система ОС поддерживает постоянной величину изгиба кантилевера (Fz = const) Напряжение на z-сканере пропорционально рельефу поверхности Исследование наноматериалов методами сканирующей зондовой микроскопии
 Контактные АСМ методики Метод постоянной высоты Ø Реализуется для образцов с малыми перепадами высоты ~ несколько Å Ø Отключенная ОС Ø Регистрация изгиба кантилевера ΔZ ~ Fz Ø Полученное изображение характеризует пространственное распределение Fz Исследование наноматериалов методами сканирующей зондовой микроскопии 33
Контактные АСМ методики Метод постоянной высоты Ø Реализуется для образцов с малыми перепадами высоты ~ несколько Å Ø Отключенная ОС Ø Регистрация изгиба кантилевера ΔZ ~ Fz Ø Полученное изображение характеризует пространственное распределение Fz Исследование наноматериалов методами сканирующей зондовой микроскопии 33
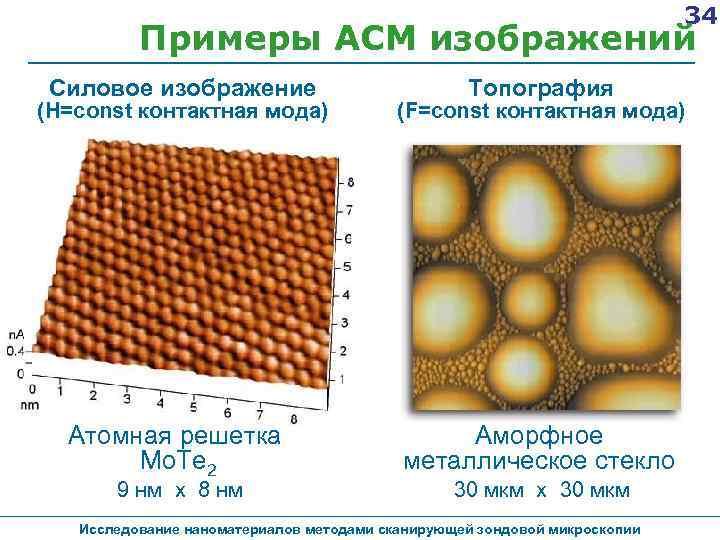 34 Примеры АСМ изображений Силовое изображение (H=const контактная мода) Атомная решетка Mo. Te 2 9 нм х 8 нм Топография (F=const контактная мода) Аморфное металлическое стекло 30 мкм х 30 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
34 Примеры АСМ изображений Силовое изображение (H=const контактная мода) Атомная решетка Mo. Te 2 9 нм х 8 нм Топография (F=const контактная мода) Аморфное металлическое стекло 30 мкм х 30 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
 35 Микроскопия поперечных сил Регистрация кручения кантилевера под действием латеральных компонент сил ð различает области с различными коэффициентами трения ð подчеркивает особенности рельефа ð возможно использование одновременно с получением рельефа поверхности Исследование наноматериалов методами сканирующей зондовой микроскопии
35 Микроскопия поперечных сил Регистрация кручения кантилевера под действием латеральных компонент сил ð различает области с различными коэффициентами трения ð подчеркивает особенности рельефа ð возможно использование одновременно с получением рельефа поверхности Исследование наноматериалов методами сканирующей зондовой микроскопии
 36 Микроскопия поперечных сил Исследование наноматериалов методами сканирующей зондовой микроскопии
36 Микроскопия поперечных сил Исследование наноматериалов методами сканирующей зондовой микроскопии
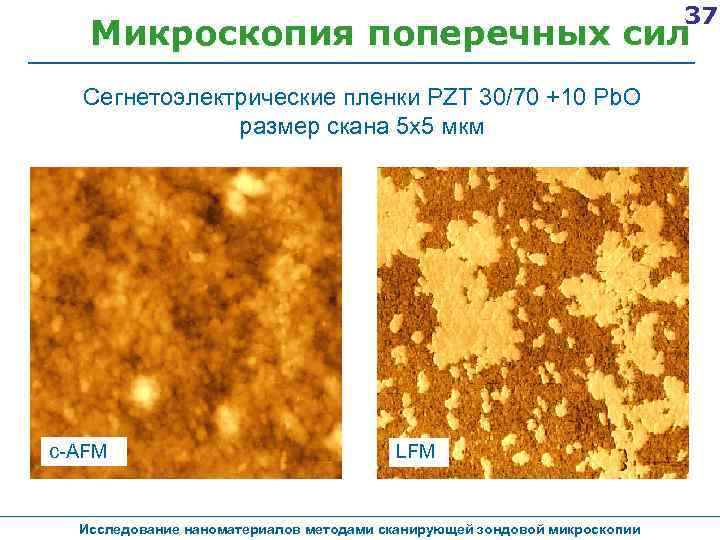 37 Микроскопия поперечных сил Сегнетоэлектрические пленки PZT 30/70 +10 Pb. O размер скана 5 х5 мкм c-AFM LFM Исследование наноматериалов методами сканирующей зондовой микроскопии
37 Микроскопия поперечных сил Сегнетоэлектрические пленки PZT 30/70 +10 Pb. O размер скана 5 х5 мкм c-AFM LFM Исследование наноматериалов методами сканирующей зондовой микроскопии
 38 Микроскопия поперечных сил Гидратные пленки на основе Al размер скана 8 х8 мкм c-AFM LFM Исследование наноматериалов методами сканирующей зондовой микроскопии
38 Микроскопия поперечных сил Гидратные пленки на основе Al размер скана 8 х8 мкм c-AFM LFM Исследование наноматериалов методами сканирующей зондовой микроскопии
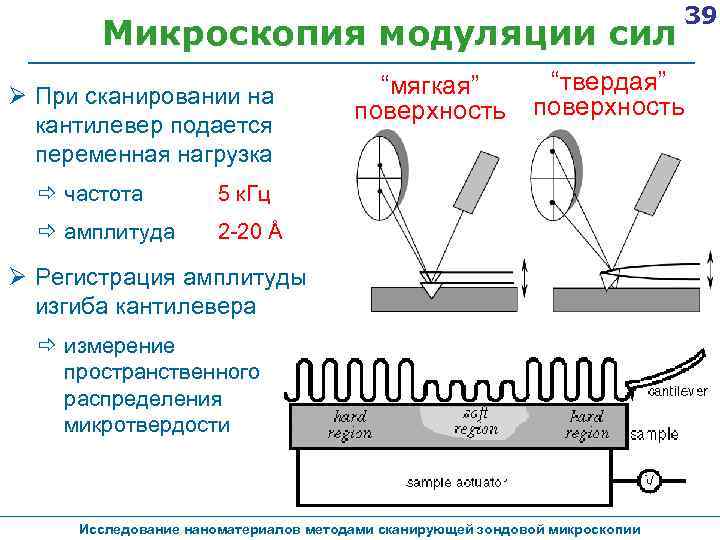 Микроскопия модуляции сил При сканировании на кантилевер подается переменная нагрузка ð частота “твердая” поверхность 5 к. Гц ð амплитуда “мягкая” поверхность 39 2 -20 Å Регистрация амплитуды изгиба кантилевера ð измерение пространственного распределения микротвердости Исследование наноматериалов методами сканирующей зондовой микроскопии
Микроскопия модуляции сил При сканировании на кантилевер подается переменная нагрузка ð частота “твердая” поверхность 5 к. Гц ð амплитуда “мягкая” поверхность 39 2 -20 Å Регистрация амплитуды изгиба кантилевера ð измерение пространственного распределения микротвердости Исследование наноматериалов методами сканирующей зондовой микроскопии
 Микроскопия модуляции сил Исследование наноматериалов методами сканирующей зондовой микроскопии 40
Микроскопия модуляции сил Исследование наноматериалов методами сканирующей зондовой микроскопии 40
 Микроскопия модуляции сил Полимерные пленки ПВХ топография микротвердость Исследование наноматериалов методами сканирующей зондовой микроскопии 41
Микроскопия модуляции сил Полимерные пленки ПВХ топография микротвердость Исследование наноматериалов методами сканирующей зондовой микроскопии 41
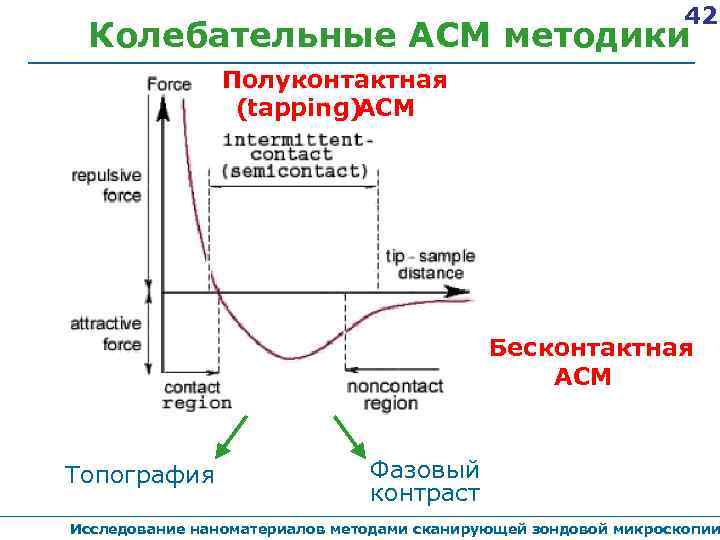 42 Колебательные АСМ методики Полуконтактная (tapping) АСМ Бесконтактная АСМ Топография Фазовый контраст Исследование наноматериалов методами сканирующей зондовой микроскопии
42 Колебательные АСМ методики Полуконтактная (tapping) АСМ Бесконтактная АСМ Топография Фазовый контраст Исследование наноматериалов методами сканирующей зондовой микроскопии
 Полуконтактная АСМ Слабая зависимость силы от расстояния ð модуляционная техника для повышения чувствительности Уменьшается механическое воздействие зонда на поверхность Открываются новые возможности АСМ по исследованию свойств поверхности Исследование наноматериалов методами сканирующей зондовой микроскопии 43
Полуконтактная АСМ Слабая зависимость силы от расстояния ð модуляционная техника для повышения чувствительности Уменьшается механическое воздействие зонда на поверхность Открываются новые возможности АСМ по исследованию свойств поверхности Исследование наноматериалов методами сканирующей зондовой микроскопии 43
 Полуконтактная АСМ 44 Вынужденные колебания кантилевера вблизи резонанса с амплитудой ~ 10 ÷ 100 нм ð кантилевер касается поверхности в нижнем полупериоде колебаний ð амплитуда и фаза колебаний кантилевера зависят от степени взаимодействия зонда с поверхностью в нижней точке колебаний Формирование изображения ð регистрация изменений амплитуды и фазы колебаний кантилевера ð система ОС поддерживает постоянной амплитуду колебаний кантилевера ð напряжение на z-сканере пропорционально рельефу поверхности ð распределению фазового контраста соответствует изменение фазы колебаний кантилевера Исследование наноматериалов методами сканирующей зондовой микроскопии
Полуконтактная АСМ 44 Вынужденные колебания кантилевера вблизи резонанса с амплитудой ~ 10 ÷ 100 нм ð кантилевер касается поверхности в нижнем полупериоде колебаний ð амплитуда и фаза колебаний кантилевера зависят от степени взаимодействия зонда с поверхностью в нижней точке колебаний Формирование изображения ð регистрация изменений амплитуды и фазы колебаний кантилевера ð система ОС поддерживает постоянной амплитуду колебаний кантилевера ð напряжение на z-сканере пропорционально рельефу поверхности ð распределению фазового контраста соответствует изменение фазы колебаний кантилевера Исследование наноматериалов методами сканирующей зондовой микроскопии
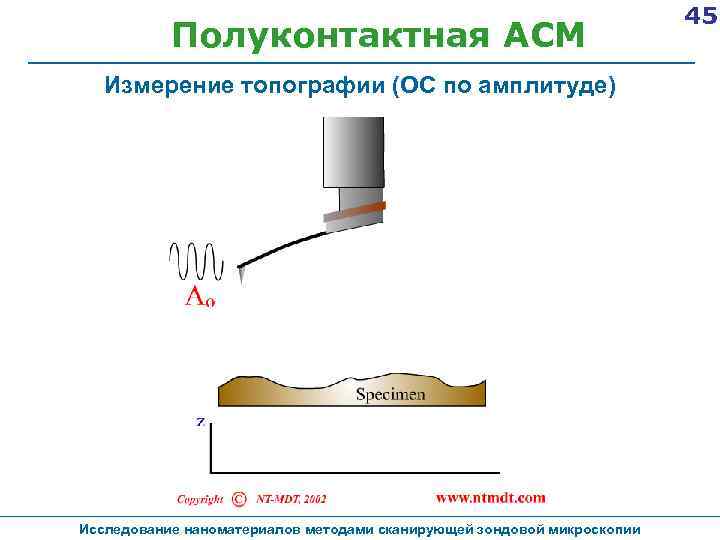 Полуконтактная АСМ Измерение топографии (ОС по амплитуде) Исследование наноматериалов методами сканирующей зондовой микроскопии 45
Полуконтактная АСМ Измерение топографии (ОС по амплитуде) Исследование наноматериалов методами сканирующей зондовой микроскопии 45
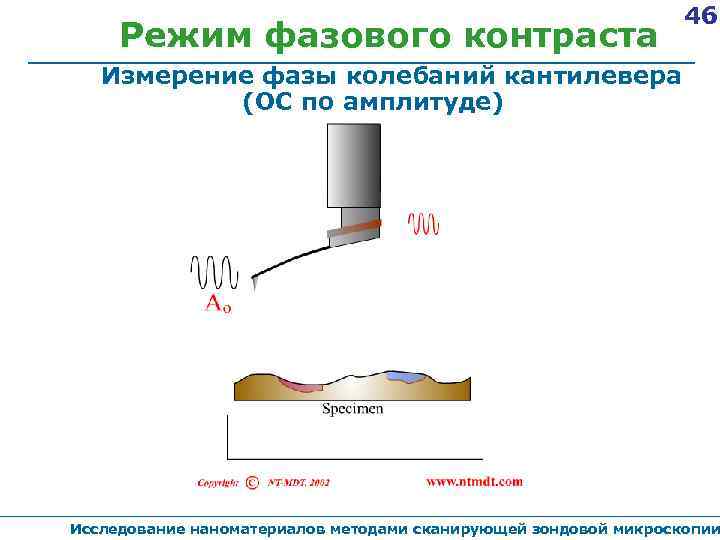 Режим фазового контраста 46 Измерение фазы колебаний кантилевера (ОС по амплитуде) Исследование наноматериалов методами сканирующей зондовой микроскопии
Режим фазового контраста 46 Измерение фазы колебаний кантилевера (ОС по амплитуде) Исследование наноматериалов методами сканирующей зондовой микроскопии
 47 Примеры АСМ изображений Топография (полуконтактная АСМ) Кристаллизация монослоя оксида полиэтилена 20 мкм х 20 мкм Коллоидное золото 14 мкм х 14 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
47 Примеры АСМ изображений Топография (полуконтактная АСМ) Кристаллизация монослоя оксида полиэтилена 20 мкм х 20 мкм Коллоидное золото 14 мкм х 14 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
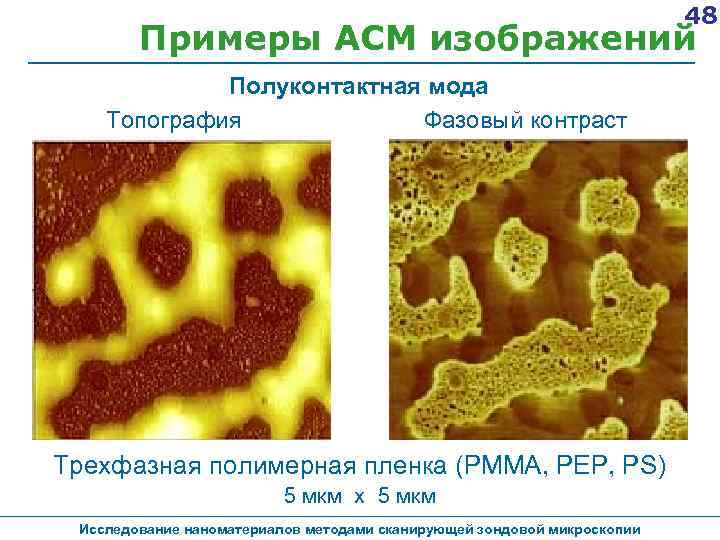 48 Примеры АСМ изображений Полуконтактная мода Топография Фазовый контраст Трехфазная полимерная пленка (PMMA, PEP, PS) 5 мкм х 5 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
48 Примеры АСМ изображений Полуконтактная мода Топография Фазовый контраст Трехфазная полимерная пленка (PMMA, PEP, PS) 5 мкм х 5 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
 Сравнение с контактной АСМ Меньше риск повредить зонд контактная АСМ Меньшее влияние на поверхность ð возможность работы с «мягкими» образцами Сильное влияние адсорбционного слоя бесконтактная АСМ Полуконтактная мода ð повышает разрешение ð «протыкает» адсорбционный слой Исследование наноматериалов методами сканирующей зондовой микроскопии 49
Сравнение с контактной АСМ Меньше риск повредить зонд контактная АСМ Меньшее влияние на поверхность ð возможность работы с «мягкими» образцами Сильное влияние адсорбционного слоя бесконтактная АСМ Полуконтактная мода ð повышает разрешение ð «протыкает» адсорбционный слой Исследование наноматериалов методами сканирующей зондовой микроскопии 49
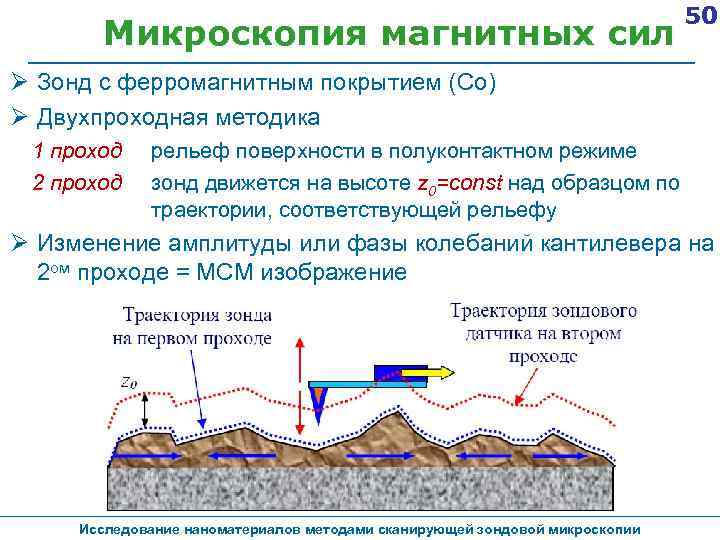 Микроскопия магнитных сил 50 Зонд с ферромагнитным покрытием (Co) Двухпроходная методика 1 проход 2 проход рельеф поверхности в полуконтактном режиме зонд движется на высоте z 0=const над образцом по траектории, соответствующей рельефу Изменение амплитуды или фазы колебаний кантилевера на 2 ом проходе = МСМ изображение Исследование наноматериалов методами сканирующей зондовой микроскопии
Микроскопия магнитных сил 50 Зонд с ферромагнитным покрытием (Co) Двухпроходная методика 1 проход 2 проход рельеф поверхности в полуконтактном режиме зонд движется на высоте z 0=const над образцом по траектории, соответствующей рельефу Изменение амплитуды или фазы колебаний кантилевера на 2 ом проходе = МСМ изображение Исследование наноматериалов методами сканирующей зондовой микроскопии
 Микроскопия магнитных сил 51 Изменение МСМ сигнала при удалении от поверхнос (тестовый образец для Explorer ) nc-AFM MFM Исследование наноматериалов методами сканирующей зондовой микроскопии
Микроскопия магнитных сил 51 Изменение МСМ сигнала при удалении от поверхнос (тестовый образец для Explorer ) nc-AFM MFM Исследование наноматериалов методами сканирующей зондовой микроскопии
 Качество МСМ изображения 52 Магнитостатическая сила зависит от доменной структуры на поверхности образца толщины ферромагнитного покрытия зонда ориентации доменов в зонде Интерпретация результатов может усложняться в результате переориентации намагниченности зонда под действием поверхности под действием зонда Условия стабильности доменной структуры Выбор материала зонда с высоким коэрцитивным полем и большой магнитной анизотропией Сканирование при достаточном расстоянии между зондом и поверхностью Исследование наноматериалов методами сканирующей зондовой микроскопии
Качество МСМ изображения 52 Магнитостатическая сила зависит от доменной структуры на поверхности образца толщины ферромагнитного покрытия зонда ориентации доменов в зонде Интерпретация результатов может усложняться в результате переориентации намагниченности зонда под действием поверхности под действием зонда Условия стабильности доменной структуры Выбор материала зонда с высоким коэрцитивным полем и большой магнитной анизотропией Сканирование при достаточном расстоянии между зондом и поверхностью Исследование наноматериалов методами сканирующей зондовой микроскопии
 Микроскопия магнитных сил 53 Специальные требования к креплению образца и кантилевера - без использования магнитов и магнитных материалов, за исключением зонда! Перед измерениями зонды намагничиваются с помощью специального устройства Исследование наноматериалов методами сканирующей зондовой микроскопии
Микроскопия магнитных сил 53 Специальные требования к креплению образца и кантилевера - без использования магнитов и магнитных материалов, за исключением зонда! Перед измерениями зонды намагничиваются с помощью специального устройства Исследование наноматериалов методами сканирующей зондовой микроскопии
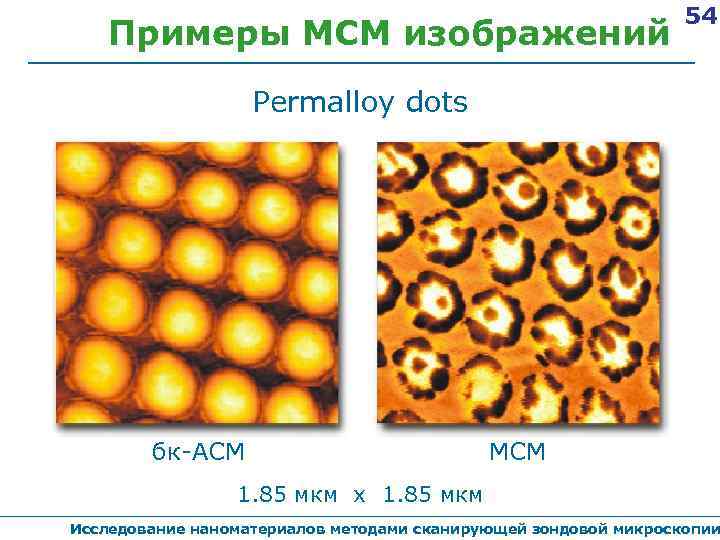 Примеры МСМ изображений 54 Permalloy dots бк-АСМ МСМ 1. 85 мкм х 1. 85 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
Примеры МСМ изображений 54 Permalloy dots бк-АСМ МСМ 1. 85 мкм х 1. 85 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
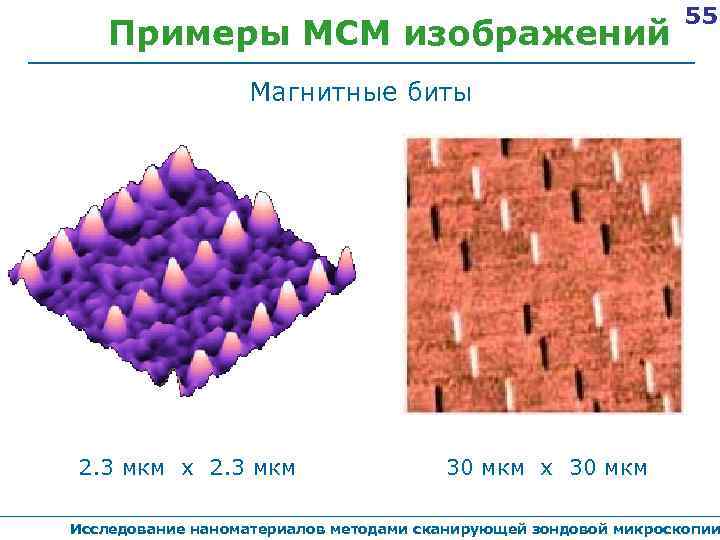 Примеры МСМ изображений 55 Магнитные биты 2. 3 мкм х 2. 3 мкм 30 мкм х 30 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
Примеры МСМ изображений 55 Магнитные биты 2. 3 мкм х 2. 3 мкм 30 мкм х 30 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
 Примеры МСМ изображений 56 Магнитные частицы, покрытые тонкой пленкой nc-AFM MFM 9 мкм х 9 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
Примеры МСМ изображений 56 Магнитные частицы, покрытые тонкой пленкой nc-AFM MFM 9 мкм х 9 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
 Примеры МСМ изображений 57 Магнитные домены в сталях 80 мкм 10 мкм х 10 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
Примеры МСМ изображений 57 Магнитные домены в сталях 80 мкм 10 мкм х 10 мкм Исследование наноматериалов методами сканирующей зондовой микроскопии
 Электрические методики СЗМ 58 Контактные электрические методики ð сканирующая микроскопия сопротивления растекания ð контактная сканирующая емкостная микроскопия ð силовая микроскопия пьезоэлектрического отклика ð сканирующая микроскопия нелинейной диэлектрической проницаемости Двухпроходные электрические методики ð электрическая силовая микроскопия ð микроскопия поверхностного потенциала (метод зонда Кельвина) ð сканирующая емкостная микроскопия Исследование наноматериалов методами сканирующей зондовой микроскопии
Электрические методики СЗМ 58 Контактные электрические методики ð сканирующая микроскопия сопротивления растекания ð контактная сканирующая емкостная микроскопия ð силовая микроскопия пьезоэлектрического отклика ð сканирующая микроскопия нелинейной диэлектрической проницаемости Двухпроходные электрические методики ð электрическая силовая микроскопия ð микроскопия поверхностного потенциала (метод зонда Кельвина) ð сканирующая емкостная микроскопия Исследование наноматериалов методами сканирующей зондовой микроскопии
 Электрические методики СЗМ 59 Основные принципы работы Электростатическое взаимодействие между проводящим зондом и заряженными областями вблизи поверхности образца Исследование наноматериалов методами сканирующей зондовой микроскопии
Электрические методики СЗМ 59 Основные принципы работы Электростатическое взаимодействие между проводящим зондом и заряженными областями вблизи поверхности образца Исследование наноматериалов методами сканирующей зондовой микроскопии
 Сканирующая микроскопия сопротивления растекания 60 Контактная AFM мода При сканировании прикладывается разность потенциалов Vdc и измеряется ток в цепи I(x, y) Строится распределение электрического сопротивления R(x, y)=Vdc/I(x, y) “Смешаны” топография и электрические свойства СМСР Топография Исследование наноматериалов методами сканирующей зондовой микроскопии
Сканирующая микроскопия сопротивления растекания 60 Контактная AFM мода При сканировании прикладывается разность потенциалов Vdc и измеряется ток в цепи I(x, y) Строится распределение электрического сопротивления R(x, y)=Vdc/I(x, y) “Смешаны” топография и электрические свойства СМСР Топография Исследование наноматериалов методами сканирующей зондовой микроскопии
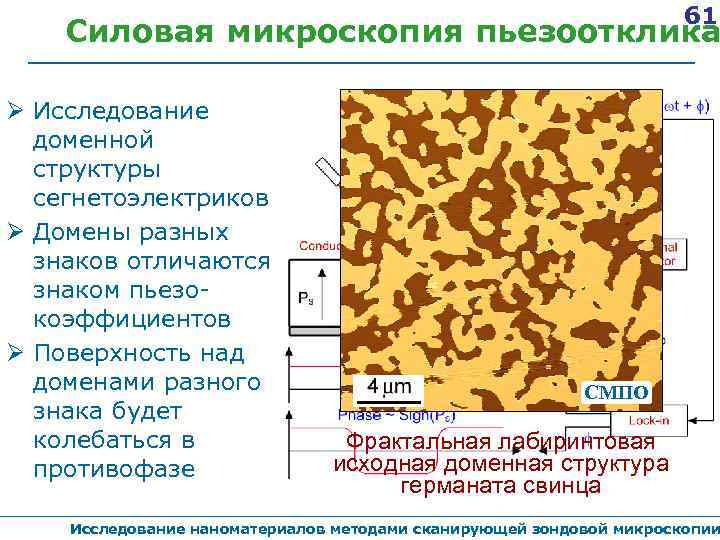 61 Силовая микроскопия пьезоотклика Исследование доменной структуры сегнетоэлектриков Домены разных знаков отличаются знаком пьезокоэффициентов Поверхность над доменами разного знака будет колебаться в противофазе СМПО Фрактальная лабиринтовая исходная доменная структура германата свинца Исследование наноматериалов методами сканирующей зондовой микроскопии
61 Силовая микроскопия пьезоотклика Исследование доменной структуры сегнетоэлектриков Домены разных знаков отличаются знаком пьезокоэффициентов Поверхность над доменами разного знака будет колебаться в противофазе СМПО Фрактальная лабиринтовая исходная доменная структура германата свинца Исследование наноматериалов методами сканирующей зондовой микроскопии
 Электрические методики СЗМ 62 Слабое взаимодействиемодуляционная техника – для повышения чувствительности ð механическая модуляция – переменное напряжение на пьезоприводе – механические колебания кантилевера ð электрическая модуляция – переменное напряжение на проводящем зонде ð комбинированные методы Двухпроходная методика 1 проход рельеф поверхности в полуконтактном режиме 2 проход зонд движется на высоте z 0=const над образцом по траектории, соответствующей рельефу измерение электрических свойств Исследование наноматериалов методами сканирующей зондовой микроскопии
Электрические методики СЗМ 62 Слабое взаимодействиемодуляционная техника – для повышения чувствительности ð механическая модуляция – переменное напряжение на пьезоприводе – механические колебания кантилевера ð электрическая модуляция – переменное напряжение на проводящем зонде ð комбинированные методы Двухпроходная методика 1 проход рельеф поверхности в полуконтактном режиме 2 проход зонд движется на высоте z 0=const над образцом по траектории, соответствующей рельефу измерение электрических свойств Исследование наноматериалов методами сканирующей зондовой микроскопии
 63 Электрическая силовая микроскопи микроскоп Независимое измерение топографии Механические колебания кантилевера на резонансной частоте при постоянной разности потенциалов Регистрация локальных изменений резонансной частоты, амплитуды или фазы колебаний за счет электростатического взаимодействия Аморфные биты на DVD-RWдиске 5 х5 мкм Топография ЭСМ Исследование наноматериалов методами сканирующей зондовой микроскопии
63 Электрическая силовая микроскопи микроскоп Независимое измерение топографии Механические колебания кантилевера на резонансной частоте при постоянной разности потенциалов Регистрация локальных изменений резонансной частоты, амплитуды или фазы колебаний за счет электростатического взаимодействия Аморфные биты на DVD-RWдиске 5 х5 мкм Топография ЭСМ Исследование наноматериалов методами сканирующей зондовой микроскопии
 64 Электрическая силовая микроскопи микроскоп Тестирование интегральных схем ( SRAM) Топография ЭСМ Исследование наноматериалов методами сканирующей зондовой микроскопии
64 Электрическая силовая микроскопи микроскоп Тестирование интегральных схем ( SRAM) Топография ЭСМ Исследование наноматериалов методами сканирующей зондовой микроскопии
 Метод зонда Кельвина 65 Сила взаимодействия зонда с поверхностью приближенно описывается формулой: где Vtip – потенциал, создаваемый на зонде: Отклик на первой гармонике: Введение обратной связи F 1 =0 позволяет измерять поверхностный потенциал Vsurf=Vdc Исследование наноматериалов методами сканирующей зондовой микроскопии
Метод зонда Кельвина 65 Сила взаимодействия зонда с поверхностью приближенно описывается формулой: где Vtip – потенциал, создаваемый на зонде: Отклик на первой гармонике: Введение обратной связи F 1 =0 позволяет измерять поверхностный потенциал Vsurf=Vdc Исследование наноматериалов методами сканирующей зондовой микроскопии
 Метод зонда Кельвина 66 Независимое измерение топографии При измерении потенциала поверхности обратная связь осуществляется за счет изменения Vdc при условии F 1 =0 Строится изображение распределения Vdc(x, y), соответствующее распределению поверхностного потенциала Vsurf(x, y) Исследование наноматериалов методами сканирующей зондовой микроскопии
Метод зонда Кельвина 66 Независимое измерение топографии При измерении потенциала поверхности обратная связь осуществляется за счет изменения Vdc при условии F 1 =0 Строится изображение распределения Vdc(x, y), соответствующее распределению поверхностного потенциала Vsurf(x, y) Исследование наноматериалов методами сканирующей зондовой микроскопии
 Метод зонда Кельвина 67 Электрический потенциал на поверхности двухкомпонентной пленки Ленгмюра-Блоджетт Топография 6 х 6 мкм Метод зонда Кельвина Исследование наноматериалов методами сканирующей зондовой микроскопии
Метод зонда Кельвина 67 Электрический потенциал на поверхности двухкомпонентной пленки Ленгмюра-Блоджетт Топография 6 х 6 мкм Метод зонда Кельвина Исследование наноматериалов методами сканирующей зондовой микроскопии
 Сканирующая емкостная микроскопия 68 Измерение производится аналогично медоду зонда Кельвина Измеряемая величина – амплитуда сигнала на удвоенной частоте: Измерение емкости может проводиться непосредственно с помощью моста. При F 2 w=const полезным сигналом будет сигнал рассогласования моста подоваемый в систему обратной связи Исследование наноматериалов методами сканирующей зондовой микроскопии
Сканирующая емкостная микроскопия 68 Измерение производится аналогично медоду зонда Кельвина Измеряемая величина – амплитуда сигнала на удвоенной частоте: Измерение емкости может проводиться непосредственно с помощью моста. При F 2 w=const полезным сигналом будет сигнал рассогласования моста подоваемый в систему обратной связи Исследование наноматериалов методами сканирующей зондовой микроскопии
 Сканирующая емкостная микроскопия 69 Измеряемая величина локальной емкости определяется ð локальной диэлектрической проницаемостью ð пространственным распределением носителей заряда ð толщиной диэлектрического слоя ð геометрией поверхностей образца и зонда Основное применение SCM ð тестирование полупроводниковых устройств ð определение толщины оксидных поверхностных слоев ð распределение примеси Исследование наноматериалов методами сканирующей зондовой микроскопии
Сканирующая емкостная микроскопия 69 Измеряемая величина локальной емкости определяется ð локальной диэлектрической проницаемостью ð пространственным распределением носителей заряда ð толщиной диэлектрического слоя ð геометрией поверхностей образца и зонда Основное применение SCM ð тестирование полупроводниковых устройств ð определение толщины оксидных поверхностных слоев ð распределение примеси Исследование наноматериалов методами сканирующей зондовой микроскопии
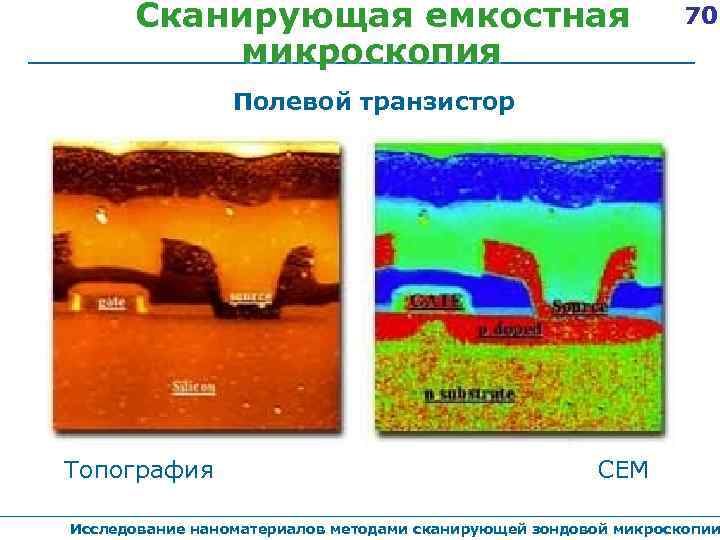 Сканирующая емкостная микроскопия 70 Полевой транзистор Топография СЕМ Исследование наноматериалов методами сканирующей зондовой микроскопии
Сканирующая емкостная микроскопия 70 Полевой транзистор Топография СЕМ Исследование наноматериалов методами сканирующей зондовой микроскопии
 71 Сканирующая тепловая спектроскопия Использование зависимости фотолюминисценции от температуры Использование редкоземельных ионов в качестве излучающих частиц Er 3+, Yb 3+, Eu 3+ Использование Родамин В в качастве излучающего тела Зависимость интенсивности и частоты излучения Cd. Se/Zn. S квантовых ям от температуры Зависимость относительной интенсивности фотолюминисценции родамина В от температуры Зависимость фотолюменисценции Pb. F 2 yнаночастиц допированных Er 3+, Yb 3+ от температуры – А) спектры, б) отношение интенсивностей линий Исследование наноматериалов методами сканирующей зондовой микроскопии
71 Сканирующая тепловая спектроскопия Использование зависимости фотолюминисценции от температуры Использование редкоземельных ионов в качестве излучающих частиц Er 3+, Yb 3+, Eu 3+ Использование Родамин В в качастве излучающего тела Зависимость интенсивности и частоты излучения Cd. Se/Zn. S квантовых ям от температуры Зависимость относительной интенсивности фотолюминисценции родамина В от температуры Зависимость фотолюменисценции Pb. F 2 yнаночастиц допированных Er 3+, Yb 3+ от температуры – А) спектры, б) отношение интенсивностей линий Исследование наноматериалов методами сканирующей зондовой микроскопии
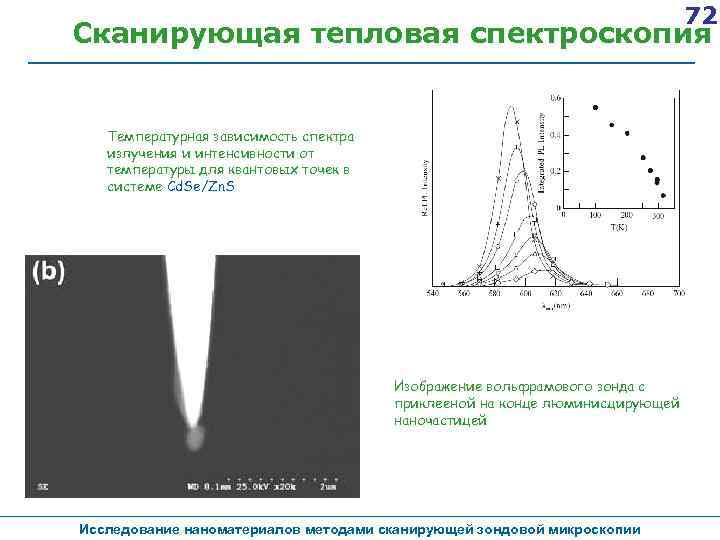 72 Сканирующая тепловая спектроскопия Температурная зависимость спектра излучения и интенсивности от температуры для квантовых точек в системе Cd. Se/Zn. S Изображение вольфрамового зонда с приклееной на конце люминисцирующей наночастицей Исследование наноматериалов методами сканирующей зондовой микроскопии
72 Сканирующая тепловая спектроскопия Температурная зависимость спектра излучения и интенсивности от температуры для квантовых точек в системе Cd. Se/Zn. S Изображение вольфрамового зонда с приклееной на конце люминисцирующей наночастицей Исследование наноматериалов методами сканирующей зондовой микроскопии
 73 Сканирующая тепловая спектроскопия Схема узла зонда. Амплитуда колебаний регистрируется фотодиодом по прерыванию лазерного луча. ОС поддерживает частоту колебаний =const Схема установки для СТо. М Лазер на 975 нм –возбуждает фотолюменисценцию. Регистрируются 2 длинны волны раздельно 520 и 550 нм. Синхронный детектор выделяет частоту задаваемую колебаниями зонда. Исследование наноматериалов методами сканирующей зондовой микроскопии
73 Сканирующая тепловая спектроскопия Схема узла зонда. Амплитуда колебаний регистрируется фотодиодом по прерыванию лазерного луча. ОС поддерживает частоту колебаний =const Схема установки для СТо. М Лазер на 975 нм –возбуждает фотолюменисценцию. Регистрируются 2 длинны волны раздельно 520 и 550 нм. Синхронный детектор выделяет частоту задаваемую колебаниями зонда. Исследование наноматериалов методами сканирующей зондовой микроскопии
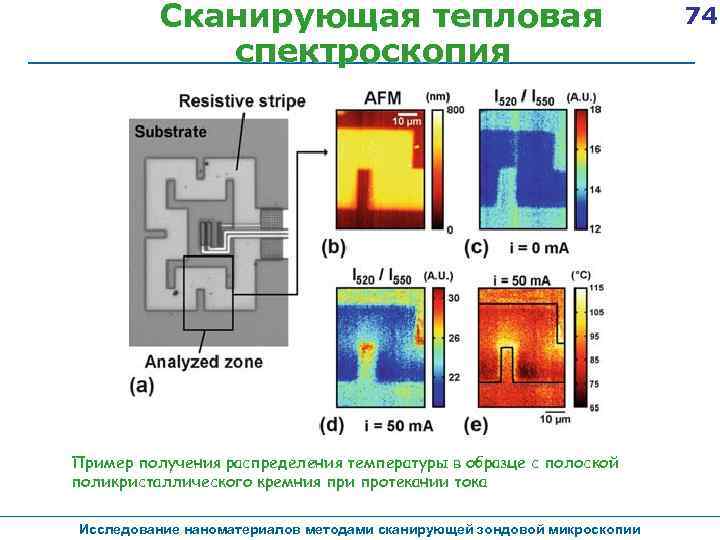 Сканирующая тепловая спектроскопия Пример получения распределения температуры в образце с полоской поликристаллического кремния при протекании тока Исследование наноматериалов методами сканирующей зондовой микроскопии 74
Сканирующая тепловая спектроскопия Пример получения распределения температуры в образце с полоской поликристаллического кремния при протекании тока Исследование наноматериалов методами сканирующей зондовой микроскопии 74
 Артефакты СЗМ изображений Постоянный наклон Постоянная составляющая Неидеальность сканера Полезный сигнал Нестабильность контакта зонд-образец Шумы аппаратуры Шумы, связанные с внешними вибрациями Исследование наноматериалов методами сканирующей зондовой микроскопии 75
Артефакты СЗМ изображений Постоянный наклон Постоянная составляющая Неидеальность сканера Полезный сигнал Нестабильность контакта зонд-образец Шумы аппаратуры Шумы, связанные с внешними вибрациями Исследование наноматериалов методами сканирующей зондовой микроскопии 75
 Артефакты СЗМ изображений Методы устранения артефактов Вычитание постоянной составляющей Вычитание постоянного наклона Вычитание поверхности 2 ого порядка неидеальность сканера Усреднение по строкам Фильтрация СЗМ изображений (например, медианная фильтрация) устранение шумовой составляющей Фурье фильтрация СЗМ изображений Исследование наноматериалов методами сканирующей зондовой микроскопии 76
Артефакты СЗМ изображений Методы устранения артефактов Вычитание постоянной составляющей Вычитание постоянного наклона Вычитание поверхности 2 ого порядка неидеальность сканера Усреднение по строкам Фильтрация СЗМ изображений (например, медианная фильтрация) устранение шумовой составляющей Фурье фильтрация СЗМ изображений Исследование наноматериалов методами сканирующей зондовой микроскопии 76
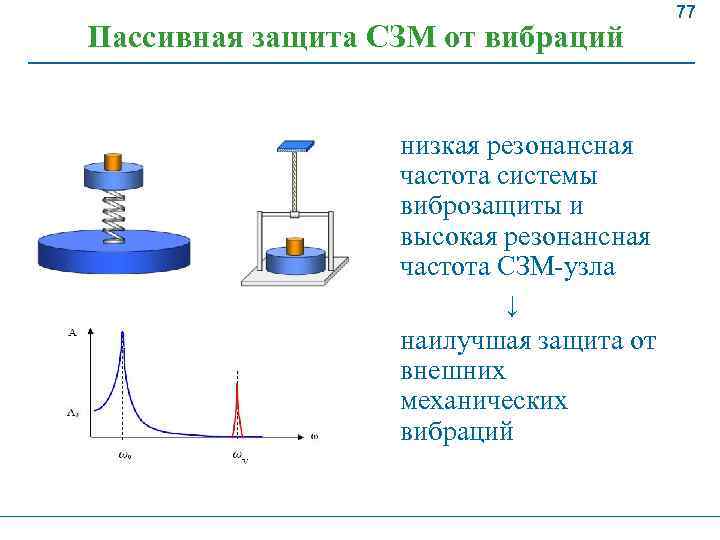 Пассивная защита СЗМ от вибраций низкая резонансная частота системы виброзащиты и высокая резонансная частота СЗМ-узла ↓ наилучшая защита от внешних механических вибраций 77
Пассивная защита СЗМ от вибраций низкая резонансная частота системы виброзащиты и высокая резонансная частота СЗМ-узла ↓ наилучшая защита от внешних механических вибраций 77
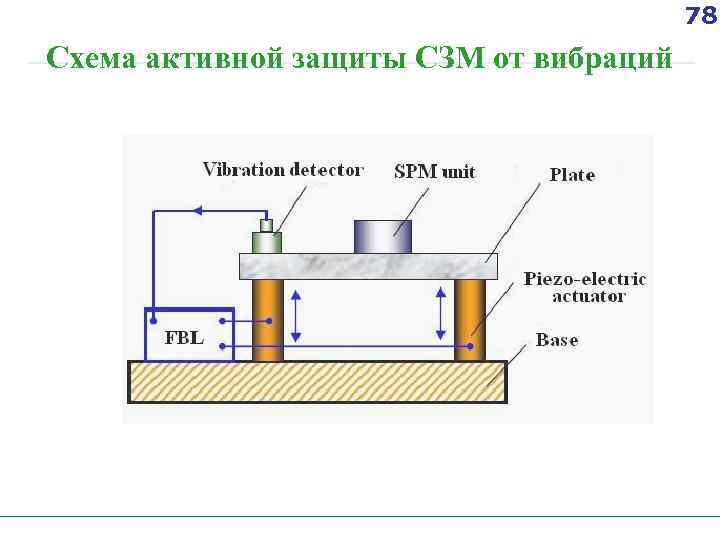 78 Схема активной защиты СЗМ от вибраций
78 Схема активной защиты СЗМ от вибраций
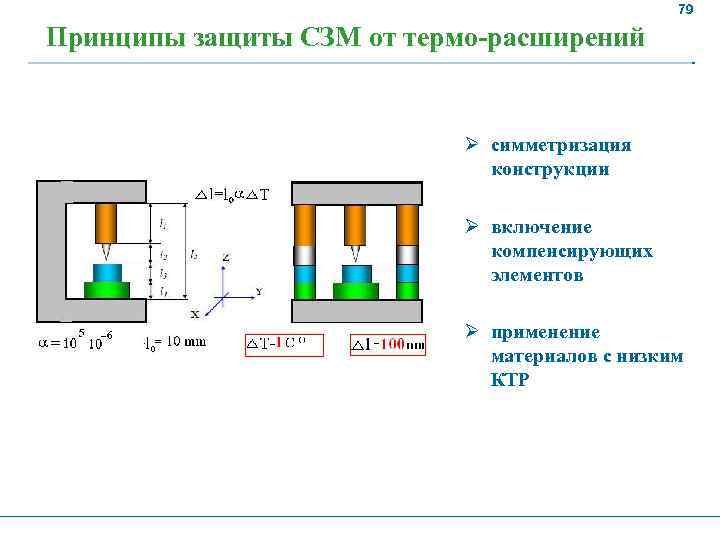 79 Принципы защиты СЗМ от термо-расширений симметризация конструкции включение компенсирующих элементов применение материалов с низким КТР
79 Принципы защиты СЗМ от термо-расширений симметризация конструкции включение компенсирующих элементов применение материалов с низким КТР
 Качество АСМ изображения Влияние формы зонда Конечный размер рабочей части зонда ð ухудшение пространственного разрешения микроскопа ð искажения при сканировании поверхностей с неровностями, сравнимыми с характерными размерами рабочей части зонда Исследование наноматериалов методами сканирующей зондовой микроскопии 80
Качество АСМ изображения Влияние формы зонда Конечный размер рабочей части зонда ð ухудшение пространственного разрешения микроскопа ð искажения при сканировании поверхностей с неровностями, сравнимыми с характерными размерами рабочей части зонда Исследование наноматериалов методами сканирующей зондовой микроскопии 80
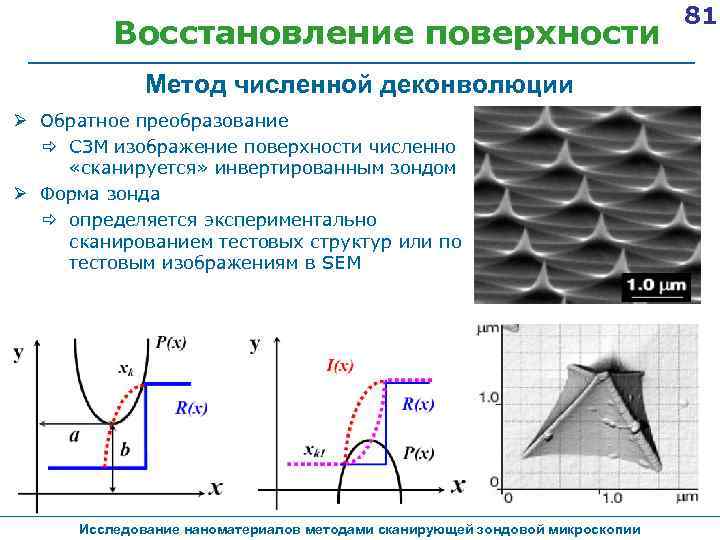 Восстановление поверхности Метод численной деконволюции Обратное преобразование ð СЗМ изображение поверхности численно «сканируется» инвертированным зондом Форма зонда ð определяется экспериментально сканированием тестовых структур или по тестовым изображениям в SEM Исследование наноматериалов методами сканирующей зондовой микроскопии 81
Восстановление поверхности Метод численной деконволюции Обратное преобразование ð СЗМ изображение поверхности численно «сканируется» инвертированным зондом Форма зонда ð определяется экспериментально сканированием тестовых структур или по тестовым изображениям в SEM Исследование наноматериалов методами сканирующей зондовой микроскопии 81


