7. Лек.9 и 10 ИС.ppt
- Количество слайдов: 50
 Дисциплина: ЭЛЕКТРОНИКА Лектор: Погодин Дмитрий Вадимович Кандидат технических наук, доцент кафедры РИИТ (кафедра Радиоэлектроники и информационно-измерительной техники) ФОЭ
Дисциплина: ЭЛЕКТРОНИКА Лектор: Погодин Дмитрий Вадимович Кандидат технических наук, доцент кафедры РИИТ (кафедра Радиоэлектроники и информационно-измерительной техники) ФОЭ
 • Микроэлектроника - современное направление электроники, включающее исследование, конструирование и производство интегральных схем (ИС) и радиоэлектронной аппаратуры на их основе. • Основной задачей микроэлектроники является создание микроминиатюрной аппаратуры с высокой надежностью и воспроизводимостью, низким энергопотреблением и высокой функциональной сложностью. Интегральная микросхема (ИС) – микроэлектронное конструктивно законченное изделие, выполняющее определенную функцию обработки сигналов и имеющее высокую плотность размещения электрически соединенных элементов и компонентов. Элемент ИС – часть ИС, выполняющая функцию транзистора, резистора или другого электрорадиоэлемента, изготовленного в едином технологическом цикле (при создании ИС) и не представляющая собой самостоятельного изделия. Компонент ИС – представляет собой самостоятельное комплектующее изделие, которое устанавливается в ИС в процессе ее изготовления. Все элементы ИС и их соединения выполнены в едином технологическом цикле на общей подложке.
• Микроэлектроника - современное направление электроники, включающее исследование, конструирование и производство интегральных схем (ИС) и радиоэлектронной аппаратуры на их основе. • Основной задачей микроэлектроники является создание микроминиатюрной аппаратуры с высокой надежностью и воспроизводимостью, низким энергопотреблением и высокой функциональной сложностью. Интегральная микросхема (ИС) – микроэлектронное конструктивно законченное изделие, выполняющее определенную функцию обработки сигналов и имеющее высокую плотность размещения электрически соединенных элементов и компонентов. Элемент ИС – часть ИС, выполняющая функцию транзистора, резистора или другого электрорадиоэлемента, изготовленного в едином технологическом цикле (при создании ИС) и не представляющая собой самостоятельного изделия. Компонент ИС – представляет собой самостоятельное комплектующее изделие, которое устанавливается в ИС в процессе ее изготовления. Все элементы ИС и их соединения выполнены в едином технологическом цикле на общей подложке.
 Основные направления развития твердотельной (полупроводниковой) электроники Центральной задачей микроэлектроники является проблема создания максимально надежных элементов, схем и устройств и разработка надежных и дешевых способов их соединения путем использования качественно новых принципов изготовления электронной аппаратуры. К числу этих принципов относится отказ от использования дискретных компонентов и формирование непосредственно в микрообъемах исходных материалов сложных интегральных микросхем.
Основные направления развития твердотельной (полупроводниковой) электроники Центральной задачей микроэлектроники является проблема создания максимально надежных элементов, схем и устройств и разработка надежных и дешевых способов их соединения путем использования качественно новых принципов изготовления электронной аппаратуры. К числу этих принципов относится отказ от использования дискретных компонентов и формирование непосредственно в микрообъемах исходных материалов сложных интегральных микросхем.
 Микроэлектроника — это область электроники, которая занимается разработкой, изготовлением и применением интегральных микросхем (ИМС) и аппаратуры на основе ИМС Интегральная микросхема (ИМС ) – микроэлектронное, конструктивно законченное изделие, выполняющее определенную функцию обработки сигналов и имеющее высокую плотность размещения электрически соединенных элементов и компонентов. • Термин "схема" в имеет смысл устройства, объекта, а не условного обозначения устройства вместе с условными обозначениями входящих в него элементов, какой придавали ему на более ранних этапах развития электротехники и электроники. • Термин "интегральная" отмечает факт объединения – интеграции – группы радиоэлементов в одном неразделимом на составные части изделии. • Термин «микро» означает , что размеры элементов имеют порядок микрометоа • Познакомимся с основными терминами микроэлектроники, принятыми в нашей стране.
Микроэлектроника — это область электроники, которая занимается разработкой, изготовлением и применением интегральных микросхем (ИМС) и аппаратуры на основе ИМС Интегральная микросхема (ИМС ) – микроэлектронное, конструктивно законченное изделие, выполняющее определенную функцию обработки сигналов и имеющее высокую плотность размещения электрически соединенных элементов и компонентов. • Термин "схема" в имеет смысл устройства, объекта, а не условного обозначения устройства вместе с условными обозначениями входящих в него элементов, какой придавали ему на более ранних этапах развития электротехники и электроники. • Термин "интегральная" отмечает факт объединения – интеграции – группы радиоэлементов в одном неразделимом на составные части изделии. • Термин «микро» означает , что размеры элементов имеют порядок микрометоа • Познакомимся с основными терминами микроэлектроники, принятыми в нашей стране.
 Внешний вид ИС. Конструкции интегральных микросхем Конструктивно интегральные микросхемы оформляются в металлических пластмассовых или керамических корпусах (рис. 7. 1). ,
Внешний вид ИС. Конструкции интегральных микросхем Конструктивно интегральные микросхемы оформляются в металлических пластмассовых или керамических корпусах (рис. 7. 1). ,
 Основные термины микроэлектроники Интегральная микросхема (ИМС ) – микроэлектронное, конструктивно законченное изделие, выполняющее определенную функцию обработки сигналов и имеющее высокую плотность размещения электрически соединенных элементов и компонентов. Элементом называется часть интегральной микросхемы, в которой реализуется функция какого-либо радиоэлемента (транзистора, диода, резистора и т. д. ) и которую нельзя отделить от схемы и рассматривать как самостоятельное изделие. Все элементы ИС и их соединения выполнены в едином технологическом цикле на общей подложке. Компонент ИС – представляет собой самостоятельное комплектующее изделие, которое устанавливается в ИС в процессе ее изготовления. Компоненты являются самостоятельными изделиями и могут быть отделены от микросхемы и заменены другими. При изготовлении ИМС используется групповой метод производства, при котором на одной подложке одновременно изготавливается множество однотипных элементов или целых микросхем, что позволяет получить изделия с одинаковыми параметрами. В некоторых случаях в состав микросхемы входят компоненты (конденсаторы, резисторы, бескорпусные транзисторы и др. ), которые устанавливаются при сборочно-монтажных операциях. . Электроника .
Основные термины микроэлектроники Интегральная микросхема (ИМС ) – микроэлектронное, конструктивно законченное изделие, выполняющее определенную функцию обработки сигналов и имеющее высокую плотность размещения электрически соединенных элементов и компонентов. Элементом называется часть интегральной микросхемы, в которой реализуется функция какого-либо радиоэлемента (транзистора, диода, резистора и т. д. ) и которую нельзя отделить от схемы и рассматривать как самостоятельное изделие. Все элементы ИС и их соединения выполнены в едином технологическом цикле на общей подложке. Компонент ИС – представляет собой самостоятельное комплектующее изделие, которое устанавливается в ИС в процессе ее изготовления. Компоненты являются самостоятельными изделиями и могут быть отделены от микросхемы и заменены другими. При изготовлении ИМС используется групповой метод производства, при котором на одной подложке одновременно изготавливается множество однотипных элементов или целых микросхем, что позволяет получить изделия с одинаковыми параметрами. В некоторых случаях в состав микросхемы входят компоненты (конденсаторы, резисторы, бескорпусные транзисторы и др. ), которые устанавливаются при сборочно-монтажных операциях. . Электроника .
 Основные термины микроэлектроники • Микросборка – микросхема, состоящая из различных элементов и (или) интегральных микросхем, которые имеют отдельное конструктивное оформление и могут быть испытаны до сборки и монтажа. • Примечание. Элементы микросборки имеют внешние выводы, могут иметь корпусы и рассматриваться как отдельные изделия. • Подложка интегральной микросхемы – основание, на поверхности или в объеме которого формируются элементы интегральных микросхем. • Базовый кристалл – подложка из полупроводникового материала с определенным набором сформированных в ней и не соединенных между собой элементов, используемая для создания интегральных микросхем путем изготовления избирательных внутрисхемных соединений. • Корпус интегральной микросхемы – часть интегральной микросхемы, предназначенная для ее защиты от внешних воздействий и для монтажа в аппаратуре с помощью соответствующих выводов.
Основные термины микроэлектроники • Микросборка – микросхема, состоящая из различных элементов и (или) интегральных микросхем, которые имеют отдельное конструктивное оформление и могут быть испытаны до сборки и монтажа. • Примечание. Элементы микросборки имеют внешние выводы, могут иметь корпусы и рассматриваться как отдельные изделия. • Подложка интегральной микросхемы – основание, на поверхности или в объеме которого формируются элементы интегральных микросхем. • Базовый кристалл – подложка из полупроводникового материала с определенным набором сформированных в ней и не соединенных между собой элементов, используемая для создания интегральных микросхем путем изготовления избирательных внутрисхемных соединений. • Корпус интегральной микросхемы – часть интегральной микросхемы, предназначенная для ее защиты от внешних воздействий и для монтажа в аппаратуре с помощью соответствующих выводов.
 Классификация ИС по сложности • Сложность интегральных микросхем оценивается степенью K = lg N, интеграции, определяемой коэффициентом , значение которого округляется до ближайшего большего целого числа, где – число элементов и компонентов, входящих в микросхему. • где K –степень интеграции, N –число простых элементов в ИМС (обычно транзисторов). • • • По степени интеграции ИМС делятся на интегральные схемы: 1 -ой степени: К=1 N<=10 т. е. с числом элементов меньше 10, их называют малыми ИС. 2 -ой степени: К=2 N<=102; с числом от 10 до 100 их называют средними ИС. 3 -ой степени: К=3 N<=103 – их называют большие ИС т. е. БИС; 4 -ой степени: К=4 N<=104 - их называют большие ИС т. е. БИС; 5 -ой степени: К=>5 N<=105 - их называют сверхбольшие ИС т. е. СБИС. • На смену СБИС, относящимся к интегральным схемам четвертого поколения, приходит пятое поколение – так называемые УБИС (ультрабольшие интегральные схемы), содержащие на одной подложке до нескольких миллионов активных элементов (>106 ‘элементов). • Сложность ИС характеризуется, также плотностью упаковки, т. е числом элементов в единице обьема или на единице площади кристалла.
Классификация ИС по сложности • Сложность интегральных микросхем оценивается степенью K = lg N, интеграции, определяемой коэффициентом , значение которого округляется до ближайшего большего целого числа, где – число элементов и компонентов, входящих в микросхему. • где K –степень интеграции, N –число простых элементов в ИМС (обычно транзисторов). • • • По степени интеграции ИМС делятся на интегральные схемы: 1 -ой степени: К=1 N<=10 т. е. с числом элементов меньше 10, их называют малыми ИС. 2 -ой степени: К=2 N<=102; с числом от 10 до 100 их называют средними ИС. 3 -ой степени: К=3 N<=103 – их называют большие ИС т. е. БИС; 4 -ой степени: К=4 N<=104 - их называют большие ИС т. е. БИС; 5 -ой степени: К=>5 N<=105 - их называют сверхбольшие ИС т. е. СБИС. • На смену СБИС, относящимся к интегральным схемам четвертого поколения, приходит пятое поколение – так называемые УБИС (ультрабольшие интегральные схемы), содержащие на одной подложке до нескольких миллионов активных элементов (>106 ‘элементов). • Сложность ИС характеризуется, также плотностью упаковки, т. е числом элементов в единице обьема или на единице площади кристалла.
 Классификация ИС по конструктивнотехнологическим признакам • Интегральные микросхемы по конструктивно-технологическим признакам разделяют на полупроводниковые (монолитные), пленочные, гибридные и совмещенные. • Полупроводниковая интегральная микросхема – интегральная микросхема, элементы которой выполнимы в объеме или на поверхности полупроводникового материала, на так называемой активной подложки (обычно это монокристалл кремния). • Пленочная интегральная микросхема – интегральная микросхема, элементы которой выполнены в виде пленок, нанесенных на поверхность диэлектрического материала (пассивную подложку). Их разделяют на тонкопленочные и толстопленочные. • Тонкопленочная интегральная микросхема – пленочная интегральная микросхема с толщиной пленок до 1∙ 10 -6 м. • Толстопленочная интегральная микросхема – пленочная интегральная микросхема с толщиной пленок свыше 1∙ 10 -6 м. • В гибридных интегральных схемах пассивные элементы выполнены в виде пленок, нанесенных на диэлектрическую подложку, а активные элементы являются навесными. • Совмещенные интегральные схемы выполняют на основе полупроводниковых и пленочных микросхем, т. е. активные элементы выполняют, как и в полупроводниковых, а пассивные элементы и межсоединения наносят в виде пленок на ту же подложку. Подложку для обеспечения электрической изоляции предварительно окисляют.
Классификация ИС по конструктивнотехнологическим признакам • Интегральные микросхемы по конструктивно-технологическим признакам разделяют на полупроводниковые (монолитные), пленочные, гибридные и совмещенные. • Полупроводниковая интегральная микросхема – интегральная микросхема, элементы которой выполнимы в объеме или на поверхности полупроводникового материала, на так называемой активной подложки (обычно это монокристалл кремния). • Пленочная интегральная микросхема – интегральная микросхема, элементы которой выполнены в виде пленок, нанесенных на поверхность диэлектрического материала (пассивную подложку). Их разделяют на тонкопленочные и толстопленочные. • Тонкопленочная интегральная микросхема – пленочная интегральная микросхема с толщиной пленок до 1∙ 10 -6 м. • Толстопленочная интегральная микросхема – пленочная интегральная микросхема с толщиной пленок свыше 1∙ 10 -6 м. • В гибридных интегральных схемах пассивные элементы выполнены в виде пленок, нанесенных на диэлектрическую подложку, а активные элементы являются навесными. • Совмещенные интегральные схемы выполняют на основе полупроводниковых и пленочных микросхем, т. е. активные элементы выполняют, как и в полупроводниковых, а пассивные элементы и межсоединения наносят в виде пленок на ту же подложку. Подложку для обеспечения электрической изоляции предварительно окисляют.
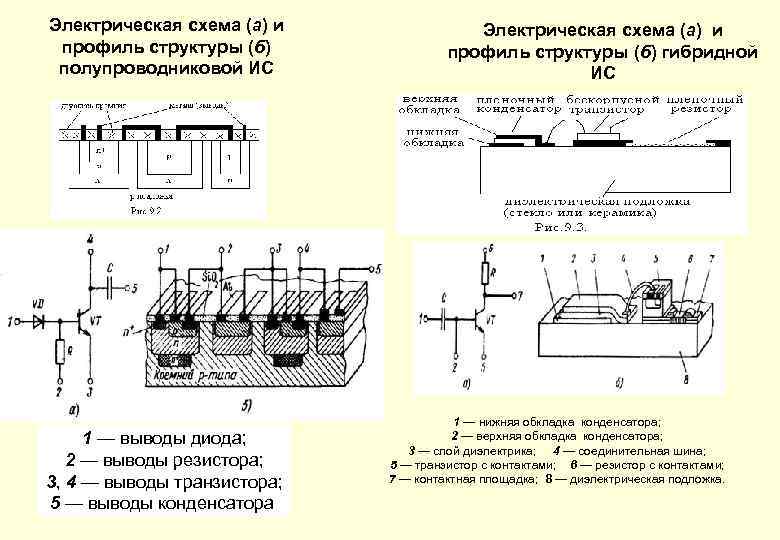 Электрическая схема (а) и профиль структуры (б) полупроводниковой ИС 1 — выводы диода; 2 — выводы резистора; 3, 4 — выводы транзистора; 5 — выводы конденсатора Электрическая схема (а) и профиль структуры (б) гибридной ИС 1 — нижняя обкладка конденсатора; 2 — верхняя обкладка конденсатора; 3 — слой диэлектрика; 4 — соединительная шина; 5 — транзистор с контактами; 6 — резистор с контактами; 7 — контактная площадка; 8 — диэлектрическая подложка.
Электрическая схема (а) и профиль структуры (б) полупроводниковой ИС 1 — выводы диода; 2 — выводы резистора; 3, 4 — выводы транзистора; 5 — выводы конденсатора Электрическая схема (а) и профиль структуры (б) гибридной ИС 1 — нижняя обкладка конденсатора; 2 — верхняя обкладка конденсатора; 3 — слой диэлектрика; 4 — соединительная шина; 5 — транзистор с контактами; 6 — резистор с контактами; 7 — контактная площадка; 8 — диэлектрическая подложка.

 Классифкация ИС по функциональному назначению По функциональному назначению все интегральные микросхемы принято делить на аналоговые и цифровые. Аналоговая интегральная микросхема (аналоговая микросхема) – это интегральная микросхема, предназначенная для преобразования и обработки аналоговых сигналов, сигналов изменяющихся по закону непрерывной функции. В основе аналоговых интегральных микросхем в частности лежат простейшие усилительные каскады. Используя много каскадов, создают различные усилители, стабилизаторы напряжения и тока, преобразователи частоты, фазы, длительности, генераторы синусоидальных, прямоугольных и других сигналов, а также другие схемы. Цифровая интегральная микросхема (цифровая микросхема) – это интегральная микросхема, предназначенная для преобразования и обработки сигналов, изменяющихся по закону дискретной функции. В основе цифровых интегральных микросхем лежат транзисторные ключи, или переключатели тока способные находиться в двух устойчивых состояниях: открытом и закрытом. Использование транзисторных ключей дает возможность создавать различные логические, арифметические и другие интегральные микросхемы. Цифровые интегральные микросхемы применяют в устройствах обработки дискретной информации электронно-вычислительных машин (ЭВМ), системах автоматики и т. п. электроника
Классифкация ИС по функциональному назначению По функциональному назначению все интегральные микросхемы принято делить на аналоговые и цифровые. Аналоговая интегральная микросхема (аналоговая микросхема) – это интегральная микросхема, предназначенная для преобразования и обработки аналоговых сигналов, сигналов изменяющихся по закону непрерывной функции. В основе аналоговых интегральных микросхем в частности лежат простейшие усилительные каскады. Используя много каскадов, создают различные усилители, стабилизаторы напряжения и тока, преобразователи частоты, фазы, длительности, генераторы синусоидальных, прямоугольных и других сигналов, а также другие схемы. Цифровая интегральная микросхема (цифровая микросхема) – это интегральная микросхема, предназначенная для преобразования и обработки сигналов, изменяющихся по закону дискретной функции. В основе цифровых интегральных микросхем лежат транзисторные ключи, или переключатели тока способные находиться в двух устойчивых состояниях: открытом и закрытом. Использование транзисторных ключей дает возможность создавать различные логические, арифметические и другие интегральные микросхемы. Цифровые интегральные микросхемы применяют в устройствах обработки дискретной информации электронно-вычислительных машин (ЭВМ), системах автоматики и т. п. электроника
 Классификация ИС по виду активных элементов • По виду активных элементов различают ИС: -на биполярных транзисторах; -на полевых МДП-транзисторах (металл диэлектрик проводник); -на КМДП-транзисторы (комплиментарных полевых транзисторах со структурой металл-диэлектрикпроводник). комплиментарные - это транзисторы с одинаковыми параметрами, но имеющие разный тип проводимости канала.
Классификация ИС по виду активных элементов • По виду активных элементов различают ИС: -на биполярных транзисторах; -на полевых МДП-транзисторах (металл диэлектрик проводник); -на КМДП-транзисторы (комплиментарных полевых транзисторах со структурой металл-диэлектрикпроводник). комплиментарные - это транзисторы с одинаковыми параметрами, но имеющие разный тип проводимости канала.
 Маркировка ИМС Промышленность выпускает ИМС сериями. Серия объединяет ряд отдельных схем единых по технологическому признаку, согласованных по напряжения питания, уровням входных и выходных сигналов и конструктивному оформлению. Серии ИМС стремятся разрабатывать так, чтобы из входящих в них схем можно было построить законченное устройство. Маркировка ИМС по ГОСТ состоит из 4 элементов. ПРИМЕР: 140 УД 8 А, К 140 УД 26 А или К 155 ЛА 3 Первый элемент три или четыре цифры - номер серии (140 или 155). Серия характеризует конструктивно-технологическое деление и состоит из двух частей: первая цифра дает деление по технологии изготовления: 1, 5, 7 – это полупроводниковые ИМС ( 7 – это бескорпусные ИС); 2, 4, 6, 8 – это ГИМС; 3 – прочие (пленочные) ИМС. две или три следующие цифры номера серии означают порядковый номер разработки ИМС. Второй элемент -две буквы – это функциональное назначение ИМС. Например, УД – операционный усилитель; ПС – аналоговый перемножитель; ЛА – логический элемент «ИНЕ» ; ЛЕ – логический элемент «ИЛИ-НЕ» ; ЕН – линейный стабилизатор напряжения; ЕП – Импульсный стабилизатор напряжения. Третий элемент - две цифры. Это порядковый номер разработки в данной серии. Четвертый элемент - буква. Она характеризует деление по параметрическим группам. Иногда перед условным обозначением стоит буква «К» , это значит микросхема широкого применения, если буквы нет, то это ИС специального назначения. Иногда перед условным обозначением стоят две буквы – они указывают тип корпуса. Например: КМ – тип корпуса, КР – пластмассовый корпус, КМ – керамо-металлический, КЕ – металло-полимерный: КМ 155 ЛА 3
Маркировка ИМС Промышленность выпускает ИМС сериями. Серия объединяет ряд отдельных схем единых по технологическому признаку, согласованных по напряжения питания, уровням входных и выходных сигналов и конструктивному оформлению. Серии ИМС стремятся разрабатывать так, чтобы из входящих в них схем можно было построить законченное устройство. Маркировка ИМС по ГОСТ состоит из 4 элементов. ПРИМЕР: 140 УД 8 А, К 140 УД 26 А или К 155 ЛА 3 Первый элемент три или четыре цифры - номер серии (140 или 155). Серия характеризует конструктивно-технологическое деление и состоит из двух частей: первая цифра дает деление по технологии изготовления: 1, 5, 7 – это полупроводниковые ИМС ( 7 – это бескорпусные ИС); 2, 4, 6, 8 – это ГИМС; 3 – прочие (пленочные) ИМС. две или три следующие цифры номера серии означают порядковый номер разработки ИМС. Второй элемент -две буквы – это функциональное назначение ИМС. Например, УД – операционный усилитель; ПС – аналоговый перемножитель; ЛА – логический элемент «ИНЕ» ; ЛЕ – логический элемент «ИЛИ-НЕ» ; ЕН – линейный стабилизатор напряжения; ЕП – Импульсный стабилизатор напряжения. Третий элемент - две цифры. Это порядковый номер разработки в данной серии. Четвертый элемент - буква. Она характеризует деление по параметрическим группам. Иногда перед условным обозначением стоит буква «К» , это значит микросхема широкого применения, если буквы нет, то это ИС специального назначения. Иногда перед условным обозначением стоят две буквы – они указывают тип корпуса. Например: КМ – тип корпуса, КР – пластмассовый корпус, КМ – керамо-металлический, КЕ – металло-полимерный: КМ 155 ЛА 3
 Основные технологические процессы • Окисление поверхности полупроводника. При нагревании пластины полупроводника, например, из кремния, на поверхности пластины образуется пленка двуокиси кремния Si. O 2. Она является хорошим диэлектриком, а поэтому широко применяется для защиты кристалла и для изоляции выводов (рис. 9. la), а также в качестве маски, сквозь отверстия которой осуществляется локальная диффузия примеси для создания областей с различными типами проводимости (рис. 9. 16). • Фотолитография — процесс фотопечати, который используется для формирования заданного рисунка топологии ИМС, расположения и конфигурации отверстий, которые затем будут изготовлены в окисной плёнке. На поверхность окисла наносится тонкий слой светочувствительного материала — фоторезиста. На фоторезист укладывается фотошаблон (стеклянная пластина с рисунком). После экспонирования и проявления засвеченные участки позитивного фоторезиста (или незасвеченные негативного) легко удаляются. Через полученные окна протравливаются отверстия нужной конфигурации в окисной пленке, через которые можно вводить донорные и акцепторные примеси для создания n- и р -областей внутри кристалла. • Диффузия примесей — процесс легирования полупроводника донорами или акцепторами в заданной концентрации и на нужную глубину. Плотность диффундирующих атомов: • П = — Dgrad. N (9. 1) • Здесь D — коэффициент диффузии, N — концентрация примеси. При известном значении D глубина диффузии определяется временем процесса: Хо ~ √Dt. Кроме диффузии применяется ионное легирование. Атомы примеси, ионизируются, затем ионный пучок ускоряется и фокусируется подобно тому, как это делается в электронно-лучевых трубках. Недостатком метода является использование специальных вакуумных камер и высоких напряжений (сотни киловольт). Достоинство — хорошая производительность при высокой точности, что особенно важно при изготовлении больших интегральных схем (БИС). • Эпитаксия — процесс выращивания на подложке монокристаллической пленки, которая повторяет кристаллическую структуру подложки. Обычно эпитаксия осуществляется продуванием водорода над поверхностью подложки при высокой температуре (1200' С). При этом происходит реакция Si. Cl 4+ 2 H 2 —> Si+4 HCl, и атомы кремния проникают в узлы кристаллической решетки подложки. В качестве донорных примесей вводят фосфин РН 3 или арсин Аs. Н 3, а в качестве акцепторной примеси — диборан B 2 H 6. Это процесс газового легирования. • Нанесение тонких пленок. Пленочная технология используется для создания контактных площадок, проводников и пленочных пассивных элементов. Тонкими считаются пленки толщиной менее 1 мкм. Пленки должны иметь необходимые электрические свойства и обладать хорошей адгезией к подложке. Процесс нанесения пленок проходит в вакуумной камере, при этом возможны несколько разновидностей процесса. • Термическое испарение осуществляется при нагреве и испарении вещества из твердой или жидкой фазы с последующим осаждением на подложку. • Достоинства метода — быстрота нанесения и чистота полученных пленок; достаток — плохая повторяемость параметров пленки. • Ионное распыление происходит в камере, заполненной разреженным инертным газом при наличии электрического поля. Катодное, ионно-плазменное и высокочастотное напыление имеют особенности, описанные в специальной литературе, но суть состоит в ионной бомбардировке мишени (распыляемого материала) с последующим осаждением выбитых атомов на подложку. Достоинства — хорошая воспроизводимость параметров пленки. • Химическое осаждение из газовой или жидкой фазы позволяет получать пленки в широком диапазоне толщин. Достоинства химического осаждения - простота и технологичность процесса. • Нанесение толстых пленок. Толстые пленки (>1 мкм) наносят продавливанием проводящих или резистивных паст через трафарет с последующим высушиванием и выжиганием. Технология толстых пленок достаточно проста, но точность воспроизведения размеров и параметров, пассивных элементов превышает 20. . . 30%.
Основные технологические процессы • Окисление поверхности полупроводника. При нагревании пластины полупроводника, например, из кремния, на поверхности пластины образуется пленка двуокиси кремния Si. O 2. Она является хорошим диэлектриком, а поэтому широко применяется для защиты кристалла и для изоляции выводов (рис. 9. la), а также в качестве маски, сквозь отверстия которой осуществляется локальная диффузия примеси для создания областей с различными типами проводимости (рис. 9. 16). • Фотолитография — процесс фотопечати, который используется для формирования заданного рисунка топологии ИМС, расположения и конфигурации отверстий, которые затем будут изготовлены в окисной плёнке. На поверхность окисла наносится тонкий слой светочувствительного материала — фоторезиста. На фоторезист укладывается фотошаблон (стеклянная пластина с рисунком). После экспонирования и проявления засвеченные участки позитивного фоторезиста (или незасвеченные негативного) легко удаляются. Через полученные окна протравливаются отверстия нужной конфигурации в окисной пленке, через которые можно вводить донорные и акцепторные примеси для создания n- и р -областей внутри кристалла. • Диффузия примесей — процесс легирования полупроводника донорами или акцепторами в заданной концентрации и на нужную глубину. Плотность диффундирующих атомов: • П = — Dgrad. N (9. 1) • Здесь D — коэффициент диффузии, N — концентрация примеси. При известном значении D глубина диффузии определяется временем процесса: Хо ~ √Dt. Кроме диффузии применяется ионное легирование. Атомы примеси, ионизируются, затем ионный пучок ускоряется и фокусируется подобно тому, как это делается в электронно-лучевых трубках. Недостатком метода является использование специальных вакуумных камер и высоких напряжений (сотни киловольт). Достоинство — хорошая производительность при высокой точности, что особенно важно при изготовлении больших интегральных схем (БИС). • Эпитаксия — процесс выращивания на подложке монокристаллической пленки, которая повторяет кристаллическую структуру подложки. Обычно эпитаксия осуществляется продуванием водорода над поверхностью подложки при высокой температуре (1200' С). При этом происходит реакция Si. Cl 4+ 2 H 2 —> Si+4 HCl, и атомы кремния проникают в узлы кристаллической решетки подложки. В качестве донорных примесей вводят фосфин РН 3 или арсин Аs. Н 3, а в качестве акцепторной примеси — диборан B 2 H 6. Это процесс газового легирования. • Нанесение тонких пленок. Пленочная технология используется для создания контактных площадок, проводников и пленочных пассивных элементов. Тонкими считаются пленки толщиной менее 1 мкм. Пленки должны иметь необходимые электрические свойства и обладать хорошей адгезией к подложке. Процесс нанесения пленок проходит в вакуумной камере, при этом возможны несколько разновидностей процесса. • Термическое испарение осуществляется при нагреве и испарении вещества из твердой или жидкой фазы с последующим осаждением на подложку. • Достоинства метода — быстрота нанесения и чистота полученных пленок; достаток — плохая повторяемость параметров пленки. • Ионное распыление происходит в камере, заполненной разреженным инертным газом при наличии электрического поля. Катодное, ионно-плазменное и высокочастотное напыление имеют особенности, описанные в специальной литературе, но суть состоит в ионной бомбардировке мишени (распыляемого материала) с последующим осаждением выбитых атомов на подложку. Достоинства — хорошая воспроизводимость параметров пленки. • Химическое осаждение из газовой или жидкой фазы позволяет получать пленки в широком диапазоне толщин. Достоинства химического осаждения - простота и технологичность процесса. • Нанесение толстых пленок. Толстые пленки (>1 мкм) наносят продавливанием проводящих или резистивных паст через трафарет с последующим высушиванием и выжиганием. Технология толстых пленок достаточно проста, но точность воспроизведения размеров и параметров, пассивных элементов превышает 20. . . 30%.
 7. 2. Технология изготовления полупроводниковых интегральных схем • • • 7. 2. 1. Подготовительные операции 7. 2. 2. Эпитаксия 7. 2. 3. Термическое окисление 7. 2. 4. Легирование 7. 2. 5. Травление 7. 2. 6. Техника масок
7. 2. Технология изготовления полупроводниковых интегральных схем • • • 7. 2. 1. Подготовительные операции 7. 2. 2. Эпитаксия 7. 2. 3. Термическое окисление 7. 2. 4. Легирование 7. 2. 5. Травление 7. 2. 6. Техника масок
 Подготовительные операции. Производство подложек 1. Монокристаллические слитки полупроводников получают обычно путем кристаллизации из расплава методом Чохральского. В этом методе стержень с затравкой в виде монокристалла после соприкосновения с расплавом медленно поднимают с одновременным вращением. Вслед за затравкой вытягивается нарастающий и застывающий слиток. Кристаллографическая ориентация слитка (его поперечного сечения) определяется кристаллографической ориентацией затравки. Типовой диаметр слитков составляет 80 мм, а максимальный 1, 5 м. 2. Слитки полупроводника разрезают на множество тонких пластин (0, 4… 0, 5 мм) - подложки. 3. Многократно шлифуют, а затем полируют, до уровня сотых долей микрона. 4. Далее поверхности очищают и обезжиривают. Схема выращивания монокристаллов методом Чохральского: 1 – тигель; 2 – расплав полупроводника ; 3 – монокристалл выращиваемого полупроводника; 4 – затравка; 5 – катушка высокочастотного индуктора
Подготовительные операции. Производство подложек 1. Монокристаллические слитки полупроводников получают обычно путем кристаллизации из расплава методом Чохральского. В этом методе стержень с затравкой в виде монокристалла после соприкосновения с расплавом медленно поднимают с одновременным вращением. Вслед за затравкой вытягивается нарастающий и застывающий слиток. Кристаллографическая ориентация слитка (его поперечного сечения) определяется кристаллографической ориентацией затравки. Типовой диаметр слитков составляет 80 мм, а максимальный 1, 5 м. 2. Слитки полупроводника разрезают на множество тонких пластин (0, 4… 0, 5 мм) - подложки. 3. Многократно шлифуют, а затем полируют, до уровня сотых долей микрона. 4. Далее поверхности очищают и обезжиривают. Схема выращивания монокристаллов методом Чохральского: 1 – тигель; 2 – расплав полупроводника ; 3 – монокристалл выращиваемого полупроводника; 4 – затравка; 5 – катушка высокочастотного индуктора
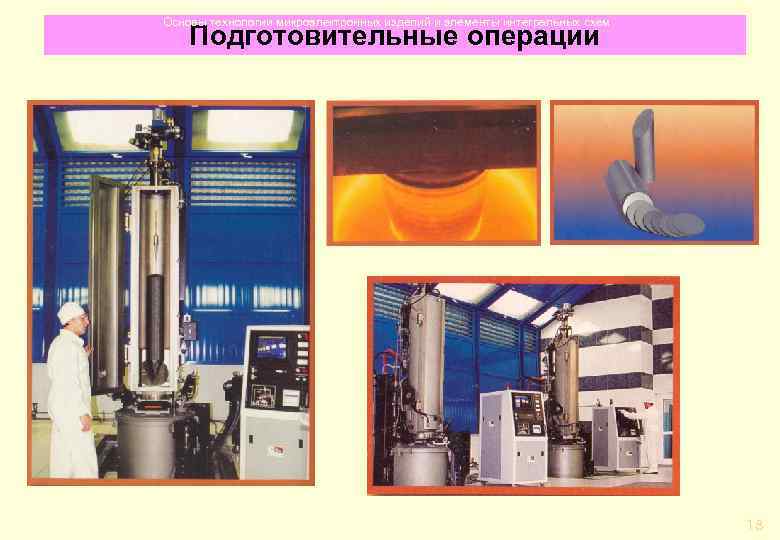 Основы технологии микроэлектронных изделий и элементы интегральных схем Подготовительные операции 18
Основы технологии микроэлектронных изделий и элементы интегральных схем Подготовительные операции 18
 Монокристаллические Эпитаксия кремниевые пластины загружают в тигель и Эпитаксией называют процесс наращивания монокристаллических слоев на подложку, при котором помещают в кварцевую трубу. Через трубу пропускают кристаллографическая ориентация наращиваемого слоя повторяет кристаллографическую ориентацию подложки. поток водорода, содержащий небольшую примесь тетрахлорида кремния. При температуре около 1200 ºС, которая обеспечивается высокочастотным нагревом тигля, на поверхности пластин происходит реакция, в результате которой на подложке постепенно осаждается слой чистого кремния. Если к парам тетрахлорида кремния добавить пары Схема хлоридного процесса эпитаксии: соединений бора или фосфора, 1 – кварцевая труба; то эпитаксиальный слой будет 2 – катушка ВЧ-нагрева; 3 – тигель с пластинами; иметь уже не собственную, а 4 – пластина кремния; соответственно дырочную или 5 – вентиль для перекрытия соответствующего газа; электронную проводимость. 6 – измеритель скорости потока 19
Монокристаллические Эпитаксия кремниевые пластины загружают в тигель и Эпитаксией называют процесс наращивания монокристаллических слоев на подложку, при котором помещают в кварцевую трубу. Через трубу пропускают кристаллографическая ориентация наращиваемого слоя повторяет кристаллографическую ориентацию подложки. поток водорода, содержащий небольшую примесь тетрахлорида кремния. При температуре около 1200 ºС, которая обеспечивается высокочастотным нагревом тигля, на поверхности пластин происходит реакция, в результате которой на подложке постепенно осаждается слой чистого кремния. Если к парам тетрахлорида кремния добавить пары Схема хлоридного процесса эпитаксии: соединений бора или фосфора, 1 – кварцевая труба; то эпитаксиальный слой будет 2 – катушка ВЧ-нагрева; 3 – тигель с пластинами; иметь уже не собственную, а 4 – пластина кремния; соответственно дырочную или 5 – вентиль для перекрытия соответствующего газа; электронную проводимость. 6 – измеритель скорости потока 19
 Примеры эпитаксиальных структур: а – пленка n-типа на n+-подложке; б – пленка р+-типа на n-подложке; в – пленка n-типа на p-подложке
Примеры эпитаксиальных структур: а – пленка n-типа на n+-подложке; б – пленка р+-типа на n-подложке; в – пленка n-типа на p-подложке
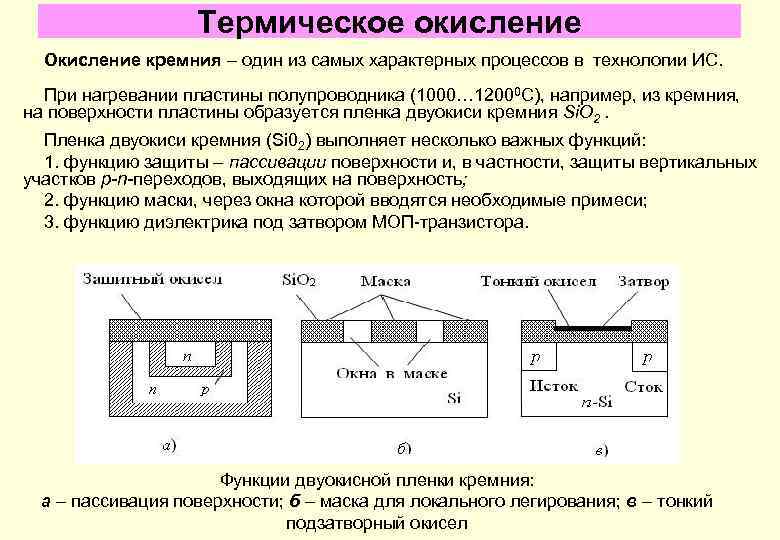 Термическое окисление Окисление кремния – один из самых характерных процессов в технологии ИС. При нагревании пластины полупроводника (1000… 12000 С), например, из кремния, на поверхности пластины образуется пленка двуокиси кремния Si. O 2. Пленка двуокиси кремния (Si 02) выполняет несколько важных функций: 1. функцию защиты – пассивации поверхности и, в частности, защиты вертикальных участков p-n-переходов, выходящих на поверхность; 2. функцию маски, через окна которой вводятся необходимые примеси; 3. функцию диэлектрика под затвором МОП-транзистора. Функции двуокисной пленки кремния: а – пассивация поверхности; б – маска для локального легирования; в – тонкий подзатворный окисел
Термическое окисление Окисление кремния – один из самых характерных процессов в технологии ИС. При нагревании пластины полупроводника (1000… 12000 С), например, из кремния, на поверхности пластины образуется пленка двуокиси кремния Si. O 2. Пленка двуокиси кремния (Si 02) выполняет несколько важных функций: 1. функцию защиты – пассивации поверхности и, в частности, защиты вертикальных участков p-n-переходов, выходящих на поверхность; 2. функцию маски, через окна которой вводятся необходимые примеси; 3. функцию диэлектрика под затвором МОП-транзистора. Функции двуокисной пленки кремния: а – пассивация поверхности; б – маска для локального легирования; в – тонкий подзатворный окисел
 Легирование - внедрение примесей в исходную пластину • 1. Путем диффузии при высокой температуре - основной способ легирования полупроводников с целью создания диодных и транзисторных структур. • Диффузия может быть общей и локальной. В первом случае она осуществляется по всей поверхности пластины, а во втором – на определенных участках пластины через окна в маске. • Диффузию можно проводить однократно и многократно. Например, в исходную пластину nтипа можно во время первой диффузии внедрить акцепторную примесь и получить p-слой, а затем во время второй диффузии внедрить в полученный p-слой на меньшую глубину донорную примесь и тем самым обеспечить трехслойную структуру. • Примеси, вводимые путем диффузии, называют диффузантами. • 2. - ИОННАЯ ИМПЛАНТАЦИЯ • Суть этого метода состоит в бомбардировке подложки ионами примеси с энергией в несколько десятков килоэлектрон-вольт. Необходимую энергию ионы получают при ускорении в электрическом поле ионно-лучевого ускорителя. • Ионная имплантация, так же как диффузия, может быть общей и локальной. В последнем случае бомбардировка проводится через маски. Материалом для масок могут служить двуокись кремния и алюминий. В принципе ионную имплантацию можно проводить многократно. Однако сочетание энергий, времен экспозиции и режимов отжига, необходимое для многократной имплантации, оказывается затрудненным. Поэтому ионная имплантация получила основное распространение при создании тонких одинарных слоев. • Главным преимуществом ионной имплантации является низкая температура процесса и его хорошая контролируемость.
Легирование - внедрение примесей в исходную пластину • 1. Путем диффузии при высокой температуре - основной способ легирования полупроводников с целью создания диодных и транзисторных структур. • Диффузия может быть общей и локальной. В первом случае она осуществляется по всей поверхности пластины, а во втором – на определенных участках пластины через окна в маске. • Диффузию можно проводить однократно и многократно. Например, в исходную пластину nтипа можно во время первой диффузии внедрить акцепторную примесь и получить p-слой, а затем во время второй диффузии внедрить в полученный p-слой на меньшую глубину донорную примесь и тем самым обеспечить трехслойную структуру. • Примеси, вводимые путем диффузии, называют диффузантами. • 2. - ИОННАЯ ИМПЛАНТАЦИЯ • Суть этого метода состоит в бомбардировке подложки ионами примеси с энергией в несколько десятков килоэлектрон-вольт. Необходимую энергию ионы получают при ускорении в электрическом поле ионно-лучевого ускорителя. • Ионная имплантация, так же как диффузия, может быть общей и локальной. В последнем случае бомбардировка проводится через маски. Материалом для масок могут служить двуокись кремния и алюминий. В принципе ионную имплантацию можно проводить многократно. Однако сочетание энергий, времен экспозиции и режимов отжига, необходимое для многократной имплантации, оказывается затрудненным. Поэтому ионная имплантация получила основное распространение при создании тонких одинарных слоев. • Главным преимуществом ионной имплантации является низкая температура процесса и его хорошая контролируемость.
 Легирование - Внедрение примесей в исходную пластину (или в эпитаксиальный слой) путем диффузии при высокой температуре является исходным и до сих пор основным способом легирования полупроводников с целью создания диодных и транзисторных структур Схема двухзонной диффузионной печи: 1 – кварцевая труба; 2 – поток газа-носителя; 3 – источник диффузанта; 4 – пары источника диффузанта; 5 – тигель с пластинами; 6 – пластина кремния; 7 – первая высокотемпературная зона; 8 – вторая высокотемпературная зона
Легирование - Внедрение примесей в исходную пластину (или в эпитаксиальный слой) путем диффузии при высокой температуре является исходным и до сих пор основным способом легирования полупроводников с целью создания диодных и транзисторных структур Схема двухзонной диффузионной печи: 1 – кварцевая труба; 2 – поток газа-носителя; 3 – источник диффузанта; 4 – пары источника диффузанта; 5 – тигель с пластинами; 6 – пластина кремния; 7 – первая высокотемпературная зона; 8 – вторая высокотемпературная зона
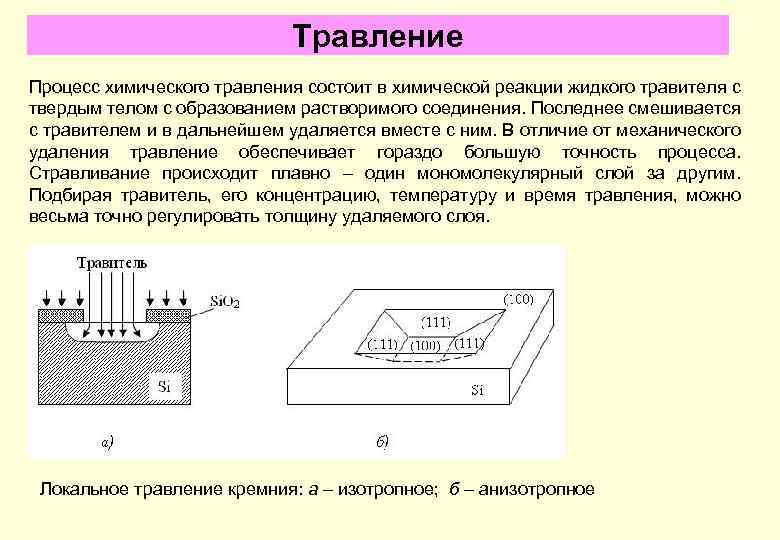 Травление Процесс химического травления состоит в химической реакции жидкого травителя с твердым телом с образованием растворимого соединения. Последнее смешивается с травителем и в дальнейшем удаляется вместе с ним. В отличие от механического удаления травление обеспечивает гораздо большую точность процесса. Стравливание происходит плавно – один мономолекулярный слой за другим. Подбирая травитель, его концентрацию, температуру и время травления, можно весьма точно регулировать толщину удаляемого слоя. Локальное травление кремния: а – изотропное; б – анизотропное
Травление Процесс химического травления состоит в химической реакции жидкого травителя с твердым телом с образованием растворимого соединения. Последнее смешивается с травителем и в дальнейшем удаляется вместе с ним. В отличие от механического удаления травление обеспечивает гораздо большую точность процесса. Стравливание происходит плавно – один мономолекулярный слой за другим. Подбирая травитель, его концентрацию, температуру и время травления, можно весьма точно регулировать толщину удаляемого слоя. Локальное травление кремния: а – изотропное; б – анизотропное
 Фотолитография Техника масок Фотолитография — процесс фотопечати, который используется для формирования заданного рисунка топологии ИМС, расположения и конфигурации отверстий, которые затем будут изготовлены в окисной плёнке. На поверхность окисла наносится тонкий слой светочувствительного материала — фоторезиста. На фоторезист укладывается фотошаблон (стеклянная пластина с рисунком). После экспонирования и проявления засвеченные участки позитивного фоторезиста (или незасвеченные негативного) легко удаляются с помощью травления. Через полученные окна протравливаются отверстия нужной конфигурации в окисной пленке, через которые можно вводить донорные и акцепторные примеси для создания n - и р -областей внутри кристалла. Этапы процесса фотолитографии: а – экспозиция фоторезиста через фотошаблон; б – локальное травление двуокиси кремния через фоторезистную маску; в – окисная маска после удаления фоторезиста
Фотолитография Техника масок Фотолитография — процесс фотопечати, который используется для формирования заданного рисунка топологии ИМС, расположения и конфигурации отверстий, которые затем будут изготовлены в окисной плёнке. На поверхность окисла наносится тонкий слой светочувствительного материала — фоторезиста. На фоторезист укладывается фотошаблон (стеклянная пластина с рисунком). После экспонирования и проявления засвеченные участки позитивного фоторезиста (или незасвеченные негативного) легко удаляются с помощью травления. Через полученные окна протравливаются отверстия нужной конфигурации в окисной пленке, через которые можно вводить донорные и акцепторные примеси для создания n - и р -областей внутри кристалла. Этапы процесса фотолитографии: а – экспозиция фоторезиста через фотошаблон; б – локальное травление двуокиси кремния через фоторезистную маску; в – окисная маска после удаления фоторезиста
 4. 7. ТЕХНИКА МАСОК • В технологии полупроводниковых приборов маски обеспечивают локальный характер напыления, легирования, травления, а в некоторых случаях и эпитаксии. Всякая маска содержит совокупность отверстий – окон. Ведущее место в технологии изготовления масок занимает фотолитография. • В основе фотолитографии лежит использование материалов, которые называют фоторезистами и которые чувствительны к ультрафиолетовому излучению. • Процесс фотолитографии для получения окон в окисной маске, покрывающей поверхность кремниевой пластины, в общих чертах состоит в следующем. • На окисленную поверхность пластины наносят тонкий (1 мкм) слой фоторезиста. Затем накладывают фотошаблон – стеклянную пластину, на одной из сторон которой нанесена тонкая непрозрачная пленка с необходимым рисунком в виде прозрачных отверстий. И экспонируют его в лучах кварцевой лампы. После этого фотошаблон снимают. Далее через фоторезистную маску производится травление окисного слоя вплоть до кремния. После удаления фоторезистной маски конечным итогом фотолитографии оказывается кремниевая пластина, покрытая окисной маской. Через нее можно осуществлять диффузию, ионную имплантацию, травление и т. п.
4. 7. ТЕХНИКА МАСОК • В технологии полупроводниковых приборов маски обеспечивают локальный характер напыления, легирования, травления, а в некоторых случаях и эпитаксии. Всякая маска содержит совокупность отверстий – окон. Ведущее место в технологии изготовления масок занимает фотолитография. • В основе фотолитографии лежит использование материалов, которые называют фоторезистами и которые чувствительны к ультрафиолетовому излучению. • Процесс фотолитографии для получения окон в окисной маске, покрывающей поверхность кремниевой пластины, в общих чертах состоит в следующем. • На окисленную поверхность пластины наносят тонкий (1 мкм) слой фоторезиста. Затем накладывают фотошаблон – стеклянную пластину, на одной из сторон которой нанесена тонкая непрозрачная пленка с необходимым рисунком в виде прозрачных отверстий. И экспонируют его в лучах кварцевой лампы. После этого фотошаблон снимают. Далее через фоторезистную маску производится травление окисного слоя вплоть до кремния. После удаления фоторезистной маски конечным итогом фотолитографии оказывается кремниевая пластина, покрытая окисной маской. Через нее можно осуществлять диффузию, ионную имплантацию, травление и т. п.
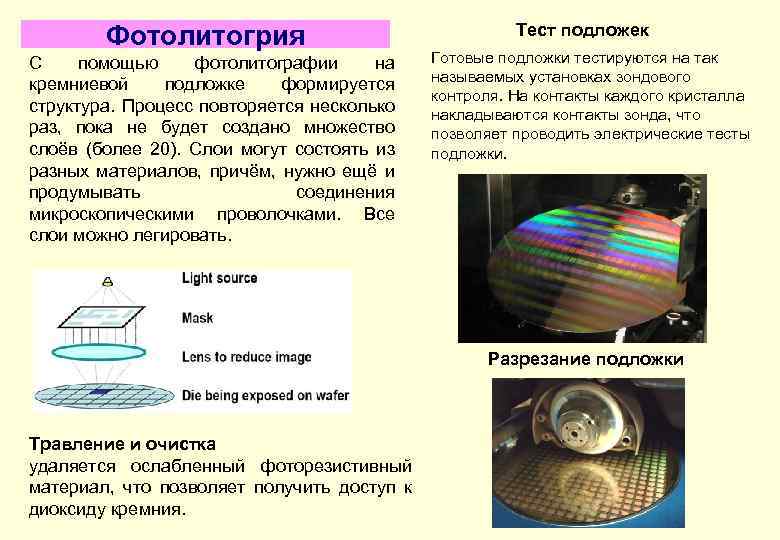 Фотолитогрия С помощью фотолитографии на кремниевой подложке формируется структура. Процесс повторяется несколько раз, пока не будет создано множество слоёв (более 20). Слои могут состоять из разных материалов, причём, нужно ещё и продумывать соединения микроскопическими проволочками. Все слои можно легировать. Тест подложек Готовые подложки тестируются на так называемых установках зондового контроля. На контакты каждого кристалла накладываются контакты зонда, что позволяет проводить электрические тесты подложки. Разрезание подложки Травление и очистка удаляется ослабленный фоторезистивный материал, что позволяет получить доступ к диоксиду кремния.
Фотолитогрия С помощью фотолитографии на кремниевой подложке формируется структура. Процесс повторяется несколько раз, пока не будет создано множество слоёв (более 20). Слои могут состоять из разных материалов, причём, нужно ещё и продумывать соединения микроскопическими проволочками. Все слои можно легировать. Тест подложек Готовые подложки тестируются на так называемых установках зондового контроля. На контакты каждого кристалла накладываются контакты зонда, что позволяет проводить электрические тесты подложки. Разрезание подложки Травление и очистка удаляется ослабленный фоторезистивный материал, что позволяет получить доступ к диоксиду кремния.
 Основы технологии микроэлектронных изделий и элементы интегральных схем Нанесение тонких пленок Схема установки термического напыления Схема установки катодного напыления Основы технологии микроэлектронных изделий. Базовые ячейки аналоговых и цифровых интегральных схем 28
Основы технологии микроэлектронных изделий и элементы интегральных схем Нанесение тонких пленок Схема установки термического напыления Схема установки катодного напыления Основы технологии микроэлектронных изделий. Базовые ячейки аналоговых и цифровых интегральных схем 28
 Основы технологии микроэлектронных изделий и элементы интегральных схем Нанесение тонких пленок Схема установки ионноплазменного напыления 29
Основы технологии микроэлектронных изделий и элементы интегральных схем Нанесение тонких пленок Схема установки ионноплазменного напыления 29
 Металлизация Получение металлической разводки методом фотолитографии Процесс металлизации призван обеспечить омические контакты со слоями полупроводника, соединения и контактные площадки. Основным материалом для металлизации служит алюминий. Он оказался оптимальным в силу малого удельного сопротивления, хорошей адгезии к окислу кремния, возможности сварных контактов, отсутствия коррозии, низкой стоимости. При создании металлической разводки сначала на всю поверхность кристалла напыляют сплошную пленку алюминия толщино около 1 мкм. Эта пленка контактирует со слоями кремния в специально сделанных с помощью фотолитографии окнах в окисле. После очередной процедуры фотолитографии, вытравливания алюминия с незащищенных участков и удаления фоторезиста остается запланированная металлическая разводка. Основы технологии микроэлектронных изделий. Базовые ячейки аналоговых и цифровых интегральных схем 30
Металлизация Получение металлической разводки методом фотолитографии Процесс металлизации призван обеспечить омические контакты со слоями полупроводника, соединения и контактные площадки. Основным материалом для металлизации служит алюминий. Он оказался оптимальным в силу малого удельного сопротивления, хорошей адгезии к окислу кремния, возможности сварных контактов, отсутствия коррозии, низкой стоимости. При создании металлической разводки сначала на всю поверхность кристалла напыляют сплошную пленку алюминия толщино около 1 мкм. Эта пленка контактирует со слоями кремния в специально сделанных с помощью фотолитографии окнах в окисле. После очередной процедуры фотолитографии, вытравливания алюминия с незащищенных участков и удаления фоторезиста остается запланированная металлическая разводка. Основы технологии микроэлектронных изделий. Базовые ячейки аналоговых и цифровых интегральных схем 30
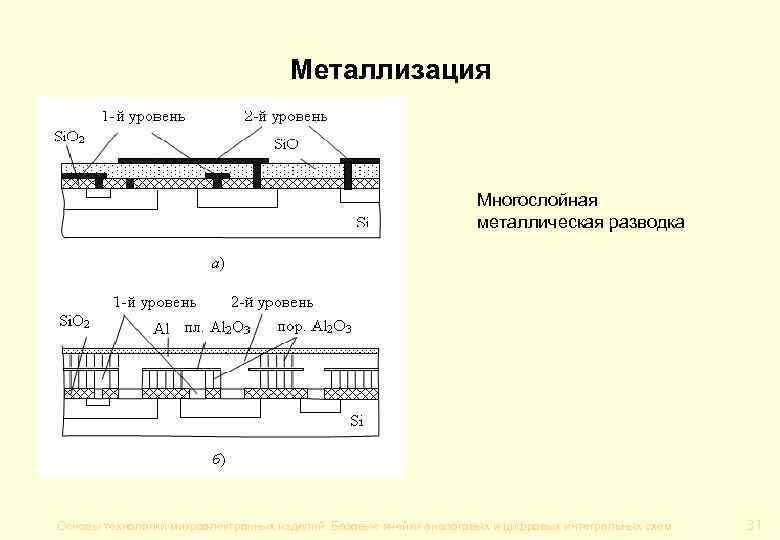 Основы технологии микроэлектронных изделий и элементы интегральных схем Металлизация Многослойная металлическая разводка Основы технологии микроэлектронных изделий. Базовые ячейки аналоговых и цифровых интегральных схем 31
Основы технологии микроэлектронных изделий и элементы интегральных схем Металлизация Многослойная металлическая разводка Основы технологии микроэлектронных изделий. Базовые ячейки аналоговых и цифровых интегральных схем 31
 Основы технологии микроэлектронных изделий и элементы интегральных схем Сборочные операции Основы технологии микроэлектронных изделий. Базовые ячейки аналоговых и цифровых интегральных схем 32
Основы технологии микроэлектронных изделий и элементы интегральных схем Сборочные операции Основы технологии микроэлектронных изделий. Базовые ячейки аналоговых и цифровых интегральных схем 32
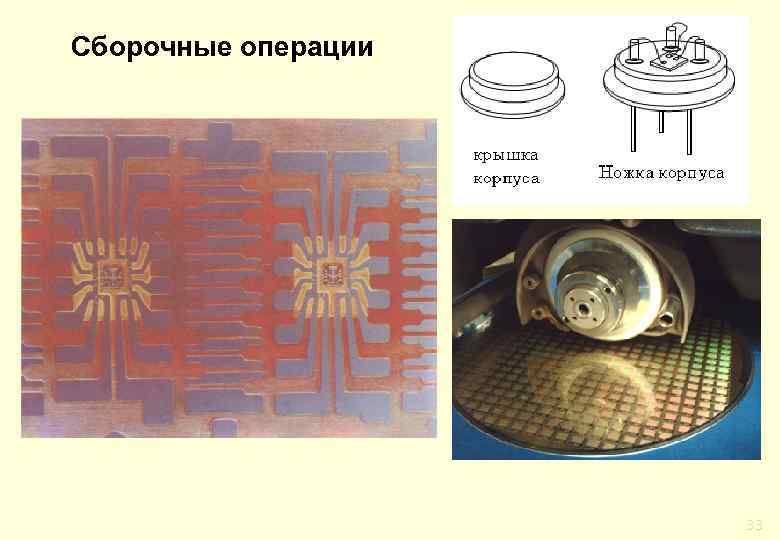 Основы технологии микроэлектронных изделий и элементы интегральных схем Сборочные операции Монтаж кристалла на ножке корпуса 33
Основы технологии микроэлектронных изделий и элементы интегральных схем Сборочные операции Монтаж кристалла на ножке корпуса 33
 ЭЛЕМЕНТЫ ПОЛУПРОВОДНИКОВЫХ МИКРОСХЕМ • Характерной особенностью полупроводниковой интегральной схемы является отсутствие среди ее элементов конденсаторов с большой емкостью, катушек индуктивности и тем более трансформаторов. Это объясняется тем, что до сих пор не удалось использовать в твердом теле какие-либо физические явления, эквивалентные электромагнитной индукции. Поэтому при разработке ИС стараются реализовать необходимую функцию без использования индуктивностей или применяют навесные индуктивные элементы. В качестве резисторов и конденсаторов в полупроводниковых ИС используют соответственно сопротивление и зарядную емкость p-n-перехода, что позволяет обеспечить единый технологический цикл изготовления структур транзисторов, диодов, резисторов и конденсаторов при производстве полупроводниковых ИС. • В настоящее время различают два класса полупроводниковых ИС: • биполярные ИС; • МДП-ИС. • Основной элемент биполярных ИС — n-p-n-транзистор, а МДП-ИС — МДП-транзистор с индуцированным каналом. Все остальные элементы схемы (диоды, резисторы и конденсаторы) изготовляют на базе основного элемента и одновременно с ним.
ЭЛЕМЕНТЫ ПОЛУПРОВОДНИКОВЫХ МИКРОСХЕМ • Характерной особенностью полупроводниковой интегральной схемы является отсутствие среди ее элементов конденсаторов с большой емкостью, катушек индуктивности и тем более трансформаторов. Это объясняется тем, что до сих пор не удалось использовать в твердом теле какие-либо физические явления, эквивалентные электромагнитной индукции. Поэтому при разработке ИС стараются реализовать необходимую функцию без использования индуктивностей или применяют навесные индуктивные элементы. В качестве резисторов и конденсаторов в полупроводниковых ИС используют соответственно сопротивление и зарядную емкость p-n-перехода, что позволяет обеспечить единый технологический цикл изготовления структур транзисторов, диодов, резисторов и конденсаторов при производстве полупроводниковых ИС. • В настоящее время различают два класса полупроводниковых ИС: • биполярные ИС; • МДП-ИС. • Основной элемент биполярных ИС — n-p-n-транзистор, а МДП-ИС — МДП-транзистор с индуцированным каналом. Все остальные элементы схемы (диоды, резисторы и конденсаторы) изготовляют на базе основного элемента и одновременно с ним.
 10. 1. Интегральные транзисторы Транзисторы полупроводниковых ИС имеют ряд особенностей по сравнению с дискретными транзисторами. На рис. 10. 1 показано схематически устройство дискретного, а на рис. 10. 2 интегрального транзисторов. Сравнивая эти рисунки, можно заметить следующие различия. 1. В дискретном транзисторе вывод коллектора сделан снизу, что соответствует направлению движения электронов от эмиттера к коллектору. При изготовлении микросхем используется планарная технология, все выводы оказываются сверху, поэтому путь электронов от активной области коллектора к выводу удлиняется. В результате сопротивление коллектора у интегрального транзистора больше, чем у дискретного, что ухудшает частотные параметры. 2. Другая особенность обусловлена тем, что интегральный транзистор создается на общей подложке с другими элементами микросхемы. Это приводит к тому, помимо основного n-р-n транзистора появляется паразитный р-n-p - транзистор. Из рис. 10. 2 видно, что эмиттером паразитного является база основного (р -область); базой паразитного — коллектор основного транзистора коллектором паразитного — подложка. Эквивалентную схему интегрального транзистора с учетом паразитной структуры можно представить в виде рис. 10. 3 а. вывод коллектора Обычно α паразитного транзистора достаточно мал (а< 0, 1), тогда влиянием паразитного транзистора можно пренебречь и учитывать только влияние емкости Cкп между коллектором и подложкой. . Указанные особенности ухудшают параметры интегрального транзистора.
10. 1. Интегральные транзисторы Транзисторы полупроводниковых ИС имеют ряд особенностей по сравнению с дискретными транзисторами. На рис. 10. 1 показано схематически устройство дискретного, а на рис. 10. 2 интегрального транзисторов. Сравнивая эти рисунки, можно заметить следующие различия. 1. В дискретном транзисторе вывод коллектора сделан снизу, что соответствует направлению движения электронов от эмиттера к коллектору. При изготовлении микросхем используется планарная технология, все выводы оказываются сверху, поэтому путь электронов от активной области коллектора к выводу удлиняется. В результате сопротивление коллектора у интегрального транзистора больше, чем у дискретного, что ухудшает частотные параметры. 2. Другая особенность обусловлена тем, что интегральный транзистор создается на общей подложке с другими элементами микросхемы. Это приводит к тому, помимо основного n-р-n транзистора появляется паразитный р-n-p - транзистор. Из рис. 10. 2 видно, что эмиттером паразитного является база основного (р -область); базой паразитного — коллектор основного транзистора коллектором паразитного — подложка. Эквивалентную схему интегрального транзистора с учетом паразитной структуры можно представить в виде рис. 10. 3 а. вывод коллектора Обычно α паразитного транзистора достаточно мал (а< 0, 1), тогда влиянием паразитного транзистора можно пренебречь и учитывать только влияние емкости Cкп между коллектором и подложкой. . Указанные особенности ухудшают параметры интегрального транзистора.
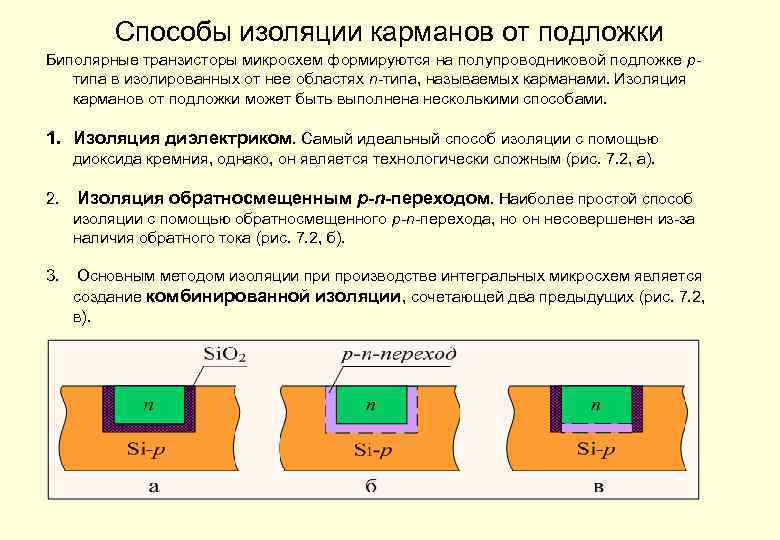 Способы изоляции карманов от подложки Биполярные транзисторы микросхем формируются на полупроводниковой подложке pтипа в изолированных от нее областях n-типа, называемых карманами. Изоляция карманов от подложки может быть выполнена несколькими способами. 1. Изоляция диэлектриком. Самый идеальный способ изоляции с помощью диоксида кремния, однако, он является технологически сложным (рис. 7. 2, а). 2. Изоляция обратносмещенным p-n-переходом. Наиболее простой способ изоляции с помощью обратносмещенного p-n-перехода, но он несовершенен из-за наличия обратного тока (рис. 7. 2, б). 3. Основным методом изоляции производстве интегральных микросхем является создание комбинированной изоляции, сочетающей два предыдущих (рис. 7. 2, в).
Способы изоляции карманов от подложки Биполярные транзисторы микросхем формируются на полупроводниковой подложке pтипа в изолированных от нее областях n-типа, называемых карманами. Изоляция карманов от подложки может быть выполнена несколькими способами. 1. Изоляция диэлектриком. Самый идеальный способ изоляции с помощью диоксида кремния, однако, он является технологически сложным (рис. 7. 2, а). 2. Изоляция обратносмещенным p-n-переходом. Наиболее простой способ изоляции с помощью обратносмещенного p-n-перехода, но он несовершенен из-за наличия обратного тока (рис. 7. 2, б). 3. Основным методом изоляции производстве интегральных микросхем является создание комбинированной изоляции, сочетающей два предыдущих (рис. 7. 2, в).
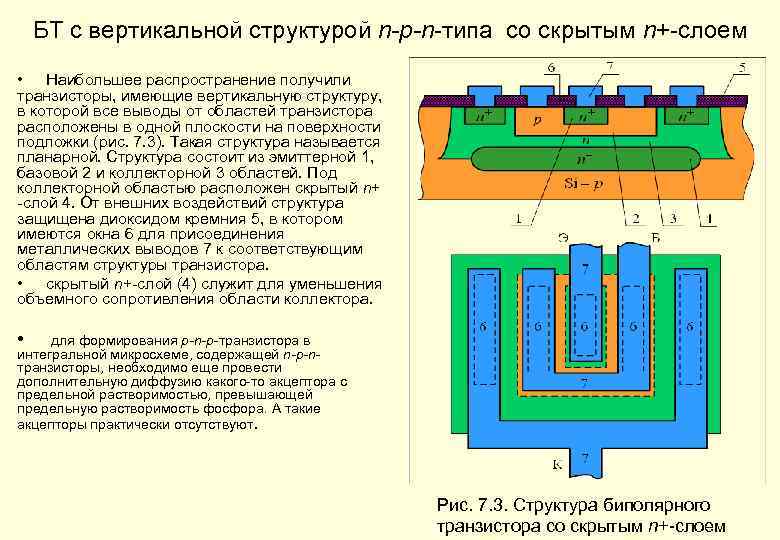 БТ с вертикальной структурой n-p-n-типа со скрытым n+-слоем • Наибольшее распространение получили транзисторы, имеющие вертикальную структуру, в которой все выводы от областей транзистора расположены в одной плоскости на поверхности подложки (рис. 7. 3). Такая структура называется планарной. Структура состоит из эмиттерной 1, базовой 2 и коллекторной 3 областей. Под коллекторной областью расположен скрытый n+ -слой 4. От внешних воздействий структура защищена диоксидом кремния 5, в котором имеются окна 6 для присоединения металлических выводов 7 к соответствующим областям структуры транзистора. • скрытый n+-слой (4) служит для уменьшения объемного сопротивления области коллектора. • для формирования p-n-p-транзистора в интегральной микросхеме, содержащей n-p-nтранзисторы, необходимо еще провести дополнительную диффузию какого-то акцептора с предельной растворимостью, превышающей предельную растворимость фосфора. А такие акцепторы практически отсутствуют. Рис. 7. 3. Структура биполярного транзистора со скрытым n+-слоем
БТ с вертикальной структурой n-p-n-типа со скрытым n+-слоем • Наибольшее распространение получили транзисторы, имеющие вертикальную структуру, в которой все выводы от областей транзистора расположены в одной плоскости на поверхности подложки (рис. 7. 3). Такая структура называется планарной. Структура состоит из эмиттерной 1, базовой 2 и коллекторной 3 областей. Под коллекторной областью расположен скрытый n+ -слой 4. От внешних воздействий структура защищена диоксидом кремния 5, в котором имеются окна 6 для присоединения металлических выводов 7 к соответствующим областям структуры транзистора. • скрытый n+-слой (4) служит для уменьшения объемного сопротивления области коллектора. • для формирования p-n-p-транзистора в интегральной микросхеме, содержащей n-p-nтранзисторы, необходимо еще провести дополнительную диффузию какого-то акцептора с предельной растворимостью, превышающей предельную растворимость фосфора. А такие акцепторы практически отсутствуют. Рис. 7. 3. Структура биполярного транзистора со скрытым n+-слоем
 интегральный транзистор p-n-p-типа Основным приемлемым вариантом интегрального транзистора p-n-p-типа является так называемый горизонтальный или боковой транзистор (рис. 7. 4). Для его формирования не надо вводить дополнительных технологических операций, так как p-области его эмиттера и коллектора получаются одновременно при создании p-области базы транзистора n-p-n-типа. Однако горизонтальный p-n-pтранзистор оказывается бездрейфовым из-за однородного легирования его базовой области – эпитаксиального слоя. Толщина активной части базы горизонтального транзистора получается относительно большой. Все это приводит к посредственным частотным свойствам горизонтального транзистора: его граничная частота не превышает обычно нескольких десятков мегагерц.
интегральный транзистор p-n-p-типа Основным приемлемым вариантом интегрального транзистора p-n-p-типа является так называемый горизонтальный или боковой транзистор (рис. 7. 4). Для его формирования не надо вводить дополнительных технологических операций, так как p-области его эмиттера и коллектора получаются одновременно при создании p-области базы транзистора n-p-n-типа. Однако горизонтальный p-n-pтранзистор оказывается бездрейфовым из-за однородного легирования его базовой области – эпитаксиального слоя. Толщина активной части базы горизонтального транзистора получается относительно большой. Все это приводит к посредственным частотным свойствам горизонтального транзистора: его граничная частота не превышает обычно нескольких десятков мегагерц.
 Многоэмиттерный транзистор • . Многоэмиттерный транзистор — это интегральный элемент, не существовавший в дискретной электронике. • Устройство многоэмиттерного транзистора показано на рис. 10. 4. • В общей базовой области расположены несколько эмиттеров. Базовая р-область имеет отросток, в конце которого сделан вывод базы, находящийся близко к выводу коллектора. Сопротивление базового отростка Rб=150. . . 300 Ом, поэтому р-n-переход между коллектором и основной областью базы соединяется с выводом базы через сопротивление, а р-n-переход между коллектором и отростком базы подключен непосредственно к выводу базы. Такая особенность топологии многоэмиттерного транзистора уменьшает инверсный коэффициент передачи, что оказывается полезным при использовании таких транзисторов в логических схемах. В остальном, многоэмиттерный транзистор подобен сборке из нескольких обычных транзисторов, у которых все коллекторы соединяются в одной точке схемы, все базы — в другой, а эмиттеры имеют отдельные выводы. На рис. 10. 4 знаком «+» отмечены области с повышенной концентрацией примеси. Эквивалентная схема многоэмиттерного транзистора показана рис. 10. 5.
Многоэмиттерный транзистор • . Многоэмиттерный транзистор — это интегральный элемент, не существовавший в дискретной электронике. • Устройство многоэмиттерного транзистора показано на рис. 10. 4. • В общей базовой области расположены несколько эмиттеров. Базовая р-область имеет отросток, в конце которого сделан вывод базы, находящийся близко к выводу коллектора. Сопротивление базового отростка Rб=150. . . 300 Ом, поэтому р-n-переход между коллектором и основной областью базы соединяется с выводом базы через сопротивление, а р-n-переход между коллектором и отростком базы подключен непосредственно к выводу базы. Такая особенность топологии многоэмиттерного транзистора уменьшает инверсный коэффициент передачи, что оказывается полезным при использовании таких транзисторов в логических схемах. В остальном, многоэмиттерный транзистор подобен сборке из нескольких обычных транзисторов, у которых все коллекторы соединяются в одной точке схемы, все базы — в другой, а эмиттеры имеют отдельные выводы. На рис. 10. 4 знаком «+» отмечены области с повышенной концентрацией примеси. Эквивалентная схема многоэмиттерного транзистора показана рис. 10. 5.
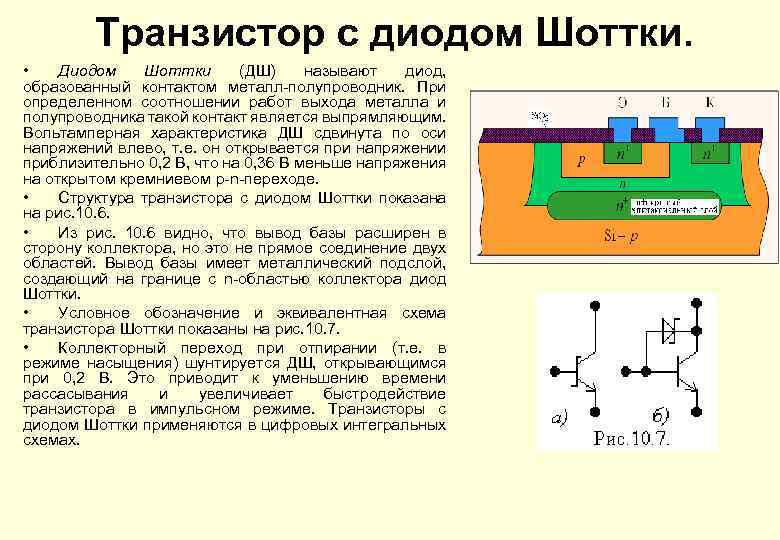 Транзистор с диодом Шоттки. • Диодом Шоттки (ДШ) называют диод, образованный контактом металл-полупроводник. При определенном соотношении работ выхода металла и полупроводника такой контакт является выпрямляющим. Вольтамперная характеристика ДШ сдвинута по оси напряжений влево, т. е. он открывается при напряжении приблизительно 0, 2 В, что на 0, 36 В меньше напряжения на открытом кремниевом р-n-переходе. • Структура транзистора с диодом Шоттки показана на рис. 10. 6. • Из рис. 10. 6 видно, что вывод базы расширен в сторону коллектора, но это не прямое соединение двух областей. Вывод базы имеет металлический подслой, создающий на границе с n-областью коллектора диод Шоттки. • Условное обозначение и эквивалентная схема транзистора Шоттки показаны на рис. 10. 7. • Коллекторный переход при отпирании (т. е. в режиме насыщения) шунтируется ДШ, открывающимся при 0, 2 В. Это приводит к уменьшению времени рассасывания и увеличивает быстродействие транзистора в импульсном режиме. Транзисторы с диодом Шоттки применяются в цифровых интегральных схемах.
Транзистор с диодом Шоттки. • Диодом Шоттки (ДШ) называют диод, образованный контактом металл-полупроводник. При определенном соотношении работ выхода металла и полупроводника такой контакт является выпрямляющим. Вольтамперная характеристика ДШ сдвинута по оси напряжений влево, т. е. он открывается при напряжении приблизительно 0, 2 В, что на 0, 36 В меньше напряжения на открытом кремниевом р-n-переходе. • Структура транзистора с диодом Шоттки показана на рис. 10. 6. • Из рис. 10. 6 видно, что вывод базы расширен в сторону коллектора, но это не прямое соединение двух областей. Вывод базы имеет металлический подслой, создающий на границе с n-областью коллектора диод Шоттки. • Условное обозначение и эквивалентная схема транзистора Шоттки показаны на рис. 10. 7. • Коллекторный переход при отпирании (т. е. в режиме насыщения) шунтируется ДШ, открывающимся при 0, 2 В. Это приводит к уменьшению времени рассасывания и увеличивает быстродействие транзистора в импульсном режиме. Транзисторы с диодом Шоттки применяются в цифровых интегральных схемах.
 Полевые транзисторы ППИС • 7. 1. 3. Полевой транзистор с изолированным затвором. • МДП-транзисторы их можно формировать без специальных островков в монокристалле интегральной микросхемы, что упрощает технологию – уменьшает число технологических операций, удешевляет интегральные микросхемы и дает возможность увеличить плотность упаковки. • Другая особенность и преимущество МДП-транзисторов в качестве активных элементов интегральных микросхем состоит в том, что при нулевом напряжении на затворе МДПтранзистора с индуцированным каналом ток стока практически отсутствует, т. е. мощность транзистором потребляется только во время подачи напряжения на затвор. Это уменьшение потребляемой мощности интегральных микросхем на МДП-транзисторах с индуцированным каналом особенно существенно для создания логических интегральных микросхем. Важным также является то обстоятельство, что цифровые интегральные микросхемы могут быть построены целиком на гальванически соединенных между собой МДПтранзисторах без использования других элементов.
Полевые транзисторы ППИС • 7. 1. 3. Полевой транзистор с изолированным затвором. • МДП-транзисторы их можно формировать без специальных островков в монокристалле интегральной микросхемы, что упрощает технологию – уменьшает число технологических операций, удешевляет интегральные микросхемы и дает возможность увеличить плотность упаковки. • Другая особенность и преимущество МДП-транзисторов в качестве активных элементов интегральных микросхем состоит в том, что при нулевом напряжении на затворе МДПтранзистора с индуцированным каналом ток стока практически отсутствует, т. е. мощность транзистором потребляется только во время подачи напряжения на затвор. Это уменьшение потребляемой мощности интегральных микросхем на МДП-транзисторах с индуцированным каналом особенно существенно для создания логических интегральных микросхем. Важным также является то обстоятельство, что цифровые интегральные микросхемы могут быть построены целиком на гальванически соединенных между собой МДПтранзисторах без использования других элементов.
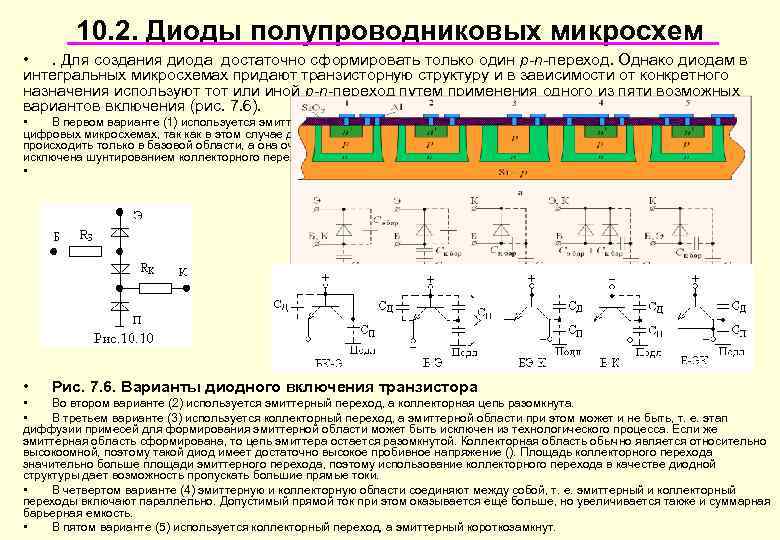 10. 2. Диоды полупроводниковых микросхем • . Для создания диода достаточно сформировать только один p-n-переход. Однако диодам в интегральных микросхемах придают транзисторную структуру и в зависимости от конкретного назначения используют тот или иной p-n-переход путем применения одного из пяти возможных вариантов включения (рис. 7. 6). • В первом варианте (1) используется эмиттерный переход, а коллекторный короткозамкнут. Такое включение используют в цифровых микросхемах, так как в этом случае достигается наибольшее быстродействие: накопление носителей заряда может происходить только в базовой области, а она очень тонкая. Возможность накопления носителей заряда в коллекторной области исключена шунтированием коллекторного перехода. Время переключения может быть около. • • Рис. 7. 6. Варианты диодного включения транзистора • Во втором варианте (2) используется эмиттерный переход, а коллекторная цепь разомкнута. • В третьем варианте (3) используется коллекторный переход, а эмиттерной области при этом может и не быть, т. е. этап диффузии примесей для формирования эмиттерной области может быть исключен из технологического процесса. Если же эмиттерная область сформирована, то цепь эмиттера остается разомкнутой. Коллекторная область обычно является относительно высокоомной, поэтому такой диод имеет достаточно высокое пробивное напряжение (). Площадь коллекторного перехода значительно больше площади эмиттерного перехода, поэтому использование коллекторного перехода в качестве диодной структуры дает возможность пропускать большие прямые токи. • В четвертом варианте (4) эмиттерную и коллекторную области соединяют между собой, т. е. эмиттерный и коллекторный переходы включают параллельно. Допустимый прямой ток при этом оказывается еще больше, но увеличивается также и суммарная барьерная емкость. • В пятом варианте (5) используется коллекторный переход, а эмиттерный короткозамкнут.
10. 2. Диоды полупроводниковых микросхем • . Для создания диода достаточно сформировать только один p-n-переход. Однако диодам в интегральных микросхемах придают транзисторную структуру и в зависимости от конкретного назначения используют тот или иной p-n-переход путем применения одного из пяти возможных вариантов включения (рис. 7. 6). • В первом варианте (1) используется эмиттерный переход, а коллекторный короткозамкнут. Такое включение используют в цифровых микросхемах, так как в этом случае достигается наибольшее быстродействие: накопление носителей заряда может происходить только в базовой области, а она очень тонкая. Возможность накопления носителей заряда в коллекторной области исключена шунтированием коллекторного перехода. Время переключения может быть около. • • Рис. 7. 6. Варианты диодного включения транзистора • Во втором варианте (2) используется эмиттерный переход, а коллекторная цепь разомкнута. • В третьем варианте (3) используется коллекторный переход, а эмиттерной области при этом может и не быть, т. е. этап диффузии примесей для формирования эмиттерной области может быть исключен из технологического процесса. Если же эмиттерная область сформирована, то цепь эмиттера остается разомкнутой. Коллекторная область обычно является относительно высокоомной, поэтому такой диод имеет достаточно высокое пробивное напряжение (). Площадь коллекторного перехода значительно больше площади эмиттерного перехода, поэтому использование коллекторного перехода в качестве диодной структуры дает возможность пропускать большие прямые токи. • В четвертом варианте (4) эмиттерную и коллекторную области соединяют между собой, т. е. эмиттерный и коллекторный переходы включают параллельно. Допустимый прямой ток при этом оказывается еще больше, но увеличивается также и суммарная барьерная емкость. • В пятом варианте (5) используется коллекторный переход, а эмиттерный короткозамкнут.

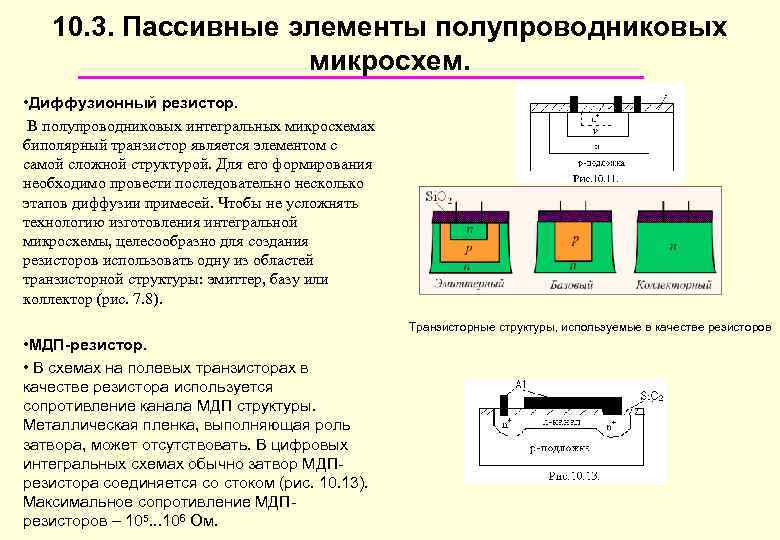 10. 3. Пассивные элементы полупроводниковых микросхем. • Диффузионный резистор. В полупроводниковых интегральных микросхемах биполярный транзистор является элементом с самой сложной структурой. Для его формирования необходимо провести последовательно несколько этапов диффузии примесей. Чтобы не усложнять технологию изготовления интегральной микросхемы, целесообразно для создания резисторов использовать одну из областей транзисторной структуры: эмиттер, базу или коллектор (рис. 7. 8). Транзисторные структуры, используемые в качестве резисторов • МДП-резистор. • В схемах на полевых транзисторах в качестве резистора используется сопротивление канала МДП структуры. Металлическая пленка, выполняющая роль затвора, может отсутствовать. В цифровых интегральных схемах обычно затвор МДПрезистора соединяется со стоком (рис. 10. 13). Максимальное сопротивление МДПрезисторов – 105. . . 106 Ом.
10. 3. Пассивные элементы полупроводниковых микросхем. • Диффузионный резистор. В полупроводниковых интегральных микросхемах биполярный транзистор является элементом с самой сложной структурой. Для его формирования необходимо провести последовательно несколько этапов диффузии примесей. Чтобы не усложнять технологию изготовления интегральной микросхемы, целесообразно для создания резисторов использовать одну из областей транзисторной структуры: эмиттер, базу или коллектор (рис. 7. 8). Транзисторные структуры, используемые в качестве резисторов • МДП-резистор. • В схемах на полевых транзисторах в качестве резистора используется сопротивление канала МДП структуры. Металлическая пленка, выполняющая роль затвора, может отсутствовать. В цифровых интегральных схемах обычно затвор МДПрезистора соединяется со стоком (рис. 10. 13). Максимальное сопротивление МДПрезисторов – 105. . . 106 Ом.
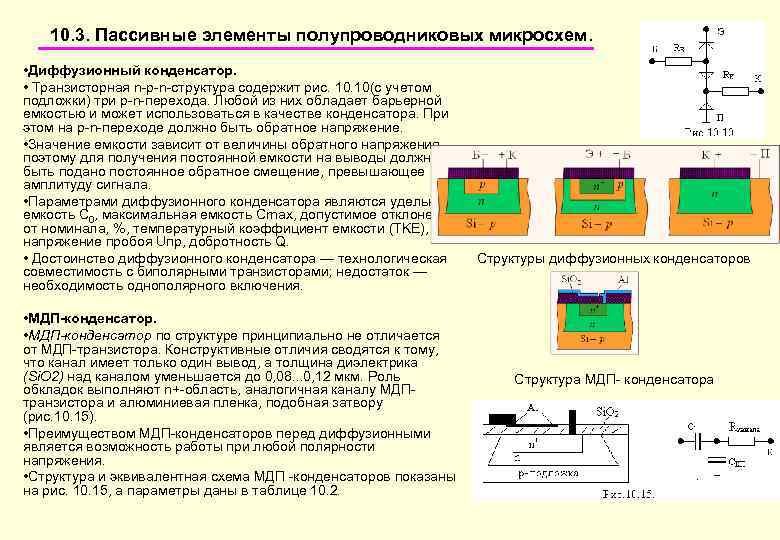 10. 3. Пассивные элементы полупроводниковых микросхем. • Диффузионный конденсатор. • Транзисторная n-р-n-структура содержит рис. 10(с учетом подложки) три р-n-перехода. Любой из них обладает барьерной емкостью и может использоваться в качестве конденсатора. При этом на р-n-переходе должно быть обратное напряжение. • Значение емкости зависит от величины обратного напряжения, поэтому для получения постоянной емкости на выводы должно быть подано постоянное обратное смещение, превышающее амплитуду сигнала. • Параметрами диффузионного конденсатора являются удельная емкость C 0, максимальная емкость Сmax, допустимое отклонение от номинала, %, температурный коэффициент емкости (TKE), напряжение пробоя Uпр, добротность Q. • Достоинство диффузионного конденсатора — технологическая совместимость с биполярными транзисторами; недостаток — необходимость однополярного включения. • МДП-конденсатор по структуре принципиально не отличается от МДП-транзистора. Конструктивные отличия сводятся к тому, что канал имеет только один вывод, а толщина диэлектрика (Si. O 2) над каналом уменьшается до 0, 08. . . 0, 12 мкм. Роль обкладок выполняют n+-область, аналогичная каналу МДПтранзистора и алюминиевая пленка, подобная затвору (рис. 10. 15). • Преимуществом МДП-конденсаторов перед диффузионными является возможность работы при любой полярности напряжения. • Структура и эквивалентная схема МДП -конденсаторов показаны на рис. 10. 15, а параметры даны в таблице 10. 2. Структуры диффузионных конденсаторов Структура МДП- конденсатора
10. 3. Пассивные элементы полупроводниковых микросхем. • Диффузионный конденсатор. • Транзисторная n-р-n-структура содержит рис. 10(с учетом подложки) три р-n-перехода. Любой из них обладает барьерной емкостью и может использоваться в качестве конденсатора. При этом на р-n-переходе должно быть обратное напряжение. • Значение емкости зависит от величины обратного напряжения, поэтому для получения постоянной емкости на выводы должно быть подано постоянное обратное смещение, превышающее амплитуду сигнала. • Параметрами диффузионного конденсатора являются удельная емкость C 0, максимальная емкость Сmax, допустимое отклонение от номинала, %, температурный коэффициент емкости (TKE), напряжение пробоя Uпр, добротность Q. • Достоинство диффузионного конденсатора — технологическая совместимость с биполярными транзисторами; недостаток — необходимость однополярного включения. • МДП-конденсатор по структуре принципиально не отличается от МДП-транзистора. Конструктивные отличия сводятся к тому, что канал имеет только один вывод, а толщина диэлектрика (Si. O 2) над каналом уменьшается до 0, 08. . . 0, 12 мкм. Роль обкладок выполняют n+-область, аналогичная каналу МДПтранзистора и алюминиевая пленка, подобная затвору (рис. 10. 15). • Преимуществом МДП-конденсаторов перед диффузионными является возможность работы при любой полярности напряжения. • Структура и эквивалентная схема МДП -конденсаторов показаны на рис. 10. 15, а параметры даны в таблице 10. 2. Структуры диффузионных конденсаторов Структура МДП- конденсатора
 ЭЛЕМЕНТЫ ГИБРИДНЫХ МИКРОСХЕМ 11. 1. Пленочные резисторы • Пленочный резистор выполнен в виде пленки из резистивного материала с металлическими контактными площадками на концах (рис. 11. la). На рис. 11. 1 б показаны линейные размеры резистивного слоя. • Сопротивление резистора определяется формулой: • R= L/S (11. 1) • где — объемное удельное сопротивление, L — длина, b — ширина резистopa, S — площадь поперечного сечения. • При заданной технологии глубина h является величиной постоянной, поэтому (11. 1) можно записать в виде: • R= c. Kф (11. 2) • Здесь с= /h - удельное поверхностное сопротивление слоя, измеряемое в омах на квадрат (Ом/. ); Кф - коэффициент формы, численно равный числу квадратов на поверхности резистивного слоя. Заметим, что это не число квадратных мм или см, а минимальное число квадратов, которое можно разместить на поверхности слоя. • Удельное поверхностное сопротивление слоя тонких пленок для некоторых материалов дано в табл. 11. 1. • При расчете топологии резисторов выбирают материал, затем определяют коэффициент формы Кф = R/ c. Если 1< Кф <10, то форма резистора прямоугольная. Выбирая ширину резистора b, находят длину L= Кф b. При этом ширина должна быть не менее минимально допустимой по технологии. • Если Кф > 10, то резистор выполняется в форме меандра или в виде нескольких прямоугольных отрезков, соединенных последовательно перемычками из проводящих пленок, как показано на рис. 11. 2 а. • Кф ‹ 1, форма резистора соответствует рис. 11. 2. , т. е. L‹б. Значения Кф ‹ 0, 1 и Кф› 50 не рекомендуется. • Таблица 11. 1. Материал Удельное поверхностное сопротивление с, Ом/ Диапазон значений, Ом Нихром 300 50… 30 000 Сплав МЛТ-3 М 500 50… 50 000 Кермет 3000… 10 000 1000… 10 000 Тантал 20… 100… 10 000 Сплав РС-3001 1000… 2000 100… 100 000
ЭЛЕМЕНТЫ ГИБРИДНЫХ МИКРОСХЕМ 11. 1. Пленочные резисторы • Пленочный резистор выполнен в виде пленки из резистивного материала с металлическими контактными площадками на концах (рис. 11. la). На рис. 11. 1 б показаны линейные размеры резистивного слоя. • Сопротивление резистора определяется формулой: • R= L/S (11. 1) • где — объемное удельное сопротивление, L — длина, b — ширина резистopa, S — площадь поперечного сечения. • При заданной технологии глубина h является величиной постоянной, поэтому (11. 1) можно записать в виде: • R= c. Kф (11. 2) • Здесь с= /h - удельное поверхностное сопротивление слоя, измеряемое в омах на квадрат (Ом/. ); Кф - коэффициент формы, численно равный числу квадратов на поверхности резистивного слоя. Заметим, что это не число квадратных мм или см, а минимальное число квадратов, которое можно разместить на поверхности слоя. • Удельное поверхностное сопротивление слоя тонких пленок для некоторых материалов дано в табл. 11. 1. • При расчете топологии резисторов выбирают материал, затем определяют коэффициент формы Кф = R/ c. Если 1< Кф <10, то форма резистора прямоугольная. Выбирая ширину резистора b, находят длину L= Кф b. При этом ширина должна быть не менее минимально допустимой по технологии. • Если Кф > 10, то резистор выполняется в форме меандра или в виде нескольких прямоугольных отрезков, соединенных последовательно перемычками из проводящих пленок, как показано на рис. 11. 2 а. • Кф ‹ 1, форма резистора соответствует рис. 11. 2. , т. е. L‹б. Значения Кф ‹ 0, 1 и Кф› 50 не рекомендуется. • Таблица 11. 1. Материал Удельное поверхностное сопротивление с, Ом/ Диапазон значений, Ом Нихром 300 50… 30 000 Сплав МЛТ-3 М 500 50… 50 000 Кермет 3000… 10 000 1000… 10 000 Тантал 20… 100… 10 000 Сплав РС-3001 1000… 2000 100… 100 000
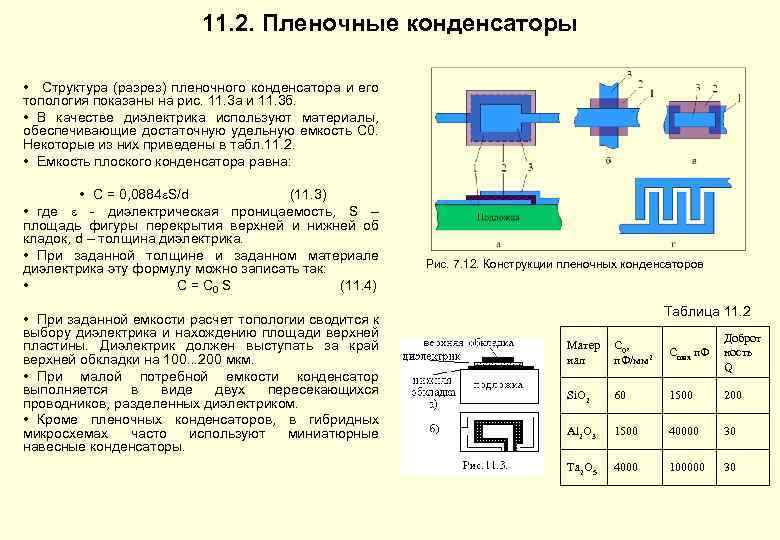 11. 2. Пленочные конденсаторы • Структура (разрез) пленочного конденсатора и его топология показаны на рис. 11. 3 а и 11. 3 б. • В качестве диэлектрика используют материалы, обеспечивающие достаточную удельную емкость С 0. Некоторые из них приведены в табл. 11. 2. • Емкость плоского конденсатора равна: • С = 0, 0884 S/d (11. 3) • где - диэлектрическая проницаемость, S – площадь фигуры перекрытия верхней и нижней об кладок, d – толщина диэлектрика. • При заданной толщине и заданном материале диэлектрика эту формулу можно записать так: • C = C 0 S (11. 4) • При заданной емкости расчет топологии сводится к выбору диэлектрика и нахождению площади верхней пластины. Диэлектрик должен выступать за край верхней обкладки на 100. . . 200 мкм. • При малой потребной емкости конденсатор выполняется в виде двух пересекающихся проводников, разделенных диэлектриком. • Кроме пленочных конденсаторов, в гибридных микросхемах часто используют миниатюрные навесные конденсаторы. Рис. 7. 12. Конструкции пленочных конденсаторов Таблица 11. 2 Матер иал C 0 , п. Ф/мм 2 Сmax п. Ф Доброт ность Q Si. O 2 60 1500 200 Аl 2 O 3 1500 40000 30 Та 2 O 5 4000 100000 30
11. 2. Пленочные конденсаторы • Структура (разрез) пленочного конденсатора и его топология показаны на рис. 11. 3 а и 11. 3 б. • В качестве диэлектрика используют материалы, обеспечивающие достаточную удельную емкость С 0. Некоторые из них приведены в табл. 11. 2. • Емкость плоского конденсатора равна: • С = 0, 0884 S/d (11. 3) • где - диэлектрическая проницаемость, S – площадь фигуры перекрытия верхней и нижней об кладок, d – толщина диэлектрика. • При заданной толщине и заданном материале диэлектрика эту формулу можно записать так: • C = C 0 S (11. 4) • При заданной емкости расчет топологии сводится к выбору диэлектрика и нахождению площади верхней пластины. Диэлектрик должен выступать за край верхней обкладки на 100. . . 200 мкм. • При малой потребной емкости конденсатор выполняется в виде двух пересекающихся проводников, разделенных диэлектриком. • Кроме пленочных конденсаторов, в гибридных микросхемах часто используют миниатюрные навесные конденсаторы. Рис. 7. 12. Конструкции пленочных конденсаторов Таблица 11. 2 Матер иал C 0 , п. Ф/мм 2 Сmax п. Ф Доброт ность Q Si. O 2 60 1500 200 Аl 2 O 3 1500 40000 30 Та 2 O 5 4000 100000 30
 • Технологические процессы: • а) наращивание полупроводникового материала на кремниевой подложке; • б) термическое окисление кремния для получения слоя окисла Si. O 2, • защищающего поверхность кристалла от внешней среды; • в) фотолитография, обеспечивающая требуемые конфигурации • пленок(Si. O 2, металл и т. п. ) на поверхности подложки; • г) локальная диффузия – перенос примесных атомов в ограниченные • области полупроводника (в настоящее время – ионная имплантация • легирующего вещества); • д) напыление тонких (до 1 мкм) пленок; • е) нанесение толстых (более 1 мкм) пленок путем использования • специальных паст с их последующим вжиганием.
• Технологические процессы: • а) наращивание полупроводникового материала на кремниевой подложке; • б) термическое окисление кремния для получения слоя окисла Si. O 2, • защищающего поверхность кристалла от внешней среды; • в) фотолитография, обеспечивающая требуемые конфигурации • пленок(Si. O 2, металл и т. п. ) на поверхности подложки; • г) локальная диффузия – перенос примесных атомов в ограниченные • области полупроводника (в настоящее время – ионная имплантация • легирующего вещества); • д) напыление тонких (до 1 мкм) пленок; • е) нанесение толстых (более 1 мкм) пленок путем использования • специальных паст с их последующим вжиганием.
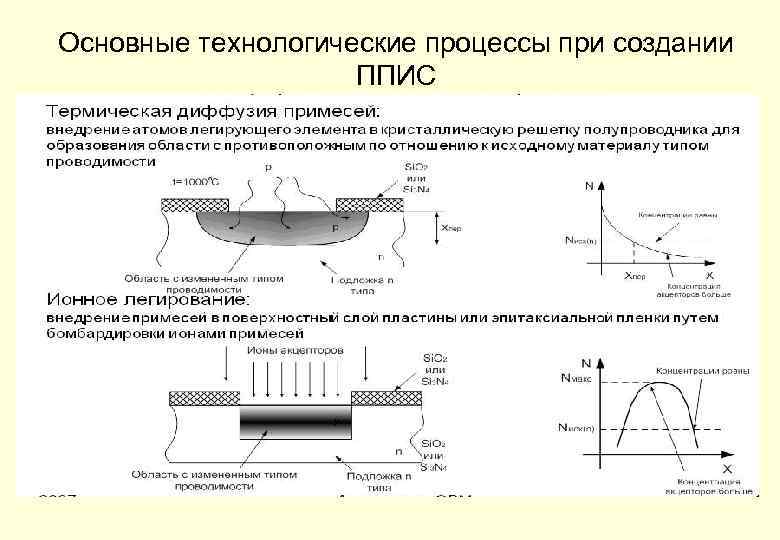 Основные технологические процессы при создании ППИС
Основные технологические процессы при создании ППИС