Anisotropic etching in (100) silicon to form V-grooves

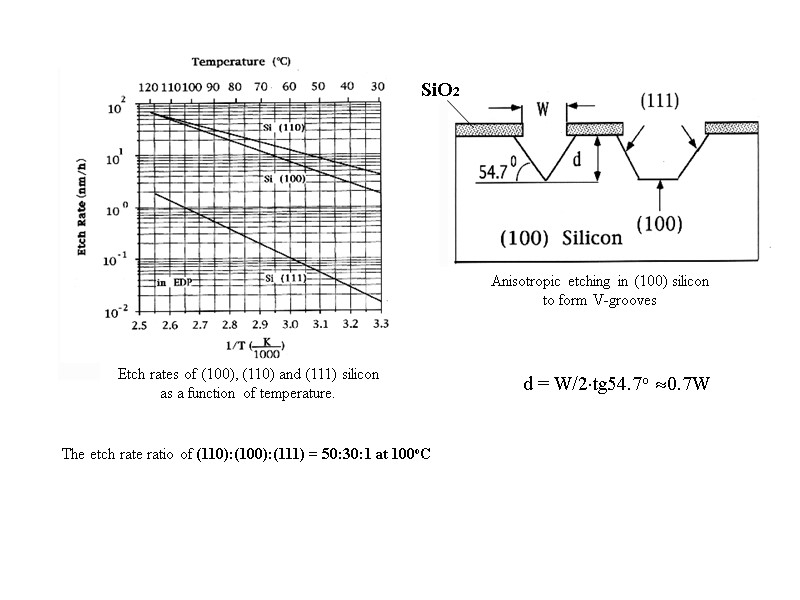

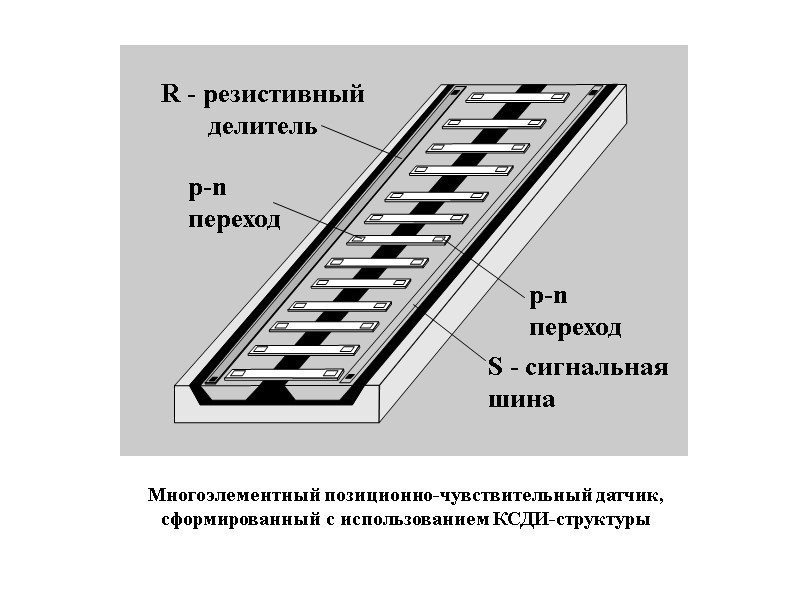
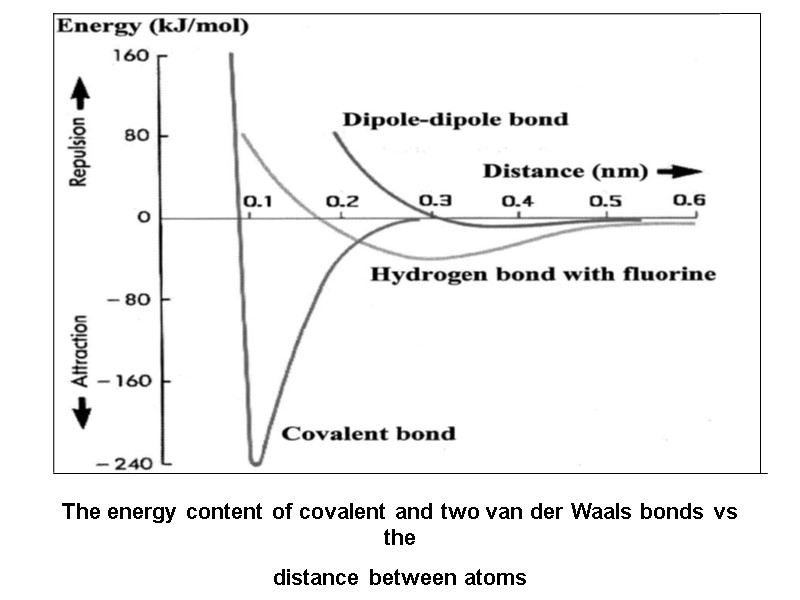

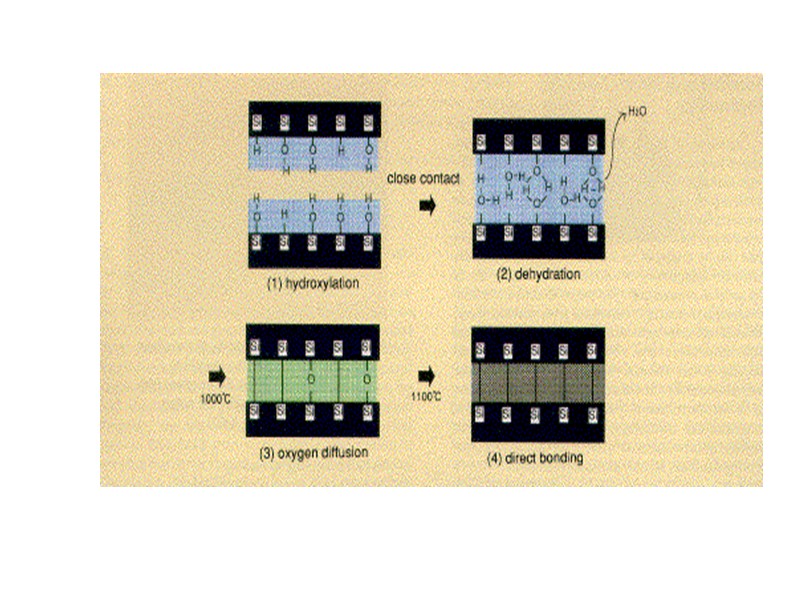

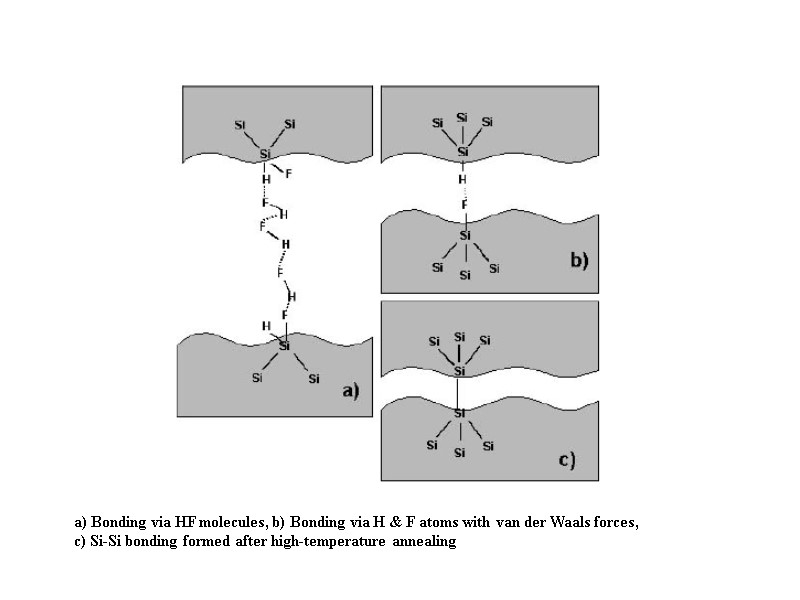



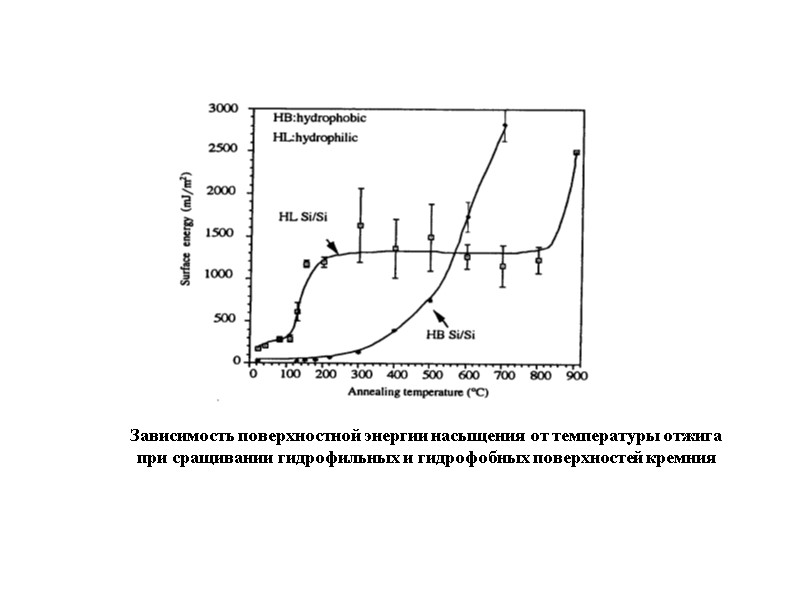

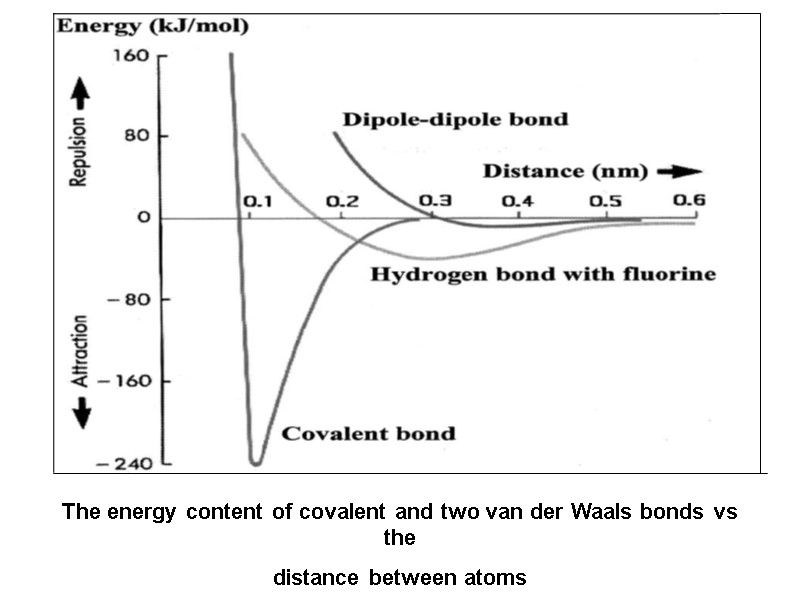


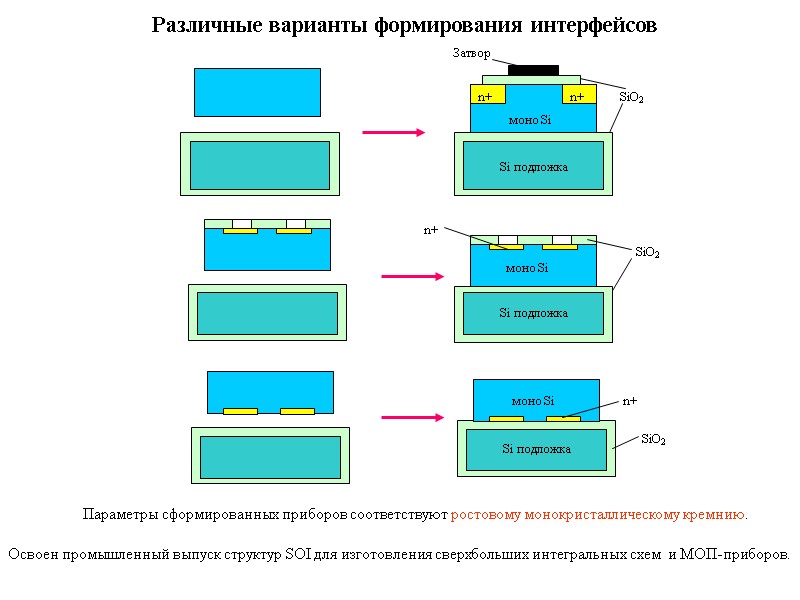
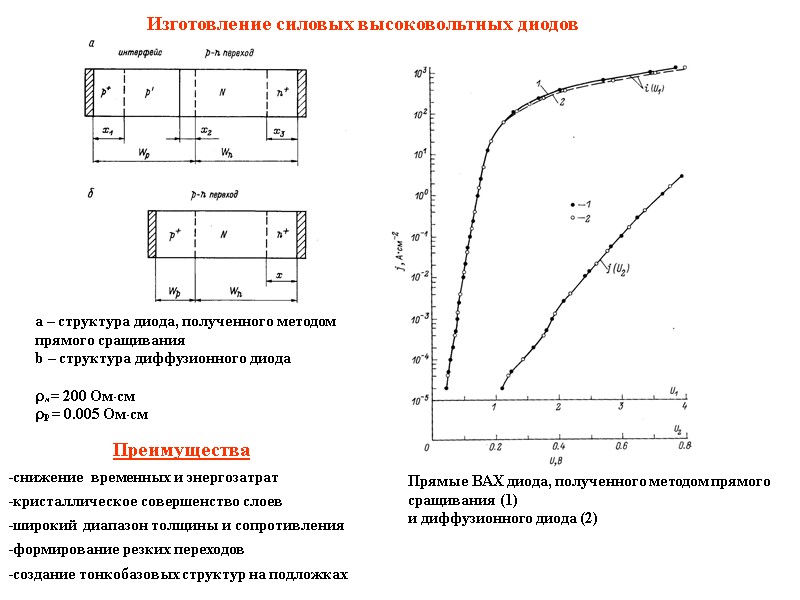

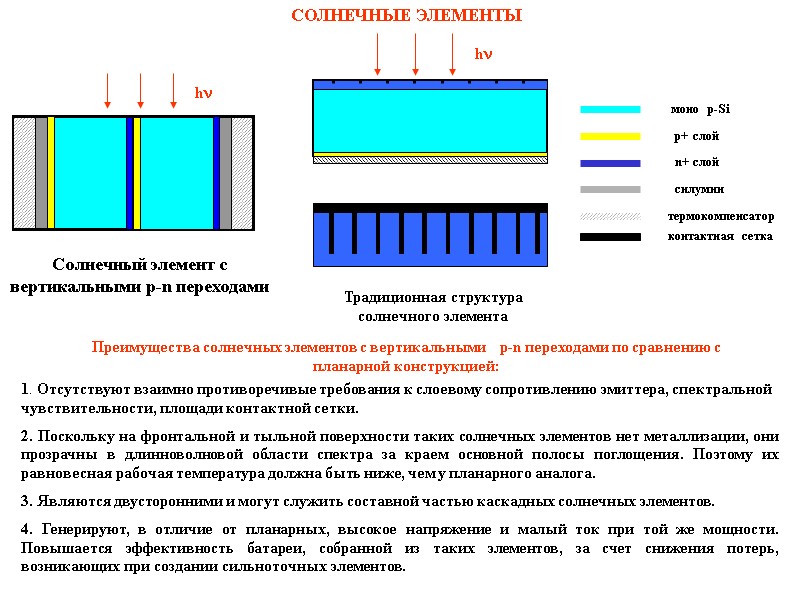
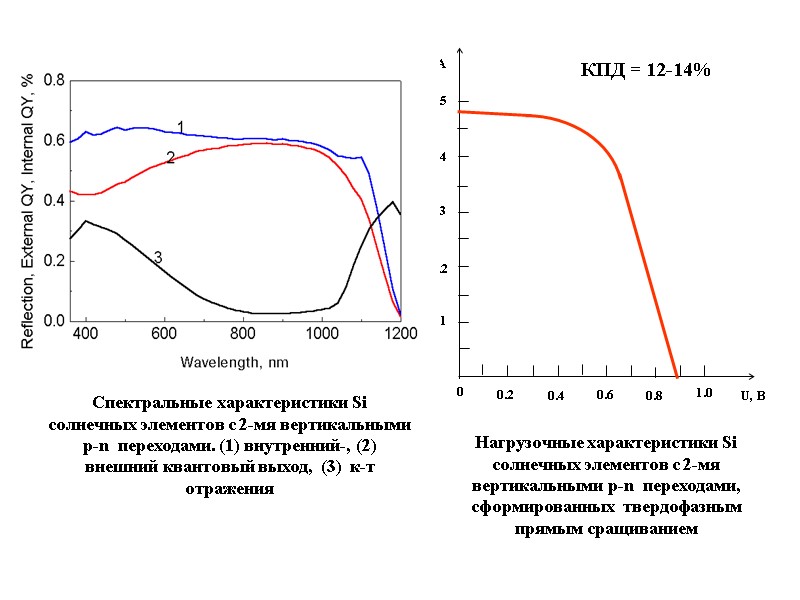


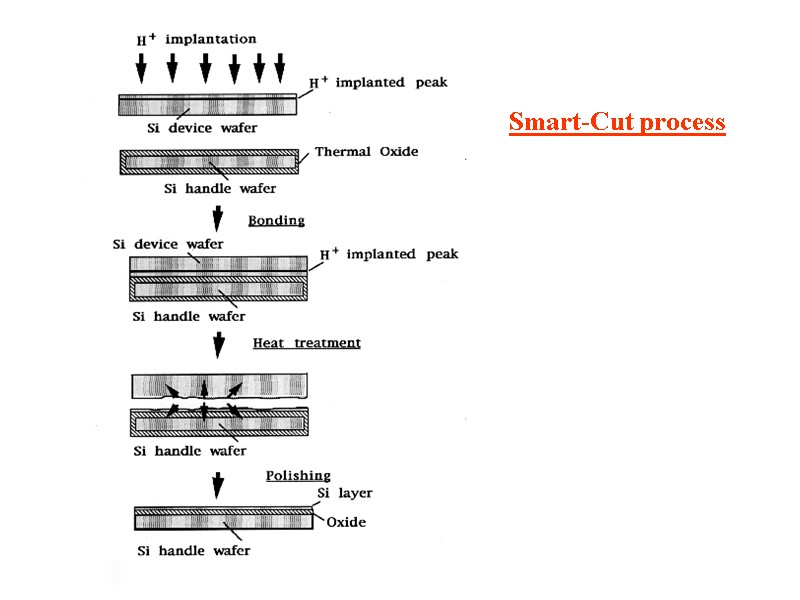



37750-lecture-bonding.ppt
- Количество слайдов: 27
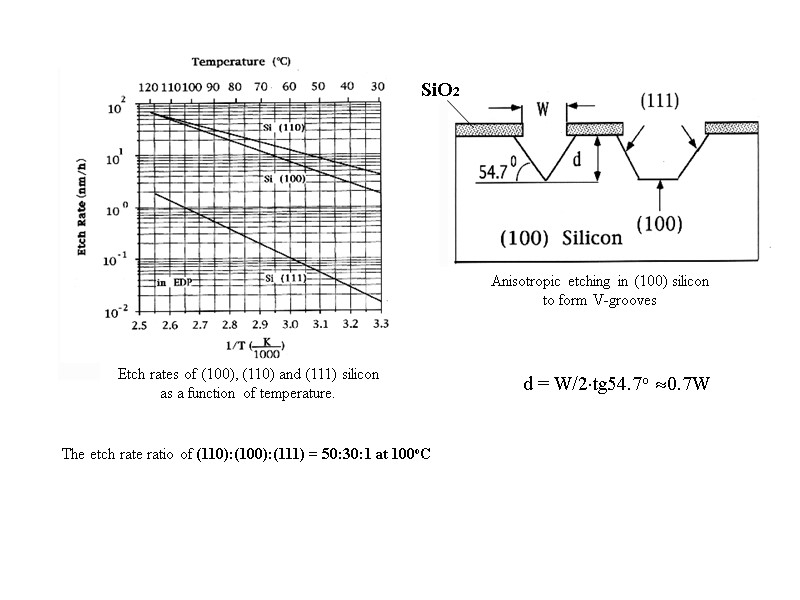 Anisotropic etching in (100) silicon to form V-grooves d = W/2tg54.7o 0.7W SiO2
Anisotropic etching in (100) silicon to form V-grooves d = W/2tg54.7o 0.7W SiO2

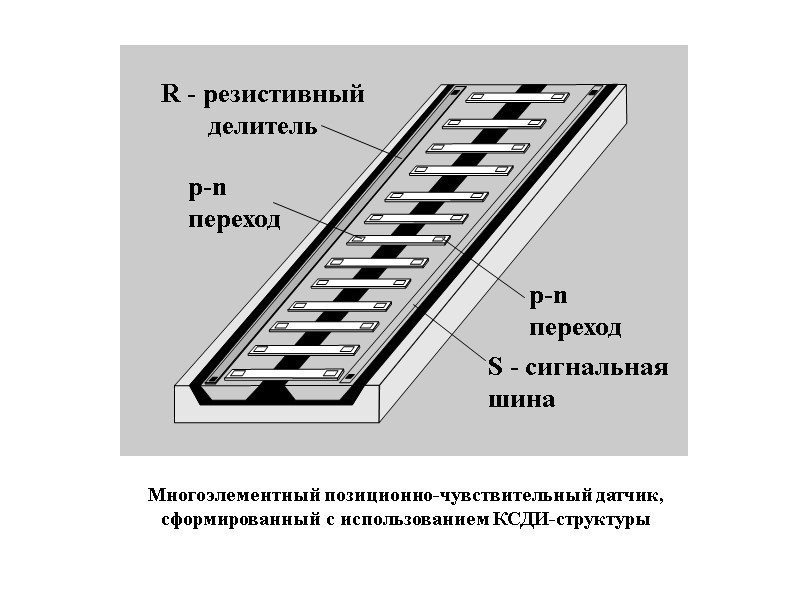
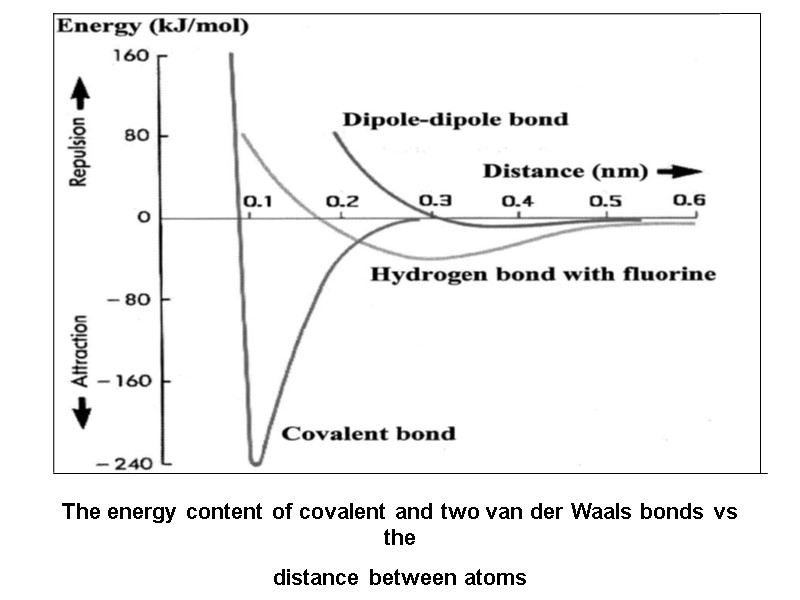
 Si-O-Si (термич.) = 144o Si-O-Si (естествен.) = 130o Частичный перенос электронной плотности Структурированная вода образует «мосты» между пластинами Si
Si-O-Si (термич.) = 144o Si-O-Si (естествен.) = 130o Частичный перенос электронной плотности Структурированная вода образует «мосты» между пластинами Si
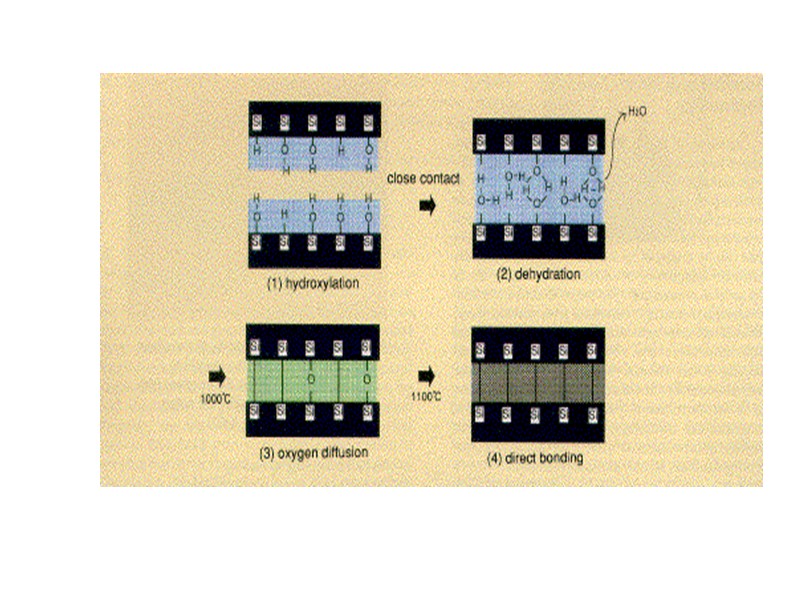
 Гидрофильные поверхности Si-OH 1) Si-OH : (H2O)2 : : (H2O)2 : HO-Si (20 оС) Образования водородных связей между молекулами воды на противоположных поверхностях 2) Si-OH : (H2O)2 : : (H2O)2 : HO-Si Si-OH: :HO-Si + 4 H2O (150 оС) Водородные связи между молекулами воды заменяются на водородные связи между силанольными группами 3) Si-OH: :HO-Si Si-O-Si + H2O (до 800 оС) Водородные связи заменяются более сильными ковалентными, то есть силанольные связи преобразуются в более прочные силоксановые. Однако площадь, на которой произошло сращивание, является ограниченной из-за микро-неоднородностей. 4) Si-O-Si Si-Si + O ( 800 оС) Расширение контактной площади.
Гидрофильные поверхности Si-OH 1) Si-OH : (H2O)2 : : (H2O)2 : HO-Si (20 оС) Образования водородных связей между молекулами воды на противоположных поверхностях 2) Si-OH : (H2O)2 : : (H2O)2 : HO-Si Si-OH: :HO-Si + 4 H2O (150 оС) Водородные связи между молекулами воды заменяются на водородные связи между силанольными группами 3) Si-OH: :HO-Si Si-O-Si + H2O (до 800 оС) Водородные связи заменяются более сильными ковалентными, то есть силанольные связи преобразуются в более прочные силоксановые. Однако площадь, на которой произошло сращивание, является ограниченной из-за микро-неоднородностей. 4) Si-O-Si Si-Si + O ( 800 оС) Расширение контактной площади.
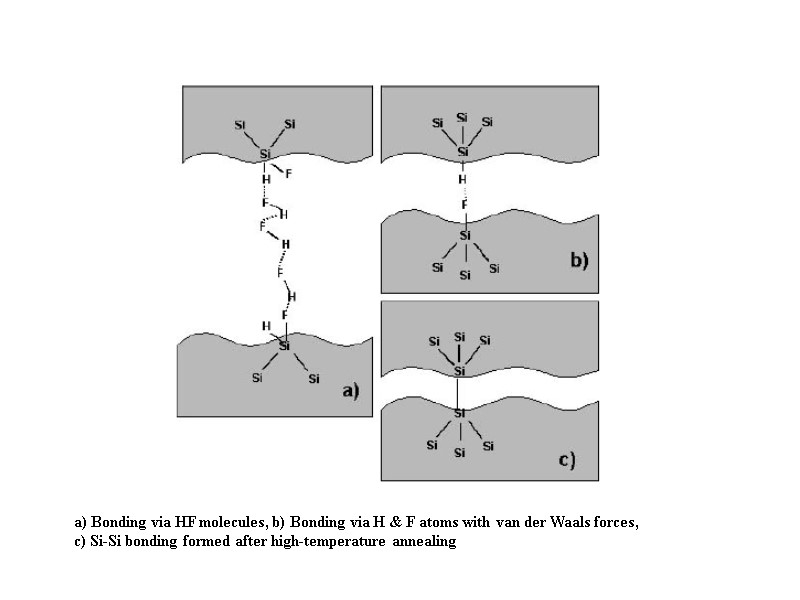 a) Bonding via HF molecules, b) Bonding via H & F atoms with van der Waals forces, c) Si-Si bonding formed after high-temperature annealing
a) Bonding via HF molecules, b) Bonding via H & F atoms with van der Waals forces, c) Si-Si bonding formed after high-temperature annealing
 Гидрофобные поверхности Si-H 1) Формирование водородных связей между молекулами HF, практическое отсутствие каких-либо реакций на поверхности пластин. (20 – 150 оС) 2) Si – H и Si – F связи (150 – 300 оС) Перестройка и десорбция молекул HF на поверхностях пластин, их взаимодействие с поверхностью кремния, приводящее к увеличению плотности водородных связей. 3) Si – H + H – Si Si – Si + H2 (300 – 700 оС) Уход молекул HF и H2 и образование ковалентных Si – Si связей 4) Залечивание микрополостей (>700 оС)
Гидрофобные поверхности Si-H 1) Формирование водородных связей между молекулами HF, практическое отсутствие каких-либо реакций на поверхности пластин. (20 – 150 оС) 2) Si – H и Si – F связи (150 – 300 оС) Перестройка и десорбция молекул HF на поверхностях пластин, их взаимодействие с поверхностью кремния, приводящее к увеличению плотности водородных связей. 3) Si – H + H – Si Si – Si + H2 (300 – 700 оС) Уход молекул HF и H2 и образование ковалентных Si – Si связей 4) Залечивание микрополостей (>700 оС)

 Энергия связи, Поверхностная энергия
Энергия связи, Поверхностная энергия
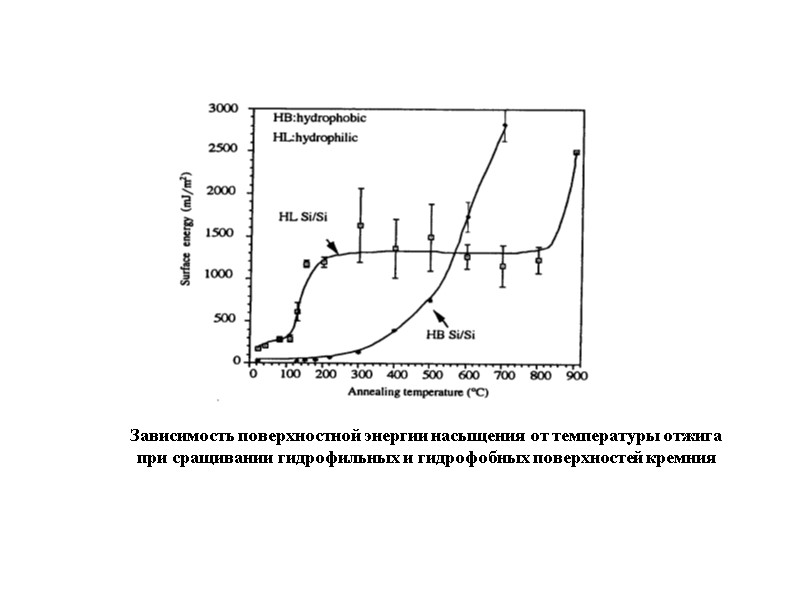
 1. Чистые (грязь, воздух) 2. Ровные (плоскостность) 3. Гладкие (шероховатость) Морфология пластин
1. Чистые (грязь, воздух) 2. Ровные (плоскостность) 3. Гладкие (шероховатость) Морфология пластин
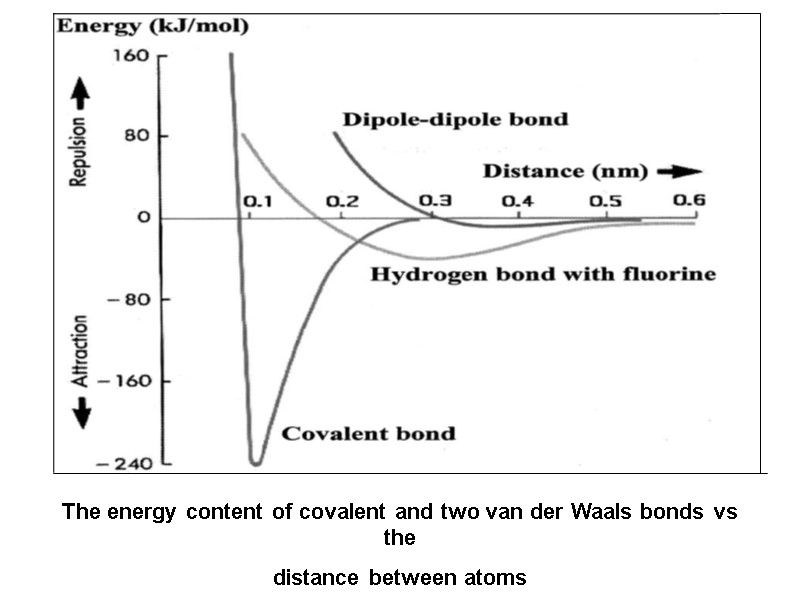
 Методы контроля шероховатости сращиваемых пластин Микроскоп атомных сил Профилометрия а) Контактная (аналог микроскопа атомных сил) в) Бесконтактная (на основе интерферометрии) 3. Контроль посторонних частиц (основан на сканировании поверхности высокоинтенсивным светом и рассеянием света на посторонних частицах)
Методы контроля шероховатости сращиваемых пластин Микроскоп атомных сил Профилометрия а) Контактная (аналог микроскопа атомных сил) в) Бесконтактная (на основе интерферометрии) 3. Контроль посторонних частиц (основан на сканировании поверхности высокоинтенсивным светом и рассеянием света на посторонних частицах)
 Дефекты, загрязнения, SiO2 потенциальный барьер n/n p/p омические ВАХ p-n переходы более жесткие требования
Дефекты, загрязнения, SiO2 потенциальный барьер n/n p/p омические ВАХ p-n переходы более жесткие требования
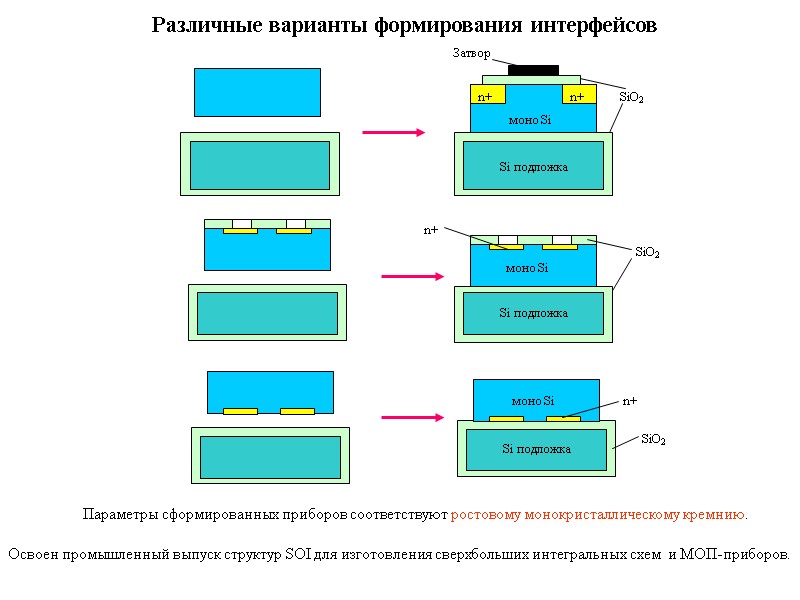 Различные варианты формирования интерфейсов Освоен промышленный выпуск структур SOI для изготовления сверхбольших интегральных схем и МОП-приборов. Параметры сформированных приборов соответствуют ростовому монокристаллическому кремнию.
Различные варианты формирования интерфейсов Освоен промышленный выпуск структур SOI для изготовления сверхбольших интегральных схем и МОП-приборов. Параметры сформированных приборов соответствуют ростовому монокристаллическому кремнию.
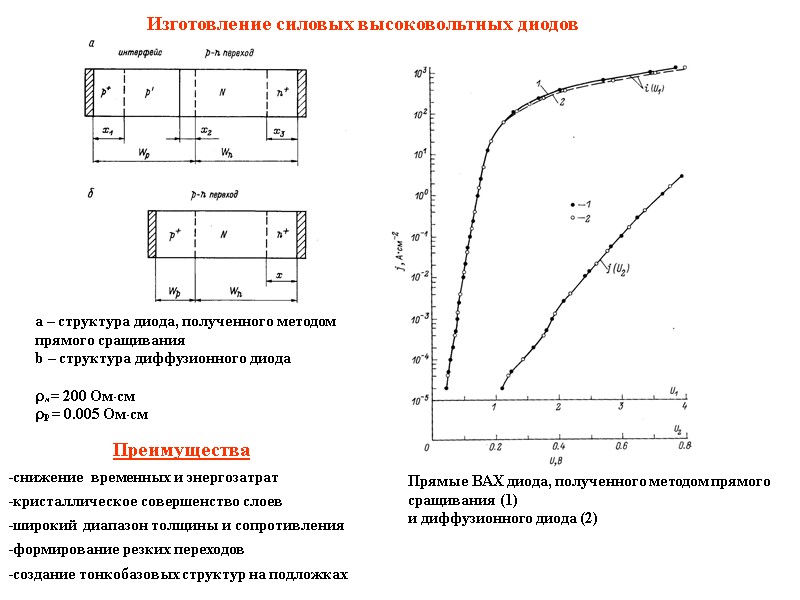

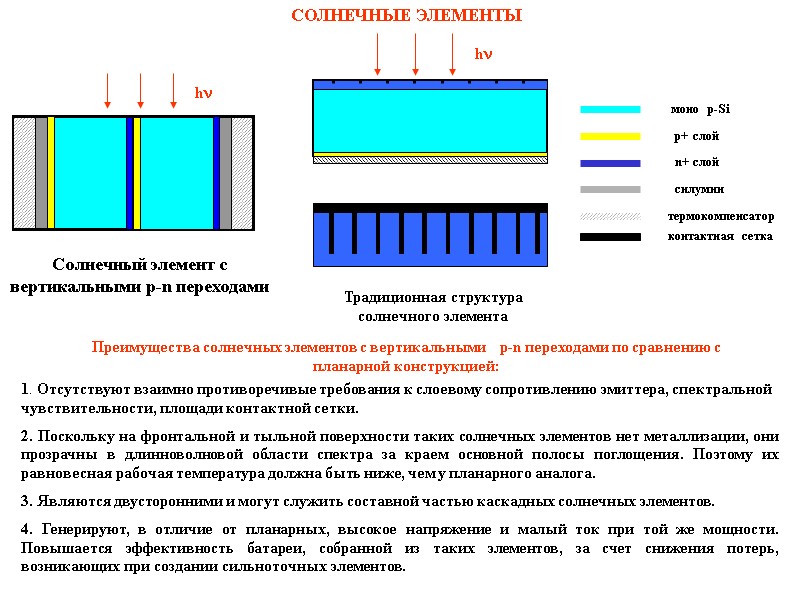
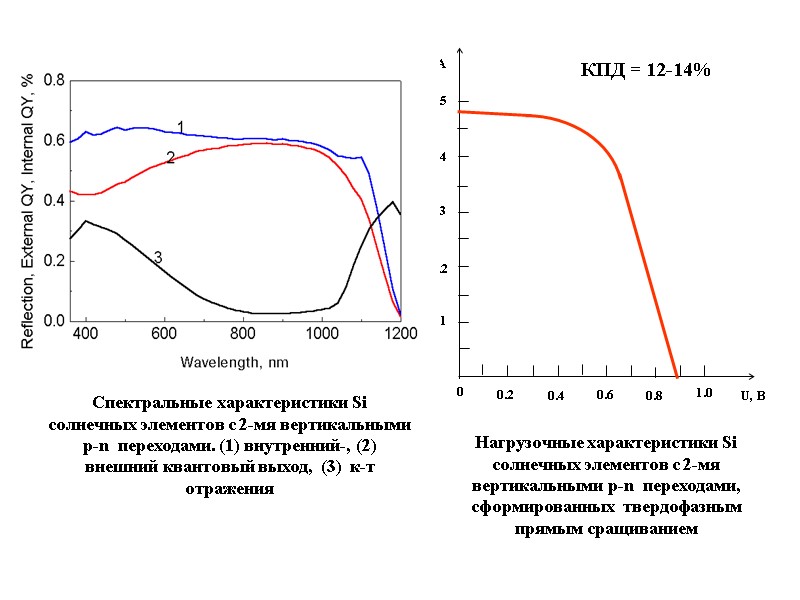

 Smart-Cut process В 1983 г. Предложен способ формирования тонких монокристаллических пленок из кремния и германия, методом «газового скалывания» в процессе термообработки. Основан на следующих основных процессах: Создание с помощью ионной имплантации микроскопических объемных дефектов, содержащих водород; Трансформация посредством термообработки созданных микродефектов в газовые поры, вызывающие объемные изменения легированного слоя; Возникновение напряжений, превышающих предел прочности материала и инициирующих хрупкое скалывание материала вдоль линии проективного пробега ионов. Скалывание тонкого слоя материала подложки по системам макродефектов по всей площади. Послерадиационный отжиг отщепленного слоя, способствующий уничтожению радиационно-индуцированных повреждений.
Smart-Cut process В 1983 г. Предложен способ формирования тонких монокристаллических пленок из кремния и германия, методом «газового скалывания» в процессе термообработки. Основан на следующих основных процессах: Создание с помощью ионной имплантации микроскопических объемных дефектов, содержащих водород; Трансформация посредством термообработки созданных микродефектов в газовые поры, вызывающие объемные изменения легированного слоя; Возникновение напряжений, превышающих предел прочности материала и инициирующих хрупкое скалывание материала вдоль линии проективного пробега ионов. Скалывание тонкого слоя материала подложки по системам макродефектов по всей площади. Послерадиационный отжиг отщепленного слоя, способствующий уничтожению радиационно-индуцированных повреждений.
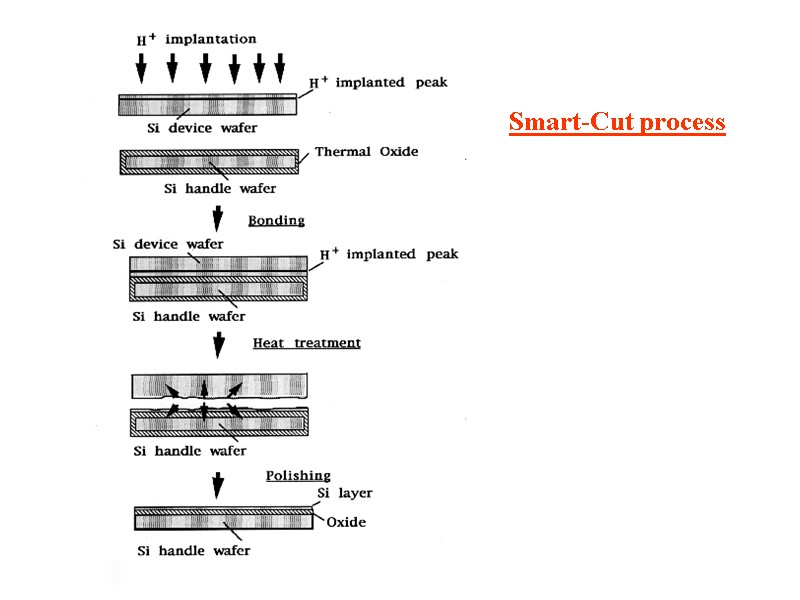 Smart-Cut process
Smart-Cut process
 Промежуточная структура из 10-мкм слоя кремния на кварце для изготовления трехмерной интегральной схемы. 200 мм. Получена в результате Smurt-Cut процесса после удаления кремниевой подложки. H+ implant energy (KeV) Device layer thickness (µm) 10 0.1 50 0.5 100 0.9 150 1.2 200 1.6 500 4.7 1000 13.5 ИЗМЕНЯЯ ЭНЕРГИЮ ИОНОВ МОЖНО ЛЕГКО ВАРЬИРОВАТЬ ТОЛЩИНУ СКАЛЫВАЕМОЙ МОНОКРИСТАЛЛИЧЕСКОЙ ПЛЕНКИ (атомный скальпель)
Промежуточная структура из 10-мкм слоя кремния на кварце для изготовления трехмерной интегральной схемы. 200 мм. Получена в результате Smurt-Cut процесса после удаления кремниевой подложки. H+ implant energy (KeV) Device layer thickness (µm) 10 0.1 50 0.5 100 0.9 150 1.2 200 1.6 500 4.7 1000 13.5 ИЗМЕНЯЯ ЭНЕРГИЮ ИОНОВ МОЖНО ЛЕГКО ВАРЬИРОВАТЬ ТОЛЩИНУ СКАЛЫВАЕМОЙ МОНОКРИСТАЛЛИЧЕСКОЙ ПЛЕНКИ (атомный скальпель)
 Промышленный выпуск слоев 0.1 мкм на подложках 300 мм Использование структур SOI (КНИ) толщиной 30-50 нм для УБИС и одноэлектронных приборов выдвигает очень высокие требования к улучшению свойств границы Si/SiO2 и уменьшению толщины переходного слоя . Метод DeleCut Отличие DeleCut от Smart Cut - перед соединением пластин слой окисла на рабочей пластине стравливается DeleCut Smart Cut DeleCut использует в качестве скрытого диэлектрика термический окисел на необлученной пластине, что обеспечивает ряд преимуществ: - позволяет избежать радиационных повреждений окисла; - граница сращивания практически не имеет переходного слоя, позволяя получать слои кремния до 3-5нм; - позволяет получить электрофизически совершенную границу сращивания
Промышленный выпуск слоев 0.1 мкм на подложках 300 мм Использование структур SOI (КНИ) толщиной 30-50 нм для УБИС и одноэлектронных приборов выдвигает очень высокие требования к улучшению свойств границы Si/SiO2 и уменьшению толщины переходного слоя . Метод DeleCut Отличие DeleCut от Smart Cut - перед соединением пластин слой окисла на рабочей пластине стравливается DeleCut Smart Cut DeleCut использует в качестве скрытого диэлектрика термический окисел на необлученной пластине, что обеспечивает ряд преимуществ: - позволяет избежать радиационных повреждений окисла; - граница сращивания практически не имеет переходного слоя, позволяя получать слои кремния до 3-5нм; - позволяет получить электрофизически совершенную границу сращивания
 ПРИМЕНЯЕТСЯ ПРИ ИЗГОТОВЛЕНИИ: - Сенсоров давления с ультратонкой мембраной - Акселерометров – Датчиков угловой скорости (гироскопов) - 3-х мерных приборов - Микромеханических систем (MEMS) - МОП – транзисторов - Биполярных транзисторов с тонкой базой - Воспроизводимое получение бездефектных слоев различной толщины с минимальным разбросом по удельному сопротивлению и толщине с надежной диэлектрической изоляцией. -Возможность изготовления многослойных композиций, содержащих не только кремний, но и другие полупроводниковые материалы, с целью использования каждого из них при разработке приборов различного назначения (многослойных структур Ge/Si, GexSi(1-x)/Si, тонких монокристаллических слоев А3В5, А2В6, структур Ge на А3В5 и А2В6 др.) РЕЗУЛЬТАТЫ
ПРИМЕНЯЕТСЯ ПРИ ИЗГОТОВЛЕНИИ: - Сенсоров давления с ультратонкой мембраной - Акселерометров – Датчиков угловой скорости (гироскопов) - 3-х мерных приборов - Микромеханических систем (MEMS) - МОП – транзисторов - Биполярных транзисторов с тонкой базой - Воспроизводимое получение бездефектных слоев различной толщины с минимальным разбросом по удельному сопротивлению и толщине с надежной диэлектрической изоляцией. -Возможность изготовления многослойных композиций, содержащих не только кремний, но и другие полупроводниковые материалы, с целью использования каждого из них при разработке приборов различного назначения (многослойных структур Ge/Si, GexSi(1-x)/Si, тонких монокристаллических слоев А3В5, А2В6, структур Ge на А3В5 и А2В6 др.) РЕЗУЛЬТАТЫ

